Анализ тепловых и рекомбинационных потерь фототока в солнечных элементах космических аппаратов
Автор: Ленченко Александр Владимирович, Логинов Юрий Юрьевич, Мозжерин Виктор Макарович
Журнал: Сибирский аэрокосмический журнал @vestnik-sibsau
Рубрика: Математика, механика, информатика
Статья в выпуске: 3 (36), 2011 года.
Бесплатный доступ
Эффективность фотопреобразования света в электрический ток ограничена рекомбинационными, тепловыми и другими потерями энергии в структурах солнечных элементов (СЭ), используемых, в том числе, в космических аппаратах (КА). Уравнения, описывающие потери, уточнены с учетом рассредоточения омических потерь в лицевом слое (ЛС). Впервые проведена оценка тепловых потерь, обусловленных эффектом Пельтье, в контактах электрической цепи СЭ. Обсуждаются также способы минимизации рекомбинационных потерь в ЛС за счет электрического поля контактных зарядов.
Солнечные элементы, фотоны, рекомбинация, фототок
Короткий адрес: https://sciup.org/148176615
IDR: 148176615 | УДК: 538.911,
Analysis of heat and photon recombination losses in solar cells
Photoconversion efficiency of light into electrical current is limited by recombination, thermal and other losses of photon energy in the structures of solar cells, including those used in space vehicles. The equations describing the loss, adjusted the light dispersal ohmic losses in the surface layer. For the first time an assessment of the heat losses due to Peltier effect at the contacts of the circuit of solar cells. The ways to minimize recombination losses in the surface layer due to the electric field of contact charges are discussed.
Текст научной статьи Анализ тепловых и рекомбинационных потерь фототока в солнечных элементах космических аппаратов
Обсудим эту проблему, считая, что именно за счет повышения параметров лицевого слоя можно увеличить КПД СЭ в целом на несколько процентов.
Уравнения баланса. Для расчета вольт-амперной характеристики (ВАХ) СЭ используем следующие уравнения переноса носителей тока:
д j„ A n
4= = gn (x)--, ax T „ djp ( x Ap
— = g p ( x) , a x t p
где j n и j p – потоки электронов и дырок; Δ n и Δ p , g n и g p , τ n и τ p – их неравновесные концентрации, скорости генерации и времена жизни носителей тока, соответственно.
Эти же уравнения могут быть представлены также и в интегральной форме:
Jn = Gn – Rn – Jns ,
Jp = Gp – Rp – Jps, где Jn и Jp – потоки электронов и дырок через p–n+-пе-реход; Jns и Jps – их рекомбинационные потоки на внешней поверхности СЭ (электронов – на тыльный контакт, дырок – на лицевую поверхность); Gn и Gp, Rn и Rp – скорости генерации и рекомбинации электронов в p-базе, дырок – в лицевом n+-слое.
Аналогичные уравнения могут быть записаны и для баланса энергии фотона в структурах СЭ.
Представим его в виде
W = Qa + Qt + Qr + Qp + Qp + J (V+Vk).(4)
Здесь приняты следующие обозначения.
Общий поток энергии излучения в СЭ:
W = E hVGv .(5)
h v> 0
Поток энергии нефотоактивной части излучения:
Qa = E hv Gv .(6)
h
V
Эта часть излучения поглощается в структурах СЭ за счет излучения фотонов, также на тыльных электродах и примесных атомах (ε g – ширина запрещенной зоны).
Кинетическая энергия фоточастиц, термолизация которых приводит к нагреву материала СЭ ( Q T – энергия термолизации):
Qt =E (hv-eg)Gv .(7)
h v>e g
Энергия, выделяемая при рекомбинации неравновесных носителей заряда (ННЗ):
Qr = R ■£g .(8)
Энергия, выделяемая в p – n -переходе:
Qnp = JqVnp,(9)
где V np – высота p – n -перехода в рабочем режиме (рис. 1, 2).
Омические потери в n +-канале:
Ф 0
Q p = J J ( ф ) d Ф , (10)
v где J(ф) - фототок, dф = ф0 - v - падение напряжение в канале освещаемой площадки СЭ до собирающего электрода.
Кроме того, в (4) V – выходное напряжение;
V k – контактная разность потенциалов полупровод-ник–электроды.
Замечая, что согласно (3),
R = G – J , R = R n + R p ,
J = J n + J p + J ps , G = G n + G p , (11)
из уравнений (4)–(8) находим
J e g = Q np + Q p + J(V + V k ) q . (12)
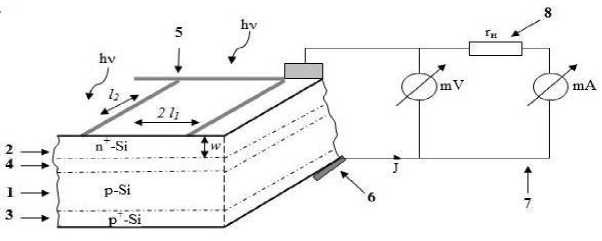
Рис. 1. Фрагмент структуры СЭ, схема измерений ВАХ:
1 – базовая p -область СЭ; 2 – высоколегированный тонкий слой n +-Si; 3 – высоколегированный слой p +-Si; 4 – p – n +-переход; 5 – собирающий электрод; 6 – металлизация тыльного электрода; 7 – электрическая цепь измерения;
8 – нагрузочное сопротивление r н
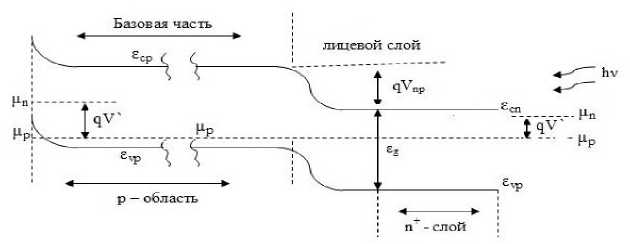
Рис. 2. Зонная структура СЭ в рабочем режиме:
μ n и μ p – уровни Ферми в n +- и p -областях; qv = μ n – μ p ; ε cn – ε vn = ε cp – ε vp = ε g , ε cn – μ n + μ p – ε vp = qV k ; ε cp – ε cn = qV np ; V ′ – падение напряжения во внешней цепи с учетом омических потерь в n +-слое
В режиме холостого хода, когда J = 0 и V = Vхх, имеем Qp = 0 и Qnp = JVnpq и, следовательно, s g = q (Vp + Vk), (13)
где qVn 0 p – высота p – n +-перехода СЭ в термодинамическом равновесии, определяемая уравнением [1]
qV p = kT ln NN- , (14)
ni где q – элементарный заряд; Na, Nd, ni – концентрации соответственных акцепторов в базовой области и доноров в ЛС.
Независимо от того, является ли контакт омическим или нелинейным, при прохождении тока на нем выделяется тепловая энергия, известная как теплота Пельтье:
Q n =n J . (15)
Здесь коэффициент Пельтье (П) может быть оценен по формуле [2] для n -полупроводника:
n n = kT fc + 5 + In — | (16)
q v 2 n )
и подобной формулой для p-полупроводника с заменой «n» на «p» и zn на zp, где zn, zp – плотности состоя- ний электронов и дырок, σ – показатель степени свободного пробега – энергия в тепловых столкновениях носителей тока, σ = – 2 для кремния.
Формула (16) справедлива для невырожденного полупроводника. В нашем случае – для базовой области, в которой концентрация дырок p ≈ 1016 см–3 и kT (
Пp = — I 2 + In -p I,(17)
q V где zp ≈ 1019 см–3 – плотность состояния дырок в кремнии. Получаем Пp ≈ 0,23 В.
Что касается ЛС, то здесь концентрация электронов достигает 1020…1021 см–3 и, следовательно, полупроводник вырожден. Коэффициент Пельтье вырожденного полупроводника отрицателен и мал (П < kT / q ≈ 0,026 В). Тепло выделяется на контактах базы: на тыльном и на границе с p – n +-переходом. Это проявляется в потере напряжения в цепи СЭ порядка П ≈ 0,23 В, что существенно.
Влияние рассредоточенности омических потерь в ЛС на ВАХ СЭ и потери мощности фототока в их структурах. Фототок J(φ) в лицевом слое (ЛС) СЭ возрастает, а напряжение φ падает от середины ЛС. Когда J = 0, а φ = φ0, по направлению к электродам, где ф = V, это описывается дифференциальными уравнениями [3-5]
dJ (Ф) = l j дx 2 Jnp’
дф д x
--p J ( Ф ), I2 W
где 0 < x < I 1 , I 1 - протяженность собирающего канала ( n +-канала ЛС); р - его удельное сопротивление; w - эффективная толщина; 1 2 - протяженность собирающего электрода.
Плотность фототока через p - n -переход здесь обозначена jnp и определяется формулой
С учетом того, что собирающие электроды СЭ имеют П-образный вид, выражения (24) и (25) обобщаются: А Vр ~ eJ-, где в - эмпирический параметр (0,33 < в < 0,5). В этом приближении ф0 = V + АVр и уравнение (20) приводится к виду qv
J = 2 ₽ ( J v+ J 0 ) - J 0 ekTF ( а ), (26)
k- ш . eа-1 где а =---, F (а) ®----- qVp а
В [3; 4; 6] уравнение (26) отличается от нашего тем, что в нем 2в = 1 и F (а) ~ e а.
Тепловые потери фототока непосредственно в p-n+-переходе определяются по формуле q Ф jnp = jv- jо(ek -1). (19)
Ниже
1 ] V +A V p Т / X
Q np =j ( V p -Ф ^ ( ф ) 1 2 dx = J —. (27)
О ' V J ( ф ) -
J np = jnp l 1 1 2 , J v = j v 1 1 1 2 , J 0 = j 0 1 1 1 2 ,
где 1 1 , 1 2 - освещаемая площадь СЭ; jv и j 0 - плотности фото- и обратного темнового токов через p - n +-пе-реход.
Как показано в [5], интегрирование уравнений (18)
В приближении А V р << V оценки Qnp можно производить по более простой формуле
Q » 1 J (V0 - V ). (28)
~ np 2 np^ np
приводит к следующему выражению для в ЛС:
фототока
rJ 2
— = Ф ( Ф 0 ) -Ф ( V );
Что касается рекомбинационных потерь Q R n в базовой области и Q Rp - в ЛС, то их можно определить по формуле (8):
QR n = s g R n = s g ( G n - J n ), QR p = s g ( G p - J p ) (29)
р 1 где - = —- w1 2
—
омическое сопротивление
участка,
или из уравнений
1 n + xn
0 < x < 1 1 - лицевого слоя, а
1 1
’Rn =— A N = — j A n ( x ) dx , T n T n -
irp q ф
Ф ( ф ) = ( J v + J 0 ) ф- — J 0 ( ekT - 1). q
xn xn
Омические потери в n +- канале следует вычислять по формуле
1 1 г , , ,
'Rp = — A P = — f A p ( x ) dx .
T p T p 0
Ф 0
Q p = J J ( ф ) d ф ,
V
Здесь А n ( x ) и А p ( x ) должны быть решениями уравнений (1) и (2) при соответствующих граничных условиях:
в которой так же, как и в (21), потенциал ф0 должен быть определен независимым путем. В частности, из второго уравнения (18) находим ф - V = AVp= J J(x)pdx, (23) 0 12 w где 11, 12 - геометрические параметры n+-канала: р - удельное сопротивление, J(x) - фототок в канале на расстоянии х от середины освещаемой площадки СЭ по направлению к электроду.
В приближении малых омических потерь следует:
J n ( x n + 1 n ) = 0, J n ( x n ) = J nv , J p ( x n ) = J pv , J p (0) = J ps ,
записанных с учетом того, что поток электронов через тыльный контакт практически отсутствует (контакт с изотипным p - p +-переходом), а в ЛС - поток Jps определяется поверхностной рекомбинацией. В приближении Jns = 0 и 1n > Ln решение уравнения (18) известно [7]:
jnv
qg ° а vLn e ~а Ln (1 + f ) ( а vL n + 1) V
f =
а v L n e v n
_ J 2г 1
Q p” — и A V p = - J(V ) - . (24)

Значения для А V р , полученные в [3]:
A V p = 3 J ■ - , J = J ( V ). (25)
При a v 1 n >> 1, f << 1
_ 1 n
G n = qg 0 e "а vxn (1 - eLn ). (34)
Эти выражения совместно с уравнением (29), в ко-qV тором Jn = Jnv + J0n + J0nekT F(а), решают проблему оценок QRn. Что касается потерь QRp = Gp – Jp, то для их оценок необходимо учесть особенности ЛС: наличие в нем тянущего поля и рекомбинации дырок на внешней поверхности ЛС. Ниже мы анализируем Jp, Rs с учетом этих факторов.
Эффект сильного поля в лицевом слое СЭ: влияние его на R-потери и эффективность фотопреобразования ЛС. Тянущее поле в ЛС создается как градиентом доноров:
кт a
E =----ln N d ( x ), (35)
q dx так и внешним источником – контактными зарядами на ПС и в диэлектрике (Ee).
Поток дырок jp имеет две составляющие:
jP = qp ц pE - q— ( D p P ). (36)
d x
Первый член – это дрейфовый поток, второй – диффузионный.
Условием сильного поля в ЛС может служить неравенство
Δ t E << Δ t D , (37)
где Δ tE – дрейфовое время пролета дырок ЛС;
l p q
A tE =---, где lp - толщина ЛС; ц = —D - под-
E цpE p kT p lp2
вижность дырок в ЛС; A tn = —— D 2 Dp
–
диффузионное
время пролета расстояния l p . Из (37) следует
Интегрирование этого уравнения дает
x
A p = - g 0 T p e a v x + Be Х p . (42)
aX- 1
Из граничного условия
d(A p ) n , = 0 при х = L
8x находим:
lp
B = g0T e"vlpeХp(43)
a v Х- 1
и st -(av-/ )lp
Ap (0) = -4^- (1 - e "p ).(44)
a v Х- 1
Поток дырок в p – n -переходе можем определить с помощью уравнения (2) в интегральной форме:
jp (Ip) - jpS (0) + — AФ p = g0 (1 - evlp).(45)
t p
Здесь gaTpXp e^a*ip (1-e)- i-e-^ a v Х-1 V 7 a v Х lp
AO = j A p ( x ) dx ^
. (46)
В результате из (45), (44) и (46) находим jp (lp) = jps (0) + (1 - eV 4, a v Х-1\ a =a v -— . (47)
x„
Уравнение (44) приводит к следующему выражению для j ps (0):
2 D
E >>--- .
Ц p l p
jps
g t ( aX- 1)
Ns a° p
*
1 - e -a plp
Замечая, что D p /μ p ≈ 2,5∙10–2 эВ и учитывая, что l p в СЭ n+–p-Si типов l p ≤ 5∙10–5 см, получаем E >> 103 В/см. Непосредственно в p–n+-переходе E ≥ 105 В/см, а в узком лицевом слое поле на порядок меньше, но условие (38) выполняется. Это означает, что в ЛС перенос дырок осуществляется под действием тянущего поля и поэтому
Из (47) и (48) находим следующее отношение потоков дырок из ЛС на ПС и в n +– p -переход:
p ( l p ) 1 + v в j ps (0) a 0 p N s
Условиями малости рекомбинационных потерь является χ >> 1 или jP = qp Ц pE . (39)
v p =ц p E >>a° p Ns в - 1 . (50)
При этом уравнение (2) с учетом того, что gp (x) = g0eavx, (40)
где α v – коэффициент поглощения света, переписывается в виде
S(Ap) Ap vx vp dx . p g0 e
( v p =Ц p E , Х p =Ц p E t p )•
Обычно Ns ~ 10 '2 ^10 '3 см-2, a p ~ 10 9 ^10 8 см3/с и P - 1 << 1, поэтому ц pE >> 10 3 ^10 5 см/с, что практически реализуется в ЛС современных СЭ.
Минимизация рекомбинационных потерь фототока в ЛС СЭ. Поверхность раздела сред полупроводник–диэлектрик всегда содержит определенное количество поверхностных состояний (ПС), залегающих в запрещенной зоне полупроводника, на которых осуществляется рекомбинация неосновных носителей тока (ННТ). Поверхностная плотность этих состояний Ns и их параметры зависят от физических свойств граничащих сред и дефектного состава поверхности. Рекомбинационный поток ННТ на ПС согласно модели Шокли [1] определяется формулой js jps
« n « p N s ( n P - ^)
« n ( M s + n i ) + a p ( P s + P 1 ) .
Здесь n s и p s – концентрации электронов и дырок у границы раздела сред; α n и α p – коэффициенты (скорости) захвата ННТ на ПС; n 1 и p 1 – параметры ПС:
n i = z n Y ns , P 1 = z p Y ps , ni P 1 = n2
^£ -£ ^ Г £ -£ ^
Yns = exp —---- , Y = exp —s ---u ; (52)
ns kT ps kT zn и zp – плотности состояний электронов в свободной зоне и дырок – в валентной; ni – концентрация носителей тока в собственном полупроводнике; A£s = £c - £s - глубина залегания ПС в запрещенной зоне.
Общепринятой считается модель теплового равновесия носителей тока в объеме и поверхности полупроводника, согласно которой [1]:
n s = n в s , P s = P в - 1 , (53)
о (qфЛ
где в s = exp I---I , ф s — поверхностный потенциал;
V kT J n и p – концентрации электронов и дырок в объеме полупроводника.
Для описания рекомбинации ННТ в ЛС на границе с диэлектриком более справедливой является модель динамического равновесия между электронами в объеме полупроводника и на ПС. Согласно этой модели концентрация электронов на ПС
Nf = Ns (ann +apP1 )
s s a n ( ns + ni ) + a P ( P s + P 1 )
В сильном электрическом поле в ЛС концентрация дырок и скорость их захвата на ПС а 0 в - 1 A p малы и тогда рекомбинационный поток j ns = j ps также будет мал. Как отмечено выше, для создания сильного поля необходимо обеспечить технологию высокого градиента легирующей примеси в ЛС. Обычно градиентное поле E в лицевом слое n +– p -Si СЭ достигает ~103 Вт/см и более. В принципе эффект поля можно усилить за счет контактной разности потенциалов на поверхности полупроводник–поверхностный диэлектрик. Как правило, любой диэлектрик обладает радиоэлектронным эффектом. Под действием ультрафиолетового солнечного излучения в электроде создается электрическое поле с контактным потенциалом Δφ k не менее половины ширины запрещенной зоны диэлектрика; оно может достигать 3…4 эВ при ширине запрещенной зоны диэлектрика 7…9 эВ. При этом на границе полупроводника, где расположен ПС, напряженность электрического поля возрастает до 104…105 В/см. Этого достаточно, чтобы ограничить доступ дырок к ПС.
Более точная оценка контактных полей, зарядов и потенциалов на поверхности ЛС затруднена из-за отсутствия информации об электрофизических свойствах и распределения дефектов у границ раздела сред. Из физических соображений следует, что в ЛС действительно много дефектов. Их образование обусловлено прежде всего тем, что n +-слой представляет собой материал, перенасыщенный фосфором до пределов растворимости ( N d ~ 1020…1021 см–3). Это приводит к распаду раствора с выделением второй фазы с участием атомов кислорода ( N O ≈ 1018 см–3) и частично углерода ( N С ≈ 1017 см–3) и бора ( N B ≈ 1016 см–3). Следует предполагать, что в таком ЛС кроме точечных дефектов (A-центров, Е-центров, акцепторнодонорных пар и других комплексов) образуются также и структурные дефекты. Они обнаруживаются по избыточному току обратно смещенного n +– p -пере-хода СЭ, который на порядок выше теплового тока:
определяет заряд ПС и, следовательно, его потенциал φ s , а скорости захвата α n и α p регулируются высотой потенциального барьера q φ s в соответствии с уравнениями
J изб >> J о = q
п D р D ^ pn pn p
.
L L I
V n p J
a = a0B ,a = a0B 1, nns, p ps,
при этом n s ≡ n и p s ≡ p .
Уравнения (51) и (54) для этого случая приобре-
тают вид
. = . = N s a 0 a P ( nP ~ n 2 )
jns jpS a 0 в s ( n + n i ) + a P в - 1 ( P + P 1 ) ,
f = a0n в s +в-1aPP1
s anвs (n + n1 ) + aPв-1 (P + P1).
В приближении n >> p и Δ p >> p ≥ p 1 , справедливым для ЛС, из (56) имеем
. ~ N s A P ns ~ 2в s
.
Те из структурных дефектов, которые оказываются в области объемного заряда n +– p -перехода, выявляются также с помощью микроплазм, возникающих при повышенном ( V обр > 5 B) обратном напряжении [8].
Все эти дефекты ухудшают электрофизические свойства ЛС: увеличивают омическое сопротивление и уменьшают время жизни ННТ (дырок). Необходима технология ( n +-слоя), которая бы обеспечивала максимальную электропроводность ЛС с максимальным градиентным (тянущим) полем и максимальной контрольной разностью потенциалов (КРП).
В заключение следует отметить, что количественная оценка фотоэлектрической эффективности ЛС может быть произведена по вышеприведенным уравнениям и формулам после уточнения концентрационного и дефектного состава ЛС и ПС, а также изучения
влияния излучения на КРП границы ЛС с диэлектриком. Прежде всего необходимы электронно-микроскопические исследования состава и распределения примесей и дефектов в поперечном сечении ЛС. Очень важной могла быть информация о зависимости электропроводности n +-канала от электрического режима СЭ (в частном от выходного потенциала V ).


