Аномальная термополевая эмиссия с поверхности ZrO2 / W наногетероструктуры
Автор: Птицын В.Э.
Журнал: Научное приборостроение @nauchnoe-priborostroenie
Рубрика: Исследования, приборы, модели и методы анализа
Статья в выпуске: 4 т.16, 2006 года.
Бесплатный доступ
Проведено исследование полевых эмиссионных свойств ZrO2/W наногетероструктуры, образованной тонким (~ 10 нм) слоем ZrO2 на поверхности острийного микрокристалла W. Установлено, что при температуре вещества наногетероструктуры ~ 2000 K процесс эмиссии электронов возбуждается при низких значениях напряженности экстрагирующего (лапласова) поля (менее ~ 50 В/мкм). Показано, что в стационарном режиме электронной эмиссии с поверхности исследованной наногетероструктуры плотность эмиссионного тока может достигать аномально высоких значений (порядка ~ 10^8 А/см^2). Предложена феноменологическая модель обнаруженного явления - аномальной термополевой эмиссии электронов с поверхности наногетероструктур вида проводник (металл)-тонкий слой диэлектрика.
Короткий адрес: https://sciup.org/14264458
IDR: 14264458 | УДК: 537.533.2
Abnormal thermal-field emission from the ZrO2 / W nanoheterostructure surface
The paper presents a study of field emission properties of a ZrO2/W nanoheterostructure formed by a thin (~10 nm) ZrO2 layer at the point W microcrystal surface. It is found that at ~2000 K electron emission in the nanoheterostructure material starts at low extracting (Laplace) field strengths (below ~50 V/mkm). It is shown that in the stationary mode of electron emission from the nanoheterostructure surface, the emission current density may reach abnormally high values (about ~10^8 A/cm^2). A phenomenological model of the revealed effect - abnormal thermal-field electron emission from the surface of the conductor (metal)-thin dielectric layer type heterostructures is offered.
Текст научной статьи Аномальная термополевая эмиссия с поверхности ZrO2 / W наногетероструктуры
Как известно [1, 2], при воздействии на поверхность тугоплавкого металла электрического поля с напряженностью Fe от ~ 3.0 107 В/см до ~ 108 В/см теоретическое значение плотности тока термополевой эмиссии ( J TFE ) может варьироваться в пределах от ~ 104 А/см2 до ~ 109 А/см2. Однако на практике стационарный процесс термополевой эмиссии (TFE) уже при плотностях тока порядка (105–106) А/см2 переходит в нестационарный, т. к. при взаимодействии с веществом сильных электрических полей (более ~ (4–5) 107 В/см) в объеме вещества эмиттера и в его приповерхностном слое развиваются взаимосвязанные нестационарные термополевые процессы, такие как нагрев вещества протекающим током высокой плотности, огранка поверхности вершины микрокристалла эмиттера, термоактивированное испарение атомов, полевая ионизация испаряющихся нейтралей и ионная бомбардировка поверхности вещества эмиттера [3–6]. В этих условиях развивается неустойчивость процесса TFE, которая заканчивается фазовым переходом конденсированного вещества эмиттера в плотную плазму и вакуумным пробоем [5, 6]. (Заметим, что классическое явление термополевой эмиссии в статье обозначается ТЕ).
В силу указанных причин явление TFE практически не применяется для создания высокоинтенсивных стационарных источников электронов. В настоящее время TFE используется только в приборах растровой электронной микроскопии и установках электронной литографии, в которых источником электронов является так называемый Zr/W<100> Шоттки-катод [7]. Однако максимальное стационарное значение плотности тока эмиссии с поверхности Zr/W<100> Шоттки-катодов [7] не превышает ~ 105 А/см2, и соответственно пол- слой диэлектрика.
ный ток эмиссии составляет менее ~ 2.0 10–4 А.
В настоящее время для реализации ряда научно-технологических проектов [8–14] необходимы интенсивные потоки электронов (с токами пучка от ~ 10–3 А до ~ 105 А) и с плотностью тока в потоке ~ (106–107) А/см2. В связи с этим весьма актуальной представляется проблема создания новых высокостабильных источников электронов, эмиссионная способность1) которых существенно (на порядки величины) превосходила бы значения γ существующих TFE-источников электронов [8].
Отметим, что исследования возможностей создания источников электронов с высокой приведенной яркостью γ ведутся уже сравнительно давно [3, 8, 15–18]. В результате проведенных исследований было показано, что полевые эмиссионные свойства низкоразмерных наноструктур (микрокристаллы CdS, алмазоподобные и углеродные пленки, углеродные нанотрубки и др.) обладают высокой эмиссионной способностью в условиях воздействия на вещество указанных наноструктур (НС) электрических полей с относительно низким уровнем пороговой напряженности поля (менее ~ 5.0 105 В/см). Вольтамперные характеристики (ВАХ) вакуумных диодов с полевыми эмиттерами на основе низкоразмерных НС не укладываются в рамки теории TFE. До настоящего времени природа особенностей (или аномалий) полевой эмис- сии с поверхности низкоразмерных НС во многих аспектах остается неясной [18].
В следующих разделах работы приведены новые экспериментальные данные, демонстрирующие возможность формирования наноструктур с аномально высокой эмиссионной способностью, а также предложена модель, позволяющая дать адекватную интерпретацию наблюдающимся аномалиям процесса полевой эмиссии с поверхности низкоразмерных НС.
МЕТОДИКА И РЕЗУЛЬТАТЫ ЭКСПЕРИМЕНТА
Изучались полевые эмиссионные свойства ZrO2/W<100> наногетероструктуры (НГС), образованной слоем ZrO2 на поверхности острийного микрокристалла (МК) W<100>. Исследования проводились для трех "состояний" поверхностного слоя ZrO2 на вершине одного и того же МК W<100>: 1 — атомарно-чистая поверхность вершины МК W<100>; 2 — монослойное покрытие комплексами ZrO2 и 3 — при толщине слоя ZrO2 ~ 10 нм. Описание экспериментальной установки, технология формирования тонких диэлектрических слоев (ZrO 2 ) на поверхности вершины ост-рийного микрокристалла W<100>, а также методика измерений термополевых эмиссионных свойств описаны в работах [19, 20].
Основные экспериментальные результаты показаны на рис. 1-3. Как представляется, содержание полученных результатов вполне понятно из подписей к соответствующим рисункам, на которых N t o — плотность неионизованных локализованных состояний в пленке ZrO 2 . Однако, т. к. на рис. 1-3 наряду с экспериментальными данными приведены и расчетные кривые, дополним подписи к рисункам соответствующими комментариями.
Показанные на вставках в рис. 1 эмиссионные изображения с точки зрения полевой эмиссионной микроскопии имеют существенные различия, которые заключаются в следующем. При толщине пленки ZrO2, равной одному монослою (рис. 1, a), наибольший вклад (до ~ 70 %) в полный ток эмиссии вносит поток электронов, эмиттируемых с плоскости (100) W. При увеличении толщины пленки ZrO 2 до ~ 10 нм эмиссионное изображение качественно изменяется (рис. 1, б). В этом состоянии ZrO2/W<100> НГС основной вклад (до ~ 80-90 %) в полный ток эмиссии вносят электроны, эмиттируемые в направлениях, перпендикулярных к граням типа {111} W. В результате эволюции эмиссионных свойств ZrO 2 /W<100> структура эмиссионного изображения трансформируется к виду, показанному на рис. 1, б.
Кривые 1, 2 (рис. 2) получены из соответствующих экспериментальных кривых 1, 2 (рис. 1) на основании количественных оценок значений
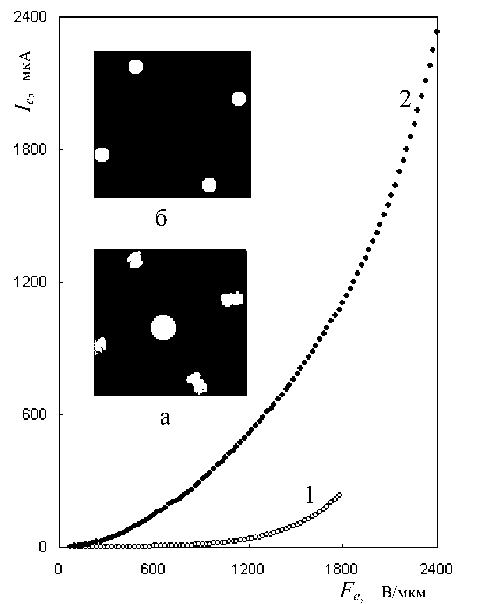
Рис. 1. Зависимость тока эмиссии от напряженности поля на поверхности ZrO2/W<100> НГС для двух различных "состояний" поверхностного слоя НГС (экспериментальные данные): 1 — Т = 2000 K, толщина слоя ZrO2 равна одному монослою; 2 — Т = 2000 K, толщина слоя ZrO2 равна ~ 10 нм.
a — эмиссионное изображение поверхности МК W<100>, покрытой монослоем ZrO2;
б — структура эмиссионного изображения поверхности ZrO2/W<100> НГС (толщина слоя ZrO2 равна ~ 10 нм)
площади эмиттирующих участков поверхности ZrO2/W<100> НГС по известным методикам полевой электронной и автоионной микроскопии [1, 21], дополненных электронно-микроскопическими измерениями геометрии вершины ZrO 2 /W<100>.
На вставке в рис. 3 приведена характерная экспериментальная кривая, характеризующая зависимость тока эмиссии от температуры вещества ZrO 2 /W<100>.
В заключение этого раздела важно отметить, что при толщине слоя ZrO2, равной ~ 10 нм, процесс эмиссии электронов при плотностях тока ~ (107-108 A/см2) отличается высокой стабильностью. Нестабильность эмиссионного тока не превышала ~ 0.2 % в течение нескольких (до 10) часов.
Таким образом, из приведенных экспериментальных данных следует, что при толщине слоя
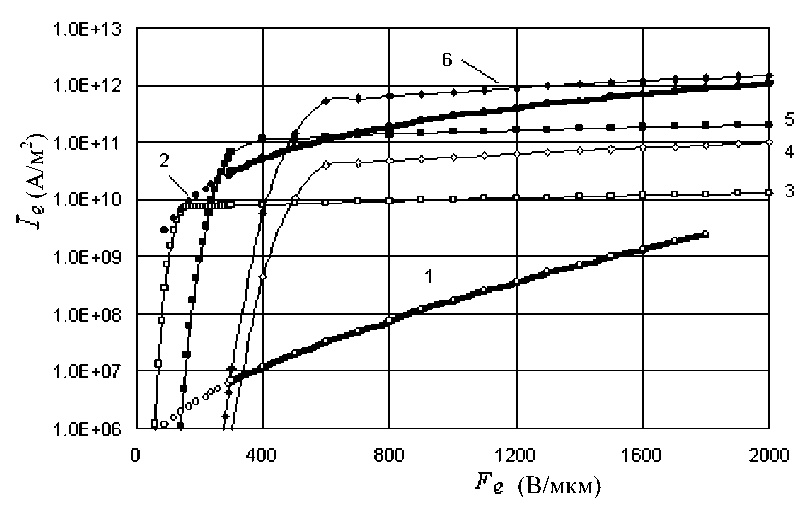
Рис. 2. Зависимость плотности тока эмиссии от напряженности поля на поверхности ZrO 2 /W<100> НГС (экспериментальные (1, 2) и расчетные данные (3–6)).
1 — Т = 2000 K, толщина слоя ZrO 2 равна одному монослою; 2 — Т = 2000 K, толщина слоя ZrO 2 равна ≈ 10 нм; 3, 4, 5, 6 — T = 2000 K, N t 0 ≈ 1025 м–3, толщина слоя ZrO 2 равна ≈ 10 нм; 3 — для электронов, инжектированных в пленку ZrO2 с граней типа {100}W по TE-механизму; 4 — для электронов, инжектированных в пленку ZrO2 с граней типа {100}W по TFE-механизму; 5 — для электронов, инжектированных в пленку ZrO 2 с граней типа {111}W по TE-механизму; 6 — для электронов, инжектированных в пленку ZrO 2 с граней типа {111}W по TFE-механизму
J i (А/м2)

Рис. 3. Расчетные (1–4) зависимости плотности тока инжекции ( J i ) в пленку диэлектрика от температуры вещества ZrO 2 /W<100> НГС для различных (кристаллографических) направлений потоков инжекции из металла в пленку ZrO2 и (на вставке) экспериментальная кривая (5) зависимости полного тока эмиссии от температуры вещества ZrO 2 /W<100> НГС при одном и том же фиксированном значении потенциала и напряженности экстрагирующего поля ( V e = 6000 В; F e ≈ 1440 В/мкм).
1 — Nt 0 ≈ 1025 м–3, τ ≈ 10 нм, инжекция электронов в направлении <111> W по механизму TFE; 2 — Nt 0 ≈ 1025 м–3, τ ≈ ≈ 10 нм, инжекция электронов в направлении <111 > w по механизму te; 3 — Nt 0 ≈ 1025 м–3, τ ≈ 10 нм, инжекция электронов в направлении <100> W по механизму TFE; 4 — Nt 0 ≈ 1025 м–3, τ ≈ ≈ 10 нм, инжекция электронов в направлении <100> W по механизму TE; 5 — эксперимент, τ ≈ 10 нм
ZrO2, равной ~ 10 нм, активированный электрическим полем и нагревом вещества процесс эмиссии электронов с поверхности ZrO 2 /W<100> НГС характеризуется рядом особенностей, которые не поддаются простой интерпретации в рамках известных теоретических представлений [1, 2] о туннельном механизме экстракции электронов с атомарно-чистой поверхности металлов или полупроводников под действием сильных электрических полей.
Для того чтобы отличать описанный выше процесс эмиссии электронов от классического явления TFE [1, 2] и для его классификации, введем для исследованного эмиссионного процесса специальную аббревиатуру — ATFE (Abnormal Thermal Field Emission). Отметим, что некоторые особенности ATFE такие, как низкий пороговый уровень напряженности поля возбуждения эмиссионного процесса и сравнительно слабая зависимость плотности тока от напряженности экстрагирующего поля наблюдались также и ранее в исследованиях полевых эмиссионных свойств МК CdS [3, 16], алмазоподобных углеродных пленок [18], а также углеродных нанотрубок [8].
МОДЕЛЬ ATFE
Модель построена на основе обобщения данных исследований полевых эмиссионных свойств низкоразмерных НС [3, 8, 16, 18]. Из этих данных, в частности, следует, что особенности (аномалии) процесса полевой эмиссии с поверхности таких НС в значительной мере определяются физикохимическими и структурными свойствами поверхностного слоя НС, который обычно представляет собой НГС, состоящую из высокопроводящей (металлической или полупроводниковой) подложки и тонкого диэлектрического слоя. Тонкий слой диэлектрика на поверхности подложки либо создается искусственно посредством современных технологических методов [18], либо образуется естественным путем в результате окисления поверхности НС [22].
Учитывая эти замечания, для построения модели ATFE с поверхности низкоразмерных НС реальный вакуумный диод моделировался 2D-струк-турой вида металл— тонкая пленка диэлектрика , находящейся в вакууме в однородном электростатическом поле напряженностью F e . В модели полагалось:
-
1) инжекция электронов из металла в свободную зону диэлектрика через межфазовую границу раздела (МФГ) раздела металл—диэлектрик может осуществляться как по механизму TFE, так и по термоэмиссионному (TE) механизму над барье-
- ром Шоттки; контакт металл—диэлектрик является запирающим [23] для электронов металла;
-
2) электрическое поле на интерфейсе ме-талл—диэлектрик представляет собой суперпозицию внешнего (лапласова) поля ( F e ), поля положительного пространственного заряда (ПЗ) ионизованных локализованных состояний в запрещенной зоне диэлектрика, а также поля ПЗ электронов, инжектированных в свободную зону диэлектрика;
-
3) если концентрация электронов, инжектированных в пленку диэлектрика, меньше объемной концентрации ионизованных локализованных состояний, то полем ПЗ электронов, в первом приближении, можно пренебречь;
-
4) ионизация локализованных состояний в пленке может осуществляться как посредством термополевого механизма, так и под действием электромагнитного излучения, поглощенного пленкой диэлектрика;
-
5) при малых толщинах диэлектрической пленки (порядка длины свободного пробега низкоэнергетических электронов) по отношению к процессу электрон-фононного рассеяния транспорт электронов в пленке осуществляется преимущественно по баллистическому механизму;
-
6) эмиттированный в вакуум поток электронов равен произведению вероятности туннелирования электронов через потенциальный барьер на МФГ-границе диэлектрик—вакуум на инжектированный в диэлектрик поток электронов.
Распределение плотности пространственного заряда ( ρ ), образованного в результате термополевой ионизации локализованных состояний в запрещенной зоне диэлектрической пленки толщиной τ , аппроксимировалось функцией нормального распределения
ρ = ρ 0 exp [– x 2/( λ 2 τ 2)], (1)
где x ( x ≤ τ ) — координата, отсчитываемая от МФГ металл—диэлектрик в направлении к МФГ диэлектрик—вакуум; λ — безразмерный параметр; ρ 0 = qN t / εε 0 . Здесь q — абсолютное значение заряда электрона; N t — объемная плотность ионизованных локализованных состояний; ε — диэлектрическая проницаемость пленки; ε 0 — электрическая постоянная.
Решение уравнения Пуассона для потенциала поля φ(x) в пленке с граничными условиями d^ F pl = 0;--= —-, где Fe — абсолютное
-
1 d x x = т - o £
значение напряженности поля на МФГ диэлектрик—вакуум (при х = τ +0), имеет вид
F V n J 1 A
p ( x ) = — x +--- Лтр 0 • erf I — I• x +
£ 2 I X J
+ Х2т 2 ^ 0
1 -
Г П J x
---x • erf I —
Хт I Хт
+ exp
- хт 2 I
J TE = A * • T s 2 • exp
ф ь k T s
.
Отметим, что уравнение (2) описывает распределение потенциала поля в пленке в так называемом приближении "нулевого тока" [2], т. е. в условиях, когда, согласно условию 3), ПЗ потока электронов не оказывает существенного влияния на распределение в пленке диэлектрика потенциала поля, созданного зарядом на внешних электродах, а также связанным зарядом в пленке. Данное приближение справедливо тогда, когда выполняется неравенство N t > n e , где n e — концентрация электронов, инжектированных в пленку диэлектрика.
Плотность тока инжекции электронов из металла в пленку диэлектрика по механизму термотуннельной эмиссии ( J TFE ) и по механизму TE ( J TE ) над барьером Шоттки может быть описана следующими выражениями [23]:
*2
TFE 1 s
•
n E 00 k 2 T s 2
•
х exp
ф ь
E 0
• exp
q ф s
E 1
,
где A* — постоянная (Ричардсона), которая, вообще говоря, зависит от величины эффективной массы m *, а также включает в себя квантовомеханический коэффициент отражения электронов от границы; T s — температура вещества НГС; φ s — потенциал поверхности пленки на МФГ диэлектрик—вакуум; ф ь — высота потенциального барьера на МФГ металл—вакуум
ФЬ = фт - Z -
q 6 -( ф т - ф d + q • Ф s ) • N t
8 п 2 £ 3 Е 0 0
ф т — работа выхода электрона из металла; х — электронное сродство в пленке диэлектрика; фd — работа выхода электрона с поверхности диэлектрика;
E 00
_ q h
N t
I
4л m ££n
;
- 1 - - oo •
E 00 k T s
-
F
th -00
k Ts
- 0 - - 00
- 1
f F
• cth -00
I kT s

ħ — постоянная Планка; k — постоянная Больцмана; m * — эффективная масса электрона;
Значения N t ( T s , F e ) определялись по известному из физики полупроводников соотношению, определяющему зависимость концентрации ионизованных локализованных состояний от температуры и напряженности поля.
Для проведения численных расчетов по уравнениям (3) и (4) в качестве исходных параметров, характеризующих физико-химические и структурные свойства моделируемой НГС, были использованы данные работ [24–33]. С учетом этих замечаний при проведении расчетов использовался следующий ряд исходных значений: ф т ~ 4.0 эВ (для W(111)) [24]; ф т = 4.5 эВ (для W(100)) [24]; ф d = ~ 4.0 эВ (для ZrO 2 ) [24]; т * ~ 0.5 т е [32]; х ~ 3.0 эВ (для ZrO2 [27]); толщина пленки диэлектрика принималась равной τ ≈ 10 нм; плотность неионизо-ванных локализованных состояний ( Nt 0) в пленке ZrO 2 (по разным данным [28–30]) может составлять от ≈ 5.0 1024 м–3 до ≈ 5.0 1025 м–3; максимум плотности локализованных состояний расположен на глубине E d ≈ 0.8 эВ [26, 31] под дном зоны проводимости ZrO 2 ; согласно данным [27, 33], средняя длина свободного пробега электронов по отношению к электрон-фононному рассеянию в различных тонких оксидных пленках составляет от ~ 3 нм до ~ 10 (и более) нм. Вероятность туннелирования через МФГ диэлектрик—вакуум принималась равной прозрачности потенциального барьера, вычисленной в ВКБ-приближении [1, 2].
Результаты моделирования приведены на рис. 2, 3. Из полученных результатов можно сделать следующие выводы.
-
1. Эмиссионная способность ZrO2/W<100> НГС значительно (на ~ 3–4 порядка величины) выше, чем у Шоттки-катода (рис. 1 и 2; кривые 1 и 2).
-
2. В области сравнительно низких значений напряженности поля ( F e < 500 В/мкм) поток эмиссии с поверхности ZrO 2 /W<100> НГС ( τ ≈ 10 нм) формируется в основном из электронов, инжектированных в пленку ZrO2 в результате процесса TE над барьером Шоттки с поверхности граней (100) и {111} МК W<100>. В соответствии с экспериментом (см. рис. 1, 2) при F e ≥ 500 В/мкм (когда прозрачность барьера становится равной 1 как для TE-, так и для TFE-электронов инжекции) ток эмиссии весьма слабо зависит от F e . В этих условиях основной (до ~ 90 %) вклад в эмиссионный поток вносят электроны, инжектированные в пленку ZrO 2 по механизму TFE c плоскостей {111} W (рис. 2, кривая 6). Остальные ~ 10 % потока эмиссии составляют TE-электроны, инжектированные в пленку ZrO 2 c грани (100) W.
-
3. Поведение расчетных кривых для зависимо-
сти плотности тока инжекции ( J i ) от температуры (рис. 3, кривые 1–4) при фиксированном значении Fe определяется ростом напряженности поля на МФГ в процессе нагрева НГС (за счет увеличения плотности связанного ПЗ в условиях термополевой ионизации локализованных состояний в запрещенной зоне ZrO2). Поведение экспериментальной кривой (рис. 3, кривая 5) на участке роста тока удовлетворительно согласуется с результатами моделирования. Наблюдающийся максимум на экспериментальной кривой (рис. 3, кривая 5), по-видимому, обусловлен частичной компенсацией ПЗ локализованных состояний зарядом инжектированного потока электронов высокой плотности.
ЗАКЛЮЧЕНИЕ
-
1. Предложенная феноменологическая модель ATFE удовлетворительно согласуется с экспериментальными данными.
-
2. ATFE обусловлено формированием в поверхностном слое низкоразмерной НС положительного связанного ПЗ высокой плотности.
-
3. В условиях ATFE поток эмиттированных с поверхности НГС в вакуум электронов формируется из электронов, инжектированных в пленку диэлектрика как по механизму TE (над барьером Шоттки), так и по термотуннельному (TFE) механизму. Другими словами, физический механизм ATFE является комплексным и не сводится к механизму какого-либо одного из этих классических эмиссионных явлений.
-
4. Эмиссионные свойства ATFE — высокая эмиссионная способность и стабильность процесса, сравнительно невысокий уровень Fe , а также высокая плотность мощности (до ~ 108 Вт/см2) эмиссионного потока могут быть использованы [34] в области микро- и наноэлектроники, включая электронику больших мощностей для создания высокоинтенсивных стационарных источников электронов, а также в области энергетики для создания эффективных систем преобразования тепловой энергии в электрическую энергию.
-
5. Исследованная в работе ZrO 2 /W<100> НГС, как представляется, не является уникальной по своим физико-химическим и структурным свойствам. Для формирования новых НГС — эффективных ATFE-эмиттеров электронов (как на основе 1D и 2D структур, так и упорядоченных массивов НГС), обладающих априорно заданными эмиссионными свойствами (в частности, способных к ATFE тока высокой плотности при T ≈ 300 K), необходимы дополнительные специальные исследования с привлечением современных методов моделирования процесса послойного эпитаксиального роста тонких диэлектрических пленок на поверхности переходных металлов (а также сильно
легированных полупроводников n-типа) и методов "зонной инженерии" [35–37].
Работа выполнена при поддержке РФФИ (грант № 05-08-33545-а).


