Атомно-слоевое осаждение HfO2 для структур с резистивным переключением
Автор: Григал И.П., Егоров К.В., Гудкова С.А., Чуприк А.А., Маркеев А.М.
Журнал: Труды Московского физико-технического института @trudy-mipt
Рубрика: Молекулярная физика и физика живых систем
Статья в выпуске: 3 (23) т.6, 2014 года.
Бесплатный доступ
В данной работе проведено исследование влияния материала подложки на процесс атомно-слоевого осаждения (АСО) пленки HfO2 и характеристики эффекта резистивного переключения в структурах металл-изолятор-металл (МИМ). Методами рентгеновской дифракции, рентгеновской рефлектометрии были изучены свойства функционального слоя HfO2 в зависимости от материала подложки. Было установлено, что скорость роста HfO2 на металлических подложках в 1.1-1.2 раза превышает скорость роста на кремниевой подложке, а также металлические подложки способствуют более ранней кристаллизации слоя HfO2. Исследование химического состояния подслоев Pt и TiN методом рентгеновской фотоэлектронной спектроскопии показало, что в случае использования в качестве материала подложи TiN, АСО пленки осуществляется на оксиде, а при использовании Pt - на металле. Структура Pt/HfO2/TiN проявляет стабильный эффект резистивного переключения (> 200 циклов перезаписи) при отношении сопротивлений в выключенном и включенном состоянии.
Атомно-слоевое осаждение, резистивное переключение, тонкие диэлектрические пленки
Короткий адрес: https://sciup.org/142186022
IDR: 142186022 | УДК: 53.082.722
Текст научной статьи Атомно-слоевое осаждение HfO2 для структур с резистивным переключением
Системы записи и хранения информации (устройства, памяти) являются ключевым и очень динамично развивающимся компонентом современной наноэлектроники. Традиционная память, основанная на. классических принципах (статическая и динамическая память произвольного доступа. SRAM и DRAM, а. также флэш-память), в своем развитии стремится к насыщению прежде всего из-за. проблем с ее дальнейшим масштабированием [1]. В поисках новых видов компьютерной памяти была, предложена, концепция универсальной памяти, которая сможет заменить все виды существующей на. сегодняшний день памяти. Такая память должна, обладать рядом характеристик: энергонезависимость, скорость записи и перезаписи ( ~ нс), срок хранения информации > 10 лет, низкое энергопотребление (~ 10 пДж), возможность масштабирования и возможность 3-D интегрирования.
В настоящее время среди новых видов памяти на. новых физических принципах память на. основе резистивного переключения является одной из наиболее перспективных [1].
Эффект резистивного переключения заключается в обратимом изменении проводимости диэлектрика, на. величины до нескольких порядков при приложении напряжения определенной амплитуды (однополярное переключение), а. в некоторых случаях при определенной амплитуде, но при условии изменения полярности напряжения (биполярное переключение) [5, 6].
Эффект переключения сопротивления наблюдается на широком спектре структур с диэлектрическим слоем, состоящим из оксидов переходных металлов, таких как NiO$ [7, 8], ТІО$ [4], СиОж [9], НЮ2 [10]. НЮ2 особенно интересен для резистивного переключения, так как он уже достаточно хорошо освоен в современной КМОП-технологии, в том числе и в промышленных масштабах. В перечисленных выше простых оксидах переходных металлов сопротивление МИМ-ячейки в состоянии «включено» практически не зависит от площади металлических электродов, что позволило научному сообществу рассматривать резистивное переключение как формирование/разрыв одного или нескольких локальных проводящих каналов - «филаментов» [2, 3]. Как правило, «свежие» МИМ-структуры не проявляют эффекта, переключения сопротивления. Чтобы эффект проявился, структуры нужно подвергнуть так называемому процессу «формовки» - приложить определенное напряжение Vf, в процессе которого сформируется проводящий филамент из кислородных вакансий или ионов металлов и вся система переходит в состояние с низким сопротивлением Ron (включенное). Чтобы перевести систему в состояние с высоким сопротивлением Roff (выключенное), нужно приложить напряжение определенной величины обратной полярности Voff (напряжение выключения). При этом проводящий филамент разрывается. Далее, чтобы вернуть систему в состояние с низким сопротивлением, нужно приложить напряжение включения - Von, которое меньше, чем напряжение формовки [3].
При создании в МИМ-структуре функционального слоя диэлектрика все чаще используют метод атомно-слоевого осаждения благодаря его уникальной возможности получать тонкие однородные пленки (несколько нм) заданной толщины и контролировать их состав [И, 12]. Конструкция МИМ-ячейки для резистивного переключения обуславливает необходимость проведения АСО-процесса на проводящих материалах - так называемых нижних электродах. В литературе по резистивному переключению обсуждается достаточно широкий спектр материалов для этих электродов - Ti, TiN, Pt, Ru, Au, высоколегированный проводящий Si [6, 8]. Однако известно, что процесс формирования АСО-пленки зависит от свойств подложки, таких как гидрофильность, параметр решетки, кристаллическая ориентация. [13, 14]. Причем зависит как толщина получаемой АСО-пленки, так и ее физические свойства, наличие и количество дефектов в получаемой структуре. Ряд работ демонстрирует необходимость использования оксидных подложек для получения вы-сокостехиометричных по кислороду диэлектрических оксидов. Так как ключевую роль в эффекте резистивного переключения играют кислородные вакансии [2-4], для RS, как правило, требуются оксиды с определенным дефицитом кислорода. Различия в условиях роста АСО-диэлектрика на разных материалах может приводить к его различному химикоструктурному состоянию, в том числе и к различной концентрации кислородных вакансий. Поэтому для изучения эффекта резистивного переключения, условий его возникновения и оптимизации подбора материалов в МИМ-структуре крайне важно исследовать процесс АСО на разных материалах подложки.
Целью данной работы было проведение исследований влияния материала подложки (TiN, Pt, Si) на процесс атомно-слоевого осаждения (АСО) слоя НЮ2 и характеристики эффекта резистивного переключения в структурах металл-изолятор-металл (МИМ) на примере использования в качестве электродов активного по отношению к кислороду (TiN) и инертного (Pt) материалов.
2. Экспериментальная часть
Функциональные слои НЮ2 были выращены методом АСО в реакторе Sunale R-150 Picosun OY с горячими стенками при пониженном давлении (5 мбар). В качестве подложек были использованы кремниевые пластины с предварительно нанесенными пленками Pt и TiN. Слои металлов толщиной ~ 50 нм были выращены на кремниевых пластинах, предварительно очищенных в 1% водном растворе НЕ, методом электронно-лучевого (Pt) и реактивного магнетронного напыления (TiN). Также для сравнения структурных характеристик диэлектрика одновременно проводилось осаждение и на предварительно очищенные пластины монокристаллического Si ориентации (100). С целью удаления естественного оксида SiO2 кремниевые подложки непосредственно перед загрузкой в камеру АСО-реактора погружались на 30 с в 1% водный раствор плавиковой кислоты НЕ.
В качестве газа носителя и для продувки камеры использовался азот особой чистоты (99.999%). Пленки НЮ2 осаждались при температуре подложки 240 °C повторением реакционных серий Hf[N(CHз)(С2Н5)]4 - ЩО. Длительность импульсов подачи реагентов Hf[N(CHз)(С2Н5)]4 и Н2О составляла 0.5 с и 0.1 с соответственно. После каждого импульса камера реактора продувалась азотом в течение б с. Для обеспечения необходимого давления насыщенных паров температура Hf[N(CHз)(С2Н5)]4 составляла 100 °C. Температура Н2О составляла 22 °C. Таким образом, был выращен ряд структур в широком диапазоне толщины диэлектрика: Si/HfO2 (4-40 нм), Si/Pt/HfO2 (~ 4 — 35 нм), Si/TiN/HfO2 (~ 4 — 35 им) - для структурных исследований. Si TIN НЮ2 (6 им) Pt ii Si Pt НЮ2 (6 HM)/TiN - для электрофизических исследований.
Напыление верхних электродов осуществлялосв через теневую маску. Размер контактных площадок варьировался от 50 мкм до 750 мкм в диаметре.
Исследование морфологии поверхности пленок и измерение шероховатости осуществлялись полуконтактным методом с помощью атомно-силового микроскопа (ACM) NT-MDT Solver Рго-М.
Анализ структурных свойств пленок методами рентгеновской дифрактометрии (РД) и рентгеновской рефлектометрии (РР) был выполнен на рентгеновском дифрактометре ARL X’TRA (Thermo Fisher Scientific), оснащенном медной рентгеновской трубкой. Измерения методом рентгеновской рефлектометрии проводились в геометрии Брэгга-Брентано.
Регистрация дифрактограмм осуществлялась в геометрии скользящего падения на дифрактометре. Использование геометрии скользящего падения позволило увеличить интенсивность сигнала от тонкой пленки. Для данных экспериментов величина скользящего угла составила 3°, скорость сканирования - 0,75°/мин, шаг сканирования - 0,05°.
Исследование влияния процессов АСО на химическое состояние подложки нитрида титана и платины осуществлялось методом рентгено-фотоэлектронной спектроскопии (РФЭС) на спектрометре Theta Probe Thermo Fisher Scientific с использованием Al К a излучения (1486,6 эВ) с энергетическим разрешением 0,8 эВ на линии Au4f в вакууме 10-9 мбар. Калибровка энергий связи проводилась по пику Pt4f (энергия связи 71.01 эВ). Спектры РФЭС снимались в режиме углового разрешения в 12 угловых диапазонах от 22,5° до 72,5° относительно нормали к поверхности, что позволяет без разрушения материала проводить исследования химических состояний элементов приповерхностных слоёв образца.
Функциональные свойства МИМ-структур были охарактеризованы с помощью вольт-амперных характеристик. Квазистатические вольт-амперные характеристики снимались при комнатных условиях с помощью зондовой станции и характериографа Agilent В1500А Semiconductor Device Analyzer.
3. Результаты и обсуждения
Для определения скорости роста АСО-слоя НЮ2 на разных подложках (Si, Pt, TiN) в данной работе был использован метод рентгеновской рефлектометрии. Наличие пленки в исследуемой структуре сопровождается интерференционными максимумами на рентгеновской рефлектограмме. Их период обратно пропорционален толщине пленки [15]. На рис. 1 показаны рентгеновские рефлектограммы, полученные от структур Si/Pt/HfO2 (черный), Si/TiN/HfO2 (красный) и Si/HfO2 (вставка на рис. 1). Толщины этих пленок составили 35 нм, 36 нм и 24 нм соответственно (375, 375 и 300 циклов осаждения). Скорость роста оксида гафния на разных подложках была определена как отношение рассчитанной из рефлектограммы толщины слоя НЮ2 к количеству циклов АСО. Скорость роста оксида гафния на кремниевой подложке составила 0.80 +/- 0.03 A/цикл, в то время как на металлических подложках она составила 0.98 +/- 0.05 A/цикл на TiN и 0.93 +/- 0.05 A/цикл на Pt. Различие в скоростях роста на кремнии и на металлах может быть вызвано самой природой метода осаждения. Дело в том, что АСО сильно зависит от химических свойств подложки, таких как наличие активных центров, гидрофильность/гидрофобность, склонность к необратимой хемосорбции и так далее. Таким образом, можно сделать вывод, что на металлических подложках (TiN, Pt) оксид гафния растет быстрее, чем на кремнии. Причем на химически активных материалах, которые имеют склонность к окислению (TiN), скорость роста ~ в 1.2 раза больше, чем на кремнии, а на инертных материалах (Pt) ~ в 1.1 раза больше.
Аналогичные результаты были получены в статье [16], где сравнивалась скорость роста ТЮ2 на металлических подложках и на. кремшш. При количестве циклов осаждения > 300 толщина пленки оксида на металлах была в 1,5 раза больше, чем на Si, обработанном в НЕ. Обработка в плавиковой кислоте кремниевых подложек пассивирует поверхность. В связи с этим авторы [17] также отмечают наличие «инкубационного» периода (до 40 циклов), то есть некоторое количество циклов, необходимое для начала устойчивого роста, в процессе осаждения пленки на кремниевую подложку, обработанную в НЕ. В работе [17] было показано на примере роста пленки Ті методом плазменно-стимулированного АСО, что на металлических подложках на первых ~ 15 циклах скорость роста пленки выше, чем на остальных циклах, а на диэлектрических (Si) - ниже.
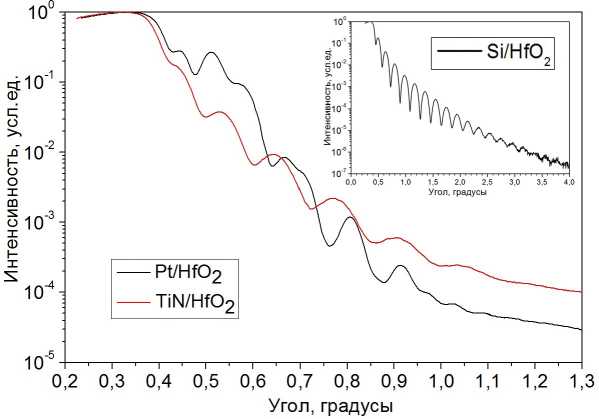
Рис. 1. Рентгеновская рефлектограмма, полученная от структур Pt/HfO2 и TiN/HfO2. Вставка -рентгеновская рефлектограмма, полученная от структуры Si/HfO2
Исследование кристаллической структуры полученных образцов проводилось методом рентгеновской дифракции под скользящим углом. Использование данного режима позволило максимизировать информацию, получаемую от пленки и минимизировать влияние подложки. На рис. 2 показаны рентгеновские дифрактограммы образцов Si/HfO2 (синий), Si/Pt/HfO2 (красный), Si/TiN/HfO2 (черный) при одинаковом количестве циклов осаждения (375). Слой оксида гафния, выращенный на монокристалле кремния, обнаруживает лишь аморфное гало, которое может быть описано как суперпозиция рефлексов (-111), (111) и (200), соответствующих моноклинному НЮ2. Этот факт говорит о наличии ближнего порядка в пленке, но отсутствии дальнего. Лишь увеличение толщины слоя до 400 А (500 циклов) приводит к появлению рефлексов от моноклинного НЮ2. Параметры решетки оксида гафния a = 5.12 А, b = 5.18 А, с = 5.25 A (ICDD 00-034-0104).
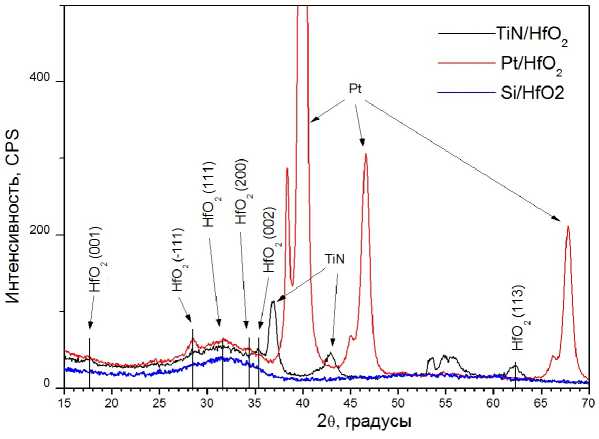
Рис. 2. Рентгеновские дифрактограммы, полученные от структуры TiN/HfO2 (черный), РІ/НЮ2 (красный), Si НЮ 2 (синий)
Осажденные слои нитрида титана и платины были поликрсталлическими с кубической решеткой (параметры решетки a = 4.24 A (ICDD 00-38-1420) и a = 3.92 A (ICDD 0004-0802), соответственно). Рентгеновские дифрактограммы структур TiN/HfO2 и Р1/НЮ2
обнаруживают рефлексы, соответствующие поликристаллическому оксиду гафния в моноклинной фазе. Таким образом, рост оксида гафния на металлических подложках (Pt, TiN) приводит к более ранней кристаллизации АСО-слоя.
Исследование топографии поверхности проводилось методом атомно-силовой микроскопии. Структуры Si/HfO 2 при толщине меньше 20 нм обладают гладкой поверхностью (не показаны на рисунке), со среднеквадратической шероховатостью на уровне 0.15 нм. На рис. 3 показаны АСМ-изображения топографии поверхности структур Si/Pt (рис. За) и Si/Pt/HfO2 (рис. 36). Поверхность платины представляет собой мелкозернистую структуру со среднеквадратической шероховатостью 0.6-0.7 нм при размере стороны кадра сканирования 5 мкм. После АСО НЮ 2 толщ иной — 24 нм на Pt шероховатость образца уменьшалась до 0.5 нм.
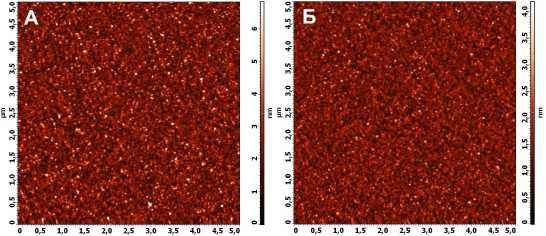
Рис. 3. Топография поверхности, полученная методом атомно-силовой микроскопии, для структур Si/Pt (a), Si/Pt/HfO2 (б)
С целью выявления особенностей химического состояния различных подложек (TiN, Pt) был проведен их анализ методом РФЭС. На рис. 4 представлен спектр Ті2рЗ/2, полученный от TiN при суммировании по всем угловым каналам. При моделировании спектра пик Ti2p 3/2 может быть разложен на 3 пика, соответствующих ТЮ2 (458.5 эВ), TiON (457 эВ) и TiN (455.5 эВ), тем самым обнаруживая три химических состояния титана. Угловые РФЭС-измерения (рис. 5) показали, что при уменьшении глубины анализа (при больших относительно нормали к поверхности образца углах сбора фотоэлектронах) интенсивность пиков ТЮ 2 (458.5 эВ) и TiON (457 эВ) по отношению к TiN нарастает, что говорит о том, что на поверхности нитрида титана содержится большее количество оксида титана.
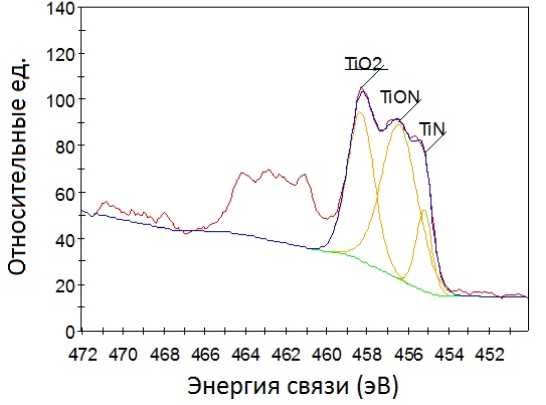
Рис. 4. Ti2p РФЭС спектр с разложением Ті2рЗ/2 пика для подложки из нитрида титана
В то же время РФЭС анализ показал, что на Pt отсутствует окисел, как на исходной подложке так и после нанесения на нее НЮ 2 толщ иной — 1.5 нм.
Таким образом, можно сделать вывод, что в случае использования в качестве материала подложи TiN, АСО-рост пленки осуществляется на оксиде, что может способствовать получению более совершенной пленки (достаточное количество активных центров - ионов кислорода). С другой стороны, при использовании Pt рост происходит на неокисленном металле, что в свою очередь может вызвать формирование более дефектного (с недостатком кислорода) АСО-слоя за счет отсутствия достаточного количества активных центров, необходимых для хемосорбции. Данное предположение коррелирует с результатом исследования скоростей роста, которое показало, что на TiN скорость роста выше, чем на Pt.
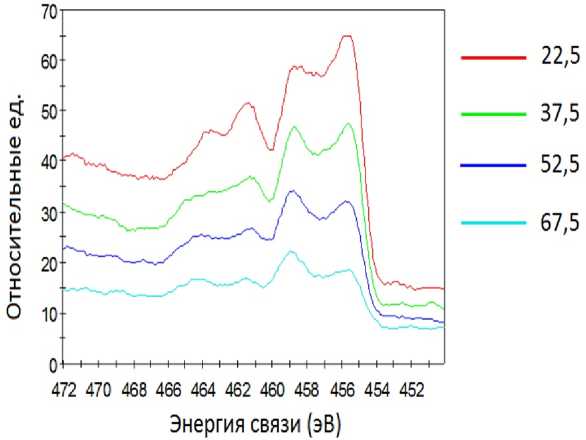
Рис. 5. Угловые зависимости Ті2р РФЭС линии, измеренные от нитрида титана сверху вниз: красный - при 22.5°, зеленый - 37.5°, синий - 52.5°, голубой - 67.5°
Электрофизические исследования структур Pt/HfO2/TiN (АСО процесс проводился на Pt) и TiN/НЮ2/Pt (АСО-процесс проводился на TiN) показали, что в структуре Pt/HfO2/TiN проявляется стабильный эффект резистивного переключения, в то время как в структуре TiN/HfO2/Pt этого эффекта не наблюдается во всяком случае при подаче напряжения до 4 В. Это может быть связано с качеством функционального слоя, сформированного на Pt и TiN. Как было сказано выше, при осаждении слоя на Pt следует ожидать более «дефектную» структуру. Дефекты, такие как кислородные вакансии, играют ключевую роль в эффекте резистивного переключения, возможно, именно поэтому в структуре Pt/HfO2/Ti эффект проявляется, а в структуре TiN/HfO2/Pt - нет.

Рис. 6. Отношение сопротивлений в выключенном и включенном состояниях (R off ^oN МИМ-структуры Pt/HfO2/TiN. Вложенный рисунок - типичная вольт-амперная характеристика МИМ-структур Pt/HfO 2 TiN
На рис. 6 во вложении показана типичная квазистатическая вольт-амперная характеристика МИМ-структуры Pt/HfO2/TiN. Напряжение, при котором структура скачкообразно переходит в состояние с низким сопротивлением (Von), составляет +1.5 В. В отличие от скачкообразного процесса включения, процессы выключения структуры носят плавный характер. Для структуры Pt/HfO2/TiN выключение происходит в диапазоне от -1.7 В до -2.5
В.
Кроме того, оценивалось отношение сопротивлений в выключенном и включенном состояниях. Сопротивления в обоих состояниях определялись как Ropp(Vread)= Vread/Іоғғ и Rov(Vread) = Vread/Iov, где Vread = 0.5 В. На основном изображении на рис. 6 показано отношение сопротивлений R off/Rov в зависимости от количества циклов перезаписи для структуры Pt/HfO2/TiN. На первых 50 циклах проявляется нестабильность Roff/Rov отношение сопротивлений скачет в диапазоне от ~ 70 до 120. На следующих 150 циклах структура ведет себя стабильно, отношение сопротивлений составляет ~ 80. Таким образом, образец Pt/HfO2/TiN стабильно демонстрирует эффект резистивного переключения более 200 циклов перезаписи с отношением сопротивлений R off/Rov ~ 80.
4. Заключение
В результате проведенных исследований было изучено влияние материала подложки на процесс атомно-слоевого осаждения слоя НЮ2. Установлено, что на металлических подложках (TiN, Pt) процесс роста идет быстрее, чем на Si примерно в 1.1 раза для Pt-подложки и 1.2 - для TiN-подложки. Это предположительно связано с пассивацией поверхности кремния после обработки в НЕ. Металлические подложки способствуют более ранней кристаллизации пленки НЮ2 в моноклинную фазу. Типы кристаллической решетки НЮ2 на разных металлических подложках (TiN, Pt) совпадают.
Было получено, что в случае использования в качестве материала подложи TiN, АСО рост пленки осуществляется на оксиде (ТІО2), что может способствовать получению при АСО более совершенной пленки НЮ2 из-за достаточного количества кислородсодержащих активных центров (например, гидрооксильных групп). С другой стороны, при использовании Pt в качестве подложки, рост происходит на неокисленном металле, что в свою очередь может вызвать формирование более дефектного (с недостатком кислорода) АСО-оксида за счет отсутствия достаточного количества активных центров, необходимых для хемосорбции. Данное предположение коррелирует как с результатом исследования скоростей роста, которое показало, что на TiN скорость роста выше, чем на Pt, так и электрофизическими измерениями, которые показали, что в структуре Pt/HfO2/TiN (предположительно более дефектной) эффект резистивного переключения присутствует, а в TiN/НЮ2/Pt - нет (во всяком случае при подаче напряжения до 4 В). Для структуры Pt/НЮ2/TiN напряжения включения и выключения составляют +1.5 и -2.5 В соответственно, отношение сопротивлений в выключенном и включенном состоянии R off/Rov ~ 80 сохраняется более 200 циклов перезаписи.
Работа выполнена при финансовой поддержке Министерства образования и науки Российской Федерации в рамках реализации ФЦП «Научные и научно-педагогические кадры инновационной России» на 2009-2013 годы по соглашению № 14.132.21.1695 с использованием оборудования Центра коллективного пользования МФТИ и НОЦ «Нанотехнологии» МФТИ.
Список литературы Атомно-слоевое осаждение HfO2 для структур с резистивным переключением
- International Roadmap of semiconductors, 2010.
- Chen F.T., Lee H. Y., Chen Y. S., Hsu Y. Y., Zhang L. J., Chen P. S., Chen W. S., Gu P. Y., Liu W. H., Wang S. M., Tsai C. H., Sheu S. S., Tsai M. J., R. Huang R. Resistance switching for RRAM applications//Sci China Inf Sci. -2011. -V. 54. -P. 1073-1086.
- Sawa A. Resistive switching in transition metal oxides. Mater. Today. -2008. -V. 11. -P. 28.
- Strukov D.B., Snider G.S., Stewart D.R., Williams R.S. The missing memristor found//Nature. -2008. -V. 453. -P. 80-83.
- Yang J.J. [et al.]. Memristive switching mechanism for metal/oxide/metal nanodevices//Nature Nanotechnology. -2008. -V. 3. -P. 429.
- Yu S., Lee B. and Wong H.-S. P. Metal oxide resistive switching memory. Functional Metal Oxide Nanostructure/J. Q. Wu, Ed. Berlin, Germany: Springer-Verlag. -2011. -P.303-335.
- Kim D.C., Seo S., Ahn S.E. [et al.]. Electrical observations of filamentary conductions for the resistive memory switching in NiO films//Appl. Phys. Lett. -2006. -V. 88. -P. 202102.
- Ryu S.W., Ahn Y.B., Kim H.J., Nishi Y. Ti-electrode effects of NiO based resistive switching memory with Ni insertion layer//Appl. Phys. Lett. -2012. -V. 100, N 13. -P. 133502.
- Dong R., Lee D.S., Xiang W.F. [et al.]. Reproducible hysteresis and resistive switching in metal-CuxO-metal heterostructures//Appl. Phys. Lett. -2007. -V. 90. -P. 042107.
- Lee H.Y., Chen P.S., Wu T.Y. [et al.]. Low power and high speed bipolar switching with a thin reactive ti buffer layer in robust HfO2 based RRAM//IEDM Tech. Dig. -2008. -P. 297-300.
- Puurunen R.L. Surface chemistry of atomic layer deposition: A case study for the trimethylaluminum/water process//J. Appl. Phys. -2005. -V. 97. -P. 121301-121362.
- Алехин А.П., Григал И.П., Гудкова С.А., Лебединский Ю.Ю., Маркеев А.М., Чуприк А.А. Атомно-слоевое осаждение трехкомпонентных диэлектриков Hf𝑥Al1-𝑥O𝑦 c высокой диэлектрической проницаемостью//ТРУДЫ МФТИ. -2011. -Т. 3, № 3. -C. 22-29.
- Delabie A., Puurunen R., Caymax M., Conard T., Onsia B., Richard O., et al. Atomic layer deposition of hafnium oxide on germanium substrates//J. Appl. Physics. -2005. -V. 97. -P. 064104.
- Wang J., Baroughi M.F., Bills B., Galipeau D., Samadzadeh R., Sivoththaman S. Substrate dependence of surface passivation using atomic layer deposited dielectrics//PVSC IEEE Conference Publcations -2009. -P. 001988.
- Петраков А.П. Метод рентгеновской рефлектометрии и его применение для исследования лазерного испарения окисной пленки с поверхности кремния//ЖЭТФ. -2003. -Т. 4, № 4. -С. 129-134.
- Won S., Suh S., Lee S., Choi G., Hwang C., Kim H. Substrate dependent growth rate of plasma-Enhanced atomic layer deposition of titanium oxide using N2O gas//Electrochemical and solid-state letters. -2010. -V. 13, N 2 -P. G13-G16.
- Kim H., Rossnagel S. Growth kinetics and initial stage growth during plasma-enhanced Ti atomic layer deposition//J. Vac. Sci. Technol. A. -2002. -V. 20. -P. 802-808.


