Атомно-слоевое осаждение трехкомпонентных диэлектриков HFXAL1-XOY c высокой диэлектрической проницаемостью
Автор: Алехин А.П., Григал И.П., Гудкова С.А., Лебединский Ю.Ю., Маркеев А.М., Чуприк А.А.
Журнал: Труды Московского физико-технического института @trudy-mipt
Рубрика: Физика, электроника, нанотехнологии
Статья в выпуске: 3 (11) т.3, 2011 года.
Бесплатный доступ
Разработан процесс атомно-слоевого осаждения тонких (∼ 4 нм) пленок трехком- понентного диэлектрика HfxAl1−xOy с использованием жидкофазного металлоор- ганического гафниевого прекурсора - Hf[N(CH3)(C2H5)]4. Разработанный процесс АСО позволяет получать тонкие пленки HfxAl1−xOy в широком диапазоне концен- траций Al: 24--85 атомных процентов со структурой аморфного твердого раство- ра. Электрофизические исследования позволили выявить оптимальный состав - Hf0,76Al0,24Oy, при котором диэлектрик характеризуется достаточно высокой ди- электрической проницаемостью khigh−k = 10,5 и низкими плотностями токов утечек 1,8 · 10−5А/см2 при напряженности электрического поля Е = 5 МВ/см. Термический отжиг Hf0,76Al0,24Oy диэлектрика приводит к увеличению толщины переходного слоя SiOx на границе раздела с кремнием и, как следствие этого, к снижению приблизи- тельно на порядок величины токов утечек и снижению (на ∼ 30 %) эффективной диэлектрической проницаемости keff в структурах Hf0,76Al0,24Oy/Si.
Короткий адрес: https://sciup.org/142185771
IDR: 142185771
Текст научной статьи Атомно-слоевое осаждение трехкомпонентных диэлектриков HFXAL1-XOY c высокой диэлектрической проницаемостью
В настоящее время необычайно быстрое уменьшение линейных размеров полевых транзисторов, изготавливаемых по КМОП (комплементарные устройства на структурах ме-талл–оксид–полупроводник) технологии, приводит к уменьшению толщины оксида кремния (диэлектрическая проницаемость к = 3 , 9 ), традиционно используемого в качестве подзатворного диэлектрика и обладающего комплексом уникальных свойств, до 1-1 , 2 нм. В результате оксид кремния становится туннельно-прозрачным с неприемлемо большими токами утечек, что и стимулировало в последние годы поиск новых диэлектриков с высокой диэлектрической проницаемостью (high-k диэлектриков), позволяющих получать требуемую емкость при большей толщине диэлектрика и при этом избежать проблем с туннельными токами утечки.
Так, такие бинарные оксиды, как HfO 2 , ZrO 2 , TiO 2 , Al 2 O 3 , обладающие как индивидуальными достоинствами, так и недостатками с точки зрения применимости в качестве high-k диэлектриков для замены SiO 2 , в последние годы привлекли большое внимание исследователей [1--6]. При этом подход, позволяющий объединить положительные свойства отдельных оксидов в сочетании с подавлением недостатков индивидуального материала путем создания диэлектриков на основе тройных или четверных систем, например, таких как Ti–Al–O [7, 8], Hf–Si–O [5], Hf–Ti–O [9], рассматривается как один из наиболее перспективных [5].
HfO 2 благодаря своей достаточно высокой диэлектрической проницаемости к = 14-20 и большой ширине запрещенной зоны Е д ~ 5 , 3-5 , 5 эВ является одним из самых перспективных материалов для high-k диэлектриков [1, 2, 6]. Однако тонкие пленки НЮ 2 не обладают достаточной термической стабильностью, проявляя тенденцию к кристаллизации при 400-450 ° C [6, 14]. Последнее обстоятельство ввиду наличия в стандартной КМОП-технологии высокотемпературных операций для активации поликремниевых затворов приводит к увеличению токов утечек по границам кристаллитов и ограничивает применимость HfO 2 в качестве high-k диэлектриков. Для преодоления этого недостатка HfO 2 компанией Intel был разработан процесс высокотемпературного отжига структур HfO 2 /Si в среде аммиака, приводящего к образованию аморфного
HfSiO x :N диэлектрика, и в результате было запущено производство логических устройств уровня 45 нм. Альтернативным подходом по преодолению тенденции НЮ 2 к кристаллизации является добавление аморфизующих примесей на этапе роста пленок. Было показано, что добавление AI 2 O 3 к HfO 2 , благодаря образованию сплава Hf x Al 1 x O y , позволяет существенно повысить температуру кристаллизации вплоть до Т ~ 1000 ° C [10], при этом сохраняется достаточно высокая диэлектрическая проницаемость к ~ 9-14 [11]. В работах [12-13] пленки Hf x Al i - x O y получали методом химического осаждения из газовой фазы, в работе [14] — методом электронно-лучевого осаждения, в работах [10, 15] — методом атомно-слоевого осаждения (АСО). Важно отметить, что метод АСО является одним из самых перспективных в современной технологии микроэлектроники, так как представляет собой последовательность чередующихся насыщаемых реакций на поверхностных активных центрах в хемисорбированных слоях. В результате метод АСО, получивший название самонасыщаемого или поверхностно-контролируемого (процесс определяется состоянием поверхности и природой реагента и слабо зависит от таких параметров, как давление и расход реагента), позволяет получать беспрецедентно однородные и конформные тонкие пленки на больших площадях с высокой воспроизводимостью [16--18]. Работы по получению методом АСО пленок Hf x Al i - x O y выполнены в основном с использованием хлорида гафния в качестве прекурсора для HfO 2 [10, 15]. Однако известно, что использование в качестве прекурсора хлорида гафния (твердое вещество) может приводить к переносу частиц на поверхность пленки [19] и к ухудшению ее диэлектрических свойств, следовательно, становятся актуальными исследования по поиску жидкофазных прекурсоров на HfO 2 для получения методом АСО пленок Hf x Al i - x O y . В работе [20] показано, что для АСО тонких пленок HfO 2 в качестве гафниевого прекурсора может быть использовано жидкое металлорганическое соединение этилметиламид гафния — Hf [ N ( CH 3 )( C 2 H 5 )] 4 , позволяющий получать качественные тонкие (~ 4-5 нм) пленки при низких (< 300 ° C ) температурах [21].
Таким образом, цель данной работы заключалась в разработке метода АСО тонких трехкомпонентных пленок Hf x Al | x O y в широком интервале концентраций x c применением в качестве гафниевого прекурсора Hf [ N ( CH 3 )( C 2 H 5 )] 4 , а также в исследовании структурно-химических и электрофизических характеристик получаемых пленок.
-
II. Экспериментальная часть
Hf x Al i - x O y пленки были выращены методом АСО в реакторе Sunale R-150 Picosun OY c горячими стенками при пониженном давлении ( 5 мбар). В качестве подложек были использованы Si (100) пластины с проводимостью p-типа и удельным сопротивлением р =12 Ом • см. С целью удаления естественного оксида SiO 2 кремниевые подложки непосредственно перед загрузкой в камеру АСО реактора погружались на 30 с в 1-процентный водный раствор плавиковой кислоты HF.
В качестве газа носителя и для продувки камеры использовался азот особой чистоты (99.999%). Пленки HfxAli-xOy осаждались при температуре подложки 240°C повторением реакционных серий из n циклов А1(СНз)з-H2O и m циклов Hf[N(CH3)(C2H5)]4-H2O. С целью получения HfxAli-xOy пленок заданной тощины общее число реакционных циклов n + m составляло величину 36. Путем варьирования отношения n : m (1:5, 1:2, 1:1, 2:1) были выращены HfxAli-xOy пленки 4-х составов. С целью получения пленок HfxAli-xOy гомогенного состава величины m и n выбирались так, чтобы за m или n реакционных циклов вырастало не более одного монослоя вещества. Принимая во внимание то, что граница раздела Al2O3 - Si, получаемая методом АСО, характеризуется крайне малой величиной переходного слоя [5], с целью обогащения границы раздела алюминием на начальном этапе роста HfxAli-xOy пленок всех 4-х составов проводилось по 2 цикла А1(СНз)з-H2O. Длительность импульсов подачи реагентов А1(СНз)з, Hf[N(CH3)(C2H5)]4 и H2O составляла 0,1 с, 0,5 с и 0,1 с соответственно. После каждого импульса камера реактора продувалась азотом в течение 6 с. Для обеспечения необходимого давления насыщенных паров температура Hf[N(CH3)(C2H5)]4 составляла 100°C. Температура А1(СНз)з и H2O составляла 22°C. Для сравнительного анализа были также выращены тонкие пленки бинарных оксидов HfO2 и Al2 O3 с использованием только циклов Hf[N(CH3)(C2 H5)]4 -- H2 O и Al(CH3)3 -- H2 O соответственно. Число реакционных циклов было равно 50 как для HfO2 , так и для Al2 O3 .
Для изучения влияния отжига на химический состав, структурные и электрофизические свойства пленок Hf x Al 1 x O y , часть выращенных пленок подвергалась быстрому термическому отжигу в атмосфере N 2 /O 2 (0,2 % ) при температуре 700 ° C в течение 60 с.
Толщина и коэффициент преломления пленок определялись методом лазерной эллипсометрии на эллипсометре Sentech SE500adv.
Элементный состав пленок контролировался методом рентгено-флюоресцентного анализа (РФА) на приборе Advanti’x Thermo Fisher Scientific c использованием программного обеспечения OptiQuant TM для безэталонного анализа, с погрешностью измерений ∼ 5 % .
Анализ структурных свойств пленок методами рентгеновской дифрактометрии (РД) и рентгеновской рефлектометрии (РР) был выполнен на дифрактометре ARL X’TRA (Thermo Fisher Scientific), оснащенном Cu рентгеновской трубкой. Измерения методом рентгеновской дифрактометрии и методом рентгеновской рефлектометрии — в геометрии Брэгга–Брентано.
Исследование химического состояния пленок Hf x Al i - x O y осуществлялось методом ex situ рентгенофотоэлектронной спектроскопии (РФЭС) на спектрометре XSAM-800 с использованием MgK a g излучения (1253.6 eV) с энергетическим разрешением 0 , 9 эВ на линии Au 4 f в вакууме • 10 -9 мбар. C целью удаления поверхностных углеродсодержащих загрязнений образцы непосредственно в камере спектрометра подвергались низкотемпературному вакуумному отжигу при Т = 200 ° C . Калибровка энергий связи проводилась по пику Si 2р з / 2 (99.3eV).
Метод спектроскопии характеристических потерь энергии электронов (СХПЭЭ) использовался для определения ширины запрещенной зоны Е g в формируемых пленках. Энергия электронов в зондирующем пучке составляла величину 500 эВ, а полная ширина на полувысоте пика упругого рассеяния — 0 , 6 эВ.
Исследование морфологии поверхности пленок и измерение шероховатости осуществлялись полуконтактным методом с помощью атомно-силового микроскопа (АСМ) NT-MDT Solver Pro–M.
Электрофизические свойства исходных и отожженных пленок исследовались методами I -V и C -V-спектроскопии. Площадь металлических электродов МДП структур Si/Hf x Al | x O y /Ti составляла от 1960 мкм 2 до 0 , 44 мм 2 . Вольт-амперные и вольт-фарадные характеристики были измерены в комнатных условиях с помощью LCR-метра Agilent E4980A и зондовой станции Ecorpia EPS1000 при частоте измерительного сигнала 10 кГц– 1 МГц. Нижний предел измерения плотности тока составил ~ 5 • 10 - 7 А/см 2 .
-
III. Результаты и обсуждения
РФА-исследования элементного состава Hf x Al i - x O y пленок показали, что при варьировании отношения числа реакционных циклов на AI 2 O 3 к числу реакционных циклов на НЮ 2 n : m в диапазоне от 0 , 2 до 2 метод АСО позволяет в широком интервале концентраций изменять содержание Al в пленках Hf x Al i - x O y . Так, на рис. 1 представлена полученная по данным РФА зависимость атомного отношения Al/Hf в выращенных пленках от отношения числа реакционных циклов n : m. Видно, что атомное отношение Al/Hf варьируется в широком диапазоне 0 , 3-5 , 7 и в пределах погрешности измерений имеет близкую к линейной зависимость от величины n : m. Расчет атомных концентраций в полученных Hf x Al i - x O y пленках показал, что содержание Al можно варьировать в интервале 24--85 ат. % (нормировка на общее содержание Al и Hf) путем варьирования отношения числа реакционных циклов n : m в пределах 0 , 2-2 . В табл. 1 приведены данные о составе полученных пленок, а также данные эллипсометрии по толшине и показателю преломления.
Исследования методом РД показали, что полученные АСО Hf x Al i - x O y пленки всех четырех составов обладали аморфной структурой. Аморфная структура пленок, по-видимому, обуславливает их низкую шероховатость. Так, исследования методом АСМ показали, что среднеквадратическая шероховатость Hf x Al i - x O y пленок находится на уровне 0 , 1 нм для кадра сканирования со стороной 5 мкм, что практически совпадает c шероховатостью исходной поверхности кремния.
Таблица 1

0,0 0,2 0,4 0,6 0,8 1,0 1,2 1,4 1,6 1,8 2,0 2,2
Отношение циклов AI2O3/HfO2
Рис. 1. Зависимость атомного отношения Al / Hf в выращенных Hf x Al 1-x O y пленках от отношения числа реакционных циклов на Al 2 O 3 к числу реакционных циклов на HfO 2

Рис. 2. Зависимость эффективной диэлектрической проницаемости и плотностей токов утечек при напряженности электрического поля 5 МВ / см пленок Hf x Al 1-x O y от содержания в них Al
Состав и характеристики полученных методом АСО пленок Hf x Al 1-x O y
|
Номер образца |
Отношение n циклов Al 2 O 3 /т циклов HfO 2 |
Состав |
Толщина, нм |
Показатель преломления |
|
1 |
0:1 |
HfO 2 |
3.9 |
2.1 |
|
2 |
1:5 |
Hf 0 , 76 Al 0 , 24 O y |
3.5 |
2.1 |
|
3 |
1:2 |
Hf 0 , 46 Al 0 , 54 O y |
3.8 |
2.05 |
|
4 |
1:1 |
Hf 0 , 29 Al 0 , 71 O y |
3.8 |
2.0 |
|
5 |
2:1 |
Hf 0 , 15 Al 0 , 85 O y |
3.9 |
2.0 |
|
6 |
1:0 |
Al 2 O 3 |
4.2 |
1.65 |
Исследования методами I - V и C - V -спектроскопии, а также методом СХПЭЭ показали, что варьирование содержания Al в Hf x Al 1 - x O y пленках позволяет существенно изменять их электрофизические свойства. Так, на рис. 2 приведены значения эффективной диэлектрической проницаемости k eff (величина k eff учитывает, как high — k Hf x Al 1 - x O y слой, так и переходный слой на границе раздела Hf x Al i - x O y /Si) и плотностей токов утечек пленок Hf x Al i - x O y от содержания в них Al. Видно, что k eff = 10 , 8 для пленки HfO 2 , а для Hf x Al i - x O y k eff снижается от 8,5 до 7 с ростом содержания Al в пленке от 24 ат. % до 71 ат. % соответственно. Отметим, что плотность токов утечек при напряженности электрического поля Е = 1 МВ/см составляют величину менее 5 • 10 -7 А/см 2 для всех полученных пленок. Плотность токов утечек при Е = 5 МВ/см для пленки HfO 2 составляет величину I = 3 , 6 • 10 -5 А/см 2 , пленка Hf o , 76 Al o , 24 O y характеризовалась несколько меньшим значением плотности тока утечки I = 1 , 8 • 10 -5 А/см 2 , а для более богатой содержанием Al пленки Hf 0 , 46 Al 0 , 54 O y наблюдается резкое увеличение плотности тока утечки до величины I = 7 • 10 -3 А/см 2 . Таким образом, пленка Hf o , 76 Al 0 , 24 O y представляется оптимальной по составу с точки зрения получения достаточно высокой диэлектрической проницаемости и обеспечения минимальных плотностей токов утечек.
На рис. 3 представлены результаты исследований пленки Hf 0 , 76 Al 0 , 24 O y , а также бинарного оксида Al 2 O 3 методом СХПЭЭ. Пленка Hf 0 , 76 Al 0 , 24 O y характеризуется большей шириной запрещенной зоны E g = 5 , 8 эВ по сравнению E g « 5 , 3 эВ пленки HfO 2 [13, 22], что, видимо, и объясняет несколько меньшие плотности токов утечек пленок Hf 0 , 76 Al 0 , 24 O y по сравнению с пленками HfO 2 .
Полученные данные по зависимости плотности токов утечек пленок HfxAl1-xOy от содержания Al находятся в соответствии с работой [13], в которой пленки HfxAl1-xOy были получены химическим осаждением из газовой фазы и было показано, что наименьшие токи утечек демонстрируют пленки, содержащие ∼ 22 aт. % Al, а пленки, содержащие ∼ 32 aт. % Al, проявляли существенное увеличение токов утечек. Согласно работе [10] увеличение токов утечек в пленках HfxAl1-xOy с относительно большим содержанием Al, может быть объяснено нарастающим с ростом отношения Al/Hf дефицитом кислорода в пленках, который, несмотря на рост ширины запрещенной зоны, начинает оказывать определяющее влияние на токоперенос в HfxAli-xOy.
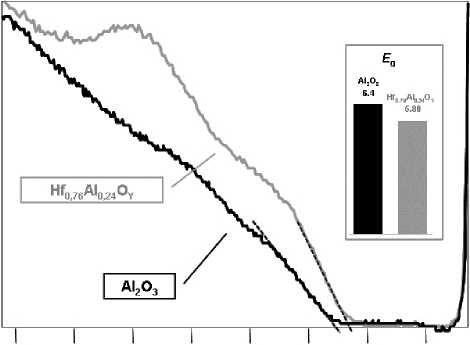
-20.0 -17.5 -15.0 -12.5 -10.0 -7.5 -5.0 -2.5
Кинетическая энергия, эВ
Рис. 3. Спектр характеристических потерь энер-
гии электронов и ширина запрещенной зоны Е д в пленках Hf 0, 76 Al 0,24 O y , и A1 2 O 3
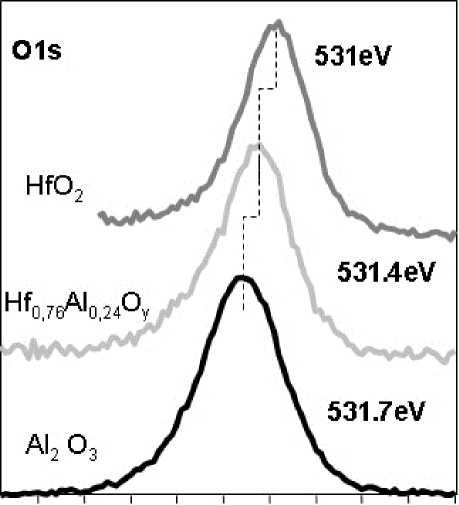
53Б 535 534 533 532 531 530 529 528 527
Энергия связи, эВ
Рис. 4. РФЭС O1s спектры, полученные от пленок
AI 2 O 3 , Hf o , 76 Al o , 24 O y и HfO 2
В работах [5, 18, 22] было показано, что high-k диэлектрики, получаемые методом АСО, демонстрируют двухслойную структуру: собственно high-k слой и переходный слой на границе раздела с Si. Поэтому для объяснения электрофизических свойств полученных АСО Hf o , 76 Al o , 24 O y диэлектриков, в частности для расчета диэлектрической проницаемости high-k слоя k high — k , с использованием методов РФЭС и РР были проведены исследования по определению химического состояния и толщины как переходного, так и high-k слоёв.
РФЭС- анализ пленки Hf o , 76 Al o , 24 O y показал, что энергии связей (Е в ) электронов Hf 4 f 7 / 2 (17.8eV) и Al2p (74.6 eV) уровней соответствуют степеням окисления Hf 4+ и Al 3+ соответственно. При этом O1s пик расположен на Е в = 531 , 4 эВ, то есть в промежуточном положении между Е в = 531 , 7 эВ для бинарного оксида АЬО з и Е в = 531 эВ для бинарного оксида HfO 2 (рис. 4). Отметим, что O1s пик пленки Hf o , 76 Al o , 24 O y не может быть разложен на два подспектра, соответствующих бинарным фазам Al 2 O 3 и HfO 2 , так как полная ширина на полувысоте FWHM = 1 , 75 эВ O1s пика пленки Hf^Alo^O y меньше FWHM = 2 , 1 эВ O1s пика пленки Л^О з - Таким образом, как положение, так и форма O1s пика пленки Hf o , 76 Al o , 24 O y указывают на то, что данная пленка по фазовому состоянию скорее представляет собой твердый раствор, чем смесь бинарных фаз Al 2 O 3 и HfO 2 .
Принимая во внимание большую важность информации о химическом состоянии границы раздела Si/ high — k слой, методом РФЭС были также измерены Si 2p спектры для пленки Hf o , 76 Al o , 24 O y (рис. 5, кривая 1). Видно, что на Si 2p спектре кроме пика Е в = 99 . 3 eV, соответствующего Si ° состоянию от объемного кремния подложки, присутствует пик с максимумом в области Е в ~ 102 , 5 эВ, соответствующее Si + состоянию. Отметим, что Е в = 102 , 5 эВ существенно ниже значения Е в = 103 , 45 эВ, характерного для степени окисления Si 4 + стехиометричного SiO 2 . Данное расхождение обычно объясняется образованием силикатных связей в переходном слое, но также может быть связано с образованием электрических диполей на границе раздела Si/SiO 2 , которые могут приводить к изменению положения SiO x пика на РФЭС спектрах [18].
Исследования методом рентгеновской рефлектометрии показали, что экспериментальный спектр от пленки Hf 0 , 76 Al 0 , 24 O y может быть смоделирован на основе двухслойной модели, включающей слой состава Hf o , 76 Al o , 24 O y толщиной ~ 3 нм и переходный слой SiO x , содержащий неболь-
ТРУДЫ МФТИ. — 2011. — Том 3, № 3 Физика, электроника, нанотехнологии 27 шое количество Al ( 6 10 % ), толщиной ~ 0 , 5 нм (рис. 6). Моделирование проводилось в программе XOP IMD [23].

Рис. 5. РФЭС Si 2p спектры, полученные от структур Si / Hf o , 76 Al o , 24 O y : до отжига (кривая 1) после термического отжига при 700 ° C (кривая 2)
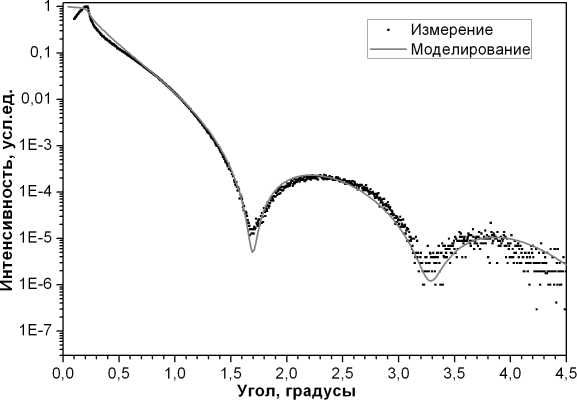
Рис. 6. Рентгеновская рефлектограмма структуры Si / Hf 0,76 Al 0,24 O y (точки — результаты измерений, линия — результат моделирования)
На основе РФЭС- и РР-данных о химическом состоянии и толщинах переходного и high-k слоев в структуре Si/Hf 0 , 76 Al 0 , 24 O y с использованием модели двух конденсаторов и измеренного значения k eff = 8 , 5 можно определить диэлектрическую проницаемость Hf o , 76 Al o , 24 O y слоя, которая составила величину k high- k = 10 , 5 , характерную для Hf x Al 1 - x O y диэлектриков приблизительно такого же состава [14].
Исследования методом РД показали, что пленка Hf 0 , 76 Al 0 , 24 O y сохраняла аморфную структуру и после термического отжига. Однако по данным РФЭС термический отжиг приводит к росту толщины переходного слоя на границе раздела Si/Hf 0 , 76 Al 0 , 24 O y . На рис. 5 (кривая 2) приведен Si 2p РФЭС-спектр, измеренный от стуктуры Si/Hf o , 76 Al o , 24 O y . Видно, что термический отжиг привел к возрастанию интенсивности Si + по сравнению с не отожженным образцом. При этом Si + пик в РФЭС спектре отожженного образца находится в положении Е ь = 103 , 4 эВ, что близко к значению, характерному для стехиометричного SiO 2 . Используя подход [24], основанный на определении отношения интенсивностей Si + /Si o пиков, была рассчитана толщина переходного слоя SiO 2 , которая составила величину ^ 2 нм.
Исследования методами С-V и I - V -метрии показали, что термический отжиг пленок Hf 0 , 76 Al 0 , 24 O y привел к снижению эффективной диэлектрической проницаемости до величины k ef f ~ 6 и к существенному (приблизительно на порядок величины) снижению плотностей токов утечек при E = 5 МВ/см до величины 1 , 2 • 10 -6 А/см 2 в этих пленках. Вероятно, наблюдаемое после термического отжига уменьшение плотности токов утечек в Hf 0 , 76 Al 0 , 24 O y связано с наблюдаемым по данным РФЭС ростом переходного слоя SiO 2 , который обеспечивает дополнительный потенциальный барьер с широкой запрещенной зоной и большим смещением относительно дна зоны проводимости Si [25]. С увеличением толщины переходного слоя SiO 2 , обладающим низкой диэлектрической проницаемостью, связано и наблюдаемое в результате термического отжига некоторое снижение k eff . Согласно работе [26] формирование на исходной кремниевой подложке тонкого (^ 1 нм) слоя SiN x , обладающего высокими барьерными свойствами по отношению к диффузии O 2 , должен приводить к подавлению роста переходного слоя в процессе отжига, и, следовательно, может позволить избежать снижения эффективной диэлектрической проницаемости.
Заключение. Разработана методика АСО тонких (^ 4 нм) пленок трехкомпонентного диэлектрика Hf x Al i - x O y с использованием жидкофазного металлоорганического гафниевого прекурсора — Hf [ N ( CH 3 )( C 2 H 5 )] 4 . Разработанный процесс АСО позволяет получать тонкие пленки Hf x Al i - x O y в широком диапазоне концентраций Al: 24-85 ат. % со структурой аморфного
28 Физика, электроника, нанотехнологии ТРУДЫ МФТИ. — 2011. — Том 3, № 3 твердого раствора. Электрофизические исследования позволили выявить оптимальный состав — Hf o , 76 Al o , 24 O y , при котором диэлектрик характеризуется достаточно высокой диэлектрической проницаемостью k high - k = 10 , 5 и низкими плотностями токов утечек 1 , 8 • 10 -5 А/см 2 при напряженности электрического поля E = 5 МВ/см.
Термический отжиг Hf o , 76 Al o , 24 O y диэлектрика приводит к увеличению толщины переходного слоя SiO х на границе раздела с кремнием, и, как следствие этого, к снижению приблизительно на порядок величины токов утечек и снижению (на ∼ 30 % ) эффективной диэлектрической проницаемости k eff в структурах Hf o , 76 Al o , 24 O y /Si.
Работа выполнена в рамках реализации ФЦП «Научные и научно-педагогические кадры инновационной России» на 2009--2013 годы по контракту № П923 с использованием оборудования Центра коллективного пользования МФТИ и НОЦ «Нанотехнологии» МФТИ.
Список литературы Атомно-слоевое осаждение трехкомпонентных диэлектриков HFXAL1-XOY c высокой диэлектрической проницаемостью
- Gusev E.P., Cabral C., Copel M., DEmic C., Gribelyuk M. Ultrathin HfO2 films grown on silicon by atomic layer deposition for advance gate dielectric applications//Microelectron. Eng. -2003. -V. 69, N 2-4. -P. 145-151
- Frank M., Kim S., Brown S.L., Bruley J., Copel M., Hopstaken M., Chudzik M., Narayanan V. Scaling the MOSFET gate dielectric: From high-k to higher-k? (Invited Paper)//Microelectronic Eng. -2009. -V. 86, I. 7-9. -P. 1603-1608.
- Robertson J. Interfaces and defects of high-k oxides on silicon//Solid-State Electron. -2005. -V. 49. -P. 283-293.
- Engstrom O., Raeissi B., Hall S., Buiu O., Lemme M.C., Gottlob H.D.B., Hurley P.K., Cherkaoui H. Navigation aids in the search for future high k dielectrics: physical and electrical trends//Solid-State Electron. -2007. -V. 51. -P. 622.
- Wilk G.D., Wallace R.M., Anthony J.M. High-κ gate dielectrics: Current status and materials properties considerations//J. Appl. Phys. -2001. -V. 89 -P. 5243-5276.
- Hall S., Buiu O., Mitrovic I.Z., Lu Y., Davey W.M. Review and perspective of high-k dielectrics on silicon//J. of Telecomunications and Information Technology. -2007. -V. 2 -P. 33-43.
- Auciello O., Fan W., Kabius B., Saha S., Carlisle J.A., Chang R.P.H., Lopez C., Irene E.A., Baragiola R.A. Hybrid titanium-aluminum oxide layer as alternative high-k gate dielectric for the next generation of complementary metal-oxide-semiconductor devices//Appl. Phys. Lett. -2005. -V. 86. -P. 042904-042906.
- Shi L., Xia Y.D., Hu B., Yin J., Liu Z. G. Thermal stability and electrical properties of titanium-aluminum oxide ultrathin films as high-k gate dielectric materials//J. Appl. Phys. -2007. -V. 101. -P. 034102-034105.
- Kukli K., Ritala M., LeskelЁa M., Sundqvist J., Oberbec L., Heitmann J., SchrЁoder U., Aarik J., Aidla A. Influence of TiO2 incorporation in HfO2 and Al2O3 based capacitor dielectrics//Thin Solid Films. -2007. -V. 515, N 16. -P. 6447-6451.
- Driemeier C., Bastos K.P., Miotti L., Baumvola I.J.R., Nguyen N.V., Sayan S., and Krug C. Compositional stability of hafnium aluminates thin films deposited on Si by atomic layer deposition//Appl. Phys. Lett. -2005. -V. 86 -P. 221911-1-3.
- Mikhelashvili V., Eisenstein G. Electrical Properties of Al2O3 -HfTiO Gate Dielectric Stacks With Less Than 0.8 nm Equivalent Oxide Thickness//Thin solid films. -2007. -V. 515. -P. 3704-3708.
- Potter R.J., Marshall P.A., Chalker P.R., Taylor S., Jones A.C., Noakes T.C.Q., and Bailey P. Characterization of hafnium aluminate gate dielectrics deposited by liquid injection metalorganic chemical vapor deposition//Appl. Phys. Lett. -2004. -V. 84, N 20. -P. 4119-4121.
- Buiu O., Lu Y., Hall S., Mitrovic I.Z., Potter R.J., Chalker P.R. Investigation of optical and electronic properties of hafnium aluminate films deposited by metal-organic chemical vapour deposition//Thin Solid Films -2007. -V. 515, N 7-8. -P. 3772-3778.
- Mikhelashvili V., Brener R., Kreinin O., Shneider J., Eisenstein G. Characteristics of metalinsulator-semiconductor capacitors based on high-k HfAlO dielectric films obtained by low-temperature electron-beam gun evaporation//Appl. Phys. Lett. -2004. -V. 85 -P. 5950-5952.
- Cho M., Park H.B., Park J., Hwang C. S. Thermal annealing effects on the structural and electrical properties of HfO2/Al2O3 gate dielectric stacks grown by atomic layer deposition on Si substrate//J. Appl. Phys. -2003. -V. 94, N 4. -P. 2563-2571.
- Puurunen R.L. Surface chemistry of atomic layer deposition: A case study for the trimethylaluminum/Water process//J. Appl. Phys. -2005. -V. 97. -P. 121301-121362.
- Алехин А.П., Лапушкин Г.И., Маркеев А.М., Сигарев А.А., Токнова В.Ф. Атомнослое-вое осаждение тонких пленок диоксида титана из тетраэтоксититана и воды//Поверхность. Рентгеновские, синхротронные и нейтронные исследования. -2010. -№ 5. -С. 23-27.
- Alekhin A.P., Chouprik A.A., Gudkova S.A., Markeev A.M., Lebedinskii Y.Y., Matveyev Y.A., Zenkevich A.V. Structural and electrical properties of TixAl1-xOy thin films grown by atomic layer deposition//J. Vac. Sci. Tech. B -2011. -V. 29. -P. 01А302-1-6.
- Ritala M, Leskela M, Niinisto L., Prohaska T., Friedbacher G., Grasserbauer M. Development of crystallinity and morphology in hafnium dioxide thin films grown by atomic layer epitaxy//Thin solid films. -1994. -V. 250. -P. 72.
- Kukli K., Ritala M, Sajavaara T., Keinonen J., Leskela M. Atomic layer deposition of hafnium dioxide films from hafnium tetrakis (ethylmethylamide) and water//Chem. Vap. Dep. -2002. -V. 8. -P. 199-204.
- Kukli K., Ritala M., Lu J., Harsta A., Leskela M. Properties of HfO2 Thin Films Grown by ALD from Hafnium tetrakis (ethylmethylamide) and water//Journal of the Electrochemical Society. -2004. -V. 151 -P. F189-F193.
- Yu H.Y., Li M.F., Kwong D.L. ALD (HfO2)x(Al2O3)1-x high-k gate dielectrics for advanced MOS devices application//Thin Solid Films. -2004. -V. 462-463. -P. 110-113.
- Windt D.L. IMD-Software for modelling the optical properties of multilayer films//Computers in Physics. -1998. -V. 12. -P. 360-370.
- Hochella M.F., Carim A.H. A reassessment of electron escape depths in silicon and thermally grown silicon dioxide thin films//Surf. Sci. -1988. -V. 197, N 3. -P. L260-L268.
- Vogel E.M., Ahmed K.Z., Hornung B., Henson W.K., Mc Larty P.K., Lucovsky G., Hauser J.R., Wortman J.J. Modeled tunnel currents for high dielectric constant dielectrics//IEEE Trans. Electron Devices. -1998. -V. 45 -P. 1350-1355.
- Torii K., Mitsuhashi R., Ohji H., Kawahara T., Kitajima H. Nitrogen profile engineering in the interfacial SiON in a HfAlO/SiON gate dielectric by NO re-oxidation//IEEE Trans. Electron Dev. -2006. -V. 53, N 2. -P. 323-328.


