Диагностика тонких полупроводниковых слоев с помощью спектроскопии поверхностного плазмонного резонанса с использованием света круговой поляризации
Автор: Яцышен В.В.
Журнал: НБИ технологии @nbi-technologies
Рубрика: Нанотехнологии и наноматериалы
Статья в выпуске: 1 т.18, 2024 года.
Бесплатный доступ
В работе представлены результаты расчетов эллипсометрических параметров отраженного света от тонких полупроводниковых слоев в условиях поверхностного плазмонного резонанса. В качестве объектов исследования использованы слои из InSb и GaAs. В методе спектроскопии поверхностного плазмонного резонанса основным параметром является разность углов, в которых достигается минимумы коэффициентов отражения соответственно со слоем и без него. Показано, что в случае InSb-слоя характерные минимумы в угловых спектрах эллипсометрического параметра с отстоят друг от друга на 6,1°. Различия в минимумах для эллипсометрического параметра Д составляют 6,8°. Для случая GaAs эти различия имеют следующие значения: для параметра с разность составляет 3,55°, для параметра Д разность равна 3,90°. Проведенный анализ является расширением обычного метода спектроскопии поверхностного плазмонного резонанса на случай поляризованного света и показывает высокую эффективность предложенного метода для диагностики тонких слоев полупроводниковых материалов.
Метод спектроскопии поверхностного плазмонного резонанса, метод характеристических матриц, эллиптически поляризованный свет, свет круговойполяризации, эллипсометрия
Короткий адрес: https://sciup.org/149145785
IDR: 149145785 | УДК: 535-4:681.7 | DOI: 10.15688/NBIT.jvolsu.2024.1.2
Diagnostics of thin semiconductor layers with spectroscopy of surface plasmon resonance using circularly polarized light
The paper presents the results of calculations of the ellipsometric parameters of reflected light from thin semiconductor layers under conditions of surface plasmon resonance. Layers of InSb and GaAs were used as objects of study. In the surface plasmon resonance spectroscopy method, the main parameter is the difference in angles at which the minimum reflection coefficients are achieved, respectively, with and without a layer. It is shown that in the case of an InSb layer, the characteristic minima in the angular spectra of the ellipsometric parameter ρ are spaced 6.1° from each other. The differences in the minima for the ellipsometric parameter Δ are 6.8°. For the case of GaAs, these differences have the following values: for the parameter ρ, the difference is 3.55°; for the parameter Δ, the difference is 3.90°. The analysis performed is an extension of the conventional method of surface plasmon resonance spectroscopy to the case of polarized light and shows the high efficiency of the proposed method for diagnosing thin layers of semiconductor materials.
Текст научной статьи Диагностика тонких полупроводниковых слоев с помощью спектроскопии поверхностного плазмонного резонанса с использованием света круговой поляризации
DOI:
В последнее среди исследователей и инженеров нарастает интерес к использованию поляризованного светового излучения для диагностики материальных сред, а также для практического использования в приборных устройствах. Особенно привлекательными являются круговая и эллиптическая поляризация. В работе [5] отмечается, что эллиптически поляризованная электромагнитная вол- на переносит линейный и угловой моменты и оказывает силу и крутящий момент на открытую поверхность.
Авторы [7] показывают, что поляризация света, отраженного от объектива с высокой числовой апертурой, существенно меняется по сравнению с поляризацией падающего света, что имеет решающее значение в приложениях поляризационно-зависимого изображения. Работа [6] посвящена возникновению оптического крутящего момента при прохож- дении линейно поляризованного света через анизотропный кристалл.
В работе [8] предлагается новый метод, заключающийся в использовании плоскопараллельной пластины для преобразования линейной поляризации в другие состояния поляризации. Авторы [1] предлагают точный эллипсометрический метод исследования когерентного света малой эллиптичности. В работе [4] сообщается о новой конструкции эллиптически поляризованного лазерного луча с непрерывным контролем соотношения осей эллипса. В работе [2] представлена теоретическая модель неадиабатического вращательного возбуждения и бесполевой молекулярной ориентации с помощью коротких специфических эллиптически поляризованных лазерных импульсов, возбуждающих полярную молекулу.
В оптической диагностике материальных сред следует отметить использование поверхностных плазмонов и поляритонов, которые при определенных условиях могут возбуждаться на границе этих сред. В качестве таких условий рассматриваются условия их возбуждения с помощью призмы НПВО – нарушенного полного внутреннего отражения. Так в работе [9] рассмотрено применение эллипсометрического метода в условиях НПВО для диагностики биологических объектов. Работа [11] посвящена эллипсометрическому методу анализа слоистых нанокомпозитных материалов на основе диэлектрической матрицы с распределенными в ней наночастицами из благородных металлов.
В работе [10] рассмотрен метод спектроскопии поверхностного плазмонного резонанса для диагностики тонких пленок. Авторы [3] рассматривают распространение и затухание поверхностных плазмонов в наноком-позитных материалах.
В настоящей работе будет рассмотрено применение спектроскопии поверхностного плазмонного резонанса для диагностики тонких пленок полупроводниковых материалов с применением световой волны круговой поляризации.
Постановка задачи
На систему, состоящую из призмы и системы слоев падает плоская гармоническая световая волна круговой поляризации (рис. 1). Методом спектроскопии поверхностного плазмонного резонанса [10] провести сравнительный расчет интенсивности и эллипсометрических параметров отраженного света в двух случаях: 1 – слой с полупроводниковым материалом отсутствует; 2 – в присутствии этого слоя. Для расчета выбраны следующие параметры: диэлектрическая проницаемость слоя серебра для длины волны света λ = 0,633μ равна ε = –18,2 + 0,5 i ; толщина слоя металла d = 0,05μ; диэлектрические проницаемости полупроводников для длины волны света λ = 0,633μ равны ε1 = 15,68 для InSb и ε2 =10,9 для GaAs. Толщины полупроводниковых слоев выбраны равными da = 10 nm.

Рис. 1. Схема Кречмана в спектроскопии поверхностного плазмонного резонанса: 1 – призма; 2 – металлический слой; 3 – слой полупроводникового материала; 4 – воздух
Методы решения
Результаты исследования
Задача решается с использованием метода характеристических матриц [10] и метода спектроскопии поверхностного плазмонного резонанса. В первом случае исследуемый слой полупроводникового материала исключается из общей характеристической матрицы слоистой системы, а во втором, наоборот, включается. В результате в соответствии с методом спектроскопии поверхностного плазмонного резонанса, мы получаем резко выделенные пички минимумов в оптических откликах, что и позволяет диагностировать исследуемые тонкие полупроводниковые слои.
На рисунках 2–5 представлены результаты исследования.
В качестве металлического слоя в схеме Кречмана использовано серебро с диэлектрической проницаемостью на длине волны падающего света λ = 0,633μ равна ε = –18,2 + 0,5 i .
Анализ полученных результатов
Из приведенных графиков видно, что наблюдаются весьма выраженные минимумы в угловых спектрах эллипсометрических параметров ρ и Δ для случаев отсутствия и при-
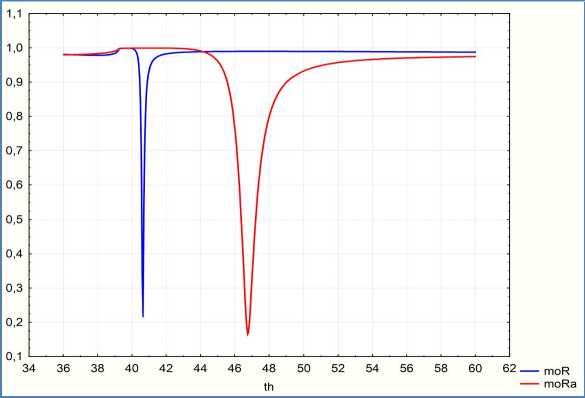
Рис. 2. Угловые спектры эллипсометрического параметра ρ для InSb: moR – без слоя 3; moRa – со слоем полупроводникового материала 3
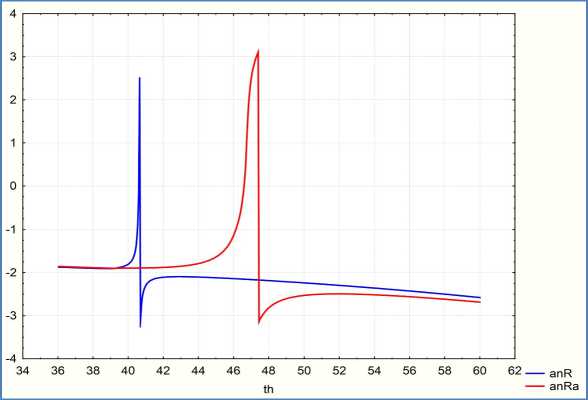
Рис. 3. Угловые спектры эллипсометрического параметра Δ для InSb: anR – без слоя 3; anRa – со слоем полупроводникового материала 3
сутствия исследуемого слоя. Необходимо подчеркнуть, что речь идет о расширении традиционного метода спектроскопии поверхностного плазмонного резонанса – исследуются минимумы эллипсометрических параметров, а не энергетические коэффициенты отражения. Анализ показывает, что в случае InSb-слоя характерные минимумы в угловых спектрах эллипсометрического параметра ρ отстоят друг от друга на 6,1°. Различия в минимумах для эллипсометрического параметра Δ составляют 6,8°. Для случая GaAs эти различия имеют следующие значения: для параметра ρ раз- ность составляет 3,55°, для параметра Δ разность равна 3,90°. Проведенный анализ показывает высокую эффективность расширенного метода спектроскопии поверхностного плазмонного резонанса для диагностики тонких слоев полупроводниковых материалов.
Список литературы Диагностика тонких полупроводниковых слоев с помощью спектроскопии поверхностного плазмонного резонанса с использованием света круговой поляризации
- Bibikova E., Al-wassiti N., Kundikova N. New Ellipsometric Approach for Determining Small Light Ellipticities. Optics and Lasers in Engineering, 2019, vol. 116, pp. 1-5. DOI: 10.1016/j.optlaseng.2018.12.004
- Maana A., Tyagi A., Prasadc V. Field-Free Molecular Orientation by Delayed Elliptically Polarized Laser Pulses. Spectrochimica Acta Part A: Molecular and Biomolecular Spectroscopy, 2018, vol. 188, pp. 268-275. DOI: 10.1016/j.saa.2017.07.012
- Potapova I.I., Yatsishen V.V. Propagation and Damping Constants of Surface Plasmons on the Boundary of Nanocomposite. AIP Conference Proceedings, 2019, vol. 2174, p. 020244. DOI: 10.1063/1.5134395
- Rodrigues G.C., Duflou J.R. Theoretical and Experimental Aspects of Laser Cutting with Elliptically Polarized Laser Beams. Journal of Materials Processing Tech, 2019, vol. 264, pp. 448-453. DOI: 10.1016/j.jmatprotec.2018.09.035
- Tan C.Z. Angular Momentum and the Stokes Parameters of an Elliptically Polarized Electromagnetic Wave. Optik, 2017, vol. 134, pp. 280-286. DOI: 10.1016/j.ijleo.2017.01.046
- Tan C.Z. Correlation of the Left- and the Right-Handed Circularly Polarized Waves in an Anisotropic Crystal. Optik, 2014, vol. 125, pp. 1120-1123. DOI: 10.1016/j.ijleo.2013.07.140
- Wu P., Min C., Zhang C. et al. Tight Focusing Induced Non-Uniform Polarization Change in Reflection for Arbitrarily Polarized Incident Light. Optics Communications, 2019, vol. 443, pp. 26-33. DOI: 10.1016/j.optcom.2019.03.025
- Xu L., Liu J., Wang C. Novel Polarization Conversion Method of Linearly Polarized Light at Specific Incident Angle Based on Plane-Parallel Plate. Optik, 2019, vol. 188, pp. 187-192. DOI: 10.1016/j.ijleo.2019.05.039
- Yatsishen V.V., Amelchenko Y.A. Ellipsometry of Biological Objects in the Mode of Attenuated Total Reflection (ATR) Using a Circularly Polarized Laser Light. Progress in Biomedical Optics and Imaging – Proceedings of SPIE, 2020, vol. 11458, p. 114580S. DOI: 10.1117/12.2564203
- Yatsyshen V.V. The Use of Plasmon Resonance Spectroscopy to Analyze the Parameters of Thin Layers. Journal of Physics: Conference Series, 2020, vol. 1515 (2), p. 022047. DOI:10.1088/1742-6596/1515/2/022047
- Yatsyshen V.V., Potapova I.I., Verevkina K.Y. Ellipsometry of Nanocomposite Layered Materials. Lecture Notes in Networks and Systems, 2021, vol. 155, pp. 258-268. DOI: 10.1007/978-3-030-59126-7_29


