Испытания электронных компонентов из лётных партий к дозовым эффектам для гарантии стойкости бортовой аппаратуры космических аппаратов
Автор: Зыков В.М., Максимов Ю.В., Максимов И.А., Кочура С.Г., Иванов В.В., Пацков А.В.
Журнал: Сибирский аэрокосмический журнал @vestnik-sibsau
Рубрика: Авиационная и ракетно-космическая техника
Статья в выпуске: 4 т.16, 2015 года.
Бесплатный доступ
Рассмотрены основные результаты испытаний лётных партий электронных компонентов (ЭК) на дозовые эффекты длительного низкоинтенсивного воздействия ионизирующих излучений космического пространства. Используемый подход обеспечивает экспериментально-расчетную оценку проектного радиационного запаса компонента в аппаратуре на этапе комплектования бортовой аппаратуры космического аппарата. Испытательный комплекс для выборочных испытаний лётных партий ЭК включает в себя две гамма-установки панорамного типа с регулировкой мощности дозы гамма-излучения Со-60 в диапазоне от 0,1 до 0,01 рад/с, а также систему дозиметрии для калибровки поля гамма-излучения по поглощенной дозе в кремнии с неопределенностью не более 2,5 %. Результаты испытаний для биполярных компонентов российского производства показали, что радиационная стойкость компонентов в зависимости от мощности дозы может иметь различный характер, выражающийся как в увеличении, так и в снижении радиационной стойкости при уменьшении мощности дозы. Обнаружены эпизодические случаи неконтролируемых изменений в технологии производства компонентов, происходящие в течение времени менее года и приводящие к изменениям в радиационной стойкости по дозовым эффектам до порядка величины. При поглощенной дозе ниже 30 крад в биполярных ЭК эффект мощности дозы может проявляться исключительно в повышенной скорости восстановления параметров ЭК после облучения при высокой мощности дозы в процессе последующего отжига при комнатной или повышенной до 100 °С температуре. Установлено, что в условиях переменной во времени мощности дозы, моделирующей последствия мощной вспышки на Солнце, в ЭК биполярной технологии, которые характеризуются эффектом, противоположным эффекту ELDRS, наблюдается временный параметрический отказ. Обнаруженные дозовые эффекты предложено принимать во внимание при корректировке стандартных методов испытаний.
Бортовая аппаратура, космический аппарат, электронные компоненты, лётные партии, радиационное испытание
Короткий адрес: https://sciup.org/148177508
IDR: 148177508 | УДК: 629.7.018.4
Testing electronic parts from flight lots on dose effects for the hardness guarantee of spacecraft onboard equipment
The main results for radiation testing electronic parts of flight lots on dose effects of long-time low-intensive influence of space ionizing radiation is observed. Such test approach provides for the given component a computational-experimental radiation design margin estimation, which is based on part's experimental radiation hardness determination at the stage of the spacecraft onboard equipment acquisition. The test complex includes two Co-60 panoramic gamma apparatuses with adjustment of gamma-radiation dose rate in a range from 0,1 rad/s to 0,01 rad/s, and a dosimetry system for calibration of a gamma-radiation field in terms of the dose absorbed in silicon with uncertainty no more than 2,5 %. The results of testing bipolar parts manufactured in Russia have shown that as the dose rate decreases, radiation hardness depending on the change in the dose rate may either increase or decrease. Incidental uncontrollable changes in the production technologies of parts occurring within a period of time less than a year and causing changes in radiation hardness of parts on dose effects to an order of magnitude are found out. If the absorbed dose is less 30 krad for bipolar parts the dose rate effect can be found out on the basis of a higher recovery rate of parts parameters after irradiation at high dose rate in the course of the subsequent annealing at room or raised to 100 °С temperature. It is shown that under the conditions of the time-varying dose rate that models aftereffects of high-power Sun flash, the bipolar parts characterized by the effect opposite to ELDRS, temporary parametric failure is detected. The discovered dose effects are offered to be taken into consideration when updating the standard test methods.
Текст научной статьи Испытания электронных компонентов из лётных партий к дозовым эффектам для гарантии стойкости бортовой аппаратуры космических аппаратов
Введение. В мировой практике, начиная с конца 1990-х годов, проведение радиационных испытаний лётных партий (RLAT) электронных компонентов (ЭК) осуществляется ведущими космическими корпорациями в рамках созданных этими корпорациями систем гарантии радиационной стойкости бортовой аппаратуры (БА) космических аппаратов (КА) [1]. Организация таких испытаний в рамках одной корпорации была вызвана многочисленными фактами существенного (до порядка величины) разброса радиационной стойкости ЭК лётных партий от партии к партии и внутри партии из-за нестабильности технологии производства, а также из-за влияния на радиационную стойкость ЭК дополнительных термовоздействий, таких как электротермотренировка, в процессе проведения дополнительных отбраковочных испытаний, проводимых в специализированных испытательных центрах. При этом разброс стойкости ЭК лётных партий к длительному низкоинтенсивному воздействию ионизирующих излучений космического пространства (ИИКП) оказался сильно зависящим от вариаций процессов оксидирования и корпусирования микросхем каждой партии. В настоящее время испытания лётных партий ЭК стали важным условием гарантии стойкости БА к дозовым эффектам длительного низкоинтенсивного ионизирующего воздействия. Они проводятся, если по результатам сертификационных испытаний ЭК лётных партий коэффициент проектного радиационного запаса для размещения этих ЭК в бортовой аппаратуре меньше необходимого значения. В настоящее время разработаны статистические методы оценки радиационной стойкости ЭК закупаемых партий для комплектования БА, основанные не только на априорных данных сертификационных испытаний, но также на накопленных данных при предыдущих испытаниях лётных партий этих ЭК [2; 3]. Такие методы учитывают полученную при испытаниях лётных партий статистику колебаний радиационной стойкости от партии к партии и внутри партии. Вместе с тем подтверждено, что только непосредственное выборочное испытание ЭК закупленной лётной партии дает наиболее достоверную оценку проектного радиационного запаса (RDM) этого ЭК в конкретном космическом проекте. Далее организационные и методические вопросы испытаний лётных партий ЭК рассматриваются на примере интегрированной испытательной структуры, созданной в г. Томске в рамках системы гарантии радиационной стойкости БА КА кооперации предприятий АО «Информационные спутниковые системы» имени академика М. Ф. Решетнёва».
Цели испытаний лётных партий ЭК. Основной целью испытаний лётных партий ЭК является оценка проектного радиационного запаса этих ЭК для установки в бортовую аппаратуру с учетом натурной радиационной обстановки для разрабатываемого космического проекта, конструктивного исполнения бортовой аппаратуры КА, а также компоновки и электрического режима ЭК в составе аппаратуры. Исходя из накопленного опыта испытаний лётных партий ЭК к дозовым эффектам, в отличие от проведения типовых сертификационных испытаний, следует учитывать, что процедуры испытаний лётных партий ЭК должны обеспечивать:
-
- оценку радиационной стойкости ЭК в партии по количественному, а не по качественному признаку, что даёт возможность выполнения компоновки аппаратуры с учётом экранировки менее стойких ЭК более стойкими, а также обеспечивает возможность обоснованного выбора локальной радиационной защиты;
-
- количественную оценку радиационной стойкости ЭК лётной партии в электрических режимах эксплуатации на борту КА (которые могут отличаться от рекомендации в ТУ);
-
- оценку влияния электрического и теплового (отжиг при повышенной и нормальной температуре) режимов на функционирование ЭК после достижения радиационного параметрического отказа или достижения нормы испытаний с целью получения информации о возможности восстановления параметрического запаса работоспособности ЭК регулировкой электрического и теплового режимов при эксплуатации этих ЭК в составе БА;
-
- оценку разброса стойкости ЭК в лётной партии и от партии к партии с определением возможности индивидуальной разбраковки ЭК в каждой партии по их радиационной стойкости;
-
- оценку влияния на радиационную стойкость ЭК эффектов низкой мощности дозы.
Таким образом, при указанных выше целевых установках гарантия стойкости БА обеспечивается своевременным уточнением проектного радиационного запаса испытуемого ЭК лётной партии для конкретной БА.
Особенности испытаний лётных партий ЭК. Особенности испытаний лётных партий ЭК на дозовые эффекты длительного низкоинтенсивного ионизирующего воздействия определяются, с одной стороны, натурными радиационными условиями худшего случая и, с другой стороны, возможностями методов ускоренной количественной оценки стойкости ЭК к дозовым эффектам в сроки, предусмотренные разработкой БА. Методика испытаний ЭК лётных партий должна включать процедуры количественной оценки радиационной стойкости ЭК, а испытательное оборудование должно быть представлено испытательными стендами с широким диапазоном регулировки мощности дозы для оценки возможных эффектов низкой мощности дозы. Обязательным является наличие высокоточной системы дозиметрии, способной работать в режиме on-line, а также аппаратуры для контроля электрических параметров и функционирования испытуемых ЭК различного уровня интеграции с необходимым программным обеспечением.
В связи с тем, что термовоздействия типа электротермотренировок, проводимых в процессе дополнительных отбраковочных испытаний ЭК в специализированных испытательных центрах, могут влиять на проявление эффектов низкой мощности дозы и на разброс стойкости ЭК по дозовым эффектам внутри партии для ЭК как биполярной технологии [4], так и КМОП-технологии [5], необходимо радиационные испытания лётных ЭК проводить после окончания дополнительных отбраковочных испытаний в специализированном испытательном техническом центре. Как известно, лётные партии ЭК подвергаются дополнительным отбраковочным процедурам в аккредитованных испытательных технических центрах, включая:
-
- электротермотренировку в составе отбраковочных испытаний и диагностический неразрушающий контроль каждой партии ЭК, предназначенной для применения в лётном комплекте БА;
-
- разрушающий физический анализ, проводимый в соответствии с требованиями НТД на выборке из закупленной партии ЭК.
При выборе верхнего предела мощности поглощенной дозы 0,1 рад/с принималась во внимание максимальная мощность дозы ионизирующего излучения, когда-либо наблюдавшаяся в натурных условиях после мощной вспышки на Солнце.
На рис. 1 приведена временная зависимость [6] изменений мощности поглощенной дозы (по кремнию) на геостационарной орбите за эквивалентной радиационной защитой из 2,54 мм алюминия в результате мощнейшей солнечной вспышки в октябре 1989 года. Видно, что последствия солнечной вспышки наблюдались в виде многодневных вариаций мощности дозы в диапазоне от 0,001 до 0,1 рад/с с максимальным значением в области 0,1 рад/с и дополнительными максимумами в области 0,01 рад/с при последующем спаде ниже 0,001 рад/с. Поэтому нижнюю границу основного диапазона мощности дозы при наземных испытаниях целесообразно выбрать равной 0,01 рад/с, в том числе для обеспечения приемлемых сроков испытаний. Такой же диапазон мощности дозы (от 0,1 до 0,01 рад/с) принят в стандарте ESA № 22900 в качестве нижнего базового диапазона для приемочных испытаний партий ЭК. С другой стороны, стандарт MIL-STD-883J (Method 1019.9) рекомендует для испытаний неизменную мощность дозы 0,01 рад/с. Однако недавно проведенные сравнительные исследования испытаний по действующим стан дартам № 22900 и MIL-STD-883J (Method 1019.9) [7] показали, что худший случай при испытаниях биполярных ЭК может реализоваться не только при мощности дозы 0,01 рад/с, но при 0,1 рад/с.

Рис. 1. Изменения мощности поглощенной дозы (по кремнию) на геостационарной орбите за защитой 2,54 мм Al после вспышки на Солнце в октябре 1989 года
Если исходить из типичного для геостационарной орбиты требования к радиационному ресурсу ЭК в 100 крад, то диапазон регулировки мощности дозы в пределах от 0,1 до 0,01 рад/с обеспечивает за 3 месяца набор указанной поглощенной дозы 100 крад при облучении с мощностью дозы 0,01 рад/с и набор поглощенной дозы 1 Мрад при облучении с мощностью дозы 0,1 рад/с. Этого достаточно для реализации при компоновке БА принципа минимизации массы радиационной защиты на основе экранировки менее стойких компонентов более стойкими. На этом же рис. 1 приведена временная зависимость мощности поглощенной дозы при имитации солнечной вспышки в лабораторных условиях гамма-излучением радионуклида Со-60.
Другие особенности методологии испытаний лётных партий ЭК обсуждаются ниже на примере специально разработанного моделирующего гамма-комплекса «Радиан».
Учитывая сформулированные выше требования к диапазону мощности дозы для проведения испытаний лётных партий, был разработан моделирующий гамма-комплекс «Радиан», основой которого стала радиационная головка гамма-терапевтического аппарата «Рокус», используемая как излучатель панорамного типа. В случае зарядки «Радиана» гамма-источником Со-60 активностью до 8,2 кКюри можно за счет геометрической расходимости гамма-пучка, путем регулировки расстояния до объекта облучения, обеспечить необходимое изменение мощности дозы, охватывающее до трех порядков величины. При этом за счет начальной угловой расходимости пучка гамма-излучения обеспечены достаточно большие размеры площади облучения для испытуемых выборок ЭК, подвергаемых длительному низкоинтенсивному облучению. Общий вид дистанционно-управляемого излучателя гамма-комплекса «Радиан» представлен на рис. 2.

Рис. 2. Панорамного типа Со-60 гамма-излучатель комплекса «Радиан»
Система дозиметрии базируется на использовании двух образцовых дозиметров универсальных ДКС-101, снабженных миниатюрной ионизационной камерой типа БМК-06 объемом 0,6 см3. При измерении поглощенной дозы ионизационная камера располагается на плате между испытуемыми ЭК и обеспечивает погрешность измерения поглощенной дозы 2 % (по кремнию). Для измерения радиального распределения пучка гамма-излучения используется дозиметрическая система, состоящая из образцового дозиметра универсального ДКС-101 с миниатюрной ионизационной камерой типа БМК-06 и координатно-позиционирующего устройства (планшета) типа УКП-1510, которые работают под управлением единой программы, обеспечивая автоматическое проведение измерений с заданным шагом по двум координатным направлениям. Точность позиционирования ионизационной камеры равна 0,5 мм, а скорость программного перемещения ионизационной камеры вдоль координатных направлений достигает 100 мм/с.
При испытаниях средняя мощность дозы и максимальная неравномерность поля излучения для испытуемой выборки ЭК, находящейся в данной секции контейнера, находятся по результатам измерений мощности дозы в 5 точках платы (четырех периферийных и одной центральной).
Формирование и метрологическая аттестация поля гамма-излучения гамма-комплекса «Радиан» детально описаны в работе [8]. По результатам метрологической аттестации стенда «Радиан» неопределенность калибровки поля гамма-излучения по мощности поглощённой дозы в кремнии составила 2,5 % в диапазоне от 0,1 до 0,01 рад/с.
Контрольное и измерительное оборудование для тестирования параметров испытуемых ЭК (включая интегральные микросхемы различного уровня интеграции) состоит из оборудования испытательного технического центра АО «НПЦ «Полюс», оборудования гамма-комплекса «Радиан», обеспечивающего измерения в режиме on-line, и универсального измерительного оборудования, находящегося в помещении, смежном с гамма-комплексом «Радиан». Универсальное контрольно-измерительное оборудование состоит из аналоговой измерительной системы, по строенной на базе измерительного комплекса ДМТ-419 (фирмы DMT), и цифровой системы тестирования на базе ATE-IC 52 фирмы National Instruments. Обе системы функционируют как независимо, так и по единой комплексной программе, позволяя тестировать микросхемы практически любой сложности, изготовленные по любой технологии (от микропроцессоров и ПЛИС до операционных усилителей и дискретных элементов).
Дополнительное испытательное оборудование обеспечивает процедуру отжига испытуемой выборки ЭК в активном электрическом режиме при повышенной температуре после окончания пошагового облучения.
Система оперативного контроля за испытаниями снабжена специальным программным обеспечением, которое дает оператору текущую информацию о типе испытуемого ЭК, номере производственной партии, номере маршрутного листа, координатах размещения в поле облучения (номере контейнера), норме испытаний, текущей и следующей шаговой дозе, времени до измерения параметров на очередном шаге облучения, времени окончания радиационных испытаний, а также о состоянии аппаратуры для поддержания заданного активного электрического режима этого ЭК.
Используемый подход при испытаниях лётных партий ЭК, в отличие от методики сертификационных испытаний, характеризуется рядом особенностей, связанных с её целевыми установками и, в частности, с необходимостью классификации испытуемой партии ЭК по следующей шкале: стойкость существенно ниже нормы ТУ, стойкость соответствует норме ТУ и стойкость существенно превышает норму ТУ. Это обеспечивает достижение целевой установки обнаружения аномально «плохих» и аномально «хороших» закупленных партий ЭК с выдачей разработчикам БА КА необходимой информации для расчета локальной защиты ЭК, имеющих аномально низкую стойкость, а также получения необходимой информации для оптимизации компоновки КА с экранированием аномально нестойких ЭК аномально стойкими. Поэтому важной особенностью методики является обязательный пошаговый набор дозы и, по возможности, количественная, а не качественная оценка стойкости ЭК испытуемой лётной партии ЭК к дозовым эффектам. Для этого пошаговое облучение испытуемой выборки ЭК проводится до достижения параметрического отказа всех ЭК выборки или до достижения дозы, соответствующей так называемому интересующему уровню облучения, который существенно превышает норму испытаний. По результатам испытаний оценка стойкости партии ЭК выполняется на основе сравнения одностороннего толерантного предела, вычисляемого на основе статистической обработки данных испытаний, например, по ГОСТ Р ИСО 16269-6-2005 [9] с допустимым значением критериального параметра ЭК. Стандартная статистическая обработка результатов испытаний лётных партий [1] состоит из следующих процедур:
-
1. На каждом шаге по поглощенной дозе из измеренного распределения значений критериального параметра определяются среднее выборочное значение параметра I , р и среднеквадратичное отклонение 5 .
-
2. В зависимости от требований по надежности аппаратуры выбирается вероятность сохранения работоспособности ЭК в условиях применения (например, Ps = 0,99) и доверительность (например, С = 0,9).
-
3. Для каждого шага по набранной дозе величина одностороннего толерантного предела находится по формуле
-
4. Точка пересечения линии одностороннего толерантного предела с допустимым по ТУ значением параметра (на рис. 3 это соответствует дозе 32 крад) дают значение дозы, для которой 99 % компонентов данной партии выживут с вероятностью 90 %.
I,ot = 1« ± K (Ps, C, N) • 5, где знак плюс соответствует параметру, возрастающему по мере увеличения дозы облучения, знак минус соответствует убывающему параметру. Коэффициент K(Р5, C, N) зависит от доверительности С, ве роятности выживания Р5, объема испытуемой выборки N = 10 и определяется по табличным значениям.
Пример оценки стойкости ИС на основе критерия одностороннего толерантного предела, построенного для доверительности 0,9 и вероятности выживания 99 % с учетом объема испытуемой выборки N = 10, представлен на рис. 3, где изображена пошаговая дозовая зависимость входного тока операционного усилителя, являющегося критериальным параметром по результатам испытаний на дозовые эффекты.
Ещё одной особенностью методики испытаний лётных партий ЭК является проведение дополнительных процедур, следующих за процедурами оценки радиационной стойкости ЭК. Эти процедуры направлены на определение возможности восстановления работоспособности ЭК после произошедших критических радиационных изменений параметров ЭК на основе изменения электрического режима питания, а также за счет выдержки при повышенной до 100 °С температуре (типично в течение 168 часов). Эта информация может оказаться полезной при возникновении нештатной ситуации на борту КА. Кроме того, дополнительная выдержка ЭК в активном электрическом режиме при комнатной температуре после окончания пошагового облучения в течение времени от 24 часов до нескольких суток может дать полезную информацию о влиянии на оценку радиационной стойкости времязависимых эффектов.
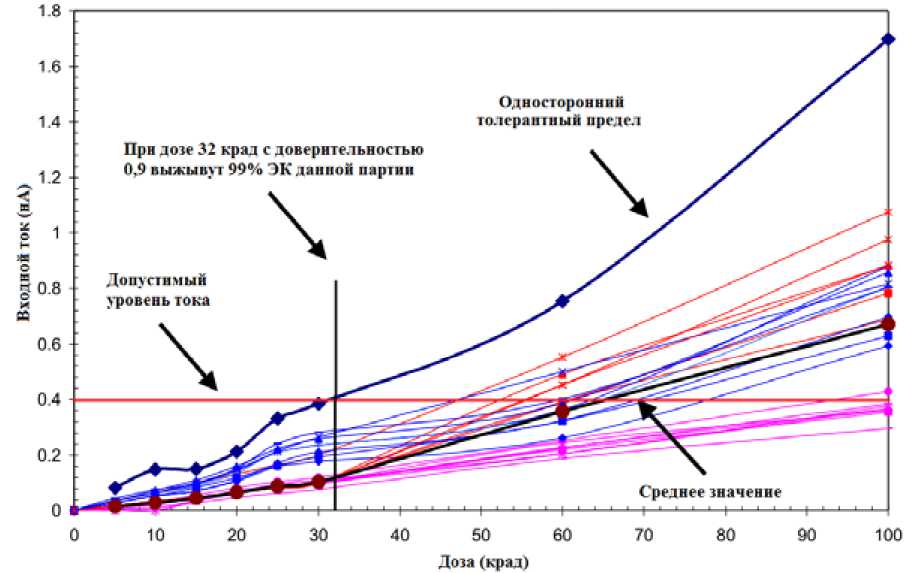
Рис. 3. Пример оценки радиационной стойкости ЭК партии методом одностороннего толерантного предела [1]
Оценка эффектов низкой мощности дозы важна для экстраполяции экспериментальных результатов проведенных ускоренных испытаний на натурные условия длительного низкоинтенсивного воздействия. Примером может служить часто наблюдаемый в ЭК биполярной технологии эффект ELDRS, для учета которого в НТД предлагается использовать степенной закон пересчета результатов ускоренных испытаний биполярных ЭК на натурные условия их применения:
ТУ х РН/ Рх D^ СС “ DNO ^Y^N/ /CND , где DНИИ - уровень стойкости ЭК при низкой мощности поглощенной дозы, соответствующей условиям эксплуатации, рад; DТУ - уровень стойкости ЭРИ в соответствии с техническими условиями (ТУ) или официальными справочными данными, рад; n - коэффициент аппроксимации зависимости уровня стойкости испытываемых образцов от мощности дозы, который в соответствии с НТД для биполярных ИС имеет рекомендуемое значение 0,26. По результатам выборочных испытаний в активном электрическом режиме лётных партий ЭК биполярной технологии российского производства на испытательном гамма-комплексе «Радиан» была установлена закономерность, касающаяся обнаружения для некоторых ЭК эффекта низкой мощности дозы, противоположного эффекту ELDRS.
Примером микросхем биполярной технологии, демонстрирующих эффект низкой мощности дозы, противоположный эффекту ELDRS, является операционный усилитель (ОУ) типа 140УД26АС1ВК ОСМ. Результаты испытаний 140УД26АС1ВК ОСМ при изменении мощности дозы гамма-излучения в диапазоне от 0,01 до 0,29 рад(Si)/с представлены на рис. 4.
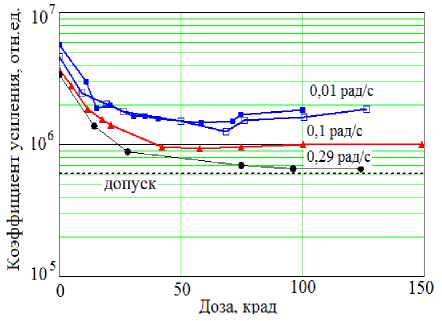
Рис. 4. Демонстрация эффекта анти-ELDRS для дозовой зависимости усредненного по испытуемой выборке коффициента усиления ОУ 140УД26АС1ВК при облучении с мощностью дозы в диапазоне от 0,01 до 0,29 рад(Si)/с
Испытаниям подвергались три партии 140УД26АС1ВК выпуска 2010 года с разбросом в дате изготовления в пределах 18 недель. Кроме того, при мощности дозы 0,01 рад(Si)/с была дополнительно испытана партия 140УД26АС1ВК выпуска 2012 года. Видно, что радиационная стойкость растет по мере уменьшения мощности дозы облучения. Длительный (168 часов) отжиг при температуре 100 °С, выполненный после окончания облучения 140УД26АС1ВК ОСМ, показал, что после облучения при более высокой мощности дозы в процессе отжига не наблюдается полной обратимости радиационных изменений коэффициента усиления. Для эффекта, противоположного эффекту ELDRS, показатель степени в формуле, описывающей степенной закон влияния мощности дозы излучения на радиационную стойкость, становится отрицательным, и применимость указанного степенного закона для пересчета стойкости к натурным условиям эксплуатации требует отдельного подтверждения.
Обнаружение аномально «плохих» лётных партий ЭК с количественной оценкой радиационной стойкости - важнейшая целевая установка испытаний лётных партий ЭК. Процедура количественной оценки радиационной стойкости обеспечивает возможность выбора дополнительной локальной защиты ЭК из «плохой» партии в случае применения её в бортовой аппаратуре при несоответствии норме испытаний и при отсутствии эквивалентной замены на другие более радиационно стойкие ЭК.
Нормативные документы по методам испытаний на дозовые эффекты ЭК биполярной технологии предусматривают периодичность испытаний партий ЭК сроком в 1 год, если в процессе производства не проводится контроль радиационной стойкости. В процессе испытаний лётных партий ЭК нами были установлены эпизодические случаи неконтролируемых изменений в технологии производства, происходящие в течение времени менее года и приводящие к незначительным изменениям в радиационной стойкости ЭК по дозовым.
Пример значительных вариаций радиационной стойкости ЭК от партии к партии на примере источника опорного напряжения ОСМ Н142ЕН19 представлен в работе [10].
Оценка воздействия на ЭК биполярной технологии последствий мощной вспышки на Солнце имеет значение для ЭК с аномальным эффектом мощности дозы.
Закономерности радиационных изменений параметров биполярных ЭК при существенной вариации (в сторону увеличения) мощности дозы, имитирующей, в частности, последствия вспышки на Солнце, можно проследить на примере операционного усилителя 140УД25АС1ВК. Наблюдаемые при увеличении мощности поглощенной дозы от 0,01 до 0,1 рад/с радиационные изменения параметров ОУ выражаются в резком росте напряжения смещения и входных токов, а также в резком увеличении разброса параметров ОУ в испытуемой выборке. На рис. 5 представлен результат испытаний выборки ОУ 140УД25АС1ВК объёмом 10 образцов с переключением мощности дозы с 0,01 на 0,1 рад/с после набора дозы 17,7 крад.
На этом же рисунке приведены результаты отжига ОУ при комнатной и повышенной температуре после окончания облучения, которые свидетельствуют о возврате входного тока в пределы допуска в процессе отжига. Таким образом, в результате воздействия, имитирующего последствия вспышки на Солнце, за короткое время ОУ переходит в нестабильное состояние, характеризующееся смещением параметров за пределы нормы примерно на период времени длительности этого воздействия.
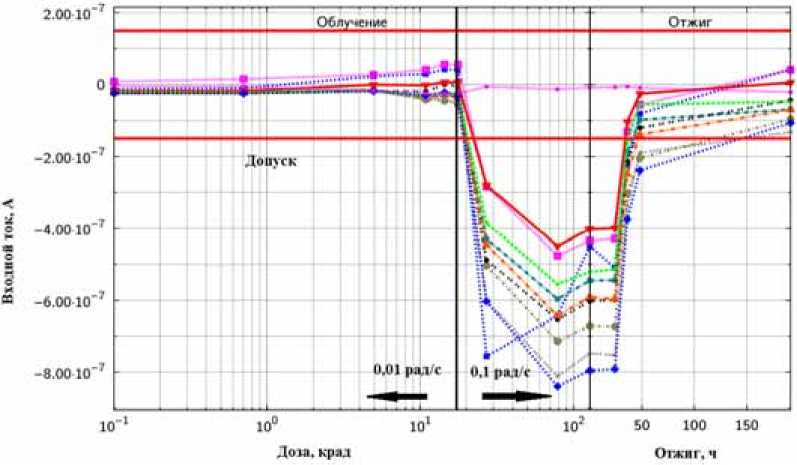
Рис. 5. Изменение с выходом за допустимые пределы входного тока 140УД25АС1ВК при росте в процессе облучения мощности дозы с 0,01 до 0,1 рад/с
Обсуждение результатов исследований. Полученные результаты исследований радиационной стойкости ЭК лётных партий к дозовым эффектам свидетельствуют о том, что:
-
- изменение радиационной стойкости различных типов ЭК биполярной технологии по мере приближения к натурным условиям за счет уменьшения мощности дозы ионизирующего излучения может иметь различную направленность, приводя как к уменьшению, так и к увеличению радиационной стойкости ЭК к дозовым эффектам;
-
- при полной дозе облучения ниже 30 крад, когда ещё отсутствует проявление эффекта ELDRS, значительная доля радиационных изменений параметров биполярных ЭК может отжигаться при комнатной или повышенной до 100 °С температуре после окончания облучения при высокой мощности дозы облучения, в то время как после облучения до этой же дозы при низкой мощности дозы, т. е. в условиях, более приближенных к натурным условиям, значительный отжиг параметров после облучения отсутствует;
-
- изменения в технологии производства биполярных ЭК могут эпизодически приводить к кратковременным незначительным вариациям радиационной стойкости ЭК к дозовым эффектам от партии к партии и внутри партии;
-
- для ЭК биполярной технологии, характеризующихся эффектом, противоположным эффекту ELDRS, последствия вспышки на Солнце могут проявляться в параметрическом отказе продолжительностью, определяемой длительностью вариаций радиационных условий на орбите.
К настоящему времени разработано несколько моделей, описывающих отклик полупроводниковых кремниевых микросхем на дозовые воздействия при низкой мощности дозы ионизирующего излучения. В своей основе все эти модели учитывают радиационное изменение параметров микросхем за счет образования объемных зарядов в объеме изолирующих слоев микросхем (типично это структура - термический диоксид кремния на кремнии) и поверхностных ловушек заряда на границе с кремнием. Ранее выполненные экспериментальные исследования показали [11; 12], что при комнатной температуре и выше ловушки заряда на границе раздела с кремнием, как правило, не формируются прямым взаимодействием дефектов атомной структуры с дырками, достигающими границы раздела, а вычисления на основе теории функционала плотности подтвердили, что соответствующая реакция не является энергетически выгодной [13]. Вместо этого формирование заряда в виде оборванных связей на границе раздела Si/SiO2 определяется несколькими реакциями, которые должны произойти заранее, чтобы освободить протоны из любых содержащих водород дефектов (такие, например, как гидрогенизированная кислородная вакансия) или из молекулярного водорода, постоянно находящегося в виде примеси внедрения. Затем протоны, перемещаемые за счет дрейфа в электрическом поле или диффузии, могут взаимодействовать с пассированными водородом оборванными связями на поверхности раздела Si/SiO2, оставляя в итоге положительно заряженную оборванную связь при поверхности раздела (DB+INT) и молекулу водорода [14]. Плотность оборванных (повисших) атомных связей на поверхности раздела с кремнием известна как плотность ловушек границы раздела Nit.
До недавнего времени аналитические подходы к моделированию эффекта ELDRS обычно полагались на системы уравнений, которые либо включают несколько неуправляемых подгоняемых параметров [15], либо обеспечивают только качественное описание наблюдаемых явлений вследствие упрощенного набора реакций [16], либо определяют параметры модели полуэмпирическим образом [17]. К настоящему времени разработаны аналитические модели, базирующиеся на достаточно полной системе уравнений, которые, с одной стороны, описывают генерацию, рекомбинацию, транспорт и обмен с ловушками неравновесных носителей заряда в объеме оксида кремния с учетом его исходной и радиационно-индуцированной дефектности, а с другой стороны, описывают образование ловушек заряда на границе с кремнием в виде оборванных (свисающих) связей кремния, которое инициируется свободными протонами, достигающими границы раздела и взаимодействующими с дефектами атомной структуры границы раздела, образованными пассивацией водородом оборванных связей кремния [18]. При этом обеспечивается обоснованный выбор типов дефектов атомной структуры оксида кремния, которые создаются на основе кислородных вакансий в оксиде кремния при изготовлении микросхем и которые способны принимать участие в более чем 20-ти типах квазихимических реакций, протекающих между этими дефектами и неравновесными носителями заряда, приводя, в конечном итоге, к деградации параметров микросхем. Оценка вероятности протекания той или иной квазихимической реакции получена путем определения величины энергетических барьеров прямой и обратной реакции на основе первых принципов вычислений (т. е. на основе теории функционала плотности). Установлено, что основными источниками протонов, приводящими к зарядке границы раздела с кремнием, являются две реакции: реакция крекинга (расщепления) [19] и реакция прямого освобождения протона [20], которые протекают на основе захвата свободных дырок. Показано, что характер зависимости радиационного изменения параметров биполярных микросхем, определяемой электрическими зарядами в объеме окисла и на границе раздела с кремнием, сложным образом зависит от исходной дефектности полевого (изолирующего) оксида кремния, содержания в нем водорода (в начальной концентрации и при поступлении из подкорпусного пространства), температуры, поглощенной дозы и мощности дозы ионизирующего излучения. Оказалось, что объемный заряд в оксиде кремния при низком содержании водорода определяется дырками, захваченными в ловушки, а при высоком содержании водорода определяется водородными комплексами, содержащими захваченные протоны H+. Показано, что рекомендуемые некоторыми руководящими документами и базовыми методиками ускоренные радиационные испытания биполярных ЭК на основе облучения при повышенной температуре не всегда обеспечивают достоверную оценку роста ловушек на границе раздела Si/SiO2 по сравнению с испытаниями облучением при низкой мощности дозы, поскольку механизмы, ограничивающие рост ловушек в этих случаях, различны [21].
Анализ областей применения различных модельных механизмов эффекта ELDRS выполнен в работе [22], где показано, в частности, что рекомбинационный механизм ELDRS работает только в области мощности дозы более 100 рад/с.
Заключение. Описанные в настоящей работе результаты выборочных испытаний лётных партий ЭК в целом не противоречат приведенным выше выводам аналитического моделирования, подразумевающего большое разнообразие топологии микросхем и исходной дефектности диоксида кремния, связанной с особенностями технологии изготовления каждого типа ЭК. Для построения количественной модели немонотонного дозового изменения параметров необходимо детальное знание топологии и технологии изготовления данного ОУ.
Обнаруженный нами в биполярных ЭК российского производства эффект восстановления значительной доли радиационных изменений параметров в процессе отжига при комнатной и повышенной до 100 °C температуре после малодозового облучения в условиях высокой мощности дозы, при отсутствии значительного отжига повреждений после такого же облучения в условиях низкой мощности дозы, подтверждается результатами работы [23], выполненной на биполярных ЭК зарубежного производства. В этой работе утверждается, что после облучения биполярных ЭК в условиях рекомендуемой стандартами высокой мощности дозы приблизительно 50 % повреждений отжигаются при комнатной температуре. Неожиданное восстановление существенной доли радиационных изменений параметров ЭК после проведения испытаний при высокой мощности дозы требует учета в стандартах и базовых методиках испытаний на дозовые эффекты.
К настоящему времени проведены испытания на дозовые эффекты более 1000 лётных партий ЭК. Опыт испытаний лётных партий ЭК оказался положительным. Были обнаружены случаи несоответствия радиационной стойкости ЭК нормам ТУ за счет эпизодических неконтролируемых изменений в технологии производства. Наблюдаемые многочисленные, но незначительные по величине, случаи выхода параметров отдельных ЭК испытуемых выборок за нормы ТУ по дозовым эффектам, возможно, являются результатом предшествующей радиационным испытаниям электротермотренировки в специализированном испытательном центре, поскольку, как известно, повышенная температура приводит к увеличению концентрации гидрогенизированных дефектов оксида кремния на основе кислородных вакансий, являющихся источником свободных протонов.
Список литературы Испытания электронных компонентов из лётных партий к дозовым эффектам для гарантии стойкости бортовой аппаратуры космических аппаратов
- Poivey C. Radiation Hardness Assurance for Space Systems . URL: http://pacs.arizona. edu/files/S021306_Reference_Document_NSREC02_SC_ Poivey.pdf (дата обращения: 17.08.2015).
- Ladbury R. Statistical Techniques for Analyzing Process or “Similarity” Data in TID Hardness Assurance//IEEE Transactions on Nuclear Science. 2010. Vol. 57, No. 6. P. 3432-3437.
- Ladbury R., Gorelick J. L. McClure S. S. Statistical Model Selection for TID Hardness Assurance//IEEE Transactions on Nuclear Science. 2009. Vol. 56, No. 6. P. 3354-3360.
- Thermal-Stress Effects and Enhanced Low Dose Rate Sensitivity in Linear Bipolar ICs/M. R. Shaneyfelt //IEEE Transactions on nuclear science. 2000. Vol. 47, No. 6. P. 2539-2545.
- Effects of burn-in on radiation hardness/M. R. Shaneyfelt //IEEE Trans. Nucl. Sci. 1994. Vol. 41. P. 2550-2559.
- Harris R. D. TID Effects in Space-Like Variable Dose Rates/Jet Propulsion Laboratory California Institute of Technology Pasadena. California JPL Publication 08-17 4/0. P. 10.
- Analysis in the Context of Space Radiation Hardness Assurance of Low Dose Rate Results Obtained With the MIL and ESCC Test Methods/R. Marec //IEEE Transactions on Nuclear Science. 2014. Vol. 61, No. 5. P. 2755-2740.
- Максимов Ю. В., Зыков В. М. Оценка разброса стойкости электронных компонентов к дозовым эффектам от партии к партии и внутри партии на гамма-комплексе «Радиан»//Вопросы атомной науки и техники. Серия «Физика радиационного воздействия на радиоэлектронную аппаратуру». 2014. Вып. 1. C. 69-71.
- ГОСТ Р ИСО 16269-6-2005. Статистические методы. Статистическое представление данных. Определение статистических толерантных интервалов.
- Флуктуации в уровне радиационной стойкости различных партий источника опорного напряжения ОСМ Н142ЕН19/С. А. Авдюшкин //Вопросы атомной науки и техники. Серия «Физика радиационного воздействия на радиоэлектронную аппаратуру». Вып. 3. С. 22-24.
- Barnaby H. J. Total-ionizing-dose effects in modern CMOS technologies//IEEE Trans. Nucl. Sci. 2006. Vol. 53, No. 6. P. 3103-3121.
- Saks N. S., Brown D. B. Interface trap formation via the two-stage H+ process//IEEE Trans. Nucl. Sci. 1989. Vol. 36, No. 6. P. 1848-1857.
- Effects of hydrogen motion on interface trap formation and annealing/S. N. Rashkeev //IEEE Trans. Nucl. Sci. 2004. Vol. 51, No. 6. P. 3158-3165.
- Oldham T.R. Ionization Radiation Effects in MOS Oxides. Singapore: World Scientific Publishing Co. Pte. Ltd., 1999.
- Mechanisms of enhanced radiation-induced degradation due to excess molecular hydrogen in bipolar oxides/X. J. Chen //IEEE Trans. Nucl. Sci. 2007. Vol. 54, No. 6. P. 1913-1919.
- Modeling the dose rate response and the effects of hydrogen in bipolar technologies/X. J. Chen //IEEE Trans. Nucl. Sci. 2009. Vol. 56, No. 6. P. 3196-3202.
- Hjalmarson H. P., Pease R. L., B. Devine R. A. Calculations of radiation dose-rate sensitivity of bipolar transistors//IEEE Trans. Nucl. Sci. 2008. Vol. 55, No. 6. P. 3009-3015.
- A Quantitative Model for ELDRS and H2 Degradation Effects in Irradiated Oxides Based on First Principles Calculation/N. L. Rowsey //IEEE Trans. Nucl. Sci. 2011. Vol. 58, No. 6. P. 2937-2944.
- Physical model for enhanced interface-trap formation at low dose rates/S. N. Rashkeev //IEEE Trans. Nucl. Sci. 2002. Vol. 49, No. 6. P. 2650-2655.
- Defect interactions of H2 in SiO2: Implications for ELDRS and latent interface trap buildup/B. R. Tuttle //IEEE Trans. Nucl. Sci. 2010. Vol. 57, No. 6. P. 3046-3053.
- The Effects of Proton-Defect Interactions on Radiation-Induced Interface-Trap Formation and Annealing/D. R. Hughart //IEEE Trans. Nucl. Sci. 2012. Vol. 59, No. 6. P. 3087-3092.
- Mechanisms Separating Time-Dependent and True Dose-Rate Effects in Irradiated Bipolar Oxides/N. L. Rowsey //IEEE Trans. Nucl. Sci. 2012. Vol. 59, No. 6. P. 3069-3076.
- Dose rate effects in linear bipolar transistor/A. Johnston //IEEE Trans. Nucl. Sci. 2011. Vol. 58, No. 6. P. 2816-2823.
- Poivey C. Radiation Hardness Assurance for Space Systems Available at: http://pacs.arizona.edu/files/S021306_ Reference_Document_NSREC02_SC_Poivey.pdf (accessed 17.08.2015).
- Ladbury R. Statistical Techniques for Analyzing Process or “Similarity” Data in TID Hardness Assurance. IEEE Transactions on Nuclear Science, 2010, Vol. 57, No. 6, P. 3432-3437. Cited 1 times. doi: 10.1109/TNS. 2010.2086480.
- Ladbury R., Gorelick J. L, McClure S. S. Statistical Model Selection for TID Hardness Assurance. IEEE Transactions on Nuclear Science, 2009, Vol. 56, No. 6,
- P. 3354-3360. Cited 3 times. Doi: 2033691 DOI: 10.1109/TNS.2009
- Shaneyfelt M. R., Schwank J. R., Witczak S. C., Fleetwood D. M., Pease R. L., Winokur P. S., Riewe L. C., Hash G. L. Thermal-Stress Effects and Enhanced Low Dose Rate Sensitivity in Linear Bipolar ICs. IEEE Transactions on Nuclear Science, 2000, Vol. 47, No. 6,
- P. 2539-2545. Cited 46 times DOI: 10.1109/23.903805
- Shaneyfelt M. R., Fleetwood D. M., Schwank J. R., Meisenheimer T. L., Winokur P. S. Effects of burn-in on radiation hardness. IEEE Transactions on Nuclear Science, 1994, Vol. 41, P. 2550-2559. Cited 41 times. Doi:
- 10.1109/23.340615.
- Harris R. D. TID Effects in Space-Like Variable Dose Rates. Jet Propulsion Laboratory California Institute of Technology Pasadena, California JPL Publication, 2008, P. 10.
- Marec R., Carlotti J. F., Marin M., Calvel P., Barillot C., Mancini R., Sarno M., Mélotte M. and Cueto J. Analysis in the Context of Space Radiation Hardness Assurance of Low Dose Rate Results Obtained With the MIL and ESCC Test Methods. IEEE Transactions on Nuclear Science, 2014, Vol. 61, No. 5, P. 2755-2740. Cited 0 times DOI: 10.1109/TNS.2014.2352856
- Maksimov Yu. V., Zykov V. M. . Voprosy atomnoy nauki
- i tekhniki. Seriya: Fizika radiatsionnogo vozdeystviya na radioelektronnuyu apparaturu. 2014, No. 1, P. 69-71 (In Russ.).
- GOST R ISO 16269-6-2005. Statisticheskie metody. Statisticheskoe predstavlenie dannykh. Opredelenie statisticheskikh tolerantnykh intervalov . Moscow, Standartinform Publ., 2005. 28 p.
- Avdyushkin S. A., Maksimov I. A., Ivanov V. V., Kochura S. G., Kondyan S. S., Patskov A. V. . Voprosy atomnoy nauki i tekhniki. Seriya: Fizika radiatsionnogo vozdeystviya na radioelektronnuyu apparaturu. 2015,
- No. 3, P. 22-24 (In Russ.).
- Barnaby H. J. Total-ionizing-dose effects in modern CMOS technologies. IEEE Transactions on Nuclear Science, 2006, Vol. 53, No. 6, P. 3103-3121. Cited 110 times. Doi: DOI: 10.1109/TNS.2006.885952
- Saks N. S., Brown D. B. Interface trap formation via the two-stage H+ process. IEEE Transactions on Nuclear Science, 1989, Vol. 36, No. 6, P. 1848-1857. Cited 64 times. Doi: DOI: 10.1109/23.45378
- Rashkeev S. N., Fleetwood D. M., Schrimpf R. D., Pantelides S. T. Effects of hydrogen motion on interface trap formation and annealing. IEEE Transactions on Nuclear Science, 2004, Vol. 51, No. 6, P. 3158-3165. Cited 39 times. Doi: DOI: 10.1109/TNS.2004.839202
- Oldham T. R. Ionizatsionnye radiatsionnye effekty v MOP okside. . 1999, World Scientific Publishing Co. Pte. Ltd., Singapore, P. 188.
- Chen X. J., Barnaby H. J., Vermeire B., Holbert K., Wright D., Pease R. L., Dunham G., Platteter D. G., Seiler J., McClure S., Adell P. Mechanisms of enhanced radiation-induced degradation due to excess molecular hydrogen in bipolar oxides. IEEE Transactions on Nuclear Science, 2007, Vol. 54, No. 6, P. 1913-1919. Cited 35 times. Doi: DOI: 10.1109/TNS.2007.909708
- Chen X. J., Barnaby H. J., Adell P., Pease R. L., Vermeire B., Holbert K. E. Modeling the dose rate response and the effects of hydrogen in bipolar technologies. IEEE Transactions on Nuclear Science, 2009, Vol. 56, No. 6, P. 3196-3202. Cited 8 times. Doi: DOI: 10.1109/TNS.2009.2034154
- Hjalmarson H.P., Pease R. L., B. Devine R. A. Calculations of radiation dose-rate sensitivity of bipolar transistors. IEEE Transactions on Nuclear Science, 2008, Vol. 55, No. 6, P. 3009-3015. Cited 21 times. Doi: DOI: 10.1109/TNS.2008.2007487
- Rowsey N. L., Mark E. L, Ronald D. S., Daniel M. F., Blair R. T., Sokrates T. P. A Quantitative Model for ELDRS and H2 Degradation Effects in Irradiated Oxides Based on First Principles Calculations. IEEE Transactions on Nuclear Science, 2011, Vol. 58, No. 6, P. 2937-2944. Cited 7 times. Doi: 2169458 DOI: 10.1109/TNS.2011
- Rashkeev S. N., Cirba C. R., Fleetwood D. M., Schrimpf R. D., Witczak S. C., Michez A., Pantelides S. T. Physical model for enhanced interface-trap formation at low dose rates. IEEE Transactions on Nuclear Science, 2002, Vol. 49, No. 6, P. 2650-2655. Cited 71 times. Doi: DOI: 10.1109/TNS.2002.805387
- Tuttle B. R., Hughart D. R., Schrimpf R. D., Fleetwood D. M., Pantelides S. T. Defect interactions of H2 in SiO2: Implications for ELDRS and latent interface trap buildup. IEEE Transactions on Nuclear Science, 2010, Vol. 57, No. 6, P. 3046-3053. Cited 5 times. Doi: DOI: 10.1109/TNS.2010.2086076
- Hughart D. R., Schrimpf R. D., Fleetwood D. M., Rowsey N. L., Law M. E., Tuttle B. R., Pantelides S. T. The Effects of Proton-Defect Interactions on Radiation-Induced Interface-Trap Formation and Annealing. IEEE Transactions on Nuclear Science, 2012, Vol. 59, No. 6, P. 3087-3092. Cited 4 times. Doi: 2220982 DOI: 10.1109/TNS.2012
- Rowsey N. L., Law M. E., Schrimpf R. D., Fleetwood D. M., Tuttle B. R., Pantelides S. T. Mechanisms Separating Time-Dependent and True Dose-Rate Effects in Irradiated Bipolar Oxides. IEEE Transactions on Nuclear Science, 2012, Vol. 59, No. 6, P. 3069-3076. Cited 5 times. Doi: DOI: 10.1109/TNS.2012.2222669
- Johnston A., Swimm R., Harris R. D., Thorbourn D. Dose rate effects in linear bipolar transistor. IEEE Transactions on Nuclear Science, 2011, Vol. 58, No. 6, P. 2816-2823. Cited 4 times. Doi: 2168979 DOI: 10.1109/TNS.2011


