Исследование особенностей роста эпитаксиальных пленок Fe3Si, выращенных на Si(111)
Автор: Волочаев М.Н., Логинов Ю.Ю.
Журнал: Сибирский аэрокосмический журнал @vestnik-sibsau
Рубрика: Технологические процессы и материалы
Статья в выпуске: 3 т.17, 2016 года.
Бесплатный доступ
Представлены результаты структурных исследований эпитаксиальных пленок ферромагнитного силицида Fe3Si, выращенных методом молекулярно-лучевой эпитаксии на атомарно чистой поверхности Si(111)7×7 при температуре подложки 150 °С. Активное исследование эпитаксиальных металлических пленок на кремнии вызвано необходимостью увеличения быстродействия, уменьшения размеров и повышения энергоэф- фективности устройств микроэлектроники, в том числе используемых в автоматических космических аппаратах. Исследование пленок ферромагнитных силицидов связано с производством наноматериалов для фотоники, микросистемной техники и устройств памяти, что тесно связано с развитием нового направления спиновой электроники, поскольку силициды железа сочетают в себе ферромагнитные и полупроводниковые свойства. Также силицид железа Fe3Si имеет гранецентрированную кубическую структуру и малый параметр рассогасования кристаллической решетки с кремниевой (4,2 %) и германиевой (0,5 %) подложками, что позволяет выращивать монокристаллические пленки Fe3Si в направлении . Методами дифракции электронов изучена структура пленок, которая идентифицирована как монокристаллическая пленка Fe3Si(111), определена толщина и шероховатость пленки, рассчитан угол поворота кристаллической решетки между пленкой Fe3Si и Si-подложкой. Полученные данные необходимы для разработки рекомендаций по улучшению технологии выращивания эпитаксиальных пленок ферромагнитных силицидов.
Ферромагнитный силицид fe3si, молекулярно-лучевая эпитаксия, просвечивающая электронная микроскопия, дифракция в сходящемся пучке
Короткий адрес: https://sciup.org/148177621
IDR: 148177621 | УДК: 620.186.14,
Investigation of the characteristics of Fe3Si epitaxial films grown on Si(111) substrates
The results of structural studies of epitaxial films of the ferromagnetic silicide Fe3Si, grown by molecular beam epitaxy on an atomically clean surface of Si (111)7×7 at a substrate temperature of 150 °C are presented. The active study of epitaxial metal films on silicon is due to the need to increase performance, reduce size and energy efficiency of microelectronics devices used, including, in the automatic spacecraft. The study of the ferromagnetic silicide films associated with the production of nanomaterials for photonics, microsystems technology and memory devices are closely linked with the development of a new direction of spin electronics. This is due to the fact that iron silicide combines ferromagnetic and semiconductor properties. Also Fe3Si silicide has a face-centered cubic structure and a small mismatch lattice parameter with silicon (4.2 %) and germanium (0.5 %) substrates that allows grow Fe3Si single-crystal film in the direction . Using electron diffraction method the structure of the films has been studied and it is identified as a single crystal film of Fe3Si(111), as well as the thickness and roughness of the film and the angle of rotation of the crystal lattice between the Fe3Si film and Si substrate were determined. The obtained data are needed to develop the recommendations to improve the technology of growing of epitaxial ferromagnetic silicide films.
Текст научной статьи Исследование особенностей роста эпитаксиальных пленок Fe3Si, выращенных на Si(111)
Введение. В последнее время активно развивается направление спиновой электроники. Полупроводниковые устройства спинтроники, такие как спин-полевые транзисторы, являются одними из возможных кандидатов для замены существующих на основе кремния металлооксидных полупроводниковых устройств [1–3]. Одной из положительных особенностей спинтроники является нечувствительность к ионизирующему излучению, что особенно востребовано в космической промышленности. В данном аспекте ферромагнитный силицид Fe 3 Si на Si-подложке является перспективным материалом для развития данного направления благодаря высокой температуре Кюри (~ 840 K), относительно высокой магнитной проницаемости, низкой магнитокристаллической анизотропии, высокому электрическому сопротивлению и высокой спиновой поляризации (~ 43 %) [4–6]. Однако из-за неконтролируемого образования различных силицидов на интерфейсе таких структур [7; 8] происходит резкое снижение возможности спинового переноса. Поэтому разработка методики выращивания кристаллов ферромагнитного силицида железа на полупроводниках Si, Ge, GaAs с высококачественным интерфейсом является актуальной задачей. Так, в работах [4; 9; 10] продемонстрированы результаты получения монокристаллической пленки Fe 3 Si на различных подложках. Однако в данных сообщениях не уделяется достаточно внимания особенностям роста пленок силицида. В настоящей работе рассматривается не только технология получения структуры Si(111)/Fe 3 Si, но также исследуется качество выращенных пленок и взаимная ориентация кристаллической решетки Si-подложки и пленки Fe 3 Si.
Эксперимент. Структура Fe 3 Si была получена методом термического испарения в сверхвысоком вакууме на легированной бором атомарно чистой подложке Si(111) (удельное сопротивление 5–10 Ом∙см) на модернизированной установке молекулярнолучевой эпитаксии «Ангара» [11]. Базовый вакуум в технологической камере составлял 1,3 х 10-8 Па. Перед синтезом подложка подвергалась химической обработке с последующим термическим отжигом в сверхвысоком вакууме. Химическая обработка, основанная на методике, предложенной в работе [12], состояла из трех этапов: процесс обезжиривания, удаление естественного слоя оксида с подложки Si и формирование пассивационной пленки из оксида (SiO2) толщиной ~ 1,5 нм на поверхности Si. После химической обработки подложка загружалась в сверхвысокий вакуум, где подвергалась термическому отжигу.
В процессе термического отжига пластина Si(111) постепенно нагревалась в течение 3 часов до 650 °С со скоростью 4 градуса в минуту и выдерживалась при этой температуре 15 мин, причем давление в камере не поднималось выше 5,6х10-7 Па. Далее осуществлялся резкий нагрев подложки до 800 °С с 30-секундной выдержкой, затем температура снижалась снова до 650 °С. Данные «импульсы» производились до тех пор, пока на дифракционной картине отраженных быстрых электронов не появлялись дополнительные рефлексы от реконструированной поверхности Si(111)7×7, что свидетельствовало о получении атомарно чистой поверхности кремния. После получения атомарно чистой поверхности температура подложки снижалась до 150 °С и выдерживалась перед напылением 60 мин.
Одновременное напыление железа и кремния осуществлялось методом термического испарения из двух эффузионных ячеек Кнудсена, изготовленных из высокотемпературного нитрида бора. Скорости осаждения отдельных материалов были откалиброваны методом лазерной эллипсометрии, обеспечивая стехиометрическое для Fe 3 Si соотношение скоростей Si:Fe ≈ 0,57. Процесс формирования структуры контролировался in situ быстродействующим лазерным эллипсометром ЛЭФ-751М [13] и методом дифракции отраженных быстрых электронов.
Для электронно-микроскопических исследований пленки были подготовлены методом поперечного сечения на установке фокусируемого ионного пучка (ФИП) FB-2100 (Hitachi, Япония). Поскольку на установке ФИП имеется только ионная пушка с жидкометаллическим источником ионов Ga+, перед началом приготовления образцов для просвечивающей электронной микроскопии полученные структуры покрывали слоем Ge, толщиной порядка 300 нм, для защиты эпитаксиальной пленки от разрушения ионным пучком в процессе приготовления. Слой германия осаждали методом вакуумного термического испарения при остаточном давлении в камере порядка 10–4 Па при комнатной температуре. Из полученных структур изготавливали ламели размером 10×3 мкм, толщиной порядка 100 нм по стандартной технологии ФИП [14]. Затем для снятия аморфизированного в процессе приготовления на ФИП слоя ламели утонялись в установке ионного травления IV4Pro (Linda Technoorg, Венгрия) при ускоряющем напряжении 1 кВ (5 мин), затем 500 В (15 мин) и 200 В (5 мин) с каждой стороны. Конечная толщина образцов составляла порядка 20–30 нм.
Структурные исследования проводились на просвечивающем электронном микроскопе HT-7700 (Hitachi, Япония) при ускоряющем напряжении 100 кВ. Изображения структуры исследовались методом светлопольной просвечивающей электронной микроскопии в проходящем пучке, исследования ориентационных соотношений проводились методом дифракции в сходящемся пучке [15].
Результаты и обсуждения. На рис. 1 представлено электронно-микроскопическое изображение поперечного сечения структуры Si(111)/Fe3Si. Толщина полученной пленки силицида составляет 70 нм, шероховатость пленки порядка 2–3 нм. Отчетливо видна резкая граница раздела между пленкой и подложкой без реакционного подслоя, что свидетельствует о высоком качестве полученного силицида и правильности выбора используемой технологии и параметров роста.
На рис. 2, а приведена картина электронной дифракция с Si-подложки (область № 1 на рис. 1), полученная методом дифракции в сходящемся пучке, ориентация образца [110]. На рис. 2, б приведена картина дифракции электронов в сходящемся пучке с пленки силицида Fe 3 Si (область № 2 на рис. 1), которая свидетельствует о монокристаллической структуре. Структура пленки идентифицирована как ГЦК-фаза
Fe3Si с ориентацией [110], повернутая на некоторый угол относительно подложки.
На рис. 3, а приведена картина дифракции, полученная с границы раздела пленки силицида и кремниевой подложки (область № 3 на рис. 1). Расшифровка дифракционной картины (рис. 3, б ) подтвердила отсутствие промежуточных фаз на границе раздела. Угол поворота кристаллической решетки пленки силицида относительно кремниевой подложки составляет 70,5°. Поскольку межплоскостное расстояние для Si ( 111) = 0,31 4 нм, Fe 3 Si(111) = 0,327 нм, то рефлек с ы { 111 }Si и { 111 }Si хорошо накладываются на { 11 1 } Fe 3 Si и {1 11 } Fe 3 Si соответственно (рис. 3, б ).
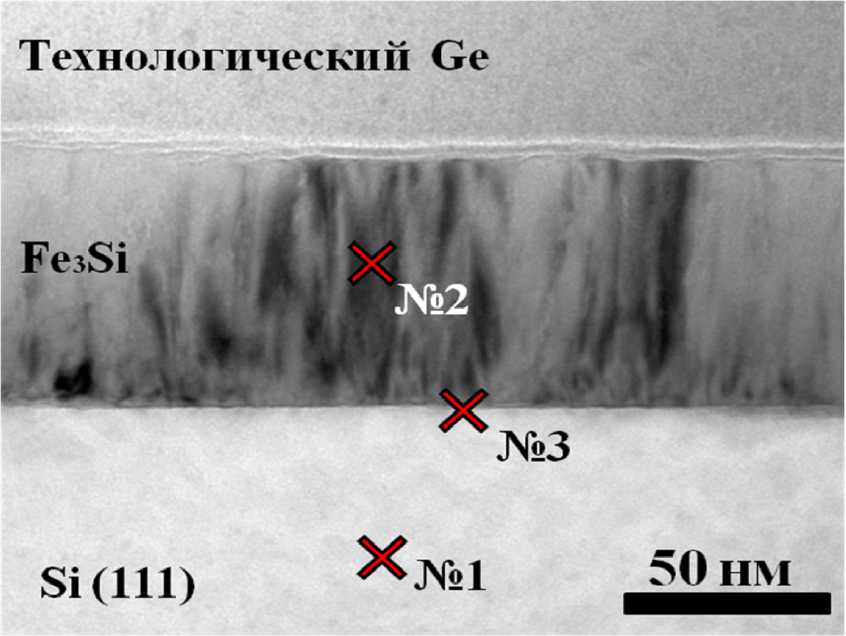
Рис. 1. Поперечное сечение эпитаксиальной пленки Fe3Si на Si(111). Крестиками обозначены области съема дифракции в сходящемся пучке

б
а
Рис. 2. Картины дифракции в сходящемся пучке с Si-подложки (область № 1 на рис. 1) ( а ) и с пленки силицида (область № 2 на рис. 1) ( б )

а б
Рис. 3. Картина дифракции в сходящемся пучке с границы раздела (область № 3 на рис. 1) ( а ) и схема ее расшифровки ( б )
При такой ориентации роста в пленке возникают большие внутренние напряжения, что приводит к образованию изгибных контуров (темные парные полосы на пленке силицида, см. рис. 1) и дефектов кристаллической решетки [16], анализ которых требует дополнительных исследований.
Заключение. Методами просвечивающей электронной микроскопии исследованы эпитаксиальные пленки ферромагнитного Fe 3 Si, полученные методом молекулярно-лучевой эпитаксии при одновременном осаждении из двух источников железа и кремния на атомарно чистую поверхность Si(111)7×7. Толщина полученных пленок составила порядка 70 нм, шероховатость – порядка 2–3 нм. Метод дифракции в сходящемся пучке показал отсутствие промежуточных фаз на границе раздела пленки силицида и кремниевой подложки. Кристаллическая решетка пленок Fe 3 Si имеет ориентацию (111), при этом решетка пленки повернута относительно подложки на 70,5°.
Acknowledgments. The authors are grateful to I. A. Tarasov and I. A. Yakovlev for giving samples of Fe 3 Si/Si(111) and useful discussions. Electron-microscopic investigations were performed on the equipment of KSC SB RAS.
Список литературы Исследование особенностей роста эпитаксиальных пленок Fe3Si, выращенных на Si(111)
- Spintronics: a spin-based electronics vision for the future/S. A. Wolf //Science. 2001. Vol. 294. P. 1488-1495.
- Sugahara S., Tanaka M. A spin metal-oxide-semiconductor field-effect transistor using half-metallic-ferromagnet contacts for the source and drain//Appl. Phys. Lett. 2004. Vol. 84. P. 2307-2309.
- Hall K. C., Flatté M. E. Performance of a spin-based insulated gate field effect transistor//Appl. Phys. Lett. 2006. Vol. 88. P. 162503.
- Epitaxial ferromagnetic Fe3Si/Si(111) structures with high-quality hetero-interfaces/K. Hamaya //Appl. Phys. Lett. 2008. Vol. 93. P. 132117.
- Исследование структурных и магнитных характеристик эпитаксиальных пленок Fe3Si/Si(111)/И. А. Яковлев //Письма в ЖЭТФ. 2014. Т. 99, вып. 9. С. 610-613.
- Оптические свойства эпитаксиальной пленки силицида железа Fe3Si/Si(111)/И. А. Тарасов //Письма в ЖЭТФ. 2014. Т. 99, вып. 10. С. 651-655.
- Structural asymmetry of Si/Fe and Fe/Si interface in Fe/Si multilayers/S. R. Naik //J. Phys. D: Appl. Phys. 2008. Vol. 41. P. 115307.
- Структурные и магнитные характеристики однослойных и многослойных пленок Fe/Si, полученных термическим напылением в сверхвысоком вакууме/С. Н. Варнаков //Письма в ЖТФ. 2005. Т. 31, вып. 22. С. 1-8.
- Temperature dependent epitaxial growth of ferromagnetic silicide Fe3Si on Ge substrate/K. Ueda //Thin Solid Films. 2008. Vol. 517. P. 422-424.
- Structural and magnetic properties of epitaxial Fe3Si/GaAs heterostructures/Y. L. Hsu //Journal of Crystal Growth. 2007. Vol. 301-302. P. 588-591.
- Автоматизация технологического оборудования для получения многослойных структур в сверхвысоком вакууме/С. Н. Варнаков //ПТЭ. 2004. № 6. С. 125-129.
- Ishizaka A., Shiraki Y. Low Temperature Surface Cleaning of Silicon and Its Application to Silicon MBE//J. Electrochem. Soc. 1986. Vol. 133. P. 666-671.
- Эллипсометрическая экспресс-методика определения толщины и профилей оптических постоянных в процессе роста наноструктур Fe/SiO2/Si(100)/И. А. Тарасов //ЖТФ. 2012. Т. 82. С. 44-48.
- TEM Sample Preparation and FIB-Induced Damage/J. Mayer //MRS BULLETIN. 2007. Vol. 32. P. 400-407.
- Фульц Б., Хау Дж. М. Просвечивающая электронная микроскопия и дифрактометрия материалов. М.: Техносфера, 2011. 904 с.
- Электронная микроскопия тонких кристаллов/П. Хирш . М.: Мир, 1968. 575 с.


