Изменение параметров диодов Шоттки под воздействием лазерного излучения
Автор: Бекбергенов С., Базарбаева Ф.М.
Журнал: Теория и практика современной науки @modern-j
Рубрика: Основной раздел
Статья в выпуске: 6 (60), 2020 года.
Бесплатный доступ
В статье рассматриваются изменение параметров диодов шоттки под воздействием лазерного излучения.
Диод, шоттки, лазер, дефект, фактор, кристалл, порог, параметр, полупроводник
Короткий адрес: https://sciup.org/140275513
IDR: 140275513 | УДК: 621.315.592
Changing the parameters of the Schottk diodes under the influence of laser radiation
The article discusses the change in the parameters of Schottky diodes under the influence of laser radiation.
Текст научной статьи Изменение параметров диодов Шоттки под воздействием лазерного излучения
Как нам известно, при изготовлении полупроводниковых диодов в процессе технологических обработок в базовой и приконтактной областях полупроводника возникают дефекты, приводящие к ухудшению функциональных характеристик и параметров приборов. Их улучшение может быть достигнуто дополнительной атермической обработкой на завершающей стадии изготовления приборов путем внешнего воздействия [1-3]. Среди них обращает внимание лазерная обработка полупроводниковых приборных структур. Так, к настоящему времени накоплен большой опыт по лазерному методу формирования омических контактов к целому ряду полупроводниковых материалов. Рассмотрено также влияние лазерных обработок на свойства полупроводниковых материалов, в том числе на GaAs. Предлагается несколько моделей механизмов воздействия лазерного излучения связанных с пороговой плотностью энергии лазерного излучения, при которых наблюдаются изменения морфологии поверхности кристаллов GaAs и InP [4]. Авторы работ [5,6] предполагают, что механизм воздействия лазерного воздействия определяется конкретными условиями и в зависимости от параметров лазерного излучения может быть как тепловым, так и атермическим. В то же время влияние воздействия лазерного излучения на электрические свойства барьерных контактов при малых интенсивностях лазерного излучения, когда отсутствует разложение полупроводникового материала, например GaAs, практически не изучено.
В настоящей работе приводятся результаты исследования влияния малых интенсивностей лазерного излучения при плотности излучения меньше критической на электрофизические характеристики арсенидгаллиевых диодных структур с барьером Шоттки Cr-n-n+-GaAs.
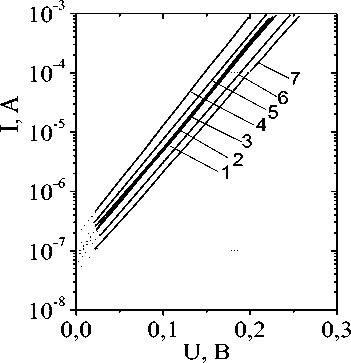
Рис. 1. Прямые ветви ВАХ диода с барьером Шоттки Cr-n-n+-GaAs в зависимости от интенсивности лазерного излучения: 1-исх, 2-7 соответственно 400, 600, 800, 1000, 1200, 1400 Вт/см2.
До и после лазерной обработки измерялись прямые ветви вольтамперных характеристик (ВАХ) диодных структур при комнатной температуре, из которых определялись фактор идеальности n , высота барьера Шоттки ф .
На рис. 1 показана прямая ветвь ВАХ диодной структуры Cr-n-n+-GaAs измеренная при комнатной температуре до и после лазерного облучения.
Рассчитанные из прямых ветвей ВАХ, приведенных на рис.1, величины фв и n представлены в табл.
Табл.
Электрофизические параметры диодов Шоттки Cr-n-n+GaAs до и после лазерной обработки.
|
Парам етры |
Интенсивность лазерного излучения, Вт/см2 |
||||||
|
Исх. |
400 |
600 |
800 |
1000 |
1200 |
1400 |
|
|
ф в , в |
0.71 |
0.71 |
0.71 |
0.70 |
0.69 |
0.71 |
0.74 |
|
n |
1.13 |
1.13 |
1.13 |
1.15 |
1.21 |
1.13 |
1.08 |
|
I s , A |
9,8 x 10 -8 |
9,2 x 10 -8 |
9,0 x 10 -8 |
1,1 x 10 -7 |
10-7 |
5,7 x 10 -8 |
4,1 x 10 -8 |
Из табл. видно, что изменение параметров диодных структур с барьером Шоттки Сr-n-n+GaAs в зависимости от интенсивности лазерного излучения носит немонотонный характер. При интенсивности лазерного излучения 400 и 600 Вт/см2 параметры диодных структур не изменяются.
Увеличение лазерного облучения до 800 и 1000 Вт/см2 сопровождается незначительным уменьшением высоты барьера ϕ В и увеличением фактора идеальности n. Облучение диодных структур при Р=1200 Вт/см2 приводит ВАХ к первоначальному (исходному) состоянию. Обработка диодов Шоттки при интенсивности излучения 1400 Вт/см2 приводит к увеличению ϕ В по сравнению с исходным значением на 0,04 В, а величина n уменьшается на 0,08. При этом величина тока насыщения немонотонно (как и высота барьера Шоттки) изменяется при увеличении интенсивности излучения от 400 Вт/см2 до 1400 Вт/см2 (табл. ).
Наблюдаемые изменения параметров барьеров Шоттки при лазерной обработке 800 и 1000 Вт/см2 связаны, по-видимому с разрушением окисной пленки на границе раздела Cr-GaAs, состоящей из окислов галлия и мышьяка и формированием в приконтактной области GaAs тонкого слоя обогащенного донорами, коими могут выступать собственные дефекты. Эти обстоятельства обусловливают уменьшение высоты барьера ϕ В и уменьшение величины n.
Увеличение интенсивности лазерного излучения до 1200, 1400 Вт/см2 может приводить к дальнейшей модификации приконтактного слоя, обогащая его вакансиями мышьяка, являющимся акцепторами, т.е. в этом слое происходит инверсия типа проводимости.
Резюмируя изложенное можно полагать, что полученные результаты по влиянию лазерного облучения на параметры диодных структур с барьером Шоттки Cr-n-n+-GaAs указывают на возможность управления их параметрами при сравнительно невысоких интенсивностях лазерного излучения.
Список литературы Изменение параметров диодов Шоттки под воздействием лазерного излучения
- Belyaev A.E., Venger E.F., Ermolovich I.B., Konakova R.V., Lytvyn P.M., Milenin V.V., Prokopenko I.V., Svechnikov G.S., Soloviev E.A., Fedorenko L.L. Effect of microwave and laser radiations on the parameters of semiconductor structures. Kiev:, Intas. 2002, 192p.
- Готра З.Ю., Осередько С.А. Управление свойствами поверхностных слоев в технологии микроэлектроники с помощью лазерного излучения. Зарубежная электронная техника, 1985, №12, с.3-50.
- Тагаев М.Б., Камалов А.Б., Бекбергенов С.Е., Насыров М.У. Влияние лазерной и ультразвуковой обработок на электрофизические свойства диодных структур Cr-GaAs. Материалы X Международной конференции "Физика полупроводников тонких пленок". Ивано-Франковск, Украина, 15-21 мая 2005 г, с.123.
- Баимбетов Ф.Б., Джумамухамбетов Н.Г. Механизм воздействия лазерных импульсов на полупроводники AIIIBV. ФХОМ, 1999, №1, с.38-40.
- Качурин Г.А., Нидаев Е.В. Лазерный отжиг точечных дефектов в кремнии и арсениде галлия. ФТП, 1980, т.14, №3, с.424-427.
- Джаманбалин К.К., Дмитриев А.Г. Дислокационная природа туннельного избыточного тока в структурах GaAs-Ni, модифицированного лазерным излучением. ФТП, 2000, т.34, вып.8, с.976-977.


