Эффект переключения электрической проводимости в структурах металл-диэлектрик-металл на основе нестехиометрического оксида кремния
Автор: Захаров П.С., Итальянцев А.Г.
Журнал: Труды Московского физико-технического института @trudy-mipt
Рубрика: Физика
Статья в выпуске: 2 (26) т.7, 2015 года.
Бесплатный доступ
Исследован эффект переключения электрической проводимости в МДМструктурах на основе нестехиометрического оксида кремния, химический состав которого контролировался посредством эллипсометрии. Показано, что такой эффект может устойчиво достигаться на атмосферном воздухе. Многократное и воспроизводимое переключение проводимости наблюдается в структурах с SiO 0,66-SiO 0,95. Отношение сопротивлений в высокоомном и низкоомном состояниях составляет 10 4 - 10 5 . Структуры с окислом слабого отклонения от стехиометрии склонны к необратимому электрическому пробою диэлектрика. На основе изложенного делается предположение о двух возможных механизмах эффекта переключения проводимости, связанных с периодическим выстраиванием и разрушением токопроводящих каналов в окисле: с участием избыточных атомов кремния и/или кислородных вакансий.
Структуры металл-диэлектрик-металл, нестехиометрический оксид кремния, переключение электрической проводимости, эффект памяти, кислородные вакансии, резистивная память
Короткий адрес: https://sciup.org/142186061
IDR: 142186061 | УДК: 538.915
Текст научной статьи Эффект переключения электрической проводимости в структурах металл-диэлектрик-металл на основе нестехиометрического оксида кремния
стать основой для работы перспективных запоминающих устройств. Такой конденсатор выполнен в виде мезаструктуры на кремниевой подложке методами технологии микроэлектроники. Особенностью данного эффекта являлось то, что он проявлял себя лишь при вакуумировании структуры ( 10 -3 Па) и требовал, так называемой, предварительной электроформовки. При дальнейших исследованиях авторами [3 – 5] было показано, что механизм явления связан с возникновением проводящих каналов на торцевой поверхности мезы. Необходимость вакуумирования существенно снижала прикладной интерес к эффекту и его использованию при разработке энергонезависимой памяти на основе обратимого переключения электропроводности ( ReRAM ).
Тем не менее позже появился ряд публикаций [6 – 11], посвященных углубленному изучению механизма «эффекта переключения» в оксиде кремния. В первую очередь интерес был обусловлен исключительной совместимостью данного материала c технологией кремниевых полупроводниковых приборов. На этой стадии изучения было установлено, что обратимый переход пленки SiO 2 к проводящему состоянию обусловлен нарушением ее стехиометрического состава и образованием проводящих микроканалов в поперечном направлении пленки. Это означает, что если соответствующая нестехиометрия будет получена сразу в процессе формирования окисла, то «электроформовка» и мезаструктура не понадобятся, а эффект будет реализован на воздухе. Это предположение было подтверждено в [12, 13], а также в настоящей работе, где структуры имели в своей основе оксид кремния заданного нестехиометрического состава. В [12] избыточное содержание кремния составляло 11%. Такие устройства не требовали электроформовки, потребляли малые токи (<1 мкА) и функционировали при напряжениях свыше 6 В. Это следует считать важным моментом, однако относительно высокие напряжения записи и стирания явились существенным практическим недостатком, т.к. современные КМОП-структуры, выполняющие роль транзисторов доступа к ячейке памяти, функционируют при 3,3 В.
В работе [13] тестовые образцы имеют PECV D -SiO x с чрезмерным избытком кремния (ж < 0 , 75 ). При этом рабочие напряжения снижены до 2 В, но переключение сопровождается высоким энергопотреблением. Кроме того, вновь возникает необходимость в электроформовке.
Таким образом, в едином элементе памяти на основе SiO ^ до сих пор не достигнут комплекс основных характеристик, удовлетворяющих требованиям, которые предъявляются к ReRAM : функционирование без вакуумирования, напряжения записи и считывания не более 3 В, энергопотребление менее 100 пДж и др.
В связи с этим данная работа посвящена исследованию эффекта переключения электрической проводимости, разработке конструкции и технологических аспектов структуры с нестехиометрическим оксидом кремния, обладающей комплексом практически значимых характеристик.
-
2. Экспериментальная часть
Получены и исследованы два типа структур с PECVD-окислом кремния. В первом случае отклонение от стехиометрии было существенным SiO o , 66 —SiO o , 95 . Во втором — содержание избыточного кремния составляло всего 2 ат.%. Химический состав задавался соотношением расходов реагентов (SiH 4 и N 2 O) и контролировался путем измерения показателя преломления SiO ^ . Для первого типа структур эта величина составила п = 1 , 52 . Для второго - п = 1 , 95 . Процесс осаждения проводили при температуре подложки 400 °С. В обоих случаях толщина диэлектрика была равна 40 нм. Верхний и нижний электроды выполнены на основе Al или Pt с помощью магнетронного напыления. Кроме того, с точки зрения профилирования использованы мезаструктуры с «открытым» торцом SiO ^ (рис. 1а), а также структуры со сплошным слоем окисла (рис. 1б). Размер верхнего электрода составлял 100 х 100 мкм 2 . Измерения выполнены с помощью измерителя ВАХ « Agilent В 1500 » и зондовой станции « Cascade Summit 12000 AP ».
Для электроформовки образцов с «открытым» торцом и сильным отклонением от стехиометрии на структуру подавалось напряжение 14–16 В, при этом наблюдалось резкое увеличение тока, который искусственно ограничивался на уровне 0,3–1 мА. После этого диэлектрик переходил в обратимое проводящее состояние. Типичная ВАХ таких структур после электроформовки представлена на рис. 2.
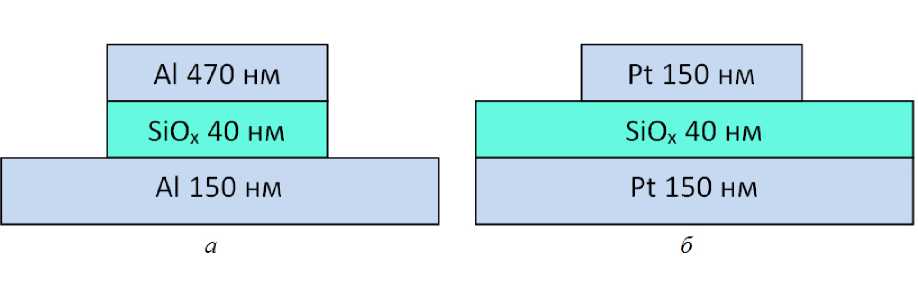
Рис. 1. Исследованные структуры с «открытым» торцом (а) и со сплошным слоем (б) SiO ^
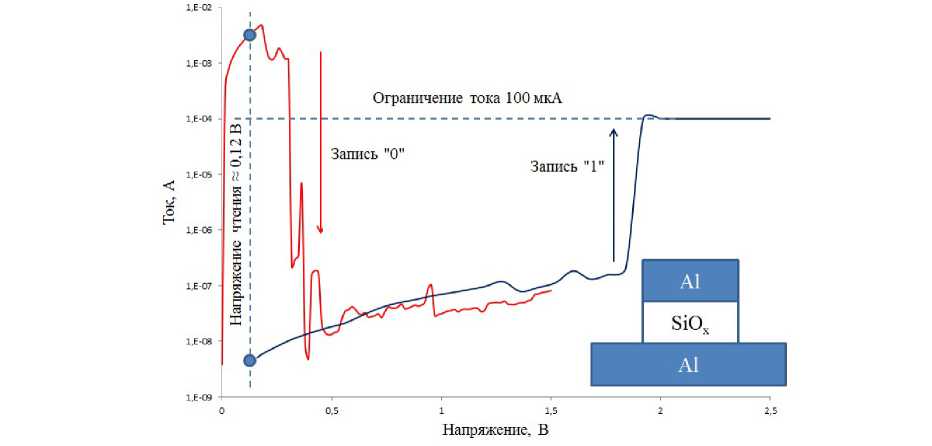
Рис. 2. Типичная ВАХ структуры с сильно нестехиометрическим окислом и «открытым» торцом
Переход из начального состояния структуры с низким электрическим сопротивлением (логическая «1») в состояние логического «0» осуществлялось путем подачи на электроды треугольного импульса напряжения амплитудой 0,6 В. Передний фронт импульса составлял 500 мс, задний – 10 нс. В результате перехода типа «1» -→ «0» проводимость падала в 10 4 – 10 5 раз. Для перехода типа «0» -→ «1», т.е. переключения в проводящее состояние, подавался аналогичный по форме импульс, но с амплитудой 2 В и ограничением тока 100 мкА. Измерения с использованием импульсного генератора ( SPGU ) показали, что данная операция осуществляется менее чем за 100 нс. Ограничение по времени в этом случае определялось аппаратурными возможностями эксперимента.
Установленное состояние логического «0» или «1» сохраняется длительное время после снятия напряжения и может быть впоследствии считано при 0,12 В. Количество циклов запись/стирание, исследованное в эксперименте, превышает 300.
Далее были исследованы образцы аналогичной конструкции — мезаструктуры на основе SiO;r. но со слабым отклонением от стехиометрии (2 ат.% избыточного кремния). В отличие от предыдущего случая режимы электроформовки и перезаписи достигаются лишь при высоких напряжениях порядка 25 В. Считывание происходило при 0,12 В. Переход в состояние логического «0» или «1» сопровождается протеканием тока менее 1 мкА. Однако добиться многократного переключения здесь не удалось вследствие необратимого пробоя диэлектрика.
Для структур со сплошным диэлектриком SiO o , 66 -SiO o , 95 и Pt-электродами (рис. 1б) также наблюдается воспроизводимый эффект переключения проводимости. Напряжения электроформовки и записи логической «1» составляют 10–14 В. Запись логического «0» осуществляется при 2–8 В (рис. 3).

Рис. 3. Типичные ВАХ структуры со сплошной пленкой SiO 0,66 –SiO 0,95
Таким образом, устойчивый эффект переключения электрической проводимости достигается как в мезаструктурах, так и в структурах со сплошным окислом. В обоих случаях требуется сильное отклонение от стехиометрии (SiO o , 66 —SiO o , 95 ). Однако низкие рабочие напряжения получены лишь в образцах с «открытым» торцом.
Что касается механизма исследованного эффекта переключения проводимости в слоях SiO x , то, по всей вероятности, он связан с последовательным и воспроизводимым образованием и разрушением электропроводящих каналов в пленке диэлектрика. Существуют различные мнения по поводу количества этих каналов [3, 8]. Однако, в любом случае, представляется, что эффект обусловлен не единственным каналом проводимости, т.к. он достаточно устойчив и мало зависит от площади электродов. Атомарный механизм эффекта переключения подлежит дальнейшему изучению. Его можно рассматривать либо с точки зрения распада пересыщенного твердого раствора Si в SiO 2 , либо с позиции образования и перестройки вакансий в подрешетке кислорода в зависимости от того, как квалифицировать состояние нестехиометрического оксида кремния. Такая работа авторами будет проведена в дальнейшем.
-
3. Выводы
Таким образом, наряду с [12, 13] в настоящей работе показано, что структура ReRAM на основе SiO ^ способна функционировать не только в вакууме [1, 3 - 11], но и на воздухе, что весьма существенно для прикладных задач создания перспективных микросхем на основе идеально совместимого с кремниевой технологией материала. Это стало возможным благодаря использованию оксида кремния с заранее заданным отклонением от стехиометрического состава.
Список литературы Эффект переключения электрической проводимости в структурах металл-диэлектрик-металл на основе нестехиометрического оксида кремния
- Yao J., Zhong L., Natelson D. Tour J.M. Etching-Dependent Reproducible Memory Switching in Vertical SiO2 Structures//App. Phys. Lett. 2008. V. 93. P. 253101-253101
- Красников Г.Я., Зайцев Н.А. Система кремний-диоксид кремния в субмикронных СБИС. М.: Техносфера, 2003. 384 с
- Yao J., Natelson D., Tour J.M. Resistive Switching in Nanogap Systems on SiO2 Substrates//Small. 2009. V. 5, N 24. P. 2910-2915
- Yao J., Sun Z., Zhong L., Natelson D., Tour J.M. Resistive Switches and Memories from Silicon Oxide//Nano Lett. 2010. V. 10. P. 4105-4110
- Yao J., Zhong L., Natelson D., Tour J.M. Intrinsic Resistive Switching and Memory Effects in Silicon Oxide//Appl. Phys. 2011. V. 102. P. 835-839
- Yao J., Zhong, L., Natelson, D., Tour, J.M. In situ Imaging of the Conducting Filament in a Silicon Oxide Resistive Switch//Nature Scientific Reports. 2012. V. 2. P. 1-5
- Yao, J. Highly Transparent Nonvolatile Resistive Memory Devices from Silicon Oxide and Graphene//Nature Commun. 2012. V. 3. P. 1-8
- Chang Y.-F., Chen P.-Y., Fowler B., Chen Y.-T., Xue F. Understanding the resistive switching characteristics and mechanism in active SiOx-based resistive switching memory//Appl. Phys. 2012. V. 112. P. 123702(1-8)
- Chen Y.-T., Fowler B., Wang Y. . Tristate Operation in Resistive Switching of 𝑆𝑖𝑂2 Thin Films//IEEE electron device letters. 2012. V. 33, N 12. P. 1702-1704
- Chang Y.-F., Chen P.-Y., Chen Y.-T., Xue F., Wang Y., Zhou F., Fowler B.,Lee J.C. Study of polarity effect in SiOx-based resistive switching memory//Appl. Phys. Lett. 2012. V. 101. P. 052111(1-4)
- Chen Y.-T., Fowler B., Wang Y., Xue F., Zhou F., Chang Y.-F., Lee J.C. Random Process of Filamentary Growth and Localized Switching Mechanism in Resistive Switching of 𝑆𝑖𝑂x Thin Films//Journal of Solid State Science and Technology. 2012. V. 1 P. 148-151
- Mehonic A. Resistive switching in silicon suboxide films//Appl. Phys. 2012. V. 111. P. 074507(1-9)
- Wang Y. Resistive switching mechanism in silicon highly rich 𝑆𝑖𝑂x (𝑥 № 0, 75) filmsbased on silicon dangling bonds percolation mode//App. Phys. Lett. 2013. V. 102. P. 042103(1-5)


