Некоторые особенности нового метода формирования микрорельефа путём прямого электронно-лучевого травления резиста
Автор: Брук Марк Аврамович, Жихарев Евгений Николаевич, Стрельцов Дмитрий Ростиславович, Кальнов Владимир Александрович, Спирин Александр Владимирович, Рогожин Александр Евгеньевич
Журнал: Компьютерная оптика @computer-optics
Рубрика: Дифракционная оптика, оптические технологии
Статья в выпуске: 2 т.39, 2015 года.
Бесплатный доступ
Представлены некоторые результаты, касающиеся механизма, особенностей и практических возможностей предложенного авторами прямого метода формирования изображения в некоторых позитивных резистах непосредственно в процессе экспонирования электронным лучом в вакууме. На примере резиста из полиметилметакрилата показано, в частности, что этот метод удобен для получения микро- и наноструктур со скруглённым профилем сечения, а также для получения пространственных 3D-структур с хорошей точностью вертикальных размеров изображения и низкой шероховатостью поверхности. Представленные данные в целом, по мнения авторов, указывают на потенциальные прикладные возможности предлагаемого метода, в частности, для изготовления дифракционных оптических элементов.
Электронно-лучевая литография, новый сухой метод формирования микрорельефа, оптоэлектроника, дифракционные оптические элементы, 3d-структуры
Короткий адрес: https://sciup.org/14059349
IDR: 14059349
Some peculiarities of a new method of microrelief creation by the direct electron-beam etching of resist
We discuss new results concerning the mechanism, characteristics and application potentialities of a novel method that allows an image to be generated in some positive resists directly during exposure by an electron beam in vacuum. In particular, using the PMMA resist as an example, we show that this method is very convenient for obtaining micro- and nano-reliefs with a rounded cross-section profile. Examples are given of obtaining 3D-structures with good accuracy of image vertical size and low surface roughness. In the authors opinion, the data presented show, on the whole, that the suggested method has application potentialities for the manufacture of diffractive optical elements.
Текст научной статьи Некоторые особенности нового метода формирования микрорельефа путём прямого электронно-лучевого травления резиста
При изготовлении дифракционных оптических элементов (ДОЭ) в настоящее время в числе прочих используют методы фото- и электронной литографии [1–4]. При этом для формирования рисунка маски или рельефа с элементами микронных и субмикронных размеров обычно применяют традиционную технологию электронной литографии (ЭЛ), которая помимо прочих операций включает в себя в качестве обязательных стадию экспонирования электронным лучом в вакууме при комнатной температуре слоя полимерного резиста на твёрдом субстрате и последующую невакуумную стадию проявления скрытого изображения, связанную с обработкой образцов большими количествами органических растворителей (см. например [5]). Ниже эту технологию будем называть «мокрой». Основным достоинством мокрого метода ЭЛ при использовании высокоразрешающих позитивных резистов (полиметилметакрилат – ПММА, ZEP и др.) является возможность получения изображения с высоким латеральным разрешением (порядка 10–20 нм). К числу недостатков этого метода как способа изготовления ДОЭ можно отнести:
-
1) необходимость больших доз экспонирования, обусловливающую сравнительно низкую производительность литографического процесса и его высокую стоимость;
-
2) сравнительную сложность получения рельефных структур со скруглённым (сферическим, асферическим, синусоидальным и т.п.) профилем сечения;
-
3) сравнительно невысокую точность вертикальных (по оси Z) размеров получаемого 3D-изображения [6].
Авторами этой статьи предложен [7, 8] новый «сухой» метод формирования изображения в некоторых позитивных резистах непосредственно в процессе экспонирования электронным лучом в вакууме (метод сухого электронно-лучевого травления резиста – метод СЭЛТР). Метод основан на протекании в полимерном резисте в процессе экспонирования при температурах, близких к температуре стеклования (или более высоких температурах), электронно-стимулированной цепной реакции деполимеризации с выделением летучих продуктов (мономера), удаляющихся из резиста непосредственно в ходе экспонирования. Метод применим к резистам, способным в указанных выше условиях к эффективной деполимеризации до мономера (ПММА, другие полиметакрилаты, поли-α-метилстирол, полиме-тилизопропенилкетон и др.). Метод СЭЛТР позволяет приблизительно в 10–300 раз повысить чувствительность ПММА-резиста в электронно-литографическом процессе по сравнению с «мокрой» технологией ЭЛ. Метод позволяет также формировать пространственные 3D-структуры с весьма высоким разрешением по вертикали (порядка 2 нм) и низкой шероховатостью поверхности (до 1 нм), что существенно лучше, чем при использовании мокрого метода. К недостаткам метода СЭЛТР можно отнести невысокое латеральное разрешение (порядка 100–150 нм) и низкий контраст изображения (0,7–1,5). При решении задач, для которых требования к этим параметрам не слишком высоки, метод, по-видимому, может представлять значительный практический интерес.
В данной статье на примере ПММА-резиста представлены некоторые новые результаты, касающиеся механизма, особенностей и практических возможностей метода СЭЛТР. Показано, в частности, что метод СЭЛТР весьма удобен для получения скруглённых рельефных микро- и наноструктур, в том числе сферических (асферических) и синусоидальных, которые могут быть использованы при изготовлении разного рода дифференциальных оптических элементов (ДОЭ).
-
1. Эксперимент
Коммерческий позитивный резист 950K PMMA наносили на кремниевую пластину методом spincoating c последующей сушкой. Толщина слоя резиста Lo составляла от 50 до 1000 нм. Полученный образец помещали на специальный нагреватель, вводили в камеру сканирующего электронного микроскопа
-
2. Результаты и обсуждение
(СЭМ) Camscan S4 или Ultra-55, разогревали до нужной температуры и в вакууме порядка 10-5 – 10-6 мбар подвергали экспонированию электронным лучом при многократном сканировании либо по площади («в кадр»), либо вдоль линии. Изображение в резисте формировалось непосредственно в процессе экспонирования. Размер сечения сфокусированного пучка электронов составлял приблизительно 0,2 мкм в СЭМ Camscan и 10– 15 нм в СЭМ Ultra.
Опыты по формированию пространственного 3D-изображения в виде «ступенек» проводили в ручном режиме следующим образом: на пластине с резистом, разогретой до необходимой температуры, при неизменном положении луча и пластины проводили последовательно несколько экспонирований при сканировании по различным последовательно уменьшающимся площадям. Соотношение линейных размеров площадей сканирования определяло ширину ступеней, формирующихся на краю экспонированной площади. Задача получения ступеней строго одинаковой ширины и высоты в проведённых экспериментах не ставилась. Дозы облучения для каждого экспонирования рассчитывались в соответствии с характеристической (контрастной) кривой травления.
Толщину слоя резиста до и после травления, а также форму получаемых фигур травления определяли на атомно-силовом микроскопе (АСМ) Veeco Multimode 8 с контроллером Nanoscope V в полуконтактном режиме с использованием кремниевого кантилевера с номинальным радиусом кривизны острия зонда 8 нм.
Как уже отмечалось во введении, метод СЭЛТР весьма удобен для получения скруглённых рельефных микро- и наноструктур. Некоторые примеры получения структур такого типа приведены на рис. 1–4.
В частности, на рис. 1 приведено изображение непрерывной структуры со скруглённым рельефом и близким к синусоидальному профилем сечения, полученной непосредственно в процессе экспонирования. На рис . 2 приведена структура с разделёнными линиями.
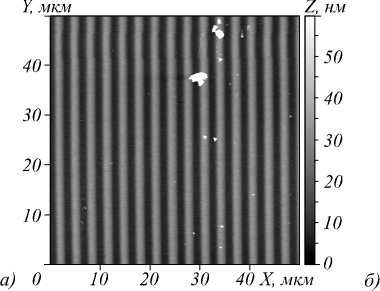
Z, мкм 1-^5


Рис. 1. Непрерывная структура со скруглённым рельефом и близким к синусоидальному профилем сечения. Экспонирование
«в кадр» при 125оС в СЭМ Camscan. Размер кадра – 2×2,6 мм. Энергия электронов E = 20 кэВ. Начальная толщина слоя резиста – L о = 80 нм. Доза, усреднённая по кадру, 0,5 мкКул/см2. Топография (а), трёхмерное изображение (б, г), профиль сечения (в)
На рис. 3 показаны рельефы различной глубины от 190 до 910 нм, полученные в слое резиста с начальной толщиной около 900 нм. Из этого рисунка видно, в частности, как изменяется форма сечения рельефа при изменении глубины «канавок». Следует также обратить внимание на весьма малые дозы экспонирования (0,1–2 мкКул/см2) и довольно большой для электронной литографии размер кадра (3×3,9 мм), что в принципе должно обеспечивать высокую производительность процесса изготовления подобных структур .
На рис. 4 приведены результаты, полученные путём экспонирования на СЭМ Ultra-55. Видно, в частности, что ширина линии получаемого изображения заметно меньше, чем при экспонировании на СЭМ Camscan, что следует связать с существенно меньшим сечением пучка электронов.
Мы полагаем, что путём подбора условий проведения процесса СЭЛТР (параметры электронного пучка, площадь экспонирования, толщина слоя резиста, температура экспонирования, глубина травления и др.) можно получать структуры со скруглённым рельефом самой различной формы.

Рис. 2. Структура с разделёнными линиями. Усреднённая по кадру доза – 0,1 мкКул/см2. Остальные условия получения –
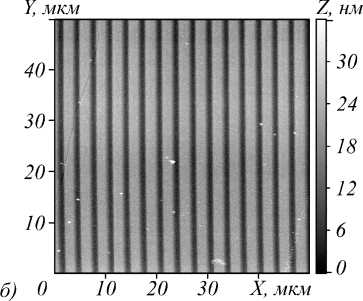
те же, что и на рис. 1: трёхмерное изображение (а), топография (б)
а)


Z, шм г 1,0

,------------------------------,------------------------------с 5
-
д) О 5 X, мкм Y, мкм
Рис. 3. Рельефы, полученные в слое резиста с начальной толщиной около 900 нм. Экспонирование «в кадр» при 160оС в СЭМ Camscan. Размер кадра 3×3,9 мм. E = 20 кэВ. Трёхмерное изображение рельефа глубиной 910 нм (а), топография этого рельефа (б), профили рельефов глубиной 190, 700 и 910 нм соответственно; дозы экспонирования 0,12, 0,48 и 2,04 мкКул/см2 соответственно (в, г, д)
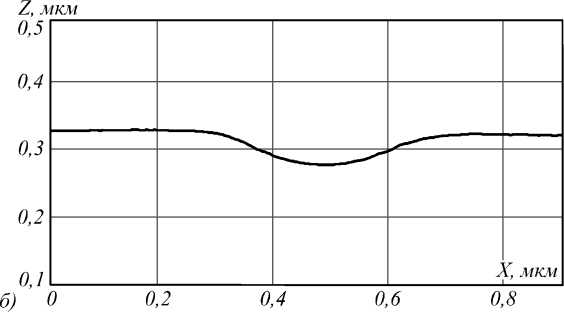
Рис. 4. Изображение линий, полученных методом СЭЛТР на СЭМ Ultra-55 при 116оС. Время экспонирования – 1 с (линия 1)

и 4 с (линия 2). Начальная толщина слоя резиста – 80 нм. Топография (а), профиль сечения линии 2 (б) в реальном (одинаковом по Х и Z) масштабе
В методе СЭЛТР в процессе экспонирования образца при температурах выше температуры стеклования резиста (в случае ПММА выше 100оС) в облучённых образцах протекает электронно-стимулированная цепная химическая реакция деполимеризации, сопровождающаяся выделением большого количества молекул мономера, удаляющегося из резиста в хо- де экспонирования. Приближённый механизм деполимеризации состоит в следующем [10]: при облучении происходит разрыв полимерных молекул резиста с образованием макрорадикалов, способных при повышенных температурах отщеплять молекулы мономера одну за другой по механизму «застежки молнии». При этом формирование рисунка (канавки или ямки травления) по глубине определяется возникновением в облучённой области полимера дополнительного свободного объёма, обусловленного уходом из полимера летучих продуктов (мономера), и вызванной этим объёмной релаксацией (усадкой) полимера под действием сил поверхностного натяжения, которая протекает достаточно быстро по сравнению со временем эксперимента.
В мокрой технологии ЭЛ в процессе экспонирования ПММА, которое проводится при комнатной температуре, под действием электронного облучения также происходит разрыв макромолекул резиста с образованием макрорадикалов. Однако эти макрорадикалы практически не способны отщеплять молекулы мономера, поскольку для реализации этого процесса необходима дополнительная энергия, т.н. «энергия активации», для получения которой комнатная температура слишком низка. Влияние облучения при этом сводится к уменьшению молекулярной массы полимера резиста, что в процессе последующего мокрого проявления приводит к ускоренному растворению резиста в облученных областях.
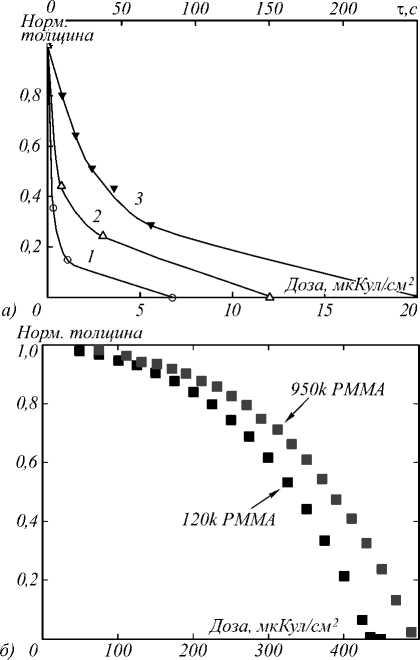
Рис. 5. Нормализованные кривые «толщина слоя – доза» при формировании изображения в ПММА-резисте методом СЭЛТР (а) и мокрым методом (б). Принципиальные различия в форме кривых иллюстрируют различия в механизмах формирования изображения.
Кривые 1, 2 и 3 на рис. 5а получены при температурах экспонирования 170, 150 и 125оС соответственно. Рис. 5a и 5б заимствованы из работ [8] и [9] соответственно
В методе СЭЛТР при экспонировании образца в условиях, когда тормозной путь электрона в резисте
Le много больше начальной толщины слоя Lo (а при энергиях электронов 10 кэВ и более это условие практически всегда соблюдается), процесс травления происходит одновременно по всей толщине слоя резиста. Были получены данные, из которых следует, что при небольшой начальной толщине слоя резиста L o (до 100–150 нм) скорость процесса травления приблизительно одинакова по всей толщине слоя. Иначе говоря, диффузия выделяющегося мономера в газовую фазу протекает достаточно быстро по всей толщине слоя и не лимитирует скорость травления. Соответственно, скорость травления пропорциональна текущей толщине слоя резиста и уменьшается по ходу процесса по мере уменьшения этой толщины, что и определяет специфическую форму кинетических кривых травления на рис. 5 а .
Форма кинетических кривых травления определяет и зависимость ширины линии формирующегося изображения от глубины травления. По мере увеличения глубины линии уширяются.
Как уже отмечалось, для метода СЭЛТР характерна довольно высокая энергетическая эффективность процесса травления. Она обусловлена прежде всего цепным характером деполимеризационного механизма травления, в соответствии с которым образование одного активного центра (макрорадикала), требующее расхода энергия излучения, вызывает самопроизвольное отщепление от макрорадикала сотен и тысяч молекул мономера, улетающих в газовую фазу. Применительно к ПММА-резисту такой механизм позволяет повысить чувствительность резиста в электронно-литографическом процессе приблизительно в 10– 300 раз по сравнению с мокрой технологией. Это открывает возможность существенного повышения производительности литографического процесса и снижения его стоимости.
В работе рассмотрен вопрос о влиянии на скорость травления начальной толщины слоя резиста L o (при прочих равных условиях). Установлено, что при значениях L o , меньших 100–150 нм, начальная скорость травления в абсолютных единицах пропорциональна L o . В области больших толщин слоя эта пропорциональность нарушается. Из рис. 6 следует, что при Lo = 340 нм начальная скорость травления в абсолютных единицах в 1,5–2 раза больше, а в относительных единицах (в долях от начальной толщины) в 2–2,5 раза меньше, чем начальная скорость при Lo = 80 нм. Эти данные, по-видимому, означают, что в слое толщиной 340 нм в ходе травления возникают существенные диффузионные задержки в удалении мономера из глубоких слоёв плёнки резиста, что тормозит процесс травления в целом (если бы таких диффузионных задержек не было, то абсолютная скорость травления при 340 нм должна была быть приблизительно в 4 раза выше, чем при Lo = 80 нм).
Как уже отмечалось выше, метод СЭЛТР весьма удобен также для получения пространственных 3D-структур. Некоторые примеры таких структур лестничного типа приведены на рис. 7 и 8. Совокупность полученных данных позволяет заключить, что метод СЭЛТР даёт возможность формировать пространственные 3D-структуры с весьма высоким разрешением по вертикали (порядка 2 нм) и низкой шероховатостью поверхности (порядка 1 нм), что существенно лучше, чем при использовании мокрого метода [6].
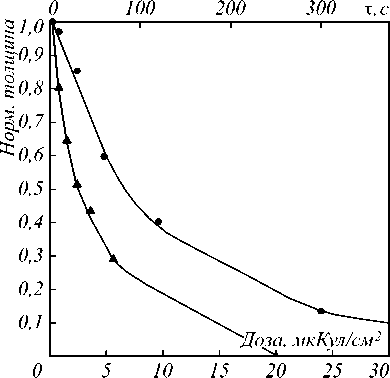
Рис. 6. Нормализованные кривые «толщина слоя – доза» в процессе травления методом СЭЛТР слоёв ПММА-резиста с различной начальной толщиной
Lo = 80 нм (нижняя кривая) и 340 нм (верхняя кривая). Температура экспонирования – 125оС
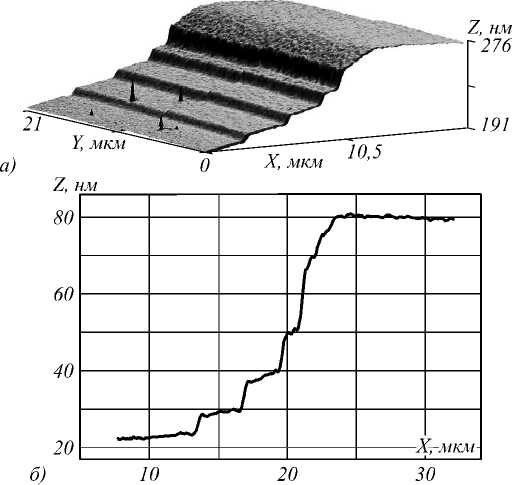
Рис. 7. Изображение лестничной структуры, полученной методом СЭЛТР на СЭМ Ultra-55 при 125оС и L o = 80 нм: трёхмерное изображение (а), профиль сечения (б)
Заключение
Представленные данные в целом, по мнения авторов, указывают на значительные потенциальные прикладные возможности метода СЭЛТР, в частности, для изготовления элементов изделий оптоэлектроники (дифракционных решёток, микролинз и их массивов, фокусаторов, оптических волноводов и др.). Получаемые предлагаемым методом микро- и наноструктуры в резисте могут использоваться либо непосредственно как целевые изделия из материала резиста, либо как маска для переноса рельефа в материал подложки и получения изделий из этого материала, либо как заготовка для получения реплик, штампов и матриц. Характерные размеры сечения получаемых в резисте элементов структур могут составлять приблизительно 0,005–2 мкм по вертикали и 0,2–10 мкм в латеральной плоскости. При переносе изображения на подложку в некоторых случаях имеется принципиальная возможность существенного (до 5–10 раз) увеличения вертикального размера элементов.
Для проведения процесса СЭЛТР можно использовать обычные электронные литографы или электронные микроскопы, снабжённые некоторыми дополнительными опциями, в частности, приставкой для нагрева образца в процессе экспонирования.
Отметим также, что для практической реализации предлагаемого авторами нового метода ЭЛ необхо- димы дополнительные исследования.


Рис. 8. Изображение 10-ступенчатой лестничной структуры, полученной методом СЭЛТР на СЭМ Camscan при 125оС и L o = 340 нм
Список литературы Некоторые особенности нового метода формирования микрорельефа путём прямого электронно-лучевого травления резиста
- Дифракционная нанофотоника/А.В. Гаврилов, Д.Л. Го-ловашкин, Л.Л. Досколович, П.Н. Дьяченко, А.А. Кова-лёв, В.В. Котляр, А.Г. Налимов, Д.В. Нестеренко, В.С. Павельев, Р.В. Скиданов, В.А. Сойфер, С.Н. Хони-на, Я.О. Шуюпова; под ред. В.А. Сойфера. -М.: Физматлит, 2011. -680 с.
- Di Fabrizio, E. Fabrication of Diffractive Optical Elements by Electron Beam Lithography/E.Di Fabrizio, L. Grella, M. Baciocchi, M. Gentili//Diffractive Optics and Optical Microsystems; ed. S. Martellucci, Arthur N. Chester. -New York: Plenum Press, 1997. -P. 149-160.
- Волков, А.В. Формирование микрорельефа ДОЭ с использованием достижений микроэлектроники/А.В. Волков, Р.В. Скиданов//Компьютерная оптика. -2001. -№ 22. -С. 65-71.
- Нестеренко, Д.В. Создание криволинейных дифракционных решёток для ультрафиолетового диапазона/Д.В. Нестеренко, С.Д. Полетаев, О.Ю. Моисеев, Д.М. Якуненкова, А.В. Волков, Р.В. Скиданов//Известия Самарского научного центра Российской академии наук. -2011. -Т. 13, №4. -С. 66-71.
- Валиев, К.А. Физика субмикронной литографии/К.А. Валиев. -М.: Наука, 1990. -528 с.
- Murali, R. Metrology for Grayscale Lithography/R. Murali//AIP Conference Proceedings. -2007. -Vol. 931. -P. 419-422.
- Брук, М.А. Способ формирования маскирующего изображения в позитивных электронных резистах/М.А. Брук, Е.Н. Жихарев, В.А. Кальнов, А.В. Спирин, Д.Р. Стрельцов//Патент РФ на изобретение №2478226 от 06.09.2011, Бюл. № 9.
- Bruk, M.A. The new dry method of mask (relief) formation by direct electron-beam etching of resist/M.A. Bruk, E.N. Zhikharev, D.R. Streltsov, V.A. Kalnov, A.V. Spirin//Microelectronic Engineering. -2013. -Vol. 112. -P. 1-4.
- Schleunitz, A. Combining nanoimprint lithography and a molecular weight selective thermal reflow for the generation of mixed 3D structures/A. Schleunitz, Ch. Spreu, M. Vog-ler, H. Atasoy and H. Schift//J. Vac. Sci. Technol. B. -2011. -Vol. 29. -P. 06FC01.
- Брук, М.А. Радиационная деполимеризация полиметил-метакрилата, адсорбированного на силохроме/М.А. Брук, М.В. Кондратьева, А.А. Баранов, К.В. Пе-балк, А.М. Сергеев, Н.В. Козлова//Высокомолекулярные соединения. Серия А. -1999. -Т. 41, № 2. -С. 256-262.


