NEXAFS и XPS исследования пористого кремния
Автор: Некипелов С.В., Ломов А.А., Мингалева А.Е., Петрова О.В., Сивков Д.В., Шомысов Н.Н., Шустова Е.Н., Сивков В.Н.
Журнал: Известия Коми научного центра УрО РАН @izvestia-komisc
Рубрика: Физико-математические науки
Статья в выпуске: 3 (35), 2018 года.
Бесплатный доступ
Методами ультрамягкой рентгеновской спектроскопии с применением синхротронного излучения исследованы пористые слои кремния с различными типами проводимости. Определена эффективная толщина оксида на поверхности кремниевого скелетона и изучена структура интерфейса на границе кремний/оксид кремния. Показано, что тонкая структура спектров поглощения Si 2p кремниевого скелета совпадает с тонкой структурой спектра кристаллического кремния, а толщина оксидного слоя на поверхности пористого кремния 1,8-2,4 нм для различных образцов. Параметр x в стехиометрической формуле SiOх оксида кремния находится в диапазоне 1,66-1,82.
Пористый кремний, оксидный слой, nexafs-спектроскопия, xps-спектроскопия
Короткий адрес: https://sciup.org/149128785
IDR: 149128785 | УДК: 538.9 | DOI: 10.19110/1994-5655-2018-3-19-22
NEXAFS and XPS studies of porous silicon
By ultra-soft x-ray spectroscopy methods with the use of synchrotron radiation, porous layers of silicon with various types of conductivity were investigated. The effective thickness of the oxide on the surface of a silicon skeleton was determined and the interface structure at the silicon/silicon oxides interface was studied. It was shown that the fine structure of the Si 2p absorption spectra of the silicon skeleton is identical to that of the spectrum of crystalline silicon, and the thickness of the oxide layer on the surface of porous silicon is 1.8-2.4 nm for various samples.The parameter x in the stoichiometric formula SiOх of silicon oxide is in the range of 1,66-1,82.
Текст научной статьи NEXAFS и XPS исследования пористого кремния
Пористый кремний (ПК) и другие пористые полупроводниковые материалы представляют большой фундаментальный и прикладной интерес в связи с проявлением в них как квантоворазмерного эффекта, так и простотой управления параметрами пор и пористого скелета [1]. Несмотря на активное изучение условий синтеза и модификации ПК, к настоящему времени имеется достаточно много открытых вопросов как в процессах формирования ПК, так и его диагностики. В частности, является актуальным изучение воздействия йода на процесс анодирования и на характеристики ПК, а также получение детальной информации о физике и химии поверхности ПК. В настоящей работе проводятся спектральные исследования с применением синхротронного излучения (СИ) слоев ПК, сформированных на стандартных подложках кремния, леги- рованных сурьмой (Si(111)(Sb) КЭС, n-тип, 0.01 Ом·см) и бором (Si(111)(B) КДБ, р-типа, 0.005 Ом·см) методом анодирования в стандартном электролите без и с добавлением 5%-ного раствора йода. При этом большое внимание уделяется изучению рентгеновских фотоэлектронных спектров (x-ray photoelectron spectra, XPS) и ближней тонкой структуры рентгеновских спектров поглощения (near edge fine x-ray absorption structure, NEXAFS) в области Si 2р – порога ионизации. Методы ультра-мягкой рентгеновской спектроскопии с применением СИ информативны для изучения приповерхностного слоя пористого кремния, поскольку дают возможность исследовать изменения состава приповерхностных слоев с глубиной в наноразмерной шкале, получать информацию о ближайшем окружении поглотившего рентгеновский квант атома и тестировать изменение атомного и химического состава поверхности ПК без ее разрушения и моди- фикации [2, 3]. В настоящей работе NEXAFS-исследования совместно с XPS – измерениями применяются для определения эффективной толщины оксида на поверхности кремниевого скелетона и изучения структуры интерфейса на границе ПК/ок-сид кремния.
Результаты и обсуждение
Исследования проводились на российско-германском канале источника синхротронного излучения BESSY-II (г. Берлин). Все спектры были получены методом полного электронного выхода (Total electron yield, TEY).
Полученные в настоящей работе NEXAFS Si2p-спектры приведены на рис. 1, из которых видно явное сходство тонкой структуры изученных образцов ПК. NEXAFS Si 2 p -спектров поглощения ПК может быть разделена на две области 99-103 эВ и 103-110 эВ и состоит из дублетных полос поглощения ( a 1 a 2 ), ( b 1 b 2 ), ( c 1 c 2 ), ( d 1 d 2 ) и e 1 , 2 с расщеплением 0 . 55-0 . 63 эВ, близким к разности (0.61 эВ) энергий связей Si 2 p 3 / 2 - и Si2 p 1 / 2 -атомных уровней.
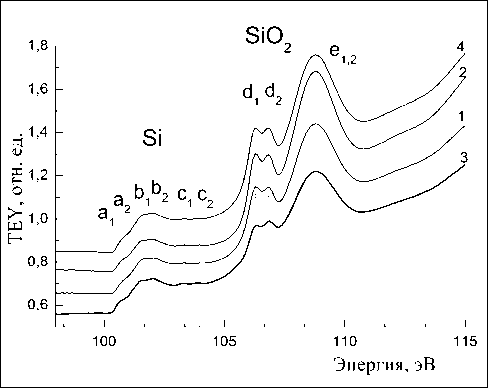
Рис. 1. NEXAFS Si2p-спектры образцов ПК: КДБ (1,2), КЭС (3,4), приготовленные травлением в электролите без (1,3) и с добавлением йода (2,4).
Fig. 1. NEXAFS Si2p spectra of PC samples: SHB (1,2), SES (3,4), etching in the electrolyte without (1,3) and with the addition of iodine (2,4).
По форме спектров и энергетическим положениям элементов тонкой структуры первая область NEXAFS Si2p – спектров может быть определенно идентифицирована как структура, связанная с кристаллическим кремнием (полосы a - c ), а вторая – с кристаллическим SiO 2 (полосы d - e ), что позволяет утверждать, что на поверхности ПК под длительным воздействием атмосферного кислорода формируется слой хорошо координированного SiO 2 .
Наличие четкой структуры металлического кремния, обусловленной сигналом TEY от рентгеновских фотоэлектронов (~90 эВ), вышедших из-под слоя оксида, дает возможность оценить толщину этого слоя deff близкой к их длине свободного пробега, т.е. порядка 1 нм. Более точные значения оксидного слоя на поверхности кремниевого скелета измерялись методом XPS.
XPS - исследования ПК проводились с целью выяснения наличия йода в кремниевом скелетоне и оценки толщины оксидного слоя на его поверхности. В первом случае для получения обзорных спектров использовалось синхротронное излучение с энергией 1000 эВ, во втором случае измерения проводились для энергий квантов 250, 400, 650 и 1000 эВ. Обзорные XPS всех изученных образцов независимо от типа проводимости и наличия в растворителе йода определяются одинаковым набором характерных пиков и отсутствием структуры, связанной с атомами йода.
На рис.2 представлены Si 2p-спектры образца ПК для разных энергий квантов hν, нормированные по интенсивности на пик SiO 2 (I 2 ). Положение основных пиков соответствует энергиям связи 2р-электронов атомов кремния в чистых Si (E 1 = 99,8 эВ) и SiO 2 (E 2 = 103,3эВ). Это указывает на то, что на поверхности ПК находится слой SiO 2 и его толщина сравнима с длинами свободного пробега λ 2

Рис.2. XPS Si 2p-спектры образца КЭС (4) для различных энергий падающих рентгеновских квантов. Спектры нормированы на интенсивность пика оксида кремния. Стрелками соответственно обозначены положения энергии связи в Si и SiO2.
Fig.2. XPS Si2p-spectra of samples SES (4) for various energies of incident X-ray. The spectra are normalized to the intensity of the silicon oxide peak. The arrows indicate the positions of the binding energy in Si and SiO 2 , respectively.
электронов в SiO 2 с кинетическими энергиями, равными разности hν и E 1 .Эти λ 2 равны 0.88, 1.27, 1.9 и 2.72 нм [4] для энергий квантов 250, 400, 650 и 1000 эВ, соответственно.
Для идентификации вклада слоев Si и SiO2 в структуру XPS-спектров нами проведено разложение спектра на отдельные пики с учетом вклада в интенсивность от других линий, которые в нашем случае представлялись как фон (back-ground). В простейшей модели можно рассматривать двухслойную структуру SiO2/Si, в которой нам удалось достаточно хорошо аппроксимировать гауссовскими пиками полосы от кремния (99,3 эВ) и оксида кремния (103,4 эВ). Однако область между основ- ными пиками от 100 – 103 эВ в рамках данного приближения описывалась неудовлетворительно.
Для улучшения аппроксимации была рассмотрена 5-слойная структура, содержащая, кроме основных слоев оксида кремния SiO 2 (Si4+) и чистого кремния Si (Si0), еще и переходные слои SiO x , в которых атом кремния находился в состояниях Si3+, Si2+ и Si+. Результаты данного разложения для энергии падающих квантов 250 эВ представлены на рис.3.

Рис.3. XPS Si2p-спектры пористого кремния для образца КЭС (4) при энергии падающего рентгеновского кванта 650 эВ.
Fig.3. XPS Si2p spectra of porous silicon for an SES sample (4) at an incident x-ray quantum energy of 650 eV.
В процессе разложения спектра для вычленения фона использовалась Shirley-аппроксимация, а спектральные пики аппроксимировались гауссовскими кривыми. Для уменьшения параметров варьирования принималось статистическое отношение интегральных интенсивностей пиков Si 3/2 /Si 1/2 = 2 и спин-орбитальное расщепление между ними бралось 0,61 эВ [5]. В табл. 1 приведены результаты обработки спектров при энергиях падающих квантов 250 и 650 эВ, где указаны положения (в эВ) и интегральная интенсивность Si 3/2 - компоненты.
Таблица 1 Результаты разложения XPS-спектров образца
КЭС (4) при различных энергиях падающих h ν квантов
Table 1
Results of the XPS spectra decomposition for the SES sample (4) at various incident h ν quanta energies
|
hν=250 эВ |
hν=650 эВ |
|||
|
Пик |
Есв |
I |
Есв |
I |
|
Si4+ |
103,13 |
1,000 |
103,09 |
1,000 |
|
Si3+ |
101,78 |
0,037 |
101,60 |
0,313 |
|
Si2+ |
100,45 |
0,007 |
100,45 |
0,057 |
|
Si1+ |
99,90 |
0,010 |
99,92 |
0,084 |
|
Si0 |
98,91 |
0,063 |
98,87 |
0,538 |
Энергетические положения для Si3+, Si2+ и Si+-пиков хорошо коррелируют с результатами, полученными в работе [5].
Интенсивности линий Il в XPS спектрах, описывающих эмиссию электронов с l- уровня, имеют сложную зависимость:
( - ^
λ cos θ
I l - n l ^ l J ^ S 1 - e
к J
где n l – концентрация атомов, ассоциирующихся с l - линией в спектре, σ l – сечение, испуская фотоэлектрон из данной подоболочки атома, зависящее от энергии падающего рентгеновского кванта hν , J – интенсивность падающего излучения, θ – угол вылета фотоэлектронов, отсчитываемый от нормали к образцу, λ – длина свободного пробега электрона в исследуемом образце, S – чувствительность установки. Следует отметить, что λ определяется энергией E kin вылетевшего фотоэлектрона , а S зависит от энергии падающего кванта hν, конкретных условий съемки и работы анализатора.
Если же мы имеем двухслойную структуру, когда образец сорта В покрыт тонким слоем другого вещества (сорта А), то интенсивность линий в XPS образца В будет иметь вид:
dB dA
----
λ cos θ λ cos θ
I B - n B ^ B J B X B S B ( 1 - e ) e . (2)
Вторая экспонента в формуле (2) связана с поглощением фотоэлектронов из образца В в покрывающем слое образца А.
В случае многослойной структуры получается система уравнений:
d k d i
I s , - n „ a tJt X tSt (1 - e l - c” e ) П e Л ' cos " , (3)
i - k - 1
где k=0…4 соответствует пикам от Si до Si4+.
Зная параметры спектров и решая систему (3), можно найти толщины слоев Si4+, Si3+, Si2+ и Si+ на поверхности чистого пористого кремния. Параметры и результаты расчетов представлены в табл. 2 и рис. 3. При моделировании длина свободного пробега в слоях Si3+, Si2+ и Si+ бралась в виде линейной аппроксимации данных для слоев Si4+ и Si0 [4], а величины J k и S k в формулах (3) – константами при фиксированной энергии падающего рентгеновского кванта для пиков в рамках одного спектра. Как видно из табл. 2, вне независимости от энергии падающего кванта результаты моделирования дают примерно одинаковые результаты для толщины d
Таблица 2
Результаты моделирования оксидных слоев на поверхности образца КЭС (4)
Table 2
The modeling results of oxide layers on the surface of the SES sample (4)
|
hν= 250 э В |
hν=650 эВ |
|||||||
|
n [5] |
λ (nm) |
σ[5] |
d(nm) |
n [5] |
λ (nm) |
σ[5] |
d(nm) |
|
|
Si0 |
1 |
0.656 [4] |
1 |
1 |
1,561 [4] |
1 |
||
|
Si1+ |
0,86 |
0,711 |
1,06 |
0,08 |
0,86 |
1,645 |
1,025 |
0,12 |
|
Si2+ |
0,73 |
0,766 |
1,12 |
0,05 |
0,73 |
1,729 |
1,05 |
0,04 |
|
Si3+ |
0,59 |
0,820 |
1,18 |
0,27 |
0,59 |
1,813 |
1,075 |
0,20 |
|
Si4+ |
0,46 |
0,875 [4] |
1,25 |
2,10 |
0,46 |
1,897 [4] |
1,1 |
2,32 |
Таблица 3
Толщины оксидных слоев (в нм) и стехиометрические формулы для исследуемых образцов
Thicknesses of oxide layers (in nm) and stoichiometric formulas for the investigated samples
Table 3
Работа выполнена при финансовой поддержке грантов РФФИ и Республики Коми №1642-110610 р-а, 16-43-110350 р-а, Программы фундаментальных исследований УрО РАН 18-10-223 и Программы повышения конкурентноспособности Балтийского федерального университета им. И. Канта.
Список литературы NEXAFS и XPS исследования пористого кремния
- Canham L.T. Silicon quantum wire array fabrication by electrochemical and chemical dissolution of wafers // Appl. Phys. Lett. 1990. Vol.57. №10. P. 1046-1048
- Stohr J. NEXAFS spectroscopy. Berlin. Springer, 1992. 403 p
- X-Ray and Synchrotron Studies of Porous Silicon / V.N.Sivkov, A.A.Lomov, A.L.Vasil'ev, S.V.Nekipelov and O.V.Petrova // Semiconductors. 2013. Vol. 47, № 8. P. 1051-1057
- NIST Electron Inelastic-Mean-Free-Path Data- base (http://www.nist.gov/srd/nist71.cfm 3)
- Full field chemical imaging of buried native sub-oxide layers on doped silicon patterns / F. de la Peсa, N. Barrett, L.F. Zagonel, M. Walls,O. Renault //Surface Science. 2010. Vol. 604. P.1628-1636


