Новый высокоинтенсивный "точечный" источник электронов
Автор: Птицын В.Э.
Журнал: Научное приборостроение @nauchnoe-priborostroenie
Рубрика: Оригинальные статьи
Статья в выпуске: 4 т.15, 2005 года.
Бесплатный доступ
Разработана физическая технология формирования самоорганизованных наногетероструктур, образованных тонким (~ 5-10 нм) слоем диэлектрика (ZrO2) на поверхности острийного микрокристалла W . Проведено исследование термоактивированного процесса электронной эмиссии в вакуум с поверхности границы раздела ZrO2-вакуум в условиях воздействия на наногетероструктуру электростатического поля. Показано, что закономерности электронной эмиссии не согласуются с теорией явления термополевой эмиссии. Исследованному явлению дано специальное наименование "аномальная термополевая эмиссия". Установлено, что в режиме аномальной термополевой эмиссии приведенная яркость и угловая интенсивность эмиссии с поверхности наногетероструктуры на два порядка величины превосходят аналогичные параметры ZrO/W Шоттки-катодов. Предложена феноменологическая модель механизма аномальной термополевой эмиссии.
Короткий адрес: https://sciup.org/14264403
IDR: 14264403 | УДК: 537.533.2:
New high-intensity point electron source
The paper presents a new physical technology to produce self-assembled nanoheterostructures formed in thin (~5-10 nm) (ZrO2) dielectric layers at the surface of pointed W microcrystals. The studies of thermally activated electron emission from the ZrO2-vacuum interface into vacuum under electrostatic field have shown that the electron emission behavior does not agree with the thermal field emission theory. The phenomenon studied was called the abnormal thermal field emission. It has been found that the normalized brightness and angular intensity of emission from the nanoheterostructure surface are two orders of magnitude higher than those of ZrO/W Schottky cathodes. A phenomenological model for the mechanism of thermal field emission is offered.
Текст научной статьи Новый высокоинтенсивный "точечный" источник электронов
Для характеристики электронного пучка в области его взаимодействия с поверхностью исследуемого образца (или мишенью), как известно [1], принято использовать следующий ряд основных электронно-оптических параметров: приведенная яркость в [ЛДм^срЪ)], угловая интенсивность 9 [А/ср], а также плотность мощности η [Вт/м2].
В настоящее время для решения научнотехнологических задач в различных областях физики и химии поверхности, а также микро- и наноэлектроники широко используются приборы растровой электронной микроскопии, спектроскопии и установки электронной литографии. Источником электронов в большинстве указанных приборов и установок являются так называемые ZrO/W<100> Шоттки-катоды [2]. Как показано в [3], электронный микрозонд, сформированный электронно-оптической системой (ЭОС) с ZrO/W<100> Шоттки-катодом, на поверхности образца имеет весьма высокий уровень приведенной яркости в ~ 10 8 Л/(м 2 ^срЪ).
Однако для реализации ряда перспективных научно-технологических проектов [4–8] необходимы электронные пучки, у которых уровень в должен достигать значений порядка ~ 1010 A/(м2·ср·В) а уровень η до ~ 1 ТВт/см2.
Принимая во внимание теорему Лиувилля [1], легко видеть, что задача формирования пучков с вышеуказанными параметрами не может быть решена посредством оптимизации или же усовершенствования электронной и магнитной оптики существующих ЭОС, так как современные ЭОС характеризуются аберрационными коэффициен- тами, которые практически близки к предельным минимальным значениям.
Цель настоящей работы заключалась в поиске подходов и методов создания нового класса источников электронов, для которых такие эмиссионные параметры, как β и θ , значительно (на порядки величины) превосходят аналогичные параметры существующих ZrO/W<100> Шоттки-катодов.
О ПОСТАНОВКЕ ЗАДАЧИ ИССЛЕДОВАНИЙ
Как известно [9], в условиях термополевой эмиссии (ТFЕ) электронов теоретически возможные значения плотности тока эмиссии J, а также в cущественно (на три, четыре порядка величины) превышают соответствующие величины, характерные для режимов Шоттки-эмиссии (SE) и расширенной (Extended) Шоттки-эмиссии (ESE).
В связи с этим первоначально исследовалась возможность создания высокоинтенсивных и высокостабильных источников электронов, которые были бы способны функционировать в условиях TFE. Для этих исследований использовались как острийные эмиттеры, изготовленные из тугоплавких переходных металлов (W, Mo, Ta, Nb), так и ZrO/W<100> Шоттки-катоды (эмиттеры). Отметим здесь, что вершина острийного эмиттера обычно представляет собой микрокристалл (МК) заданной кристаллографической ориентации, причем поверхность вершины острийного МК либо является атомарно-чистой, либо, как это имеет место для ZrO/W<100> Шоттки-катодов, покрыта монослоем адсорбата.
Выполненные эксперименты показали, что в условиях TFE при температурах (Ts), превышаю- щих ~ 1500 К, эмиттеры с атомарно-чистой поверхностью, а также ZrO/W<100> Шоттки-катоды являются нестабильными источниками электронов. Физический механизм взаимосвязанных термополевых процессов, которые приводят к нестабильности тока эмиссии, возбуждению неустойчивости тока TFE и вакуумному пробою, описан в [10, 11]. Как показано в [10, 11], в условиях интенсивной TFE вакуумный пробой вполне закономерно развивается в сильных электрических полях (Fs ~ 5.0·107 В/см) в результате формирования у вершины МК плазменного сгустка, ионная составляющая которого образуется вследствие полевой и ударной ионизации испаряющихся собственных поверхностных атомов вещества МК.
Таким образом, если опустить более подробное рассмотрение всего комплекса взаимосвязанных термополевых процессов, то на основании проведенных исследований можно констатировать, что в условиях интенсивной TFE (т. е. при T s ≥ (1500– 2000) К, F s ≥ (4.0–5.0)·107 В/см) как острийные эмиттеры, изготовленные по "классической" технологии Э. Мюллера [12], так и эмиттеры, изготовленные по стандартной технологии формирования ZrO/W<100> Шоттки-катодов [2], непригодны для практического использования в качестве стационарных источников электронов (катодов) в ЭОС различного назначения. Заметим, что вышесказанное не относится к так называемым автоэлектронным (или, как их сейчас принято называть, полевым) катодам, которые нашли практическое применение в просвечивающей и растровой электронной микроскопии сверхвысокого разрешения и успешно эксплуатируются в условиях T s = (77–300) К и F s< 4.0 107 В/см и соответственно характеризуются следующими эмиссионными параметрами: J ≤ 104 А/см2 и β < 108 A/(м2·ср·В).
Другое важное следствие, очевидно, заключается в том, что поставленная в работе задача разработки и создания новых высокоинтенсивных стабильных источников электронов, способных функционировать в условиях интенсивной TFE, не может быть решена на основе традиционных технологических методов формирования острийных эмиттеров [2, 12].
В связи с этим в основу изложенного ниже метода создания новых высокоинтенсивных стабильных источников электронов были положены результаты работ [10, 13]. В этих работах было обнаружено, что интенсивная эмиссия (~ 103 А/см2) электронов с поверхности широкозонных полупроводниковых острийных эмиттеров (на основе МК CdS) может возбуждаться при весьма низких значениях напряженности поля (≤ 50 В/мкм) на границе раздела полупроводник—вакуум. В [10, 13] показано, что на процесс эмиссии, активируемой электрическим полем, могут оказывать существенное влияние такие факторы, как степень ле- гирования CdS (атомами Ni) и температура эмиттера (Ts). Оказалось, что при относительно низкой степени легирования (nNi ~ 1016 см–3) процесс электронной эмиссии возбуждается при невысоких значениях (менее ≈ 100–300 В) экстрагирующего потенциала (Ve), причем зависимость полного тока эмиссии (I) от Ve не подчиняется закону Фауле-ра—Нордгейма, а описывается степеннóй функцией вида: I ~ (Ve)n, где n ≈ 2 ± 0.1. Кроме того, было показано, что при прочих равных условиях в широком диапазоне значений Ve низколегированный CdS-эмиттер по сравнению с высоколегированным (nNi ~ 1019 см–3) CdS-эмиттером имеет более высокие (на один, два порядка величины) значения β и θ. Анализ обнаруженных "аномалий" в закономерностях эмиссионного процесса с поверхности CdS показал [10], что в случае низколегированных широкозонных полупроводников (или диэлектриков) в запрещенной зоне этих эмиттеров при определенных условиях формируется связанный (на локализованных состояниях (ловушках)) пространственный заряд, который даже при низком экстрагирующем потенциале на вытягивающем электроде создает сильные электростатические поля (~ 103 В/мкм и выше) на границе раздела (контакте) металл—полупроводник (диэлектрик). В сильном электрическом поле потенциальный барьер на границе раздела становится туннельнопрозрачным для электронов металла. Последующий перенос инжектированного в объем полупроводника (диэлектрика) потока электронов может осуществляться как по баллистическому, так и по прыжковому механизму. Развитые в [10] представления хорошо согласовались с теорией переноса заряда в гетерофазных макроструктурах типа: металл—диэлектрик—металл (вакуум), для которых (при монополярном характере инжекции носителей заряда в вещество диэлектрика) плотность тока проводимости пропорциональна квадрату разности потенциалов между поверхностями инжекции и стока носителей [14, 15].
Дальнейшие широкие исследования эмиссионных свойств систем металл—диэлектрик—вакуум, в которых в качестве вещества диэлектрика использовались углеродные и алмазоподобные пленки, а также графитовые нанотрубки и фуллерены, проводились и ведутся до настоящего времени во многих странах. Однако до последнего времени проблема, которую теперь принято называть "Low Macroscopic — Field Electron Emission" (LMFE), остается нерешенной [16]. Теория явления LMFE, которая была бы адекватна многочисленным экспериментальным данным, пока не создана, а применяемые физические нанотехнологии формирования металлопленочных систем не позволяют создавать источники электронов с априорно заданными и воспроизводимыми эмиссионными параметрами. Кроме того, разработанные экспериментальные образцы источников электронов на основе явления LMFE характеризуются сравнительно невысокими уровнями β и J и низкой временнóй стабильностью. Неудовлетворительная воспроизводимость эмиссионных свойств больших (~ 10–100 см2) металлопленочных макросистем может быть [16] обусловлена как локальной неоднородностью структуры границы раздела: металл—диэлектрик, так и зависимостью функции распределения плотности локализованных состояний в запрещенной зоне диэлектрика от вариаций и особенностей в нанотехнологиях формирования диэлектрических пленок, применяемых в различных экспериментах.
Учитывая вышеперечисленные факторы, для создания прототипа нового высокоинтенсивного источника электронов была выбрана наногетероструктура (НГ), представляющая собой тонкую пленку (~ 5–10 нм) особочистого ZrO 2 на поверхности вершины острийного МК W<100>, радиус закругления вершины которого составлял ~ 0.2– 1.0 мкм.
Важно отметить здесь, что в отличие от ZrO/W<100> Шоттки-катодов, у которых толщина слоя адсорбата примерно равна одному монослою
(т. е. ~ 0.3 нм), в настоящей работе толщина слоя ZrO2 была многократно увеличена. Это позволяет при интерпретации результатов измерений рассматривать пленку ZrO 2 как конденсированное вещество и соответственно использовать известные представления физики конденсированного состояния.
Для формирования пленок ZrO 2 заданной толщины использовался как метод молекулярнопучковой эпитаксии, так и метод автоэпитаксии ZrО 2 в условиях воздействия на НГ сильных электрических и тепловых полей. Для контроля за толщиной слоя диэлектрика применялся импульсный режим возбуждения эмиссии с поверхности формируемой НГ [10]. Оценка толщины слоя ZrO 2 осуществлялась посредством измерения характерных времен переходного процесса на осциллограммах эмиссионного тока [10, 14].
После разработки нанотехнологии воспроизводимого формирования тонких диэлектрических слоев на вершине МК W<100> были проведены исследования закономерностей активируемого электрическим полем процесса электронной эмиссии с поверхности НГ при различных температурах НГ.

Рис. 1. Блок-схема автоматизированного модуля для исследования эмиссионных свойств НГ на основе наногетероструктуры ZrO 2 /W<100>.
1 — ZrO 2 / W<100> острийный эмиттер; 2 — покрытый люминофором экстрагирующий электрод (коллектор); 3 — супрессорный электрод; 4 — дужка из поликристаллической W-проволоки (диаметром 0.127 мм); 5 — стабилизированный источник постоянного тока для нагревания W-дужки; 6 — компьютер; 7 — процессор; 8 — коммутатор напряжения; 9 — аналого-цифровой преобразователь; 10 — цифро-аналоговый преобразователь; 11 — стабилизированный высоковольтный источник напряжения (HW 30/P); 12 — стабилизированный источник напряжения, задающий потенциал супрессора; 13 — цилиндр Фарадея для измерения тока в приосевой части пучка; 14 — камера сверхвысоковакуумной установки; G — гальванометр; R — резистор
ТЕХНИКА И РЕЗУЛЬТАТЫ ЭКСПЕРИМЕНТА
Формирование НГ, а также исследование ее эмиссионных свойств проводилось в сверхвысоковакуумной физико-технологической установке, состоящей из двух модулей: 1 — технологический модуль для формирования исходной НГ и 2 — модуль для исследования эмиссионных свойств НГ. Описание технологического модуля установки приведено в [17]. Для исследования эмиссионных свойств сформированной НГ последняя посредством поворота в вакууме на заданный угол устанавливалась на оси автоматизированного модуля (АМ) установки. Блок-схема АМ показана на рис. 1. При проведении измерений рабочая температура поверхности НГ устанавливалась посредством пропускания определенного тока накала через поликристаллическую W-проволоку (дужку) 4. Разность потенциалов (до 30 кВ) между коллектором 2 и НГ 1 формировалась источником напряжения 11, на вход которого подавалось управляющее напряжение (в пределах от 0 до 10 В). Для измерения полного тока эмиссии использовался калиброванный прецизионный резистор R. Процессор 7, аналого-цифровой преобразователь 9, цифро-аналоговый преобразователь 10 и коммутатор напряжения 8 сопрягались с управляющим компьютером 6 при помощи интерфейсного канала RS232 на выходе СОМ-порта компьютера. Укажем, что цифро-аналоговый преобразователь 10 формирует управляющее напряжение высоковольтного источника 11 в диапазоне от 0 до 10 В, а аналого-цифровой преобразователь через коммутатор напряжения 8 производит как измерение тока эмиссии (посредством преобразования падения напряжения на R в цифровой код), так и напряжения высоковольтного источника 11. Программное обеспечение (ПО) АМ включает исполняемый файл Cathode.exe и два файла конфигурации — SysPar.cnf и ParRegVAF.cnf. Кроме того, операционная система (OC) должна содержать системные файлы Mfc42.dll, Mfc42d.dll, Mfco42d.dll, Msvcirtd.dll, Msvcrtd.dll. ПО работает в среде ОС Windows 98 и легко может быть адаптировано в среду OC Windows XP. Более подробное описание АМ дано в [18].
Основные результаты исследований приведены на рис. 2–7. На рис. 2 показаны типичные вольт-амперные характеристики (ВАХ) для одного и того же исходного острийного МК W<100>. Кривая 1 соответствует ВАХ острийного МК W<100>, на вершине которого сначала было создано моно-слойное покрытие молекулярными комплексами ZrO2. После проведения измерений ВАХ монослой ZrO 2 удалялся с поверхности МК W<100> за счет высокотемпературного (~ 2500–3000 К) испарения адсорбата. Затем на атомарно-чистую поверхность

Рис. 2. Вольт-амперные характеристики НГ, последовательно сформированных на одном и том же исходном острийном микрокристалле W<100> различными методами (точки — эксперимент, линии — аппроксимирующие аналитические функции):
1 — монослой ZrO 2 /W(100) (Шоттки-катод), аппроксимация y = 0.0226 • e " """4 x ;
2 — тонкий слой ZrO 2 /W(100), аппроксимация y = 2 Л0- 8 • x 19876
МК W<100> из молекулярной пушки наносился тонкий (~ 5–10 нм) слой ZrO2 и проводились следующие измерения ВАХ. Результаты этих измерений показаны на рис. 2 (кривая 2). Из рис. 2 следует, что функциональные зависимости для кривых 1, 2 существенно различаются. Так, для монослой-ного покрытия МК W<100> комплексами ZrO2 в соответствии с уравнением для ESE [2] экспериментальная кривая Ie(Ve) с достоверностью R2 = = 0.998 близка к экспоненте (рис. 2, кривая 1). Если же на вершине МК W<100> сформирован тонкий слой ZrO2, то ВАХ (рис. 2, кривая 2) представляет собой степенную функцию вида Ie ≈ Ve2 (R2 = = 0.996), причем при прочих равных условиях полный ток эмиссии с поверхности ZrO2/W<100> источника в 2–3 раза превосходит полный ток эмиссии с поверхности ZrO/W<100> Шоттки-катода. Если же учесть, что Шоттки-катод при полных токах, больших ~ 0.2–0.25 мА, переходит в режим TFE и утрачивает стабильность эмиссии, то соотношение между полными токами эмиссии для этих источников возрастает более чем в 10 раз.


Наряду с указанными изменениями ВАХ в результате создания на вершине W<100> острийного МК тонкого слоя ZrO2 происходит также существенная трансформация эмиссионного изображения. Сравнивая изображения поверхности МК W<100> для различных источников (рис. 3, б и рис. 3, в), легко видеть, что в условиях эмиссии с поверхности ZrO 2 /W<100> интенсивная эмиссия наблюдается только с поверхности локальных участков, прилегающих к трехгранным углам в направлениях типа <111>. Кроме того, необходимо отметить, что угол расходимости потоков электронов, эмиттированных вблизи направлений <111>, оказывается значительно (в 2–3 раза) меньшим, чем у центрального потока электронов, экстрагируемого с поверхности ZrO 2 /W(100) в режиме Шоттки-эмиссии.
Результаты измерений влияния температуры на процесс эмиссии с поверхности ZrO 2 /W<100> источника приведены на рис. 4. Как видно из этого рисунка, зависимость I e( T s) является весьма сильной (близка к экспоненциальной) и имеет пороговый характер по величине температуры, начиная с которой (при фиксированном значении потенциала V e ) происходит возбуждение процесса эмиссии. Кривая I e( T s) достигает максимума при T s ≈ ≈ 2150 К.

Рис. 3. Эмиссионные изображения микрокристалла W<100> на различных стадиях формирования структуры эмиттирующей поверхности источника электронов.
а — исходная атомарно-чистая поверхность скруг-ленно-сглаженной вершины микрокристалла W<100>; б — распределение локальных участков эмиссии на вершине W<100> c монослойным покрытием комплексами ZrO2; в — распределение локальных участков эмиссии на вершине W<100>, покрытой тонким слоем диэлектрика ZrO 2

Рис. 4 Зависимость тока эмиссии от температуры для НГ, образованной тонким слоем ZrO 2 на поверхности МК при фиксированном значении экстрагирующего потенциала ( V e = = 6000 В)
Совокупность приведенных выше данных не поддается простой интерпретации в рамках существующих представлений о механизмах известных эмиссионных явлений [9]. Как следует из экспериментальных данных, исследованный в работе эмиссионный процесс с поверхности ZrO 2 /W<100> НГ активируется электростатическим полем и демонстрирует весьма сильную зависимость эмиссионной способности НГ от температуры. В связи с тем, что формально такие эмиссионные процессы, как термоэлектронная эмиссия (TE), SE, ESE, а также полевая (автоэлектронная) эмиссия, являются частными случаями явления TFE, исследованному в работе эмиссионному процессу можно дать собственное наименование — аномальная термополевая эмиссия (ATFE).
Не останавливаясь пока на обсуждении механизма ATFE, отметим, что после завершения технологического процесса формирования НГ, процесс ATFE характеризуется высокой ( ~ 0.1 %/ч) временнóй стабильностью (см. рис. 5) и сверхвысокой (порядка ~ 1010 А/(м2·ср·В) приведенной яркостью β (см. рис. 6). Оценочные расчеты величины θ для каждого из потоков электронов в направлениях, близких к <111> (см. рис. 3, б), показали, что данный параметр достигает значений ~ 102 мА/ср. Отметим, что вклад в полный ток эмиссии ( I e) от всех 4 потоков электронов в направлениях типа <111> составляет от ~ 80 до ~ 90 %. Откуда следует, что использование разработанных источников электронов вида ZrO2/W<111> в ЭОС формирования микрозондов позволит создавать микрозонды с током до ~ 0.5 мА (и более) и плотностью мощности до ~ 1.0 ТВт/см2.
ОБСУЖДЕНИЕ РЕЗУЛЬТАТОВ. ЗАКЛЮЧЕНИЕ
Для интерпретации установленных в работе закономерностей ATFE будем основываться на полученных экспериментальных данных. Согласно этим данным, плотность тока в области тетраэдрических углов в направлениях <111> (см. рис. 3, в) может достигать значений ~ 108–109 А/см2. Этот результат означает, что инжекция электронов через границу раздела (металл (W))—(диэлектрик (ZrO2)) может происходить только по туннельному (или точнее, термополевому) механизму [9, 11], и, следовательно, на этой границе в условиях ATFE создается сильное (порядка ~ 108 В/см) электрическое поле ( F si ).
Для полусферической модели границы раздела диэлектрик—вакуум в одномерном приближении локальное значение напряженности поля в произвольной точке на межфазовой границе раздела W—ZrO2 можно представить в виде

Рис. 5. Характерная кривая временнóй стабильности полного тока эмиссии с поверхности НГ (тонкий слой ZrO2/ W <100>)
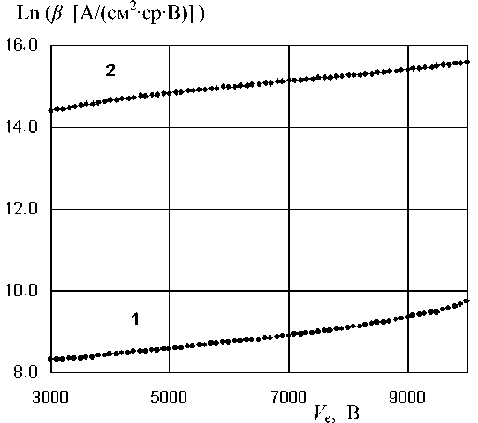
Рис. 6. Зависимость параметра β от экстрагирующего потенциала для НГ, сформированных различными технологическими методами:
1 — монослой ZrO 2 /W<100> (или Шоттки-катод); 2 — тонкий слой ZrO 2 /W<100>
Fsi = γ FL + Flc – Fsc, (1) ε где γ — локальный фактор усиления поля; ε — относительная диэлектрическая проницаемость; FL — напряженность (лаплассового) поля на границе раздела диэлектрик—вакуум; Flc — поле пространственного заряда, локализованного на уровнях доноров в запрещенной зоне диэлектрика; Fsc — поле пространственного заряда потока электронов.
Входящие в (1) величины γ, Flc и Fsc являются неизвестными, поэтому для определения вклада каждого из слагаемых будем использовать как вышеприведенные данные, так и результаты работ [19–21].
Т. к. геометрия электродов и вершины эмиттера (рис. 1) аналогична геометрии электродов, описанной в [2], то из данных этой же работы следует, что в условиях настоящих экспериментов напряженность (лаплассового) поля F L на границе раздела диэлектрик—вакуум во всем исследованном диапазоне изменения V e не превышала ~ 3.0·107 В/см. Принимая во внимание, что в условиях TFE при высоких плотностях тока (вплоть до J ≈ 109 А/см2) напряженность поля пространственного заряда F sc не превосходит ~ 107 В/см [19], и учитывая, что в зависимости от технологии формирования и толщины пленки численное значение ε для пленок ZrO 2 может варьироваться в пределах от ~ 5 до ~ 32 [20], а параметр γ (для направлений типа [111]) удовлетворяет неравенству γ ≤ 5 [12], получим такую оценку:
γ ⋅ F L - F sc ε
≤ 0.2 ⋅ F lc .
Таким образом, из (2) следует, что в условиях ATFE основной вклад в результирующее поле Fsi создается объемным зарядом в пленке ZrO2. Согласно рис. 4, напряженность поля Flc при фиксированном значении Ve весьма сильно зависит от температуры. На участке роста тока (рис. 4) зависимость Ie(Ts) близка к экспоненте. Такой характер температурной зависимости, по-видимому, обусловлен возрастанием поля Flc за счет роста концентрации заряда на локализованных уровнях донорного типа в запрещенной зоне ZrO2. Как представляется, рост концентрации заряда в этих условиях прежде всего связан с фотоионизацией локализованных состояний равновесным тепловым излучением вещества НГ, а также, разумеется, определенный вклад в этот процесс должна вносить термоэлектронная ионизация в электростатическом поле (ионизация по Френкелю). В рамках этих представлений переход кривой Ie(Ts) через экстремум при температурах, больших ~ 2150 К (рис. 4), вызван смещением максимума спектра равновесного теплового излучения в более коротковолновую область (по закону Вина). Отметим, что, согласно предложенной интерпретации, в запрещенной зоне ZrO2 функция распределения плотности локализованных состояний должна иметь экстремум в "точке" ~ 0.84 эВ ниже дна зоны проводимости ZrO2. Кроме того, при T ~ ~ 2000 К возможно аллотропное изменение структуры диэлектрика [21], которое может сопровождаться уменьшением плотности локализованных состояний.

Рис. 7. Энергетическая диаграмма НГ (тонкий слой ZrO2/W<100>) в условиях ATFE (ионизованные уровни локализованных состояний показаны знаком + , остальные обозначения являются общепринятыми)
На рис. 7 представлена энергетическая диаграмма исследованной НГ в условиях ATFE. В этих условиях (ATFE) концентрация объемного заряда возрастает настолько, что доминирующим механизмом инжекции в пленку диэлектрика становится процесс TFE.
В рамках вышеизложенных представлений квадратичная функциональная зависимость I e от V e (рис. 2, кривая 2) является следствием ограничения потока электронов пространственным зарядом в слое ZrO2. Аномально высокие (по сравнению с Шоттки-катодом) значения β и θ для разработанного источника электронов обусловлены специфическими кристаллографическими особенностями наногетероструктуры, которая формируется на вершине МК переходного металла в условиях высокотемпературного эпитаксиального роста тонкого cлоя ZrO2 в сильных электрических полях. В этих условиях одновременно с формированием слоя диэлектрика происходит процесс термополевой перестройки МК W [10, 22]. Процесс термополевой перестройки заканчивается после огранки МК плотноупакованными гранями типа {100}, {110} и {112} или гранями типа {100}, {110}. Заметим, что это завершенное состояние огранки принято называть "равновесной формой кристалла". Для кристаллов в равновесной форме свободная поверхностная энергия достигает минимального значения. В результате образования равновесной формы МК граница раздела металл—диэлектрик представляет собой многогранник, состоящий из плоских участков, образованных плотноупакован-ными гранями. Стыкам плотноупакованных граней соответствуют направления типа [111], вблизи которых локальная кривизна поверхности имеет максимальное значение [12]. В связи с этим в условиях ATFE наибольшее численное значение фактора γ и соответственно F si в (1) должно отвечать направлениям типа [111], что и наблюдается экспериментально (см. рис. 3, в). Если исходить из весьма реалистичной оценки линейных размеров (~ 10–30 нм) для наиболее интенсивно эмитти-рующих локальных участков поверхности вблизи направлений [111], то, как отмечалось выше, плотность тока ATFE для этих участков будет составлять ~ 108–109 А/см2. Откуда следует, что при Ω ≤ 0.01 ср для каждого из четырех потоков (рис. 3, в) β достигает значений ~ 1010 A/(м2·ср·В) и выше, а θ ≥ 102 мА/ср.
В заключение представляет интерес оценить среднюю объемную плотность заряда (nv) на локализованных состояниях на границе раздела W <100>—ZrO2, а также плотность (Nv) этих состояний. В приближении однородного распределения связанного заряда в пленке диэлектрика можно положить Flc ~ {e (nv)2/3 / ε0} ≈ 108 В/см, где e — заряд электрона, ε0 — электрическая постоян- ная. Тогда имеем такую оценку: nv ≈ 1020 см–3. Полагая Nv ≈ nv/Eg, где Eg — ширина запрещенной зоны ZrO2 (Eg ≈ 7.8 эВ [21]), получим Nv ≈ ≈ 1019 см–3·эВ–1. Последняя оценка дает основания полагать, что в условиях ATFE тонкий слой ZrO2 на поверхности МК W<100> является структурнонеупорядоченным, или другими словами находится в аморфном состоянии [23]. Если последнее заключение справедливо, то высокая стабильность процесса ATFE объясняется высокой инертностью аморфных пленок по отношению к взаимодействию с газами, а также большой энергией когезии аморфных оксидных пленок.
Основные результаты работы заключаются в следующем.
-
1. Разработана и создана оригинальная физическая нанотехнология формирования самоорга-низованных НГ, образованных тонким (~ 5–10 нм) слоем диэлектрика (ZrO2) на поверхности острий-ного микрокристалла W<100>.
-
2. На основании исследований полевых эмиссионных свойств разработанных НГ показано, что при определенных температурах созданные НГ являются новыми высокоинтенсивными и высокостабильными точечными источниками электронов и характеризуются уникальными эмиссионными параметрами, а именно приведенной яркостью β до ~ 1010 A/(м2·ср·В) и угловой интенсивностью эмиссии θ до ~ 102мА/ср.
-
3. Показано, что закономерности активированной электрическим полем электронной эмиссии не согласуются с теорией явления термополевой эмиссии. Обнаруженному эмиссионному явлению дано специальное наименование — ATFE. Предложена феноменологическая модель механизма ATFE.
Работа выполнена при поддержке РФФИ, грант № 05-08-33545а.


