Обеспечение радиационной стойкости микросхем энергонезависимых сегнетоэлектрических запоминающих устройств
Автор: Орлов Андрей Александрович, Уланова Анастасия Владиславовна, Боруздина Анна Борисовна
Журнал: Спецтехника и связь @st-s
Статья в выпуске: 4-5, 2011 года.
Бесплатный доступ
Рассматривается динамика развития энергонезависимых сегнетоэлектрических запоминающих устройств (FRAM). Приведены результаты радиационных исследований зарубежных образцов FRAM при импульсном и дозовом воздействиях. Экспериментально подтверждено предположение о том, что уровень радиационной стойкости FRAM определяется стойкостью КМОП периферии.
Сегнетоэлектрическое оперативно-запоминающее устройство, сегнетоактивная керамика типа pzt, радиационная стойкость, импульсное и стационарное излучения
Короткий адрес: https://sciup.org/14967057
IDR: 14967057
Текст научной статьи Обеспечение радиационной стойкости микросхем энергонезависимых сегнетоэлектрических запоминающих устройств
В настоящее время можно наблюдать возросший интерес разработчиков аппаратуры к запоминающим устройствам (ЗУ) на основе сегнетоэлектрических материалов. Под «ферроэлектрической памятью» понимаются энергонезависимые сегнетоэлектрические ЗУ с произвольной выборкой (FRAM – Ferroelectric RAM).
Микросхемы FRAM выпускаются компанией Ramtron и рядом ведущих иностранных фирм: Texas Instruments, Rohm, Fujitsu, Toshiba, Samsung, Hitachi, NEC, Asahi Chemical, Infineon. Количество современных и перспективных отечественных образцов аппаратуры, в которых применяются FRAM, постоянно увеличивается. В частности, они используются в блоке определения пространственной ориентации изделий в инерциальной геоцентрической системе координат звезд, в аппаратуре радионавигации, в блоке управления системой наведения антенн, в комплексе автоматики и стабилизации, командно-измерительной системе, бортовом информационно-вычислительном комплексе, аппаратуре дальномерно-доплеровской системы, аппаратуре сбора и передачи специальной информации, бортовом синхронизирующем устройстве.
По информации фирм – изготовителей и поставщиков FRAM их можно отнести к высоконадежным компонентам по устойчивости к внешним воздействующим факторам. Так в [1] указывается, что разработанные FRAM «отвечают всем требованиям по различным видам вооружения». Однако данные по радиационным исследованиям и испытаниям FRAM в иностранной литературе представлены недостаточно полно и касаются стойкости к отдельным ядерным частицам [1], а в отечественных публикациях практически отсутствуют, что требует проведения дополнительных исследований.
Основные этапы развития и принцип работы FRAM
Стимулом для разработки новой энергонезависимой памяти в 1980-х годах послужила необходимость создания конкурентно-способных микросхем, т.е. энергонезависимых схем со свойствами оперативных запоминающих устройств (ОЗУ). Данное развитие стало возможно благодаря известным физическим свойствам сегнетоэлектриков и успехам, полученным при создании традиционных ЗУ на основе полупроводниковой технологии.
Основные этапы развития FRAM приведены в табл. 1 .
Основным материалом для элементов FRAM – сегнетоэлектрических транзисторов (ferroelectric transistor) и конденсаторов (ferroelectric capacitor) – являются смешанные полиметаллические оксиды, спекаемые в сегне-тоактивные керамики. Наиболее распространенным является семейство PZT (Perovskite lead zirconate titanate) с общей формулой Pb(ZrxTi1-x)O3. Сегнетоэлектрики, используемые при создании конденсаторных элементов FRAM, представляют собой особую группу кристаллических диэлектриков, обладающих в отсутствии внешнего электрического поля в определенном интервале температур и давлений спонтанной (самопроизвольной) поляризацией, направление которой может быть изменено электрическим полем. Принцип работы FRAM заключается в следующем [3 – 5]. При приложении электрического поля к сегнетоэлектрическому кристаллу центральный атом движется в направлении поля. Перемещение атома в пределах кристалла сопровождается затратами энергии на преодоление потенциального барьера, результатом чего является спонтанная поляризация кристалла. Схема управления накопителем позволяет определить величину заряда и состояние ячейки памяти (ЯП). После исчезновения
Таблица 1. Основные этапы развития FRAM [2]
|
Год |
Событие |
|
1984 |
Открытие материала перовскита. Фирма RAMTRON (США) приступила к разработке технологии производства ЗУ типа FRAM |
|
1989 |
Введена в эксплуатацию первая фабрика для производства FRAM |
|
1992 |
RAMTRON получен работающий образец FRAM при использовании титаната свинца PZT (Perovskite lead Zirconate Titanate) с общей формулой Pb(ZrxTi1-x)O3 |
|
1992 |
Разработки отечественных экспериментальных FRAM (ОАО «НИИМЭ и Микрон) |
|
1992-1993 |
RAMTRON освоено производство 4 Kб FRAM с архитектурой 2Т-2С |
|
1993-2001 |
Плоскостная архитектура ячеек памяти 2Т-2С |
|
1993-1997 |
RAMTRON освоено производство 16-64 Kб FRAM (нормы 1 мкм) |
|
1998-1999 |
RAMTRON выданы лицензии на производство FRAM 256 Кб компаниям Rohm (1 мкм) и Fujitsu (0,5 мкм) |
|
2001 |
RAMTRON освоено производство FRAM 1 Мб с технологическими нормами 0,35 мкм. RAMTRON перешла от структуры ЯП 2T-2С к структуре ЯП 1Т-1С |
|
2001-2006 |
Плоскостная архитектура ЯП 1Т-1С |
|
2004-2006 |
Иностранные образцы FRAM с технологическими нормами 0,18 мкм |
|
2006 |
Иностранные образцы FRAM с технологическими нормами 0,13 мкм |
|
2006 |
Ярусная архитектура (Stacked) ЯП 1Т-1С |
|
2004-2009 |
RAMTRON освоено производство FRAM 4-8 Мб с технологическими нормами 0,18-0,13 мкм |
|
2009 |
TOSHIBA на конференции ISSCC 2009 (International SolidState Circuits Conference, Международной конференции, посвященной новейшим разработкам в областях твердотельных схем и систем на кристалле), представила высокоскоростную 128 Мб FRAM с высокой плотностью компоновки. В новых чипах, построенных по 0,13 мкм технологии, единичные ячейки памяти имеют площадь 0,252 мкм2, скорость записи-чтения составляет 1,6 Гб/с, время цикла – 83 нс, время доступа – 43 нс |
|
2009-2010 |
Fujitsu Laboratories и Fujitsu Limited совместно с Токийским технологическим институтом на основе модифицированного композита феррита висмута (BiFeO3, или BFO) при технологических нормах 0,065 мкм разработали 256 Мб FRAM |
|
2010 |
Серийно освоена архитектура (3D) ЯП 1Т-1С с возможностью построения FRAM 16-32 Мб, время выборки 90 нс |
поля центральный атом остается в том же положении, определяя состояние ЯП. FRAM не нуждается в регенерации и после отключения питания сохраняет свое содержимое.
По энергетическому значению состояния «0» и «1» далеко разнесены, что позволяет произвести их однозначную идентификацию. При чтении из ЯП прикладывается электрическое поле и измеряется энергия, затрачиваемая на изменение поляризации. Наличие или отсутствие затрат энергии оценивается как двоичная информация. В процессе чтения происходит разрушение информации, поэтому вслед за чтением автоматически включается цикл регенерации. Время восстановления состояния ячейки памяти составляет менее 100 нс. Этот механизм существенно отличается от используемой в других типах энергонезависимой памяти технологии плавающего затвора. Для записи в ячейку EEPROM требуются единицы миллисекунд, а время записи в ячейку FRAM составляет менее 150 нс. На определение поляризации при чтении или изменение при записи в ячейку FRAM требуется около 1 нс, при меньших мощностях по сравнению с ОЗУ.
На данный момент имеется большое количество всевозможнейших комбинаций основных элементов, из которых строится ячейка памяти, – сегнетоэлектрических транзистора и конденсатора. Но при рассмотрении этих комбинаций можно выявить 4 основных типа, которые являются базовыми, все остальные типы ячеек FRAM являются лишь их комбинациями. Это однотранзисторная ячейка 1Т FRAM, одноконденсаторная ячейка 1С FRAM, называемая еще SFRAM (statically read, non-volatile, ferroelectric random access memory), наиболее распространенная транзисторно-конденсаторная ячейка 1Т-1С [2] и наиболее стабильная из всех вышеперечисленных двойная ячейка 2T-2C FRAM [6].
В настоящее время благодаря совместным разработкам компаний Toshiba и Infineon Technologies AG в серийно изготавливаемых за рубежом микросхемах FRAM используются в основном ячейки памяти типа 1T-1C [2], т.к. они более компактны и позволяют спроектировать схемы большей информационной емкости. Этот тип FRAM очень близок по структуре к обычному динамическому запоминающему устройству (DRAM). Основное отличие от DRAM состоит в наличии сегнетоэлектрического конденсатора и в способе подключения ячейки к общей структуре. Конструкции ячеек 1Т-1С FRAM показаны на рис. 1 . Основным элементом в структуре 1Т-1С, отвечающим за запись данных, является конденсатор. Запись происходит после открытия транзистора. Следовательно, имеется некая временная константа, включающая время срабатывания транзистора плюс время поляризации конденсатора. Именно эта

б
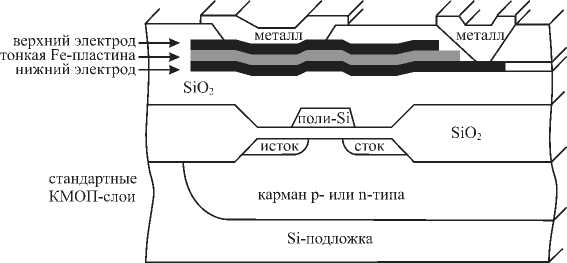
сегнетоэлектрик
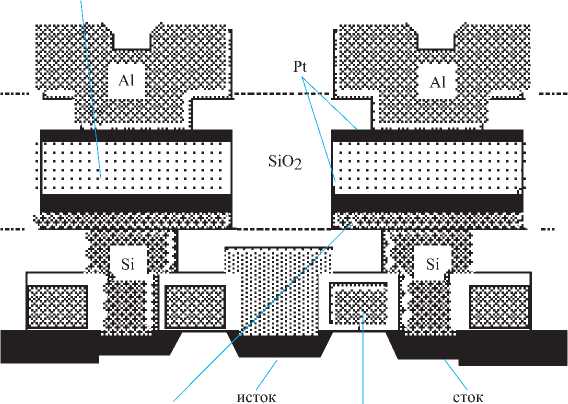
барьерный слой МОП-затвор
Рис. 1. Конструкции ячеек 1Т-1С FRAM: планарная конструкция (а) и вертикальная конструкция ячейки (б)
константа определяет скорость работы FRAM ЗУ. Естественно, что для каждого сегнетоэлектрика эта константа будет разной, следовательно, главной задачей исследователей на ближайшее время будет поиск материалов и легирующих добавок, для которых эта временная константа будет наименьшей.
Однако конструкция ячеек 1Т-1С FRAM обладает одним очень существенным недостатком – на шине записи-считывания (в литературе встречается сокращение BL [7]) при считывании формируется слабый недифференциальный информационный сигнал. Обработка такого сигнала требует построения достаточно сложной схемы формирования опорного сигнала и усилителей считывания. Схемы такого типа обладают низкой помехозащищенностью, и возможность их применения в технике специального назначения ограничена. Другой проблемой при проектировании сегнетоэлектрической энергонезависимой памяти является взаимное влияние друг на друга различных ячеек в массиве при срабатывании общей шины управления нижними обкладками сегнетоэлектрических конденсаторов (в литературе встречается сокращение PL [7]). Необходимо также отметить, что использование ячеек памяти типа 1T-1C требует применения высококачественных сегнетоэлектрических материалов, обладающих стабильными электрофизическими параметрами, и стабильных параметров всех остальных структур кристалла [8].
Поэтому в микросхемах, предназначенных для использования в аппаратуре специального назначения, можно рекомендовать использование ячеек памяти с двумя сегнетоэлектрическими элементами. У данного типа памяти элементарная ячейка представляет собой сдвоенные ячейки 1T-1C типа. Ячейка такого типа, в которой каждому биту соответствует индивидуальный опорный бит, позволяет определять разницу зарядов с высокой точностью. А благо-
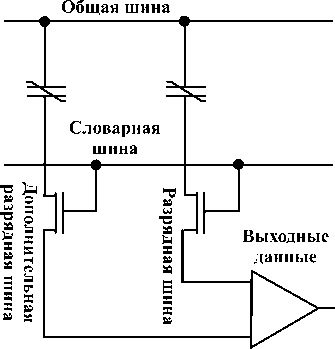
Рис. 2. Электрическая схема ячейки 2Т-2С FRAM
даря считыванию дифференциального сигнала ячейки исключается влияние разброса параметров конденсаторов ячеек [5]. Электрическая схема ячейки 2Т-2С представлена на рис. 2 .
В данной конструкции ячейка 2T-2C подключена к управляющей линии (словарная шина) и линии управления поляризацией (общая шина), но линия данных разделена на две раздельные линии (разрядная и дополнительная разрядная шины), соответственно запись-чтение на сегнетоэлектрические конденсаторы производится раздельно. Данные, записываемые в эти два конденсатора, дублируются, что приводит к увеличению надежности хранения данных.
Помимо конденсаторов присутствует усилитель, необходимый для считывания данных из ячейки 2T-2C. Усилитель и две структуры 1T-1C увеличивают размер ячейки 2T-2C по сравнению с 1T-1C. Крупнейшим фирмам-производителям, занимающимся разработкой и производством данного типа памяти, таким как NEC, Matsushita и Fujitsu, не удалось пока получить чипы с объемом информации свыше 1 Мб, в то время как для 1Т-1С структуры созданы уже промышленно выпускаемые чипы с емкостью свыше 32 Мб.
Основным преимуществом памяти 2T-2C FRAM является высокая надежность. Ячейка устойчива к воздействию магнитных и электромагнитных полей, не теряет информацию под действием ионизирующих излучений [2]. На основе таких ЯП в ОАО «Ангстрем» в 2009 г. сделана попытка реализовать FRAM емкостью 256 бит. Стоит отме-

1) Ch2: 200 mVolt 250 ns

а

б

Рис. 3. Типичные осциллограммы импульсной реакции выходных напряжений низкого (а, б) и высокого (в, г) логических уровней FRAM 2 при уровне импульсного воздействия 7,0×109 ед/с (а, в) и 1,0×1010 ед/с (б, г)

Рис. 4. Изменения тока потребления в режиме хранения FRAM 1, FRAM 2 и КМОП ОЗУ 256 К при стационарном воздействии. Среднее значение начального тока ICCS составляет: для FRAM 1 – 3,4 мкА, для FRAM 2 – 0,4 мкА, для КМОП ОЗУ 256К – 10 мкА
тить, что полученная емкость данного FRAM накопителя является недостаточной для применения в перспективной аппаратуре.
С учетом интереса разработчиков аппаратуры к запоминающим устройствам на основе сегнетоэлектрических материалов необходимо проведение исследований радиационной стойкости данных типов памяти при импульсных и дозовых воздействиях.
Результаты исследований FRAM при радиационных воздействиях
Целью исследований являлись оценка уровней стойкости и определение характера деградации основных парамет- ров микросхем FRAM при импульсном и дозовом воздействиях ионизующих излучений.
Объектом исследований являлись микросхемы FRAM информационной емкостью 256 Кбит (организация 32К×8 бит): FRAM 1 – FM18L08-70-SG (фирма Ramtron) и FRAM 2 – MB85R256H (фирма Fujitsu Semiconductor). Контролируемыми в процессе исследований параметрами являлись: выходные напряжения логических нуля (UOL) и единицы (UOH), токи потребления в режиме хранения (ICCS), функционирование, тиристорный эффект (ТЭ) и катастрофические отказы (КО). Исследования проводились на лазерном («РАДОН-5» [9, 10]) и рентгеновском («РЕИМ» [9, 11]) имитаторах с калибровкой уровней воз- действия на моделирующих установках «АРСА» и «У-31/33» соответственно.
Контроль работоспособности микросхем и измерение электрических параметров осуществлялись с использованием специализированного аппаратного комплекса фирмы National Instruments, основу которого составляла измерительная модульная платформа PXI-1033 в составе FPGA модуля PXI-7953R. Управление осуществлялось посредством виртуального прибора, разработанного с использованием программного обеспечения LabView.
В результате исследований установлено, что для FRAM 1 и FRAM 2 КО, ТЭ и сбоев информации в накопителе не наблюдалось при уровнях импульсных воздействий вплоть до 7,5×1011 рад(Si)/с. Сбои наблюдались при контроле выходного напряжения в режиме статического считывания из ячейки при импульсном ионизирующем воздействии. Сбои выражались в переключении выходного уровня в противоположное состояние ( рис. 3 ). Уровень бессбойной работы составил 7,0×109ед/с. Повторное считывание без перезаписи ячейки приводило к восстановлению информации и верному считыванию, что может свидетельствовать о сбое в выходных КМОП-каскадах усилителя считывания, а не в накопителе.
Таким образом, можно предположить, что при импульсном ионизирующем воздействии накопитель не сбивается, сбои наблюдаются в усилителе считывания.
Уровень функционального отказа (УФО) при дозовом воздействии составил: для FRAM 1 – 4,8×104 ед, для FRAM 2 – 1,8×104 ед.
В ходе проведения функционального контроля применялись линейные алгоритмы типа «Марш» сложностью 10N и выше, которые в сочетании с алгоритмами меньшей сложности («Шахматы» и пр.) позволяли выявлять ошибки в периферийных схемах и оценить их вклад в общее число отказов. В результате было выявлено, что наблюдавшиеся ошибки связаны с отказом КМОП периферии.
В работе [10] установлено, что для образцов FRAM FM1608 и FM1808 при поглощенной дозе 12,5 крад (Si) наблюдаются частичные ошибки в считывании с полной потерей функционирования при воздействии 25 крад(Si). Испытания проводились на гамма-установке Co-60.
Выходные уровни и динамический ток потребления в процессе дозового воздействия изменялись слабо. Наиболее чувствительным параметром при дозовом воздействии является статический ток потребления в режиме хранения, его изменения в процессе воздействия отражены на рис. 4 . Там же для сравнения приведены аналогичные зависимости для КМОП ОЗУ 256 Кбит.
Таким образом, уровень радиационной стойкости FRAM к импульсному ионизирующему излучению не выше, а к дозовому воздействию даже ниже, чем стойкость ОЗУ, выполненной по стандартной КМОП технологии. Данное обстоятельство предположительно может быть связано с тем, что радиационная стойкость FRAM определяется стойкостью КМОП периферии [2]. Для повышения уровня стойкости можно рекомендовать применение технологии изготовления КМОП элементов FRAM по радиационно-стойкому КМОП технологическому процес- су или на КНС/КНИ технологических базисах [13].
Заключение
Микросхемы FRAM позволяют в настоящее время рассматривать их как эффективное решение для применения в качестве энергонезависимого запоминающего устройства в современных и перспективных образцах аппаратуры. Зарубежная технология изготовления FRAM позволяет получать образцы с информационной емкостью 16 – 32 Мб с временем выборки 90 нс по технологическим нормам не более 0,18 мкм. Отечественные образцы FRAM, освоенные в серийном производстве, отсутствуют. В микросхемах, предназначенных для использования в аппаратуре специального назначения, можно рекомендовать использование FRAM с помехозащищенными ячейками памяти с двумя сегнетоэлектрическими элементами типа 2T-2C. Для FRAM (1Т-1С), изготовленных по стандартному КМОП технологическому процессу, уровень импульсной радиационной стойкости составляет не более 1010 рад(Si)/с (наблюдаются сбои в периферии, накопитель не сбивается до уровня не менее 1011 рад(Si)/с). Отсутствие стирания информации из накопителя позволяет использовать FRAM как стойкое ядро при импульсных ионизирующих излучениях вместо схем ОЗУ по технологии КНИ/КНС. Дозовая стойкость исследованных образцов FRAM фирмы Ramtron не превышает 15 – 50 крад(Si) и также определяется отказами в периферийных КМОП-элементах. Для повышения уровня стойкости можно рекомендовать применение технологии изготовления КМОП-элементов FRAM по радиационно стойкому КМОП технологическому процессу или на КНС/ КНИ технологических базисах.
Исследования проведены при частичной поддержке ФЦП «Кадры», ГК № П1101
Список литературы Обеспечение радиационной стойкости микросхем энергонезависимых сегнетоэлектрических запоминающих устройств
- George C. Messenger and Floyd N. Coppage R&D «Associates Ferroelectric memories: a possible answer to the hardened nonvolatile question»./IEEE Transactions on Nuclear Science, December 1988. ? Vol. 35. ? No. 6.
- Http://www.ramtron.com.
- Добрусенко С. Элементная база электроники. Сегнетоэлектрические ОЗУ фирмы Ramtron. Быстроразвивающаяся ЭНП./Электроника: Наука, Технология, Бизнес, 2003. ? № 4.
- Вихарев Л. Перспективные технологии производства памяти. Современное состояние./Компоненты и технологии, 2006. -№ 12.
- Зайцев И. Что же с памятью FRAM стало?/Компоненты и технологии, 2007. ? № 8.
- Ali Sheikholeslami, MEMBER, IEEE, AND P. Glenn Gulak, SENIOR MEMBER, IEEE. PROCEEDINGS OF THE IEEE. A Survey of Circuit Innovations in Ferroelectric Random-Access Memories. NO. 5, MAY 2000;
- Такиев А. Будущие технологии памяти: FeRAM изнутри./3D News, 2003. ? № 2.
- Воротилов К.А., Сигов А.С. Сегнетоэлектрические запоминающие устройства технологии и материалы./Нано-и микросистемная техника, 2008 ? № 10. ? С. 30 ? 42.
- Агаханян Т.М., Аствацатурьян Е.Р., Скоробогатов П.К. Радиационные эффекты в интегральных схемах. -М.: Энергоатомиздат, 1989. -256 с.
- Никифоров А.Ю., Скоробогатов П.К. Физические основы лазерного имитационного моделирования объемных ионизационных эффектов в полупроводниковых приборах и ИС: нелинейная модель./Микроэлектроника, 2006. -Т. 35. -№ 3. -С. 164 -177.
- Никифоров А.Ю., Телец В.А., Чумаков А.И. Радиационные эффекты в КМОП ИС. ? М.: Радио и связь, 1994. ? 164 с.
- TID Testing of Ferroelectric Nonvolatile RAM, D. N. Nguyen, and L. Z. Scheick, 2000 Proceedings of the IEEE, May 2000. ? vol. 88. ? no. 5. ? PP. 667 -689.
- Давыдов Г.Г., Согоян А.В., Никифоров А.Ю., Киргизова А.В., Петров А.Г., Седаков А.Ю., Яшанин И.Б. Методика оперативного неразрушающего контроля дозовой стойкости КМОП БИС на КНС структурах./Микроэлектроника, 2008. -Том 37. -№ 1. -С. 67 -77.
- 14 http://trs-new.jpl.nasa.gov/dspace/bitstream/2014/13434/1/01-2372.pdf>.


