Осаждение тонких металлических пленок на поверхность микрочастиц в плазме магнетронного ВЧ-разряда
Автор: Паль Александр Фридрихович, Рудавец Александр Григорьевич, Рябинкин Алексей Николаевич, Серов Александр Олегович
Журнал: Ученые записки Петрозаводского государственного университета @uchzap-petrsu
Рубрика: Физико-математические науки
Статья в выпуске: 8 (113), 2010 года.
Бесплатный доступ
Пылевая плазма, магнетронное распыление, покрытие, порошок, термализация атомов, ван-дер-ваальсовское взаимодействие
Короткий адрес: https://sciup.org/14749802
IDR: 14749802
Текст статьи Осаждение тонких металлических пленок на поверхность микрочастиц в плазме магнетронного ВЧ-разряда
Получение тонких металлических пленок на микрочастицах диаметром порядка 5 мкм может быть использовано для модификации электрической проводимости [14], [19], усиления оптического отклика [9], изменения их механических свойств [25]. С помощью этих пленок может быть получено гигантское рамановское рассеяние, увеличена добротность оптических мод, в частности шепчущей галереи на поверхности микросфер [23], [24], для задач молекулярной спектроскопии, для разработки сверхчувствительных химических сенсоров. Квантово-размерные эффекты пленок заметно усиливают туннелирование электронов в полупроводниках. Все эти эффекты могут найти применение в устройствах плазмонной электроники, для обработки сигналов, для фотоэнергетики [16], [17]. Рассеяние плазмонов на дефектах металлической пленки приводит к нежелательному уширению плазмонных резонансов. Качество покрытий является критичным для функционирования атомных чипов [1], где шероховатости поверхности приводят к флуктуациям электрических и магнитных полей и потерям атомов Бозе-конденсатов.
Традиционным методом нанесения пленок является магнетронное осаждение, основанное на распылении электродов-мишеней в плазме [12], [22]. Этот метод может быть также использован для нанесения покрытий на поверхность микрочастиц. В этом случае получается меньшая шероховатость поверхности, чем при использовании химического метода [2].
При плазменно-пылевом способе осаждения покрытие наносится на частицы, удерживающиеся в особых областях плазмы – плазменнопылевых ловушках. Частицы в плазме приобретают большие отрицательные заряды, благодаря которым может быть подавлена их нежелательная агломерация. Впервые такой способ нанесения был предложен и реализован в [8]. Здесь частицы захватывались в ловушку в ВЧ-плазме над плоским электродом, а покрытие наносилось потоком атомов, создаваемым магнетронным распылителем на постоянном токе. Схема [6] позволяла обрабатывать большие количества порошка, но она не годится для хрупких частиц.
ЭКСПЕРИМЕНТ
Схема экспериментальной установки для нанесения металлических покрытий на поверхность хрупких сферических частиц представлена на
рис. 1. Частицы удерживались в плазме емкостного ВЧ-разряда магнетронного типа в ловушке кольцеобразной формы; при помощи того же разряда распылялся электрод-мишень. Под заземленным электродом располагалась магнитная система, создававшая арочное магнитное поле в области ВЧ-разряда. Полюса магнитной системы собирались из постоянных магнитов, расположенных на плоском железном магнитопроводе; ее сечение показано на рис. 1. Электроны плазмы движутся вдоль силовых линий магнитного поля в область более слабого магнитного поля. В этой области плотность плазмы увеличивается и ионный ток на электрод возрастает. Локальная толщина приэлектродного слоя уменьшается, создавая радиальные градиенты электрического поля, формирующие ловушку для частиц. Прямо под этой областью ионы бомбардируют электрод наиболее эффективно. Здесь поверхность электрода распыляется и возникает пучок атомов, формирующий покрытие на частицах в ловушке.
ВЧ-разряд частотой 5 МГц и размахом напряжения до 240 В поддерживался в аргоне при давлении 6,5–13 Па и потоке 2 sccm (стандартных кубических сантиметра в минуту). Положительное самосмещение нагруженного электрода (имевшего бóльшую площадь, чем ненагружен-ный) составляло до 60 В. Использовался медный или серебряный распыляемый электрод. Разрядная плазма сверху выглядела как продолговатое светящееся кольцо и находилась вблизи заземленного электрода (на расстоянии менее чем в 3 мм от его поверхности). После включения разряда под плазмой возникала кольцеобразная область распыления с осями 23 и 185 мм (рис. 1). Для инжекции частиц в плазму вблизи одного из концов области распыления в заземленный электрод был введен дополнительный маленький цилиндрический электрод, который располагался с внешней стороны зоны распыления на длинной ее оси. Порошок помещался на ВЧ-электрод тонким слоем вблизи дополнительного электрода. После включения ВЧ-разряда на дополнительный электрод подавалось положительное постоянное напряжение 150 В в течение 1 с, частицы взлетали и попадали в ловушку. Причины взлета частиц могут быть связаны с их электростатической зарядкой [3]. Сбор обработанных частиц осуществлялся на специальную подложку, которая помещалась вблизи противоположного конца распыляемой области. Центр подложки находился на расстоянии 210 мм от дополнительного электрода. Перемещение магнитной системы и наклон камеры позволяли перемещать ловушку и частицы в ней в область над подложкой. До начала процесса сбора частиц собирающая подложка была закрыта от распыленных атомов подвижным экраном.
Использовались порошки, состоящие из стеклоуглеродных шаров (Hochtemperatur-Werkstoffe GmbH) с диаметрами в диапазонах 0,4–12, 8–26 и 15–32 мкм или из монодисперсных час- тиц окиси кремния диаметром 5,35 мкм (microParticles GmbH).
Обрабатываемые частицы левитировали очень близко к электроду-мишени (1–3 мм в зависимости от массы частиц, величины магнитной индукции в области плазмы, давления газа и величины разрядной мощности). В конце процесса осаждения, после перемещения ловушки с частицами в область над подложкой, ВЧ-напряжение выключалось и частицы падали на собирающую подложку.
РЕЗУЛЬТАТЫ И ОБСУЖДЕНИЕ
На подложку осаждалось не менее 105 шаров в конце каждого опыта. Применявшийся способ диспергирования, как показал анализ изображений частиц, осажденных на подложку, обеспечивает практически полное их отделение друг от друга, не повреждая их. Условия эксперимента были таковы, что вязкое трение [11], [27] значительно уменьшало скорости хаотического движения частиц. Их агломерация, идущая с преодолением потенциала электростатического отталкивания [5], оказывалась подавлена.
Изображения частиц окиси кремния – исходной и с серебряным покрытием – показаны на рис. 2; почти все исследованные частицы имели такое сплошное покрытие. Шероховатость покрытий, полученных на большинстве шаров окиси кремния в экспериментах с медным распыляемым электродом, меньше, чем у покрытий на рис. 2, их изображения почти неотличимы от изображения исходных частиц и здесь не приводятся.
Частицы в ловушке движутся по связанным траекториям вдоль контура ловушки [13] в направлении кольцевого электронного тока магнетрона [18]. Это движение обеспечивает одинаковые условия напыления и, соответственно, одинаковые параметры покрытий на всех частицах.
Согласно СЭМ-наблюдениям, исходные частицы стеклоуглерода с диаметрами менее 10 мкм и все исходные частицы окиси кремния имели гладкую поверхность. На мелких частицах с изначально бездефектной поверхностью отслоения покрытий не наблюдалось. Напротив, на больших частицах стеклоуглерода иногда наблюдались отслоения, по-видимому, происходящие из-за дефектов их исходной поверхности. По разрывам пленки на поверхности мы оценили ее толщину и среднюю скорость роста, последняя имела порядок 10–1 нм/с.

Рис. 1. Схема эксперимента:
1 – ВЧ-электрод, 2 – область плазменно-пылевой ловушки,
3 – дополнительный электрод для диспергирования порошка,
4 – подложка для сбора частиц из ловушки, 5 – магнитная система, 6 – пучок распыленных атомов
Относительные концентрации элементов на частицах окиси кремния с серебряным покрытием, ат. %
|
Частицы окиси кремния |
Кремниевая подложка после процесса |
||
|
обработанные |
исходные |
||
|
C |
9,31 |
4,50 |
12,89 |
|
O |
60,14 |
61,77 |
1,1 |
|
Ag |
1,99 |
0 |
0 |
|
Si |
28,56 |
33,73 |
86,01 |
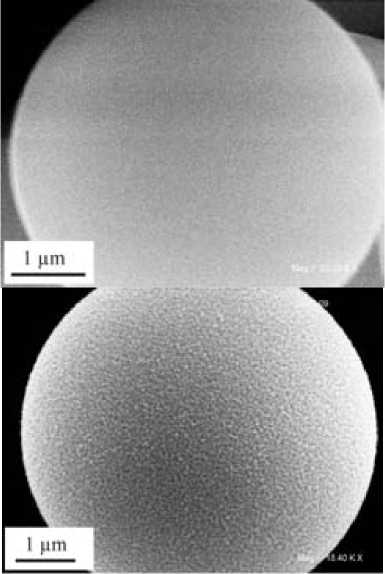
Рис. 2. Исходная частица окиси кремния и частица с серебряным покрытием
Относительные концентрации элементов на частицах и на подложке, полученные с помощью локального рентгеноспектрального анализа (ЛРСА), приведены в таблице.
Известно, что структура пленки обусловлена энергетическими потоками на поверхность подложки (потоком излучения, потоком заряженных и нейтральных атомов, теплотой конденсации, рекомбинацией на поверхности и т. д.) [4]. Шероховатость пленки зависит от энергии атомов, осаждающихся на покрытии [15]. Распыленные атомы, перед тем как достигнуть поверхности частицы, испытывают упругие столкновения с атомами газа, теряя энергию. Расстояние, на котором энергия атома сравняется с энергией атомов газа, называют длиной термализации.
Длина термализации, как и длина свободного пробега, зависит от плотности газа и сечения столкновений. При высоких энергиях столкновений справедлива модель столкновений твер- дых сфер: OHS = п(r1 + r2) , где r1, r2 - эффективные радиусы атомов, которые получаются из квантовых расчетов отталкивающего кора. Энергия распыленных атомов при магнетронном распылении обычно не превышает 50 эВ [26]. Длина свободного пробега, рассчитанная по модели твердых сфер в газокинетической теории с использованием квантовых радиусов, в случае столкновения атомов меди и аргона при давлении 6 Па оценивается величиной порядка 0,5 см. Тогда можно было бы ожидать, что на подложку, расположенную на расстояниях порядка длины свободного пробега от магнетронного распылителя, будут осаждаться нетермализованные атомы распыляемого вещества.
Однако при типичных энергиях распыленных атомов сечение столкновений определяется даль-нодействующим потенциалом Ван-дер-Ваальса. При этом длина свободного пробега оказывается на порядки меньше, чем в модели твердых сфер. Прямое экспериментальное измерение абсолютных сечений столкновений атомов при низких энергиях по распаду флуоресценции возбужденных атомов стало возможным с появлением магнито-оптических ловушек [10]. Величины полученных сечений на порядки превышают величины сечений модели твердых сфер и совпадают с сечениями вандерваальсовых столкновений.
В нашем эксперименте энергия ионов, бомбардирующих поверхность мишени, составляет величину порядка 150 эВ. Соответственно, энергия распыленных атомов, оцененная на основе данных распыления меди ионами [26], оказывается порядка 10 эВ. Для потенциала взаимодействия
С
V ( R ) = ”-Rn
( Cn – константа, не зависящая от расстояния между частицами R ) интегральное сечение рассеяния может быть записано в виде [21]:
Г C A n-
^ LL (V) = Y Ll | " I ,
I hv J
где v – относительная скорость движения частиц, h – постоянная Планка.
n
Y LL = 2 • n n - 1 sin
n
n - 3 n - 1

n - 1

В случае потенциала Ван-дер-Ваальса ( n = 6)
Y LL ” 8 .
AB
C6 = 2 “■ “‘]^ [7], где a^ , af - средние дипольные статические поляризуемости атомов A и B, I1A , I1B – их потенциалы ионизации.
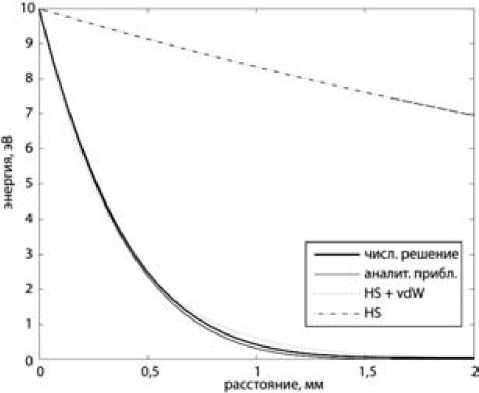
Рис. 3. Изменение энергии распыленного атома меди, движущегося в аргоне при давлении 6 Па:
толстая линия – точное численное решение, тонкая линия – приближенное аналитическое решение, пунктир – газокинетическое приближение с сечением Ван-дер-Ваальса OLL , взятым для среднеарифметического значения начальной и конечной энергии (HS + vdW), штрих-пунктир – газокинетическое приближение с сечением модели твердых
сфер O HS (HS)
При рассеянии атомов меди с энергией 10 эВ на атомах аргона полное сечение Ван-дер-Ваальса равно:
0 LL = 1.79 x 10-14 см2 (aAr = 11.08 a 03, aC" = 45.214a03 [20], где a0 = 0.53 -10-8 см - боров ский радиус, I1Ar = 15.76 эВ, IC" = 7.73 эВ).
Для сравнения , соответствующее сечение модели твердых сфер оказывается на порядок меньше:
O = 1.33 x 10 - 15 см2 ( r. = 71 пм, r„, = 135 пм).
HS Ar Cu
Сечения вандерваальсовых столкновений атомов при низких энергиях дают более точное описание процессов, чем экспериментальная подгонка в приближении модели твердых сфер, которые принципиально не учитывают зависимости сечений от относительной скорости сталкивающихся атомов (для вандерваальсовых столкновений g LL ~ v - 2/5).
Потери энергии частицы с энергией E 1 , взаимодействующей с атомами газа, имеющими энергию E 2 на расстоянии dx , можно описать уравнением:
—1 = J r ( Ep E 2 ) 0 LL ( Ex, E 2 ) n ( E 2 ) -E 2 , dx 0
где T ( E 1, E 2) – изменение энергии E 1 в одном столкновении с частицей с энергией E 2 , точное выражение которой можно получить из законов сохранения энергии и импульса в бинарном столкновении,
TO j n (E2) -E2 = n, n – концентрация атомов газа, n(E2 ) – функция распределения Максвелла.
Приближенное решение уравнения (1), полученное в предположении E 1 >> E 2 , для термализации атома с начальной энергией E 0 имеет вид:
( 1 Y
Ej(x) = E05 - const x x I , const = 1.4^n (C62 mj )5
где y =
4 m 1 m 2
( m 1 + m 2 ) 2
m 1 , m 2 – массы распыленного атома и атома газа соответственно.
На рис. 3 изображены кривые термализации, полученные с помощью приближенного аналитического и численного решения уравнения потерь энергии атома в газе. Для сравнения на том же рисунке приводятся соответствующие кривые столкновительной термализации в модели твердых сфер с сечениями O HS и o ll . Вандерва-альсово сечение O LL взято для среднеарифметического значения начальной и конечной энергии. Это сечение обеспечивает хорошее совпадение кривой термализации в газокинетическом приближении с точным расчетом.
Полная термализация достигается на расстоянии порядка 2 мм. Таким образом, в наших экспериментах частицы в ловушке находились на границе зоны баллистической бомбардировки частиц.
ВЫВОДЫ
Разработан метод нанесения покрытий на поверхность микрочастиц, удерживаемых в ловушках в плазме ВЧ магнетронного разряда на границе зоны баллистической бомбардировки атомами, распыленными при помощи этого же разряда. Покрытия равномерно наносились по всей поверхности частиц со скоростью роста пленки порядка 10–1 нм/с. Полученное покрытие имеет низкую шероховатость.
Осуществлен неразрушающий способ диспергирования частиц, обеспечивающий практически полное отделение шарообразных частиц порошка друг от друга.
Дана теоретическая оценка роли ван-дер-ваальсовских столкновений и проведен численный расчет термализации распыленных атомов в газе. Получена приближенная аналитическая формула, которая дает результаты, практически совпадающие с численным расчетом. Доминирующий характер вандерваальсового механизма релаксации приводит к быстрой термализации распыленных атомов, осаждающих покрытие.
Работа выполнена при поддержке гранта РФФИ № 07-02-00504.
Список литературы Осаждение тонких металлических пленок на поверхность микрочастиц в плазме магнетронного ВЧ-разряда
- David T. et al. Magnetic interactions of cold atoms with anisotropic conductors//The European Physical Journal D: Atomic, Molecular, Optical and Plasma Physics. 2008. Vol. 48(3). Р. 321-332.
- Chujiang C. et al. A comparison of two methods for metallizing fly-ash cenosphere particles: electroless plating and magnetron sputtering//Journal of Physics D: Applied Physics. 2007. Vol. 40. Р. 6026-6023.
- Flanagan T. M., Goree J. Dust release from surfaces exposed to plasma//Physics of Plasmas. 2006. Vol. 13. Р. 123504-1-123504-11.
- Han J. G. Recent progress in thin film processing by magnetron sputtering with plasma diagnostics//Journal of Physics D: Applied Physics. 2009. Vol. 42(4). Р. 043001-1-043001-16.
- Huang F. Y., Hwang H. H., Kushner M. J. A model for transport and agglomeration of particles in reactive ion etching plasma reactors//Journal of Vacuum Science & Technology A. 1996. Vol. 14(2). Р. 562-566.
- Ivanov A. et al. DCM Production in a Dusty-Plasma Trap//Plasma Processes and Polymers/R. d'Agostino et al., Editors. Wiley-VCH Verlag GmbH & Co. KgaA, 2005. Р. 455-464.
- Kaplan I. G. Intermolecular Interactions: Physical Picture, Computational Methods and Model Potentials. John Wiley & Sons, Ltd., 2006. 380 р.
- Kersten H. et al. Examples for application and diagnostics in plasma-powder interaction//New Journal of Physics. 2003. Vol. 5. Р. 93.1-93.15.
- Larsson M., Dinyari K. N., Wang H. Composite Optical Microcavity of Diamond Nanopillar and Silica Microsphere//Nano Letters. 2009. Vol. 9(4). Р. 1447-1450.
- Matherson K. J. et al. Measurement of low-energy total absolute atomic collision cross sections with the metastable 3P2 state of neon using a magneto-optical trap//Physical Review A. 2008. Vol. 78. Р. 042712-1-042712-5.
- Nitter T. Levitation of dust in rf and dc glow discharges//Plasma Sources Science & Technology. 1996. Vol. 5(1). Р. 93-111.
- Ohring M. Materials Science of Thin Films: Deposition and Structure. Academic Press Inc., 2001. 794 р.
- Pal A. F. et al. Rotation of Dusty Structures in RF Magnetron Discharge//18th Europhysics Conference on the Atomic and Molecular Physics of Ionized GasesLecce, Italy, 2006. Р. 203-204.
- Park H. -G., et al. Electrically Driven Single-Cell Photonic Crystal Laser//Science. 2004. Vol. 305(5689). Р. 1444-1447.
- Paul A., Wingbermuhle J. Surface morphology for ion-beam sputtered Al layer with varying sputtering conditions//Applied surface science. 2006. Vol. 252(23). Р. 8151-8155.
- Pillai S. et al. Surface plasmon enhanced silicon solar cells//Journal of Applied Physics. 2007. Vol. 101(9). Р. 093105-1-093105-8.
- Prodan E. et al. A Hybridization Model for the Plasmon Response of Complex Nanostructures//Science. 2003. Vol. 302(5644). Р. 419-422.
- Rossnagel S. M., Kaufman H. R. Induced drift currents in circular planar magnetrons//Journal of Vacuum Science & Technology A. 1987. Vol. 5(1). Р. 88-91.
- Rossnagel S. M., Kuan T. S. Alteration of Cu conductivity in the size effect regime//Journal of Vacuum Science & Technology B. 2004. Vol. 22(1). Р. 240-247.
- Shen Y., Bel Bruno J. J. Studies of Neutral and Ionic CuAr and CuKr van der Waals Complexes//Journal of Physical
- Chemistry A. 2005. Vol. 109(44). Р. 10077-10083.
- Springer Handbooks of Atomic, Molecular, and Optical Physics/Еd. G. W. F. Drake. Springer Science+Business Media, 2006. 1506 р.
- Swann S. Magnetron sputtering//Physics in Technology. 1988. Vol. 19. Р. 67-75.
- Thieme G. et al. Whispering Gallery Mode Spectroscopy as a Diagnostic for Dusty Plasmas//AIP Conference Proceedings. 2008. Vol. 1041. Р. 281-282.
- Vernooy D. W. et al. Cavity QED with high-Q whispering gallery modes//Physical Review A. 1998. Vol. 57(4). Р. R2293.
- Vieiraa M. T. et al. Surface modification of stainless steel powders for microfabrication//Journal of Materials Processing Technology. 2008. Vol. 201(1-3). Р. 651-656.
- Wasa K., Kitabatake M., Adachi H. Thin film materials technology: sputtering of compound materials. William Andrew, Inc. and Springer-Verlag GmbH & Co. KG, 2004. 518 р.
- Watanabe Y. Formation and behaviour of nano/micro-particles in low pressure plasmas//Journal of Physics D: Applied Physics. 2006. Vol. 39(19). Р. R329-361.


