Получение фотоактивных структур Si( N +)/Si( P)/Si( P +) методом ионно-лучевой кристаллизации
Автор: Варавка Валерий Николаевич, Чеботарв Сергей Николаевич, Пащенко Александр Сергеевич, Ирха Владимир Александрович
Журнал: Advanced Engineering Research (Rostov-on-Don) @vestnik-donstu
Рубрика: Технические науки
Статья в выпуске: 5-6 (74) т.13, 2013 года.
Бесплатный доступ
Разработана физико-математическая модель массопереноса при ионно-лучевой кристаллизации. Рассмотрено получение фотоактивных структур Si(n +)/Si(p)/Si(p +) на подложках 100 мм методом ионно-лучевой кристаллизации. Определены оптимальные условия этого процесса: остаточное давление в ростовой камере — 10 −4 Па; температура подложки — 550 °C; плотность ионного тока — 2 мА/см 2; ускоряющее напряжение пучка — 400 В; расстояние «мишень — подложка» — 150 мм. Данные сканирующей электронной микроскопии показывают, что выращенные фотоструктуры имеют практически бездефектную поверхность. Установлено, что фотоструктуры Si(n +)/Si(p)/Si(p +) характеризуются внешним квантовым выходом более 90 % в диапазоне длин волн 550—900 нм (спектр AM 1,5) при следующих условиях: толщина фронтального слоя Si(n +) 100 нм, уровень легирования n + = 5·10 18 см −3, толщина слоя Si(p) 130 мкм, уровень легирования p = 2·10 16 см −3, толщина слоя Si(p +) 500 нм, уровень легирования p + = 1·10 18 см −3.
Ионно-лучевая кристаллизация, фотоактивная структура, внешний квантовый выход
Короткий адрес: https://sciup.org/14250011
IDR: 14250011 | УДК: 539.231 | DOI: 10.12737/1283
Derivatization of photoactive structures Si( N +)/Si( P)/Si( P +) through ion-beam crystallization
The physical and mathematical mass-transfer model of the ion-beam crystallization method is developed. The derivatization of photoactive structures Si(n +)/Si(p)/Si(p +) on 100 mm substrates through ion-beam crystallization is considered. The optimum conditions for the process: residual pressure in the growth chamber — 10 −4 Pa; the substrate temperature — 550 °C; ion current density — 2 mA/cm 2; acceleration voltage — 400 V; target — substrate distance — 150 mm are determined. The scanning electron microscopy data show that the grown photoactive structures have closely a faultless surface. The results demonstrate that the photoactive structures Si(n +)/Si(p)/Si(p +) offer the external quantum efficiency over 90 % in the wavelength range of 550—900 nm (spectrum AM 1.5) under the following conditions: front layer thickness Si(n +) — 100 nm; donor doping density n + = 5∙10 18 cm −3; layer thickness Si(p) — 130 μm; acceptor doping density p = 2∙10 16 cm −3; layer thickness Si(p +) — 500 nm; acceptor doping density p + = 1∙10 18 cm −3.
Текст научной статьи Получение фотоактивных структур Si( N +)/Si( P)/Si( P +) методом ионно-лучевой кристаллизации
Введение. Достижения в фотовольтаике стимулировали исследования фотоактивных материалов и структур, а также разработку методов их получения. На основе кремния и соединений AIIIBV созданы высокоэффективные солнечные элементы [1].
Для получения структур c фотоактивными областями широко применяются методы молекулярно-лучевой [2] и газофазной эпитаксии [3]. В последние три десятилетия технологии получения фотоактивных материалов и структур стремительно развиваются, производство становится сложнее. При этом исследователи продолжают искать новые методы получения фотоактивных материалов. Цель настоящей работы — получение и исследование фотоактивных слоёв и структур на основе Si методом ионно-лучевой кристаллизации (ИЛК).
Теоретическая часть. Для теоретического исследования ионно-лучевой кристаллизации однокомпонентных полупроводниковых материалов разработана математическая модель процесса. Она основана на имитационном подходе Монте-Карло.
На рис. 1 показана схема моделируемого процесса ионно-лучевой кристаллизации и используемые математические величины. Первичный пучок ионов аргона с энергией EAr+ , плотностью тока jAr+ , диаметром dAr+ падает на центральную часть мишени. Причём диаметр мишени должен быть больше диаметра ионного пучка. Угол падения (между вектором jAr+ и плоскостью мишени) — произвольный α = (20—70)°. Пучок ионов выбивает атомы мишени, центр которой удалён от подложки диаметром Dsub (с радиусом Rsub) на расстояние L. Количество атомов ростового материала определяется коэффициентом распыления, зависящим от E , и а.
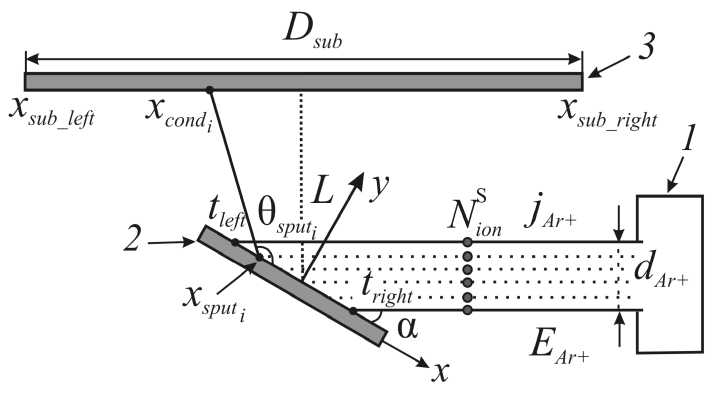
Рис. 1. Схема процесса ионно-лучевой кристаллизации
Условия и симметрия задачи допускают одномерное моделирование процесса при следующих допущениях:
-
1) распылённые атомы распределяются в пространстве по закону косинуса;
-
2) распылённые атомы не сталкиваются друг с другом и с атомами рабочего газа;
-
3) распылённые атомы конденсируются в точке соударения с подложкой;
-
4) максимальная интенсивность выбитых атомов наблюдается при углах распыления, близких (или равных) углу зеркального отражения;
-
5) ионы первичного пучка имеют одинаковую энергию и распределяются по сечению ионного пучка равномерно.
Количество ионов N on с зарядом q в ионном пучке сечением S и плотностью тока j A , , провзаимодействовавших с поверхностью мишени за время проведения процесса τ, устанавливается выражением:
Non = jAr + qS "T(1)
Предполагается, что ионы в пучке движутся по равноудалённым параллельным траекториям и сосредоточены в p сечениях. Число ионов в одном сечении равно:
,/V.
-Son = p ■(2)
Процесс моделирования является итерационным. Так как ионы первичного пучка моноэнергетич-ны и распределены по его сечению равномерно, то для получения координат локальной области распыления атомов мишени можно воспользоваться генератором псевдослучайных чисел, подчиняющимся равновероятностному закону распределения. Координата точки распыления i -го атома xsputi выбирается на отрезке [ tleft , tright ] при помощи генератора равновероятностного распределения:
x sputi = ( t right - t left ) " W i , (3)
где i = 1, - On , w i — случайное число, равномерно распределённое в интервале [0;1].
Далее для каждого распылённого атома рассчитывается траектория движения в системе отсчёта xy (рис. 1, а). Угол, задающий направление движения в системе xy , моделируется генератором псевдослучайных чисел, подчиняющимся косинусоидальному закону распределения:
8 sputi = arccos ( 2W i — 1 ) , (4)
где i = 17 N I ■
Уравнение траектории атома, распылённого из точки с координатами ( xsputi , 0), имеет вид:
y = tg ( S sputi )( x + x sput, ) .
Уравнение подложки в системе xy имеет вид:
y = tg ( a ) x + — L— . cos ( a )
Возможная координата кристаллизации атома на подложке xcondi находится решением системы уравнений, образованной выражениями (5) и (6):
x condi
k 2 • x sput
—
где k 1 = tg ( a ) , k 2 = tg ( arccos ( 2w i — 1 ) ) , b =
k1 —
L cos ( a ) ,
k 2
b
,
ω i — случайное число, равномерно распре-
делённое в интервале [0; 1].
Если x condi e [ x sub left , x sub right ] , то атом считается осаждённым на подложке. В противном случае атом не взаимодействует с подложкой и не учитывается при моделировании роста слоя.
Для построения профилей распределения толщины выращиваемых слоёв подложка разбивалась на M одинаковых ячеек длиной l M . Номер ячейки i , в которую конденсировался атом, определялся из выражения:
r i = F n
( x condi
—
x sub _ lef )
к
( x sub _ right
—
x sub _ left
) J ,
где F — функция округления .
При повторении описанной процедуры для N ion подсчитывалось общее число распылённых атомов мишени Nsput , конденсированных атомов Ncond , число атомов в каждой ячейке Nsput , определялись коэффициент массопереноса (9) и толщина слоя в i -й ячейке (10):
K m
h _ cond i
i
N cond
•
_ N cod , sput
K m ' jA, + • m aT τ,
P a • q
где m a и ρ a — атомная масса и плотность распыляемого материала.
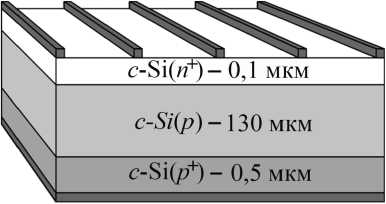
Рис. 2. Выращиваемая фотоактивная структура
На рис. 2 представлено схематическое изображение выращиваемых фотоактивных структур. В работе [4] проведено компьютерное моделирование фотоактивных структур предложенной конструкции и показано, что эффективность выращиваемых фотоактивных структур будет максимальной при толщине фронтального фотоактивного слоя Si( n +) 100–300 нм и уровне концентрации легирующей примеси 5·1018 см-3.
Экспериментальная часть. Для исследования свойств фотоактивных структур Si( n +)/Si( p )/Si( p +) методом ионно-лучевой кристаллизации были изготовлены три серии образцов. Процессы проходили при различных температурах подложки, энергиях распыляющих ионов и временах после диффузионного отжига. В качестве основы для базовой области структуры Si( n +)/Si( p )/Si( p +) были выбраны подложки кремния p- типа проводимости c ориентацией (100). Мишенями для выращивания фронтального слоя служили пластины низкоомного кремния n -типа проводимости с ориентацией (100).
Формирование высоколегированных областей n + и p + проводилось стандартным методом диффузии из легированного слоя SiO 2 . Получение p +-слоя структуры осуществлялось при температуре 950 °С в течение 40 минут в атмосфере кислорода. Фронтальный фотоактивный слой n +-типа формировался при температуре 950 °С в течение 10 минут в атмосфере кислорода. Глубина залегания p-n- переходов контролировалась измерением вольт-фарадных характеристик барьера Шоттки, образованного ртутным зондом и полупроводниковой структурой. Структура и морфология поверхности исследовались методами сканирующей зондовой микроскопии (СЗМ). Фотоэлектрические свойства структур исследовались измерением спектральных зависимостей внешнего квантового выхода.
Результаты экспериментов и их обсуждение. Ранее в работе [5] были исследованы зависимости процесса ИЛК от параметров конфигурации системы «источник ионов — мишень — подложка». Установлено, что слои с минимальным радиальным разбросом толщины будут осаждаться на подложки 100 мм при следующих условиях:
-
— плотность ионного тока — 2 мА/см2;
-
— расстояние «мишень — подложка» — 150 мм;
-
— угол наклона «мишень — ионный пучок» — 45°.
Методами сканирующей зондовой микроскопии исследовано влияние температуры подложки и энергии ионов пучка на структуру и качество выращенных методом ИЛК слоёв кремния. Видно, что при температуре 550 °C (энергия ионов фиксирована и равна E A + = 380 эВ) получаются практически бездефектные и однородные слои кремния высокого качества (рис. 3). Это можно объяснить следующим образом.
При ионно-лучевой кристаллизации для создания условий равномерного роста слоя необходимо обеспечить достаточную скорость осаждения материала, чтобы при данной температуре происходил равномерный послойный рост плёнки на всей площади подложки Si. На основе данных (рис. 3, а , б , в ) можно сделать вывод, что при температуре подложки 550 °C (рис. 3, б ) реализуется оптимальное соотношение скорости поверхностной диффузии атомов к скорости осаждения распылённых атомов.
Результаты исследования влияния энергии ионов на качество формируемых кремниевых слоёв при температуре подложки 550 °C отражают СЗМ-изображения поверхности центральной части слоёв при трёх различных значениях энергии распыляющих ионов (рис. 4, а , б , в ). При энергии ионов 400 эВ наблюдается практически эпитаксиальный рост малодефектных слоёв кремния (рис. 4, б ). При энергиях ионов, отличных от 400 эВ, превалируют процессы дефектооб-разования и ухудшения структуры выращенного слоя (рис. 4, а , в ).
Проведены СЗМ-исследования влияния температуры подложки и энергии ионов на структуру поверхности осаждённых слоёв кремния. Данные этих экспериментов позволили установить оптимальные параметры ростового режима и конфигурации системы «источник ионов — мишень — подложка», при которых выращенные слои кремния обладают высоким структурным совершенством и минимальным разбросом толщины:
-
— давление в ростовой камере — 10-4 Па;
-
— температура подложки — 550 °C;
-
— плотность ионного тока — 2 мА/см2;
-
— энергия ионов пучка — 400 эВ;
-
— угол наклона «мишень — ионный пучок» — 45°;
-
— расстояние «мишень — подложка» — 150 мм;
-
— диаметр подложки — 100 мм;
-
— диаметр ионного пучка — 44 мм.
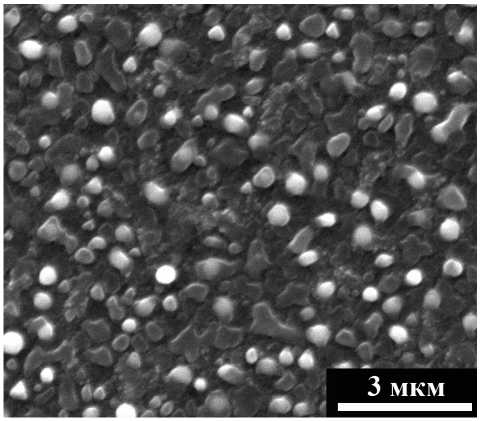
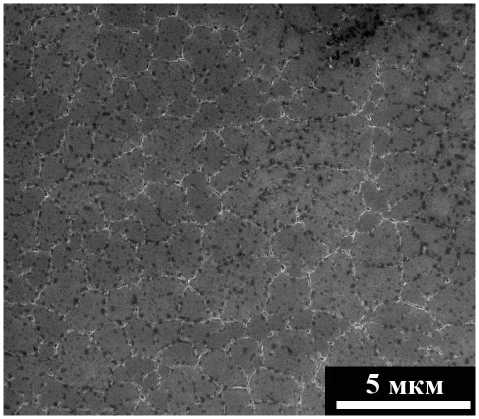
а )

а )
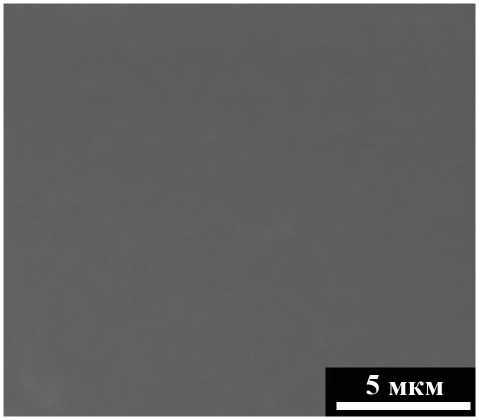
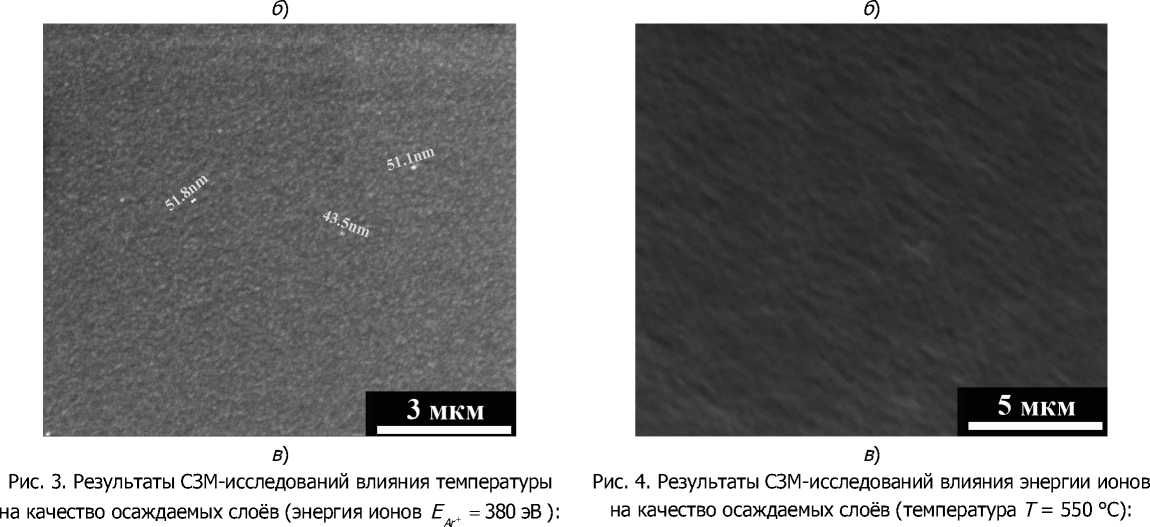
T = 400 °C ( а ), T = 550 °C ( б ), T = 700 °C ( в )
E A + = 150 эВ ( а), E Ar + = 400 эВ (б), E Ar + = 600 эВ (в)
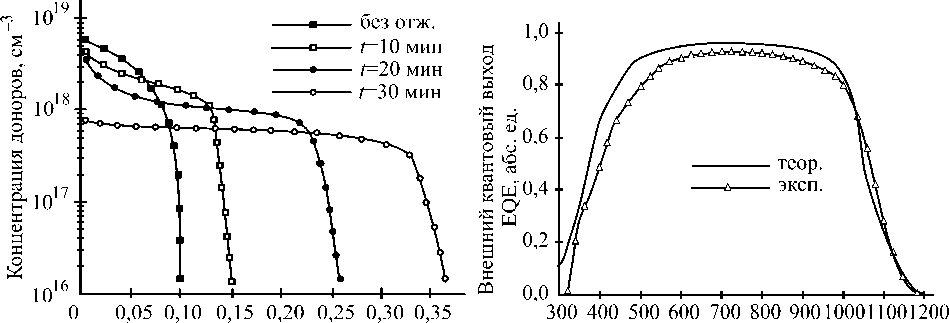
Глубина, мкм Длина волны X, нм
а ) б )
Рис. 5. Результаты исследования структуры Si( n +)/Si( p )/Si( p +): глубина залегания p-n- перехода ( а ), спектральная зависимость внешнего квантового выхода ( б )
Исследован процесс формирования p-n- переходов методом ионно-лучевой кристаллизации для получения фотоактивных структур. Результаты представлены на рис. 5, а . Анализ показывает, что увеличение времени отжига приводит к улучшению равномерности распределения фосфора по глубине фронтального слоя Si( n +). Однако с улучшением однородности распределения концентрации фосфора по глубине фронтального слоя наблюдается смещение границы p-n -перехода в объём структуры, сопровождающееся уменьшением концентрации фосфора в фронтальном слое. Экспериментально установлено, что при отжиге в течение 10 минут наблюдается оптимальная глубина залегания p-n -перехода (100—200 нм) в сочетании с высоким уровнем легирования (4·1018 см-3) и равномерным распределением концентрации фосфора по глубине фронтального слоя Si( n +).
Для оценки качества и анализа эффективности фотоэлектрического преобразования излучения в фотоактивных структурах Si( n +)/Si( p )/Si( p +), полученных ионно-лучевой кристаллизацией, выполнены исследования спектральных зависимостей внешнего квантового выхода (рис. 5, б ). Полученная спектральная зависимость характеризуется высоким внешним квантовым выходом в спектральном диапазоне 550—900 нм, который достигает значений до 90 %. Это, по-видимому, обусловлено высоким структурным совершенством фронтальных слоёв Si, выращенных ионнолучевой кристаллизацией. Полученные экспериментальные данные хорошо согласуются с результатами компьютерного моделирования [4] фотоактивных структур Si( n +)/Si( p )/Si( p +) для толщины фронтального слоя Si( n +) 0,1 мкм и уровня легирования 5·1018 см-3 в спектральном диапазоне 300—1200 нм при условии освещения AM 1,5 (рис. 5, б — сплошная линия).
Выводы. Разработана математическая модель ионно-лучевой кристаллизации фотоактивных материалов, которая позволила теоретически исследовать зависимость процесса ионно-лучевой кристаллизации слоёв от параметров конфигурации системы «источник ионов — мишень — подложка». На основе теоретических данных экспериментально определены оптимальные параметры формирования слоёв Si для получения фотоактивных структур Si( n +)/Si( p )/Si( p +) методом ионнолучевой кристаллизации. Установлено, что однородные по толщине, практически бездефектные слои кремния на подложках 100 мм получаются при следующих ростовых режимах: — давление в ростовой камере — 10-4 Па;
-
— температура подложки — 550 °C;
-
— плотность ионного тока — 2 мА/см2;
-
— ускоряющее напряжение пучка — 400 В;
-
— угол наклона «мишень — ионный пучок» — 45°;
-
— расстояние «мишень — подложка» — 150 мм.
Данные анализа профилей распределения концентрации фосфора в фронтальном слое c -Si( n +) свидетельствуют о том, что увеличение времени отжига приводит к улучшению равномерности распределения фосфора по глубине фронтального слоя c -Si( n + ). Экспериментально установлено, что оптимальная глубина залегания p-n -перехода (0,1—0,2 мкм) наблюдается при отжиге в течение 10 минут при температуре 900 °C.
Список литературы Получение фотоактивных структур Si( N +)/Si( P)/Si( P +) методом ионно-лучевой кристаллизации
- Алфёров, Ж. И. Тенденции и перспективы развития солнечной энергетики/Ж. И. Алфёров, В. М. Андреев, В. Д. Румянцев//Физика и техника полупроводников. -2004. -Т. 38, вып. 8. -С. 937-948.
- Структуры GaAs c квантовыми точками InAs и As, полученные в едином процессе молекулярно-лучевой эпитаксии/В. Н. Неведомский [и др.]//Физика и техника полупроводников. -2009. -Т. 43, вып. 12. -С. 1662-1666.
- Высокоэффективные двухпереходные GaInP/GaAs солнечные элементы, полученные методом МОС-гидридной эпитаксии/В. М. Лантратов [и др.]//Физика и техника полупроводников. -2007. -Т. 41, вып. 6. -С. 751-755.
- Чеботарёв, С. Н. Моделирование зависимостей функциональных характеристик кремниевых солнечных элементов, полученных методом ионно-лучевого осаждения от толщины и уровня легирования фронтального слоя/С. Н. Чеботарёв, А. С. Пащенко, М. Л. Лунина//Вестник Южного научного центра. -2011. -Т. 7, № 4. -С. 25-30.
- Ионно-лучевое осаждение фотоактивных нанослоёв кремниевых солнечных элементов/Л. С. Лунин [и др.]//Неорганические материалы. -2012. -Т. 48, № 5. -С. 517-522.


