Получение варизонного твердого раствора Si1-xGex из жидкой фазы
Автор: Раззаков Алижон Шоназарович, Латипова Муборак Аманбаевна, Кадиров Алибек Хамраевич
Журнал: Бюллетень науки и практики @bulletennauki
Рубрика: Технические науки
Статья в выпуске: 3 т.7, 2021 года.
Бесплатный доступ
Приведены теоретические расчеты с использованием экспериментальных данных, а также результаты исследований зависимости состава растворов-расплавов ( Sn + Ge + Si , Ga + Ge + Si ) от температурного режима. Получены монокристаллические пленки варизонного твердого раствора Si1-xGex (0 методом жидкофазной эпитаксии из ограниченного оловянного, галлиевого раствора-расплава. Найдены оптимальные технологические режимы роста, для получения кристаллических совершенных эпитаксиальных слоев и структур.
Дислокация, эпитаксия, кластер, твердый раствор, кристаллизация
Короткий адрес: https://sciup.org/14120467
IDR: 14120467 | УДК: 544.35.03 | DOI: 10.33619/2414-2948/64/20
Getting variable-gap solid solution Si1-xGex from a liquid phase
Using experimental data, as well as using theoretical calculations, the results of studies of the composition of melt solutions ( Sn + Ge + Si , Ga + Ge + Si ) from temperature conditions are presented. Single-crystal films of a graded-gap solid solution Si1-xGex (0 substrates were obtained by liquid-phase epitaxy from a limited tin, gallium solution-melt. Optimal technological growth modes are found for obtaining crystalline perfect epitaxial layers and structures.
Текст научной статьи Получение варизонного твердого раствора Si1-xGex из жидкой фазы
Бюллетень науки и практики / Bulletin of Science and Practice
УДК 544.35.03
С целью совершенствования технологии получения высококачественных тонких слоев полупроводникового материала методом жидкофазной эпитаксии, с заданными электрофизическими и фотоэлектрическими свойствами, на такую дешевую подложку как кремний, является весьма актуальной.
Авторы [1–3] старались получить структурно совершенные эпитаксиальные слои
Si - ( Si2 ) ( Ge2 )x( GaAs ) Si - Si Ge - ( Ge7 ). ( GaAs )
Si i - x Ge x и гетеропереходы 2 y 2 y , 1- x x v 271- x x ,
Si - Si 1 — x Ge x - GaAs на их основе. Для этого они исследовали технологические режимы роста, электрические и фотоэлектрические свойства эпитаксиальных слоев Si 1 - x Ge x и их структур [4].
В процессе роста из жидкой фазы эпитаксиальных слоев Si1-xGex используются кремниевые подложки, у которых параметр решетки и коэффициент термического расширения (КТР) близки к образующимся эпитаксиальным слоям. Подбирались разные методы и переменный варизонный состав твердого раствора, чтобы избежать дислокаций и микротрещин, а также частичных растворений подложек (при положении не до пересыщенного раствора к компонентам подложки) и т. д.
В этой работе, в результате исследований, использованы апробированные экспериментальные научные методы,, с помощью которых, получены экспериментальные данные. Обычно, при выращивание твердого раствора Si 1 - xGex используются подложки с определенными наименьшими уклонами во время роста пленок из жидкой фазы, которые способствуют образованию эпитаксиальных слоев на поверхности. Любая поверхность твердого тела имеет определенную шероховатость, поэтому, поверхностная энергия распределяется неравномерно и влияет на выращивание твердого раствора на подложке, а также на образование дислокаций, которые связаны с такими технологическими параметрами, как: температура начала кристаллизации (Т нк ), скорость роста (υ), зазор между подложками (d), состав компонентов в растворе-расплаве, с ориентациями подложек и т. д.
Выращивание производилось из жидкой фазы. В качестве металла-растворителя использовали Pb, Sn. In иGa. Наиболее качественные слои выращивались при использовании Sn.
Подложками служили кремниевые шайбы диаметром 20 мм, с кристаллографической ориентацией (111) и (100), марки КДБ, с удельным сопротивлением 1÷10 Ом ⋅ см.
Эпитаксиальные пленки на кремниевых подложках кристаллографической ориентации (111) росли хорошо, тогда как на подложках с ориентацией (100) росли очень плохо или вообще не росли.
Для выращивания варизонного твердого раствора
Si
1
-
xGex
(0
Исследование химического состава поверхности и скола выращенных эпитаксиальных слоев Si1 - x Ge x , были проведены на рентгеновском микроанализаторе Jeol JSMLV-1059-Japan. Полученные растровые картины свидетельствовали о почти однородном распределении по поверхности эпитаксиального слоя, и о варизонности твердого раствора по толщине (Рисунок 1). Включения макроскопических дефектов и второй фазы в слоях пленки отсутствуют.


Рисунок 1. Растровые картины Si - Si Ge структур, снятые при помощи Jeol JSMLV-1059-Japan.
Во время выращивания при контакте подложка-раствор-расплав смачивание подложки со стороны раствора и диффузионные движения компонентов, образующих твердый раствор, способствуют росту эпитаксиальных слоев, это приведено нами в работе [6]. Это недостаточно для выращивания структурно совершенных Si Ge эпитаксиальных слоев и гетероструктур на их основе.
Проведя эксперименты, было выяснено: изменяя зазор между подложками “d” (то есть изменяя объем раствора-расплава между подложками), при одинаковом режиме роста, выращенные эпитаксиальные слои на нижних и на верхних подложках не отличались друг от друга, с кристаллическими совершенностями на поверхности и на границе подложки-пленки до d<1,2 mm (Рисунок 2 а, б).
В условиях d≥1,2 mm всегда у верхних подложек образуются толстые и более низкокачественные слои, чем у нижних, которые связаны с диффузионным и с конвекционным потоками компонентов в ограниченном растворе (если плотность растворяемых компонентов меньше плотности растворителя) [7].
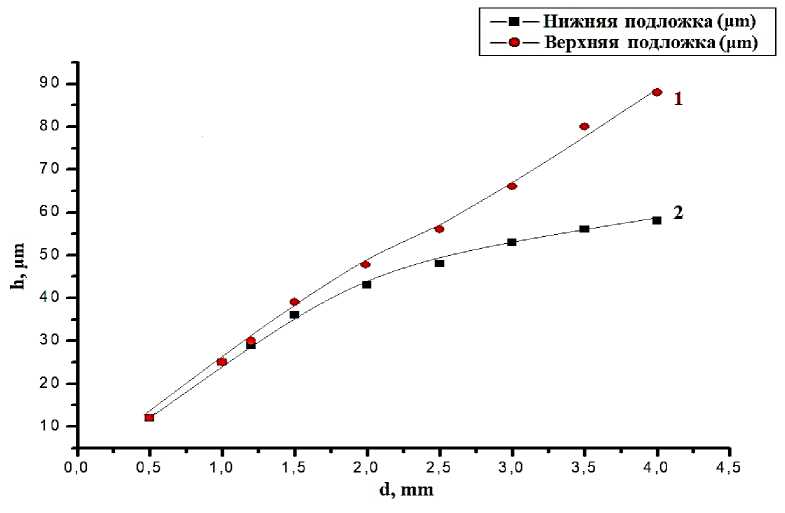
Рисунок 2а. Зависимость толщины эпитаксиальных слоев (h) от величины зазора между подложками (d): 1— на верхней, 2 — на нижней подложках, при температуре начала кристаллизации Tнк = 900 °С из оловянного раствора-расплава.

Рисунок 2б. Зависимость разницы толщины верхней и нижней подложки эпитаксиальных слоев (∆h), от зазора между подложками (d) при температуре начала кристаллизации Tнк = 900 °С из оловянного раствора-расплава.
Использовав формулу Эйнштейна-Смолуховского, нами теоретически рассчитано, что во время роста в растворе-расплаве, некоторые атомы успевают объединиться за счет процесса коагуляции (чем больше температура, тем больше число коагуляций) одинаковых компонентов раствора и образуют кластеры размером 1–10 nm. Эти кластеры составляют незначительную часть доли всех растворенных элементов. Ионы участвуя в процессе роста, с наименьшими концентрациями, чем в выращиваемых компонентах не разрушают монокристалличность варизонного твердого раствора [8]. Они, способствуют образованию дислокаций, как на границу подложки-пленки, так вдоль направления роста пленки, и ухудшают кристаллическую совершенность пленок и структур, соответственно — их электрофизические и фотоэлектрические свойства, являющиеся важнейшими параметрами в применении приборостроения.
Учитывая вышеуказанное, можем предположить, что атомы Si и Ge внутри раствора образуют достаточно малое число молекулярных или кластерных соединений, участвующих в кристаллообразовании, и доминируют в процессе увеличения плотности дислокаций. Особенно, на эпитаксиальных слоях пленки, выращенных на верхней подложке, что объясняется результатом силы Архимеда и тяжести, проявляется укрупнением кластера и является незначительной величиной. Хотя там доминирует диффузионный процесс атомов и молекул.
Скопление кластеров, на верхней поверхности растворов, вблизи подложек и беспорядочные диффузионные движения, способствуют их участию во время роста и соответственно образованию дислокаций.
Было исследовано морфология поверхности полученных пленок, с помощью металлографического микроскопа МИМ-8М. Подобран состав травителя (использовались смеси концентрированных плавиковой (HF), азотной (HNO 3 ) и уксусной (CH 3 COOH) кислот в соотношениях 1чHF+3чHNO 3 +4чCH 3 COOH). Для выявления дислокационных ямок травления на плоскости (111) образцы подвергали травлению в растворе, затем травитель разбавляли деионизованной водой и промывали. Для определения плотности дислокаций
(N D ), на каждом послойном образце было сделано 6–7 подсчетов.
Полученные экспериментальные данные показали, что плотность дислокаций (N D )
выращенных полупроводниковых твердых растворов Si1-xGexзависит от всех технологических параметров: от температуры роста, скорости принудительного охлаждения, ориентации и чистоты подложек, типа растворителя. Содержание кремния, начиная с границы подложка-пленка Si - Si1-xGex вдоль направления роста уменьшается, соответственно содержание германия увеличивается и таким образом выращиваем варизонные эпитаксиальные слои, у которых ширина запрещенный зоны (∆E) изменяется плавно, начиная от кремния (∆ESi=1.12eV) заканчивая на германии ∆EGe=0.67eV).
Нами были получены, зеркальногладкие эпитаксиальные слои полупроводникового твердого раствора
Si 1 - x Ge x
и определены оптимальные режимы роста для выращивания
кристаллических совершенных
Si 1 - x Ge x
эпитаксиальных слоев из ограниченного оловянного и
галлиевого раствора-расплава на монокристаллических подложках Si с ориентацией.
Список литературы Получение варизонного твердого раствора Si1-xGex из жидкой фазы
- Fadaly E. M., Dijkstra A., Suckert J. R., Ziss D., van Tilburg M. A., Mao C.,.. Bakkers E. P. Direct-bandgap emission from hexagonal Ge and SiGe alloys // Nature. 2020. V. 580. №7802. P. 205-209. DOI: 10.1038/s41586-020-2150-y
- Jo K. W. et al. Impact of SiGe layer thickness in starting substrates on strained Ge-on-insulator pMOSFETs fabricated by Ge condensation method // Applied Physics Letters. 2019. V. 114. №6. P. 062101. DOI: 10.1063/1.5068713
- Saidov A. S., Usmonov S. N., Amonov K. A., Niyazov S., Khudayberdiyeva A. I. Photothermovoltaic Effect in p-Si- n-(Si 2) 1-x-y (Ge 2) x (ZnSe) y Structure // Applied Solar Energy. 2019. V. 55. №5. P. 265-268. DOI: 10.3103/S0003701X19050116
- Тимофеев В. А. Морфология и структура поверхности на начальных стадиях роста пленок GeSi и GeSiSn на Si(100): дисс. … физ.-мат. наук. Новосибирск, 2014. 171 с.
- Сапаев Б., Саидов М. С., Саидов А. С., Каражанов С. Ж. Твердые растворы (C IV 2) 1-x (A III B V) x, полученные из ограниченного объема оловянного раствора-расплава // Физика и техника полупроводников. 2004. Т. 38. №11. С. 1285-1293.
- Раззаков А. Ш., Курбанов Д. Ш. Зависимость дислокаций на твердом растворе Si1-xGex от температур роста на контактной фазе "твердое тело - жидкость" // РИАК-XII-2020: Республиканская конференция. 2020. С. 275-277.
- Боцелев С. П., Марончук И. Е., Марончук Ю. Е. Кристаллизация эпитаксиальных слоев AlGaAs из ограниченного объема раствора-расплава // Неорганические материалы. 1977. Т. 13. №5. С. 769-772.
- Rudolph P., Jurisch M. Fundamental and technological aspects of Czochralski growth of high quality semi-insulating GaAs crystals // Crystal Growth Technology. 2003. P. 293-321. DOI: 10.1002/0470871687


