Повышение точности контактного метода измерения текущей площади кристаллов, выращиваемых способом Чохральского
Автор: Саханский С.П., Юленков С.Е.
Журнал: Сибирский аэрокосмический журнал @vestnik-sibsau
Рубрика: Технологические процессы и материалы
Статья в выпуске: 3 т.19, 2018 года.
Бесплатный доступ
Для кристаллов, выращиваемых из жидкого расплава по способу Чохральского, при контроле и управлении текущей площадью кристалла, на основе контактного метода измерения определены основные требования для обеспечения точности измерения площади кристалла на цилиндрической части выращивания. В системе управления по координатам перемещения кристалла и тигля необходимо применять фотосчитывающие оптические линейки с дискретностью отсчета 0,1 мкм для определения величины перемещений за время цикла оценки сигнала управления. Для устранения ошибки из-за точности стабилизации уровня расплава в тигле предложен следующий алгоритм работы установки выращивания кристаллов. За время оценки сигнала управления на цилиндрической части выращиваемого кристалла принимается время выборки заданного количества импульсов перемещения тигля. Начинается вычисление времени оценки сигнала управления в момент замыкания датчика расплава и заканчивается в момент замыкания датчика расплава при условии выборки заданного количества импульсов перемещения тигля. Время оценки сигнала управления в предыдущем цикле управления используется в текущем цикле для вычис- ления паузы замыкания как части вычисленного времени цикла оценки. В системе управления в момент замы- кания контактного датчика выдерживается пауза замкнутого и последующая такая же пауза разомкнутого состояния датчика уровня. В моменты пауз состояние контактного датчика системой управления не анали- зируется, и управление подъемом тигля происходит с замедленной и ускоренной скоростью подъема тигля в моменты «условно замкнутого» и «условно разомкнутого» состояний датчика уровня. Все это обеспечивает в данной системе управления точность измерения текущей площади кристалла на цилиндрической части величиной не хуже 1 %.
Ращивание, кристаллы, контактный метод измерения
Короткий адрес: https://sciup.org/148321869
IDR: 148321869 | УДК: 004.07 | DOI: 10.31772/2587-6066-2018-19-3-550-561
Increasing the accuracy of the contact method of measuring the current square of crystals grown by the way of the Czohralsky
For crystals grown from a liquid melt by the Czochralski method, when monitoring and controlling the current crystal area, based on the contact method of measurement, the basic requirements for ensuring the accuracy of measuring the area of the crystal on the cylindrical part of the growing are determined. In the control system with respect to the coordinates of the movement of the crystal and the crucible, it is necessary to use photo-reading optical rulers, with a sampling resolution of 0.1 µm, to determine the amount of movement during the control signal evaluation cycle. To eliminate the error due to the accuracy of stabilization of the melt level in the crucible, the following algorithm for the operation of the crystal growing apparatus is proposed. During the evaluation of the control signal on the cylindrical part of the growing crystal, the sampling time of the predetermined number of pulses of the crucible movement is adopted. Calculation of the evaluation time of the control signal begins at the moment of closure of the melt sensor and ends when the melt sensor closes, provided that a predetermined number of pulses of the crucible transfer is sampled. The evaluation time of the control signal in the previous control cycle is used in the current cycle to calculate the closure pause as part of the calculated evaluation cycle time. In the control system, at the moment of closing the contact sensor, a pause of the closed sensor is maintained, followed by a similar pause of the open state of the level sensor. During the moments of pauses, the state of the contact sensor by the control system is not analyzed and the control of the crucible lift occurs with a slowed and accelerated rate of the crucible lift during the moments of the “conditionally” closed and “conditionally” open states of the level sensor. All this ensures in this control system the accuracy of measuring the current area of the crystal, on the cylindrical part, by a value not worse than 1 %.
Текст научной статьи Повышение точности контактного метода измерения текущей площади кристаллов, выращиваемых способом Чохральского
Введение. В работе [1] предложен оригинальный способ контроля процесса выращивания монокристалла по способу Чохральского, который основан на использовании в качестве программатора шаблона, имитирующего кристалл заданной формы. Тигель с расплавом и контейнер с жидкостью помещают на верхнечашечные лабораторные весы. В процессе роста шаблон погружают в жидкость с той же скоростью, с какой кристалл вытягивается из расплава. Шаблон и кристалл соединены гибкой тягой. Равновесие сохраняется, если количество твердой фазы и жидкости, вытесняемой шаблоном в единицу времени, одинаково. При нарушении равновесия (уменьшение или увеличение диаметра кристалла) сигнал рассогласования весов после оптоэлектронного преобразователя и усиления используется как программирующий для температурного контроля нагревателя совместно с сигналом от термопары. В устройстве [2] при вытягивании монокристалла заданного диаметра за счет лазерного измерителя контролируют непрерывно убывающий уровень расплава в тигле. Сигнал с лазерного измерителя уровня расплава сравнивают с программируемым задатчиком изменения уровня, а разностный сигнал после данного сравнения используют для коррекции температуры расплава через регулятор мощности нагревателя и скорости вытягивания кристалла. Посредством данного регулирования стабилизируют текущий диаметр кристалла.
Микропроцессорные системы управления выращиванием кристаллов германия, разработанные на основе патентов [3; 4], были внедрены в полупроводниковое производство выращивания кристаллов германия (рис. 1). В свою очередь, данная разработка является аналогом систем управления, приведенных в работах [1; 2].
Работа систем управления, основанных на контактном методе измерения текущей площади выращиваемых кристаллов (рис. 1), заключается в следующем: под управлением системы управления в камере производится выращивание кристалла диаметром d , со скоростями выращивания V з и вращения W з кристалла, при этом расплавленный металл, находящийся в тигле с внутренним диаметром D , вращается с угловой скоростью W т по мере убывания расплава в тигле.
Сигнал с контактного датчика подается через сглаживающий фильтр C 1, R 1, R 2 и блок согласования в ЭВМ для принятия решения об управлении подъемом тигля вверх, которое осуществляется блоком управления шаговым двигателем. Кроме скорости подъема тигля вверх V т в системе происходит формирование информации о перемещении тигля X итц
(с дискретностью x т ) и информации X изц о перемещении кристалла (с дискретностью x з ). Управление от ЭВМ скоростями выращивания кристалла V з, вращения кристалла W з, вращения тигля W т осуществляется через соответствующие приводы. Управление температурой расплава осуществляется на основе формирования задания температуры Т з от ЭВМ на регулятор температуры, с обратной связью по датчику температуры боковой поверхности нагревателя.
Основы работы систем управления, при контактном методе измерения текущей площади выращиваемых кристаллов. Управление скоростью выращивания кристалла V з ( x ), температурой боковой поверхности нагревателя T з ( x ), скоростью вращения кристалла W з( x ) и тигля W т( x ) формируется на основе выражений (1)–(4):
V , ( x ) = V зп ( x ) + Z ■ K ■ y , (1)
T , ( x ) = T m( x ) + Z ■ A t ■ / y ■ dx , (2)
W з ( x ) = W зп ( x ), (3)
W т ( x ) = W тп ( x ), (4)
где KV - пропорциональный коэффициент регулирования по скорости; AT - интегральный коэффициент регулирования по температуре; V зп( x ), W зп( x ), W тп( x ), T зп( x ) - программное задание закона изменения технологических параметров; V з ( x ), W з ( x ), W т ( x ), T з ( x ) - общее управление технологическими параметрами; Z - признак захвата управления по диаметру на цилиндрической части кристалла; x - перемещение вдоль оси кристалла; y – сигнал управления по отклонению текущей площади выращиваемого кристалла от заданной.
Процесс стабилизации диаметра кристалла происходит в системе управления в соответствии с выражениями (1), (2), при включении признака захвата управления по диаметру ( Z = 1) на цилиндрической части кристалла, на основе сигнала управления y .
Программные задания технологических параметров процесса выращивания кристалла германия V зп ( x ), W зп ( x ), T зп ( x ) в микропроцессорных системах были основаны на задании кадровой системы управляющих параметров, где в каждом кадре записана скорость, направление изменения параметра и время кадра. Если задать геометрию выращиваемого кристалла и его осевой градиент в твердой части, то можно предварительно смоделировать задание скорости и температуры выращивания на всех участках кристалла по разработанной авторами модели роста [5].

Рис. 1. Система управления на основе контактного метода измерения:
1 – привод вращения затравки; 2 – привод перемещения затравки; 3 – контактный датчик; 4 – блок согласования с ЭВМ; 5 – датчик температуры; 6 – регулятор температуры; 7 – ЭВМ; 8 – привод вращения тигля; 9 – шаговый двигатель; 10 – блок управления шаговым двигателем; 11 – датчик перемещения затравки; 12 – камера; 13 – слиток;
14 – расплав металла; 15 – тигель; 16 – экран; 17 – нагреватель
-
Fig. 1. Control system based on the contact method of measurement:
-
1 – seed rotation drive; 2 – seed drive; 3 – contact sensor; 4 – coordination unit with a computer; 5 – temperature sensor;
-
6 – temperature regulator; 7 – the computer; 8 – rotational drive of the crucible; 9 – stepper motor; 10 – stepper motor control unit; 11 – the sensor of seed movement; 12 – the chamber; 13 – ingot; 14 – melt of metal; 15 – crucible;
16 – screen; 17 – heater
Конструктивное исполнение системы автоматического управления вытягиванием монокристаллов германия приведено на рис. 2, а на рис. 3 приведен вид плавающего графитового экрана с графитовым датчиком уровня расплава, на рис. 4 показан вид выращенного монокристаллического слитка германия диметром 104 мм.
Основой для контактного метода контроля и управления выращиванием кристаллов [6–18] является управление текущей площадью (или диаметром при круглой форме) растущего кристалла по сигналу управления y, вычисленному как функция отклонения текущей площади кристалла от заданной, с использованием перемещений кристалла Xзц и тигля Xтц за период Tц оценки сигнала управления y. От точности определения сигнала управления y и отсутствия в вычисленном значении значительных помех напрямую зависит форма выращиваемого кристалла на его цилиндрической части.

Рис. 2. Микропроцессорная система управления вытягиванием монокристаллов германия
-
Fig. 2. Microprocessor control system for drawing germanium single crystals

Рис. 3. Плавающий графитовый экран и датчик уровня расплава
-
Fig. 3. Floating graphite screen and melt level sensor

Рис. 4. Слиток германия диаметром 104 мм
Fig. 4. A germanium billet with a diameter of 104 mm
Скорость убывания расплава в тигле V р , а также ускоренная скорость подъема тигля вверх V тм после размыкания контактного датчика и замедленная скорость подъема тигля после замыкания контактного датчика V тм/ M определяются по выражениям (5)-(9), в которых введены коэффициенты увеличения скорости ( C = 4) и уменьшения скорости подъема тигля ( M = 4), что нашло применение при выращивании цилиндрической части кристалла и обеспечивает периодическое замыкание и размыкание контактного датчика в диапазоне изменения уровня расплава порядка 1–2 мкм. При выращивании прямого и обратного конуса кристалла для управления скоростью перемещения тигля вверх применяется условие полной остановки подъема тигля в моменты замкнутого состояния датчика уровня расплава ( M = ∞):
материала; d 1 - заданный диаметр выращиваемого кристалла на цилиндрической части; d max – максимально допустимый диаметр выращиваемого кристалла, с соблюдением которого выполняется основное условие, при котором датчик и экран сомкнутся после размыкания; d min – минимально допустимое значение диаметра кристалла, при котором соблюдается условие отставания экрана от датчика после его замкнутого состояния.
Для контактного метода измерения сигнал управления y , величина перемещения затравки X зц и тигля X тц за время оценки T ц могут быть представлены в виде выражений (10)–(14):
y
= X
k итц
K y X изц
^^^^^^^^^^^^^^^^^^^^^^^^^^^> ^^^^^^* ^^^^^^^^^^^^^^^^^^^^^^^^^^в
A ■ B A
,
„ ТЛ Рт d
V - = V •, Б
ρ ж
K y = B ■
x т ■ Р ж x 3 ■ Р т
D
d 1
у = у = у. т тм р
V т =
У
тм
M
d
max d
d = d, max 1
= V ■ р
ρ т
з
ρ ж
d max
D
V1 -1/ с ’
d min d
= V ,^
ρ ж
max
d„ = d min

,
d min
D
,
где V т - скорость подъема тигля; V р - скорость убывания расплава в тигле; V з - скорость выращивания кристалла; d - текущий диаметр кристалла; D - внутренний диаметр тигля; рт - удельная плотность твердого материала; рж - удельная плотность жидкого
)
- 1
X зц = X изц ■ X 3 , (13)
X тц X итц X т ,
где А , В - коэффициенты масштабирования; K у - уставка заданного диаметра (площади) выращиваемого кристалла; X изц - перемещение затравки с дискретностью отсчета x з; X итц - перемещение тигля с дискретностью отсчета x т ; x з - дискретность отсчета перемещения затравки; x т - дискретность отсчета перемещения тигля.
Выражение (12) показывает непосредственную связь сигнала управления y с отклонением текущей площади кристалла от заданной. За время цикла оцен-
ки T ц сигнал управления y вычисляют в системе управления по выражению (10), а с помощью записи в систему управления уставки диаметра K у на цилиндрической части выращиваемого кристалла задают площадь выращивания.
В качестве привода подъема тигля для управления скоростью подъема вверх применяют разомкнутый шаговый привод с шаговым двигателем, обеспечивающий процесс многократного изменения скорости подъема тигля по сигналу с контактного датчика уровня.
Выражения для импульсов перемещения затравки X изц, тигля X итц и времени T ц оценки сигнала управления y можно представить в виде выражений (15), (16):
X итц ' K y
X изц B *
T = X изц • x з = X зц = X итц • K y ' x з ц V , V з B ' V ,
где T ц - период оценки сигнала управления (время отработки заданного количества импульсов X итц или X изц ).
Примем за время оценки T ц сигнала управления y на цилиндрической части выращиваемого кристалла время выборки заданного количества импульсов перемещения тигля X тц (в процессе убывания расплава в тигле) в соответствии с выражениями (17), (18):
гивания германия применена временная диаграмма управления (рис. 5) при выращивании цилиндрической части кристалла, состоящая в том, что в системе управления в момент замыкания контактного датчика необходимо выдержать программную паузу τ замкнутого и последующую паузу τ разомкнутого состояния датчика уровня. В моменты пауз величиной τ состояние контактного датчика системой управления не анализируется, и управление подъемом тигля происходит с замедленной и ускоренной скоростью подъема тигля в моменты «условно замкнутого» и «условно разомкнутого» состояний датчика уровня.
После выдержки двух пауз происходит анализ условий замыкания датчика уровня расплава и управление приводом перемещения тигля вверх.
Данное управление повышает помехозащищенность метода вычисления текущей площади на цилиндрической части выращиваемого кристалла за счет отсутствия реакции системы на срабатывания контактного датчика в моменты двух пауз.
Величина размыкания уровня расплава на цилиндрической части выращиваемого кристалла L p задается в пределах 2 мкм. Время паузы τ и время t дм ( d ) замыкания датчика (после двух пауз) можно представить в виде выражений (21), (22) при условии размыкания датчика расплава на величину L p :
т =
ρ т
X тц X зц ρ ж
T = X тц
T ц V з
d i 1 2
D
D 1
d 1
L р ' T ц

Время суммарного движения t в процессе замыкания контактного датчика с замедленной скоростью и время суммарного движения с ускоренной скоростью движения тигля после размыкания датчика t д, а также число циклов K ц по замыканию и размыканию датчика за период оценки сигала управления T ц можно представить в виде выражений (19), (20):
X тц '
t дм ( d ) = т -
С л Л2
1 -I d min l
LI d J J
- т
^ )2
max
1 1 - 1
_( d J J




где т - время движения тигля с замедленной скоростью V тм / M после замыкания датчика (при убывании расплава на величину L p); t дм( d ) - время движения тигля с ускоренной скоростью V тм после выдержки двух пауз τ до замыкания датчика.
Число циклов K ц по замыканию и размыканию датчика за период оценки сигала управления T ц можно представить в виде выражения (23):
K.. = T , ц ( t дм ( d ) + т • 2 )
T
к = г^, ( t д + t )
где t - время движения тигля с замедленной скоростью V тм / M после замыкания датчика за период оценки сигала управления; t д - время движения тигля с ускоренной скоростью V тм после размыкания датчика за период оценки сигала управления; K ц - число циклов замыкания и размыкания датчика за время T ц.
Точность контактного метода измерения текущей площади выращиваемого кристалла. В рассматриваемой системе управления установкой вытя-
где K ц - число циклов замыкания и размыкания датчика за время T ц.
Число замыканий контактного датчика K ц за период оценки T ц должно находиться в пределах 5–10, при этом необходимо обеспечить условие постоянного вращения графитового экрана в течение всего технологического процесса за счет наличия легкой выпадающей графитовой иголки на конце датчика (см. рис. 3), имеющей фиксированное нижнее положение. Временная диаграмма работы привода подъема тигля с учетом выдержки двух пауз после замыкания датчика уровня представлена на рис. 6.
По выражению (12) можно оценить величину вычисляемого сигнала управления y , представленную графически на рис. 7.
Погрешность r в вычислении сигнала управления в зависимости от точности стабилизации уровня расплава в тигле можно представить в виде выражения, которое графически представлено на рис. 8:
x ■ Р ж
r =-----
x з ■ Р т
D
d 1
где r - погрешность в вычислении сигнала управления за цикл измерения; x - точность стабилизации уровня расплава в тигле.
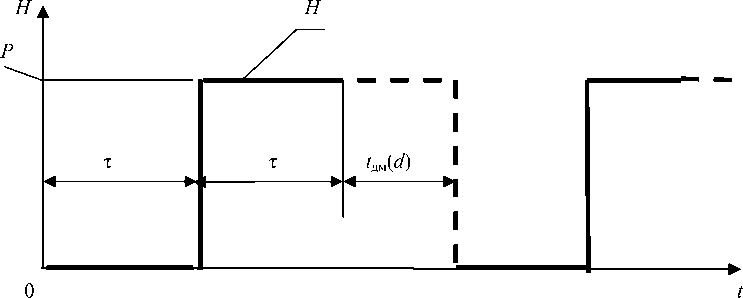
Рис. 5. Временная диаграмма работы датчика уровня:
H - работа контактного датчика уровня ( Р - датчик разомкнут)
Fig. 5. Timing diagram of the level sensor:
H - operation of the contact level sensor ( P - sensor open)

Рис. 6. Диаграмма изменения скорости подъема тигля V т:
x т = 0,0266 мкм; x з = 0,0216 мкм; d 1 = 100 мм; D = 300 мм; d = 105 мм; V з = 0,0083 мм/с; C = 4; M = 4;
L p = 2 мкм; X !ц = 1000 мкм; р т = 5,35 г/см 2 ; р ж = 5,57 г/см 2
Fig. 6. Diagram of the change in the crucible lift rate V т:
x т = 0,0266 µm; x з = 0,0216 µm; d 1 = 100 mm; D = 300 mm; d = 105 mm; V з = 0,0083 mm/s; C = 4; M = 4;
L р = 2 pm; X щ = 1000 pm; Р т = 5,35 g/cm 2 ; р ж= 5,57 g/cm 2
r
y

Рис. 7. Зависимость сигнала управления y от отклонения текущего диаметра d от заданного d 1 при d 1 = 100 мм, x з = 0,02127 мкм, X зц = 1000 мкм, A = 1
Fig. 7. Dependence of control signal y on deviation of the current diameter d from the given d 1 with: d 1 = 100 mm; x з = 0,02127 µm; X зц = 1000 µm; A = 1

Рис. 8. Погрешность сигнала управления r в зависимости от точности стабилизации уровня расплава в тигле x при x з = 0,0216 мкм, d 1 = 100 мм, D = 300 мм, A = 1, ρ т = 5,35 г/см 2 , ρ ж = 5,57 г/см 2
Fig. 8. The error of the control signal r, depending on the accuracy of stabilization of the melt level in the crucible x with: x з = 0,0216 µm; d 1 = 100 mm; D = 300 mm; A = 1; ρ т = 5,35 g/cm 2 ; ρ ж = 5,57 g/cm 2
f

Рис. 9. Временная зависимость ошибки регулирования f при x т = 0,0266 мкм, x з = 0,0216 мкм, A т = 0,2 мкм, A з = 0,2 мкм, d 1 = 100 мм, D = 300 мм, Н т = 2 мм, Н з = 4 мм, φт = π/2 рад, φз = π/8 рад, V з = 0,0166 мм/с
-
Fig. 9. Time dependence of the control error f :
for x т = 0,0266 µm; x з = 0,0216 µm; A т = 0,2 µm; A з = 0,2 µm; d 1 = 100 mm; D = 300 mm; Н т = 2 mm; Н з = 4 mm; φ т = π/2 rad; φ з = π/8 rad; V з = 0,0166 mm/s
При коэффициенте А = 1, исходя из выражений (10)–(14), сигнал управления y , величину перемещения затравки X зц и тигля X тц за время оценки T ц можно представить в виде выражений
ления f , которая на основе выражений (26), (27) при-
мет вид
y =
X ■ рж ■ цρ т
D
d 1
x з
^^^^^^в
X зц
,
f = Р ж
ρ т
D d 1
^^^^^^B
A з x з
■ sin
x з
(VJ I2
D v- J
■ V:1+
H т
■ ( V= ■ t
■ sin 3 +
I H з

Ф т
^^^^^^в
X зц = V . ■ Т ц + A з ■ sin |
2 (Г )
X тц = V . ■ Т ц ■ + A т ■ sin ■ + Ф т , (27)
D DH
т где Aт - амплитуда помехи по перемещению тигля, мкм; Aз - амплитуда помехи по перемещению затравки, мкм; Vз - скорость выращивания кристалла, мм/с; Нт - шаг винтовой пары по перемещению тигля, мм; Нз - шаг винтовой пары по перемещению затравки, мм; φт - угол смещения помехи по тиглю, рад; φз - угол смещения помехи по затравке, рад; t - время процесса вытягивания, с.
Синусоидальные члены в выражениях (26), (27) учитывают ошибки, возникающие в трапецеидальных винтовых парах с периодичностью шага винта, для систем управления перемещением штока затравки и тигля без обратной связи, что в свою очередь создает в системах по перемещению помеху в сигнале управ-
Временная зависимость ошибки f приведена на рис. 9, она хорошо согласуется с графиком ошибки измерения, полученным при работе промышленной установки на рис. 10. Ошибка f соответствует неточности изготовления винтовой передачи в пределах шага винтовых пар трапецеидальной формы и обусловлена неточностью стабилизации уровня расплава. На рис. 10 видно, что ошибка f имеет сложный периодический вид.
Так как в реальном процессе выращивания фаза сигналов ошибки φт и φз носит случайный характер, то учесть и компенсировать данную ошибку на основе проверки и тестирования установки вытягивания программными средствами оказалось невозможным.
Уменьшение погрешности f возможно за счет применения прецизионных шариковых винтовых передач или установки в качестве отсчета перемещений на установке выращивания кристаллов по координатам перемещения затравки и тигля фотосчитывающих оптических линеек с дискретностью отсчета 0,1 мкм, что является наиболее приемлемым вариантом.

Рис. 10. График изменения сигнала управления y (d_Diametra)
-
Fig. 10. Control signal change graph y (d_Diametra)
Для устранения ошибки из-за точности стабилизации уровня расплава в тигле r предлагается следующий программный алгоритм работы:
-
1. За время оценки T ц сигнала управления y на цилиндрической части выращиваемого кристалла берется время выборки заданного количества импульсов перемещения тигля X тц .
-
2. Начинается вычисление времени оценки T ц сигнала управления y в момент замыкания датчика расплава.
-
3. Заканчивается вычисление времени оценки T ц сигнала управления y в момент замыкания датчика расплава при условии выборки заданного количества импульсов перемещения тигля X тц.
-
4. Время оценки T ц сигнала управления y в предыдущем цикле управления используется в текущем цикле для вычисления паузы замыкания по выражению (21).
Все это позволяет свести погрешность r в сигнале управления y до величины порядка 100-150 ед.
Заключение. Для кристаллов, выращиваемых из жидкого расплава по способу Чохральского при контроле текущей площади кристалла на основе контактного метода измерения определены основные требования для обеспечения точности измерения текущей площади кристалла на цилиндрической части выращиваемого кристалла. В системе управления по координатам перемещения кристалла и тигля необходимо применять фотосчитывающие оптические линейки с дискретностью отсчета 0,1 мкм для отсчета величины перемещений за время цикла оценки.
Для устранения ошибки из-за точности стабилизации уровня расплава в тигле предлагается новый программный алгоритм работы установки выращивания кристаллов. За время оценки Tц сигнала управления y на цилиндрической части выращиваемого кристалла принимается время выборки заданного количества импульсов перемещения тигля Xтц. Начинается вычисление времени оценки Tц сигнала управления y в момент замыкания датчика расплава, заканчивается вычисление времени оценки Tц сигнала управления y в момент замыкания датчика расплава при условии выборки заданного количества импульсов перемещения тигля Xтц. Время оценки Tц сигнала управления y в предыдущем цикле управления используется в текущем цикле для вычисления паузы замыкания как части времени оценки Tц. В системе управления в момент замыкания контактного датчика выдерживается пауза замкнутого и последующая такая же пауза разомкнутого состояния датчика уровня. В моменты пауз состояние контактного датчика системой управления не анализируется, и управление подъемом тигля происходит с замедленной и ускоренной скоростью подъема тигля в моменты «условно замкнутого» и «условно разомкнутого» состояний датчика уровня. Все это обеспечивает в данной системе управления точность измерения текущей площади кристалла на цилиндрической части величиной не хуже 1 %.
Список литературы Повышение точности контактного метода измерения текущей площади кристаллов, выращиваемых способом Чохральского
- Schmidt F., Voszka R. Phantom controlled automatic Czochralski growth appparatuss // Crystal Research and Technology. 1981. Vol. 10, № 11. P. 127-128.
- Пат. 2337169 Федеративная Республика Германия, МКИ В0 1 J 17/18. 1974.
- Пат. 2128250 Российская Федерация, МПК С 30 В 15⁄20, 15/22, 15/26. Способ управления процессом выращивания монокристаллов германия из расплава и устройство для его осуществления / Саханский С. П., Подкопаев О. И., Петрик В. Ф. Заявл. 16.01.97, опубл. 27.03.99, Бюл. № 9.
- Пат. 2184803 Российская Федерация, МПК С 30 В 15⁄20, 15/22, 15/12 29/08. Способ управления процессом выращивания монокристаллов германия из расплава и устройство для его осуществления / Саханский С. П., Подкопаев О. И., Петрик В. Ф., Лаптенок В. Д. Заявл. 12.11.99, опубл. 10.07.02, Бюл. № 19.
- Саханский С. П. Управление формой полупроводниковых кристаллов при выращивании по способу Чохральского // Журнал Сибирского федерального университета. Техника и технологии. 2014. № 7(1). С. 20-31.


