Разработка методов микро- и нанолитографии по оксидным пленкам переходных металлов
Автор: Величко Андрей Александрович, Дутиков Дмитрий Андреевич, Кулдин Николай Александрович, Кундозерова Татьяна Валерьевна, Параничев Даниил Константинович, Пергамент Александр Лионович, Путролайнен Вадим Вячеславович
Журнал: Ученые записки Петрозаводского государственного университета @uchzap-petrsu
Рубрика: Физика
Статья в выпуске: 11 (105), 2009 года.
Бесплатный доступ
Оксиды переходных металлов, нанолитография, резист, модификации пленок оксидов
Короткий адрес: https://sciup.org/14751332
IDR: 14751332
Текст статьи Разработка методов микро- и нанолитографии по оксидным пленкам переходных металлов
Основным технологическим процессом в микроэлектронике в течение более чем 40 лет продолжает оставаться литография. Литографические процессы классифицируются по способу энергетического воздействия (экспонирования) на чувствительный слой (резист), наносимый на полупроводниковую подложку: оптическая, электронно-лучевая (ЭЛ), рентгеновская и ионная литографии. Литографический процесс дол- жен обеспечить создание определенного топологического рельефа на полупроводниковой пластине. Базовый литографический процесс представлен на рис. 1 и включает в себя по крайней мере 10 ступеней.
Анализируя ключевые аспекты литографического процесса с разрешением < 100 нм, нужно выделить две основные проблемы: источник экспонирования и адекватный резист. Любые из раз-
рабатываемых систем экспонирования, в частности оптические ДУФ (длинноволновый ультрафиолет), ЭУФ (экстремальный вакуумный ультрафиолет) и ЭЛ (электронно-лучевые), в принципе обеспечивают необходимое разрешение, тогда как проблема резиста остается открытой. До настоящего момента в литографическом процессе использовались и используются органические резисты на основе полимерных соединений. Классический органический резист состоит из трех компонентов: полимера (резины), фотоактивного соединения и растворителя. Рассмотрим процессы, протекающие в органических резистах при облучении, на примере классического органического ультрафиолетового фоторезиста DNQ / Novolac (диазонафтоквинон / новолачная смола). В представленной композиции Novolac – это резина (смола), а DNQ – фотоактивное соединение. При облучении резиста DNQ превращается в нестабильное промежуточное соединение – кетон, которое сразу вступает во взаимодействие с молекулами воды в матрице резиста и образует инденкарбоновую кислоту (ICA). ICA хорошо растворяется в щелочных растворителях.
Новолачная смола также растворима в щелочах, но добавление DNQ значительно снижает растворимость смолы и таким образом обеспечивает необходимую химическую стойкость резины к щелочному проявителю. В результате существенное отличие растворимости облученной и исходной областей резиста позволяет при проявлении в щелочах получать необходимый топологический рельеф на поверхности подложки.
В табл. 1 представлены наилучшие, по данным международного симпозиума 2006 года, достигнутые метрические характеристики в ЭУФ-литографии с применением сложных органических резистов [52].
Однако для органических резистов характерен ряд существенных недостатков. Во-первых, спектральная ограниченность органических резистов, то есть то, что один тип резиста может работать только в определенной области длин волн модифицирующего источника. Развитие источников экспонирования и смещение рабочих длин волн в коротковолновую область спектра ведут к необходимости разрабатывать новые серии органических резистов, а это всегда дорогостоящий и трудоемкий процесс. Второй недостаток заключается в низкой стойкости существующих органических резистов к плазменным процессам. Резистивные материалы, представляющие собой органические полимерные композиции (например, ПММА – полиметилметакрилат), легко разрушаются в ходе плазменного травления. Кроме того, плазменная обработка сопровождается нагревом обрабатываемой поверхности, что приводит к дополнительной деградации резистивного слоя. При создании структур с высоким отношением высоты линии к ширине толщина резиста не может превышать ширины линии. Это приводит к необходимости использования сложных много- слойных резистов, в которых обычные полимерные композиции обеспечивают высокую экспозиционную чувствительность, тогда как другие слои добавляют необходимую плазмо- и термостойкость. В-третьих, органические резисты являются источником дополнительных загрязнений поверхности подложки; отсюда возникает необходимость проведения ее тщательной очистки от продуктов загрязнения перед каждым новым технологическим этапом. Наконец, применение органических резистов исключает возможность проведения полностью «сухого» литографического процесса.
Альтернативный подход к решению трудностей, связанных с применением органических резистов, заключается в разработке и применении в микроэлектронной промышленности неорганических соединений, обладающих эффектом резиста.
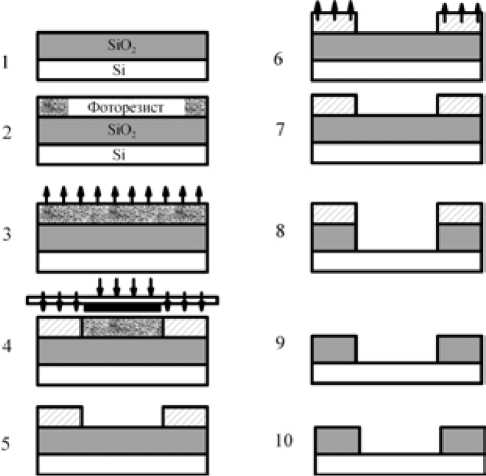
Рис. 1. Базовый литографический процесс:
1) подготовка поверхности (промывка и сушка); 2) нанесение резиста; 3) сушка, удаление растворителя и перевод резиста в твердую растворимую фазу; 4) совмещение фотошаблона и экспонирование (положительный резист под действием света переходит в нерастворимую фазу); 5) проявление резиста (промывка в растворителе, удаляющем неэкспонированный резист); 6) стабилизирующий отжиг, удаление остатков растворителя; 7) контроль и исправление дефектов; 8) травление (непосредственный перенос рисунка маски на поверхность полупроводниковой структуры); 9) удаление фоторезиста; 10) финишный контроль.
Таблица 1
Метрические характеристики в ЭУФ-литографии с применением сложных органических резистов [52]
Состояние на 2006 год
Разрешение, нм
Размытие края изображения, нм
Чувствительность, мДж/см2
|
28 |
29 |
45 |
|
6,3 |
4,9 |
> 10 |
|
12 |
27 |
6 |
Таблица 2
Сравнение неорганических и органических резистов
|
Неорганические резисты |
Органические резисты |
|
|
Процедура нанесения |
Сухой, (вакуумные методы нанесения) |
Жидкий (центрифугирование) |
|
Отжиг |
Не требуется |
Необходим на этапах стабилизации и сушки |
|
Огнеопасность / |
Отсутствует |
Огнеопасен, приме- |
|
токсичность |
няются растворители |
|
|
Толщина резиста |
Тонкий слой (< 0,15 мкм) |
Толстый слой (0,2–1,5 мкм) |
|
Сохраняемость ре-зистных свойств облученных / необ-лученных областей материала |
Месяцы |
Дни |
|
Источник загрязнения |
Зависит от типа резиста |
Растворители, атмосфера |
Главные преимущества, связанные с применением неорганических резистов по сравнению с органическими полимерными соединениями, представлены в табл. 2.
В соответствии с активационным механизмом неорганические резисты могут быть разделены на две группы: неорганические фото- (электроно) резисты (халькогенидные полупроводники) и неорганические термические резисты (металлоксидные соединения).
Термин «неорганические резисты» впервые использовал Синклэйр с соавторами [48] при изучении оксида железа Fe 2 O 3 . Облученный потоком электронов или лазером исходно аморфный материал кристаллизуется и в этом случае растворяется в растворе 5 % хлорной кислоты намного медленнее, чем необлученный, при этом он ведет себя как негативный резист. Однако его чувствительность гораздо ниже, чем у органических резистов (требуется ~100 Дж/см2).
Бозлер и другие в работах [14], [39] сообщают о другом металл-оксидном термическом резисте – AlO. AlO-терморезист наносился методом термического вакуумного испарения алюминия в кислородной среде . Таким образом, нанесенная пленка представляет собой смесь металлического Al и Al2O3 около 30 нм толщиной. При облучении ультрафиолетовым лазерным импульсом длительностью 20 нс и энергией 40–100 мДж/см2 изначально электропроводящий материал переходит в диэлектрическое «темное» состояние. Преобразованные области растворяются в водных растворах фосфорной кислоты значительно медленнее, чем исходная пленка. Таким образом, AlO-резист может быть проявлен в растворах кислот и затем использован в качестве защитного покрытия в процессах реактивного ионно-лучевого плазменного травления с применением CHF3-химии . Хотя AlO- терморезист является более чувствительным по сравнению с Fe2O3, доза в 100 мДж/см2 в несколько раз превышает дозы, используемые для традиционных органических резистов (10–50 мДж/см2).
В работе [49] авторы предложили двухслойный неорганический терморезист на основе легкоплавких металлов BiIn (толщина слоев – 15/15 нм). При облучении ультрафиолетовым лазерным импульсом длительностью 20 нс и энергией 10 мДж/см2 исходная двухслойная металлическая пленка преобразуется в BiIn-сплав . Экспонированная область проявляется в водном растворе азотной и уксусной кислот (HNO 3 :CH 3 COOH:H 2 O), и резист ведет себя как негативный.
Очень высокое разрешение (~1 нм) демонстрируют такие материалы, как MgF 2 , CaF 2 , AlF 3 , TiO 2 и MgO, при электронно-лучевом экспонировании, однако они требуют очень высоких экспозиционных доз (~107 мкКл/см2 при 100 кВ). Высокое разрешение этих неорганических тонких пленок объясняется малым размером молекул и тем, что пороговая энергия экспозиции выше энергии вторичных электронов.
Интерес к неорганическим резистам возрос после публикации ряда работ [9], показавших, что аморфные халькогенидные стекла при облучении ультрафиолетовым светом или электронным излучением ведут себя как резисты. Пленки GeSe x наносят на подложку вакуумным испарением или из раствора и покрывают тонким слоем серебра (около 0,1 мкм) погружением пленки в водный раствор AgNO 3 . Аморфные халькогенидные пленки легко растворяются в водных растворах как неорганических, так и органических оснований. Сразу же после облучения резиста УФ-светом или электронным излучением серебро диффундирует в матрицу халькогенида, которая при этом становится нерастворимой в основаниях. Следовательно, материалы ведут себя как негативные резисты. Чувствительность резистов относительно низка (80 мкКл/см2 при 10 кВ), однако контрастность исключительно высокая (γ = 8). Система при экспонировании электронным пучком дает линии шириной 300 нм.
Подобные результаты получил Тай с соавторами [51] для системы халькогенидного стекла GeSe 2 с Ag 2 Se в качестве радиационно-модифицируемого слоя. Чувствительность таких резистов лежит в интервале 10–100 мкКл/см2, γ > 6. Резисты совершенно не набухают, термически стабильны, обладают отличной стойкостью при плазменном травлении.
Изучены возможности применения в литографии As 2 S 3 , As 2 Se 3 , GeSe 2 совместно с различными содержащими серебро веществами: Ag, Ag 2 S, Ag 2 Se, Ag 2 Te и другими [31].
Недостаток халькогенидных резистов заключается в необходимости получать высокостехиометрич-ные пленочные структуры, что представляет определенную сложность. Кроме того, наличие атомов серебра в составе радиационно-модифицируемого слоя губительно влияет на характеристики будущего полупроводникового устройства.
Таблица 3
Преимущества и недостатки разрабатываемых и применяемых в микроэлектронике резистов
|
Тип материала |
Преимущества |
Недостатки |
|
Традиционные |
Хорошо отработанный |
Слишком толстые; взаимосвязь между чувствитель- |
|
органические резисты |
литографический процесс |
ностью и разрешением |
|
Традиционные |
Высокое разрешение; |
Низкая чувствительность; |
|
неорганические резисты |
плазмостойкие; тонкопленочные |
диэлектрики; точная стехиометрия |
|
Оксиды |
Высокая чувствительность; |
Нарушение обратимости (условия экспонирования |
|
переходных |
высокое разрешение; тонкопленочные; |
требуют дальнейшего изучения); |
|
металлов |
плазмо- и термостойкие; совместимы с полностью вакуумным процессом; совместимы с существующими технологиями |
через 10 дней после получения чувствительность ухудшается; до экспонирования пленки должны быть защищены от влаги и тепла (> 50 °С); двухслойный |
Сравнительные характеристики неорганических резистов
Таблица 4
|
Чувствительность, мкКл/см2 или мДж/см2 |
Разрешение, нм |
Контраст |
Применение |
|
|
Ag/GeSex |
80 |
300 |
8 |
ЭЛ-литография |
|
Ag/GeSe2 |
10–100 |
~300 |
> 6 |
ЭЛ-литография |
|
AlF 3 |
107 |
~1 |
– |
ЭЛ-литография |
|
VO 2 |
200–300 |
< 100 |
– |
ЭЛ-литография |
|
FeO x |
100 |
~1000 |
– |
Фотолитография |
|
AlO x |
40–100 |
– |
– |
ЭЛ-литография |
|
Bi/In |
10 |
~300 |
– |
ЭЛ-литография |
|
AsSe |
8 |
~200 |
– |
ЭЛ-литография |
|
WO 3 |
1000 |
< 100 |
– |
Электроно-, фото-, ионная литография |
|
MoO 3 |
1000 |
< 100 |
– |
Электроно-, фото-, ионная литография |
|
V 2 O 5 |
100 |
< 100 |
– |
Фотолитография |
Параметры изготовления образцов
Таблица 5
|
Номер образца |
Метод получения |
Подложка |
Давление |
Т подложки, °С |
Толщина пленки, нм |
|
1 |
V 2 O 5 , терм. |
стекло |
0,2 · 10-5 Торр |
20 |
300 |
|
2 |
V2O5, терм. |
Si/SiO 2 |
0,2 · 10-5 Торр |
20 |
200 |
|
3 |
V 2 O 5 , терм. |
Si/SiO 2 |
0,2 · 10-5 Торр |
20 |
250 |
|
4 |
V2O5, терм. |
Si/SiO 2 |
0,2 · 10-5 Торр |
20 |
200 |
|
5 |
V 2 O 5 , терм. |
Si |
5 · 10-5 Торр |
20 |
250 |
|
Имп. |
Si, |
||||
|
6 |
металлизированный |
70 мТорр |
20 |
120 |
|
|
лазерное испарение |
платиной (60 нм) |
||||
|
7 |
Имп. |
стекло |
70 мТорр |
20 |
100 |
|
лазерное испарение |
В наших работах [50] было показано, что перспективными для разработки неорганических резистов являются метастабильные аморфные пленки диоксида ванадия, получаемые методом анодного окисления и имеющие высокую чувствительность к фотонному и электронному облучению.
В ряде работ показана возможность использования в качестве электронного резиста аморфных пленок оксидов переходных металлов WO3 [12] и MoO3 [38], а также аморфных оксидов WO3, MoO3 и V2O5 для ионно-лучевой литогра- фии [30]. Следует упомянуть в том числе и работу по фотолитографии по аморфному V2O5 [42].
В табл. 3 приведены основные преимущества и недостатки резитов, а в табл. 4 – сравнительные характеристики неорганических резистов.
В настоящее время не существует неорганических резистов, способных полностью удовлетворить требованиям современной микро- и нанолитографии. Обладая необходимой стойкостью к плазмо- и термообработке и высокой разрешающей способностью, неорганические со- единения существенно проигрывают в чувствительности к экспонирующему излучению традиционным органическим резистам, что препятствует широкому использованию неорганических резистов в микро- и нанолитографии. Таким образом, поиск новых материалов, способных сочетать в себе преимущества органических и неорганических резистов и при этом обладать совместимостью с существующими микро- и нанотехнологиями, является актуальной задачей.
МЕТОДИКА ЭКСПЕРИМЕНТА
В качестве методов синтеза применялись следующие методы: термического испарения в вакууме, импульсного лазерного испарения и магнетронного реактивного распыления металла в вакууме.
Параметры изготовления образцов
В ходе экспериментальных исследований было изготовлено 9 типов образцов (табл. 5).
РЕЗУЛЬТАТЫ
Исследование фотоиндуцированной модификации физико-химических свойств пентаоксида ванадия, полученного методом термического испарением в вакууме
В ходе экспериментальных исследований применялись образцы 1–5 (табл. 5).
Анализ работ [1]–[56] по модификации V 2 O 5 показал, что проблеме производства функциональных V 2 O 5 - и VO 2 -микроструктур уделяется небольшое внимание. В данном разделе представлены результаты селективного химического травления пленок пентаоксида ванадия после модификации УФ-облучением при нормальных условиях с последующим восстановлением до фазы VO 2 .
УФ-модификация (длина волны – 402 нм) производилась при нормальных условиях через маску стандартного степпера Karl Suss mA6/BA6. Вольт-амперные характеристики и температурные зависимости проводимости измерялись с использованием источника-измерителя KEITHLEY Model 2410. Оптический спектр пропускания измерялся при помощи спектрометра Nicolet 5700.
Рентгеноструктурный анализ (образец 2) показал, что пленка аморфна: рентгеновский спектр не имеет отдельных дифракционных пиков [43].
Было установлено, что пленки, полученные термическим осаждением, имеют более высокую чувствительность к УФ-облучению, чем те, которые получены методом лазерной абляции. Это может быть связано с тем фактом, что в случае лазерной абляции осаждаемые молекулы обладают более высокой энергией, что уменьшает количество дефектов и, следовательно, уменьшает степень метастабильности пленки. Поэтому основные результаты, представленные ниже, были получены на пленках, приготовленных термическим осаждением.
Спектры пропускания пленок до и после УФ-модификации представлены на рис. 2. Наблюдаемое смещение спектра в коротковолновую область может быть связано с процессами, которые имеют место в случае фотохромного эффекта.
Проявление модифицированных пленок проводилось в водном растворе метанола (10:1), при этом процесс проявления происходит как в случае негативного резиста (образцы 2–4). Также проявление проводилось в растворе муравьиная кислота – ацетон – формалин (15:10:1), процесс происходит как для позитивного резиста (образец 2). Время проявления составляло 5–10 мин с последующим промыванием в ацетоне и сушкой.
На рис. 3 представлена фотография поверхности, сделанная при помощи сканирующего электронного микроскопа. Линия V2O5 шириной 8 мкм селективно вытравлена в водном растворе метанола после экспонирования дозой ~10 Дж/см2.
Размытие края линии (~500 нм) происходит из-за засветки этой области УФ-облучением. Разрешение V2O5-резиста определяется гранулированной (зерновой) структурой пленки. В наших экспериментах размеры зерен после травления

Рис. 2. Спектры пропускания исходной (1) и модифицированной (2) аморфной V2O5-пленки с дозой ~20 Дж/cм2. Применялся образец 1.
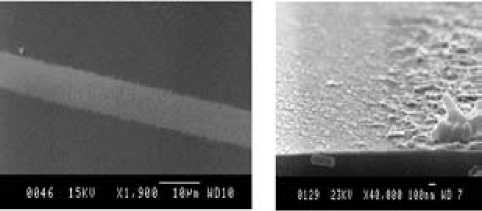
а) б)
Рис. 3. Изображение 8 мкм линии пентаоксида ванадия после проявления в водном растворе метанола
а) вид сверху, б) край. Применялся образец 2.

Рис. 4. Снимок с атомно-силового микроскопа V2O5-пленки на Si/SiO 2 -подложке (a), профиль поверхности (б). Образец 2
составляли около 30–50 нм, и, как показано в работе [26], зерновая структура (морфология) аморфной пленки зависит от типа подложки и ее температуры. Зерновая структура проявляется уже после напыления пленки, хотя пленка является аморфной. Как видно на рис. 4, высота неоднородностей составляет порядка 3 нм, а продольный размер – порядка 30–40 нм.
После проявления (образцы 2, 3, 4) полученные структуры были восстановлены до стехиометрии VO2. Процесс восстановления производился методом отжига в° кислородной атмосфере (10 мТорр) при T = 450 °C в течение 30 мин.
Различное поведение пленок, осажденных из различных испарителей, представлено на рис. 5.
В случае Al2O3-испарителя стехиометрия может быть восстановлена до VO 2 с фазовым переходом металл – изолятор (ФПМИ) и скачком проводимости на 2–3 порядка (кривая 1, образец 2). Подавление ФПМИ (кривые 2 и 3, образцы 3 и 4 соответственно) связано с легированием (загрязнением) диоксида ванадия атомами Mo и Ta.
Таким образом, было показано, что после процесса УФ-модификации и жидкофазного химического травления получена V 2 O 5 -структура, которая может быть восстановлена до стехиометрии VO 2 , обладающего ФПМИ.
После восстановления 8 мкм V2O5-линий в фазу VO 2 сверху были напылены золотые контакты на расстоянии ~80 мкм друг от друга. На рис. 6 представлены вольт-амперные характеристики д° анных структур (образец 2) при температуре T = 55 °C.
Эффект переключения связан с джоулевым разогревом образцов выше температуры фазового перехода. Характер переключения ВАХ зависит от ограничительного тока, проходящего через структуру I c . Наибольшая величина I c соответствовала максимальной проводимости во включенном состоянии. Это связано с тем, что при наибольшем токе формируется более широкий канал металлической фазы.
Отметим, что для модификации свойств аморфного V2O5 могут быть использованы источ- ники с более короткой длиной волны ( < 402 нм), и, следовательно, доза облучения, необходимая для инициирования фотохимических превращений в пленке, будет меньше.
Механизм модификации физико-химических свойств оксида ванадия может быть объяснен в терминах модели двойной инжекции (внедрение ионов водорода):
V 2 O 5 + xH+ xe- = H x V 2 O 5 .
Источником ионов водорода в данном случае выступают адсорбированные на поверхности пленки молекулы воды [43].
Исследование лазерной и электронно-лучевой модификации физикохимических свойств пентаоксида ванадия, полученного методом лазерной абляции
В ходе экспериментальных исследований, представленных в данном разделе, применялись образцы 6 и 7.
Для лазерной модификации аморфных пленок использовался KrF – эксимерный лазер (COMPEX -102), имеющий следующие характеристики: λ = 248 нм, длительность импульса – 20 нс, площадь пятна - 8 X 24 мм. Экспонирование аморфной пленки пентаоксида ванадия производилось одиночным импульсом с энергией 100–200 мДж. Результатом воздействия лазерного излучения было изменение различных свойств пленки V 2 O 5 .
Сразу после экспозиции поверхность пленки темнела (образец 6), цвет изменялся с желтого на темно-коричневый, причем наименьшее изменение контраста соответствует импульсу с наименьшей энергией (100 мДж), а наибольшее изменение – импульсу с максимальной энергией (200 мДж).
Результат измерения спектра поглощения пленки (образец 7) до и после облучения импульсом с энергией 150 мДж показан на рис. 7а. В ультрафиолетовой и видимой области с длиной волны меньше, чем 600 нм, поглощение выше для модифицированной пленки, в то время как для области длинных волн ( > 700 нм) она становится более прозрачной.
Оптическая ширина запрещенной зоны может быть определена из соотношения Тауца:
α • hν = B • (hν – Eg)n [44]. Здесь основной параметр n определяет тип электронных переходов и принимает следующие значения: 1/2 – прямой разрешенный, 3/2 – прямой запрещенный, 2 – непрямой разрешенный, 3 – непрямой запрещенный. В нашем случае экспериментальные данные описывались при n = 1/2 [22].
Как показано на рис. 7б, величина собственного края поглощения материала остается постоянной в процессе модификации и составляет ~2,6 эВ (образец 7). Таким образом, можно заключить, что в ходе лазерной обработки в материале нет изменений стехиометрии, но происходит увеличение оптической плотности вблизи
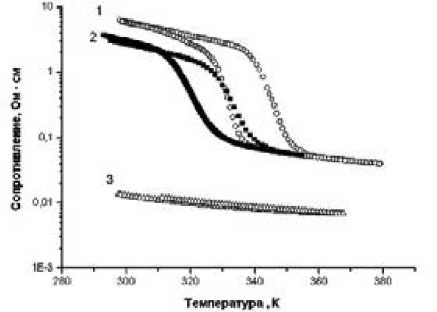
Рис. 5. Температурные зависимости сопротивления 8 мкм линии пентаоксида ванадия, полученные с использованием напыления из Al2O3- (1), Ta- (2), Mo-лодочек (3).
Применялись образцы 2, 3, 4 соответственно.

Ндеря>*имг В
Рис. 6. Вольт-амперные характеристики VO2-планарной структуры с различными значениями ограничительного тока Ic. Температура – 55 °C. Применялся образец 2.
области фундаментального поглощения. Стехиометрия исследуемого оксида близка к V2O5, величина оптического края собственного поглощения которого лежит в области энергий 2,2–2,5 эВ [8], [5].
Исследования поверхности пленки методами электронной и атомно-силовой спектроскопии показали, что после модификации (один импульс с энергией 150 мДж) морфология поверхности пленки изменяется.
На рис. 8 представлено изображение поверхности оксида, полученное с помощью сканирующего электронного микроскопа Zeiss DSM-942 (образец 6). Среднеквадратичная шероховатость поверхности Rq составляет ~30 нм, что более чем в 8 раз превосходит значение параметра для не-модифицированного оксида (~3,5 нм).
По-видимому, модификация свойств V 2 O 5 определяется тепловым действием лазерного импульса.
В работе [15] анализ структуры тонких пленок оксида ванадия, полученных методом лазерной абляции, показал, что до и после ультрафиолетовой лазерной обработки исследуемые V2O5-пленки аморфны, восстановление оксида не происходит. Облучение исходной пленки пентаоксида ванадия ведет к уменьшению размеров областей упорядоченного расположения атомов с 2,4 до 1,2 нм. Минимальной структурной единицей аморфных оксидных пленок является сильно искаженный кислородный октаэдр. Характер искажения тетрагональных пирамид в исходной и модифицированной пленке различен и отличается от такового для кристаллической фазы. Кроме того, наблюдается дефицит по кислороду в первом координационном многограннике (тетрагональной пирамиде), то есть небольшая часть пирамид в исследуемых пленках пентаоксида ванадия не достроена (отсутствует одна из вершин).
Химическое, физическое плазменное и ионно-лучевое травление оксидов ванадия
В ходе экспериментальных исследований, представленных в данном разделе, применялся образец 6.
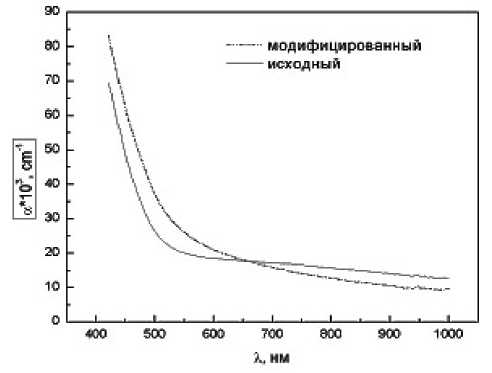
а)

hv. эВ
б)
Рис. 7. Спектр поглощения (а) и оптический край собственного поглощения (б) аморфной пленки пентаоксида ванадия до и после лазерной модификации. Применялся образец 7

Рис. 8. Морфология поверхности пленки оксида после воздействия лазерным импульсом с энергией 150 мДж. Применялся образец 6

Рис. 9. Зависимость скоростей ИЛТ-модифицированного (2) и немодифицированного (1) оксидов ванадия от энергии бомбардирующих ионов Ar.
Средняя величина селективности ИЛТ – 2,8 ± 0,2.
Таблица 6
Скорости ИЛТ различных материалов в аргоне, пересчитанные к плотности мощности ионного тока w = 0,5 Вт/cм2
|
Материал |
v тр , нм/мин |
Селективность материала относительно экспонированного V2O5 |
|
|
Облученный V2O5 |
6–7 |
Результаты |
|
|
Исходный V2O5 |
17–20 |
2,6–3 |
настоящей работы |
|
GaAs |
132–150 |
20–23 |
|
|
Ag |
102–150 |
15–23 |
|
|
LiNbO 3 |
30 |
4,6 |
|
|
Si |
18–30 |
2,8–4,6 |
Согласно |
|
Ti |
18 |
2,8 |
|
|
SiO 2 * |
24–36 |
3,7–5,5 |
данным из [5] |
|
Пермаллой |
18–30 |
2,8–4,6 |
|
|
Al 2 O 3 |
4,8–6 |
отсутствует |
|
|
V |
9–18 |
1,4–2,8 |
|
|
ПММА |
42–48 |
6,5–7,4 |
* Термически осажденный диоксид кремния.
После фотонного воздействия (доза облучения ~150 мДж/см2) наблюдался эффект селективного ионно-лучевого травления (ИЛТ) аргоном. Эксперименты по ИЛТ аргоном были выполнены с помощью стандартного ионного источника типа Кауфмана (Veeco Microetch) с давлением газа в разрядной камере 10-4 Торр. Давление остаточных газов в рабочей камере составляло 2 · 10-6 Торр. Для эффективного охлаждения образцы с помощью теплопроводящей пасты соединялись с водоохлаждаемым медным держателем, который вращался с постоянной скоростью в течение всего процесса, обеспечивая однородность травления. Глубина травления измерялась с помощью профилометра (Tencor P10).
На рис. 9 представлена скорость травления для модифицированного (доза ~150 мДж/см2) и исходного оксидов как функция энергии ионного луча (300–700 эВ). Как видно, с ростом энергии ионов Ar скорость травления оксида возрастает, причем экспонированные области оксида травятся медленнее. Среднее значение селективности ИЛТ составляет 2,8 ± 0,2. В табл. 7 приведены значения скоростей ИЛТ различных материалов в аргоне [5], пересчитанные к плотности мощности ионного тока w = 0,5 Вт/см2 при вертикальном падении ионов и давлении остаточных паров воды и кислорода в камере менее 10-4 Торр.
Из табл. 6 видно, что скорость травления для экспонированного оксида в 3–4 раза меньше скорости травления большинства материалов, применяемых в микроэлектронной промышленности. Особенно высокая селективность проявляется по отношению к A 3 B 3 -полупроводникам типа GaAs, InAs, InSb, имеющим много потенциальных приложений в оптоэлектронных устройствах [18].
Рассмотрим более подробно процессы тепловыделения и теплоотвода при воздействии лазерного импульса с энергией 150 мДж на оксидную пленку.
Фотонная энергия лазерного излучения (5 эВ) больше, чем энергия запрещенной зоны ( E g ~ 2,65 эВ) исследуемого оксида, следовательно, основным механизмом поглощения можно считать процесс генерации электронно-дырочных пар. Поскольку плотность потока мощности излучения (3,9 · 106 Вт/см2) значительно превышает 104 Вт/см2, потери энергии на отражение и теплоотвод в подложку в процессе модификации можно не учитывать. Вся энергия лазерного излучения в основном расходуется на нагрев материала. Глубина проникновения тепловой энергии определяется выражением (α · τ)1/2 и составляет ~350 нм, где α – температурный коэффициент диффузии ~6 · 10-6 м2/с, τ – длительность импульса ~20 нс. Изменение температуры поверхности можно рассчитать, используя формулу:
(α⋅τ)12⋅ρ⋅Cν⋅ΔT≡I0⋅τ,
где ρ – плотность ~3,36 г/см3, Cv – теплоемкость ~0,70 Дж/г · K, I0 – интенсивность лазерного из- лучения ~3,9 · 106 Вт/cм2. Из выражения следует, что ΔT~960 К.
Как видно, при воздействии лазерного импульса температура поверхности достигает ~1250 K, что превышает температуру плавления аморфного оксида (~923 K). Однако рентгеноструктурные исследования обработанной пленки показали отсутствие начала процессов кристаллизации, то есть исследуемый материал до и после лазерного воздействия остается аморфным.
Теоретические исследования процессов теплопередачи и теплоотвода, представленные выше, показывают, что при импульсах с энергией более 50 мДж/см2 температура поверхности оксида превышает температуру плавления. В таких условиях существенное изменение морфологии поверхности пленки можно объяснить с точки зрения процесса вытеснения расплава вследствие влияния мелкомасштабных неоднородностей давления паров испарившегося материала на поверхность [2].
Таким образом, максимально допустимая плотность энергии для используемого в работе модифицирующего излучения с применением исследуемого рабочего материала (пентаоксида ванадия) составляет 50 мДж/см2. На рис. 10 показаны проявленные линии оксидно-ванадиевого резиста на кремниевой подложке.
Отметим, что чувствительность анодных оксидов ванадия к ультрафиолетовому излучению составляет ~1 мДж/см2 [50]. Оценим чувствительность для исследуемых нами V 2 O 5 -пленок.
Согласно определению, чувствительность резистов характеризует минимальную энергию (дозу), необходимую для инициирования модификации физико-химических свойств (например, растворимости) чувствительного слоя. Как известно, интенсивность излучения при прохождении через вещество убывает по экспоненциальному закону:
Ι=Ι0 ⋅ e-αd.
Здесь I0 – интенсивность света на входе в поглощающий слой, d – толщина слоя, α – коэффициент поглощения. Профиль интенсивности света в толще резиста показан на рис. 11. Пороговая толщина dпор, соответствующая пороговой интенсивности Iпор, отмечает границу между засвеченным и незасвеченным участками. Когда толщина резиста превышает dпор, после экспонирования в структуре остается незасвеченный слой. Если теперь структуру подвергнуть жидкофазному травлению, будет наблюдаться эффект подтравливания под засвеченную область резиста и отслаивание его от подложки. В наших экспериментах при жидкофазном травлении V2O5-резиста в растворе ацетон : вода (2:1) подобного эффекта не наблюдалось. Резист травился равномерно до подложки, причем растворимость засвеченных участков была в 5 раз меньше исходных. Следовательно, при выбранных условиях облучения резист засвечивается на всю толщину пленки. Зная I0, d и α, можно рассчитать интенсивность I на выходе из слоя. Если I0 = 2,5 · 106 Вт/см2, d = 120 нм, α = 1,1 · 107 м-1, то I составляет 6,4 · 105 Вт/см2. Следовательно, энергия в импульсе длительностью 20 нс, соответствующая интенсивности I, составляет 13 мДж/см2. Таким образом, можно заключить, что чувствительность исследуемого V2O5-резиста не хуже 13 мДж/см2.
На основе полученных выше результатов проведем качественное сравнение оксидно-ванадие-вого резиста с традиционными органическими резистами (на примере ПММА).
Селективность травления большинства материалов относительно ПММА составляет 1/4 (см. табл. 7).
Показан профиль интенсивности света I в толще резиста. Пороговая толщина dпор, соответствующая пороговой интенсивности Iпор, отмечает границу между засвеченным и незасве-ченным участками.
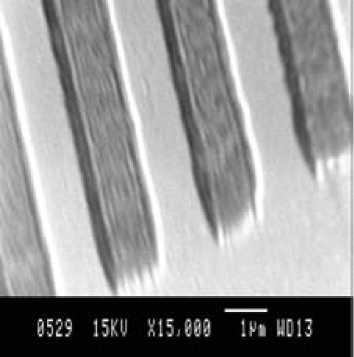
Рис. 10. Линии оксидно-ванадиевого (V2O5) резиста на кремниевой подложке.
Плотность модифицирующего излучения – 50 мДж/см2,
1 импульс.
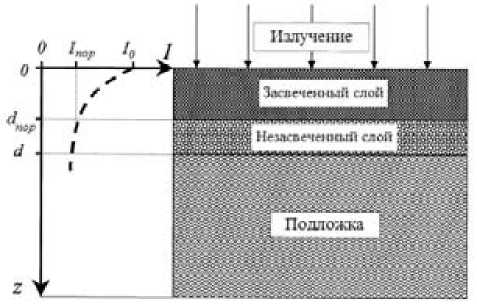
Рис. 11. Схематическое изображение исследуемой структуры: слой оксидно-ванадиевого резиста, нанесенный на подложку
Таблица 7
Сравнительные характеристики
V2O5-резиста, Al2O3-резиста и ПММА для ИЛТ
|
V 2 O 5 -резист |
Al 2 O 3 -резист |
ПММА [56] |
|
|
Чувствительность, мДж/см2 |
50 (13) (λ = 248 нм) |
40–100 (УФ) |
> 500 (λ = 248 нм) |
|
Скорость ИЛТ, нм/с |
6–7 |
4,8–6 |
42–48 |
|
Минимальная толщина, мкм |
< 0,05 |
0,03 |
> 0,15 |
Следовательно, с помощью ИЛТ через органическую резистивную маску (ОРМ) на основе ПММА толщиной 0,4–0,6 мкм нельзя вытравить материал на глубину более 0,1 мкм, а этого явно недостаточно в подавляющем большинстве случаев. Увеличение толщины ПММА приводит к возникновению нежелательного процесса перео-саждения распыленных атомов рабочего материала при ИЛТ и в целом снижает селективность травления относительно ОРМ. Кроме того, толстые пленки ПММА усложняют процесс формирования ОРМ с необходимым профилем, что связано с эффектами недоэкспонирования со стороны поверхности пленки и рассеянием излучения в прямом и обратном направлениях [10]. Поэтому при ИЛТ бесполезно использовать толстые ОРМ. В случае же малой толщины резиста увеличивается вероятность образования точечных проколов. Зависимость скорости травления материала от угла падения ионного пучка приводит к изменению профиля ОРМ, что вызывает уход размеров создаваемого рисунка. Из сказанного выше следует вывод, что с помощью ИЛТ непосредственно через ОРМ нельзя получить рисунки с субмикронными размерами в слоях рабочих материалов необходимой толщины.
Резисты на основе оксидов ванадия обладают хорошей плазмостойкостью по сравнению с другими материалами. Стехиометрия резиста определяется только технологическим процессом осаждения, а толщина может варьировать от десятков нанометров до микрометров. Чувствительность представленного резиста к УФ-облучению сравнима с аналогами среди традиционных органических резистов или лучше их (табл. 7).
МЕХАНИЗМ ЛАЗЕРНО-ИНДУЦИРОВАННОЙ МОДИФИКАЦИИ СВОЙСТВ ОКСИДОВ ВАНАДИЯ
На основе результатов, представленных в предыдущих разделах, рассмотрим возможный механизм трансформации свойств пленок аморфного пентаоксида ванадия под действием лазерного ультрафиолетового излучения высокой интенсивности.
Лазерная модификация инициирует рост плазмохимической стойкости материала в процессах ионно-лучевого и плазменного травле- ния. Процесс физического распыления материалов характеризуется коэффициентом распыления (КР), который определяется как число атомов, выбиваемых из материала мишени одним пада- ющим ионом.
Согласно теории физического распыления аморфных и поликристаллических материалов, разработанной Зигмундом [47], если энергия падающих под прямым углом к поверхности ионов Еи меньше некоторой величины E*, КР выражается формулой:
S 3 в Ш и Ш а Е и
П 2 (Ши + Ша ) 22 Есуб где в — безразмерный параметр, зависящий от mA/ти, Есуб — энергия сублимации материала мишени. В области энергий Еи > Е*
S , (E >
2 Е суб
S = 4 , 2 - 10 18
где величина V (Еи) представляет собой ядер-я ное тормозное сечение ионов.
Как видно из представленных выше выражений, КР обратно пропорционален энергии сублимации Е суб материала мишени. При сублимации происходит удаление атомов с поверхности, где действует только половина связей [6]. Следовательно, чтобы удалить атом из объема материала, необходима энергия 2E суб . При столкновении с ионом атом не только выбивается из занимаемого им положения, но и внедряется в решетку, смещая другие атомы. Для осуществления такого процесса необходима энергия не менее 4E суб .
Из сказанного следует, что энергия сублимации в теории физического распыления Зигмунда характеризует энергию связи атомов вещества мишени.
Таким образом, уменьшение скорости травления, а следовательно, и коэффициента распыления пентаоксида ванадия вследствие лазерной обработки можно объяснить увеличением энергии сублимации распыляемого материала.
С другой стороны, рентгеноструктурный анализ пленок выявил лазерно-индуцированную модификацию атомной структуры V 2 O 5 , то есть наблюдаются изменения топологической разупорядоченности (разупорядоченности ближнего порядка) и нарушения координации атомов металла и кислорода. Подобные трансформации структуры ближнего порядка допускают локальные флуктуации углов и, возможно, длин связи V–О–V, двугранных углов кислородных полиэдров и взаимных расположений последних в сетке оксида. Энергия связи V–О зависит от величины угла V–О–V в кислородном полиэдре. Следовательно, лазерное воздействие может инициировать такое структурное состояние вещества, в котором энергия связи атомов материала увеличится (увеличится энергия сублимации), что подтверждается в экспериментах по физическому травлению V 2 O 5 .
Отметим, что в спектральной области фундаментального поглощения модифицированного пентаоксида ванадия наблюдается рост коэффициента поглощения материала, что может быть объяснено увеличением 2p-3d-гибридизации и вероятности 2p-3d – электронных переходов вследствие уменьшения средних V–O межатомных расстояний в оксиде.
Таким образом, механизм лазерно-инициированного роста стабильности V 2 O 5 , полученного методом импульсного лазерного испарения, к ионно-лучевым воздействиям заключается в изменении топологической разупорядоченности и нарушении координации атомов металла и кислорода с образованием нового (по сравнению с исходным) структурного состояния вещества, в котором материал обладает большей энергией сублимации.
Электронно-лучевая модификация V 2 O 5 -пленок
В ходе экспериментальных исследований, представленных в данном разделе, применялся образец 6.
Для экспонирования использовался электронный сканирующий микроскоп Zeiss DSM-942 с техническими характеристиками, позволяющими варьировать ускоряющие напряжения от 1 до 50 кВ, электронные токи – от 10 до 5000 пА. Сразу после экспонирования на поверхности оксида наблюдался хорошо различимый в оптический микроскоп рисунок. Чувствительность пленок составила 55–60 мкКл/см2.
Электронно-микроскопическое исследование экспонированных образцов показало, что на их поверхности нет топологического рельефа (даже для больших экспозиционных доз, формирующих высококонтрастные рисунки), а наблюдаемый рисунок определяется изменением оптических свойств исходного материала под действием электронной бомбардировки.
Удовлетворительные результаты были получены при травлении оксида в растворе изопропанол : вода (3:1). На рис. 12 представлены проявленный прямоугольник 50 · 40 мкм2 и линии (2 мкм), доза ~150 мКл/см2. Оксид ведет себя как положительный резист.
Размер вытравленного участка ~50 × 40 мкм2, ширина линий ~4 мкм.
Наблюдаемый эффект селективного травления можно объяснить в рамках полупроводниковой теории окисления и восстановления оксидных фаз [40]. Согласно этой теории, растворение полупроводникового материала при контакте с электролитом сопровождается переносом электронов между ионами полупроводника и раствора, а скорость растворения зависит от концентрации электронов вблизи поверхности полупроводника. Таким образом, увеличение скорости травления экспонированных областей V2O5-пленки может быть вызвано увеличением концентрации электронов в этих областях.

Рис. 12. Изображение модифицированной электронами (доза 150 мКл/см2) поверхности V2O5-пленки после проявления в водном растворе изопропанола
Эксперименты по ИЛТ модифицированных пленок ионами аргона не выявили селективности процесса. Происходит равномерное стравливание оксида. По-видимому, внедрение электронов в пленку не приводит к значительной трансформации структуры и стехиометрии оксида, и, следовательно, энергия сублимации материала не изменяется.
Отметим, что при разработке сухих методов проявления пентаоксида ванадия как неорганического электронорезиста может эффективно использоваться плазмохимическое травление в реактивных газах, таких как, например, CH 4 или SF 6 [50].
ВЫВОДЫ
Из проведенных экспериментов и теоретического анализа вытекают следующие основные выводы и результаты работы.
-
1. Разработана методика нанесения тонких пленок метастабильного аморфного пентаоксида ванадия с применением метода термического испарения в вакууме и метода импульсного лазерного испарения. Физико-химические свойства синтезированных таким образом пленок оксида ванадия модифицируются стационарным и лазерным ультрафиолетовым излучением, электронной бомбардировкой.
-
2. Воздействие стационарным и лазерным ультрафиолетовым излучением, электронной бомбардировкой на аморфные пленки оксида ванадия инициирует изменение физико-химических свойств, заключающееся, в частности, в росте плазменной и химической стабильности оксида, что делает его перспективным материалом для применения в микроэлектронике в качестве неорганического резиста.
-
3. Разработан процесс селективного ионно-лучевого проявления V 2 O 5 -резиста. Среднее значение селективности ИЛТ составляет 2,8 ± 0,2. Материал ведет себя как негативный фоторезист.
-
4. Механизм модификации в результате стационарного ультрафиолетового облучения определяется процессами инжекции водорода и снижением валентности ванадия до V 4+ с образованием водородной ванадиевой бронзы H x V 2 O 5 .
-
5. Механизм лазерно-инициированного роста стабильности V 2 O 5 к ионно-лучевым воздействиям заключается в изменении топологической разупорядоченности и нарушении координации атомов металла и кислорода с образованием нового (по сравнению с исходным) структурного состояния вещества, в котором материал обладает большей энергией сублимации.
-
6. После модификации и травления полученные структуры могут быть восстановлены методом отжига в вакууме до стехиометрии кристаллического VO 2 , обладающего фазовым переходом металл – полупроводник и эффектом переключения.
-
7. Разработанный процесс фотолитографии по оксидам ванадия является перспективным для создания микро- и наноприборов на ос-
- нове двуокиси ванадия с ФПМП, совместимых с кремниевой электроникой, управляемых процессами в кремниевых структурах и входящих в состав кремниевых микрочипов.
БЛАГОДАРНОСТЬ
Выражаем благодарность И. М. Некрыловой за ценные замечания.
Работа выполнена при поддержке Федерального Агентства РФ по науке и инновациям ГК № 02.513.11.3351 и ГК № 02.740.11.0395, аналитической ведомственной целевой программы «Развитие научного потенциала высшей школы» (Министерство образования РФ, проекты № 4978 и 8051), Федерального агентства по образованию, федеральной целевой программы «Научные и научно-педагогические кадры инновационной России на 2009–2013 год» (контракты П1156, П1220), а также при поддержке Американского фонда гражданских исследований и развития (CRDF) № Y5-P-13-01.
Список литературы Разработка методов микро- и нанолитографии по оксидным пленкам переходных металлов
- Алешина Л. А., Малиненко В. П., Фофанов А. Д. Методика рентгенографического исследования тонкопленочных объектов на монокристаллических и поликристаллических подложках//Заводская лаборатория. 1991. Т. 57. Вып. 2. С. 39.
- Арутюнян Р. В., Баранов В. Ю., Большов Л. А и др. Воздействие лазерного излучения на материалы. М.: Наука, 1989. 367 с.
- Величко А. А., Стефанович Г. Б., Пергамент А. Л., Борисков П. П. Детерминированный шум в структурах на основе диоксида ванадия//Письма в ЖТФ. 2003. Т. 29. Вып. 10. С. 82-87.
- Гаврилюк А. И., Рейнов Н. М., Чудновский Ф. А. Фото-и термохромизм в аморфных пленках V2O5//Письма в ЖТФ. 1979. Т. 5. Вып. 20. С. 227-230.
- Данилин Б. С., Киреев В. Ю. Ионное травление микроструктур. М.: Сов. радио, 1979. 104 с.
- Данилин Б. С., Киреев В. Ю. Применение низкотемпературной плазмы для травления и очистки материалов. М.: Энергоатомиздат, 1987. 264 с.
- Дорожко Е. В., Савицкий В. Г. Оптическое поглощение пятиокиси ванадия в области энергий 1.0-5.5 эВ//ФТТ. 1977. Т. 10. Вып. 4. С. 953.
- Кикалов Д. О., Малиненко В. П., Пергамент А. Л., Стефанович Г. Б. Оптические свойства тонких пленок аморфных оксидов ванадия//Письма в ЖТФ. 1999. Т. 25. Вып. 8. С. 81.
- Костышин М. Т., Михайловская Е. В., Романенко П. Р. Об эффекте фотографической чувствительности тонких полупроводниковых слоев, находящихся на металлических положках//Физика твердого тела. 1966. Вып. 8. С. 571.
- Моро У. Микролитография: В 2 ч. Ч. 1: Пер. с англ. М.: МИР, 1990. 605 с.
- Озеров Р. П. Молибдена, ванадия и вольфрама кислородные соединения, их кристаллохимия//Успехи химии. 1955. Т. 24. Вып. 8. С. 951.
- Baba M., Ikeda T. A new inorganic electron resist using amorphous WO3 films//Japanese Journal of Applied Physics. 1981. Vol. 20(2). Р. 149-152.
- Benmoussa M., Outzourhit A., Bennouna A., Ameziane E. L. Electrochromism in sputtered V2O5 thin films: structural and optical studies//Thin Solid Films. 2002. Vol. 405. P. 11-16.
- Bozler C. et al. Solid-transformation thermal resist: US Patent. 1986. 4619894.
- Cheremisin А. B., Loginova S. V., Velichko А. А., Putrolaynen V. V., Pergament А. L., Grishin А. М. Modification of Atomic Structure of Thin Amorphous V2O5 Films under UV Laser Irradiation//Journal of Physics: Conference Series. 2008. Vol. 100. Р. 052096.
- Chudnovskii F. A., Pergament A. L., Schaefer D. A., Stefanovich G. B. Efect of laser irradiation on the properties of transition metal oxides//J. Sol. St. Chem. 1995. Vol. 118. P. 417-418.
- Duchene J., Terraillon M., Pailly M. R. F. and D. C reactive sputtering for crystallinf and amorphous VO2 thin film deposition//Thin Solid Films. 1972. Vol. 12. P. 231-234.
- Frost F., Schindler A., Bigl F. Reactive ion beam etching of InSb and InAs with ultrasmooth surfaces//Semicond. Sci. Technol. 1998. Vol. 13. Р. 523.
- Gavrilyuk A. Nature of photochromism in amorphous V2O5 thin films//Proc. of the SPIE. The Int. Society for Optical Engineering. 1997. Vol. 2968. Р. 195-200.
- Gavrilyuk A. I., Mansurov A. A., Chudnovskii F. A. Photoinjection of hydrogen in amorphous MoO3 and V2O5 films//Sov. Tech. Phys. Lett. 1984. Vol. 10. Р. 292-293.
- Glen A. N., Buhrman R. A. Summary Abstract: Preparation and optical properties of reactively evaporated VO2 thin films//Vac. Sci. Technol. 1984. Vol. A2 (2). P. 301-302.
- Han S. Y., Lee D. H., Chang Y. J., Ryu S. O., Lee T. J., Chang C. H. The Growth Mechanism of Nickel Oxide Thin Films by Room-Temperature Chemical Bath Deposition//J. Electrochem. Society. 2006. Vol. 153. № 6. Р. C382.
- Han Young Yu, Byung Hyun Kang, Ung Hwan Pi, Chan Woo Park, and Sung-Yool Choi, Gyu Tae Kim. V2O5 nanowire-based nanoelectronic devices for helium detection//Appl. Phys. Lett. 2005. Vol. 86. Р. 253102.
- Imada M., Fujimori A., Tokura Y. Metal-insulator transitions//Rev. Mod. Phys. 1998. Vol. 70. P. 1059-1063.
- Iwanaga S., Darling R.B., Cobden D. H. Preparation of coiled carbon fibers by pyrolysis of acetylene using a Ni catalyst and sulfur or phosphorus compound impurity//Appl. Phys. Lett. 2005. Vol. 86. Р. 133113.
- Julien C., Guesdon J. P., Gorenstein A., Khelfa A., Ivanov I. The influence of the substrate material on the growth of V2O5 flash-evaporated films//Appl. Surface Science. 1995. Vol. 90. Р. 389-391.
- Julien C., Haro-Poniatowski E., Camacho-Lopez M. A., Escobar-Alarcon L., Jimenez-Jarquin J. Growth of V2O5 thin films by pulsed laser deposition and their applications in lithium microbatteries//Materials Science and Engineering. 1999. Vol. B65. Р. 170-176.
- Kim B.-J., Lee Y.-W., Chae B.-G., Yun S.-J., Oh S.-Y., Kim H.-T., Lim Y.-S. Optical properties of synthesized organic nanowires//Appl. Phys. Lett. 2007. Vol. 90. Р. 023515.
- Kim H.-T., Chae B.-G., Yоun D.-H., Aeng S.-L, Kim G., Kang K.-Y., Lim Y.-S. Mechanism and observation of Mott transition in VO2-based two-and three-terminal devices//New J. Phys. 2004. Vol. 6. Р. 52.
- Koshida N., Ohtaka K., Ando M., Komuro M., Anoda N. Focused Ion Beam Lithography with Transition Metal Oxide Resists//Japanese Journal of Applied Physics. 1989. Vol. 28 (10). Р. 2090-2094.
- Lis S. A., Lavine J. M., Goldberg G. M. Options and opportunities with inorganic photoresist systems//Mat. Proc. of SPIE. 1984. Р. 393-394.
- Liu Z., Fang G., Wang Y., Bai Y., Yao K.-L. Laser-induced coloration of V2O5//J. Phys. D: Appl. Phys. 2000. Vol. 33. Р. 2327-2332.
- Min M.-R., Kim J.-H., Kim E.-K., Kim Y.-K., Ha J.-S., Kim K.-T. Electrical properties of V2O5 (vanadium pentoxide) nanowires//J. Korean Phys. Soc. 2006. Vol. 49. 1097-1100.
- Moshfegh A. Z., Ignatiev A. Formation and characterization of thin film vanadium oxides: Auger electron spectroscopy, X-ray photoelectron spectroscopy, X-ray diffraction, scanning electron microscopy, and optical reflectance studies//Thin Solid Films. 1991. Vol. 198. Р. 251-268.
- Nagase K., Shimizu Y., Miura N., Yamazoe N. Oriented lead germanate thin films by excimer laser ablation//Appl. Phys. Lett. 1992. Vol. 60. P. 802-804.
- Nishio S., Kakihana M. Evidence for Visible Light Photochromism of V2O5//Chem. Mater. 2002. Vol. 14. Р. 3730-3733.
- Nobuyoshi K., Koichi O., Masanobu A., Masanori K., Nobufumi A. Formation of Nickel Oxyhydroxide Thin Films by Electrodepositon and Their Electrochromic Characteristics.//J. Appl. Phys. Japan. 1988. Vol. 27. Р. 314-318.
- Okamoto M., Baba M., Ikeda T. Application of MoO3 Electron Resist to Lift-Off Process//Japanese Journal of Applied Physics. 1990. Vol. 29 (3). Р. 518-520.
- Pang S. W., Kunz R. R., Rothschild M., Goodman R.B., Horn M. W. Aluminum oxides as imaging materials for 193-nm excimer laser lithography//J. Vac. Sci. Technol. 1989. Vol. 7 (6). Р. 1624.
- Peter Van Zant. Microchip Fabrication. 3rd ed. McGraw-Hill Companies, 1997. 623 p.
- PMMA resists//http://www.microchem.com/products/pdf/PMMA_Data_Sheet.pdf.
- Putrolaynen V. V., Velichko A. A., Pergaent A. L., Cheremisin A. B., Grishin A. M. UV patterning of vanadium pentoxide films for device applications//J. Phys. D: Appl. Phys. 2007. Vol. 40. Р. 5283-5286.
- Rajendra Kumar R. T., Karunagaran B., Senthil Kumar V., Jeyachandran Y. L., Mangalaraj D., Narayandass S a. K. Structural properties of V2O5 thin films prepared by vacuum evaporation//Materials Science in Semiconductor Proc. 2003. Vol. 6. Р. 543-546.
- Ramana C. V., Naidu B.S., Hussain O. M., Pinto R. Low-temperature growth of Vanadium pentoxide thin films produced by pulsed laser ablation//J. Phys. D: Appl. Phys. 2001. Vol. 34. Р. L35.
- Rozen J., Lopez R., Haglund Jr. R. F., Feldman L. C. Effects of polymer gate dielectrics roughness on pentacene field-effect transistors//Appl. Phys. Lett. 2006. Vol. 88. Р. 081902.
- Sarunic M. V., Chapman G. H., Tu Y. Prototype laser-activated bimetallic thermal resist for microfabrication//Mat. Proc. of SPIE. 2001. Vol. 4274. Р. 183.
- Sigmund P. Theory of sputtering//Phys. Rev. 1969. Vol. 184. № 2. Р. 383.
- Sinclair W. R., Rousseau D. L., Stancavish J. J. Iron Oxide -An Inorganic Photoresist and Mask Material//J. Electrochem. Soc. 1974. Vol. 121 (7). Р. 925.
- Smith D. J., Mc Cartney M.R., Bursill L. A. The electron-beam-induced reduction of transition metal oxide surfaces to metallic lower oxides//Utramicroscopy. 1987. Vol. 23. Р. 299-303.
- Stefanovich G. B., Pergament A. L., Velichko A.A., Stefanovich L. A. Anodic oxidation of vanadium and properties of vanadium oxide films//J. Phys.: Cond. Mat. 2004. Vol. 16. Р. 4013-4024.
- Tai K. L., Sinclair W. R., Vadimsky R. G. Bilevel high resolution photolithographic technique for use with wafers with stepped and/or reflecting surfaces//J. Vac. Sci. Technol. 1979. Vol. 16 (6). Р. 1977.
- Thoas I. Ryoung-han Kim, Bruno La Fontaine, Patrick P., Anderson Ch. N., Sandberg R. L. Progress in EUV photoresist technology//Mat. Proc. of SPIE. 2007. 6533, 653317.
- Wakaki M., Nakao R., Sakata H., Shibuya T., Yoshikado A. Maskless patterning characteristics of vanadium pentoxide amorphous films by frequency-doubled Q-seitched Nd:YAG laser irradiation//Proc. of SPIE -The Int. Society for Optical Engineering. 2002. Vol. 4915. Р. 317-325.
- Warren B. E. X-ray diffraction. New York, 1969. 563 p.
- Wu Q.-H., Thissen A., Jaegermann W. Photoelectron Spectroscopy of Na Intercalation into V2O5 Thin Films//Sol. St. Ion. 2004. Vol. 167. Р. 155-163.
- Yoshitaka F., Katsuhiro M., Chiei T. On the Electrochromism of Evaporated V2O5 Films//Japan J. Appl. Phys. 1985. Part 1. Vol. 24. Р. 1082-1086.


