Рентгеновская рефлектометрия поверхностей монокристаллов, нанокомпозитных и оксидных пленок
Автор: Петраков А.П., Садовников Д.В.
Журнал: Вестник геонаук @vestnik-geo
Статья в выпуске: 9 (141), 2006 года.
Бесплатный доступ
Короткий адрес: https://sciup.org/149128119
IDR: 149128119
Текст статьи Рентгеновская рефлектометрия поверхностей монокристаллов, нанокомпозитных и оксидных пленок
В настоящее время в дополнение к хорошо разработанным и широко применяемым методам исследования веществ при помощи рентгеновских лучей — рентгеноструктурному, рентгеноспектральному анализам и малоугловому рассеянию, стал развиваться метод рентгеновской рефлектомет-рии (РР), позволяющий решать некоторые специфические задачи, недоступные для других методов [1].
Этот метод позволяет с высокой точностью оценить физические и геометрические свойства приповерхностной области твердых и жидких тел, а также тонких пленок, наносимых различными способами на подложки [2— 5]. В основе РР лежит измерение отражательной способности в интервале малых углов скольжения (вблизи полного внешнего отражения — ПВО) [6].
Наибольшее развитие получил интегральный метод, с помощью которого можно определить такие параметры, как плотность материала, среднеквадратичную высоту шероховатости поверхности и толщину пленки, нанесенной на гладкую поверхность.
Также широко используются исследования поверхности нa основе дифференциальных кривых рентгеновской рефлектометрии. Угловое распределение коэффициента отражения определяется диэлектрической постоянной вещества и характеристиками поверхности.
Целью данной работы являлось ус-
, (1)
где
I а S\ S г ( X , ,
1 + а 5, + 5;
Θ — угол поворота образца; s 0 = sin Θ ;
/ 2 \ I'-'
; χ 1,2 — реальная часть поляризуемости пленки и подложки соответственно; f 1,2 = exp[0.5( q 1,2 σ 1,2)2] — факторы ослабления; q 1 = 2 ks 0; q 2 = 2 kRes 1; k = 2 π / λ ; λ — длина волны падающего излучения ( λ = 1.54 Ε); σ 1,2 — среднеквадратичная высота шероховатости пленки и подложки соответственно; ϕ = 2 ks 1 d . Величина Q зависит от толщины пленки d и описывает интерференцию волн. В частности, если пленка отсутствует, то Q = 1. Толщина пленки приравнивается к нулю, а ее поляризуемость к соответствующей величине подложки.
Образцы монокристаллов NaCl для исследования получали скалыванием. Поверхность монокристаллов, совпадавшая с плоскостью (100), травилась в дистиллированной воде в течение 5, 15, 35, 60 и 120 секунд. Полученные значения σ приведены в табл. 1, а снятые экс-
Таблица 1
Зависимость среднеквадратичной высоты шероховатости поверхности монокристалла от времени травления поверхности
|
Время травления, с |
0 |
5 |
15 |
35 |
60 |
120 |
|
<7, А |
20±1 |
23±1 |
26±1 |
29±1 |
20±1 |
21±1 |
периментально и построенные теоретические рефлектограммы показаны на рис. 1.
На поверхности монокристалла после скалывания имелась шероховатость величиной σ = 20 Ε. После 5 с травления высота шероховатости возросла за счет большего растворения приповерхностных дефектов кристалла, которые образовались, возможно, во время скалывания. Это явление наблюдалось вплоть до 35 с травления, в дальнейшем высоты шероховатости снизилась, что указывает на уменьшении количества дефектов по мере продвижения в глубь кристалла. Неизменность высоты шероховатости во временном интервале травления 60—120 с свидетельствует о равномерном распределении дефектов в объеме.
В качестве гранулированных композитов металл-диэлектриков, представляющих собой наноразмерные (2—10 нм) металлические частицы, распределенные в диэлектрической матрице, была взята гранулированная аморфная пленка (Fe40Co40Zr20)x (Al2O3)100-x, где x — содержание металла в образце. Нанокластеры спла-вa Fe40Co40Zr20, хаотично распреде- тановление зависимости шероховатости поверхности монокристаллов NaCl от времени травления, нанокомпозит-ных пленок нa основе железа и алюминия (Fe40Co40Zr20)x(Al2O3)100-x от их состава (x), окисных пленок SiO2 и Ta4O5 от условий анодного окисления. Толщина пленок определялась рефлек-тометрическим методом. Теоретическая интегральная кривая строилась по формуле [7]
Таблица 2
Зависимость физических свойств нанокомпозитной пленки от ее состава
|
X |
Критический угол, угл. мин |
d, А |
о, к |
р, г/смл |
|
30 |
17.31 |
260±7 |
16±2 |
3.989 |
|
40 |
18.5 |
220±7 |
12±1 |
4.556 |
|
52 |
20.08 |
190±7 |
10±1 |
5.373 |
|
63 |
19.99 |
170±7 |
10±1 |
5.373 |
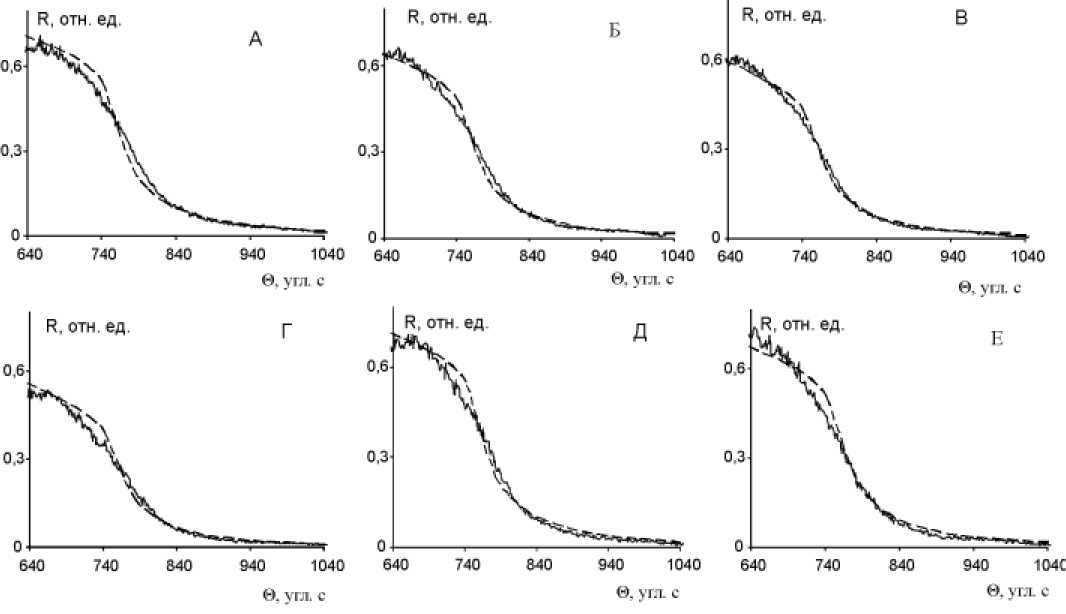
Puc. 1. Интегральные кривые рентгеновской рефлектометрии монокристаллов NaCl: A — сколотого кристалла, Б — протравленного в течение 5 с, В — 15 с, Г — 35 с, Д — 60 с, Ε — 120 с. Сплошные линии — экспериментальные данные, пунктирные — теоретические

Puc. 2. Интегральные кривые рентгеновской рефлектометрии нанокомпозитной пленки (Fe40Co40Zr20)x(Al2O3)100-x: A — при x = 30, Б — при x = 40, В — при x = 52 и 60. Сплошные линии — экспериментальные данные, пунктирные — теоретические
ленные в изолирующей аморфной матрице Al2O3, были получены методом ионно-лучевого напыления в атмосфере аргона. Для этого использовались составные мишени ферромагнетика и диэлектрика, напыление производилось на неохлаждаемые подложки из ситала. Полученные таким способом образцы представляли собой пленки толщиной 0.15—6.5 мкм. Из табл. 2 видим, что каждому значению x соответствует свой критический угол.
Увеличение угла связано с возрастанием плотности. Плотность пленки, оцененная по положению критическо- го угла, составила 3.99 и 4.56 г/см3 для x = 32 и 40 %, и 5.37 г/см3 для x = 52 и 63 %. Критический угол определялся по положению точки с интенсивностью, равной половине максимальной. Плотность пленки при минимальных значениях x немного превышала плотность Al2O3 (3.96 г/см3). По мере увеличения металлической фазы до 52 % плотность пленки возрастала. Прекращение повышения плотности с увеличением x наблюдалось в области выше порога перколяции (45^50 %).
Для исследования окисных пленок были взяты две пленки SiO2, полученные путем анодного окисления при раз- ной плотности тока (j1 = 2мА/см2, j2 = 10 мА/см2) и одинаковом напряжении U = 70 В.
Как видно на рис. 3 и в табл. 3, у окисной пленки SiO2, полученной при плотности тока j2, среднеквадратичная высота шероховатости больше, чем у пленки, образовавшейся при j1, незначительно отличается толщина пленки. Можно сделать вывод, что при большей плотности тока поверхность пленки сильно отличается от идеальной.
Окисная пленка SiO2, имеет высоту среднеквадратичной шероховатости меньше, если ее окислять при ма-

Puc. 3. Интегральные кривые рентгеновской рефлектометрии окисной пленки SiO2: А — пленка при j2 = 10 мА/см2, Б — пленка при j1 = 2 мА/см2. Сплошные линии — экспериментальные данные, пунктирные — теоретические
лой плотности тока, возможно, при этом уменьшается влияние неровностей поверхности. Так же при малой плотности тока анодного окисления плотность пленки по глубине более равномерна.
Для исследования окисных пленок Ta4O5 были взяты две пленки, полученные при анодном окислении с разным напряжением (U1 = 50 В, U2 = 80 В).
У пленок Ta4O5 по сравнению с пленками SiO2 сильно отличается их толщина. Из рис. 4 видно, что критический угол у интегральной кривой рентгеновской рефлектометрии, снятой у пленки, окисленной при напряжении U1 = 50, значительно больше, чем
Зависимость физических свойств окисной пленки SiO2 от величины плотности тока при анодном окислении
Таблица 3
|
Плотность тока, мА/см2 |
Критический угол, у гл. с |
d, к |
^пленки? А |
р, г/см' |
|
2 |
835 |
250±7 |
20±2 |
2.75 |
|
10 |
774 |
220 ±7 |
35±4 |
2.65 |
у пленки, окисленной при напряжении U2 = 80.
Толщина окисной пленки Ta4O5 сильно зависит от напряжения анодного окисления. С ростом напряжения критический угол смещается в сторону больших углов, что указывает на возрастание плотности пленки. Величина напряжения не влияет на высоту шероховатости пленки.
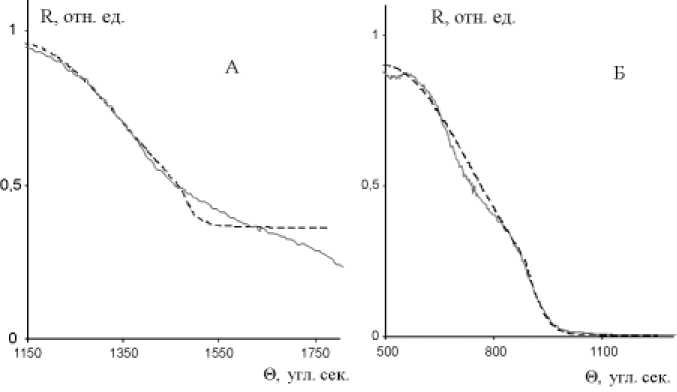
Puc. 4. Интегральные кривые рентгеновской рефлектометрии окисной пленки Ta4O5: А — пленка при U1 = 50 В, Б — пленка при U2 = 80 В. Сплошные линии — экспериментальные данные, штриховые — расчетные
Зависимость физических свойств окисной пленки Ta4O5 от величины напряжения при анодном окислении
Таблица 4
|
Напряжение, В |
Критический угол, у гл. с |
d, А |
^пленкю А |
р, г/см’ |
|
50 |
1800 |
1000±20 |
22±2 |
11,7 |
|
80 |
1390 |
700±10 |
21±2 |
8,71 |
Список литературы Рентгеновская рефлектометрия поверхностей монокристаллов, нанокомпозитных и оксидных пленок
- Sinha S. K., Sirota E. B., Garoff S., Stanley H. B. X-ray and neutron scattering from rough surfaces // Phys. Rev. B, 1988. V. 38. № 4. P. 2297-2311.
- Петраков А. П. Рентгеновские рефлектометрические исследования нефтяных дисперсных систем // Поверхность, 2003. № 12. С. 75-77.
- Петраков А. П., Кряжев А. А. Восстановление микрогеометрии поверхности по данным рентгеновской рефлектометрии // Зав. лаб. Диаг. мат., 2003. Т. 69, № 8. С. 26-31.
- Петраков А. П. Метод рентгеновской рефлектометрии и его применение для исследования лазерного испарения окисной пленки с поверхности кремния // ЖТФ, 2003. Т. 73. В. 4. С. 129-134.
- Петраков А. П., Голубев Е. А. Рентгеновская рефлектометрия фуллереносодержащих углеродных пленок // Поверхность, 2000. № 9. С. 15-16.
- Андреев А. В. Рентгеновская оптика поверхности // УФН, 1985. Т. 145. В. 1. С. 113-136.
- Бушуев В. А., Петраков А. П. Рентгеновская рефлектометрия пленок бора, полученных лазерным напылением на кремниевые подложки // Сб. докл. Национальной конференции по применению рентгеновского и синхротронного излучений, нейтронов и электронов. Т. II. Дубна, 1997. С. 188-193.


