Структурно-химические и электрофизические свойства тонких пленок Ti03Al0.7OY, полученных методом атомно-слоевого осаждения
Автор: Алехин Анатолий Павлович, Григал Ирина Павловна, Гудкова Светлана Александровна, Маркеев Андрей Михайлович, Стариков Павел Александрович, Чуприк Анастасия Александровна
Журнал: Труды Московского физико-технического института @trudy-mipt
Рубрика: Полупроводниковая электроника и нанотехнологии
Статья в выпуске: 3 (15) т.4, 2012 года.
Бесплатный доступ
Трехкомпонентные пленки Ti0.3Al0.7Oу толщиной 3-40 нм были выращены на Si-подложках методом атомно-слоевого осаждения. Исходные пленки обладают аморфной структурой вне зависимости от толщины. Быстрый термический отжиг (БТО) при температуре 700 оС приводит к формированию кристаллической фазы TiAl2O5 в пленках Ti0.3Al0.7Oу толщиной 40 нм, более тонкие пленки остаются аморфными. Диэлектрическая проницаемость отожженных Ti0.3Al0.7Oу -пленок варьируется в диа- пазоне k = 14-19 при изменении толщины от 3 до 40 нм. Значение эквивалентной толщины CET (capacitance equivalent thickness ) пленки толщиной 3 нм равно 1.4 нм. На границе раздела Ti0.3Al0.7Oу -Si в течение АСО-процесса образуется переходный слой SiOх толщиной 0,6-0,7 нм, увеличивающийся в результате БТО до 2-3 нм, что приводит к уменьшению токов утечек на три порядка величины. Оптимальная тем- пература БТО с точки зрения наибольшей величины k и наименьших токов утечки составляет 700 оС.
Атомно-слоевое осаждение (асо), диэлектрики с высокой ди- электрической постоянной, токи утечки, электрофизические свойства
Короткий адрес: https://sciup.org/142185855
IDR: 142185855
Structural chemical and electric properties of Ti03Al0.7OY thin films grown by atomic layer deposition
Ternary oxide Ti0.3Al0.7Oу thin films with thickness 3-40 nm are grown by an atomic layer deposition technique. The grown titanium aluminate films are shown to be a homogeneous alloy and exhibit the amorphous structure in the whole thickness range, while rapid thermal processing (RTP) induces the crystallization of TiAl2O5 phase in the thickness range 20-40 nm. Thinner films remain amorphous after RTP. The permittivity k of annealed films varies in the range k = 14-19 depending on film thickness. The 0.5-nm-thick SiOх layer formeds at the Si-film interface, while the deposition grows up to 2 nm upon RTP and presumably affects the leakage current decreasing three orders of magnitude upon annealing. The optimal temperature of RTP for the maximization k and minimization leakage current densities is T = 700 °C.
Текст научной статьи Структурно-химические и электрофизические свойства тонких пленок Ti03Al0.7OY, полученных методом атомно-слоевого осаждения
Дальнейшее увеличение быстродействия и уменьшение размеров транзисторов в микросхемах логики и памяти, изготовленных по технологии КМОП (комплементарные устройства на структурах металл-оксид-полупроводник), стимулирует поиск новых диэлектриков с высокой диэлектрической проницаемостью, а. также развитие методов формирования сверхтонких диэлектрических слоев.
Высокие значения диэлектрической проницаемости диоксида титана ТІО2 (30-100) делают его одним из наиболее привлекательных бинарных оксидов для КМОП-технологии. Однако ТІО2 имеет узкую запрещенную зону (3.3-3.4 эВ), обладает близким к нулю смещением зоны проводимости по отношению к Si п-типа, подвержен нежелательной кристаллизации при низких температурах (~ 400 °C), которая в свою очередь приводит к высоким токам утечки. С другой стороны, оксид алюминия Al2O3 имеет широкую запрещенную зону (8.8 эВ), большое смещение зоны проводимости по отношению к Si п-типа, термодинамически стабилен в контакте с Si, однако имеет относительно малое значение диэлектрической проницаемости (7-10). Поэтому в последнее время актуален подход комбинирования ТІО2 и AI2O3 в виде трехкомпонентных оксидов ТіжА 1і-жОу или многослойных пленок TiO2/АІ2О3 с целью улучшения электрофизических свойств диэлектрического слоя. В настоящее время трехкомпонентные оксиды ТіЖА 11-жОу получают методами ионного распыления [1], импульсного лазерного осаждения [2], электронно-лучевого напыления [3].
В последнее время в разработках новых процессов получения тонких пленок большое внимание привлекает метод атомно-слоевого осаждения (АСО), представляющий собой последовательность циклически чередующихся реакций в хемосорбированных слоях. Так как при этом химические реакции протекают на. активных центрах поверхности, становится возможным осуществление процесса, роста, в условиях насыщения при заполнении всех доступных активных центров. В результате процесс АСО иногда называют самонасыщаемым или поверхностно контролируемым, т.е. когда процесс определяется состоянием поверхности и природой реагента и слабо зависит от таких параметров, как давление и расход реагента, что позволяет получатв беспрецедентно однородные и конформные тонкие пленки на больших площадях с высокой воспроизводимостью [4-6].
В работе [7] было изучено влияние концентрации Ті-Al на структурные и электрофизические свойства трехкомпонентных оксидов Ті ЖА 11-жОу толщ иной ~40 нм, полученных методом АСО. Было установлено, что наиболее перспективным для применения в качестве подзатворного диэлектрика в КМОП-технологии является трехкомпонентный оксид состава Ті0.3АІ0.7Оу. Учитывая потребность современной микроэлектроники в диэлектриках разных толщин, включая и сверхтонкие (~3 нм), целью данной работы стало получение методом АСО Ті0.3АІ0.7Оу-пленок в широком диапазоне толщин 3-40 нм, сравнение их структурно-химических и электрофизических характеристик как до, так и после быстрого термического отжига.
1. Экспериментальная часть
Ті0.3АІ0.7Оу-пленки различной толщины были выращены методом АСО в реакторе с горячими стенками при пониженном давлении (5 мбар) Sunale R-150 Picosun OY. В качестве подложек были использованы Si (100) пластины с проводимостью p-типа и удельным сопротивлением р = 12 Ом-см. Непосредственно перед загрузкой пластин в камеру АСО-реактора Si-пластины были обработаны однопроцентным раствором плавиковой кислоты HF с целью удаления естественного оксида SiO2.
В качестве газа-носителя и для продувки камеры использовался азот особой чистоты (99.999%). Пленки Ті0.3АІ0.7Оу осаждались при температуре подложки 300 °C с чередованием реакционных циклов: 1 цикл А1(СН3)3 - Н2О и 1 цикл Ті(ОС2Н5)4 - Н2О. Длительность импульсов подачи реагентов А1(СН3)3 и Т^ОСД^Д составляла 0.1 с, в то время как длительность импульсов подачи Н2О - 0.2 с. После каждого импульса камера реактора продувалась азотом в течение 4 с. Для обеспечения необходимого давления насыщенных паров температура Ті(ОС2Н5)4 составляла 150 °C. Температура А1(СН3)3 и Н2О составляла 22 °C.
Толщина и коэффициент преломления пленок определялись методом лазерной эллипсометрии на эллипсометре Sentech SE500adv. Общее число реакционных циклов составляли величины 34, 116 и 500 для пленок толщиной ~ 3, 10 и 40 нм соответственно.
Для изучения влияния отжига на химический состав, структурные и электрофизические свойства Ті0.3AI0.7Oу-пленок выращенные пленки были подвергнуты быстрому термическому отжигу в атмосфере N2/02(0,2%) при температуре 500, 600, 700 °C в течение 60 с. Элементный состав пленок Ті0.3АІ0.7Оу конторолировался методом рентгенофлюоресцентного анализа (РФА) на приборе Optim’x Thermo Fisher Scientific с использованием программного обеспечения OptiQuant™ для без эталонного анализа.
Анализ структурных свойств пленок методами рентгеновской дифрактометрии (РД) и рентгеновской рефлектометрии (РР) был выполнен на дифрактометре ARL X’TRA (Thermo Fisher Scientific), оснащенном Си рентгеновской трубкой. Измерения методом рентгеновской дифрактометрии были выполнены в геометрии скользящего падения (6°), методом рентгеновской рефлектометрии — в геометрии Брэгга-Брентано.
Исследование химического состояния пленок Ті0.3АІ0.7Оу осуществлялось методом рентгено-фотоэлектронной спектроскопии (РФЭС) на спектрометре Theta Probe Thermo Fisher Scientific с монохроматизированным АИа-излучением (I486 эВ) и разрешением 0,45эВ на линии Au4f в вакууме 5-10-10 мбар. Калибровка энергий связи проводилась по пику Si2p3/2 (99.3eV). Для определения толщин исследуемых слоев было использовано стандартное программное обеспечение Thermo Fisher Scientific.
Исследование морфологии поверхности пленок и измерение шероховатости осуществлялись полуконтактным методом с помощью атомно-силового микроскопа (ACM) NT-MDT Solver Рго-М.
Электрофизические свойства исходных и отожженных пленок исследовались методами I - V- и С - Р-спектроскопии. Площадь металлических электродов МДП-структур Si/Ti 0.3AI0.7O у/А1 составлял а от I960 мкм2 до 0.44 мм2. Вольт-амперные и вольт-фарадные характеристики были измерены в комнатных условиях с помощью LCR-метра Agilent Е4980А и зондовой станции Ecorpia EPS1000 при частоте измерительного сигнала 10 кГц-1 МГц. Нижний предел измерения плотности тока составил ~5•10-7 А си2
2. Результаты и их обсуждение
РФА-анализ показал, что содержание металлических элементов в пленках всех трех полученных толщин как до, так и после отжига соответствовало составу Ti0.3АІ0.7Оу.
Исследования методом РФЭС показали, что энергии связи Еь электронов Ті2р и А12р уровней в Ti0.3АІ0.7Оу-пленках всех трех толщин до и после отжига соответствуют степеням окисления Ti 4+ л А13+ в ТЮ2 и АІ2О3 соответствешю.
В случае тонкой (~ 3 нм) Ti0.3Al0.7Oу-пленки метод РФЭС позволяет исследовать химическое состояние границы раздела Si/Ti0.3AI0.7Oу. На рис. 1 приведены Si2p РФЭС спектры, полученные от структур Si/Ti0.3AI0.7O у (3 нм) до (кривая 1) и после ВТО при 700 °C (кривая 2). На обоих спектрах наряду с дуплетом Si2p с положением Si2p3/2 пика на 99.3 эВ, соответствующего Si-Si-связям кремниевой подложки, присутствует пик на 102,9 эВ, соответствующий Si-O-связям переходного слоя между Ti0.3AI0.7OуИ Si. Энергия связи SiOж-пика Еь = 102, 9 эВ существенно ниже значения Еь = 103,45 эВ, характерного для степени окисления Si 4+ стехиометричного SiO2. Данное расхождение обычно объясняется образованием силикатных связей в переходном слое [3], но также может быть связано с образованием электрических диполей на границе раздела Si/SiO2, которые могут приводить к измененению положения SiOж-пика на РФЭС-спектрах [7].

Рис. 1. РФЭС-спектры, полученные от структур Si/Ti0.3AI0.7Oу (3 им) до (кривая 1) и после БТО при 700 °C (кривая 2)
Важно отметить, что БТО приводит к значительному увеличению интенсивности SiOж-пика (рис. 1, кривая 2) по сравнению с SiOж-пиком на РФЭС-спектре от неотожженного образца (рис. 1, кривая 1), т.е. к увеличению толщины переходного слоя. Так, расчет по соотношению интенсивностей SiOж- и Si-пиков показал, что переходный слой составляет величину ~ 0.7 нм в неотожженной пленке и ~ 3 нм после БТО при 700 °C.
Исследования методом РР показали, что экспериментальные спектры от пленок Ti0.3AI0.7O у всех трех толщин как до, так и после БТО (700 °C) могут быть смоделированы на основе двухслойной модели, включающей слой состава Ti0.3AI0.7O у и переходный слой
SiOж. Результаты расчетов толщин указанных слоев приведены в табл. 1. Видно, что толщина переходного слоя SiO$ для неотожженных пленок всех трех толщин составляет величину ^0.6 нм. БТО образцов приводит к существенному увеличению толщины переходного слоя SiO $ до величин 1.8 3.0 нм. Указанная в таблице погрешность измерения толщины определяется погрешностью математической обработки РР-данных и не превышает 17% для переходного слоя SiO х толщиной 0.6 нм. Отметим, что РР-данные по толщинам переходного слоя для тонкой (~ 3 нм) как отожженной, так и неотожженной Ті0.3А10.7О^-пленки, граница раздела которой доступна для РФЭС-анализа, находятся в хорошем соответствии с результатами РФЭС-измерений.
Таблица!
Толщины слоев Ti0-3А10.7Оу, переходного слоя 8іОж, шероховатость (RMS) поверхности слоев Ti0-3А10.7Оу и относительные диэлектрические проницаемости £-слоев SiOж/Ті0.3А10.7Оу
|
До БТО |
После БТО |
|||||||
|
Число циклов |
Толщина слоя Ti 0.3AI0.7 Ою нм |
RMS, нм |
Толщина переходного слоя SiOж, нм |
к |
Толщина слоя Ti 0.3AI0.7 Оу, нм |
RMS, нм |
Толщина переходного слоя SiOж, нм |
к |
|
500 |
40.7 ±0.8 |
0.1 |
0.6 ±0.1 |
17 |
38.4 ±0.8 |
0.4 |
1.8 ±0.1 |
19 |
|
116 |
9.4 ±0.2 |
0.1 |
0.6 ±0.1 |
12 |
9.0 ±0.2 |
0.4 |
1.9 ±0.1 |
14 |
|
34 |
3.0 ±0.1 |
0.1 |
0.6 ±0.1 |
13 |
2.8 ±0.1 |
0.1 |
3.0 ±0.2 |
15 |
Исследования Ti0.3AI0.7О^-пленок методом РД показали, что пленки всех трех толщин в неотожженном состоянии обладают аморфной структурой. Однако, по данным РД, структура отожженных (700 °C) Ti0.3А10.7О^-пленок существенно различается в зависимости от толщины пленки. На рис. 2 приведены рентгеновские дифрактограммы отожженных пленок толщиной ^40 нм (кривая 1) и толщиной ^3 нм (кривая 2). Видно, что на ди-фрактограмме от толстой пленки присутствуют дифракционные рефлексы на углах 2Ө, равных 18,6° и 33.9°, которые соответствуют рефлексам от плоскостей (200) и (230) тройного соединения ТІА1205 с орторомбической решеткой. Таким образом, отожженная толстая пленка обладает поликристаллической структурой, в то время как тонкая пленка сохраняет аморфную структуру (рис.2, кривая 2).

Рис. 2. Рентгеновские дифрактограммы отожженных пленок Ti 0.3А10.7 Оу толщ иной ~40 нм (кривая 1) и толщиной ~3 нм (кривая 2)
Диэлектрические свойства исходных и отожженных Ті0.3АІ0.7О^- пленок различной толщины были охарактеризованы с помощью высокочастотных вольт-фарадных характеристик МДП-структур Si/Ті0.3А10.7O^/Al. Поскольку шероховатость поверхности (RMS), измеренная с помощью АСМ, достаточно мала по сравнению с толщиной пленки (таблица 1), можно использовать модель плоского конденсатора для определения диэлектрической проницаемости слоев. При этом погрешность измерения диэлектрической проницаемости, связанная с шероховатостью слоев Ті0.3АІ0.7О^, не превышает 3.7%. Общая диэлектрическая проницаемость к диэлектрических слоев SiOж/ТІ0.3АІ0.7О^ была вычислена из емкости МДП-структуры в режиме аккумуляции.
Следует отметить, что емкость в режиме аккумуляции имеет существенную дисперсию в диапазоне частот измерительного сигнала 10 кГц - 1 МГц за счет довольно большого последовательного контактного сопротивления. В данном случае корректировка вольт-фарадных характеристик с учетом контактного сопротивления стандартными математическими методами [8] невозможна, поскольку проводимость в режиме аккумуляции имеет сильную зависимость от напряжения смещения. Поэтому для того, чтобы минимизировать влияние контактного сопротивления, диэлектрическая проницаемость определялась при частоте измерительного сигнала 10 кГц. При этой частоте влияние емкости поверхностных состояний на емкость в режиме аккумуляции еще не должно быть существенным.
Все измеренные вольт-фарадные характеристики (рис. 3) имеют плато на наклонном участке, соответствующее моноэнергетическим ловушкам на границе раздела SiOж/ Ті0.зА10.7 О?/ (рис. 3). Плато на вольт-фарадных характеристиках отожженных образцов менее плоское за счет более толстого переходного слоя SiOж (по данным РФЭС и РР), приводящего к увеличению времени жизни ловушек. Этот эффект объясняет и небольшой (50-200 мВ) гистерезис вольт-фарадных характеристик, который появился после отжига.
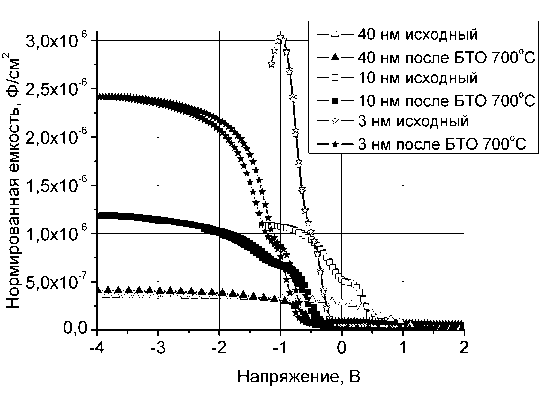
Рис. 3. Вольт-фарадные характеристики МДП-структур на основе диэлектрических Ті0.3A10.7О^ пленок различной толщины
Кроме того, представленные вольт-фарадные характеристики говорят о наличии отрицательного встроенного заряда в Ті0.3А10.7О^-слоях. В данном случае наиболее вероятными источниками встроенного заряда являются ионы тетраэдрального А13+ [9] и вакансии кислорода, заряженные одним или двумя электронами. После отжига суммарный отрицательный встроенный заряд уменьшается за счет увеличения положительного заряда, локализованного на границе раздела между переходным слоем SiOж и Si [3].
Эквивалентная толщина СЕТ (capacitance equivalent thickness) [10] для исходной Ті0.3АІ0.7О^-пленки толщиной ^3 нм, вычисленная из вольт-фарадных характеристик, составляет СЕТ = 1.2 нм. После ВТО значение СЕТ незначительно увеличивается (до 1.4 нм) (рис. 4).

Рис. 4. Общая диэлектрическая проницаемость к и СЕТ для отожженных при 700 °C Ті0.3А10.70^ пленок разной толщины
БТО Ті0.3АІ0.7О^-пленок влияет как на к (табл. 1), так и на плотность токов утечки (рис. 5). Чтобы объяснить влияние БТО на электрофизические свойства Ті0.3АІ0.7Оу пленок, необходимо учесть несколько типов процессов, происходящих в пленке во время отжига: (1) рост переходного слоя SiOж на границе раздела 8і/Тіо.зА1о.7О^, (2) насыщение кислородных вакансий, являющихся источником электронов в оксидах металлов, (3) уплотнение пленки Ті0.3АІ0.7Оу и (4) образование кристаллинеской фазы в пленках толщиной ^40 нм. Вероятно, наблюдаемое после БТО уменьшение плотности токов утечек для Ті0.3АІ0.7Оу всех представленных толщин главным образом связано с ростом переходного слоя SiOж, который обеспечивает дополнительный потенциальный барьер с широкой запрещенной зоной и большим смещением относительно дна зоны проводимости Si [11, 12]. Увеличение толщины SiOж подтверждается результатами РФЭС и РР.
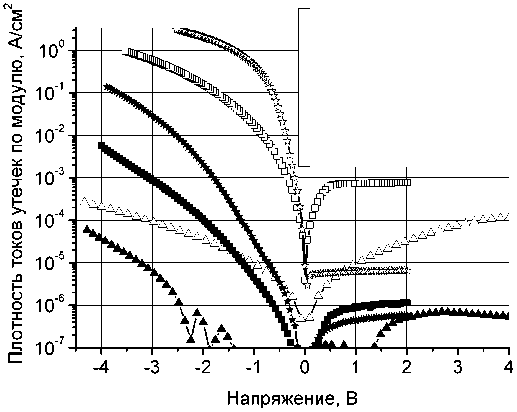
— △ —40 нм исходный
—▲—40 нм после БТО 700°С
—□— 10 нм исходный
—■— 10 нм после БТО 700°С
— ☆ —3 нм исходный
—*—3 нм после БТО 700°С
Рис. 5. Вольт-амперные харатеристики МДП-структур на основе исходных и отожженных при 700 °C Ті0.3АІ0.7О^-пленок различной толщины
Несмотря на рост переходного слоя SiOж с малой к при БТО, общая к двойного диэлектрического слоя SiOж/ТІ0.3АІ0.7Оу немного увеличивается при любой толщине ТІ0.3АІ0.7Оу-пленки (см. табл. 1). Данный факт говорит о преимущественном влиянии процесса (3), который эффективно увеличивает к Ті0.3АІ0.7О^-пленок любой толщины. Кроме того, в случае пленки толщиной ^40 нм БТО, как было показано методом РД, приводит к образованию поликристаллической фазы TiAl2O5, которая обладает высокой диэлектрической проницаемостью к ^ 30.
Для более деталвного изучения влияния отжига на электрофизические свойства пленки Ті0.3АІ0.7О^ была выбрана наиболее интересная с точки зрения практического применения в КМОП-технологии пленка толщиной ^3 нм. На рис. 6 представлены вольт-амперные характеристики для исходных и отожженных образцов при температурах 500, 600, 700 °C, а на рис. 7 - зависимости плотности токов утечки при электрических полях -1 МВ/см и -2 МВ/см от температуры БТО. Резкое изменение токов утечки (на три порядка величины) произошло при температурном переходе от 600 к 700 °C: значения токов утечек при напряженности поля -1 МВ/см изменилось от ^5•10 3 А/см2 до 3-10 6А/см2 (рис. 7).
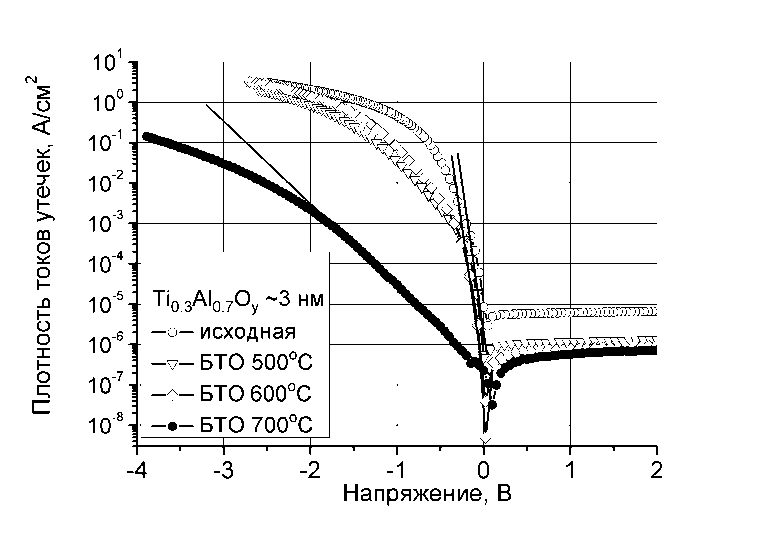
Рис. 6. Вольт-амперные харатеристики МДП-структур на основе Ті0.3АБ.7О^-пленок толщиной ~ 3 нм после БТО при различных температурах
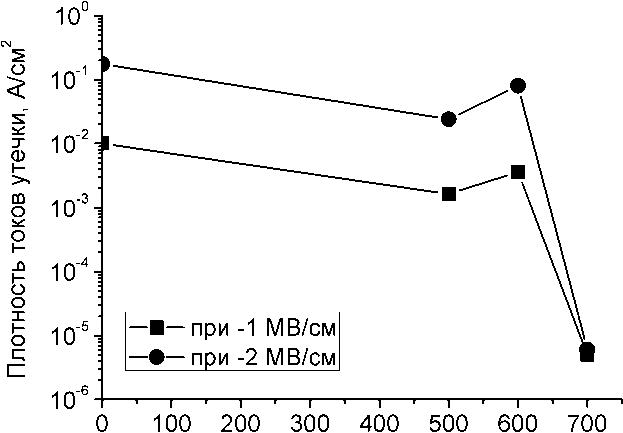
Температура БТО, °C
Рис. 7. Зависимость плотности токов утечки Ті0.3АБ.7О^-пленок толщиной ~ 3 нм при напряженности поля -1 МВ/см и -2 МВ/см от температуры БТО
Исходные и отожженные пленки демонстрируют различные механизмы токопереноса.
При малых электрических полях вольт-амперные характеристики (ВАХ) исходного образца хорошо описываются моделью Шоттки. ВАХ, представленная в координатах Шоттки ln(J) - Е 1/2, при малых Е линейна (рис. 8). Поскольку реальные диэлектрики, в особенности оксиды металлов, содержат собственные структурные дефекты — кислородные вакансии [3], величина потенциального барьера для инжекции электронов из металла в зону проводимости диэлектрика (в сравнении с бездефектным диэлектриком) существенно понижается. Высота барьера Шоттки, вычисленная из экспериментальных данных, составляет 0.82 эВ.
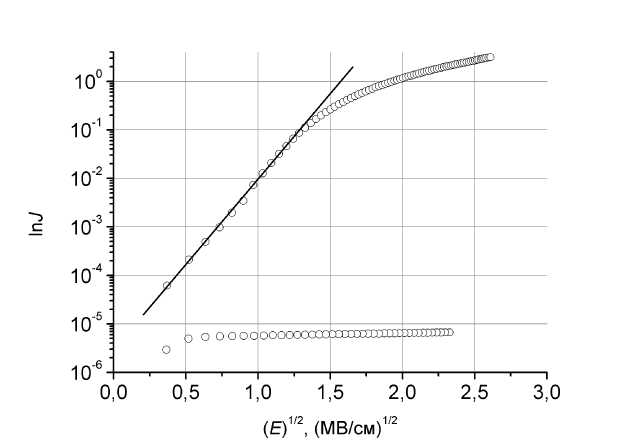
Рис. 8. ВАХ исходной Ti0.3А10.7О^-пленки толщиной ^ 3 нм в координатах Шоттки
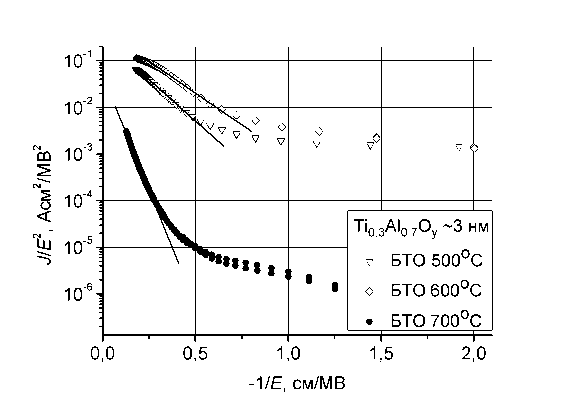
Рис. 9. ВАХ исходной и отожженных Ti0.3AI0.7О^-пленок толщиной ~ 3 нм в координатах Фаулера-Нордгейма
Известно, что ВТО при температурах выше 300 °C приводит к насыщению вакансий кислорода [13], обеспечивающих проводимость диэлектрических слоев, что в свою очередь уменьшает проводимость тонкой пленки Ti0.3AI0.7О^. Было установлено, что токи утечки пленки после БТО при 500 и 600 °C при малых значениях напряженности поля (до -0.6 МВ/см) определяются прямым туннелированием носителей (рис. 6), а при средних и больших полях (0.6-5.0 МВ/см) — эмиссией горячих носителей (механизм Фаулера-Нортгейма) из Si-подложки в Al-электрод через диэлектрический слой толщиной 3-5 нм (рис. 9).
При температурном переходе БТО от 600 к 700 °C токи утечки Ті0.3АІ0.7Оу-пленки уменьшаются на три порядка величины, что связано с увеличением переходного слоя SiOж до ~3 нм. Добавление дополнительного потенциального барьера одновременно с насыщением кислородных вакансий приводит к тому, что при малых и средних полях (до -3.5 МВ/см) токи утечки соответствуют прямому туннелированию через потенциальный барьер, а при больших полях (3.5-6.7 МВ/см) — эмиссии горячих носителей.
Таким образом, БТО приводит к залечиванию дефектов (кислородных вакансий) в Ті0.3AI0.7Oу-пленках толщиной ~ 3 нм, являющихся источниками носителей собственного заряда диэлектрического слоя, и увеличению толщины переходного слоя SiOж, в результате чего ток утечки уменьшается на три порядка величины. Было установлено, что оптимальная температура БТО составляет 700 °C.
Вывод
Методом АСО с чередованием реакционных циклов ТІО2 и AI2O3 на Si-подложках были выращены гомогенные пленки трехкомпонентного оксида Ті0.3АІ0.7Оу толщиной 3-40 нм. Исходные пленки аморфны независимо от толщины. БТО приводит к кристаллизации пленок толщиной ~40 нм, более тонкие пленки остаются аморфными. В зависимости от толщины диэлектрическая проницаемость отожженных пленок составляет к = 14-19. Значение СЕТ-пленки толщиной ~3 нм составляет 1.4 нм. На границе раздела Ti0.3Al0.7Oy-Si в течение АСО-процесса образуется переходный слой SiO ж толщ иной ~0.6 нм, увеличивающийся в результате БТО до 3,0 нм, что в конечном итоге уменьшает токи утечки на три порядка величины. Оптимальная температура БТО с точки зрения наибольшей величины к и наименьших токов утечки составляет 700 °C.
Работа выполнена в рамках реализации ФЦП «Научные и научно-педагогические кадры инновационной России» на 2009-2013 годы с использованием оборудования Центра коллективного пользования МФТИ и НОЦ «Нанотехнологии» МФТИ.
Список литературы Структурно-химические и электрофизические свойства тонких пленок Ti03Al0.7OY, полученных методом атомно-слоевого осаждения
- Auciello O., Fan W., Kabius B., Saha S., Carlisle J.A., Chang R.P.H., Lopez C., Irene E.A., Baragiola R.A. Hybrid titanium-aluminum oxide layer as alternative high-k gate dielectric for the next generation of complementary metal-oxide-semiconductor devices//Appl. Phys. Lett. -2005. -V. 86. -P. 042904-042906.
- Shi L., Xia Y.D., Hu B., Yin J., Liu Z.G. Thermal stability and electrical properties of titanium-aluminum oxide ultrathin films as high-k gate dielectric materials//J. Appl. Phys. -2007. -V. 101. -P. 034102-034105.
- Mikhelashvili V., Eisenstein G. Composition, surface morphology and electrical characteristics of Al2O3-TiO2 nanolaminates and AlTiO films on silicon//Thin Solid Films. -2006. -V. 515. -P. 346-352.
- Puurunen R.L. Surface chemistry of atomic layer deposition: A case study for the trimethylaluminum/water process//J. Appl. Phys. -2005. -V. 97. -P. 121301-121362.
- Алехин А.П., Лапушкин Г.И., Маркеев А.М., Сигарев А.А., Токнова В.Ф. Атомно-слоевое осаждение тонких пленок диоксида титана из тетраэтоксититана и воды//Поверхность. Рентгеновские, синхротронные и нейтронные исследования. -2010. -№. 5. -С. 23-27.
- Alekhin A.P., Chouprik A.A., Gudkova S.A., Markeev A.M., Lebedinskii Y.Y., Matveyev Y.A., Zenkevich A.V. Structural and electrical properties of Ti𝑥Al1-𝑥O𝑦thin films grown by atomic layer deposition//J. Vac. Sci. Tech. B -2011. -V. 29. -P. 01А302-1-6.
- Schroder D.K. Semiconductor material and device characterization. -Third edition. -New York: John Wiley and Sons, 2006.
- Bae S.H., Lee C.H., placeClark R., Kwong D.L. MOS characteristics of ultrathin CVD HfAlO gate dielectrics//IEEE Electron Device Lett. -2003. -V. 24. -P. 556-558.
- Kukli K., Ritala M., Lu J., Harsta A., Leskela M. Properties of HfO2 Thin Films Grown by ALD from Hafnium tetrakis(ethylmethylamide) and Water//Journal of the Electrochemical Society. -2004. -V. 151. -P. F189-F193.
- Wilk G.D., Wallace R.M., Anthony J.M. High-𝜅 gate dielectrics: Current status and materials properties considerations//J. Appl. Phys. -2001. -V. 89 -P. 5243-5276.
- Vogel E.M., Ahmed K.Z., Hornung B., Henson W.K., McLarty P.K., Lucovsky G., Hauser J.R., Wortman J.J. Modeled tunnel currents for high dielectric constant dielectrics//IEEE Trans. Electron Devices -1998. -V. 45 -P. 1350-1355.
- Mikhelashvili V., Brener R., Kreinin O., Shneider J., Eisenstein G. Characteristics of metalinsulator-semiconductor capacitors based on high-k HfAlO dielectric films obtained by lowtemperature electron-beam gun evaporation//Appl. Phys. Lett. -2004. -V. 85 -P. 5950-5952.


