Влияние окисной пленки на коэффициенты распыления кремния
Автор: Раббимов Э.А., Жраева Н.М., Ахмаджонова У.Т.
Журнал: Экономика и социум @ekonomika-socium
Рубрика: Основной раздел
Статья в выпуске: 6-2 (73), 2020 года.
Бесплатный доступ
Основной целью данной работы являлось изучение влияния внедренных атомов Ba на коэффициент распыления поверхности кремния и изучение влияния ионной бомбардировки на разрушение тонкой окисной пленки формирующийся на поверхности Si.
Вакуум, оже-электронной спектроскопии, высокотемпературным прогревом, монте-карловская модель
Короткий адрес: https://sciup.org/140252612
IDR: 140252612 | УДК: 004.02:004.5:004.9
Effect of oxide film on silicon spray coefficients
The main goal of this work was to study the effect of embedded Ba atoms on the sputtering coefficient of the silicon surface and to study the effect of ion bombardment on the destruction of a thin oxide film formed on the Si surface.
Текст научной статьи Влияние окисной пленки на коэффициенты распыления кремния
EFFECT OF OXIDE FILM ON SILICON SPRAY COEFFICIENTS
Rabbimov Eshboy Azimovich
Associate Professor, Jizzakh Polytechnic Institute Jizzakh, Uzbekistan
Juraeva Nasiba Mardievna
Senior Lecturer, Jizzakh Polytechnic Institute
Akhmadjonova Umida Tozhimurodovna
Assistant, Jizzakh Polytechnic Institute, Jizzakh, Uzbekistan annotation
Monte Carlo model
Бомбардировка чистого Si и Si с окисной пленкой проводились ионами Ba+, Si+ и Ar+ с энергией Е0 = 0,5 – 5 кэВ перпендикулярно к поверхности при вакууме не хуже, чем 10-5 Па. Состав поверхности и приповерхностных слоев изучались методом оже-электронной спектроскопии (ОЭС). Профили распределения атомов по глубине определялись методом ОЭС в сочетании с травлением поверхности ионами Ar+ с Е0 = 3 кэВ. Перед ионной бомбардировкой образцы Si (111) очищались высокотемпературным прогревом.
Расчеты выполнялись с использованием статических моделей и алгоритмов, разработанных Т.С. Пугачевой, где использовалась динамическая монте-карловская модель CASNEW-D [1]. В этой модели рассматривается изменение концентраций всех компонент (в том числе и имплантируемой примеси) в каждом слое толщиной порядка межатомного расстояния. Такое изменение происходит за счет каскадного перемешивания, распыления, а также релаксации концентрационных напряжений, возникающих при больших дозах облучения. На рис. 1 приведены экспериментальные и расчетные профили распределения атомов Ba в Si для Si, имплантированного ионами Ba+ с Е0 = 1 кэВ при дозах D = 5·1015, 1016 и 8·1016 см-2 [2]. Видно, что с повышением дозы распределение стремится к ступенчатому.

Рис. 1. Расчетные (1′ – 3′) и экспериментальные (1 – 3) зависимости атомной концентрации Ва по глубине Si для Е 0 = 1 кэВ при дозах D, см-2: 1, 1′ – 6·1015, 2, 2′ – 1016, 3, 3′ – 2·1016, 4′ – 8·1016.
Экспериментальные результаты показали, что начиная с D = 2·1016см-2с ростом дозы ионов концентрация Ba немного увеличивается лишь на поверхности и вблизи нее. При высоких дозах облучения наступает насыщение. В расчетах насыщение наступает начиная с D = 4·1016 см-2, а в эксперименте – с D = 8·1016см-2. Грубые расчеты выполненные согласно формуле показали, что при Е0 = 1 кэВ и r = 0,6, значение Спред=0,58 (58 ат.%), что близко соответствует точному расчету (СBa = 52ат.%) и экспериментальным данным (СBa = 49 ат.%).
На рис. 2 приведены расчетные кривые зависимости парциальных коэффициентов распыления атомов Si и Ba от дозы облучения, происходящие при бомбардировке Si ионами Ba+ с Е0 = 1 кэВ [2]. Видно, что при низких дозах ионов (D ≤ 5·1015 см-2) с ростом дозы коэффициент распыления Si почти линейно растет, а начиная с D= 1016см-2 заметно не меняется.
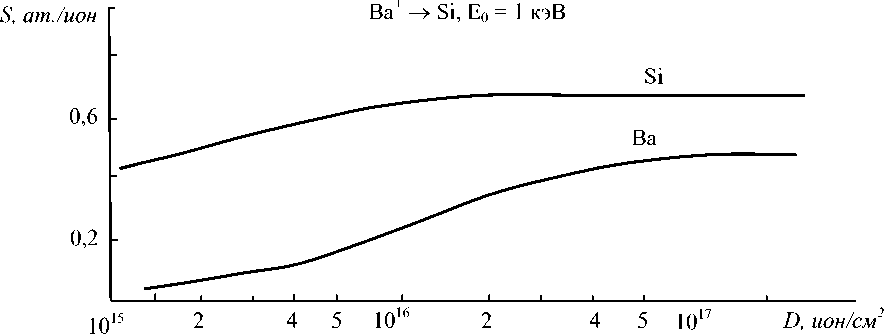
Рис. 2. Зависимость от дозы парциальных коэффициентов распыления Si и Ba для Е 0 = 1 кэВ.
Одновременно в поверхностном слое концентрация атомов Ва увеличивается, соответственно в интервале доз от ~ 5·1015 см-2 до ~ 5·1016 см-2 увеличивается коэффициент их распыления. При высоких дозах (D ≥ 5·1016 см-2) наступает насыщение, т.е. начиная с определенной дозы не меняется концентрация примеси в поверхностном слое и парциальные коэффициенты распыления Si и Ba стабилизируются на определенном уровне.
Список литературы Влияние окисной пленки на коэффициенты распыления кремния
- Pugacheva T.S., Jurabekova F.G., Lem S.A., Miyagawa Y., Valiev S.Kh. // Nucl. Instrum. Methods. Phys. Res. B. 1997. V. 127 - 129. P. 260.
- Рузибаева М.К., Умирзаков Б.Е. Исследование профиля распределения имплантируемой примеси при высоких дозах облучения. XXII Международная конференция взаимодействие ионов с поверхностью «ВИП-2015». Москва, Россия. 20 - 24 августа 2015 г. с. 183 - 185.


