Желатин-глицериновые "красные" регистрирующие системы с метиленовым голубым
Автор: Выговский Ю.Н., Дработурин П.А., Коноп А.Г., Коноп С.П., Малов А.Н.
Журнал: Компьютерная оптика @computer-optics
Рубрика: Технологии компьютерной оптики
Статья в выпуске: 18, 1998 года.
Бесплатный доступ
Короткий адрес: https://sciup.org/14058369
IDR: 14058369
Текст статьи Желатин-глицериновые "красные" регистрирующие системы с метиленовым голубым
При использовании для изготовления дифракционных оптических элементов технологии фотолитографии одним из ответственных этапов является травление. Традиционным способом травления является жидкостное травление. Этот способ хорошо отработан и используется давно, но он имеет ряд ограничений, которые невозможно обойти [1]. Например. подтравливание под край маски (клин травления) ограничивает минимальный размер элемента структуры по площади и его высоту. При жидкостном травлении трудно обеспечить контролируемость и управляемость технологических процессов. Жидкостное травление предъявляет жесткие требования к адгезии и стойкости фоторезиста или другого маскирующего материала, используемого в процессе травления. Плазменное или ‘ ’сухое” травление позволяет во многих случаях обойти эти ограничения. а также дает новые технологические возможности, недоступные при жидкостной проработке рельефа. Например, перенос рельефа со сложной (наклонной и др.) формой поверхности, полученной в фоторезисте, в твердый субстрат; или травление таких стойких материалов как сапфир (А12О3 - мо нокристаллический). Для работы нами была использована опытно-промышленная установка травления пластин в ВЧ разряде с магнитным полем, применяемая для электронной литографии, которая позволяет получать размеры элементов с разрешением 0,1 мкм. Она предназначена для промышленного травления пленок алюминия, а также для травления поликремния, нитрида кремния и оксидов металлов в лабораторных условиях. Данное оборудование обеспечивает регулирование давления в рабочей камере в диапазоне 0,065 + 1,3 Ра, регулировку падающей ВЧ мощности при работе на разрядную камеру в диапазоне от 100 до 700 Вт и поддержание ее с погрешностью ±10%. Важно, что установка обеспечивает напуск газа по четырем каналам в широких пределах и поддерживает расход газовой смеси с высокой точностью, снабжена системой подачи части В Ч мощности на рабочий столик и магнитной системой стабилизации плазмы.
Приведенные выше параметры технологического оборудования позволяют вести травление пластин кремния диаметром до 150 мм с равномерностью травления слоев ± 5%, что является существенным для нашей работы.
На рис. 1 показана схема рабочего объема установки. При подаче на рабочий столик части ВЧ мощности от генератора возникает смешанный режим туннель-пролетного ВЧ реактора с реактором диодного типа.
13,36 МГц геиераюр
Рис. 1
Схема рабочего объема плазмохимической установки: 1- ВЧ индуктор; 2- генератор ВЧмощности (1 кВт,
13,56 МГц); 3- обрабатываемый образец; 4-водоохлаждаемый поворотный рабочий столик (подложкодержатель); 5- электромагнитная катушка; 6- система подачи и смешивания газов в рабочий объем.
Изготовление субмикронного дифракционного рельефа в кремнии С целью получения высокоэффективной, делящей на пучки неодинаковой интенсивности и отклоняющей на большие углы падающее излучение, отражающей дифракционной решетки для длины волны X = 590 нм, был проведен расчет численными методами [2,3] который дал следующие параметры рельефа элемента: период решетки d « 0,6 мкм, высота ступени h » 0,1 мкм.
Для изготовления такого элемента было решено использовать кремний (полированные пластины d = 100 мм, марки КДБ-4,5), т.к. он обладает высокой скоростью травления в плазме. "Сухое" или плазменное травление применялось из-за возможности получить профиль рельефа лучшего качества путем анизотропного травления и из-за возможности четкого контроля высоты ступени при травлении. Травление в жидких реагентах было неприменимо также из-за плохой адгезии резиста и неполной его проработки. Исходный рисунок решетки получали с помощью электронного литографа в слоях фоторезиста толщиной около 0,1 мкм. Резист наносился непосредственно на полированные пластины кремния, в которых через маску из проявленного резиста и получали "сухим" травлением необходимый рельеф. Для переноса рельефа через маску с заданной высотой ступени необходимо подобрать такой режим чтобы:
-
а) скорость разрушения резистивной маски позволяла бы получить в твердом материале необходимую высоту' ступени (в данном примере скорость
травления резиста Ур не должны превышать скорость травления кремния VK: Vp<, ^ „ vK , где То - время процесса);
-
б) обеспечивалось полирующее травление кремния без загрязнения поверхности образца про-дук-тами разложения.
Для травления кремния был использован газовый травитель состоящий из смеси СС12 F2 и О2 в соотношении 5:1 соответственно. Кислород добавляется для того, чтобы увеличить количество химически активных атомов фтора и хлора, а также подавить выделение органических загрязнений на трави-мой поверхности. При травлении кремния, покрытого маской фоторезиста, количество кислорода, добавляемого к основному газу, увеличивалось до 25% с целью подавить дополнительные органические загрязнения, вносимые при разложении фоторезиста.
Добавление 25% смеси не вызывало увеличения отношения скоростей травления кремния к резисту по сравнению с обработкой в чистом разряде ССЬ Р2, лишь увеличивало эти скорости пропорционально. Чтобы исключить перегрев и деградацию маски из электронного фоторезиста и дтя получения стабильного повторяемого воздействия плазмы, все процессы обработки образцов велись при мощности разряда около 350 Вт. Вносить изменения в процесс оказалось необходимым только при выборе способа подаче этой ВЧ мощности в рабочий объем (см. ниже). Давление газовой смеси во всех процессах было примерно одинаковым и составляло -1 Ра. Поскольку предварительные эксперименты со слоями фоторезиста, нанесенными на кремний, показали, что кремний и эти слои разрушаются со сравнимыми 1 скоростями - было решено проводить процесс травления до тех пор, пока на поверхности пластины кремния присутствует фоторезист. Исходный рельеф, полученный в резисте с помощью электронного литографа, показан на рис. 2. Данное изображение (а также все последующие) получено с помощью сканирующего зондового микроскопа P4-SPM-MDT.
На рис.З показан тот же шраЗсц г чссм^мм Фоторезистом при более высоком увеличении.
видно, что присутствует много нарушений заданной структуры в виде пиков, провалов и т.д„ также видно, что профиль структуры синусоидальный (не П - образный). Эти дефекты связаны с несовершенством технологии получения и проявления сверхтонких слоев фоторезиста с субмикронным рисунком. В данном исследовании параметры профиля в резисте от нас не зависели, т.к. исходные образцы поставлялись по заказу-. Поэтому было важно подобрать режим переноса рельефа "сухим" травлением в кремнии таким образом, чтобы обеспечить расчетную высоту ступени (по оси z) и по возможности улучшить "П - образность" профиля рельефа. Выше-поставленныс задачи можно решить подобрав относительные скорости травления резиста и кремния и обеспечив анизотропию травления по оси г. Такая работа была проведена с контрольными одинаковы- ми образцами размером изображения 25x5 мм2 в резисте на кремнии. Параметры рельефа этих образцов были примерно одинаковы (рис.2).
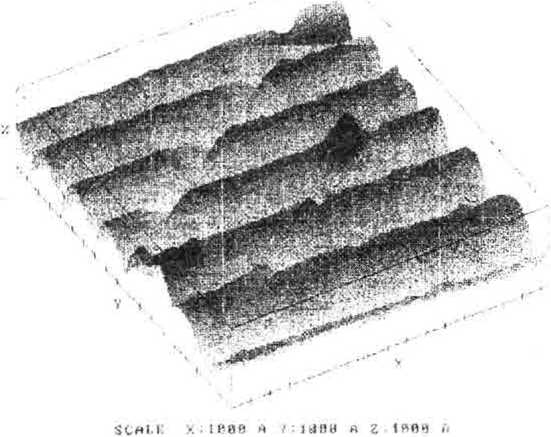
Рис. 2 Исходный микрорельеф в электронном резисте (в одном дечении -0.1 мкм)

. х- ’в^й Л V^eiJO Л ;■ tittle А
Рис. 3 Увеличенный фрагмент исходного микрорельефа (в одном дечении -0,1 мкм)
столик, а в процессах типа 4х она осуществлялась. Различие в воздействии плазмы на образцы можно объяснить увеличением скорости травления резиста относительно кремния при повышении степени физической бомбардировки образцов ионами газов, а также увеличением концентрации химически активных атомов и радикалов непосредственно в области поверхности образца при подаче ВЧ мощности на рабочий столик.
В результате для изготовления необходимого рельефа был выбран режим 5х, еще и потому, что высота получаемого рельефа h по оси z в данном процессе контролировалась с точностью 10 нм.
Окончательно рельеф был получен размером 25x5 мм" в кремниевой пластине. Для изготовления копии решетки с такой кремниевой матрицы в дальнейшем использовался фотополимер с последующим напылением слоя отражающего металла (А1). Таким путем была получена дифракционная решетка площадью 10x10 см2. Оптический эксперимент с изготовленной дифракционной решеткой показал ее хорошую работоспособность и соответствие расчетным параметрам.
На рис.4 и рис. 5 показаны фрагменты решетки, получившиеся в кремнии с исходных образцов, которые обрабатывались при разных режимах плазменного травления (назовем их режим 4х и 5х соответственно).
При работе в режиме 4х скорость травления резиста на порядок выше, чем скорость травления кремния, хотя исходная форма, заданная рисунком резиста, переносится в кремний. На рис. 6 показан фрагмент такого рельефа с большим увеличением. На рисунке 4 хорошо заметен конусообразный дефект. обусловленный загрязнением исходного образца пылинкой.
Режим 5.x показал, что скорости травления резиста и кремния в данном случае примерно одинаковые. На рис.7 показан с высоким увеличением рельеф. полученный в таком процессе.
Типичное время режима 4х - около 10 минут, а процесса 5х - 40 минут. Основным отличием 4х от 5х было в том. что при 5х не было подачи части мощности ВЧ - генератора (см. рис.1) на рабочий
Рис. 4 Микрорельеф в кремнии, полученный при подаче части ВЧ-моищости на подложкодержатель

I^c. 5 Микрорельеф в кремнии, полученный без подачи ВЧ-мощности на подложкодержатель

а Я Н Н 4; |* t И *1Р Я 2 1 d Н J А

scale x inae я у таи a .<: my a
Рис. 6 Фраг.меиш .микрорельефа (рис. 4) с Гюлышсн разрешением

Рис. ^ Фрагмент .микрорельефа (рис. 5) с Ju няшен ри .решением
Благодари ость
Работа выполнена при поддержке Российского фонда фундаментальных исследований (грант № 96-15-96026) и Министерства науки и технологий России, обеспечившего исследования ИСОИ РАН сканирующим зондовым микроскопом производства ТОО «Нанотехнологии МДТ».


