Анализ способов снижения LER-эффекта при создании фотонных интегральных схем
Автор: Кульпинов М.С., Лосев В.В., Балашов А.Г., Переверзев А.Л., Красюков А.Ю.
Журнал: Международный журнал гуманитарных и естественных наук @intjournal
Рубрика: Технические науки
Статья в выпуске: 11-2 (98), 2024 года.
Бесплатный доступ
В работе проведен анализ способов и экспериментальных технологий по уменьшению неровностей фоторезистивной маски, воздействующие на характеристики ФИС, связанные с оптимизацией процесса фотолитографии, использование специализированных материалов и технологий их нанесения при формировании слоев антиотражающих покрытий и жесткой маски, применение дополнительных технологий и способов обработки поверхности формируемых слоев.
Неровности края линии фоторезиста, ler-эффект, фотонные интегральные схемы
Короткий адрес: https://sciup.org/170208874
IDR: 170208874 | DOI: 10.24412/2500-1000-2024-11-2-229-232
Analysis of ways to reduce the LER effect when creating photonic integrated circuits
The paper analyzes methods and experimental technologies to reduce the irregularities of the photoresistive mask, affecting the characteristics of the FIS associated with the optimization of the photolithography process, the use of specialized materials and technologies for their application in the formation of layers of anti-reflective coatings and rigid masks, the use of additional technologies and methods of surface treatment of the formed layers.
Текст научной статьи Анализ способов снижения LER-эффекта при создании фотонных интегральных схем
По мере того, как размеры устройств и элементов в полупроводниковой промышленности продолжают уменьшаться, технология формирования топологического рисунка элементов с малыми линейными размерами приобретает все большее значение при изготовлении современных интегральных схем. Существующие методы создания топологического рисунка в фоторезистивной маске (ФРМ)
могут привести к образованию неровностей края линии и шероховатостей боковых стенок фоторезиста [1].
Известно, что LER-эффект характеризует величину шероховатости или неровности краев фоторезистивных масок, создаваемых в процессе производства полупроводников и определяет отклонение краев элементов маски от идеальной прямой линии (рис. 1).

Рис. 1. SEM-изображение LER-эффекта
LER-эффект особенно критично проявляется в области производства фотонных интегральных схем (ФИС), где неровности боковых стенок волноводов оказывают влияние [2], во-первых на увеличение оптических потерь в волноводе, особенно в волноводах меньшего размера, где эффекты рассеяния и искажения более существенны, во-вторых, на дисперсию оптического сигнала (неровности линии края могут вносить поляризационную зависимость в устройства ФИС, что важно для устройств, чувствительных к поляризации), в-третьих, на снижение эффективности связи между волноводами, соединителями и другими оптическими компонентами, что сказывается на снижении качества, функциональных возможностей и производительности устройств. Это, в конечном счете, предъявляет повышенные требования ко всем производственным процессам изготовления высокоточных оптических компонентов. При этом, одной из основных проблем при формировании структур ФИС является необходимость существенного повышения качества элементов топологического рисунка в фоторезисте и переноса его в функциональные слои [3].
В последние годы большой интерес вызывают исследования, связанные с разработкой способов уменьшения LER-эффекта [8-9]. Известен способ формирования фоторезистив-ной маски полупроводникового прибора путем атомно-слоевого осаждения. В способе предлагается формирование фоторезистивной маски, который заключается в том, что кремниевая подложка со слоем фоторезиста, в котором сформирован топологический рисунок элементов нагревается до температуры от 80 до 120°C, затем на ее поверхность из газовой фазы распыляется органический растворитель, который осаждается на рельеф фоторезиста и сглаживает гребешки шероховатостей линий преимущественно на боковых стенках фоторезиста, что приводит к уменьшению неровностей бокового рельефа фоторезистивной маски (рис. 2). Данный процесс позволяет уменьшить величину шероховатости боковых стенок в верхней части рельефа, но при этом неровности края фоторезистивной маски на горизонтальной поверхности подложки остаются неизменными.

Рис. 2. SEM-изображение уменьшения LER путем атомно-слоевого осаждения
В одном из способов с помощью химического осаждения из газовой фазы на подложку осаждается дополнительный слой (металл или кремнийсодержащий материал), используемый в дальнейшем в качестве жесткой маски, на котором формируется фоторезистивная маска, представляющая собой топологический рисунок структуры, рельеф которой характеризуется толщиной фоторезиста, шероховатостью боковой поверхности и неровностью края линии в донной части рельефа. При плазменном травлении дополнительного слоя через фоторезистивную маску и последующем ее удалении в кислородосодержащей плазме на поверхности подложки остается жесткая маска, характеризующаяся меньшей величиной неровностей и шероховатостей линий, по сравнению с первоначально сформированной фоторезистивной маской. Использование данного способа позволяет незначительно минимизировать шероховатость боковой поверхности и неровность края линии в донной части рельефа [10-11].
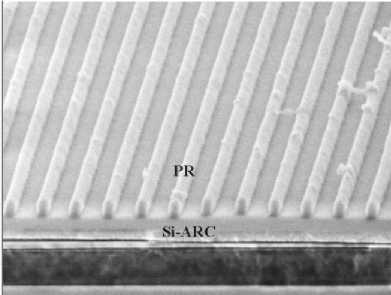
Рис. 3. SEM-изображение уменьшения LER с помощью химического осаждения
На рисунке 4 представлен способ, позволяющий уменьшить LER-эффект за счет использования плазмоактивированного атомнослоевого осаждения, которое позволяет конформно наносить слой материала, повторяющий контур топологического рельефа. После этого следует плазменное травление осажденного слоя, позволяющее частично сгладить неровности и шероховатости поверхности контура исходной маски. Для усиления эффекта необходимо многократно и циклично повторять данную последовательность операций [12-13]. Этот способ полностью не решает проблему возникновения неровностей краев линий фоторезистивной маски, но приводит к потере производительности процесса формирования наноразмерных структур [14].

Рис. 4. Схематическое представление процесса уменьшения LER-эффекта:
а – структура со сформированной фоторезистивной маской до плазмоактивированного осаждения выравнивающего слоя, б – структура со сформированной фоторезистивной маской после
плазмоактивированного осаждения выравнивающего слоя
Таким образом, в ходе выполнения работы ческих стадий процесса фотолитографии, ис- проанализированы. экспериментальные технологии снижения LER-эффекта при формировании фоторезистивной маски и показано, что оптимизация и совершенствование крити- пользование специализированных материалов, дополнительных плазменных обработок поверхности формируемых слоев позволяют уменьшить влияние LER-эффекта.
Список литературы Анализ способов снижения LER-эффекта при создании фотонных интегральных схем
- Патент Российской Федерации RU 2 827 959 C1.
- Nanofabrication: Principles, Capabilities and Limits, Zheng Cui, Springer, 2017, 343 р.
- Kim I, Park S, Jeong C, Shim M, Simulator acceleration and inverse design of fin field-effect transistors using machine learning. Scientific Reports. 2022.
- Chen H. et al. "Line Edge Roughness Modeling for Continuous Time-space Resist Simulations", 2024 2nd International Symposium of Electronics Design Automation (ISEDA), Xi'an, China, 2024.
- Kao M.Y., Kam H., Hu C. Deep-Learning-Assisted Physics-Driven MOSFET Current-Voltage Modeling. IEEE Electron Device Letters. 2022.


