Физико-химические основы выращивания варизонного полупроводникового Si1-xGex твердого раствора из жидкой фазы
Автор: Раззаков Алижон Шоназарович, Матназаров Анвар Рустамович, Латипова Муборак Аманбаевна, Жапаков Азамат Икромбоевич
Журнал: Бюллетень науки и практики @bulletennauki
Рубрика: Химические науки
Статья в выпуске: 9 т.6, 2020 года.
Бесплатный доступ
Выращены монокристаллические пленки варизонного твердого раствора Si1-xGex (01-xGex, выращенных при различных технологических условиях, а также влияние кластерообразования в растворе, кристаллическая совершенность структуры пленок при росте. Приведены оптимальные технологические режимы роста, для получения кристаллических совершенных эпитаксиальных слоев и структур.
Эпитаксия, кристаллизация, раствор-расплав, твердый раствор, дислокация, подложка, седиментация, дисперсная фаза, дисперсионная среда, ультрамикрогетерогенная, кластер
Короткий адрес: https://sciup.org/14117869
IDR: 14117869 | УДК: 548.31 | DOI: 10.33619/2414-2948/58/01
Physico-chemical bases cultivation variable-gap semiconductor solid solution Si1-xGex from the liquid phase
Single-crystal films of a graded-gap solid solution Si1-xGex (0 1-xGex solid solution was studied. Optimal technological growth modes for obtaining crystalline perfect epitaxial layers and structures are given.
Текст научной статьи Физико-химические основы выращивания варизонного полупроводникового Si1-xGex твердого раствора из жидкой фазы
Бюллетень науки и практики / Bulletin of Science and Practice
УДК 548.31
cc) 0
Получить тонкопленочный структурно совершенный полупроводниковый твердый раствор с заданными электрофизическими и фотоэлектрическими свойствами на дешевую подложку как кремний является весьма актуальной. Поэтому авторы старались получить структурно совершенные Si 1-x Ge x эпитаксиальные слои и гетеропереходы Si - ( Si2\ - x - y ( Ge 2 ) x (GaAs ) y , Si - Sh - xGex - ( Ge2\ - x ( GaAs ) x , Si - Si^ x Ge x - GaAs на их основе [13]. Для этого они исследовали технологические режимы роста и электрические, фотоэлектрические свойства эпитаксиальных слоев Si1-xGex и структур.
В процессе роста из жидкой фазы эпитаксиальных слоев Si 1-x Ge x используются кремниевые подложки, которым параметр решетки и коэффициент термического расширения (КТР) близки к образующим эпитаксиальным слоям. Подбирались разные методы и переменный варизонный состав твердого раствора чтобы избегать от дислокаций и микротрещин, частные растворения подложек (при положении недопересыщенного раствора к компонентам подложки) и т. д.
Однако, до настоящего времени режимы технологического роста такой системы изучены крайне недостаточно, особенно те, которые связаны с физическими и химическими свойствами выращиваемого раствора-расплава. В работе показаны, результаты исследований температурного состава раствора-расплава (Sn+Ge+Si, Ga+Ge+Si) используя, экспериментальные данные, а также теоретические формулы и расчеты полученные на основе литературы. Использованы апробированные экспериментальные научные методы. Обычно, используются подложки с определенными наименьшими уклонами во время роста пленок из жидкой фазы, которые, способствуют образованию эпитаксиальных слоев на поверхности (в нашем случае в качестве подложек были использованы монокристаллические Si (111) с отклонением — (0*15 I + 0*30I) - (0*15 I + 0*30 I ) n-типа проводимости) подложке. Любая поверхность твердого тела имеет определенную шероховатость, поэтому поверхностная энергия распределяется неравномерно и влияет на выращивание твердого раствора на подложке, а также на образование дислокаций, которые связаны с технологическими параметрами, как температура начала кристаллизации (Т нк ), скорость роста (υ), зазор между подложками (δ), состав компонентов в растворе-расплаве, с ориентациями подложек и т. д.
Для выращивания варизонноготвердого раствора Si Ge (0 Смачивание подложки со стороны раствора и диффузионные движения компонентов образующие твердый раствор способствует росту эпитаксиальных слоев, это приведено нами в работе [4]. Но это недостаточно для выращивания структурно совершенных Si1-xGex эпитаксиальных слоев и гетероструктур на их основе. Проведя эксперименты было выяснено: изменяя зазор между подложками δ (то есть изменяя объем раствора-расплава между подложками), при одинаковом режиме роста выращенные эпитаксиальные слои на нижних и на верхних подложках не отличились друг от друга с кристаллическими совершенностями на поверхности и на границе подложки-пленки до δ=1,2 мм. В условиях δ>1,2 мм всегда у верхних подложек образуются толстые и более низкокачественные слои, чем у нижней, который связан с диффузионным и с конвекционным потоком компонентов в ограниченном растворе (если плотность растворяемых компонентов меньше плотности растворителя) [5]. В литературе это объясняется массаподводом, конвекционным потоком раствора между подложками в поле силы тяготения [6]. Считаем, что в поле взаимодействует сила Архимеда и тяготения, а также диффузии большой концентрацией Si и Ge накапливается вблизи поверхности у верхней подложки, чем у нижнего, который ускоряет скорость роста эпитаксиальных слоев Si1-xGex. Для выращивания эпитаксиальных слоев, то есть повторение направления ориентации подложки со стороны выращиваемого слоя, должно выполнятся в минимальных условиях образования ячейки монокристалла, значит число атомов в одном квазичастиц должно быть в пределах от 1 до 14, не образуя совершенный элементарный ячейки Si, Ge или Si1-xGex. Только в этом случае мы сможем получить монокристалл из раствора-расплава. Но во время начала кристаллизации эпитаксиальных слоев из жидкой фазы, сначала идет подготовка к росту, что называется гомогенизацией, и потом при температуре насыщение раствора-расплава (это определяется из диаграмм состояний компонентов в определенном температуре) загружаются подложки с помощью графитовой кассетой и выращивается монокристалл из раствора. При выращивание эпитаксиальных слоев компоненты твердого раствора кремний и германий участвуют в виде атома и молекулы [7–8]. Одновременно, некоторые атомы успеют объединяться за счет процесса коагуляции (чем больше температура, тем больше число коагуляции) одинаковых компонентов раствора и образуют нанокластеры с размерами 1–10 нм, теоретически рассчитано нами использовав формулу Эйнштейна–Смолуховского, который составляет часть доли 0,01–0,02% всего растворенных элементов. Эти нанокластеры участвуя в процессе роста, с наименьшими концентрациями, чем выращиваемых компонентов не разрушают монокристалличность варизонного твердого раствора, но способствуют на образование дислокаций и на границу подложки-пленки и вдоль направления роста пленки, который ухудшает кристаллический совершенность пленок и структур, соответственно их нее электрофизические и фотоэлектрические свойства являющиеся важнейшими параметрами в применении приборостроения. Учитывая вышеуказанное мы можем предположить атомы Si и Ge внутри раствора образуя достаточно малое число молекулярных или миникластерных соединений участвующие в кристаллообразовании и доминирует в процессе увеличения плотности дислокаций. Особенно на эпитаксиальных слоев пленки выращенных на верхней подложке, который объясняется результатом силы Архимеда и тяжести, который проявляется укрупнением нанокластера и является незначительной величиной, хотя там доминирует диффузионный процесс атомов и молекул. Скопление на верхней поверхности растворов вблизи подложек нанокластеров, и беспорядочные диффузионные их нее движение способствует, участие во время роста, и соответственно образование дислокаций. Применение седиментационного анализа для определения размеров частиц высокодисперсной, (ультрамикрогетерогенных) фазы дала возможность определить r-радиус частиц и состояние компонентов Si, Ge в растворе с помощью следующей формулы [9]: r= 9ndm 2gm0(Рдф - Рдср )t' где, m’ — масса компонентов на поверхности подложек, t - различные моменты времени от начала крисстализации, d — путь седиментации, ш0- общая масса компонентов дисперсной фазы в объеме дисперсионной среды, п — вязкость раствора, р, Рдср — плотность дисперсионной среды и частиц дисперсной фазы, соответственно, g — ускорение свободного падения. Таким образом, определены размеры кластеров компонента в растворе, которые, связаны с кристаллической совершенностью выращенных эпитаксиальных слоев, зависимо от величины зазора между подложками при разных температурах начало кристаллизации: rSi = 4,4 нм для температуры начало кристаллизации Tнк = 900 °С rSi = 4,71 нм для температуры начало кристаллизации Tнк = 970 °С rSi = 5,55 нм для температуры начало кристаллизации Tнк= 1050 °С Из уравнения Эйнштейна–Смолуховского можно найти перемещение молекулы или кластеры дисперсной фазы в дисперсной системе который, двигается тем быстрее, чем выше температура, меньше размер молекулы или кластера и вязкость дисперсионной среды. - RTt ∆= у 3NАппг R — универсальная газовая постоянная, NA — число Авогадро, η— вязкость, r — радиус молекулы или кластера, k — постоянная Больцмана, T — абсолютная температура, t — время. Диффузия в полной мере проявляется в ультрамикрогетерогенных (высокодисперсных) системах, у которых интенсивность седиментации и диффузии близки, вследствие чего с течением времени в таких системах происходит выравнивание диффузионных и седиментационных потоков Iсед = Iдифф ; и устанавливается седиментационно-диффузионное равновесие, описываемое гипсометрическим законом Лапласа: ( V (Рдф — Рдср )gh n = nо ' exP(--kT ---) С помощью этой формулы вычислено относительное изменение концентрации компонентов (n) в зависимости от расстояния от поверхности верхней подложки в растворе-расплаве (Рисунок 1): — = exp(-0,92 • d), для температуры начало кристаллизации Тнк= 900 °С; n0 — = exp(-1,063 • d) для температуры начало кристаллизации Тнк= 970 °С; — = exp(-1,61 d) для температуры начало кристаллизации Тнк= 1050 °С; n0 Рисунок 1. Относительное изменение концентрации компонентов n в зависимости от n0 расстояния, от поверхности верхней подложки в растворе-расплаве. Из Рисунка 1 видно, с увеличением температуры начало кристаллизации (Tнк) твердого раствора Si1-xGex, относительное изменение концентрации компонентов n n по высоте n0 увеличивается, что объясняется увеличением размера кластера и скорость коагуляции компонентов. Это отличие явно наблюдается при большом размере между подложками (d), особенно на поверхности верхних подложек. Кластерообразования компонентов в растворе зависимо от его размера и от концентрации, отрицательно влияет на кристаллическую совершенность выращиваемого эпитаксиального слоя при выращивания полупроводникового Si1-xGex твердого раствора из жидкой фазы. А также исследуя образования дислокаций, во время выращивания твердого раствора при разных технологических процессах, наблюдается 2 варианта (кроме классических общеизвестных факторов влияющие на образование дислокаций, таких как чистота и достаточно наименьшие шероховатости на поверхности подложки, отсутствие других чужих летучих и растворимых компонентов в системе и в растворе): а) если при температуре насыщения раствора-расплава по отношению своих компонентов начинается процесс роста, то относительно большая плотность дислокаций эпитаксиальных слоев, будет на границе подложки-пленки и уменьшается вдоль направления роста до поверхности пленки б) если при температуре начала кристаллизации составляющие компоненты раствора является не насыщенным по отношению к подложке в) компоненты раствора кремний и германий, подложка — кремний и в тоже время начинается рост, в том случае рост начинается с частичным подрастворением подложек. Тогда плотности дислокаций сначала плавно увеличиваются вдоль направления роста до определенной толщины пленки и потом уменьшается до поверхности пленки. Выращенные варизонные эпитаксиальные слои имеют волнистую поверхность по распределении компонентов вдоль направления роста. Оба случаи уменьшение плотности дислокаций в направлении роста, связано сглаживанием несоответственных решеток подложки и пленки. Были получены зеркально гладкие эпитаксиальные слои полупроводникового твердого раствора Si1-xGex и определены оптимальные режимы роста для выращивания кристаллических совершенных Si1-xGex эпитаксиальных слоев из ограниченного оловянного раствора-расплава на монокристаллических подложках Si с ориентацией (111), которыми являются следующие технологические параметры: –температуры в начале кристаллизации (Tнк) варьировались в интервале от Tнк = 900 °С до Tнк = 1050 °С; –принудительные охлаждения раствора-расплава со скоростью 0,5–1,5 град/минут. –зазор между подложками (соответствуя на высоту раствора-расплава) в интервале 0,5– 1,5 мм. Теоретические, экспериментальные исследования кристаллообразования при выращивании варизонных твердых растворов Si1-xGex из ограниченного оловянного, галлиевого раствора-расплава на кремниевые (относительно дешевые) подложки и получение кристаллически совершенных эпитаксиальных слоев с наименьшими плотностями дислокации является перспективным. Варизонные пленки Si1-xGex можно использовать в качестве буферного слоя для сглаживания несоответствий решеток подложки и пленки при получении гетероструктур Si- Si1-xGex -(Ge2)1-x(ZnSe')x, Si- Si1-xGex- (Ge2)1—x—y(Ga As)x(ZnSe)y, Si-Sii—xGex -Gei-xSnx,, Si-Sii—xGex -(Ge2')1-x(Sn^)x, Si-Sii-xGex -^^(GaAs^ ,Si-Sii-xGex -(GaAs^-xtZnSe^, а также как полупроводниковым материалом для изготовления фотоэлектрических приборов.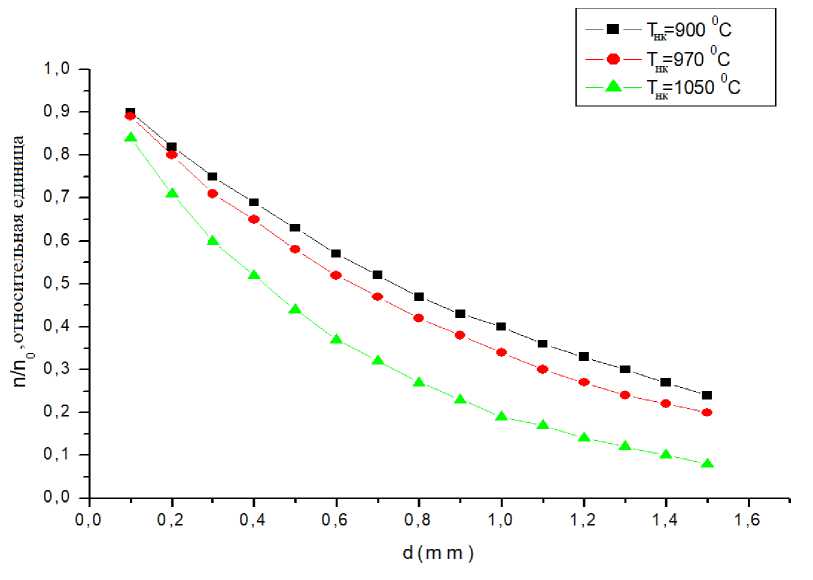
Список литературы Физико-химические основы выращивания варизонного полупроводникового Si1-xGex твердого раствора из жидкой фазы
- Fadaly, E. M. T., Dijkstra, A., Suckert, J. R., Ziss, D., van Tilburg, M. A. J., Mao, C., … Bakkers, E. P. A. M. Direct-bandgap emission from hexagonal Ge and SiGe alloys // Nature. 2020. V. 580. №7802. P. 205-209. DOI: 10.1038/s41586-020-2150-y
- Saidov A. S., Usmonov S. N., Amonov K. A., Niyazov S., Khudayberdiyeva A. I. Photothermovoltaic Effect in p-Si-n-(Si2)1-x-y(Ge2)x(ZnSe)y Structure // Applied Solar Energy. 2019. V. 55. №5. P. 265-268. DOI: 10.3103/S0003701X19050116
- Сапаев Б., Саидов А. С. Исследование некоторых свойств структур Si-Si1-xGex (0≤ x≤ 1), выращенных из ограниченного оловянного раствора-расплава методом жидкофазной эпитаксии // Физика и техника полупроводников. 2005. Т. 39. №10. С. 1183-1188.
- Раззаков А. Ш., Курбанов Д. Ш. Зависимость дислокаций на твердом растворе Si1-xGex от температур роста на контактной фазе "твердое тело-жидкость" // РИАК-XII-2020. Республиканская конференция-2020. С. 275-277.
- Saidov A. S., Razzakov A. S., Risaeva V. A., Koschanov E. A. Liquid-phase epitaxy of solid solutions (Ge2)1-x(ZnSe)x // Materials chemistry and physics. 2001. V. 68. №1-3. P. 1-6. DOI: 10.1016/S0254-0584(00)00230-3
- Боцелев С. П., Марончук И. Е., Марончук Ю. Е. Кристаллизация эпитаксиальных слоев AlGaAs из ограниченного объема раствора-расплава // Неорганические материалы. 1977. Т. 13. №5. С. 769-772.
- Saidov A. S., Usmonov S. N., Kalanov M. U., Kurmantayev A. N., Bahtybayev A. N. Structural and some electrophysical properties of the solid solutions Si1-xSnx (0 ≤ X ≤ 0.04) // Physics of the Solid State. 2013. V. 55. №1. P. 45-53. DOI: 10.1134/S1063783413010290
- Saidov A. S. et al. Photothermovoltaic Effect in p-Si-n-(Si2)1-x-y (Ge2)x(ZnSe)y Structure // Applied Solar Energy. 2019. V. 55. №5. P. 265-268. DOI: 10.3103/S0003701X19050116
- Щукин Е. Д., Перцов А. В., Амелина Е. А. Коллоидная химия. М.: Высш. шк., 2004. 444 с.


