Интеллектуальный анализ данных в пространственном распределении параметров жизнедеятельности в физическом процессе
Автор: Струк П.В.
Журнал: Пространство, время и фундаментальные взаимодействия @stfi
Рубрика: Прикладные аспекты методов фундаментальной науки
Статья в выпуске: 2 (23), 2018 года.
Бесплатный доступ
Сверхбольшая база данных (от английского Very Large Database, VLDB) - это база данных, которая занимает довольно большой объём на физическом устройстве для хранения различных данных.Данная работа показывает моделирование процесса нагрева металлической мишени магнетрона. Для проведения подобных исследований был использован программный пакет Comsol Multiphysics, который способен решать математические и физические задачи при помощи моделирования. Были исследованы зависимости температуры мишени от плотности мощности, для двух металлов - медь и титан. Также для зависимости температуры мишени от времени при разных значениях плотности было проведено сравнение нагрева горячей и холодной мишени.
Пространство, процесс, информация, структура, развитие
Короткий адрес: https://sciup.org/142216017
IDR: 142216017 | УДК: 004.451.53 | DOI: 10.17238/issn2226-8812.2018.2.86-100
Intellectual analysis of data in the spatial distribution of vital activity parameters in the physical process
A very large database (from the English Very Large Database, VLDB) is a database that takes up a rather large volume on a physical device for storing various data.This paper shows the simulation of the heating of a metal target of a magnetron. To conduct such studies, the software package Comsol Multiphysics was used, which is capable of solving mathematical and physical problems by means of modeling. The dependences of the target temperature on the power density were investigated, copper and titanium for the two metals. Also, to compare the temperature of the target against time for different values of the density, a comparison was made between the heating of the hot and cold targets.
Текст научной статьи Интеллектуальный анализ данных в пространственном распределении параметров жизнедеятельности в физическом процессе
Сверхбольшая база, данных (от английского Very Large Database, VLDB) — это база, данных, которая занимает довольно большой объём па. физическом устройстве для храпения различных данных.
-
1 E-mail: pavelstruk@yandex.ru
Само понятие предполагает предельно возможные объёмы БД, которые формируются новейшими достижениями в разработках физического сохранения информации и в разработках программного оперирования данными.
Количественное установление определения «чрезвычайно огромный объём» изменяется во времени; в настоящее время считается, то что это объём, определяемый по меньшей мере петабайтами. Для сопоставления, в 2005 году наиболее большими в пашем обществе считались БД с объёмом хранилища, в режиме 100 терабайт.
Специалисты фиксируют потребность специальных подходов к проектированию сверхбольших БД. С целью их формирования зачастую исполняются специализированные планы с целью поиска, подобных системотехнических решений, которые дали возможность бы хоть как-то действовать с подобными крупными объёмами информации.
Но в основном, нужны специализированные решения для дисковой подсистемы, специализированные версии операционной среды и специализированные аппаратура, обращения СУБД к данным [3]. Изучения в сфере храпения и обработки сверхбольших БД VLDB постоянно пребывают в острие теории и практики баз данных. Например, с 1975 года, идет ежегодная конференция International Conference on Very Large Data. Bases («Интернациональное собрание согласно сверхбольшим базам данных»). Большая часть исследований ведется под эгидой некоммерческой компании VLDB Endowment (Фонд целевого денежных средств «VLDB»), что гарантирует развитие академических работ и обмен данными в сфере сверхбольших БД и смежных сферах.
Высокомощное импульсное магнетронное распыление является прогрессивным методом современной пауки, базирующийся па. положительных аспектах предыдущих способов, таких как классическое магнетронное распыление и дуговое испарение. Данный метод представляет собой довольно новую технику иопизироваппого физического осаждения, осиоваииого на. паровой фазе. При высокомощном распылении очень короткие импульсы большой мощности наносятся на. мишень при очень низких рабочих циклах, таким образом, что средняя мощность остается такой же, как и при магнетронном распылении с постоянным током. Высокомощные короткие импульсы образуют высокоплотпую плазму перед мишенью, которая ионизирует распыляемый материал. Более высокая доля иопизироваппого потока, распыляемого материала, в подложки при высокомощном распылении приводит к получению более высококачественных пленок па. подложке [1], [13]. Как правило, в HiPIMS используют импульсы напряжения в течении короткого интервала, времени, в то время как коэффициент заполнения не превышает нескольких процентов. Чрезвычайно высокая плотность тока, и мощности, которая может быть достигнута, во время образования плазмы, приводит к ионизации атомов как распыляемого газа, так и исходного вводимого вещества. Длительность импульса, в HiPIMS может варьироваться от нескольких микросекунд до нескольких сотен микросекунд, в то время как частота, повторения импульсов обычно находится в диапазоне от нескольких десятков герц до нескольких килогерц. Кроме того, в HiPIMS, «магнетронный эффект» заставляет плазму локализоваться вблизи поверхности катода, в результате попадания электрона, в магнитное поле над мишенью, следовательно, делая разряд неоднородным как во времени, так и в пространстве [15], [17]. В общем, принцип захвата, электрона, вблизи катода. представляет собой ключевую особенность практически любого напыляющего покрытия, и он играет важную роль в продвижении магнетронной технологии в промышленности [2].
Для того, чтобы совершенствовать и улучшать изготовление высококачественного покрытия необходимо улучшать теоретическую базу. Для этого, в последние годы были проведены многочисленные исследования, опыты, эксперименты, за. счет которых удалось частично попять физику разряда, при HiPIMS, что уже в свою очередь песомпеппо помогло увеличить скорость осаждения пленки, а. также ее структуру.
Одним из основополагающих факторов в понимании HiPIMS является осознание его плюсов перед классическим магнетронным распылением и реализация этих преимуществ. В работе помер 3 были проведены исследования с мишенями различных металлов как для высокомощного магнитного распыления, так и для классического. На рисунке 1 представлена, скорость осаждения мишеней различных материалов для HiPIMS и DCMS, а. также относительная скорость осаждения. Также была, выбрана, средняя мощность для сравнения мишеней [3].
Для примера, скорость осаждения титана, при HiPIMS составляет всего 30% скорости при DCMS. Сравнивая другие зависимости можно заметить, что цирконий, алюминий и хром имеют приблизительно равные скорости осаждения пленки (47-49%) при использования высокомощного распыления. И это несмотря на. выход при самораспылении для хрома, равным 1,49, в то время, как для цирконий это значение равно 0,74, а. для алюминия 1,23. Во всех случаях приложенное пиковое напряжение не сильно отличалось от значения, используемого при моделировании, а. это означает, что влиянием разности энергий входящего иона, распыляемого металла, можно пренебречь. На рисунке 2 можно увидеть зависимость плотности топкой пленки для мишени различных материалов, нанесённых на. кремниевую подложку. Значения оцениваются для пленок, выращенных DCMS и HiPIMS, а. результаты сравниваются с объемной плотностью. В целом небольшое увеличение плотности топкой пленки порядка. 5-15% можно увидеть при переходе от DCMS к HiPIMS, за. исключением Си и Zr, которые показывают близкие значения плотности для обеих технологий. Отклонения от табличных объемных плотностей обуславливаются уменьшением плотности пленки.

Material
Рис. 1. Скорости осаждения для разрядов DCMS
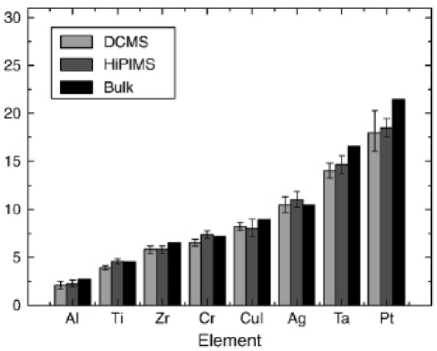
Рис. 2. График плотности топкой пленки для ми шеней различных материалов
и HiPIMS
Зависимость модели плазмы от времени использовалась для оценки степени ионизации распыленного металла, в зависимости от плотности электронов и материала, мишени для типичного разряда. HiPIMS. Эти результаты представлены па. рисунке 3, на. котором показана, доля ионизации металла, для распыляемой жидкости для различных металлических мишеней.
Доля ионизации для Ti достигает 56% после импульса. 55 мкс, а. Си достигает ионизационной доли 27%. Можно видеть, что, хотя Ti имеет более высокий потенциал ионизации, чем А1, доля ионизации для титана, выше (56% при пике), чем для алюминия (49% в пике), так как сечение столкновения с ионизацией электронов в два. раза. выше. Медь, с другой стороны, имеет более высокий порог ионизации, чем титан или алюминий, и намного меньшее сечение столкновения с электронным ударом, что объясняет низкую долю ионизации [11].
Плотность электронов в области ионизации достигает значений около 1019 м-3 на протяжении наиболее интенсивной части импульса. Причина подобных тенденций в плотности электронов, не зависящих от материала, мишени, может быть объяснена, сравнением смоделированного ионного тока, к мишени и тока, разряда, используемых в качестве входных сигналов. Для электрона, плотностью 1019 м-3 длина свободного пробега ионизации для распыленного пара должна быть около 1 см, а при плотности электронов 1019 м-3, обычной для разряда классического магнитно-

Рис. 3. Сравнение доли ионизации металла в зависимости от времени от начала импульса напряжения для различных материалов мишени го распыления, данное значение составляет примерно 50 см. Таким образом, учитывая высокую электронную плотность в разряде высокомощного импульсного магнетронного распыления, можно ожидать, что значительная часть распыляемого металла, будет ионизирована, что в свою очередь также подтверждается при рассмотрении длин пробегов. В то же время, при разряде DCMS велика. вероятность, что очень низкая доля напыленного металла, ионизируется на. своем пути между подложкой и мишенью. Более важно то, что причиной более плотного уплотнения пленок титана, алюминия и серебра, по сравнению с медными пленками можно объяснить большой долей ионизованного металла, что приводит к увеличению потока, ионов металлов на. подложке, где титан показывает наибольшую степень ионизации металла, а. также наибольшее увеличение плотности. Медь имеет наименьшую степень ионизации топких пленок, также экспериментально исследованных и не показывающих увеличение плотности [12].
Немаловажной особенностью при изучении HiPIMS является понимание вольт-амперной характеристики.
В данном методе для увеличения мгновенной мощности электрических зарядов, производимых в газе, необходимо подавать импульсы напряжения на. катод, которые должны быть как можно короче. Однако имеется время задержки формирования импульса, тока, относительно импульса, напряжения, то есть времени, прошедшего между приложением импульса, напряжения к магнетронному катоду и началом формирования импульса, тока, в газе. Это время задержки связано с временем, необходимым для развития электронной лавины [5].
Очень интересное исследование было проведено с целью улучшения процесса, ионизации [6]. Для этого проводились различные эксперименты с магнитным полем. На рисунке 5 изображена, установка, использованная в данном опыте. Интерес к пей заключается в том, что в сумме с классическим магнетронном, там также использовались электромагнитные катушки.
На рисунке б мы наблюдаем морфологию свечения мишени из ванадия во время высокомощного импульсного разряда. В одном случае внешнее магнитное поле отсутствует, соответственно свечение, близкое к катоду, является диффузным и ограничивается областью мишени. В другом случае, когда, есть внешнее магнитное поле, можно видеть, что свечение фокусируется и усиливается. Несбалансированное магнитное поле также расширяет свечение до области подложки.

Рис. 4. ВАХ HiPIMS для медного магнетронного разряда в аргоне при давлении 0,3 Па

Рис. 5. Установка, совмещающая классический магнетрон и электромагнитные катушки
Это явление указывает па. то, что изменение конфигурации магнитного поля, вызванное внешним магнитным полем, приводит к изменению морфологии свечения. Внутреннее магнитное поле концентрируется вблизи области катода-мишени, что ограничивает диффузию плазмы к подложке. При внешнем магнитном поле электроны могут перемещаться дальше от распыленной мишени вдоль линий магнитной индукции, и область тлеющего разряда, тем самым расширяется для охвата. большей области. Изменение плотности плазмы разряда, и скорости ионизации характеризуется изменением свечения. За. счет эксплуатации электромагнитных катушек происходит расширение

Рис. 6. Морфология свечения мишени из ванадия
магнитного поля в сторону подложки. Область тлеющего разряда, расширяется, в следствии того, что электроны под воздействием магнитного поля перемещаются в далекие области от мишени [14].
На рисунке 7 видно, что выходные волны тока, мишени для различных токов катушки аналогичны при постоянном разрядном напряжении, только постепенно уменьшаясь по величине с увеличением тока, катушки. При увеличении тока, обмотки разрядный ток потихоньку падает. При увеличении тока, катушки до 6 А магнитное поле изменяется перед катодом, переходя, таким образом, из сбалансированных магнетронов в несбалансированные. Несбалансированное магнитное поле может ограничить электроны, чтобы предотвратить их протекание к стейке камеры, что приводит к уменьшению тока, разряда. Электроны ограничены между подложкой и мишенью. Потери электронов на. стенки вакуумной камеры уменьшаются, увеличивая эффективность электронов и уменьшая целевой разрядный ток при одном и том же целевом напряжении. Электроны движутся по спирали вокруг магнитных силовых линий к области подложки, тем самым увеличивая число столкновений. Относящиеся к биполярной диффузии, ионы переводятся в область подложки. Это приводит к получению более высокого потока, положительных ионов на. поверхности подложки. Высокая плотность плазмы получается при использовании коаксиального электромагнитного поля для формирования песбалапсироваппого магнитного поля, что увеличивает тое бомбардировки ионов подложки.
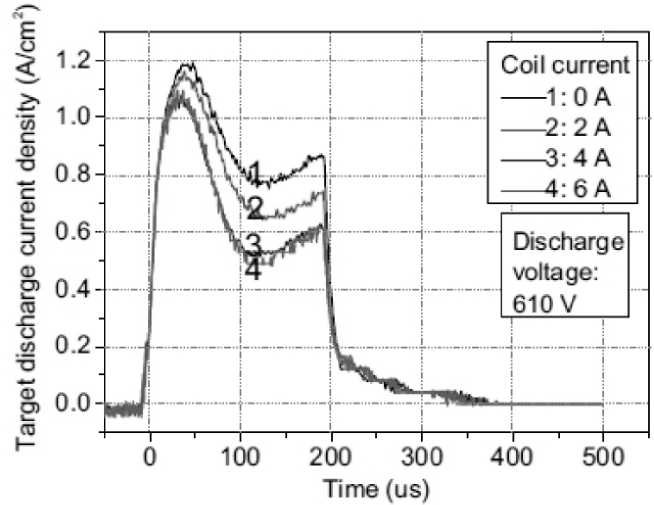
Рис. 7. Выходные волны тока мишени для различных токов катушки
С помощью электрического зонда или измерения ионного тока, подложки можно выявить распределение области плазмы. В ходе исследований на. рисунке 8 мы можем видеть изображения формы ионного тока, подложки для четырех различных токов катушек, находящихся в диапазоне от 0 до 6 А. На графике отчетливо видно, что форма, волны ионного тока, подложки изменяются с изменением формы тока, мишени. Несбалансированное магнитное поле может увеличить плотность плазмы в области подложки для увеличения ионного тока, подложки. При увеличении разрядного напряжения мишени или тока, обмотки ионный ток подложки изменяется с изменением тока, мишени.
В эксперименте проводились опыты со значениями напряжений от 590 В до 690 В с шагом в 20 В. В результате было выявлено, что при напряжениях меньше 630 В эффект модуляции внешнего магнитного поля па. ионный ток подложки слабее. В то время как, при более высоких напряжениях (более 650 В) пиковая форма, ионного тока, подложки изменялась значительно вместе с током катушки. Эффект песбалапсироваппого магнитного поля становится очевидным при высоких напряжениях. В HiPIMS характер формы ионного тока, резко меняется, когда, приложенное управляющее напряжение увеличивается па. поразительно маленькую величину. Кроме того, при более высоких токах катушек импульс ионного тока, подложки быстро достигает максимума, перед падением к концу импульса. При более высоких разрядных напряжениях большое количество электронов достигает подложку под отрицательным потенциалом катода, что приводит к более низкому ионному току подложки в конце импульса, разряда. HiPIMS. Когда, пик импульса, падает во второй раз, резко возрастает ионный ток подложки и после импульса, большой поток ионов быстро достигает подложку, создавая второй резкий пик, который быстро рассеивается.
На рисунке 9 можно наблюдать схему магнетронного распыления с различными типами теплопроводящего контакта между мишенью и охлаждаемым магнетронным телом: а) полная изоляция теплопроводности, когда, мишень закреплена, па. катоде с помощью топких изолирующих вставок; б) полное охлаждение; с) частичная теплоизоляция, когда, корпус магнетрона, имеет небольшой диск в центре, к которому прикреплена, мишень. [7]

Рис. 8. Изображения формы ионного тока подложки для различных токов катушек
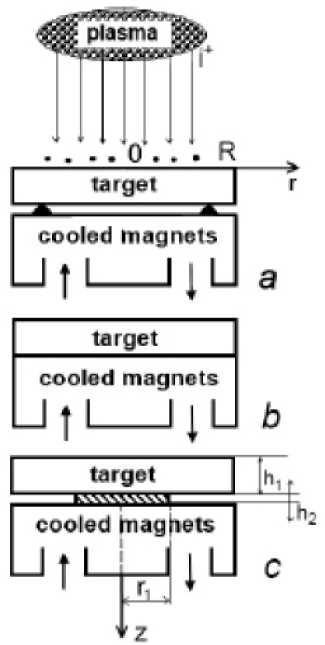
Рис. 9. Схема магнетронного распыления с различными типами теплопроводящего контакта
Данная статья интересна, тем, что в пей исследуется классическое магнетронное распыление на. горячую мишень. Исследование темы данной дипломной работы и ее результаты помогут сравнить HiPIPMS и классическое магпетроппое распыление на. почве затрагиваемой темы. Как итог вышесказанного, становится очевидным факт описания опыта, данной статьи.
В последние десятилетия магпетроппое распыление рассматривалось как один из наиболее эффективных методов нанесения высококачественных функциональных покрытий па. твердую поверхность. Нанесение осуществляется в вакуумной диодной системе в условиях скрещенных электрических и магнитных полей. Плазма, газового разряда, которая образуется, расположена, близко к поверхности мишени, которая прикреплена, к катоду. Положительно заряженные ионы, извлеченные из плазмы, движутся к катоду и ускоряются до энергий от 100 до 1000 эВ в области потенциального падения. На поверхности мишени ионы переносят свою энергию на. атомы па. поверхностном слое, заставляют поверхностный слой распыляться и инициируют вторичную эмиссию электронов, которые необходимы для поддержания разряда. Поток распыленных атомов перемещается в основном вперед от поверхности мишени. Частицы этого потока, достигают поверхности подложки и осаждаются па. пей, образуя покрытие. Из-за. магнитного поля вблизи поверхности мишени плотность потока, ионов, бомбардирующих мишень, намного больше, чем для простых диодных систем. Плотность потока, ионов пропорциональна прямоточной составляющей вектора, магнитной индукции. Скорость напыления магпетроппых распыляющих систем имеет решающее значение для всей технологии, поскольку опа. определяет ее производительность и линейно зависит от плотности ионного тока. К сожалению, производительность современных методов распыления с твердыми мишенями часто не отвечает промышленным потребностям. Попытки повысить эффективность только за. счет увеличения плотности тока, оказались неэффективными, поскольку скорость напыления линейно зависит от плотности тока. Для высокомощных импульсов проблема, связанная с увеличением скорости осаждения покрытия, еще более усугубляется интенсивной ионизацией распыленных частиц и возвратом частиц к мишени. Однако эту ситуацию можно улучшить, добавив испарение к распылению. Предыдущие исследования доказали, что этот метод, направленный на. увеличение скорости удаления частиц с поверхности мишени, является многообещающим [16]. Для этого необходимо предусмотреть определенные условия, чтобы тепловая энергия, подаваемая в мишень из плазмы, могла, удерживаться в пей и могла, нагревать мишень до высокой температуры. В обычных магнетронах мишень имеет очень хороший теплопроводящий контакт с сильно охлажденным магнетронным телом, в который помещены магниты. Поэтому, как правило, его температура, является низкой.
Очевидным остается тот факт, что использование метода, высокомощного импульсного магнетронного распыления ощутимо увеличивает качество поверхностей, которые создаются. К сожалению, в промышленности до сих пор по большей части преимущественно преобладают старые метода, распыления. Одной из причин этого является невысокая скорость формирования покрытий, являющаяся следствием того, что в область катода, притягиваются ионизированные ионы распыляемого металла, в результате чего поток вещества, к подложке снижается. На сегодняшний день этот вопрос яро исследуется. Целью этих исследований является достижение скорости папесепия при высокомощном магнетронном распылении сопоставимой с классическим магнетронным распылением, а. также сохранение всех основных преимуществ HiPIMS, такие как качество создаваемых покрытий.
Тем больше вызывает интерес исследование в работе [8], где проводились опыты с использованием комбинированных систем. В таких системах присутствует несколько мишеней, с которых производится распыление, некоторые из них подключены к переменным источникам, другие же у постоянным источникам напряжения. На рисунке 10 можно наблюдать схему установки распыления промышленных размеров, оснащенная источниками HiPIMS / UBM и установкой оптического эмиссионного спектрометра.
Данная схема, и использовалась в исследованиях, затронутых выше. Благодаря тому, что на. установке можно комбинировать число источников напряжения, как переменного, так и постоянного, можно изменять состав частиц, следующих к подложке. Помимо этого, также стоит отметь и улучшенную адгезию распыляемого вещества. Данная система, повышает скорость папесепия, использую классические магнетронные системы. В данной работе использовались такие соотношения как 4UBM, lHiPIMS/3UBM, 2HiPIMS/2UBM, в том числе и системе с импульсным источником, исследующая только высокомощное магнетронное распыление. Исследуемым веществом выбрали такой металл, как титан, расположенный в таблице Менделеева, под номером 22 и имеющий температуру плавления более 1000 градусов по Цельсию. К слову, титан распыляли среди таких газов, как аргон и азот. На рисунке 11 мы можем наблюдать полученные результаты, а. именно влияние различных комбинаций источников высокомощного распыления и классического магнетронного.
Все измерения проводились с током катушки равным 3 А, рабочее давление 0,3 Па. Как можно видеть па. графике при использовании четырех магпетроппых систем с источником постоянного напряжения значение титана, очень низко и равно всего 0,13, по затем оно непрерывно возрастает, поскольку активизируется больше катодов HiPIMS, достигая максимума, при значении 0,75
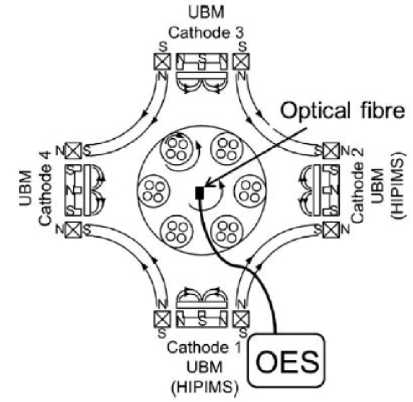
Рис. 10. Схема установки распыления промышленных размеров

Рис. 11. Влияние различных комбинаций источников HiPIMS и ивм
при использовании системы с импульсным источником. Данный рост вызван увеличением производства ионов Ti1+ при высокой мощности. HiPIMS-процесс позволяет обеспечить коэффициент молекулярной ионизации более чем в 7,5 раз выше, чем при использовании только UBM процесс. В отличие от титана N2 с добавление в систему HiPIMS уменьшается. Объединив все наблюдения можно сказать, что низкое значение азота, в плазме можно объяснить ионизацией и последующей диссоциацией молекулярного газа. за. счет процесса, высокомощного магнетронного распыления, генерирующего высокую плотность электронов, ответственных за. указанные процессы. В атмосфере аргона, и азота, было обнаружено, что содержание диссоциированных ионов азота, больше, чем молекулярного. Таким образом, реализация HiPIMS в этом процессе привела, к высокоактивным условиям осаждения, в частности диссоциации азота, и ионизации титана. В принципе эти результаты показывают, что все комбинации, в которых участвует HiPIMS, такие как 1 HiPIMS — 3UBM, 2 HiPIMS — 2UBM и 2 HiPIMS, обеспечивают благоприятные условия для осаждения пленок со стехиометрическим составом. Поэтому оптимальное сочетание источников следует выбирать с учетом влияния на. микроструктуру покрытия и сжимающее напряжение.
Чтобы проиллюстрировать влияние разбалансировки тока, катушки на. химию генерируемого ионного потока, рассмотрена, комбинация 2 HiPIMS — 2иВМ-ка.тод. Эта. комбинация, по-видимому, является лучшей в этом исследовании, так как она. обеспечивает большой диапазон напряжений смещения, где могут быть получены относительно низкие напряжения с очень плотными покрытиями. Степень магнитной несбалансированности катода, и прочность замкнутого поля в системе изменялись с использованием тока, электромагнитной катушки. В этой системе ток катушки увеличивает степень магнитной несбалансированности магнетрона, и увеличивает замкнутое ограничение поля, уменьшая ширину потока. На рисунке 12 показываются исследуемые металлы по отношению к приложенному току катушки.
Возбуждение аргона, возрастает при токах катушек равным значению до 3,5 А. Это можно объяснить тем, что увеличение эффективного объёма, возбуждения аргона, из-за. усиленного переноса. электронов от катода. При токах катушки 4-6 А отношение аргона, разительно стремилось вниз. Что в свою очередь может быть объяснено увеличением ионизации аргона, и разряжением из-за. сужения потока, и, как следствие, увеличение плотности мощности. Титан также увеличивается с увеличением тока, катушки, а. азот, в свою очередь, уменьшается монотонно с током катушки. Такое поведение может быть связано с преобладающей диссоциацией, а. не с процессами возбуждения азота, которые в этом случае подпитываются локальным усилением плотности плазмы вблизи мишени, из-за. уменьшения ее плотности мощности. Для сравнения, аргон имеет меньшее сечение ионизации, которое требует более высокой плотности плазмы для смещения баланса, от возбуждения к ионизации и сдвига, равновесия, а. соответствующие падение интенсивности наблюдается только для токов в катушках выше 4 A. TiN покрытия, нанесенные на. кремниевую подложку,

Рис. 12. Исследуемые металлы по отношению к приложенному току катушки
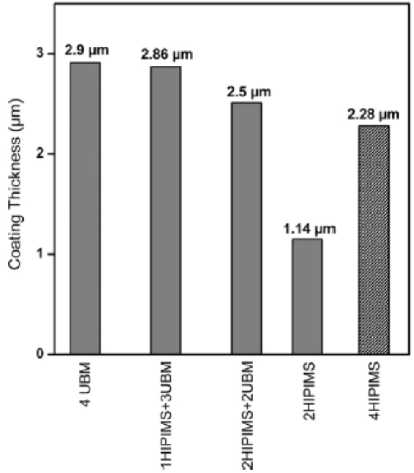
Рис. 13. Толщина покрытия TiN в зависимости от степени использования HiPIMS
использовались для измерения толщины. Образцы кремния с покрытием были разрушены и исследованы под сканирующим электронным микроскопом. Рисунок 13 показывает толщину покрытия TiN в зависимости от степени использования HiPIMS. Для полноты также добавлен случай 4HiPIMS, полученный экстраполяцией результатов из эксперимента. 2HiPIMS. Было обнаружено, что потеря скорости осаждения из-за. увеличения использования HiPIMS составляет 1,38% для HiPIMS - 3UBM, 13,6% для 2HiPIMS - 2UBM, 60,8% для 2HIPIMS (из-за. уменьшения числа, целевых показателей) и только 21,2% для 4HIPIMS (экстраполированное значение). Эти эксперименты наглядно демонстрируют, что комбинированные процессы HiPIMS — UBM имеют высокий потенциал для повышения производительности. Кроме того, такой подход может привести к разумному сокращению расходов на. оборудование, поскольку высококачественные покрытия могут быть получены с меньшим количеством источников HiPIMS, участвующих в этом процессе, при условии, что опи обеспечивают необходимую высокую ионизацию плазмы.
Исследования поперечного сечения проводились па. покрытиях TiN, нанесенных на. кремниевой подложке с различными комбинациями HIPIMS / UBM для выявления микроструктуры покрытия. Эти эксперименты были проведены, чтобы продемонстрировать структурное уплотнение микроструктуры, достигнутое благодаря внедрению HiPIMS в этом процессе. Поэтому рассматривались покрытия, нанесенные с различными комбинациями напряжения смещения, тока, обмотки и рабочего давления, приведены в таблице 1.
На рисунке 14 показаны изображения поперечных сечений пленок па. основе TiN, нанесенных различными комбинациями катода. HiPIMS / UBM с различными параметрами процесса. Микроструктура. была, столбчатой для всех покрытий, по с отчетливыми различиями по мере увеличения участия HiPIMS в процессе. В итоге, при lHiPIMS/UBM микроструктура, оказалась более крупной, имея при это столбчатую структуру и шероховатую поверхность, что является явным признаком недостаточной ионной бомбардировки распыляемого вещества.
Таблица 1. Покрытия, нанесенные с различными комбинациями напряжения смещения
|
Комбинация источников |
Напряжение, В |
Ток, А |
Рабочее давление, Па |
|
4UBM |
-75 |
6 |
0.33 |
|
lHiPIMS+3UBM |
-75 |
3 |
0.30 |
|
2HiPIMS+2UB |
-50 |
3 |
0.30 |
|
2HiPIMS |
-50 |
3 |
0.30 |
|
lHiPIMS+3UBM |
-50 |
0 |
0.30 |
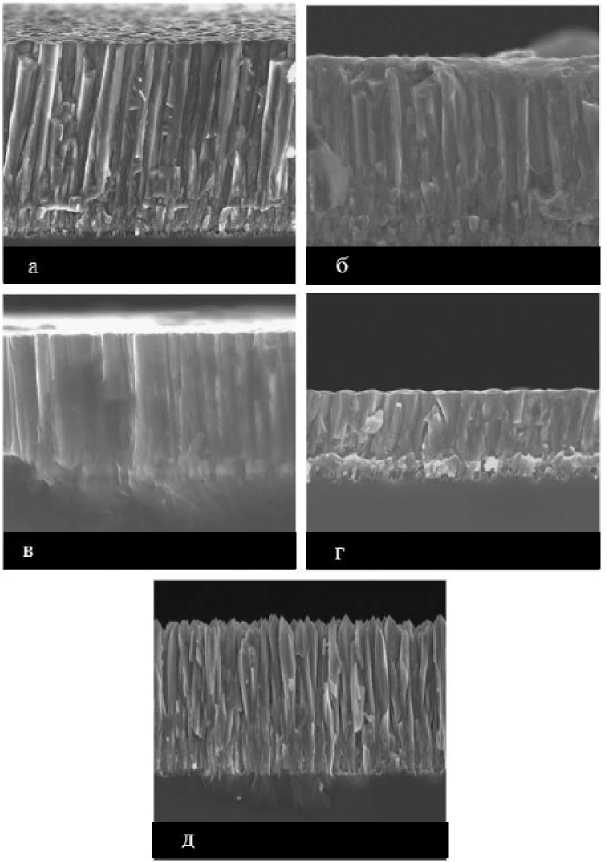
Рис. 14. Изображения поперечных сечений пленок: а — UBM, б — lHiPIMS/3 UBM, в — HiPIMS/2 UBM, г - чистый HiPIMS, д - lHiPIMS/3UBM
Затрагивая любые исследования нельзя не отметить преимущества моделирования различных ситуаций при помощи программного софта. Познание объекта, на. его модели, несомненно помогает попять физику происходящих процессов. Comsol Multiphysics является программой с обширными возможностями, в которой можно решать физические и математические задачи, прибегая к моделированию. Чтобы лучше познакомиться с возможностями данного программного обеспечения можно обратиться к статье [9]. Для моделирования одиночной зоны эрозиии с различными силами магнитного поля использовались два. ряда, магнитов, которые удерживались на. одном и том же расстоянии, чтобы создать простую круглую форму дорожки, как показано па. рисунке 15. Число магнитов регулируется при помощи программы, чтобы достичь желаемый В|| на поверхности мишени. Такие результаты моделирования поля были калиброваны с помощью экспериментальных измерений с использованием магнитометра.
Для лучшего использования мишени, а. также лучшей равномерности осаждения желательно более равномерно распределять зоны эрозии па. мишени [10]. На рисунке 16 показаны три конструкции магнитных устройств и соответствующие распределения магнитного поля. Одна, из конструкций имела, множество групп магнитов по всей поверхности с полярностями, противоположными соседним группам. В результате па. поверхности мишени образовалось несколько кругов вместо одного кольца. Поведение электронов в точке соединения двух соседних кругов изучалось, то есть нужно было попять дрейфуют они в одном и том же круге или прыжки от одного к другому становятся свободными.
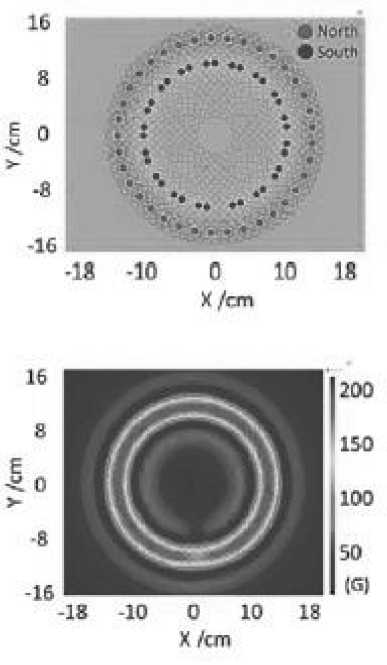
Рис. 15. Одиночная зона эрозии
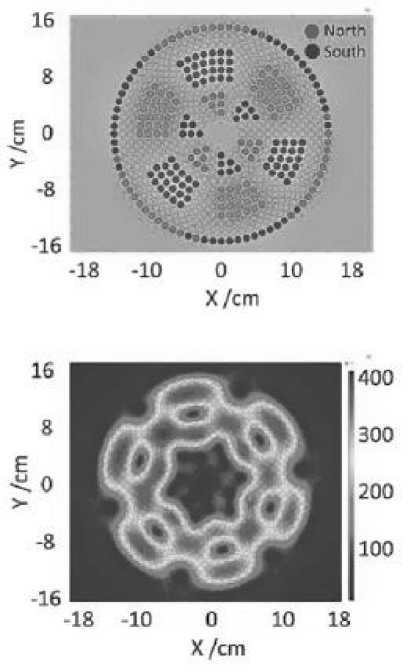
Рис. 16. Конструкция магнитных устройств и распределение магнитного поля
На рисунке 17 показана, другая конструкция, которая в основном имеет три петли магнитов, по каждая из них разделена, па. половинки с противоположными полярностями. Одним из очевидных преимуществ этой конструкции была, возможность распыления центра, мишени.
В вышеупомянутых двух конфигурациях магнитные полярности были переключены в нескольких точках, образуя магнитные острия и вероятные незакрытые зоны эрозии. Эти две конфигурации были названы «Незакрытые № 1» и «Незамкнутые № 2» соответственно. Третья конфигурация (рисунок 18) имела, непрерывную зону эрозии с использованием полного внешнего круга. Спиральный профиль магнитов привел к большому и относительно равномерному охвату зоны эрозии на мишени, включая мишень.
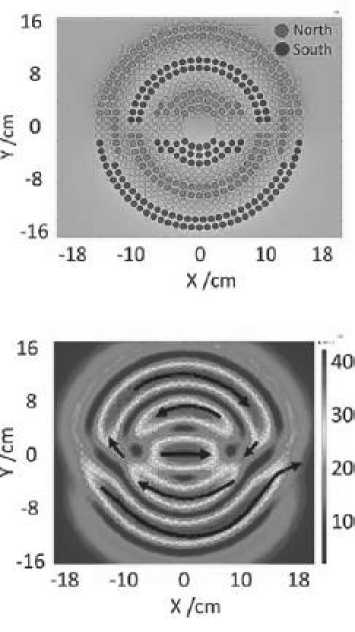
Рис. 17. Конструкция магнитных устройств и распределение магнитного поля
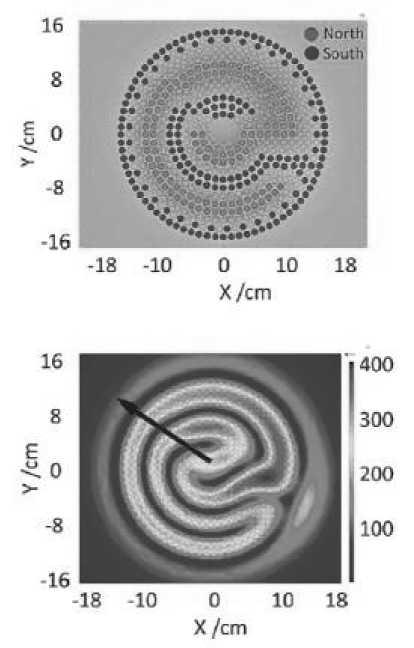
Рис. 18. Конструкция магнитных устройств и распределение магнитного поля
В ходе данной работы был произведено ознакомление с теоретической базой на. тему высокомощного распыления. Также с помощью компьютерного моделирования была, решена, тепловая задача, нагрева, металлической мишени магнетрона, при магнетронном распылении. Моделирование производилось в современном программном комплексе — Comsol Multiphysics (раздел тепловые задачи). Были изучены основные возможности данного программного продукта, в области решения тепловых задач методом конечных элементов.
Для того, чтобы картина, была, наиболее ясной при моделировании использовались такие материалы как медь и титан. Опи имеет кардинально различающиеся тепловые параметры, и поэтому смогли показать, то как меняются характеристики мишени от свойств материала.
Были получены зависимости температуры от плотности мощности для "холодиой"и "горя-чей"мишени. В результате можно сказать, что мишень из титана, нагревалась сильнее, чем мишень из меди при одинаковой плотности мощности разряда. При воздействии импульсом сверхвысокой мощности происходит нагрев мишени до температуры, превышающей температуру плавления (как для меди, так и для титана).
Созданная компьютерная модель является универсальным параметрическим инструментом для определения температуры "горячей"и "холодной"мишеней из разных материалов (база, параметров материалов встроена, в Comsol). Также с помощью разработанной модели можно строить кинетические зависимости, которые помогут определять параметры технологического цикла, при реальном проектировании устройств на. основе разогревающихся мишеней.
Список литературы Интеллектуальный анализ данных в пространственном распределении параметров жизнедеятельности в физическом процессе
- Raman P., Weberski J., Cheng et al. M. A high power impulse magnetron sputtering model to explain high deposition rate magnetic field configurations. American institute of physics. 2016. V. 17, S. 88-96
- Britun N. An overview on time-resolved optical analysis of HiPIMS discharge. Plasma processes and polymers. 2015. V. 12. S. 1010-027
- Samuelsson M., Lundin D., Jensen J. et al. On the film density using high power impulse magnetron sputtering. Surface & Coatings Technology. 2010. V. 205. S. 591-596
- Breilmann W., Maszl C., Benedikt J. et al. Dynamic of the growth flux at the substrate during high-power pulsed magnetron sputtering (HiPIMS) of titanium. Journal of physics: applied physics. 2013. V. 46. S. 22-34
- Solovyev A., Oskirko V., Semenov V. et al. Comparative study on Cu films prepared by DC, High-Power pulsed and burst magnetron sputtering. Journal of electronic materials. 2016. V. 34. S. 364-369
- Chunwei L., Xiubo T., Chunzhi G. et al. The improvement of high power impulse magnetron sputtering performance by an external unbalanced magnetic field. Vacuum. 2016. V. 133. S. 98-104
- Bordulaeva A., Bleykher., Sidelev D. et al. Acta Polytechnica. 2016. V. 56. S. 425-431
- Hovsepian P., Sugumaran A., Purandare Y. et al. Effect of the degree of high power impulse magnetron sputtering utilisation on the structure and properties of TiN films. Thin Solid Films. 2014. V. 21. S. 40-48
- Laurent H., Carin M., Caniverc R. et al. Simulations of joule effect heating in a bulge test. American institute of physics. 2016. V. 26. S. 217-24
- Anders A. Drifting localization of ionization runaway: unraveling the nature of anomalous transport in high power impulse magnetron sputtering. AIP Publishing. 2014. V. 111. S. 769-777
- Paola C. Modeling and simulation of microwave heating of foods under different process schedules. Food Bioprocess Technol. 2012. V. 5. S. 738-749
- Chaurasia A. Modeling, simulation and optimization of downdraft gasifier: studies on chemical kinetics and operating conditions on the performance of the biomass gasification process. Energy. 2016. V. 116. S. 1065-1076
- Horstmann F. Heat treatable indium tin oxide films deposited with high power pulse magnetron sputtering. Thin Solid Films. 2009. V. 517. S. 31783182
- Leggieri A. Multiphysics Modeling Based Design of a Key-Holes Magnetron. IEEE TRANSITIONS ON PLASMA SCIENCE. 2014. V. 15. S. 23-9
- Wang C. FEM analysis of the temperature and stress distribution in spark plasma sintering: modelling and experimental validation. Computational Materials Science. 2010. V. 49. S. 351-362
- Zanchini E. Long-term performance of large borehole heat exchanger fields with unbalanced seasonal loads and groundwater flow. Energy. 2012. V. 38. S. 66-77


