Исследование диэлектрических свойств тонких пленок оксида алюминия, выращенных методом молекулярного наслаивания
Автор: Борисова Татьяна Михайловна, Кастро Арата Рене Алехандро
Журнал: Труды Московского физико-технического института @trudy-mipt
Рубрика: Нанотехнология и нанометрия
Статья в выпуске: 1 (17) т.5, 2013 года.
Бесплатный доступ
Впервые экспериментально исследованы диэлектрические свойства МДП-структур на основе слоев оксида алюминия, полученных методом молекулярного наслаивания (МН). Определены значения диэлектрических параметров для слоев Al2O3 двух толщин. Обнаружено, что диэлектрическая релаксация в исследуемых структурах определяется вкладом дипольной и межфазной поляризаций. Температурно-частотная зависимость удельной проводимости указывает на существование прыжкового механизма переноса заряда с энергией активации ΔЕ = (0,15-0,30 ± 0,01) эВ.
Структуры, поляризация, диэлектрические параметры
Короткий адрес: https://sciup.org/142185891
IDR: 142185891
Study of dielectric properties of thin aluminium oxide layers grown by atomic layer deposition
Dielectric properties of MIS-structures based on aluminium oxide layers obtained by atomic layer deposition (ALD) are experimentally investigated for the first time. The value of dielectric parameters for Al2O3 layers of two thicknesses is determined. It is found that the dielectric relaxation in studied structures is defined by the contribution of dipole and interfacial polarization. The temperature and frequency dependence of conductivity indicates the existence of thermally activated hopping mechanism of charge transport with activation energy ΔЕ = (0,15-0,30 ± 0,01).
Текст научной статьи Исследование диэлектрических свойств тонких пленок оксида алюминия, выращенных методом молекулярного наслаивания
Расширение круга, применяемых в микроэлектронике полупроводниковых структур металл—диэлектрик—полупроводник (МДП) требует получения для них качественных диэлектрических слоев при относительно низких температурах, позволяющих избежать деградации поверхности полупроводника. С этой точки зрения перспективными являются слои оксида алюминия Al2O3, синтезируемые методом молекулярного наслаивания. Данный материал имеет высокое значение диэлектрической проницаемости (е = 10) и является кандидатом для замены подзатворного SiO2 (е = 3,9) в МДП-транзисторах [1]. Помимо этого, пленки Al2O3 имеют малые токи утечки по сравнению с НЮ2 (также широко применяющегося в транзисторах).
Конденсаторные структуры с пленками Al2O3 могут быть использованы в качестве сенсоров влажности емкостного типа, имеющих достаточно высокие чувствительность и быстродействие [2]. Перспективным является использование аморфного оксида, алюминия и в качестве блокирующего слоя во ФЛЭШ-элементах памяти (~ 5 нм), основанных на локализации заряда, на. квантовых точках и изготовляемых преимущественно на. базе нитрида, кремния [3].
До настоящего времени, к сожалению, уделялось мало внимания изучению диэлектрических характеристик слоев Al2O3, хотя исследования такого рода необходимы для установления корреляции между процессами диэлектрической поляризации и переноса, заряда, что необходимо при определении надежности работы полупроводниковых систем и электронных устройств на. их основе. Целью данной работы явилось исследование влияния толщины диэлектрического слоя Al2O3 на процессы релаксации и переноса заряда в МДП-структурах методом диэлектрической спектроскопии.
Измерения диэлектрических параметров выполнены в частотном диапазоне J = 10-1... 106 Гц и в температурном интервале 0... 100 °C на спектрометре «Concept 41» (Novocontrol Technologies). Система, состоит из частотного анализатора, импеданса. ALPHA ANB, измерительной ячейки, устройства, термостатирования Novocool Cryosystem, сосуда дьюара с системой испарения и подачи газообразного азота, а также системы автоматического сбора данных с компьютерным интерфейсом. При измерениях температура стабилизировалась с точностью ^ 0,3 °C. На образец подавалось измерительное напряжение 1 В. Алюминиевые контакты площадью 0,24 мм2 наносились на диэлектрик термическим испарением в вакууме. Оксид алюминия выращен методом МН на. кремниевой подложке (p-типа) с ориентацией (100) марки КДБ-10 из смеси газов триметилалюминия А1(СН3)3 (ТМА) и воды. Толщина оксидного слоя, измеренная с помощью эллипсометра
ЛЭФ-3 [4, 5], составляла: образец № ИЗ — 78 нм; образец № 2В — 36 нм (погрешность измерения не превышала 2%).
На рис. 1 представлена частотная зависимость действительной части комплексной диэлектрической проницаемости е‘ при температуре 50 °C. Для образцов двух толщин зависимости e'(f,T ) характеризуются резким увеличением значения е‘ с уменьшением f и ростом температуры, что говорит о преобладании эффектов межфазной и дипольной поляризации в данном интервале частот [3, 6]. Увеличение толщины оксидного слоя приводит к уменьшению значения е' в области средних частот. Диаграммы Коула—Коула е"(е') указывают на существование недебаевского механизма релаксации с широким распределением времен релаксации.
Из рис. 2 следует, что в исследуемой области f и температур диэлектрические потери характеризуются наличием релаксационных максимумов; причем как для образца № 1В, так и для № 2В максимумы tg 6 наблюдаются при одной и той же частоте (при Ti = 50 °C — fi = 80 Гц. а. при T2 = 100 °C — /2 = 155 Гц). В яиапазоне f < 10 Гц мы имеем дело с проявлением потерь проводимости. Влияние температуры обнаруживается в увеличении значения tg 6 с ростом T. Также к существенному изменению диэлектрических потерь (в среднем в 2-3 раза) приводит увеличение толщины слоя оксида алюминия, что может быть связано с увеличением активных составляющих поляризационных токов.
В ходе эксперимента обнаружена степенная зависимость действительной части комплексной проводимости и’ от часто ты вида Аш® (рис. 3). Показатель степени s = (0,65-0,96 ± 0,01) уменьшается с температурой, что говорит о существовании прыжкового механизма проводимости.
Температурная зависимость о7 в координатах Аррениуса имеет экспоненциальный характер с наличием одного участка с энергией активации для образца № 1В AS1B = (0,16 ± 0,01) эВ. для образца. У 2В ДТДв = (0,24 ± 0,01) эВ. Увеличение проводимости с температурой может быть связано: во-первых, с ростом количества, носителей заряда выброшенных с мест на ионах или вакансиях; во-вторых, со значительным изменением амплитуды колебаний решетки, приводящим к росту подвижности носителей заряда. [7].
Обнаруженные закономерности объясняются аморфностью оксидного слоя, наличием в нем большого числа, дефектов как собственных, так и примесных, образованных при синтезе образцов [2]. Увеличение толщины оксидного слоя вызывает ухудшение диэлектрических характеристик, что проявляется в уменьшении значения диэлектрической проницаемости е‘ в области средних частот и росту удельной проводимости в интервале f ~ 10-1 ^ 106 Гц. Помимо этого с увеличением толщины диэлектрического слоя уменьшается и энергия активации.
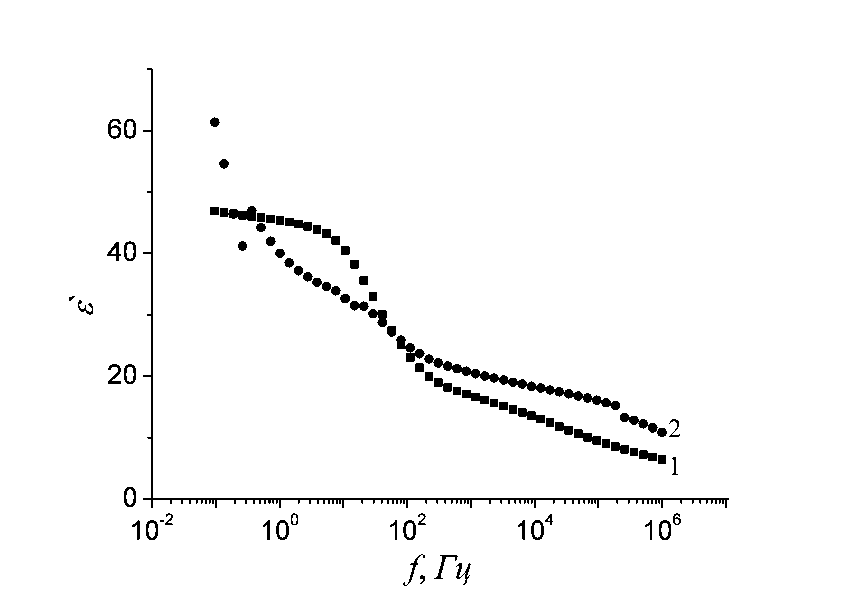
Рис. 1. Частотная зависимость действительной части комплексной диэлектрической проницаемости s’ при температуре 50 °C: 1 — № 1В, 2 — № 2В

Рис. 2. Частотная зависимость тангенса угла диэлектрических потерь tg 5 для образца № 1В и № 2В при разных температурах. Т К: 1 — № 1В при 50 °C, 2 — № 1В при 100 °C, 3 — № 2В при 50 °C, 4 - № 2В при 100 °

Рис. 3. Зависимость от обратной температуры логарифма действительной части комплексной проводимости а ‘ при частоте 103 Гц для двух образцов: 1 — № 1В, 2 — № 2В
Список литературы Исследование диэлектрических свойств тонких пленок оксида алюминия, выращенных методом молекулярного наслаивания
- Robertson J. High dielectric constant oxides//Eur. Phys J. Appl. -2004. -N. 28. -P. 265-291.
- Ahmed Farag I. S., Battisha I. K., El-Rafaay M. M. Study of dielectric properties of 𝛼-alumina doped with MnO, CdO and MoO//Indian J. of Pure & App. Phys. -2005. -N. 43. -P. 446-458.
- Новиков Ю.Н., Гриценко В. А., Насыров К. А. Многофононный механизм ионизации ловушек в Al2O3: эксперимент и численное моделирование//Письма в ЖЭТФ. -2009. -Т. 89, вып. 10. -С. 599-602.
- Сазанов С. Г., Зулуев З. Н., Дрозд В. Е., Никифорова И. О. Зарядовые свойства слоев оксида алюминия, синтезированных методом молекулярного наслаивания//Письма в ЖТФ. -1998. -Т. 24, вып. 13. -С. 58-63.
- Барабан А. П., Егоров Д. В., Милоглядова Л. В. Особенности строения тонких многослойных диэлектрических пленок//Электронный журнал «Исследовано в России». -http://zhurnal.ape.relarn.ru/articles/2003/216.pdf. -2003. -Вып. 216. -С. 2513-2522.
- Choong-Ki Lee, Eunae Cho, Hyo-Sug Lee, Kwang Soo Seol and Seungwu Han. Comparative study of electronic structures and dielectric properties of alumina polymorphs by firstprinciples methods//Phys. rev. -2007. -N. 76. 245110. -P. 1-7.
- Орешкин П.Т. Физика полупроводников и диэлектриков: уч. пособие. -М.: Высш. школа, 1997.


