Электронно-микроскопические исследования дефектообразования в легированных примесями монокристаллах CdTe, ZnS и ZnSe
Автор: Логинов Ю.Ю., Мозжерин А.В., Брильков А.В.
Журнал: Сибирский аэрокосмический журнал @vestnik-sibsau
Рубрика: Технологические процессы и материалы
Статья в выпуске: 3 (49), 2013 года.
Бесплатный доступ
Методом просвечивающей электронной микроскопии исследованы закономерности образования структурных дефектов в легированных и нелегированных полупроводниках CdTe, ZnS и ZnSe, выращенных из газовой фазы. Установлено, что при отжиге в легированных полупроводниках образуются примесные выделения на ростовых дислокациях и дефектах упаковки, при этом происходит перемещение дислокаций. Образование примесных выделений (преципитатов) на ростовых дефектах объясняется миграцией примесей и точечных дефектов на дислокации с формированием пересыщенного твердого раствора, который конденсируется в виде преципитатов, содержащих легирующую примесь. Содержание легирующей примеси в преципитатах подтверждается локальным электронно-зондовым микроанализом.
Структурные дефекты, дислокации, преципитаты, просвечивающая электронная микроскопия, полупроводники
Короткий адрес: https://sciup.org/148177109
IDR: 148177109 | УДК: 548.571
The electron microscopic study of the defect formation in the doped single crystals CdTe, ZnS and ZnSe
The structural defects formation in the doped and not doped semiconductors CdTe, ZnS and ZnSe grown from the gas phase were investigated by transmission electron microscopy. 1t is found that the annealing of doped semiconductors leads to the formation of impurity precipitates at the grown-in dislocations and stacking faults, that leads to dislocation migration. The precipitate formation at the growth defects due to the migration of point defects and impurities on the dislocation with the formation of a supersaturated solid solution which is condensed in the form of precipitates containing dopant. The content of impurities in precipitates is confirmed by the local electron probe microanalysis.
Текст научной статьи Электронно-микроскопические исследования дефектообразования в легированных примесями монокристаллах CdTe, ZnS и ZnSe
Полупроводниковые материалы и приборы широко применяются в космических аппаратах, устройствах электроники, изготовлении солнечных элементов [1]. В процессе выращивания и термообработок в полупроводниковых кристаллах формируются структурные дефекты, размеры и плотность которых зависят от условий обработки и природы материалов [1; 2]. С целью улучшению качества получаемых полупроводниковых кристаллов важным является контроль типа и плотности дефектов при различных технологических режимах и установление механизмов их формирования.
В данной работе методом просвечивающей электронной микроскопии (ПЭМ) исследовали полупроводниковые кристаллы CdTe, ZnS и ZnSe, выращенные из газовой фазы в запаянной ампуле и легирован- transmission electron microscopy, semiconductors.
ные Ga и отдельно In с концентрацией 8∙1018 см–3, 1.3∙1019 см–3 и 2.3∙1019 см–3, соответственно для CdTe, ZnS и ZnSe. Содержание Ga и In в кристаллах контролировали методом атомного абсорбционного анализа с помощью прибора Perkin-Elmer 5000. Часть образцов ZnS и ZnSe отжигали при 850 0С в течение трех дней в вакууме, в парах Zn в запаянной кварцевой ампуле, а CdTe в атмосфере паров Cd при 650 0С также в течение трех дней.
Электронно-микроскопические исследования проводили на приборах JEM-100 CX и JEM-2100 с использованием электронно-зондового микроанализа и метода дифракции электронов, темнопольной и светлопольной трансмиссионной электронной микроскопии. Образцы для исследования в ПЭМ приготавливали стандартным методом, сначала механически утончая, используя устройство Gatan Dimple Grinder, а затем ионным травлением на установке Precision Ion Polishing System (PIPS), Gatan.
В ходе исследований установлено, что в кристаллах без отжига имеются ростовые дислокации и дефекты упаковки (рис. 1, а ). Также видны хорошо развитые параллельные полосы (страты), свидетельствующие о политипной модификации ZnS. Они особенно видны, когда вектор дифракции g перпендикулярен полосам. Каких либо примесных выделений в этих образцах не обнаружено.
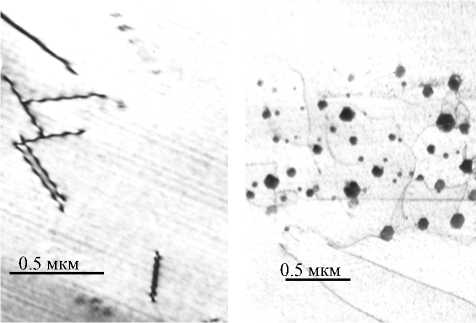
Рис. 1. Электронно-микроскопическое изображение ZnS(In): а – до отжига; б – после отжига при 850 оС
В образцах ZnS(In), отожженных в парах цинка, наблюдается большое число примесных выделений (преципитатов), которые декорируют ростовые дислокации и дефекты упаковки (рис. 1, б ). Небольшие преципитаты имеют форму близкую к сферической, в то время как более крупные имеют четко выраженную шестигранную огранку. Локальная плотность преципитатов составляет 3 ⋅ 108 см–2, а их размеры изменяются в пределах от 30 до 200 нм. Подобные дефекты были обнаружены в ZnS, легированном Ga, также после отжига в атмосфере цинка.
Отжиг кристаллов ZnSe(In) в парах цинка при 850 оС в течение трех дней также ведет к образованию колоний преципитатов на дислокациях и дефектах упаковки. Формирование примесных выделений в ZnSe(In) аналогично процессам, наблюдаемым в ZnS, легированном In или Ga.
Природа преципитатов была установлена с помощью метода энерго-дисперсионного рентгеновского микроанализа. Варьируя размер конденсорной диафрагмы можно получить диаметр электронного пучка ~0.2 мкм, что сравнимо с размерами отдельных преципитатов.
Спектр рентгеновского характеристического излучения, полученный с места локализации отдельных преципитатов в ZnSe(In) приведен на рис. 2. Видно, что имеется пик, связанный с In. Спектры рентгеновского излучения, полученные с соседних областей, не содержащих преципитаты, не имеют пиков, связанных с In или Ga. Таким образом, следует считать, что преципитаты обогащены легирующей примесью In в ZnSe(In), ZnS(In) и Ga в ZnS(Ga).

Рис. 2. Спектр характеристического рентгеновского излучения с области ZnSe(In), содержащей преципитаты
В кристаллах CdTe, легированных In или Ga, также обнаружены примесные выделения на дислокациях после термоотжига. Электронно-зондовый микроанализ с области содержащей преципитаты показал наличие легирующей примеси в преципитатах.
На рис. 3 показан электронно-микроскопический снимок преципитата с области CdTe, легированного In, на котором отчетливо видны линии полосчатого муарового контраста, возникающего при разориента-ции решеток матрицы и выделения.
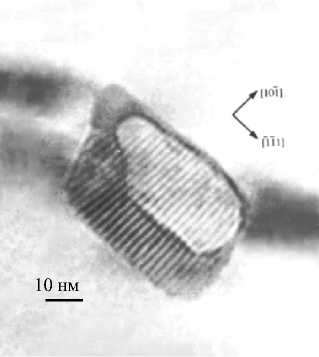
Рис. 3. Муаровый контраст на изображении преципитата, образовавшегося в CdTe(In) после отжига в атмосфере Cd при 650 оС в течение трех дней
Период муарового контраста D , возникающий при повороте решеток с параметрами d 1 и d 2 на угол α , может быть определен как [3]:
dd
D = 2212 (1)
d12+ d22-2d1d2cosα или
D = 12 , если α= 0. (2)
d 1 - d 2
Экспериментальные значения периода муарового контраста D и сравнение расчетных dx и известных d величин межплоскостных расстояний
|
Экспериментальные значения |
Известные значения [4] |
||||||
|
D , нм |
hkl |
dx , нм |
d , нм |
соеди-нение |
тип решетки |
hkl |
I/I 0 , % |
|
1,848 |
111 |
0,308 |
0,307 |
InTe |
кубич. |
200 |
100 |
|
0,309 |
In 3 Te 4 |
гексаг. |
107 |
100 |
|||
|
0,306 |
In 2 Te 3 |
кубич. |
600 |
50 |
|||
Зная межплоскостные расстояния d hkl (CdTe) для определенных плоскостей отражения ( h , k , l – индексы Миллера), соответствующих векторам дифракции g hkl , а также экспериментально измеренные периоды D i можно рассчитать межплоскостные расстояния d x кристаллической решетки преципитата.
Из рис.3 следует, что полосы муарового контраста параллельны плоскостям {111} и D = 1,848 нм, а α = 0. Это позволяет рассчитать d x = 0,3083 нм. Возможные варианты известных величин d приведены в таблице. Видно, что расчетному значению d x соответствуют с высоким процентом интенсивности излучения межплоскостные расстояния от InTe(кубич.) и In 3 Te 4 (гексаг.). В процентах указана интенсивность линии излучения ( I/I 0).
Формирование примесных преципитатов на дислокациях можно объяснить тем, что в процессе отжига в атмосфере Zn для ZnS и ZnSe или Cd для CdTe легирующая примесь, первоначально локализованная в позициях катиона, вытесняется атомами цинка (кадмия) из узловых позиций в междоузельные, что обуславливает миграцию In или Ga на дислокации и дефекты упаковки, где происходит распад пересыщенного твердого раствора с формированием преципитатов.
Процесс сопровождается трансформацией ростовых дислокаций, что необходимо для релаксации упругих напряжений в матрице и характерно при взаимодействии точечных дефектов (вакансий и междо-узельных атомов) с протяженными структурными дефектами. В частности, часть вакансий решетки матрицы, по-видимому, уходит в область формирования преципитата, предоставляя тем самым определенный объем для атомов, образующих преципитат. Об этом свидетельствует отсутствие развитого деформационного контраста вокруг отдельных преципитатов на электронно-микроскопических снимках. Нескомпен-сированная часть собственных междоузельных атомов матрицы может вызывать неконсервативное перемещение дислокаций. Процесс преципитации примесей на дислокациях лимитируется диффузией атомов Se (Te), которые расходуются как при переполза- нии дислокаций, так и при формировании новой фазы типа InTe или In2Te3 в случае CdTe.
Таким образом, установлено, что при отжиге легированных полупроводников CdTe, ZnS и ZnSe в них образуются примесные выделения на ростовых дислокациях и дефектах упаковки и происходит перемещение дислокаций. Образование примесных выделений объясняется миграцией примесей и точечных дефектов на дислокации с формированием пересыщенного твердого раствора, который конденсируется в виде преципитатов, содержащих легирующую примесь.


