Калибровка просвечивающего электронного микроскопа с использованием срезов рельефных структур
Автор: Васильев Александр Леонидович, Гавриленко Валерий Петрович, Ковальчук Михаил Валентинович, Митюхляев Виталий Борисович, Озерин Юрий Васильевич, Раков Александр Васильевич, Роддатис Владимир Владимирович, Тодуа Павел Андреевич, Филиппов Михаил Николаевич
Журнал: Труды Московского физико-технического института @trudy-mipt
Рубрика: Нанотехнология и нанометрия
Статья в выпуске: 1 (17) т.5, 2013 года.
Бесплатный доступ
Предложен новый тест-объект для калибровки просвечивающего электронного микроскопа и растрового просвечивающего микроскопа. Тест-объект изготовлен путем ионного резания кремниевой рельефной структуры с аттестованными размерами элементов рельефа, что позволило его использовать как в диапазоне больших увеличений (при прямом наблюдении кристаллической решетки), так и в диапазоне средних (вблизи 30 000-х) увеличений.
Тест-объект, просвечивающий электронный микроскоп, рельефные структуры
Короткий адрес: https://sciup.org/142185892
IDR: 142185892
Transmission electron microscope calibration by relief structures cross-sections
We propose a new type of reference material as a magnification standard of a transmission electron microscope (TEM) and a scanning transmission electron microscope. The reference material represents a thin cross-section of a silicon relief structure with certified sizes of its dements. It is fabricated using ion milling. This reference material can be used for high microscope magnifications (by direct observation of the lattice), as well as for moderate magnifications (about 30000 times).
Текст научной статьи Калибровка просвечивающего электронного микроскопа с использованием срезов рельефных структур
Просвечивающий электронный микроскоп (ПЭМ) является одним из основных средств измерения линейных размеров нанообъектов и наноструктурированных материалов. Пространственное разрешение по точкам и в режиме просвечивающего растрового микроскопа. достигает 70-80 им. Широкий диапазон реализуемых в ПЭМ увеличений (от 50 до 250 000-500 000) приводит к необходимости использования для калибровки увеличения различных по структуре и технологии изготовления тест-объектов. Как правило, для различных диапазонов увеличений используют разные тест-объекты. В области увеличений вблизи 20 000 применяют реплики с решеток, латексные сферы [1]. Для ПЭМ высокого разрешения (ВРПЭМ) (увеличение свыше 100 000), применяют тонкие срезы монокристаллов. Калибровку в этом случае проводят по межплоскостному расстоянию монокристаллов, в частности Ап и Si. Отдельную проблему представляет собой создание тест-объектов для просвечивающего растрового электронного микроскопа. (ПРЭМ). Существующие тест-объекты обладают рядом недостатков. Так, в частности, латексные сферы подвержены радиационным повреждениям, существенным является также изменение размеров из-за. контаминации. Недостатком реплик с решеток является возможное изменение их размера, в процессе снятия, неровность края. Кроме того, аттестованным является средний период между штрихами, при этом конкретное расстояние между соседними элементами может отличаться.
Наибольший интерес представляют собой тест-объекты на. основе неорганических материалов, прежде всего из кремния. Кремний является относительно радиационно стойким и механически прочным материалом. Важно, что межплоскостное расстояние кремния в процессе работ по определению числа. Авогадро было определено с относительной неопределенностью до 1 • 10—9 [2] и прослеживаемо к эталону метра [3]. Тонкие срезы кремния можно использовать для калибровки увеличения ВРПЭМ по межплоскостному расстоянию аналогично тому, как это сделано в [4, 5]. Эти объекты являются радиационно стойкими и обладают хорошей механической прочностью.
В данной работе мы предлагаем тест-объект для калибровки ПЭМ и ПРЭМ, изготовленный на. основе тонкого среза, калиброванной шаговой кремниевой структуры МШПС 2.0К
[6-9], линейные размеры рельефных элементов которой прослеживаются к эталону метра. В отличие от использованных ранее тест-объектов данный объект может применяться не только для калибровки ВРПЭМ по межплоскостным расстояниям, но и для средних увеличений, благодаря наличию в нем элементов в микрометровом диапазоне с аттестованными размерами.
Изготовление тест-объекта
Для создания тест-объекта использована шаговая структура МШПС 2.0-К, с калиброванными размерами трапециевидных элементов рельефа [6-9]. Структура изготавливается на основе пластин промышленного кремния с ориентацией (100) (отклонение рабочей поверхности от плоскости (100) не превышает 1°). Структура изготавливается методом анизотропного травления поверхности через маску, сформированную методом фотолитографии. В результате анизотропного травления формируются элементы рельефа с трапециевидным профилем, объединенные в группы по 10 элементов. На рис. 1 показана схема рельефной структуры с указанием расположения кристаллографических плоскостей, на рис. 2 - РЭМ-изображение общего вида сформированной на поверхности структуры, на рис. 3 - вид двух рельефных элементов в РЭМ. Видимое различие в яркости верхнего и нижнего оснований (рис. 3) определяется двумя факторами. Первый из них связан со значительным вкладом в видеосигнал от верхнего основания вторичных электронов, порожденных обратно отраженными электронами, выходящими через поверхность наклонных стенок. При используемом в эксперименте ускоряющем напряжении 20 кВ размер зоны выхода обратно отраженных электронов больше, чем размер выступа. Этот эффект детально рассмотрен в работе [10]. Второй фактор заключается в том, что вероятность попадания вторичных электронов из верхнего основания в детектор выше, чем из нижнего.
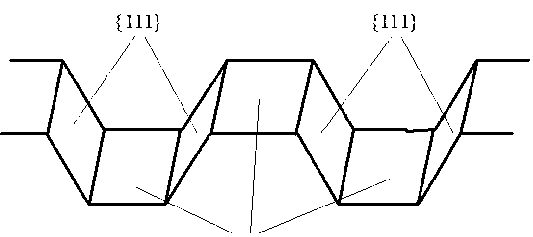
{100}
Рис. 1. Расположение кристаллографических плоскостей в рельефной структуре МШПС-2.0-К
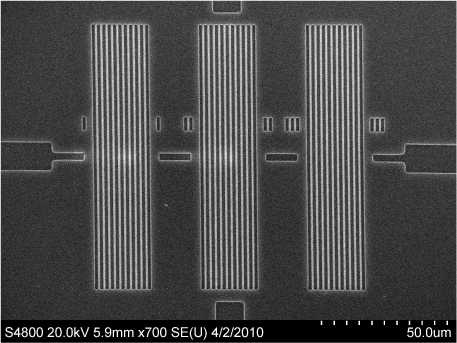
Рис. 2. Общий вид готовой структуры МШПС-2.0-К, режим ВЭЭ РЭМ
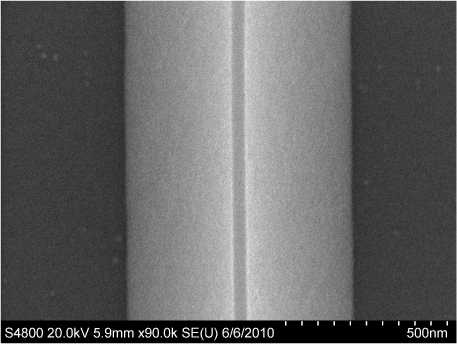
Рис. 3. РЭМ-изображение трапециевидных выступов шаговой структуры
Верхнее и нижнее основания выступов параллельны плоскости (100), боковые стенки - плоскостям (111). Описанная техника используется для получения структур с шириной верхнего основания от 10 нм до 700 нм. Тест-объект для ПЭМ готовили, осуществляя срез нескольких выступов структуры МШПС 2.0-К по плоскости, перпендикулярной направлению канавок и плоскости оснований выступов (кристаллографическое направление [100]). Плоскость среза параллельна кристаллографической плоскости кремния (ПО). При подготовке тест-объекта для ВРПЭМ использовали структуры с шириной верхнего основания, меньше чем 45 нм.
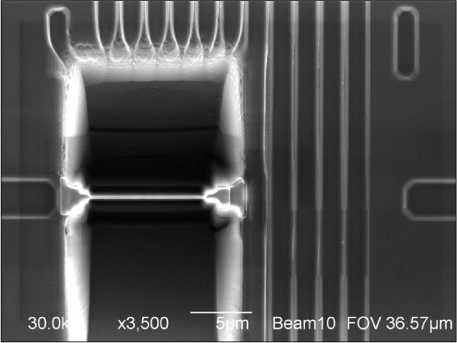
Рис. 4. РЭМ-изображение участка рельефной структуры в процессе ионного резания
Срез структуры получали с помощью ионного резания [11, 12] на установке «Multi-beam system ЛВ-4500» (JEOL). Предварительно выбранный участок структуры покрывали защитным слоем угля в газе-носителе с использованием электронной стимуляции (5 кэВ, 1 нА) до толщины около 150 нм. Затем проводили осаждение слоя углерода с помощью ионов Ga, 30 кэВ до толщины 1,0-1,5 мкм. После осаждения углерода сфокусированным пучком ионов Ga с энергией 30 кэВ формировали срез, плоскость которого ориентирована параллельно плоскости (ПО). Структура в процессе формирования среза показана на рис. 4. Полученный срез переносили в наноманипулятор IB-3201FPUS Specimen Pick-Up System, где его монтировали на стандартный держатель образца ПЭМ. Затем объект на держателе вновь помещали в Multi-beam SEM-FIB system, где укрепляли его на держателе осаждением углерода на область контакта срез-держатель и дополнительное утонение среза. Последнюю операцию для минимизации нарушенного слоя осуществляли с помощью наклонного пучка ионов Ga [13] (угол скольжения пучка с обрабатываемой плоскостью около 1°, энергия пучка 30 кэВ) до окончательной толщины среза 30-50 мкм. Использование описанной выше техники позволяет создавать срез, состоящий из трех слоев. Внутренний слой среза имеет кристаллическую структуру, тогда как два наружных слоя - аморфные [13]. Хотя наличие аморфных слоев приводит к ослаблению сигнала, оно вносит вклад в фазовый контраст в ВРПЭМ.
Исследование характеристик тест-объекта и обсуждение результатов
Срез шаговой структуры МШПС-2.0К исследован с помощью ПЭМ Titan 80-300 с корректором сферической аберрации (FEI Company) при ускоряющем напряжении 300 кВ. На рис. 5 приведено изображение в режиме прямого разрешения кристаллической структуры. На снимке видны плоскости 100 (ряды атомов, параллельные верхнему основанию) и (111) (ряды атомов, параллельные боковым стенкам). На снимке хорошо видно, что боковые стенки выступов являются с точностью до одного атомного слоя атомарно гладкими. Номинальное значение параметра решетки кремния а = 0,543102064 нм [14,15]. Следует отметить, что наличие аморфных слоев в срезе, а также повреждений, которые могут возникнуть в некоторых атомных монослоях, не вносят значительного вклада в фазовый контраст в ВРПЭМ. Это объясняется тем, что фазовый контраст является результатом взаимодействия электронов с атомами слоев, имеющих кристаллическую решетку (см. [1]). Этот факт позволяет использовать для калибровки lattice plane spacing of bulk materials (cm. [4, 5]).
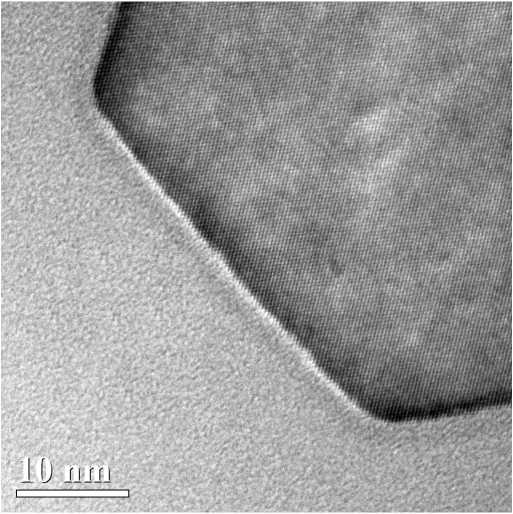
Рис. 5. Изображение тест-объекта в ПЭМ, видны атомные плоскости кремния
Высокое совершенство структуры, наблюдаемое на снимке среза (соответствие физических плоскостей и атомных рядов), позволяет использовать формулы кристаллографии для получения значений межплоскостных расстояний d 111 = 0,313560122 нм. Наличие легирования исходного материала и его уровень дефектности приводит к увеличению относительной неопределенности.
Была проведена оценка относительной неопределенности межплоскостного расстояния согласно методу, используемому в работе [2]. Тест-объекты были изготовлены с использованием кремния, легированного фосфором до уровня 1 • 1015 см-3. Бюджет неопределенности включает в себя следующие факторы. Первый фактор заключается в изменении межплоскостного расстояния кремния из-за примесей (фосфора, азота, углерода и кислорода). Второй фактор связан с возможным отклонением плоскости поверхности пластины от кристаллографической плоскости. Третий фактор - влияние температуры на период решетки. Расчеты показали, что относительная неопределенность межплоскостного расстояния не превышает 10-4. Поэтому для целей калибровки ВРПЭМ в качестве номинальных значений предложено использовать dщ. Калибровку ВРПЭМ предлагается проводить путем пересчета числа атомов на определенном участке изображения. Учитывая размеры поля зрения при наблюдении атомных плоскостей, неопределенность результата калибровки составляет около 1%. Учитывая, что погрешность, вносимая реальной дисторсией изображения, неопределенностью установки высоты образца и остаточным гистерезисом электронных линз может составлять 1-5 % [1], достигнутая точность калибровки ВРПЭМ является достаточной.
Наличие на срезе сечений элементов рельефа с аттестованными размерами позволяет использовать данный тест-объект в области более низких увеличений ПЭМ и ПРЭМ. На рис. 6 приведено изображение среза в режиме ПРЭМ при более низком увеличении. На снимке видны соседние выступы, аттестованное расстояние между которыми (2000 ± 2) нм. Отметим, что аттестованные размеры элементов микрорельефа прослеживаются к эталону метра Международной системы единиц [5]. Следует отметить, что поверхность структуры МШПС 2.0-К покрыта слоем атмосферного окисла, причем его толщина на различных кристаллографических гранях различна. Кроме того, возможна неоднородность толщины атмосферного окисла в пределах одной и той же грани. Исследования применяемого промышленного кремния и рельефных структур на его основе, показали, что неоднородность окисла в пределах одной кристаллографической грани не превышает ±0,5 нм, на различных гранях одной и той же ориентации разброс также не превышает ±0,5 нм. Поэтому, если в основу калибровки ПЭМ и ПРЭМ положить измерение шага структуры между точками, расположенными на одной и той же грани, можно пользоваться номинальным значением периода, полученным при аттестации исходной структуры, с учетом вносимой неопределенности из-за неоднородности толщины атмосферного окисла.
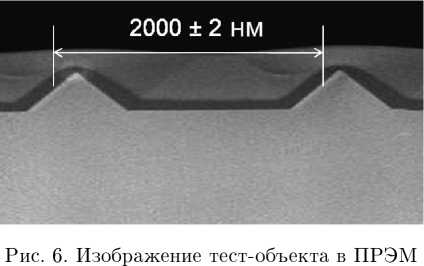
Процедура калибровки ПРЭМ вполне аналогична таковой для РЭМ и может быть проведена по аналогичной методике. Учет полного бюджета неопределенности показывает, что расширенная неопределенность калибровки в этом случае не превышает 1 нм.
Выводы
Предложен тест-объект для калибровки ПЭМ в диапазонах увеличений 100 000 х -500 000 х и 10 000 х - 35 000х, созданный методом ионного резания на основе структуры МШПС 2.0-К с аттестованными размерами элементов рельефа. Номинальные размеры тест-объекта являются прослеживаемые к эталону метра Международной системы единиц.
Неопределенность, вносимая самим материалом и способом обработки данных в режиме непосредственного разрешения кристаллической решетки, не превышает 1%.
Этот же тест-объект может использоваться для калибровки ПРЭМ с неопределенностью не более 1 нм. Предложенный тест-объект является радиационно стойким и пригоден для многократного использования.
Работа проводилась при финансовой поддержке Министерства образования и науки Российской Федерации с использованием оборудования Центров коллективного пользования МФТИ и ницпв.
Список литературы Калибровка просвечивающего электронного микроскопа с использованием срезов рельефных структур
- Reimer L. Transmission Electron Microscopy: Image Formation and Microanalysis. -Berlin: Springer, 1997.
- Becker P., Bettin H., Danzebrink H.-U., Glдser M., Kuetgens U., Nicolaus A., Schiel D., De Biиvre P., Valkiers S., Taylor P. Determination of the Avogadro constant via the silicon route//Metrologia. -2003. -V. 40 -P. 271-287.
- SRM 2000: calibration standard for high-resolution 𝑥-ray diffraction/Gaithersburg: National Institute of Standards and Technology, 2008.
- Handbook of Silicon Semiconductor Metrology/ed. by Diebold A.C. -New York: Dekker, 2001.
- Orji N.G., Dixson R.G., Garsia-Gutierrez D.I., Bunday B.D., Bishop M., Cresswell M.W., Allen R.A., Allgair J.A. TEM calibration methods for CD standards//Proc. SPIE. -2007. -V. 6518. -P. 651810.
- Novikov Yu.A., Ozerin Yu.V., Rakov A.V., Todua P.A. Method for linear measurements in the nanometer range//Meas. Sci. Technol. -2007. -V. 18. -P. 367-373.
- Novikov Yu.A., Darznek S.A., Filippov M.N., Mityukhlyaev V.B., Rakov A.V., Todua P.A. Nanorelief elements in reference measures for scanning electron microscopy//Proc. SPIE. -2008. -V. 7025. -P. 702511.
- Gavrilenko V.P., Mityukhlyaev V. B., Novikov Yu.A., Ozerin Yu.V., Rakov A.V., Todua P A. Test object of the linewidth with a trapezoidal profile and three certified sizes for an SEM and AFM//Meas. Sci. Technol. -2009. -V. 20. -P. 084022.
- Gavrilenko V.P, Filippov M.N, Novikov Yu.A., Rakov A.V., Todua P.A. Test objects for automated dimensional measurements at the nanoscale level using a scanning electron microscope//Proc. SPIE. -2009. -V. 7378. -P. 737813.
- Reimer L. Scanning electron microscopy: Physics of Image Formation and Microanalysis. -Berlin: Springer, 1998.
- Barna A., P/𝑒cz B., Menyhard M. Amorphisation and surface morphology development at low-energy ion milling//Ultramicroscopy. -1998. -V. 70. -P. 161-171.
- McCaffrey J.P., Phaneuf M.W., Madsen L.L. Surface damage formation during ion-beam thinning of samples for transmission electron microscopy//Ultramicroscopy. -2001. -V. 87. -P. 97-104.
- Gao Q., Zhang M., Niou Ch., Li M., Kary Chien W. T. Experiment study on cristal/amorphous structure of TEM samples prepared by FIB milling//Proc. 32nd Int. Symp. for Testing and Failure Analysis. -2006. -P. 76-78.
- Mohr P.J., Taylor D.N. CODATA recommended values of the fundamental physical constants//Rev. Mod. Phys. -2000. -V. 72. -P. 351-495.
- Fundamental physics constants. The NIST Reference on Constants, Units and Uncertainty. http://physics.nist.gov/cuu/Constants.


