Контроль изменений температуры поверхности полупроводниковых материалов в вакууме методом эллипсометрии
Автор: Асалханов Ю.И., Абарыков В.Н., Санеев Э.Л., Дарибазарон Э.Ч.
Журнал: Научное приборостроение @nauchnoe-priborostroenie
Рубрика: Оригинальные статьи
Статья в выпуске: 3 т.14, 2004 года.
Бесплатный доступ
Зарегистрированы температурные зависимости эллипсометрических параметров оптически полированных образцов полупроводниковых материалов на различных стадиях очистки от адсорбированных газов и следов окисла. Очистка проводилась высокотемпературным отжигом в условиях сверхвысокого вакуума. Установленная прямая пропорциональная зависимость эллипсометрического параметра Ψ от температуры для монокристаллов Si(111) свидетельствует об эффективности эллипсометрического метода в нетрадиционном его использовании - для бесконтактной регистрации изменений температуры полупроводниковых материалов в условиях вакуума. Проведено обсуждение полученных результатов.
Короткий адрес: https://sciup.org/14264346
IDR: 14264346 | УДК: 621.382
Ellipsometric control of surface temperature changes of semiconductor materials in vacuum
Тhе temperature dependences for ellipsometric parameters оf optically polished samples of semiconductor materials at various stages of clearing from the adsorbed gases and remains of oxides are obtained. The cleaning was done by high heating in super-high vacuum. The established direct proportional dependence of the ellipsometric parameter Ψ on temperature for Si(111) monocrystals proves the effectiveness of the ellipsometric method in its unconventional use, that is for contactless measurement of temperature changes of semiconductor materials in vacuum. The results are discussed.
Текст научной статьи Контроль изменений температуры поверхности полупроводниковых материалов в вакууме методом эллипсометрии
В настоящее время для исследования адсорбционных процессов, в особенности в области суб-монослойных покрытий, широко применяется эллипсометрический метод [1, 2]. Метод является бесконтактным, отличается исключительно высокой чувствительностью к присутствию инородных молекул на поверхности твердых тел (до 0.02 монослоя [3]), является неразрушающим и позволяет исследовать адсорбционные процессы непосредственно в ходе их протекания [4]. Он может быть использован в широком диапазоне температур и в различных агрессивных средах. Метод позволяет наблюдать даже процессы нарушения динамического равновесия физически адсорбирующихся молекул на границе раздела "газ—твердое тело" [5] и к тому же отличается простотой и удобством в экспериментальном плане.
Суть метода заключается в регистрации изменения состояния поляризации света при его отражении от поверхности твердых тел. Данное изменение характеризуется двумя параметрами: Д — относительным сдвигом фаз двух взаимно перпендикулярных компонент Е p и Е s световой волны и Ψ — относительным изменением амплитуд этих компонент ( Е p и Е s — компоненты электрического поля световой волны, параллельная и перпендикулярная поверхности соответственно). При появлении на исходных поверхностях каких-либо концентраций чужеродных молекул экспериментально наблюдаемые δΔ и δΨ пересчитываются согласно максвелловской теории распространения электромагнитных волн в протяженных средах в показатель преломления n 1 , коэффициент поглощения k 1 и толщину d 1 образующихся поверхностных покрытий.
Цель настоящей работы — демонстрация нетрадиционного применения эллипсометрического метода: его способность к регистрации изменений температуры полупроводниковых материалов в условиях высокого вакуума, основанная на установленной прямой пропорциональной зависимости эллипсометрического параметра У от температуры поверхности полупроводника.
ТЕОРЕТИЧЕСКОЕ ОБОСНОВАНИЕ
Различие между системами энергетических уровней объема и приповерхностной области кристалла приводит к локализации электрического заряда на поверхностных уровнях кристалла. Атомарно чистая поверхность кристалла может быть заряжена за счет локализации носителей тока на поверхностных уровнях, например таммовского типа.
Поверхностный заряд нейтрализуется объемным зарядом — носители тока из объема кристалла притягиваются в приповерхностную область. Так возникает двойной заряженный слой. Адсорбция молекул из окружающей кристалл газовой фазы меняет протяженность двойного слоя и напряженность электрического поля в его пределах.
Если на поверхности твердого тела с работой выхода ф с находится диэлектрическая пленка с работой выхода ф i , то при условии ф i - ф с > 4 kT обогащенная электронами область простирается в пленку на расстояние К о , равное [6]
K o 2
п ( 2 KT ee,
1/2
о
где
V
e2 N c J
( exp
V
Ф1^Х ) 2 kT
.. J 2nmkT V/2 Г ( ф - %) ...
N = 2 |--- exP - i — (2)
c ( h2 J L kT J эффективная плотность состояний на границе раздела. Здесь k — постоянная Больцмана; Т — абсолютная температура; £ — диэлектрическая проницаемость пленки; £0 — диэлектрическая проницаемость вакуума; % — электронное сродство материала пленки; е, m — заряд и масса электрона соответственно; h — постоянная Планка. Концентрация электронов в пленке с расстоянием х от границы раздела при этом меняется по закону
N ( x ) = N c
( А , )
А + x
V o J
а потенциал слоя объемного заряда:
V ( x ) = C • exp
■ - A
V oJ
где С — постоянная, зависящая от соотношения работ выхода пленки и подложки.
В представлении модели свободных электронов данные положения приводят к зависимости показателя поглощения света с расстоянием х от границы раздела в виде [7]

700 800 900 1000 Т, К
Рис. 1. Изменения Д после проведения предварительного обезгаживания образцов в ходе циклов "нагрев—охлаждение". Стрелками указано направление изменения температуры
K
x
к = 2ne2 Nо в Г A, n n2mопт • ю(ю2 + в2)LA, + x
Здесь k и n — коэффициент поглощения и показатель преломления пленки; в = l / т о — декремент затухания колебаний электрона, происходящих под действием электрического поля световой волны; т о — характерное время затухания колебаний; го — частота возбуждающего излучения; m опт — оптическая масса электрона, N о — число осцилляторов в единице объема отражающей поверхности.
Характер изменения Kx с расстоянием, определяющий значения k и n поверхности и соответственно значения Д и V, устанавливается протяженностью Ао и потенциалом слоя объемного заряда V(x). В свою очередь Ао и V(x), задаваемые уровнем электронейтральности контактирующих сред Фо, зависят от числа и рода молекул, адсорбированных на единице поверхности монокристалла. Последовательное удаление адсорбата субмонос-лойного диапазона с поверхности изменяет протяженность двойного слоя Ао и напряженность электрического поля Е в его пределах. Результатом суперпозиции напряженности электрического поля двойного слоя и Еp и Еs — компонент электрического поля световой волны, проходящей через двойной слой, — является относительное изменение отношения параметров отраженной и па- дающей световых волн Еp.отр / Еp.пад и Еs.отр / Еs.пад, определяемое параметром V.
Меняющийся наряду с этим градиент концентрации свободных электронов вдоль нормали к поверхности, т. е. в направлении E s -компоненты, и отсутствие такового для Ep -компоненты приводят к относительному сдвигу фаз между ними, что выражается в изменении параметра Д .
ЭКСПЕРИМЕНТ
Измерения выполнены в цельнометаллической вакуумной ( Р пред = (2 + 3) ^ 10-7 Па) системе, позволяющей проводить, в частности, регистрацию изменений эллипсометрических параметров поверхности, степень покрытия поверхности различными адсорбатами, а также наблюдение и запись термодесорбционного масс-спектра с поверхности исследуемых образцов на любой стадии образования или удаления адсорбата [8]. Описание элементов установки и способа регистрации эллипсометрических параметров приведены ранее [9–12].
РЕЗУЛЬТАТЫ И ИХ ОБСУЖДЕНИЕ
На рис. 1 представлен один из этапов изменения ∆ , наблюдающийся в цикле "нагрев—охлаждение" монокристаллов Si(111). После регистрации медленно меняющихся значений ∆ производилось изменение температуры в направлении, указанном стрелками. Общая продолжительность измерений составляла около 8 ч. Для устранения громоздкости на графике нанесены не все зарегистрированные значения ∆ , полученные при различных температурах монокристаллов. Представлены шесть последовательных циклов. Циклы со 2-го по 6-й из соображений наглядности смещены по шкале значений ЭП с выбором масштаба, обеспечивающего ясность деталей. В данном режиме отжига образцов наблюдается постепенное уменьшение разности значений при температуре образцов, равной 670 К, — соответственно около 1.5, 1, 0.5о и т. д. При 6-м и дальнейших прогревах монокристаллов необратимые изменения параметра ∆ в данном температурном диапазоне отсутствуют. При этом общее изменение ∆ составляет величину около 3.5о.
На рис. 2 представлены изменения параметра Ψ , соответствующие изменениям ∆ , приведенным на рис. 1. В данном температурном диапазоне с большой точностью (несколько угловых минут) наблюдается прямая пропорциональная зависимость Ψ ( Т ). На рисунке приведены три семейства прямых Ψ ( Т ). Разнос семейств сделан специально для того, чтобы показать одинаковость поведения Ψ во всех циклах нагрева образца до одной и той же температуры Т i. max . На самом же деле все три семейства прямых расположены в достаточно узком "коридоре" значений Ψ , в области, обозначенной индексом А.
На рис. 3 представлены изменения ∆ и Ψ , наблюдающиеся при комнатной температуре монокристаллов после их отжига до температур, указанных на рисунке. Данный общий ход изменений ∆ и Ψ установлен на основании зависимостей, аналогичных приведенным на рис. 1 и 2, с различными значениями максимальных температур отжига Т i. max . Последовательные отжиги при Т i. max проводились после 10–12-часовой выдержки образцов при комнатной температуре в вакууме ~10–6 Па. Видно, что эллипсометрический параметр ∆ увеличивается почти прямо пропорционально температуре отжига в трех определенных температурных интервалах, вплоть до Т i .max ≅ 1180 К, после чего изменения ∆ резко меняются на обратные. При этом поверхность теряет оптическую полировку, резко возрастает деполяризация отраженного светового луча, и точное определение значений ∆ становится затруднительным.

700 800 900 1000 £ К
Рис. 2. Изменения Ψ после проведения циклов "нагрев—охлаждение", представленных на рис. 1
Изменения Ψ носят аналогичный характер, но направления их изменений противоположны изменениям параметра ∆ . При этом величины изменений Ψ значительно меньше изменений ∆ и границы между интервалами прямых пропорциональных зависимостей с различными угловыми коэффициентами менее резко выражены.
Представленные изменения δΔ и δΨ , согласно теории Друдэ [1, 2], можно интерпретировать как последовательное удаление слоев адсорбата, полагая, что для его удаления или какой-то его части необходима вполне определенная температура. Зависимости δΔ ( T t ) и δΨ ( T t ) во время многократных отжигов поверхности образцов до T t ≤ T i .max с последующим охлаждением до 300 К, представленные на рис. 3, отражают, по-видимому, температурную зависимость n ( Т ) и k ( Т ) поверхностей с остающимися на них пленками оки-слов. В пользу данного предположения говорит то обстоятельство, что величина необратимых изменений Δ , как это видно из рис. 1, уменьшается с ростом температуры отжига образцов.
На рис. 4 представлена запись изменения температуры образца (монокристалл Si(111)), записанная
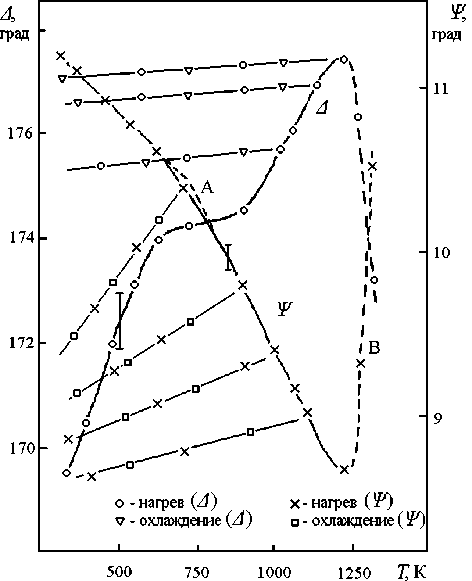
Рис. 3. Изменения параметров ∆ и Ψ монокристаллов Si(111) после их отжига до указанных температур. Пунктиром отмечен диапазон неустойчивых изменений ∆ и Ψ . Прямые линии (A, B) — зависимости ∆ ( Т ) и Ψ ( Т ) при многократном повторении циклов "нагрев (монокристаллов до заданной температуры, не превышающей температуру проведенного отжига)—охлаждение (до комнатной)" с точностью нескольких угловых минут
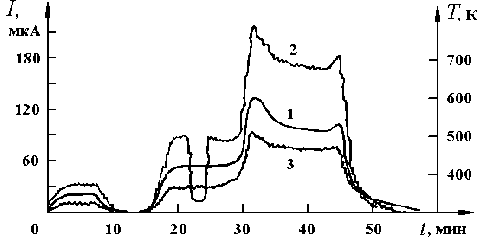
Рис. 4. Зависимость тока ФЭУ при неизменных азимутах элементов эллипсометра от температуры образца при разных углах падения света на образец (2 и 3). 1 — запись температуры образца, проведенная с помощью вольфрам—рениевой термопары. Спад уровня тока ФЭУ после 20-й минуты вызван вращением поляризатора и установкой его в исходное положение
с помощью вольфрам—рениевой термопары (кривая 1) и запись изменения тока фотоумножителя ФЭУ-29 для двух углов падения света на поверхность (кривые 2 и 3). Элементы эллипсометра ЛЭФ-3М находятся в состоянии "гашения". Запись свидетельствует о наличии в достаточной степени прямой пропорциональной зависимости между током фотоумножителя и температурой поверхности образца и аналогичной зависимости эллипсометрического параметра Ψ и температуры поверхности монокристалла. Запись демонстрирует также наличие сильной угловой зависимости относительного изменения амплитуд Е p и Е s компонент светового луча эллипсометра от температуры поверхности. Изменение тока ФЭУ вызвано изменением состояния поляризации отраженного луча, на что указывает спад уровня тока ФЭУ после 20-й минуты, когда производилось "гашение" интенсивности отраженного света изменением азимута поляризатора, соответствующего в избранной схеме измерения азимуту Ψ . Как видно из записи, чувствительность измерения составляет при указанных ранее условиях величину около 4.2 град/угл.мин, т. е. изменение температуры на 4.2º вызывает поворот осей эллипса поляризации отраженного света на одну угловую минуту, что, в свою очередь, в указанных ранее условиях, вызывает изменение тока фотоумножителя на величину, равную (1.0–1.5) мкА. Следует отметить тот факт, что чувствительность эллипсометрического параметра Ψ к изменению температуры поверхности увеличивается со степенью покрытия θ . Прямая пропорциональная зависимость при многократных прогревах поверхности при постоянном θ при этом сохраняется. Отжиг поверхности при более высокой температуре, приводя к уменьшению θ , сопровождается уменьшением чувствительности на что указывает уменьшение углового коэффициента данной прямой пропорциональной зависимости.
ВЫВОДЫ
-
1. Диэлектрическая проницаемость двойного электрического приповерхностного слоя, обусловленная энергетическими уровнями молекул адсорбата и энергетическими уровнями приповерхностной области кристалла, изменяется вследствие десорбции молекул при отжиге кристалла.
-
2. Электрическое поле двойного слоя, напряженность которого нормальна к поверхности кристалла, при суперпозиции с электрическим полем падающей на поверхность поляризованной световой волны изменяет состояние ее поляризации. При этом величина напряженности поля определяет относительное изменение амплитуд световой волны Ψ , а больцмановское распределение кон-
- центрации свободных электронов в двойном слое относительно нормали к поверхности определяет относительный сдвиг фаз световой волны ∆. Сдвиг фаз электромагнитных волн зависит от разности концентраций электронов сред, через которые распространяются волны.
-
3. При постоянной степени покрытия нагрев полупроводника приводит к возрастанию числа свободных электронов и, следовательно, к возрастанию ∆ . Однако, как видно из рис. 3, это возрастание значительно меньше, чем убыль Ψ , что приводит к заключению — рост концентрации свободных электронов более резко уменьшает напряженность поля двойного слоя.
-
4. Прямая пропорциональная зависимость Ψ ( Т ), позволяя осуществить бесконтактную регистрацию изменения температуры полупроводниковых материалов, показывает, что изменения эллипсометрических параметров не обязательно связаны с образованием каких-либо покрытий на поверхностях твердых тел.
Работа выполнена в рамках научно технической программы "Университеты России".
Список литературы Контроль изменений температуры поверхности полупроводниковых материалов в вакууме методом эллипсометрии
- Ржанов А.В. и др. Основы эллипсометрии. Новосибирск: Наука, 1979. 365 с.
- Аззам Р., Башара Н. Эллипсометрия и поляризованный свет. М.: Мир, 1981. 583 с.
- Archer R.J.//Opt. Soc. Amer. 1962. V. 52. P. 970.
- Bartell L.S., Betts J.F. A Radiotracer Study of an Optical Method for Measuring Adsorption//J. Phys. Chem. 1960. V. 64. P. 1075-1076.
- Способ определения времени установления равновесного состояния адсорбированного слоя молекул на поверхности полупроводниковых материалов: А. с. 1749782 РФ/Асалханов Ю.И., Домбровский И.И., Дарибазарон Э.Ч./Опубл. 1992. БИ. № 27.
- Мотт Н., Герни Р. Электронные процессы в ионных кристаллах. М.: ИЛ., 1950. 304 с.
- Roberts E.F.I., Ross D. Anomalous Optical Constants of Thin Films//Surf. Sci. 1976. V. 56. P. 425-439.
- Асалханов Ю.И., Иванов К.Н., Ширапова Д.Ц.//ПТЭ. 1991. № 1. С. 167.
- Устройство для позиционирования образца в вакууме: А. с. 146661 СССР/Асалханов Ю.И., Дондоков Д.Д., Пронькинов И.Т./Опубл. 1988. БИ. № 24. С. 4.
- Асалханов Ю.И., Санеев Э.Л. Изменение работы выхода и прозрачности потенциального барьера монокристаллов W(100) и GaAs(110) при удалении естественного окисла с поверхности//ФХОМ. 2002. № 3. С. 66-72.
- Асалханов Ю. И., Санеев Э.Л. Поведение эллипсометрических параметров монокристаллов Si(111) при удалении адсорбата с их поверхности//Опт. и спектр. 2003. Т. 95. № 3. С. 424-428.
- Асалханов Ю.И. Исследование адсорбции газов на поверхности Мо(100) эллипсометрическим методом. Дисс.... канд. физ.-мат. наук: 01.04.07. Л.: ЛГУ, 1975. 127 с.


