Моделирование воздействия позитивного и негативного фоторезиста на LER-эффект
Автор: Кульпинов М.С., Лосева В.В., Балашов А.Г., Красюков А.Ю., Калнов А.Д.
Журнал: Международный журнал гуманитарных и естественных наук @intjournal
Рубрика: Технические науки
Статья в выпуске: 11-2 (98), 2024 года.
Бесплатный доступ
В работе проведен анализ и оценка влияния негативного и позитивного тона фоторезиста на образование неровностей фоторезистивной маски и шероховатостей ширины линий. Проанализирована взаимосвязь между вариацией шероховатости, критическим размером и шагом с помощью моделирования.
Позитивный тон фоторезиста, негативный тон фоторезиста, неровности фоторезистивной маски, шероховатость ширины линии, критические размеры
Короткий адрес: https://sciup.org/170208875
IDR: 170208875 | DOI: 10.24412/2500-1000-2024-11-2-237-240
Modeling the effects of positive and negative photoresist on the LER effect
The paper analyzes and evaluates the influence of the negative and positive tone of the photoresist on the formation of irregularities of the photoresistive mask and roughness of the line width. The relationship between the variation of roughness, critical size and pitch is analyzed using modeling.
Текст научной статьи Моделирование воздействия позитивного и негативного фоторезиста на LER-эффект
Предварительная оценка неровностей фо-торезистивной маски позволяет сделать прогнозы относительно параметров проектируемых элементов, что позволит учитывать возможные отклонения, возникающие в технологическом процессе при производстве нано-электронных устройств. Величина шероховатости ширины линии (LWR) и шероховатости края линии (LER) фоторезистивной маски является все более важным источником ошибок в литографической обработке. Сдвиг порогового напряжения и ток утечки в выключенном состоянии в типичном МОП-транзисторе и более продвинутых устройствах FinFET могут зависеть от LER и LWR [1]. Неровности формируемых элементов конечного затвора транзистора в основном обусловлены шероховатостью рисунка фоторезиста, напечатанного в процессе литографии, который частично переносится на стек затворов во время последующих этапов плазменного травления [2].
В процессе литографии часто встречаются различные критические размеры (CD) и шаблоны шага на одной маске, включая различ- ные рабочие циклы. В конечном итоге на пластинах из этих различных шаблонов будут видны различные неровности фоторезистив-ной маски. Тщательный анализ изменений LER-эффекта в различных шаблонах помогает выявить слабые места процесса, улучшая стабильность литографического процесса и обеспечивая оптимальную производительность продукта [3]. Это исследование демонстрирует механизм путем моделирования аэрофотоснимков и концентраций ингибиторов для изучения корреляции между шероховатостью и шаблонами изменения CD и шага.
В ходе исследования рассматриваются два фоторезиста: один с проявлением позитивного тона (PTD), а другой с проявлением негативного тона (NTD). В частности, два материала представляли собой химически усиленные позитивные фоторезисты с высокой контрастностью и разрешением. Толщина и однородность фоторезиста измеряются и поддерживаются на рабочем уровне. Стопки пленок на двух пластинах идентичны. Структура подслоя включает органическое нижнее антибли- ковое покрытие (BARC), за которым следует слой SiON [4]. Применялись различные шаблоны для исследования изменения LER путем изменения шага и фиксации линии критических размеров. Все тестовые шаблоны экспонировались на одной маске, что означает идентичные условия процесса. Полученные образцы были обследованы с помощью сканирующего зондового микроскопа, и данные LER были записаны для анализа изменения шероховатости с различными образцами [5].
Сначала изучается тенденция изменения шероховатости на пластине с позитивным тоном фоторезиста. Как показано на рисунке 1, когда CD зафиксирован на 90 нм, LER уменьшается с 17 нм до 13 нм при увеличении шага от 100 до 200 нм. Уменьшение шероховатости можно четко увидеть на изображении SEM, края линейного рисунка довольно изви- листые, есть некоторые спайки внизу, когда шаг составляет 100 нм. Край линейного рисунка постепенно становится прямым при увеличении шага до 200 нм, контраст между линией и пространством улучшается в то же время. Подобная тенденция изменения LER наблюдалась, когда CD был зафиксирован на 130 нм. LER уменьшился с 18 нм до 14 нм при изменении шага от 150 нм до 180 нм. Небольшой рост LER наблюдался при дальнейшем увеличении шага до 200 нм, значение LER изменилось до 15 нм [6-8]. Этот отскок можно объяснить ошибками измерения. Приведенные выше данные показывают, что более низкий рабочий цикл тестового образца приводит к более выраженным неровностям фоторезистивной маки в позитивном тоне фоторезиста.
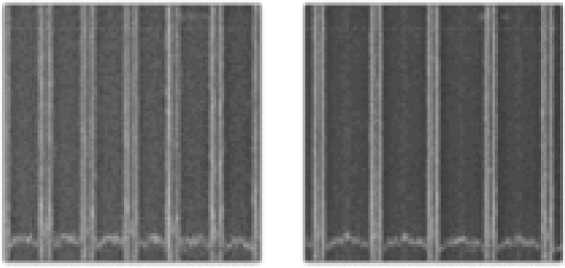
Рис. 1. SEM-изображение неровностей фоторезистивной маски позитивного тона фоторезиста
Анализ LER также выполняется на пластине с негативным тоном фоторезиста для дальнейшего изучения изменения шероховатости (рис. 2). При изменении шага с 130 нм до 180 нм значение LER увеличивается с
13 нм до 15 нм. Это говорит о том, что для пластин с негативным фоторезистом, чем выше рабочий цикл тестового шаблона, тем ниже неровности фоторезистивной маки [9-11].
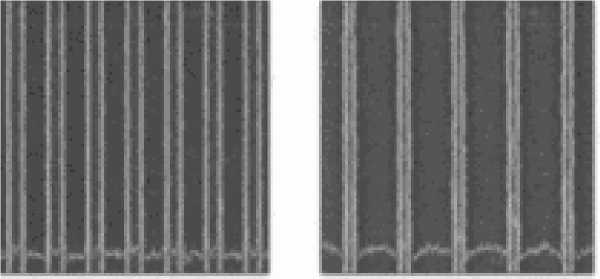
Рис. 2. SEM-изображение неровностей фоторезистивной маски негативного тона фоторезиста
Наблюдаемая тенденция изменения LER в пластине негативным тоном фоторезиста контрастирует с поведением пластины позитив- ным тоном фоторезиста, разница в подходах к проявлению способствует этому результату. Фактически, в течение одного шага тестового шаблона малый рабочий цикл в пластине PTD и большой рабочий цикл в пластине NTD оба демонстрируют увеличение прозрачной области в пределах шага, это также подразумевает расширение области воздействия. На основа- нии вышеупомянутых результатов можно сделать вывод, что при воздействии в идентичных условиях более полированная поверх- ность линии достигается за счет увеличения области воздействия в пределах шага [12].
Чтобы глубже изучить взаимосвязь между вариацией шероховатости, критическим размером и шагом, был проанализирован базовый механизм этого явления с помощью моделирования, параметры моделирования установлены на основе фактических параметров процесса. Результаты моделирования успешно воспроизвели данные кремния, показав, что вариация шероховатости узоров на двух пластинах с различными методами проявления согласуется с данными кремния [13]. В частности, на пластинах с позитивным тоном фоторезиста фиксированный критический размер соответствует меньшему значению LER по мере увеличения шага и наоборот, на пластинах с негативным тоном фоторезиста больший шаг приводит к большему значению неровностей фоторезистивной маски.
Дополнительные расчеты моделирования выполняются для анализа аэрофотоснимка и концентрации ингибитора, учитывая как оптические, так и химические аспекты. В случае пластины PTD интенсивность аэрофотоснимка постепенно увеличивается с шагом, что говорит о том, что больше фотонов может быть захвачено фоторезистом. Следовательно, увеличивается генерация молекул кислоты и уменьшается статистическая неопределенность распределения кислоты. Концентрация ингибитора изменяется быстрее с увеличени- ем шага, что указывает на уменьшение случайности диффузии фотокислоты. В результате происходит более организованное и предсказуемое движение молекул кислоты, что приводит к более высокой тенденции к накоплению в целевой области и созданию более гладких границ между линиями и пространством. На пластинах NTD фиксированный критический размер и малый шаг приводят к более высокой интенсивности аэрофотоснимка, что также приводит к более быстрым изменениям концентрации ингибитора и уменьшению LER [14]. Согласно данным моделирования выше, независимо от используемого метода проявления, увеличение площади экспозиции шага приводит к более гладким краям линий и уменьшению значения LER.
Таким образом увеличение площади экспозиции фоторезиста приводит к улучшению шероховатости и эта связь сохраняется при различных методах проявления. Большая площадь экспозиции позволяет фоторезисту захватывать больше фотонов, что приводит к образованию дополнительных фотокислот посредством химических реакций усиления.
Список литературы Моделирование воздействия позитивного и негативного фоторезиста на LER-эффект
- Huynen M., Waeytens R., Bosman D., Gossye M., Rogier H., Ginste D.V. Reduced-Order Stochastic Testing of Interconnects Subject to Line Edge Roughness // IEEE 27th Workshop on Signal and Power Integrity (SPI), Aveiro, Portugal, 2023.
- Kang I., Kim T., Hur S., Ban C., Park J., Oh H. Line width roughness variation and printing failures caused by stochastic effect at extremeultraviolet exposure // Proc. SPIE 11609, Extreme Ultraviolet (EUV) Lithography XII, 116091K, 22 February 2021.
- Brunner T.A., Chen X., Gabor A., Higgins C., Sun L., Mack C.A. Line-edge roughness performance targets for EUV lithography // Proc. SPIE 10143, Extreme Ultraviolet (EUV) Lithography VIII, 101430E, 24, March, 2017.
- Rahmani M., Ahmadi V., Faez R. Engineered nanopores-based armchair graphene nanoribbon FET with resonant tunneling performance // IEEE Trans. Electron Devices. - 2019. - Vol. 66, № 12. - Pp. 5339-5346.
- Seo J., Jung S., Shin M. The performance of uniaxially strained phosphorene tunneling field- effect transistors // IEEE Electron Device Lett. - 2017. - Vol. 38, № 8. - Pp. 1150-1152. EDN: YIZUDO


