О перспективах создания кремниевого полевого СВЧ-транзистора для работы в режиме температур 450-700 К
Автор: Федотов А.Б.
Журнал: Физика волновых процессов и радиотехнические системы @journal-pwp
Статья в выпуске: 4 т.17, 2014 года.
Бесплатный доступ
Предложена модель кремниевого МДП-транзистора, предназначенного для работы в импульсном режиме вплоть до T = 550 К. Основная особенность модели заключается в аномально высоком уровне легирования области стока. Выполнена оценка скорости деградации рабочих параметров прибора. Показано, что время работоспособности прибора при длине канала L ~ 600 нм и глубине его расположения под рабочей поверхностью x_10 ≥ 500 нм составляет не менее 1,5 лет. Расчеты времен деградации выполненные для T = (600-700) К могут быть полезны при проектировании высокотемпературных приборов на базе широкозонных полупроводников.
Кремниевый полевой свч-транзистор, импульсный режим, высокий уровень легирования области стока, скорость деградации
Короткий адрес: https://sciup.org/140255886
IDR: 140255886
About the prospects of silicon field-effect transistor microwave for running a temperature of 450-700 K
Proposed a model of silicon MOS transistor designed for pulsed operation up to T = 550 K. The main feature of the model is an abnormally high level of doping drain region. The estimation of the rate of degradation of the operating parameters of the device. It is shown that the uptime of the device when the channel length L ~ 600 nm and depth of its location beneath the work surface x_10 ≥ 500 nm is not less than 1.5 years. Calculations of the degradation performed for T = (600-700) K may be useful in the design of high-temperature devices based on wide bandgap semiconductors.
Текст научной статьи О перспективах создания кремниевого полевого СВЧ-транзистора для работы в режиме температур 450-700 К
Полупроводниковые приборы, предназначенные для эксплуатации при высоких температурах, востребованы в различных областях современной техники. В частности, они применяются в системах безопасности ядерных реакторов, аэрокосмических технологиях, электроэнергетике, вулканологических исследованиях, глубинном бурении, могут быть полезны при мониторинге двигателей внутреннего сгорания, создании роботов для работы в экстремальных условиях [1–3; 5].
Выбор базового полупроводникового материала для полупроводниковых диодов и транзисторов обусловлен не в последнюю очередь требованием предотвращения теплового пробоя; по оценкам [4; 5], тепловой пробой кремниевых транзисторов, работающих в непрерывном режиме, неизбежен уже при температуре коллекторного перехода T = 500 К. Немаловажным обстоятельством является также проблема ограничения токов утечки и обратных токов p – n -переходов, что является особенно критичным фактором для работы биполярных и полевых транзисторов как в дискретном, так и в интегральном вариантах исполнения.
В силу этих причин большие надежды возлагались и отчасти возлагаются поныне на широкозонные полупроводники, среди которых можно выделить карбид кремния SiC, ширина за- прещенной зоны которого в зависимости от типа кристаллизации принимает значения в интервале A Eg е (2, 36—3,23) эВ и фосфид галлия GaP с шириной запрещенной зоны A Eg = 2,25 эВ.
Однако несмотря на то, что эти материалы характеризуются слабой летучестью компонентов в широком интервале температур и сравнительно высокой стойкостью к воздействию ионизирующих излучений [1–3], необходимо учитывать как существенный недостаток, низкую подвижность их носителей заряда. Уже при комнатной температуре T = 300 К подвижность электронов как в SiC, так и в GaP не превыша- см2
ет значения цn = 250 . С увеличением рабочей температуры T следует ожидать уменьшения подвижности по закону цn (T) = цn (300)(300 / T)-3/2 (1) вследствие рассеяния носителей на акустических фононах [6].
Данное обстоятельство ставит под сомнение перспективу применимости широкозонных полупроводников в качестве материалов для создания элементной базы СВЧ-устройств. В этой связи представляется целесообразным возврат к традиционным материалам микроэлектроники GaAs и кремнию (A E g = 1,43 и 1,12 эВ соответственно). Транзисторы на их основе, будучи малоперспективными для работы в непрерыв-

Рис. 1. Вариант кремниевого МДП-транзистора с V-образной канавкой: 1 – исток; 2 – затвор; 3 – сток; 4 – диэлектрик (SiO 2 )
ном режиме при температурах T > 500 К (см. выше), могут оказаться вполне работоспособными при существенно более высоких температурах в случае их использования в импульсном режиме , а также в качестве маломощных ячеек памяти. В этой паре материалов кремний, уступая арсениду галлия в подвижности носителей 22
заряда (цn = 1500 —— против 8500 ), обладает преимуществом более долговечного материала, что связано с высокой летучестью кристаллов GaAs и сопутствующим ростом концентрации вакансий в подрешетке мышьяка в обсуждаемом интервале температур [7; 8]. Как известно, p–n-переходы в кремнии работоспособны в непрерывном режиме вплоть до 270° C даже при уровне легирования базы Nб = 1015 см-3 [9]. Но концентрацию неосновных носителей, ответственную за работоспособность и определяемую температур 450–700 К. Для исследования выбран топологический вариант МДП-транзистора с V-образной канавкой (рис. 1). Традиционный метод создания n+ -p-n-n+-структуры, изображенной на рис. 1, основан на поэтапной диффузии атомов бора и фосфора в кристалле кремния n-типа.
На первом этапе проводится диффузия бора для формирования области с дырочной проводимостью и границы x 2 между каналом и областью стока. Вслед за этим с помощью диффузии фосфора формируется сильно легированная n + -об-ласть истока с границей p – n -перехода x 1. Одновременно n + -область создается вблизи стокового контакта, который на рис. 1 отмечен цифрой 3. Эта технология позволяет достичь предельно малых, субмикронных значений длины канала L « x2 - Х 1 , что является необходимым условием для работы прибора в диапазоне СВЧ. Однако требование минимизации длины канала при работе в высокотемпературном режиме вступает в противоречие с требованием стабильности характеристик прибора. По свидетельству [11; 12] в интервале температур 450 < T < 1200 К атомы легирующих примесей фосфора и бора мигрируют в Si по ускоренному междоузельному механизму; зависимость их коэффициентов диффузии от температуры имеет вид:
D P = 0,335 exp ( -1,86 eV / kT ) см2 / с , (2) D В = 1,58 ■ 10 - 3exp ( -2,50 eV / kT ) см2 / с . (3)
При этих обстоятельствах неправомерно пренебрегать диффузионным перераспределением атомов легирующих примесей в случае эксплуатации транзистора в экстремальных условиях (высокие температуры, воздействие ионизирующих излучений и т.д.), когда диффузионные длины D B t и, в особенности, D P t не являются пренебрежимо малыми по сравнению с длиной канала. В частности, в случае длительной эксплуатации прибора при температурах T > 450 К следует ожидать заметного смещения границ p – n -переходов x 1 и x 2. Это смещение и связанное с ним изменение длины канала L необходимо учитывать, поскольку оно неизбежно влечет за собой деградацию основных рабочих характеристик транзистора.
С учетом вышеизложенного одномерная краевая задача для дополнительной разгонки обеих примесей в процессе эксплуатации либо хранения прибора при T е (450-700) К ставится на системе уравнений диффузии

Рис. 2. Начальные условия: 1) N р ( x ,0 ) , 2) N в ( x ,0 ) , 3) N стока

Рис. 3. Диффузионное смещение границы ( x 1 ): Х 10 = 634 нм, x 20 = 1086 нм, Т — 500 К

Рис. 4. Уменьшение длины канала: x 10 — 224 нм (1), 295 нм (2), 367 нм (3), 442 нм (4), 518 нм (5), 576 нм (6), 634 нм (7)
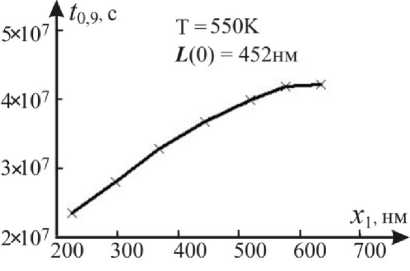
Рис. 5. Время деградации транзистора в зависимости от x 10
n - p — N р ( x , t ) + N стока - N B ( x , t ) . (7)
С помощью (7) координаты физических границ слоев x 1,2 могут быть определены из условия n - p — 0 (рис. 2, 3). Вычисления проводились на интервале времен эксплуатации 0 > t < 4 ■ 10 9 c для температур T — 450, 500, 550, 600, 650, 700 К. Расчеты показывают, что эффект смещения границ x 12 при температуре эксплуатации 450 К пренебрежимо мал на всем исследованном интервале времен. По всей видимости, этот эффект не имеет практического значения также и при температуре T — 500 К. На рис. 3 показаны расчетные профили n - p — f ( x ) для этой температуры и времен работы в интервале от t — 0 (начальные условия, кривая 1) до t — 4 ■ 10 9 с (кривые 2–4). Рисунок показывает, что заметного смещения границы x 1 можно ожидать лишь через 109 с (приблизительно 30 лет работы или хранения при T — 500 К).
Аналогичные результаты расчета длины канала в зависимости от времени термостатирования при T — 550 К и различных исходных значений x 10 представлены на рис. 4. Учитывая, что дли-

Рис. 6. Время деградации транзистора в зависимости от длины канала при фиксированном значении x 20

на канала является основным топологическим параметром, определяющим характеристики транзистора, в качестве времени деградации прибора предлагается принять время tдегр = t09, в течение которого длина канала уменьшается на 10% по сравнению с исходным значением L (°).
Значения этого параметра для различных исходных глубин канала x 10 определялись графически на пересечении семейства зависимостей L ( t ) и горизонтальной пунктирной линии 0,9 L ( 0 ) (рис. 3).
Графики зависимостей времени деградации при температуре T = 550 К от исходной глубины границы «исток-затвор» ( x 10) и от исходной длины канала при фиксированном значении границы «затвор-сток» ( x 20) представлены на рис. 5, 6.
Графики показывают, что параметры транзистора с достаточно стабильными характеристиками должны удовлетворять условиям:
-
1) глубина границы канала х ^ > 500 нм;
-
2) ее исходная длина L ( 0 ) > 600 нм.
Такие параметры обеспечивают работоспособность прибора в течение ( 4-6 ) ■ 10 7 с (1,5-2 года) при T = 550 К1.
Деградация основных характеристик транзистора (коэффициент усиления по напряжению, эффективная подвижность носителей заряда в коротком канале, предельная рабочая частота и другие) определяется в основном деградацией длины канала, однако имеются особенности, вынуждающие рассматривать каждую из харак- теристик в отдельности.
Коэффициент усиления в ( dU стока
/ dU затвора ^
I стока const с точностью до множителя, зависящего от выбора рабочей точки и близкого по значению к
Т= 1) 450К, 2) 500К, 3) 550К, 4) 600К, 5) 650К, 6) 700К
Рис. 7. Коэффициент усиления единице, как функция длины канала определяется соотношением в = 4 L / 5 L , где
5 L
U стока 2 бб 0
\ eN e стока
– модуляция длины канала. В рассматриваемой 19 - 3
модели транзистора N стока = 2 ■ 10 см , что при б = 12 и U стока = 5 В дает значение Р 0 = 99. Скорость деградации этой характеристики для разных температур эксплуатации либо хранения показана на рис. 7, где нумерация кривых соответствует температурам: 1) T = 450 К, 2) T = 500 К, 3) T = 550 К, 4) T = 600 К, 5) T = 650 К и 6) T = 700 К. С помощью рисунка можно определить время деградации по коэффициенту усиления по горизонтальной отсечке на уровне 0.9Р 0 .
Эффективная подвижность электронов в коротком канале определяется выражением ц L = ц n ( 1 - a / L ) , где эмпирический параметр a = 0,35 мкм [9], а ц n — подвижность электронов в длинном канале ( L » a ), которая в связи с рассеянием на фононах сама по себе является убывающей функцией температуры (1). В связи с этим определение времени деградации по отсечке 0.9ц l 0 теряет смысл. Тем не менее рис. 8, иллюстрирующий зависимость ц L ( t ) , дает возможность оценить значение этого параметра при разных временах и режимах термостатирования.
В частности при T = 550 К эффект короткого канала вкупе с эффектом рассеяния на фононах уменьшает ц L более чем в 10 раз, что существенно больше эффекта диффузионного смещения границ p – n -переходов. Однако необходимо подчеркнуть, что диффузионное смещение,
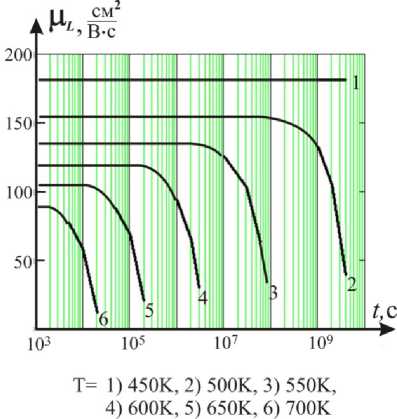
Рис. 8. Эффективная подвижность электронов
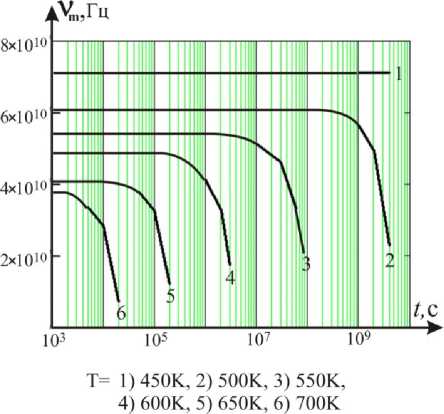
Рис. 9. Предельная рабочая частота
несмотря на свою относительную малость, является необратимым, в отличие от эффектов рассеяния и короткого канала.
Аналогичный вывод можно сделать относительно температурной и временной зависимостей предельной рабочей частоты транзистора, оцениваемых по формуле
V m = Ц L U стока (рис. 9).
2 n L 2
Заключение
Исследована возможность создания кремниевого полевого транзистора с индуцированным каналом, предназначенного для работы в высокотемпературном режиме. Предложена модель высоколегированного транзистора, предположительно работоспособного в импульсном режиме вплоть до T = 550 К. Поставлена и решена краевая задача для диффузионного смещения границ p – n -переходов при длительном термостатировании в интервале T е (450-700) К.
Установлено, что скорость диффузионной деградации МДП-транзистора зависит от исходной длины канала L ( 0 ) и ширины слоя истока х ^. длины канала. В частности, при L ( 0 ) > 600 нм и Х ю > 500 нм время необратимого уменьшения длины канала на 10 % достигается по истечении 1,5–2 лет эксплуатации или хранения при T = 550 К. Аналогичные результаты, полученные для T е (600-700) К, могут быть полезны для проектирования высокотемпературных приборов на базе широкозонных полупроводников.
Список литературы О перспективах создания кремниевого полевого СВЧ-транзистора для работы в режиме температур 450-700 К
- Полищук А. Полупроводниковые материалы и приборы для жестких условий эксплуатации // Совр. технологии. 2006. № 4. С. 20-24.
- Панютин Е.А. Высокотемпературные приборы на основе фосфида галлия: эпитаксиальная технология, концепция легирования, электрические свойства: автореф. дис.. канд. физ.-мат. наук. СПб.: ФТИ им. А.Ф. Иоффе РАН, 2009. 22 с.
- Жиляев Ю.В., Панютин Е.А., Федоров Л.М. Высокотемпературные динисторы на основе фосфида галлия // Письма в ЖТФ. 2009. Вып. 17. С. 50-57.
- Китаев В.Е., Бокуняев А.А., Колканов М.Ф. Расчет источников электропитания для средств связи. М.: Радио и связь, 1993. 232 с.
- Пожела Ю.К. Физика быстродействующих транзисторов. Вильнюс: Мокслас, 1989. 264 с.
- Шалимова К.В. Физика полупроводников. М.: Лань, 2010, 400 с.
- Айспрук Н. Арсенид галлия в микроэлектронике. М.: Мир, 1988. 555 с.
- Кузнецов Ф.А. Процессы роста полупроводниковых кристаллов и пленок. Новосибирск: Сибирское отделение РАН, 1988. 195 с.
- Гуртов В.А. Твердотельная электроника. М.: Мир, 2005. 492 с.
- Федотов А.Б. Оценка скорости изменения параметров биполярного СВЧ-транзистора, работающего в высокотемпературном режиме // Физика волновых процессов и радиотехнические системы. 2014. Т. 17. № 1. С. 45-49.
- Александров О.В. Модель высоко- и низкотемпературной диффузии фосфора в кремнии по дуальному парному механизму // ФТП. 2001. Т. 35. Вып. 11. С. 1289-1298.
- Velichko O.I., Aksenov V.V., Kovaleva A.P. Modeling of the interstitial diffusion in crystalline silicon // Journal of Engineering Physics and Thermophysics. 2012. Vol. 85. № 4. P. 926-932.


