Оценка скорости изменения параметров биполярного СВЧ-транзистора, работающего в высокотемпературном режиме
Автор: Федотов А.Б.
Журнал: Физика волновых процессов и радиотехнические системы @journal-pwp
Статья в выпуске: 1 т.17, 2014 года.
Бесплатный доступ
Вычислена скорость изменения топологических параметров (ширина и уровень легирования базы, коэффициент неоднородности) биполярного p-n-p-транзистора, предназначенного для работы при температурах T = [500-700] K. Выполнена оценка скорости деградации рабочих параметров прибора. Показано, что достаточно стабильный высокотемпературный транзистор должен иметь уровень легирования базы не менее 5*10 18 см -3 при достаточно большой глубине ее залегания.
Свч-транзистор, высокотемпературный режим, топологические параметры, скорость деградации, уровень легирования
Короткий адрес: https://sciup.org/140255850
IDR: 140255850
Evaluation parameters rate of change of the microwave bipolar transistor operated in the high mode
Calculated rate of change of topological parameters (width and doping level of the base as well as the coefficient of heterogeneity) bipolar p-n-p-transistor, designed for operation at temperatures T = [500-700] K. The estimation of the degradation rate of operating parameters of the device. It is shown, that stable enough high-level transistor must have at least base doping k = 8,62*10 -5 eV/K at a sufficient depth of its occurrence.
Текст научной статьи Оценка скорости изменения параметров биполярного СВЧ-транзистора, работающего в высокотемпературном режиме
Проблема улучшения характеристик биполярных СВЧ-транзисторов принуждает проектировщиков к уменьшению ширины их базы [1—3]. С другой стороны, имеющиеся литературные данные [4; 5] свидетельствуют о том, что в интервале температур 450 < T < 1200 K атомы легирующих примесей фосфора и бора мигрируют в кремнии по ускоренному междо-узельному механизму; зависимость их коэффициентов диффузии от температуры имеет вид D р = 0,335 exp ( -1,86 eV / kT ) см2 / с и D р = 1,58 ■ 10 - 3 exp ( -2, 50 eV / kT ) см2 / с соответственно. Здесь постоянная Больцмана подставляется в виде к = 8,62 ■ 10 5 eV / K).
При этих обстоятельствах актуализируется проблема, связанная с диффузионным перераспределением атомов легирующих примесей в случае эксплуатации транзистора в экстремальных условиях (высокие температуры, воздействие ионизирующих излучений и т. д.), когда диффузионные длины ^ D в t и в особенности ^D p t не являются пренебрежимо малыми по сравнению с шириной базы. Это перераспределение и связанное с ним изменение топологических параметров структуры необходимо учитывать, поскольку оно неизбежно влечет за собой деградацию основных рабочих характеристик прибора.
1. Постановка задачи
Цель данной работы состояла: а) в расчете кинетикидиффузионных процессовв кремниевых p — n — p -транзисторах, предназначенных для работы при температурах T е ( 500 ^ 700 ) K; б) в прогнозировании предельного срока их службы, а также в выработке рекомендаций по проектированию указанного класса приборов.
Для исследования была выбрана p — n — p -структура, несмотря на то что в этом варианте неосновными носителями в базе, определяющими быстродействие прибора в целом, являются дырки, чья подвижность уступает подвижности электронов в кремнии. Дело в том, что для нормальной работы высокотемпературного прибора необходимо обеспечить более высокий уровень легирования базы по сравнению с обычными приборами, поскольку выпрямляющие характеристики обоих p — n -переходов в случае низколегированной базы ( N базы < 1017 см 3 ) резко ухудшаются. Уже при T = 500 K равновесная концентрация собственных носителей заряда в 14 - 3
кремнии достигает значения n ^ ® 10 см против n ® 1010 см - 3 при комнатной температуре. Поэтому для предотвращения неприемлемо высокой равновесной концентрации неосновных носителей в базе ~ ni 2 / N базы необходимо повысить уровень ее легирования по меньшей мере до значения N б азы = 5 ■ 1018 см - 3. Технологически
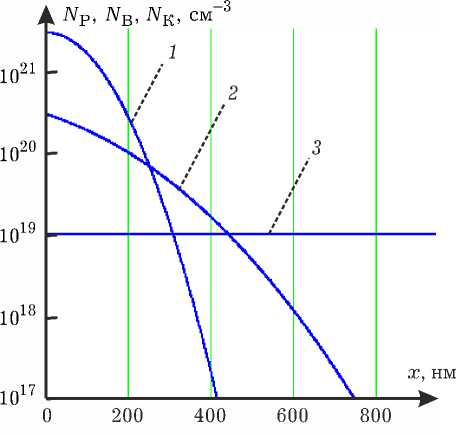
Рис. 1. Начальные условия (тонкая база): 1 — N в ( x ,0 ) ; 2 — N P ( x ,0 ) ; 3 — N K
это требование удобнее осуществить в случае, когда базу формирует донорная примесь (фосфор). Таким образом, можно сказать, что, выби- рая вариант p–n–p вместо n–p–n-транзистора, мы жертвуем уменьшением подвижности неосновных носителей заряда в базе (и, кстати, коэффициента инжекции у = 1 - N базы/ Nэмиттера) в обмен на работоспособность прибора при высо- ких температурах.
Такой прибор может быть изготовлен по двухэтапной технологии, в которой на первом этапе проводится формирование эмиттерного слоя путем ионной имплантации атомов бора в монокристаллическом кремнии p-типа, легированном акцепторной примесью до концентрации NK = const, на втором — формирование базы с помощью диффузии фосфора из неограниченного источника с одновременной дополнительной разгонкой бора. Повышение уровня легирования базы влечет за собой требование к ширине эмиттера; она должна быть сопоставима по порядку величины с шириной базы.
В связи с вышеизложенным одномерная краевая задача для дополнительной разгонки обеих примесей в процессе эксплуатации прибора при температурах T е (500 т 700) K была сформулирована в виде системы уравнений диффузии dNP _ d2NP dNB _ d2NB dt " P dx2 ; dt " B dx2 ’ решаемых при начальных условиях (рис. 1)
- 3
,
N p ( x , 0 ) = 3 ■ 1020 erfc ( x / x p 0 ) см
N в ( x , 0 ) = 3,0 ■ 1021 exp ( - x 2 / x B 0 ) см
- 3
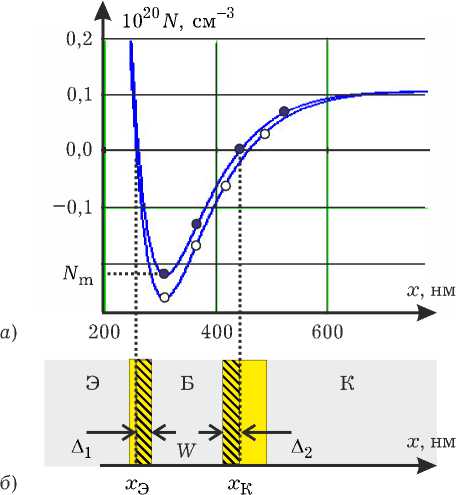
Рис. 2. Тонкая база, N к = 1019 см 3, T = 500 K: а ) профили N , t = 0 ( • ), t = 3 ■ 10 8 с ( ° ); б ) к расчету ширины базы (см. текст)
и граничных условиях, соответствующих отражающей границе x = 0:
д N p в(0, t ) z ч
P,Bk ; = 0 , N p,B ( », t ) = 0. (3)
-
д x
В выражениях (1)–(3) NP и NB – концентрации атомов фосфора и бора; параметры xP0 и xB0 – исходные диффузионные длины фосфора и бора, соответственно. Эти параметры ва- рьировались с целью сравнения двух вариантов структуры транзистора: с шириной базы W1 = 180 нм (далее — тонкая база) и W2 = 360 нм (широкая база) при различных значениях ширины эмиттера. Также (как дополнительный фактор регулирования исходной ширины базы и эмиттера) варьировался уровень легирования t = 3 ■ 108 с (~ 10 лет) при температуре T = 500 K в сравнении с исходным профилем N (x, 0) . Соответственно, металлургическая ширина базы определяется как L (t) = xк - xэ.
Физическая ширина базы вычисляется по формуле W ( t ) = L ( t ) - А 1 - А 2 , где А 12 — длины областей пространственного заряда (ОПЗ) в базе вблизи эмиттерного и коллекторного переходов (рис. 2, б ). На рисунке эти области изображены в виде прямоугольников с косой штриховкой. Используя известные выражения для А 12 из [6], получаем
W ( t ) = L ( t )
-
2ББ 0 Аф э eN р ( x э , t )
-
2ББ 0 Афк eN р ( x к , t )
где Б = 11, 7 — диэлектрическая проницаемость кремния; Аф э к — высоты потенциальных барьеров эмиттерного и коллекторного переходов. Для кремния принимается Аф э = Аф к = 1 В.
Коэффициент неоднородности донорной примеси в базе определяется как отношение n = W /2 ^ 0 , где l 0 – расстояние, на котором концентрация доноров уменьшается в e = 2,72 раза. Этот параметр как функция времени определялся путем численного решения уравнения
N P ( x Э + ^ 0 , t ) = e — 1 N P ( x Э , t ) .

Рис. 3. Коэффициент усиления, T = 500 K: а ) x р0 = 215 нм ( х ), 294 нм ( о ), 865 нм ( • ); б ) x р0 = 280 нм ( х ), 400 нм ( о ), 1080 нм ( • )
Результаты расчета относительного увеличения уровня легирования базы А N m / N m , ее ширины А W / W и коэффициента неоднородности Ап / П для времени работы прибора t = 3 ■ 10 8 с и рабочей температуры T = 500 K представлены в таблице ниже. Из данных этой таблицы следует, что стабильность топологических параметров существенно зависит от начальных условий (2). Скорость изменения уровня легирования, ширины базы и коэффициента неоднородности резко уменьшается вместе с увеличением исходной ширины базы, а также с увеличением параметров N K и x P0.
Этой информации, однако, еще недостаточно для выбора оптимальной конфигурации высокотемпературного СВЧ-транзистора. Необходимо наряду с данными таблицы учитывать скорость изменения его рабочих характеристик.
3. Деградация характеристик транзистора
Коэффициент переноса и коэффициент инжекции вычислялись по формулам / = 1 - W 2 х х ( 1 + n ) / L p и у = 1 - N p ( x э , t ) / N в ( 0, t ) . Здесь
L p = kTT ц p т r — диффузионная длина дырок; ц p — их подвижность; т r — время рекомбинации [6].
Низкочастотный коэффициент усиления по току в схеме с общим эмиттером вычисляется как в = а ( 1 - а ) 1, где а = у/. Очевидно, величина в определяется тем из сомножителей, который больше отличается от единицы. Принимая для T = 500 K (и с учетом повышенного уровня легирования базы) значения ц p = 50 см2 / В ■ с и т r = 4 ■ 10 5 с [7], можно убедиться, что для высокотемпературного транзистора выполняется соотношение 1 - у » 1 - / при обоих вариантах ширины базы. Поэтому в качестве разумного приближения для коэффициента усиления было принято: в = У ( 1 - у ) 1 . Таким образом, в практически не зависит от ширины базы. Зато весьма существенна зависимость этого параметра от текущего значения у = 1 - N p ( x э , t ) / N в ( 0, t ) . Именно этот фактор обуславливает высокую скорость деградации в в случае сравнительно малых диффузионных длин x P0 и, соответственно, малых глубин коллекторного перехода (рис. 3). Рисунок показывает, что стабилизация достижима путем увеличения параметра x P0 за счет существенного уменьшения коэффициента усиления.

Рис. 4. Деградация СВЧ-характеристик, T = 500 K. Точечные линии – тонкая база; сплошные – широкая база (см. пояснения к рис. 3): а ) время пролета; б ) предельная частота; в ) сдвиг фаз
^^^^^^в
Время пролета дырок т = 0, 5тr (W / Lp ) (1 -n) 1, предельная рабочая частота транзистора упр = 2,53 (Lp / W) [2лтr (1 + n)] и фазовый сдвиг сигнала на коллекторе Аф = arctg (vtrW2 / / 2Lp), как функции времени эксплуатации представлены на рис. 4. Сдвиг фаз вычислялся для рабочих частот 1 ГГц (тонкая база) и
500 МГц (широкая база). В случае сравнительно неглубоких коллекторных переходов (малых значений NК и xP0) для всех параметров ожида- ется 10 ^ 20 -процентная деградация за 5 ^ 10 лет работы при T = 500 K. Увеличение значений Nк и xP0 эффективно стабилизирует все характеристики, но сопряжено с увеличением времени пролета приблизительно в 2 раза (рис. 4, а).
Максимальная рабочая частота высокотемпературного транзистора при ширине базы 180 нм не превысит vп р = 2 ГГц. Уменьшение этого параметра до значений W = 50 ^ 100 нм может решить проблему и позволит увеличить vп р до 10 ГГц, если удастся преодолеть трудность обеспечения достаточно высокого уровня легирования базы.
-
4. Прогноз срока службы прибора при рабочих температурах T > 500 K
Ожидаемый срок службы длительностью в несколько лет представляется вполне достаточным на фоне быстрого морального устаревания приборов и техники СВЧ. Ниже будет показано, что эти сроки труднодостижимы уже при T = 600 K. Для оценки этих сроков в качестве критерия был избран параметр t ( 10 % ) , определенный как время изменения ширины базы на 10 ^.
Нетрудно убедиться, что краевая задача (1)–(3) инвариантна по отношению к сомножителям произведения D р ( T ) t , если пренебречь сравнительно медленным смещением границы эмиттер–база. Иными словами, изменение ширины базы при любой температуре эксплуатации однозначно определяется величиной произведения D р ( T ) t . Из этого, в свою очередь, следует, что величина параметра t ( 10 % ) для любой рабочей температуры в интервале Т е 500 ^ 700 K может быть рассчитана на основе соотношения t ( 10 % ) = 1 500 D р ( 500 ) / D p ( T ) , где 1 500 — значение этого параметра при T = 500 K.
Результаты этого расчета для тонкой и широкой базы приведены на рис. 5, а , б . Видно, что при увеличении температуры эксплуатации скорость деградации стремительно растет; в результате изменение параметров транзистора с базой 180 нм на 10 ^ может произойти уже через 1 ^ 2 часа работы прибора при T = 700 K.
Заключение
Достаточно стабильный кремниевый биполярный p – n – p -транзистор, предназначенный для работы при температурах до T = 500 K включительно, может быть реализован. Условия этой реализации: 1) повышение уровня ле-
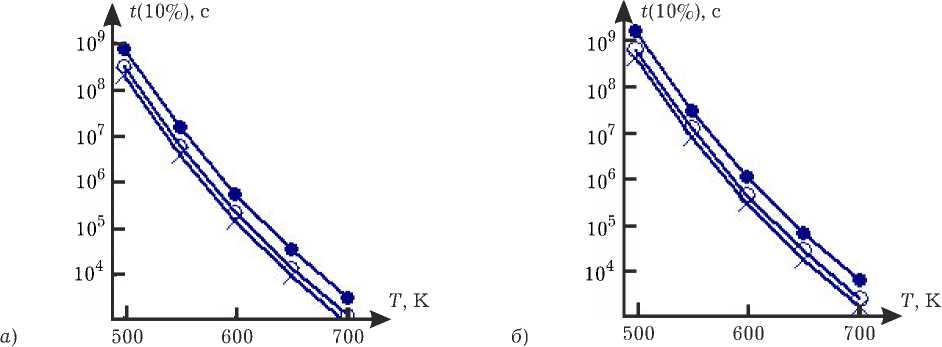
Рис. 5. Время изменения (прогноз), A W / W = 10% (см. пояснения к рис. 3): а ) тонкая база; б ) широкая база
гирования базы по меньшей мере до значения N р = 5 ■ 10 18 см 3 ; 2) обеспечение максимальной глубины залегания коллекторного перехода при 20 - 3
уровне легирования коллектора N к = 10 см .
При ширине базы 180 нм рабочая частота такого транзистора может достигать значения 2 ГГц, а коэффициент усиления в = 18.
Таблица
|
7 s о о ю II |
Тонкая база, W = 180 нм |
A N m / N m = 72 % A W / W = 25 % An / n = 9,1 % ( x P0 = 215 нм) |
7 s о о II |
A N m / N m = 18,6 % A W / W = 11 % An / n = 4,4 % ( x P0 = 294 нм) |
7 о II |
A N m / N m = 2,7 % A W / W = 2 % An / n = 2,7 % ( x P0 = 865 нм) |
|
Широкая база, W = 360 нм |
A N m / N m = 16,6 % A W / W = 7,7 % An / n = 1,3 % ( x P0 = 280 нм) |
A N m / N m = 3,1 % A W / W = 3,3 % An / n = 1,1 % ( x P0 = 400 нм) |
A N m / N m = 0,6 % A W / W = 0,6 % An / n = 0,2 % ( x P0 = 1080 нм) |
Список литературы Оценка скорости изменения параметров биполярного СВЧ-транзистора, работающего в высокотемпературном режиме
- Пожела Ю.К. Физика быстродействующих транзисторов. Вильнюс: Мокслас, 1989. 264 с.
- Hansen O. Diffusion in a short base // Solid-State Electronics. 1994. V. 37. № 9. P. 1663-1669.
- Pulfrey D.L., St. Denis A.R., Vaidyanatham M. Compact modeling of high-frequency smoll-dimention bipolar transistor // IEEE COMMAD98. 1998. P. 1-5.
- Александров О.В. Модель высоко- и низкотемпературной диффузии фосфора в кремнии по дуальному парному механизму // ФТП. 2001. Т. 35. Вып. 11. С. 1289-1298.
- Velichko O.I., Aksenov V.V., Kovaleva A.P. Modeling of the interstitial diffusion in crystalline silicon // Journal of Engineering Physics and Thermophysics. 2012. V. 85. № 4. P. 926-932.
- Гуртов В.А. Твердотельная электроника. М.: Мир, 2005, 492 с.
- Шалимова К.В. Физика полупроводников. М.: Энергоатомиздат, 1985. 392 с.


