Определение параметров уровней, участвующих в процессе деградации светодиодов на основе InGaN
Автор: Грушко Наталья Сергеевна, Вострецова Любовь Николаевна
Журнал: Известия Самарского научного центра Российской академии наук @izvestiya-ssc
Рубрика: Физика и электроника
Статья в выпуске: 4-4 т.14, 2012 года.
Бесплатный доступ
В работе исследуются изменение вольт-амперных характеристик светодиодов синего свечения с модулированным и однородным легированием на основе GaN и его твердых растворов при длительной наработке и под воздействием -облучения (0,1 – 0,5 Мрад). Установлен различный механизм изменения электрических свойств исследуемых структур в зависимости от вида легирования. Определены параметры уровня, участвующего в создании туннельного потока.
Cветодиоды, деградация, рекомбинация, туннелирование, яркость
Короткий адрес: https://sciup.org/148201333
IDR: 148201333 | УДК: 621.315.592
Defining the parameters of levels involved in the degradation of leds based on InGaN
Тhe change of the current-voltage characteristics of the LEDs glow blue with the modulated and uniform doping based on GaN and its solid solutions with a long running time and under the influence of γ-irradiation (0.1 - 0.5 Mrad) was studied. Defined a different mechanism to change the electrical properties of the structures depending on the type of doping. The parameters of the levels involved in the creation of the tunnel flow.
Текст научной статьи Определение параметров уровней, участвующих в процессе деградации светодиодов на основе InGaN
Полупроводниковые приборы на основе InGaN и GaN обладают широким диапазоном рабочих температур, служат основой для устройств высокотемпературной оптоэлектроники, обладают высокой яркостью и всепогодным исполнением, применяются в устройствах с меняющейся информацией, а также в системах атмосферной оптической связи, охранных системах [1 - 3]. Преимуществом таких светодиодных (СД) осветительных приборов является малое потребление энергии, малое тепловыделение, вибростойкость, отсутствие специальных патронов, достаточная гамма излучения, высокая долговечность. СД синего свечения используются для получения прибора белого свечения. По сравнению с лампами накаливания светодиоды способны обеспечить более высокий квантовый выход и долговременную стабильность [4-5]. Однако процессы изменения характеристик светодиодов под действием внешнего воздействия продолжают оставаться важной проблемой для светодиодов.
Исследованию процессов деградации при длительной наработке СД на основе гетероструктур посвящено большое число экспериментальных и теоретических работ [6-8]. В работе [6] представлены результаты экспериментальных исследований деградации вольтамперных (ВАХ) и ваттамперных характеристик СД на основе гетероструктур InGaN на SiC при длительном воздействии электрической нагрузки. Установлено, что заметная деградация ВАХ в области микротоков начинается в первые 100 часов работы под нагрузкой, обнаружено появление неустойчиво-
стьи в области контактов. Процесс деградации контактного соединения приводил в конечном итоге к полному отказу СД.
В [7] исследовались синие СД с InGaN/GaN -квантовой ямой, через которые в течение нескольких часов пропускались токовые импульсы. После деградации синих InGaN/GaN СД, ускоренной токовыми импульсами амплитудой до 50 мА, наблюдались нестабильные утечки прямого тока. В режиме коротких импульсов обнаружена задержка в распределении интенсивности ЭЛ по площади, а при увеличении длительности импульсов — темные участки вблизи p-контактных площадок. Изменение относительной яркости с напряжением в участках под p- -контактом в рабочем СД вызвано повышением плотности отрицательно заряженных акцепторных граничных состояний.
В [8] исследовалось изменения люминесцентных и электрических характеристик СД на основе InGaN при длительной работе. Обнаружено две стадии старения исследуемых структур, связанные с активацией акцепторов магния и образованием донорных вакансий.
В работе [9] исследовались вольт-амперные характеристики при комнатной температуре до и после гамма облучения для транзисторов на основе AlGaN/GaN, выращенных на сапфире. Ток насыщения показывает нелинейную зависимость от дозы излучения. Отклонение параметров устройства не превышает 20 % при самой высокой дозе, 109 Рад, и устройства с большой длиной затвора показывают более высокую радиационную стойкость. Установлено, что для маленькой лучевой дозы до 7 105 Рад, основные параметры транзистора – ток насыщения и крутизна, были улучшены после облучения.
В работе [10] исследовалось влияние на СД на основе GaN/InGaN с многими квантовыми ямами гамма излучения Со-60 при очень высоких дозах до 2 Град (Si). Установлено, что InGaN/
GaN –СД с длинами волны в диапазоне 410-510 нм являются все еще эксплуатационными после после облучения гамма-квантам с дозами до 2 Град (Si)
В данной работе исследовались изменения ВАХ характеристик структур на основе InGaN синего свечения под действием длительного протекания прямого тока (0 - 750 часов) иу-облуче-ния с дозами 0,1 – 0,5 МРад.
-
2. ИССЛЕДОВАНИЕ ПРОЦЕССА ДЕГРАДАЦИИ СТРУКТУР С ОДНОРОДНЫМ И МОДУЛИРОВАННЫМ ЛЕГИРОВАНИЕМ
НА ОСНОВЕ INGAN/GAN
Эксперимент проводился на СД Hewlett Packard синего свечения на основе твердого раствора InGaN. Исследовалось две группы образцов. Деление образцов на группы проведено по виду профиля распределения легирующей примеси: с однородным и модулированным легированием активной области. На рис. 1 приведен профиль легирования исследуемых структур, определенный по методике [11-13].
Эксперимент показал, что изменение оптических и электрических характеристик исследуемых структур различно.
В случае модулированного легирования квантовой ямы наблюдается уменьшение яркости свечения образцов по мере увеличения времени наработки на прямом токе 30 мА. При этом на ВАХ наблюдается увеличение туннельной составляющей тока (рис. 2а).
В работе [14] показано, что туннельная составляющая в неоднородных полупроводниковых структурах описывается выражением
Ir = U^U SdU )o,N 2, (1), где to - вероятность туннелирования через потенциального барьера, N – концентрация глубоких уровней, S – площадь р-п-перехода, d – ширина области пространственного заряда (ОПЗ), определяемая из ВФХ структур, Uk – контактная разность потенциалов, k – постоянная Больцмана, T – температура.
Из (1) можно получить выражения для тока в структуре с КЯ, если учесть, что вероятность туннелирования в таких структурах описывается выражением [15]:
to(U ) = to о exp (yU), (2), где to0 - постоянная, характеризующая туннельную прозрачность потенциального барьера, y □
N d
N a
В выражении (2) используется вероятность туннелирования, отнесенная к единичной концентрации состояний N, по которым идет пере- to(U)
нос: to ( U ) ^ n (3) [16]. Тогда:
Ir = kT TTSd U H N ехр(уи). (4) Uk - U
Из формулы (4) видно, что увеличение туннельной составляющей связано с увеличением концентрации глубоких центров, отвечающих за безызлучательную рекомбинацию.
В работе [17] предложен метод определения

Рис. 1. Профиль легирующей примеси для структуры: а – с модулированным легированием; б – с однородным легированием
10 -1
I, A 10 -2
10 -3
10 -4
-5
10 -13
10 -14
10 -6
10 -7
10 -8
10 -9
10 -10
10 -11
10 -12

а)
10 -1
10 -2
10 -3
10 -4
10 -5
10 -6
10 -7
10 -8
10 -11
10 -9
10 -10
10 -12
-13

U,B
10 -15
U,B
10 -15
Рис. 2. Вольт-амперные характеристики исследуемых структур: а – с модулированным легированием; б – с однородным легированием
энергии уровня, участвующего в создании туннельной составляющей ВАХ, по зависимости приведенной скорости рекомбинации R np = f(U) (рис. 3).
R np
ax
x2 + bx + d
ня и его коэффициент захвата: Е=0,9 эВ, с= 0 , 72 - 10 — 12 см3/с.
Анализ зависимости R np = f(U) при разных временах наработки показал, что в процессе деградации не изменяется энергия глубокого центра и его коэффициент захвата. Значение приведенной скорости рекомбинации в макси-
toN2
a =--- ni
, n 2toN , toNn, ; b=—+---; d=—г ni nic cni2
муме пропорционально величине
np N . 2 t
Из условия максимума функции -. p = 0
находим, что d = x2 . Выбирая две точкИ на за-max висимости Rnp (U ) вблизи максимума, мы получаем уравнение для нахождения b :
-
K = R R
np 1
np 2
x1 ( x 2 + bx 2 + d x 2 ( x^ + bx 1 + d
Зная b и d , из (5) определяем n 1 n i :
отношение
Y = ni ni
b — -J b 2 — 8 d
.
С учетом (6) из d определяем коэффициент захвата уровня, а из выражения для Y - положение уровня:
to NY c = ,— dn i ,
E t
kT ln[ N ^
.
По положению максимума на зависимости
R- пр = f(U) (8) были определены энергия уров-
С ледовательно, увеличение туннельного тока, и как следствие возрастание амплитуды максимума зависимости приведенной скорости рекомбинации от напряжения, связано с увеличением концентрации глубоких центров, ответственных за безызлучательную рекомбинацию.
Так у структур с однородным легированием активной области наблюдается уменьшение туннельной составляющей на начальном этапе наработки (0-750 часов). ВАХ исследуемых структур при разном времени наработки приведены на рис. 2б
Из формулы (1) видно, что уменьшение туннельной составляющей связано с уменьшением концентрации глубоких центров (возможно упорядочивание границы раздела InGaN/GaN), отвечающих за безызлучательную рекомбинацию.
На концентрационных профилях структур с однородным легированием наблюдается увеличение максимума профиля на границе с активной областью (квантовой ямой). Подобное поведение профилей заряженной примеси наблюдалось в работе [18], и связано с активацией акцепторных центров Mg при разрушении комплексов Mg-H.
На рис. 4 приведены ВАХ структуры на основе InGaN с модулированным легированием для разных доз у -облучения.

Рис. 3. Приведенная скорость рекомбинации при 250 часах наработки

Рис. 4. ВАХ структуры а основе InGaN/GaNс модулированным легированием при различных дозах у -облучения
Из рис. 4 видно, что при малых напряжениях токи, протекающие через облучённые образцы, значительно меньше тока, протекающего через необлученный образец при соответствующих напряжениях. На участке ВАХ 2.3ё2.5 В графики для всех образцов “сливаются” в одну линию. С дальнейшим увеличением напряжения значение силы тока облучённых образцов вновь растёт быстрее, чем необлучённого, причём для меньшей дозы облучения растёт быстрее.
Анализ показал, что после облучения в образцах сохраняется такой механизм токо-переноса, как прыжковая проводимость, но значительно меняются распределение плотности локализованных состояний после облучения.
По зависимости приведенной скорости рекомбинации R np = f(U) определена энергии уровня, участвующего в создании туннельной составляющей ВАХ (рис. 5, таблица 1).
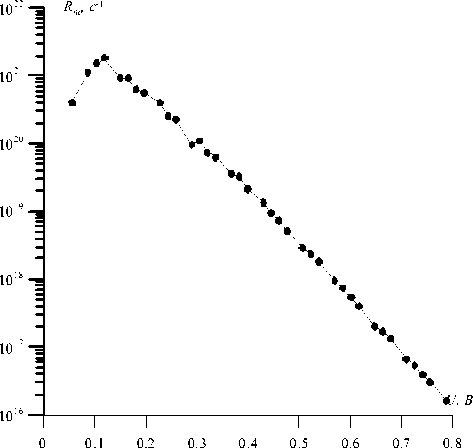
Рис. 5. Приведенная скорость рекомбинации при дозе у — облучения 0,3 Мрад
|
Доза, МРад |
E t , эВ |
|
R пр |
|
|
0 |
1.7 |
|
0.3 |
1.67 |
|
0.5 |
1.71 |
ЗАКЛЮЧЕНИЕ
В ходе проведенных исследований обнаружено следующее:
. В случае модулированного легирования квантовой ямы наблюдается уменьшение яркости свечения образцов по мере увеличения времени наработки на прямом токе 30 мА.
. В случае однородного легирования квантовой ямы наблюдается увеличение яркости СД на протяжении 750 часов наработки. Уменьшение туннельной составляющей связано с уменьшением концентрации глубоких центров (возможно упорядочивание границы раздела InGaN/GaN), отвечающих за безызлучательную рекомбинацию.
. Установлено, что в случае однородного легирования квантовой ямы наблюдается уменьшение яркости свечения образцов по мере увеличения времени наработки на прямом токе 30 мА. При этом на ВАХ наблюдается увеличение туннельной составляющей тока. Туннельная составляющая в неоднородных полупроводниковых структурах пропорциональна концентрации глубоких уровней, вероятности туннелирования через потенциальный барьер, а также определяется зависимостью вероятности туннелирования от приложенного напряжения. Увеличение туннельной составляющей связано с увеличением концентрации глубоких центров, отвечающих за безызлучательную рекомбинацию.
. Для определения энергии уровня, участвующего в создании туннельной составляющей ВАХ использовался метод по зависимости приведенной скорости рекомбинации от напряжения. По положению максимума на зависимости были определены энергия уровня и его коэффициент захвата: Е=0,9 эВ, с=0,72·10-12 см3/с.
. Малые дозы ионизирующего g-излучения инициируют уменьшение числа дефектов и упорядочение структуры. Значительная доля дефектов компенсируется на границах раздела слоев гетероструктуры – следствие локального разогрева [19-20].
Работа выполнена при поддержке Министерства образования и науки Российской Федерации в рамках федеральных целевых программ “Научные и научно-педагогические кадры инновационной России на 2009 - 2013 годы” и “Исследования и разработки по приоритетным направлениям развития научно-технологического комплекса России на 2007-2013 годы”
Список литературы Определение параметров уровней, участвующих в процессе деградации светодиодов на основе InGaN
- Полищук А., Туркин А. Светодиодные светильники -эффективный метод решения проблемы энергосбережения//Энергосбережение. 2008. № 2. С. 8
- Гужов С., Полищук А. Концепция применения светильников со светодиодами совместно с традиционными источниками света//СТА. 2008. №1, С. 14 -18
- Туркин А., Аверин Е. Применение мощных светодиодов в освещении//Энерго Style. 2009. №1. С. 10 -19.
- Грушко Н.С., Хайрулина А.С. Параметры белых светодиодов InGaN/AlGaN/GaN: светоотдача, КПД, координаты цветности//Опто-наноэлектроника, нанотехнологии и микросистемы: Труды Х международной конференции. Ульяновск, 2008. С. 252.
- Гридин В.Н., Рыжиков И.В., Виноградов В.С., Щербаков В.Н. Полупроводниковая лампа -источник освещения, альтернативный лампам накаливания и электролюминесцентным лампам//Компьютерная оптика. 2008. Т. 32. № 4. С. 375 -383.
- Ефремов А.А., Бочкарева Н.И., Горбунов Р.И., Лавринович Д.А., Ребане Ю.Т., Тархин Д.В., Шретер Ю.Г. Влияние джоулева разогрева на квантовую эффективность и выбор теплового режима мощных голубых InGaN/GaN светодиодов//ФТП. 2006. Т. 40. Вып 5. С. 621 -627.
- Бочкарева Н.И., Ефремов А.А., Ребане Ю.Т., Горбунов Р.И., Клочков А.В,Шретер Ю.Г. Неоднородность инжекции носителей заряда и деградация голубых светодиодов//ФТП. 2006. Т. 40. Вып. 1. С. 122 -127.
- Полищук А., Туркин А. Деградация полупроводниковых светодиодов на основе нитрида галлия и его твердых растворов//Компьютеры и технологии. 2008. №2. С. 25 -28.
- Low-Frequency Noise in AlGaN/GaN High Electron Mobility Transistors Irradiated by g-Ray Quanta/Vitusevich S.A., Klein N., Petrychuk M.V., Belyaev A.E., Danylyuk S.V., Konakova R.V., Avksentyev A.Yu., Danilchenko B.A., Tilak V., Smart J., Vertiatchikh A., and Eastman L.F.//Investiphys. Stat. Sol. (c) 0. No. 1. 78-81 (2002).
- Ren High dose Co-60 gamma irradiation of InGaN quantum well light-emitting diodes/Rohit Khanna, Sang Youn Han, and S. J. Pearton, D. Schoenfeld, W. V. Schoenfeld, F.//Applied Physics Letters, 87, 212107 _2005
- Берман Л.С. Ёмкостные методы исследования полупроводников. Л.: Наука, 1972. 104 с.
- Батавин В.В., Концевой Ю.А., Федорович Ю.В. Измерение параметров полупроводниковых материалов и структур. М.: Радио и связь. 1985. 264 с.
- Каретникова И.Р., Нефедов Н.М., Шашкин В.И. О точности восстановления профиля легирования полупроводников на основе вольт-фарадных измерений в процессе электрохимического травления//ФТП. 2001. Т. 35. Вып. 7. С. 801 -807.
- Грушко Н.С., Лакалин А.В., Евстигнеева Е.А. Исследование вольт-амперных характеристик и спектров электролюминесценции светодиодов с квантовой ямой, изготовленных на основе GaN//Известия вузов. Электроника. 2002. №3. С. 48 -56.
- Грушко Н.С., Лакалин А.В., Евстигнеева Е.А. Исследование вольт-амперных характеристик светодиодов, изготовленных на основе GaN с квантовой ямой//Ученые записки Ульяновского государственного университета. Серия Физическая. 2001. Вып. 2(11). С. 34 -39.
- Булярский С.В., Ионычев В.К. Кузьмин В.В. Туннельная рекомбинация в кремниевых лавинных диодах//ФТП. 1997. Т. 37. Вып. 1. С. 117 -120.
- Грушко Н.С., Логинова Е.А., Потанахина Л.Н. Процесс туннельной рекомбинации в пространственно неоднородных структурах//ФТП, 2006. Т. 40. Вып. 5. С. 584 -588.
- Ковалев А.Н., Маняхин Ф.И., Кудряшов В.Е., Туркин А.Н., Юнович А.Э.//ФТП. 1999. Т. 33. Вып. 2. С. 224-231.
- Чернов И.П., Тимошников Ю.А., Мамонтов А.П., Коротченко В.А., Лапскер И.А., Семухин Б.С. Изменения структуры сплава ВК при воздействии малых доз g-излучения//Атомная энергия. Июль 1984. Т. 57. Вып. 1. С. 58-59.
- Чернов И.П., Мамонтов А.П., Ботаки А.А., Черданцев П.А., Чахлов Б.В., Шаров С.Р.//Атомная энергия. июль 1984. Т. 57. Вып. 1. С. 56-58.


