Особенности применения реконструированной поверхности кремния для калибровки СТМ при измерении геометрических параметров объектов
Автор: Кузин Александр Юрьевич, Тодуа Павел Андреевич, Панов Владимир Иванович, Орешкин Андрей Иванович
Журнал: Труды Московского физико-технического института @trudy-mipt
Рубрика: Полупроводниковая электроника и нанотехнологии
Статья в выпуске: 3 (15) т.4, 2012 года.
Бесплатный доступ
Продемонстрирована возможность использования реконструированной поверхности 7х7-Si(111) и монотоатомных ступеней на этой поверхности в качестве эталонных объектов для калибровки сверхвысоковакуумного сканирующего туннельного микроскопа.
Сканирующий туннельный микроскоп, реконструкция, кремний, сверхвысокий вакуум
Короткий адрес: https://sciup.org/142185858
IDR: 142185858
Peculiarities of silicon reconstructed surface application for STM calibration in objects geometric parameters measurements
The possibility to use 7х7-Si(111) surface and monoatomic steps on this surface as reference samples for an ultrahigh vacuum scanning tunneling microscope has been demonstrated.
Текст научной статьи Особенности применения реконструированной поверхности кремния для калибровки СТМ при измерении геометрических параметров объектов
Современные методы измерений и диагностика процессов, учитывающие специфику объектов нанометровой геометрии, требуют обеспечения единства измерений в нанометровом диапазоне вплоть до сотых и даже тысячных долей нанометра. В значительной степени это связано с развитием зондовых микроскопов, среди которых наилучшим разрешением обладают сканирующие туннельные микроскопы (СТМ), особенно работающие в условиях сверхвысокого вакуума. Такие микроскопы (СВВ СТМ) занимают особое место среди СЗМ, поскольку предназначены для измерений как геометрических параметров объекта, так и локальной туннельной проводимости, характеризующей распределение плотности электронных состояний р(х,у) Вместе с тем при измерении геометрических параметров объектов с помощью СТМ, особенно в диапазоне от единиц до долей нанометра, возникают значительные погрешности вследствие зависимости туннельного тока СТМ от р(х, у) и ее изменений, вызываемых наличием в области контакта локализованных состояний даже на. участках с атомно гладкой поверхностью (рис. 1). Поэтому для калибровки СВВ СТМ часто используются двумерные поверхностные решетки различных кристаллов, обладающих достаточной проводимостью для получения туннельного тока. Однако и в этих случаях особенности реконструкции, присутствие на поверхности болтающихся связей, влияние подповерхностных зарядовых состояний и др. могут вызвать значительные погрешности измерений геометрических параметров и плотности электронных состояний [1]. Среди двумерных решеток, которые обеспечивают высокую стабильность геометрических параметров поверхностной структуры в СТМ-изображениях, часто используется поверхность 7x7-Si(lll). Параметры этой решетки хорошо изучены различными методами, включая метод дифракции медленных электронов (ДМЭ). Она. является особенным примером полупроводниковой поверхности, для которой СТМ изображение в наименьшей степени зависит от параметров туннельного перехода, чем обеспечивается стабильная информация о геометрическом расположении поверхностных атомов и о расстоянии между атомными ступеньками. Следовательно, в отличие от большинства поверхностных атомных структур, реконструированная поверхность 7x7-Si(lll) может использоваться в качестве эталонной меры для СВВ СТМ.
По этим причинам в настоящей работе рассматривается возможность применения реконструированной поверхности кремния для калибровки СВВ СТМ при измерении геометрических параметров объектов в нанометровом диапазоне.
Рис. 1. СВВ СТМ-изображение атомно-гладкого участка поверхности InAs при наличии под поверхностью примесного атома S и атомный рельеф этого СТМ-изображения вдоль линии, проведенной на верхнем рисунке
2. Условия эксперимента
В качестве образцов используются пластины кремния (Si), плоскость которых перпендикулярна кристаллическому направлению [111]. Выбор материала образцов определяется широким использованием кремния в микро- и нанотехнологиях и его применением для изготовления стандартных образцов и мер для СЗМ. В основу методики приготовления образцов положено фундаментальное свойство поверхности (111) кремния, которая при определенном способе обработки в сверхвысоком вакууме, подвергается реконструкции 7 х7 — увеличению каждой из сторон плоской элементарной решетки в 7 раз по сравнению с плоской решеткой в объеме. В результате на поверхности (111) кремния формируется (вырастает) увеличенная в 7 х7 раз периодическая структура, состоящая из 102 атомов кремния. Геометрические параметры этой поверхностной решетки не зависят от способа её получения и являются фундаментальным свойством монокристаллического кремния. Размер стороны этой увеличенной решетки, составляет 2.690 ± 0.003 нм [2]. Верхний слой этой решетки состоит из 12 атомов, называемых адатомами. Эти адатомы (атомы кремния верхнего слоя реконструированной поверхности) создают СТМ-изображение, по которому определяются фундаментальные геометрические параметры решетки, используемые для калибровки прибора. Для приготовления образцов используются стандартные кремниевые пластины, пассивированные SiO2.Поверхность (111) пластины должна быть срезана с точностью не хуже 0.5°. Толщина используемой пластины может варьироваться от 0.3 до 0.5 мм. Лабораторные образцы эталонной меры имеют ширину 4-5 мм и длину от 10-12 мм. Для приготовления образцов эталонной меры используется метод прогрева прямым током. Для этого концентрация допирующих примесей кристалла должна быть в диапазоне 1016 см-3 - 1018 см-3. Весь инструмент, и детали прибора, соприкасающиеся с образцом, должны быть свободными от примесей никеля. Образец, закрепленный на держателе из молибдена, загружается в сверхвысоковакуумную систему СТМ через шлюзовую камеру. Первоначальная дегазация образца и его держателя в манипуляторе точных перемещений СТМ внутри сверхвысоковакуумной камеры проводится методом резистивного прогрева ниже температуры свечения в течение нескольких часов, пока давление в системе не ста- билизируется на уровне 5 xl0-10 мбар. После этого образец прогревается в течение 12 часов методом прямого пропускания тока при температуре, достаточно низкой для удаления естественного природного оксида кремния (Т < 600 °C). Давление в системе при этом должно быть не более 2 х10-10 мбар. При очень длительных временах дегазации и (или) высокой концентрации допирующих примесей на поверхности может происходить сегрегация допирующих атомов. Этот процесс приводит разрушению поверхностных реконструкций. В этом случае следует сократить процедуру дегазации до необходимого минимума. На следующем этапе проводится импульсный нагрев образца до 1250 °C путем кратковременного пропускания через него тока. В процессе импульсного нагрева давление в системе не должно превышать 1 х10-9 мбар. При приближении давления к этому значению надо остановить протекание тока через образец, выждать, пока давление в системе полностью восстановится, и затем повторить процедуру. Альтернативный путь предполагает уменьшение тока с применением коротких импульсов до момента, когда станет возможным поддерживать температуру образца 1250 °C в течение 3 секунд. Описанная выше процедура приводит к появлению на поверхности кремния реконструкции поверхности 7x7-Si(lll) с хорошо определенными параметрами элементарной ячейки. Длина стороны ромбоэдрической элементарной ячейки, объединяющей 4 угловые ямки, составляет 2.69 нм. Полученная элементарная решетка содержит 102 атома и состоит из трех атомных слоев [3]. На верхнем слое находятся 12 атомов, которые формируют СТМ-изображение реконструированной 7x7-Si(lll) поверхности и определяют геометрические параметры эталонной меры.

Рис. 2. СТМ-изображение высокого разрешения поверхности (7x7)-Si(lll). Расстояние между двумя ближайшими угловыми ямками равняется 2.69 им
Для реконструированной 7 x7-Si(lll) поверхности число оборванных связей для элементарной ячейки (7х7) сокращается до 19 в сравнении с 49 оборванными связями для (1x1) поверхностной структуры. Поэтому СТМ-изображения поверхности 7x7-Si(lll) показывают 12 «топографических» максимумов на одну элементарную ячейку (рис. 2). Эти максимумы могут быть приписаны оборванным связям над адатомами реконструированной поверхностной структуры (7 x7). В каждой элементарной ячейке структуры 7x7-Si(lll) присутствуют 12 адатомов. Каждый адатом замыкает на себе три оборванных связи от нижележащего атомного слоя, оставляя одну оборванную связь незамкнутой вследствие четырехвалентности кремния. Оборванные связи над адатомами являются частично заполненными и поэтому дают свой вклад как в изображения заполненных состояний, так и в изображения незаполненных состояний. Местоположение наблюдаемых максимумов не зависит от полярности приложенного к туннельному контакту напряжения, то есть максимумы для изображения заполненных и незаполненных состояний пространственно совпадают. Следовательно, 7x7-Si(lll) является особенным примером полупроводниковой поверхности, для которой СТМ-изображения обеспечивают получение стабильной геометрической информации о положении поверхностных атомов и межплоскостных расстояний и, в отличие от большинства поверхностных атомных структур, могут использоваться в качестве эталонной меры для калибровки СВВ СТМ в нанометровом и суб-нанометровом диапазоне. Измерения производились на сверхвысоковакуумном сканирующем туннельном микроскопе Omicron STM 1 [4], предназначенном для измерений линейных размеров нанорельефа поверхности и туннельной проводимости р(х, у) твердотельных проводящих структур. Основные технические характеристики измерительной системы СТМ:
Область сканирования манипулятора (в плоскости) 1,3 х 1,3 мкм
Диапазон измерений по вертикали 0,7 мкм
Разрешение в плоскости 0,01 нм
Вертикальное разрешение 0,001 нм
Диапазон измеряемого туннельного тока 10 нА - 10 нА
Диапазон задаваемого напряжения смещения 1 мВ 4 В
Важной составляющей СТМ-измерений является наличие проводящих зондирующих острий (электродов) с малым радиусом (вплоть до одного атома) на конце, которыми производится сканирование поверхности образца. Для этого проводящие острия изготавливают из вольфрамовой проволоки диаметром около 0,2-0,3 мм путем электролитического травления с последующим отжигом в сверхвысоком вакууме камеры СТМ при температуре порядка 2000 °C. Перед отжигом форма острий контролируется электронным микроскопом. Такая процедура позволяет получить острия атомного размера на конце при отсутствии оксидного слоя, мешающего получать атомное разрешение СТМ. После проведения процедуры приготовления образцов и острий, производится рекомендованный руководством пользователя подбор параметров туннельного перехода (величины постоянного туннельного тока и туннельного напряжения), а также скорости сканирования, величины поля сканирования и коэффициента усиления в цепи обратной связи в зависимости от особенностей измеряемого образца. На следующем этапе оператор задает количество точек вдоль осей _А и У, в которых происходит регистрация сигнала (количество строк и столбцов в матрице топографических данных), количество измерений в каждой точке, по которым осуществляется усреднение и значение шага сканирования, которое определяет размер области сканирования. После чего производится съемка микрорельефа поверхности в топографическом режиме работы СТМ.
3. Результаты экспериментов и их обсуждение
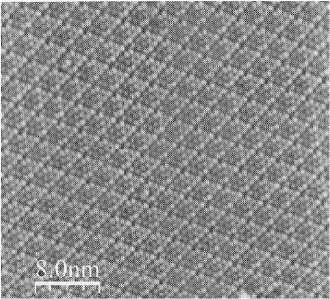
Рис. 3. СТМ-изображепие бездефектного участка, атомно-гладкой поверхности с периодически повторяющейся структурой элементарной поверхностной решетки 7 х7-Si(lll)
Измерение геометрических параметров поверхности при помощи сканирующего туннельного микроскопа. Omicron STM 1 осуществляется с использованием специального программного обеспечения микроскопа. Обработка, результатов измерений производится с помощью программ, предназначенных для обработки изображений, получаемых методами сканирующей зондовой микроскопии. Все СТМ-изображения получены в режиме постоянного туннельного тока, при туннельном токе 25 нА и напряжении смещения на. туннельном контакте 1,5 В.
Результаты измерений микрорельефа атомно-гладкого участка поверхности 7 x7-Si(lll) показаны на рис. 3. СТМ-изображение представляет собою бездефектный участок атомногладкой поверхности с периодически повторяющейся структурой элементарной поверхностной решетки 7x7-Si(lll). На полученных изображениях проявляются все детали атомного рельефа, позволяющие с высокой точностью определить геометрические параметры решетки, что позволяет использовать её в качестве эталонной меры при калибровке СТМ в плоскости XY.
Результаты серии измерений И (нм) периода между угловыми ямками поверхностной решетки реконструкции кремния 7x7-Si(lll) представлены в табл. 1 (двадцать значений периода):
Таблица!
|
2.57 |
2.61 |
2.78 |
2.51 |
|
2.68 |
2.82 |
2.69 |
2.7 |
|
2.65 |
2.69 |
2.72 |
2.64 |
|
2.7 |
2.69 |
2.81 |
2.77 |
|
2.75 |
2.67 |
2.56 |
2.68 |
Оценка математического ожидания параметра элементарной ячейки поверхности 7x7-Si(lll) определяется ее средней арифметической величиной
1 = 20 Е2=і U = 2.685 нм
Среднее квадратическое отклонение отдельного результата измерения составляет:
» = ф^ъЕІТАТ2 = 0.08 нм
Среднеквадратичное отклонение (СКО) среднего арифметического вычисляется по формуле st = ^А = 0.02нм.
Поскольку разность между измеренным значением (2,685 нм) и действительным значением (2,69 нм) значительно меньше CKO S t, при оценке погрешности результата измерений, т.е. при оценке погрешности калибруемого СТМ, систематической составляющей погрешности можно пренебречь.
При доверительной вероятности Р = 0, 95 (коэффициент Стъюдента для двадцати измерений t = 2,093) абсолютная погрешность составит 0.04 нм. Полученные результаты позволяют сделать вывод о том, что пределы относительной погрешности калибруемого СТМ не превышают 3% при доверительной вероятности 0.95 (для латеральных измерений) .
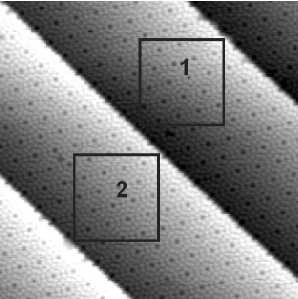
Рис. 4. СТМ-изображение моноатомных ступеней на поверхности 7x7-Si(lll)
СТМ-изображение реконструированной поверхности 7x7-Si(lll), полученное вблизи моиоатомиых ступенек, показано на. рис. 4. Высота, таких ступеней хорошо определена, независимыми методами измерений, включая просвечивающую электронную микроскопию
(ПЭМ), и составляет 0,314±0,001 нм [5]. Направление моноатомных ступеней, как правило, совпадает с направлением сторон элементарной ячейки структуры 7x7-Si(lll) как для верхней, так и для нижней террасы. Из полученных СТМ-изображений видно, что реконструированная поверхность 7 х7 на верхней и нижней террасах моноатомной ступеньки содержит не более 1 атомного дефекта на 10 элементарных поверхностных ячеек реконструкции, а ширина террасе составляет не менее 10 нм. Изображение террасе моноатомных ступенек устойчиво и надежно воспроизводится в СТМ-измерениях, что позволяет использовать параметры ступенек в качестве эталонной меры при калибровке СТМ в направлении по нормали к поверхности образца (Z).
Процедура калибровки манипулятора точных перемещений в направлении Z заключается в последовательном выполнении следующих операций.
-
1) Получение с помощью СВВ СТМ топографических изображений моноатомных ступеней на реконструированной поверхности 7x7-Si(lll) в режиме постоянного туннельного тока (процедура подготовки установки СТМ, приготовление поверхности и туннельного зонда - согласно описанной методике). Реконструированная поверхность 7х7 на верхней и нижней террасах (относительно моноатомной ступеньки: см. пример на рис. 3) должна содержать не более 1 атомного дефекта на 10 элементарных поверхностных ячеек реконструкции 7 х7, а ширина террасе должна быть не менее 10 нм. Количество N независимо полученных топографических изображений моноатомных ступеней не должно быть менее 5. Изображения сохраняются на жесткий диск или любой другой цифровой носитель информации.
-
2) С помощью програмных пакетов обработки результатов СТМ-измерений на топографическом изображении моноатомной ступени (полученной в п.1) осуществить выбор участка поверхности на верхней (см. пример на рис. 4 (1)) и нижней террасах (см. пример на рис. 4 (2)) площадью не менее 125 нм2. Выбранные участки 1 и 2 не должны содержать атомных дефектов в реконструкции 7х7, а также не должны захватывать участки поверхности, содержащей саму ступень. Участки поверхности 1 и 2 должны находиться на наименьшем расстоянии друг от друга, по обе стороны от моноатомной скупеньки, и их площади должны быть равны.
-
3) Методом МНК первого порядка аппроксимировать каждый из выбранных участков 1 и 2 плоскостью а-ж + b-у + с = z, выделив при этом коэффициенты a i, bi, ci — для выделенного участка 1, и а 2, ^2, С2 — для выделенного участка 2 соответственно. При соблюдении условий подготовки эксперимента полученные плоскости параллельны ДРУГ ДРУГУ, и расстояние между плоскостями равно высоте hi монатомной ступеньки на реконструированной поверхности 7x7-Si(111) (ho = 0, 314 нм - известное значение высоты моноатомной ступени 7x7-Si(lll).
-
4) Пункт 3 повторяется для всех N топографических изображений, полученных в п.
-
1. Результаты измерения высоты hi моноатомной ступеньки записываются в таблицу, после чего вычисляются среднее значение, дисперсия, стандартное отклонение, а также доверительные интервалы для погрешности калибруемого СТМ.
5) Исключение систематической составляющей погрешности измерений СТМ (калибровка манипулятора точных перемещений в направлении Z) производится путем изменения первоначального (произвольного) коэффициента преобразования манипулятора Кzi на новый коэффициент преобразования Кz истинный, полученный исходя из соотношения КZhcthiiiiый = Кгi- ( ho/hi).
4. Выводы
Полученные результаты позволяют сделать вывод о том, что пределы относительной погрешности калибруемого СТМ (по оси Z) не превышают 3% при доверительной вероятности 0,95.
Распространение СТМ-измерений геометрических параметров наноструктур в область десятых и даже сотых долей нанометра требует создания рельефных мер, способных обеспечить надежную калибровку приборов с точностью, необходимой для проведения таких измерений. Вместе с тем изготовление подобных рельефных мер с помощью средств микро-и нанотехнологии представляет значительные трудности. Применение в настоящей работе реконструированной поверхности кремния для калибровки СВВ СТМ при измерении геометрических параметров объектов нанометровых и субнанометровых размеров показало перспективность использования поверхностных атомных структур для калибровки сканирующих зондовых микроскопов высокого разрешения. После проведения дополнительных исследований однородности и стабильности предложенных структур, а также доказательства прослеживаемости их аттестованных значений (2.69 нм в латеральном направлении и 0.314 нм в направлении нормали к поверхности), данные структуры можно будет утвердить (аттестовать) в качестве стандартных образцов, предназначенных для калибровки сканирующих зондовых микроскопов высокого разрешения.
Важность использования рельефных мер естественного происхождения, показанная в настоящей работе, вызвана особенностями и возможностями применения СТМ в физических исследованиях и нанодиагностике, которые требуют повышенной точности определения геометрических параметров поверхностных структур.
Работа проводилась при финансовой поддержке Федерального агентства по техническому регулированию и метрологии Российской Федерации и Министерства образования и науки Российской Федерации с использованием оборудования Центров коллективного пользования МГУ им. М.В. Ломоносова и НИЦПВ.
Список литературы Особенности применения реконструированной поверхности кремния для калибровки СТМ при измерении геометрических параметров объектов
- Oreshkin A.I., Oreshkin S.I., Savinov S.V., Maslova N.S., Muzychenko D.A., Mancevich V.N., Panov V.I., Arseev P.I.//JETP Letters. -2007. -85, N 1. -P. 40-45.
- Бехштедт Ф., Эндерлайн Р. Поверхности и границы раздела полупроводников/под редакцией д.ф.-м.н. И.П. Звягина. -М.: Мир, 1990.
- Takayanagi K., Tanishiro Y., Takahashi M., Takahashi S.//Surf. Sci. -1985. -164. -P. 367.
- The UHV STM 1 User's Guide, Version 1.3, October 02, (2003).
- Creswell M.W., Dixon R.G., Guthrie W.F., Allen R.A., Murabito C.E., Park B., Martinez de Pinillos J.V., Hunt A. CD Reference Features with Sub-five Nanometer Uncertainty//Proceedings of the International Society for Optical Engineoring (SPIE), Microlithography. -2005. -P. 295.


