Особенности выращивания тонкопленочных покрытий на основе нитридов
Автор: Халтанов В.Э.
Журнал: Вестник Бурятского государственного университета. Химия. Физика @vestnik-bsu-chemistry-physics
Статья в выпуске: 3, 2024 года.
Бесплатный доступ
Рассмотрены условия выращивания тонких пленок нитридов (TiN, Si3N4 и AlN) ионно-лучевым методом получения слоев, что предполагает наличие трех этапов: распыление мишени ионами химически активного компонента или его смеси с инертным газом; перенос распыленных частиц на поверхность подложки; формирование тонкой пленки на поверхности подложки. Проведено моделирование первого этапа роста нитридных пленок по теории Зигмунда с использованием математической программы MathCad. Осуществлены расчеты коэффициентов распыления мишеней Ti, Si и Al пучками ионов Ar+ и N2+, а также смесью газов Ar+ и N2+ различного состава в интервале энергий распыляющих ионов от 1 до 10 кэВ. Результаты расчетов позволили предложить оптимальные режимы выращивания покрытий.
Моделирование, тонкие пленки, нитриды, ионные пучки, распыление
Короткий адрес: https://sciup.org/148329961
IDR: 148329961 | УДК: 539.231 | DOI: 10.18101/2306-2363-2024-3-41-47
Features of growing thin film nitride-based coatings
The article considers the conditions for growing thin films of nitrides (TiN, Si3N4 and AlN) by ion-beam sputtering. The ion-beam method for obtaining layers involves three stages: sputtering of the target with ions of a chemically active component or its mixture with an inert gas; transfer of sputtered particles to the substrate surface; formation of a thin film on the substrate surface. Using the MathCad mathematical program we have simulated the first stage of nitride film growth according Sigmund’s theory. We have calculated the sputtering coefficients of Ti, Si and Al targets by beams of Ar+ and N2+ ions, as well as by a mixture of Ar+ and N2+ gases of various compositions in the range of sputtering ion energies from 1 keV to 10 keV. The calculation results allowed us to propose optimal coating growth modes.
Текст научной статьи Особенности выращивания тонкопленочных покрытий на основе нитридов
Интерес к нитридам обусловлен их уникальными физико-химическими свойствами. Нитридные покрытия обладают повышенной химической инертностью, высокой твердостью, тугоплавкостью, прочностью, пластичностью, износостойкостью, термической стабильностью, превосходными механическими свойствами. Тонкопленочные защитные покрытия на основе нитридов титана, кремния и алюминия являются материалами с высокими эксплуатационными характеристиками, что предопределило их широкий спектр применения в различных областях техники и технологий.
Среди различных методов получения нитридных слоев перспективной технологией является ионно-лучевой метод [1]. Данная технология примечательна тем, что область горения тлеющего разряда и рабочая камера, где происходит рост слоев, отделены друг от друга, что обеспечивает чистоту эксперимента. Также возможен контроль важных ростовых параметров.
Результаты и обсуждение
В работе рассмотрено распыление мишеней Ti, Si и Al пучками ионов Ar+ и N2+, а также смесью газов Ar+ и N2+ различного состава в интервале энергий рас- пыляющих ионов от 1 до 10 кэВ. В расчетах по теории Зигмунда [2] была использована математическая программа MathCad.
Проведено исследование первого этапа роста нитридных пленок по теории Зигмунда, а именно распыление поверхности мишеней при бомбардировке потоками ионов. На рис. 1 изображено распыление мишени потоками ионов.

Рис. 1. Распыление мишени потоком ионов: 1 — мишень; 2 — пучок ионов;
3 — подложка; 4 — след ионного пучка на поверхности мишени
В теории Зигмунда [2] рассматривается распыление поверхности мишени как процесс, происходящий в приповерхностных слоях, характеризующийся атомными столкновениями. Был введен коэффициент распыления S — количество атомов мишени, выбитых одним распыляющим ионом. На значение S влияют многие факторы: характеристики разряда, энергии частиц, кристаллическая решетка, рельеф поверхности, углы падения ионов. Оптимальными являются углы падения от 600 до 700. Коэффициент распыления S изменяется от угла падения ионов по формуле:
S(α)=S(0º)/cosα. (1)
S прямо пропорционально зависит от энергии ионов. Коэффициенты распыления рассчитывались из соотношения:
S=0,042*α*Sn (E)/U 0,

Рис. 2. Упругое соударение двух частиц
где U 0 — энергия связи атома; α-фактор — функция отношения M/m (М — масса иона, m — масса атома; S n (E) — энергия упругого торможения; S n (E)= 4*π*Z*z*e2*a*S n (φ)*m / (m+M); (Z — заряд ядра иона, z — заряд ядра атома мишени); a=0,885*r*(Z2/3+z2/3)-1/2, r — боровский радиус; S n (φ) — функция от φ.
На рис. 2 показано упругое соударение налетающей частицы 1 и покоящейся 2.
Б ыли ос у щ е с тв ле ны расчеты коэффициентов распыления мишен е й Ti , Si и A l при б омба рди ровк е и он а м и Ar + и N2+, а также смесью ионов Ar+ и N2+ в разных кон ц ент рац и я х при эн е рги ях и онов от 1 до 10 кэВ.
На р ис. 3 п р ед ст ав л ены зависимости коэффициентов распылени я тит а ново й миш ени п учк а ми и онов а ргон а и азота .
Зависимость 5(E) при падений пучка Аг+ и N2+

—•—Зависимость 5*(атом/ион) при падении пучка Аг+
—•—Зависимость 5*(атом/ион) при падении пучка N2+
Рис. 3. За в ис им о сть коэффициентов распыления S титановой (Ti) м ише ни по д воз дейс твием п у ч ков ионов ар го на (A r + ) и азота (N 2 + ) в диапазоне энергий от 1 до 10 кэВ
Ан а л и з зави сим ос т е й S(E) показывает, что коэффициенты распы ле ни я мише ни и он ами арг он а зн ач ительно превышают коэффициенты распылен ия ион ами а зот а. Эт о о б ъ я сн я е т ся тем, что молекулы аргона тяжелее по сравнен ию с м ол екулами а зот а. К он ечн о, возможна технология получения пленок нитри да ти тан а пу т е м ра сп ы ле ния т ит а новой мишени пучком ионов аргона с после д у ющ и м оса жд е нием азот а н а п оверхность подложки, где и произойдет форми ров а н ие покрытия TiN.
Но наиболее целесообразным представляется облучение титановой мишени пучком ионов, состоящим из смеси газов Ar+ и N2+, а также определить оптимальные их соотношения. В связи с этим были проведены расчеты коэффициен- тов распыления титана при различных концентрациях ионов: 50% Ar+ и 50% N2+; 75% Ar+и 25% N2+; 95% Ar+и 5% N2+ (рис. 4).
Рас че ты к о э ффи циентов распыления титана при распылении по т оком ион ов с ме с и р азн ы х сос тав о в показывают, что наиболее эффективным являе тся и с п ользование смеси 95% Ar+ и 5% N 2 +. А этого количества распыленных молекул тита на и а зот а достат оч но для формирования на подложке тонкой пленк и н ит ри д а т и т а н а с ог ласн о ре а к ц и и: 2Ti + N 2 = 2TiN.
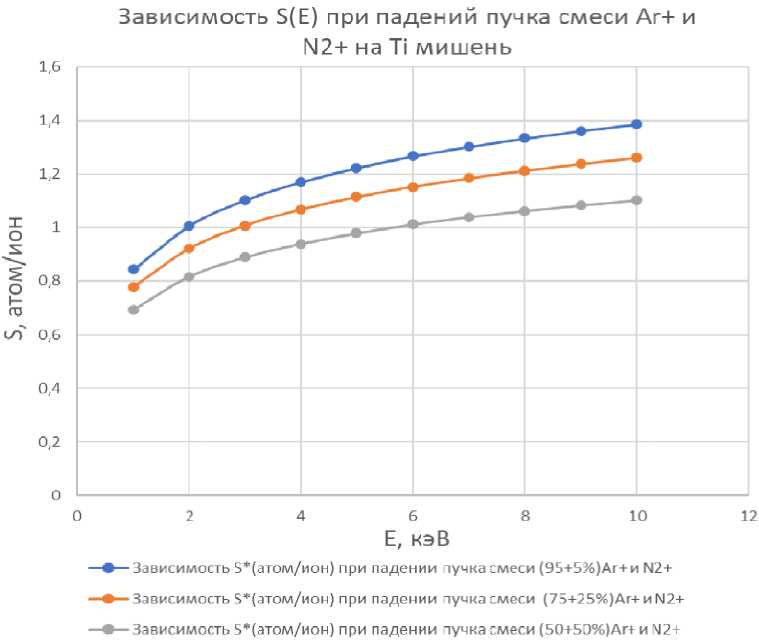
Рис. 4. З ав и с имос ть коэффициентов распыления S титановой (Ti) мишени п о д воз дейс твием п у ч ков ионов р а зличны х с м е се й газов аргона (Ar + ) и азота (N2 + ) в диапазоне энергий от 1 до 10 кэВ
Ос у щ е с тв ле ны рас че т ы для рас пы ле ни я Si-мишеней. На рис. 5 показаны зави с и мос т и к о э ффи циент ов ра с пы л е н ия Si-мишени пучками ионов аргона Ar+ и азота N2+ ; н а ри с. 6 показа н ы зави си мос т и к оэффи ц и е нтов распыления Si-мишени при бом бард ировк е п о токами ионов аргона и азота различных ко н ц ентра ц ий . Ан а л и з ре зу льт ат ов р асчетов показывает, что также достаточно и спольз ова ть мин и м а л ьн ое с од ер ж ан ие азота в газовой смеси (5%) для получения ма к сима льных коэффиц и ент ов ра спыления титана для осуществления на подло жке хими ческой реакции: 3Si + 2N 2 = Si 3 N 4 .
Зависимость S(E) при падений пучка Аг+ и N2+

♦ Зависимость 5’(атом/ион] при падении пучка N2+
Рис. 5. За в ис им о ст ь коэффициентов распыления S кремниевой (Si) мишени п о д воз дейс твием п у ч ков ионов ар го на (A r + ) и азота (N 2 + ) в диапазоне энергий от 1 до 10 кэВ

—♦—Зависимость 5*(атом/ион) при падении пучка смеси (95+5%)Аг+и N2+
♦ Зависимость 5*(атом/ион) при падении пучка смеси (75+25%}Аг+ и N2+
—♦—Зависимость 5*(атом/ион) при падении пучка смеси (5Oi5O%)Ari hN2i
Рис. 6. За в ис им о ст ь коэффициентов распыления S кремниевой (Si) мишени п о д воз дейс твием п у ч ков ионов р а зличны х с м е се й газов ар го на (A r + ) и азота (N 2 + ) в диапазоне энергий от 1 до 10 кэВ
Были осуществлены расчеты для распыления мишеней из алюминия, которые подтвердили расчеты, полученные при распылении титана и кремния. На рис. 7 показаны зависимости коэффициентов распыления Al-мишени потоками ионов аргона и азота, а на рис. 8 — зависимости коэффициентов распыления Al-мишени при бомбардировке потоками ионов аргона и азота различных концентраций. Наиболее предпочтительным является минимальное содержание азота в газовой смеси (5%) для получения максимальных коэффициентов распыления алюминия для осуществления на подложке химической реакции: 2Al + N2 = 2AlN.

Рис. 7. За в ис им о сть коэффициентов распыления S титановой (Ti) м ише ни по д воз дейс твием п у ч ков ионов ар го на (A r + ) и азота (N 2 + ) в диапазоне энергий от 1 до 10 кэВ
Зависимость 5(E) при падений пучка смеси

—♦—Завис и месть 5*(атом/ион) при падении пучка смеси (5 О+5Э%)Агт и N2+
Рис. 8. За в ис им о сть коэффициентов распыления S титановой (Ti) м ише ни п о д воз дейс твием п у ч ков ионов р а зличны х с м е се й газов ар го на (A r + ) и азота (N 2 + ) в диапазоне энергий от 1 до 10 кэВ
Таким образом, проведенное моделирование особенностей выращивания тонкопленочных покрытий на основе нитридов титана, кремния и алюминия (TiN, Si 3 N 4 , AlN) показывает, что для улучшения ростовых процессов нитридных слоев целесообразно использование смеси газов Ar+ и N2+, причем оптимальным является минимальное содержание азота в газовой смеси (5%). Полученные теоретические расчетные данные хорошо коррелируют с экспериментальными результатами [3].
Список литературы Особенности выращивания тонкопленочных покрытий на основе нитридов
- Семенов А. П. Пучки распыляющих ионов: получение и применение. Улан-Удэ: Изд-во БНЦ СО РАН, 1999. 207 с. Текст: непосредственный.
- Sigmund P. Theory of Sputtering. Phys. Rev. 1969; 184(2): 383-416.
- Belyanin A. F., Semenov A. P., Haltanova V. M. AlN thin film deposition by ion beam sputtering. Diamond and Diamond-Like Film Applications. Lancaster-Basell, USA. 1998: 388-402.


