Развитие эллипсометрии
Автор: Дронь О.С.
Журнал: Научное приборостроение @nauchnoe-priborostroenie
Рубрика: 25 лет институту аналитического приборостроения РАН
Статья в выпуске: 4 т.12, 2002 года.
Бесплатный доступ
В работе приведено краткое изложение результатов разработок эллипсометров и теоретических подходов в ИАнП РАН за последние несколько лет. Рассмотрены метрологические возможности приборов и области применения. Приведены примеры анализа, сравнительного с существующими, нового способа оптимальной оценки измеряемых параметров и определения их погрешности с учетом корреляции.
Короткий адрес: https://sciup.org/14264260
IDR: 14264260 | УДК: 535.5.511
Evolution of ellipsometry
A summary of ellipsometer development results and theoretical approaches at IAI RAS for the last few years is given. Metrological capalilitiers and application areas are considered. Examples of analysis of the new method for evaluating measured parameters and defining their errors taking into account correlation are demonstrated and compared with that for existing methods.
Текст научной статьи Развитие эллипсометрии
Эллипсометрия за последнее десятилетие претерпевает период интенсивного развития и существенного расширения области применения. Это прежде всего связано с высокой чувствительностью метода к состоянию поверхности, точностью измерения толщин пленок вплоть до долей ангстрема и важным достоинством — неразрушающим и невозмущающим характером измерений и возможностью проведения исследований не только in situ, но и in vivo. Особенно интенсивно развиваются приложения метода в нанотехнологии и молекулярно-лучевой эпитаксии. В ряде случаев это оказывается практически единственный методом, позволяющим осуществлять неразрушающий контроль в процессе синтеза структур, отвечающим все возрастающим требованиям к точности и информативности контроля и управления технологическим процессом. Интенсивно развиваются приложения метода в областях медицины, биологии и экологии созданием высокочувствительных сенсоров и анализаторов (метод плазмонного резонанса, реакции антиген—антитело и т.п.).
СТОКС-ЭЛЛИПСОМЕТР
Фактически первый отечественный автоматический эллипсометр, пригодный к серийному производству, был разработан в 1990 г. в виде приставки к ручному эллипсометру ЛЭФ3М-1, выпускавшемуся Феодосийским приборостроительным заводом. Простая для таких приборов конструкция приставки и новый теоретический подход позволили получить высокие показатели, заметно превосходящие зарубежные аналоги, при весьма низких ценах. Следует заметить, что за рубежом впервые стокс-эллипсометр фирмы Gaertner (в серийном исполнении) появился на 3 года позже, и цена его составляла $98 000. В настоящее время приставка несколько модернизирована и подключается к компьютеру через USB-разъем.
Принципиальная схема эллипсометра допуска- ет сочетание в одном приборе "нулевого" и фотометрического подходов. Базовый эллипсометр ЛЭФ3М-1 был естественным образом (без конструктивных изменений) дополнен приставкой, позволяющей осуществить автоматизированный измерительный процесс стокс-параметров по фотометрической схеме. Оптическая схема комбинированного прибора приведена на рис. 1.
Схема ручного эллипсометра содержит источник света J — He-Ne лазер, поляризатор P, компенсатор C и анализатор A, установленные в лимбы с ручным приводом и шкалами отсчета; переключатель направления светового потока в виде поворотного зеркала З и фотоприемник ФЭУ с усилителем и индикацией уровня сигнала (на схеме не показаны). Автоматизация измерений осуществляется за счет установки модулятора поляризации M и фотометрического блока ФД. Управление модулятором и цифровая обработка сигнала осуществляются посредством платы контроллера, подключаемого к компьютеру через USB-разъем (на схеме не показаны). Пакет программного обеспечения осуществляет все необходимые функции по управлению измерением и обработке данных.
В режиме автоматических измерений (положение элементов в позиции 1) отраженное от образца S излучение модулируется модулятором M и, пройдя анализатор, попадает на фотоприемник ФД. Результатом измерения является полный вектор Стокса отраженного излучения [1].
В режиме ручного измерения (положение элементов в позиции 2) модулятор M выводится из оптического тракта, а сигнал попадает на фотоприемник ФЭУ. Таким образом, прибор работает по стандартной схеме нуль-эллипсометра.
Кроме очевидных преимуществ автоматизации измерений и более высокой точности по сравнению с зарубежными аналогами, стокс-эллипсометрия содержит больше информации об измеряемом объекте. Четыре параметра Стокса, кроме чисто поляризационных параметров, содержат также информацию о деполяризующих свойствах
ФЭУ
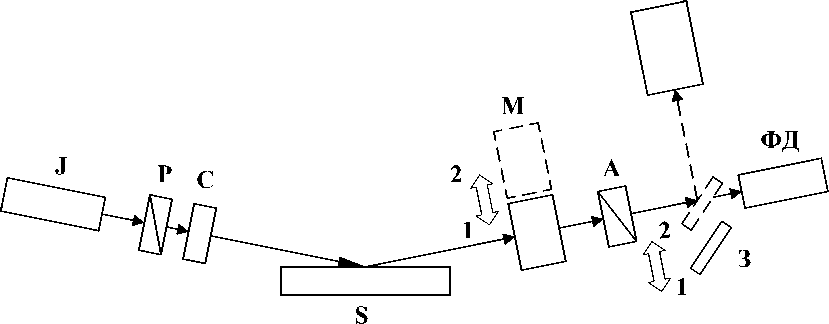
Рис.1. Оптическая схема комбинированного эллипсометра
образца и амплитудных коэффициентах отражения [1]. Модели реальной поверхности с учетом неоднородности и деполяризации более естественно и ясно формулируются в терминах стокс-векторов и матриц Мюллера. Нуль-эллипсометрия в этом случае дает лишь некоторые эффективные значения Ψ и ∆ , которые трудно однозначно интерпретировать. Таким образом, можно сказать, что стокс- и нуль-эллипсометрия измеряют несколько различные параметры исследуемых объектов. Совпадение значений Ψ и ∆ , вычисленных из результатов стокс-измерений, и измерений в режиме нуль-эллипсометрии должно наблюдаться только для поверхности и пленок, близких к идеально планарным, с малой дисперсией в пределах измеряемого спектра и при строго параллельном пучке света.
Комбинированная схема позволяет также оптимизировать измерения для каждого образца. Это достигается путем выбора оптимального состояния поляризации падающего излучения посредством установки соответствующих положений P и C.
В полуавтоматическом режиме возможно полное измерение анизотропии. Для этого проводятся четыре измерения при четырех комбинациях (P, C) i ( i = 1, 2, 3, 4), что дает возможность определить полную матрицу Мюллера исследуемой системы.
Принципиальной и важнейшей особенностью такого измерительного комплекса является возможность его метрологического самотестирования и проверки посредством измерения одного и того же объекта разными способами.
МИНИ-СТОКС-ЭЛЛИПСОМЕТР
Разработан новый для данной области тип прибора — малогабаритный cтокс-эллипсометр, который не уступает по метрологическим характеристикам стационарным приборам, но имеет габариты не более 140 × 80 × 70 мм. Для данной области это является поворотным этапом развития, т. к. позволяет использовать данный метод не только в лабораторных условиях и высокотехнологичных производствах, но и в мобильных лабораториях, клиниках, в системах экологического мониторинга как сверхчувствительный датчик или анализатор различных веществ (на основе плазмонного резонанса и химически селективных пленок). Это существенно расширяет области применения данного метода. Данный прибор обладает весьма высокими метрологическими возможностями и при неизменной базовой конструкции может быть легко модифицирован под конкретные технологические и исследовательские задачи. Например, могут быть добавлены еще несколько измерительных каналов с разными длинами волн или направлений измерения, что позволяет за одно измерение определять полные характеристики анизотропии пленки или подложки (ориентацию и величины компонент тензора диэлектрической проницаемости). Добавление многоканального спектрофотометра на ПЗС-линейках и световодных элементов вво-да/вывода дает возможность измерения спектральных характеристик анизотропии за то же время. Вследствие малых габаритов, веса и осо- бенностей конструкции (весь прибор находится выше плоскости образца) мини-эллипсометр идеально подходит для задач сканирования крупногабаритных деталей, например плоских мониторов, кремниевых пластин диаметром 300 мм и более, покрытий крупногабаритной оптики и т. п., т. к. вместо перемещения самой детали, что применяется в зарубежных аналогах (SOPRA, Gaertner), гораздо проще перемещать измерительный прибор.
ПРОГРАММНОЕ ОБЕСПЕЧЕНИЕ
Программное обеспечение и методы обработки сигнала также подверглись существенным изменениям. Кроме общего развития вычислительных процедур, улучшения интерфейса, расширения и уточнения различных моделей поверхностных структур и процессов, особо следует отметить существенное продвижение в области собственно измерительного процесса, оптимальной оценки измеряемых параметров, фильтрации шумов и учета полной информации о погрешности измеряемых параметров, включая и свойства корреляции в виде ковариационных матриц.
Существенной особенностью эллипсометрии является значительная зависимость погрешности измерений от свойств измеряемого объекта. Например, при прочих равных условиях погрешность эллипсометрических параметров Ψ и Δ может увеличиваться на несколько порядков при стремлении Ψ к нулю; погрешность измерения толщины пленки резко увеличивается, если показатель преломления ее приближается к показателю преломления подложки. Кроме того, как сами параметры Ψ и Δ или компоненты вектора Стокса, так и вычисляемые по ним параметры пленок и поверхностных структур оказываются сильно коррелированными. До настоящего времени при вычислении значений параметров погрешности не учитывались, а определялись по статистической обработке при многократных измерениях. Полное изложение вопроса предполагается в дальнейших публикациях. Здесь мы кратко коснемся только некоторых результатов.
Рассмотрим фотометрический эллипсометр, содержащий источник света, поляризатор и/или модулятор поляризации, измеряемый образец, анализатор и/или модулятор поляризации и фотоприемник. Предполагается, что оптическая система линейна, и все ее компоненты (кроме исследуемого образца) — недеполяризующие, т. е. модуляторы и поляризаторы описываются с помощью формализма матриц Джонса. Модуляторы могут находиться как в одном из плеч, так и в обоих одновременно. Модуляция имеет периодический характер с периодом T. В этих предполо- жениях в силу линейности любая система может быть представлена в виде
J ( t ) =
= J 0 • ( m 1 ( t ) • x 1 + ... + m 4 ( t ) • x 4), (1)
где J 0 — интенсивность источника света (полагаем, что J 0 — приведенное значение, учитывающее потери света на оптических элементах), xi — компоненты вектора отражения X , mi ( t )— коэффициенты модуляции, зависящие от времени, и J ( t )— интенсивность света на фотоприемнике. Если определить еще вектор модуляции системы M T( t )
M T( t ) = ( m 1 ( t ), m 2 ( t ), m 3 ( t ), m 4 ( t ) ) (2)
то интенсивность на фотоприемнике может быть представлена в виде скалярного произведения
J ( t ) = J 0 • M T( t ) • X . (3)
Конкретный вид компонент вектора модуляции однозначно определяется конструкцией прибора. Например, для системы P R SA — вращающийся поляризатор ( P = to t ), образец S, анализатор A , измеряются только три компоненты X T = ( R p У ^Re( R p R * )^, ^ Rs 2 ^) — компоненты вектора модуляции для идеальных элементов имеют вид
MT (t) = 1 (cos2 A[1 + cos(2P)], sin(2A) sin(2P), sin2 A[1 - cos(2P)]). (4)
Если вектор X не зависит от времени, то система, состоящая из оптической части плюс измерительный тракт, может быть представлена в виде

где a.
a ij
т
- ( i + 1)
n
J m j ( t )d t ,
T
i
n или в компактной форме
I = AX . (6)
Здесь n — число измерений (используемых функционалов) за период T , k — размерность измеряемого вектора X , I — вектор измеренных значений, A — матрица прибора. Очевидно, что должно быть n > k . Матрица A , или ее можно назвать "прямой" матрицей прибора (в статистике "конструкционная" матрица), — это полная характеристика данной системы, и все систематические погрешности и несовершенства оптических элементов имеют значение только относительно влияния на компоненты этой матрицы. В силу линейности соотношений решение системы может быть выражено также в виде линейного уравнения
X = BI , (7)
где B мы называем "обратной" матрицей прибора. Очевидно, что если n = k и матрица A неособенная, то решением является
B = A - 1 . (8)
Если n > k , то матрица B может быть определена в общем случае неоднозначно. Именно избыточность числа измерений n по сравнению с размерностью вектора X и позволяет оптимизировать процесс обработки сигнала.
Подходящим аппаратом для решения подобных задач является обобщенный метод наименьших квадратов ОМНК [7]. Если известна ковариационная матрица ошибок D ( I ) для измеренных значений вектора I , то задача минимизации погрешностей вектора X в уравнении (7) имеет, согласно [7], аналитическое решение в виде
B = ( A t D(I) - 1 A ) - 1 A T D(I) - 1 , (9)
D(X) = (A T D(I) - 1 A) - 1 . (10)
Здесь D(X) — ковариационная матрица ошибок измеряемого вектора X . Из уравнения (9) очевидно, что обратная матрица B в общем случае не является постоянной, а зависит от измеряемых параметров.
Для примера рассмотрим частный случай дробового шума. Дробовой шум характеризуется распределением Пуассона, основное свойство которого заключается в том, что дисперсия пропорциональна интенсивности сигнала, и последовательные измерения можно считать статистически независимыми. Следовательно, ковариационная матрица D ( I ) имеет диагональный вид с элементами диагонали, пропорциональными измеренным интенсивностям. Коэффициент пропорциональности можно определить, используя подход, примененный в [4–6]. В принятых здесь обозначениях матрица имеет вид
I 1
D ( I ) sh = K 2 hv
I 2
I n
h — постоянная Планка, ν — частота света, K — коэффициент усиления измерительного тракта (если измерение ведется в режиме счета фотонов, т. е. I i — сумма зарегистрированных частиц, то K = 1).
Если дробовой шум является определяющим, то, подставив выражение (11) в (9) и (10), а также в (7), можно получить следующие соотношения:
D(X)sh =[A t D(I)-1 A ]-1,(12)
X = D(X)sh С,(13)
T
С = A Т D(I)s—h11 = П_ Jm( t )d t,(14)
Khv *
где η — квантовая эффективность фотоприемника.
Вектор C не зависит от измеренных значений и не зависит от числа разбиений n . Он является характеристикой прибора, определяющей величину погрешностей измеряемого вектора X для одного измерительного цикла. Если измерения усредняются за N циклов, то соответственно C ( N) = N С Например, для системы с вращающимся поляризатором
C ' rotP = -^T [ cos2 A, 0 , sin2 A ] . (15) rotP Kh v 2
Уравнения (12) и (13) позволяют вычислять наилучшую оценку X и ее доверительную область, определяемую ковариационной матрицей R ( X ).
Формула (13) является обобщением закономерностей пуассоновского распределения на многопараметрические и нестационарные процессы. В частности, формула Шоттки может быть получена как частный случай этого выражения ( k = 1, M ( t ) = const).
Для количественного сравнения рассмотрим обработку измерений с помощью "Hadamard summation", применяемого в приборах фирмы Sopra, и предлагаемый подход. Метод "Hadamard summation" [8] в данных обозначениях математически эквивалентен применению фиксированной обратной матрицы B и числу разбиений n = 4. На рис. 2 приведено семейство графиков отношения площадей доверительных областей в зависимости от числа разбиений n периода модуляции T . Из графиков видно, что данный метод позволяет значительно повысить точность измерений — на порядок
Отношение площадей, S 1 / S 2

Рис
. 2. Сравнительные размеры и ориентации доверительных областей для различных значений Ψ и числа разбиений n
а

Рис. 3. Сравнительные размеры доверительных областей вектора Х для белого шума (Ψ = 2.5°, Δ = 175°; оптимальная оценка и SOPRA).(а, б — виды с разных позиций одного объекта)
и более и что следует стремиться к наибольшей скорости обработки сигнала для увеличения числа отсчетов за период модуляции. Следует также заметить, что малые значения Ψ соответствуют углу Брюстера, при котором достигается наибольшая точность определения параметров тонких пленок.
Для белого шума, характерного при применении лазерных источников, результаты оказываются еще более впечатляющими. На рис. 3 приведены трехмерные доверительные области для векторов Стокса. Так как разница в размерах составляет около двух порядков, область оптимальной фильтрации видна как черточка внутри эллипсоида, соответствующего обычным расчетам.
На рис. 4 представлены доверительные области Ψ и Δ, соответствующие данным, представленным на рис. 3. Область фильтрации видна как маленькая черточка, т. к. размеры областей отличаются более чем на три порядка.
ВЫВОДЫ
Новые технические и теоретические решения позволяют существенно повысить эффективность и точность эллипсометрических приборов, расширить область их применений и, возможно, получить новые результаты в области фундаментальных исследований. Предлагаемый метод оптимизации и оценки погрешности является универсальным, применим практически к любым фотометрическим системам поляриметрии и эллипсометрии, дает надежную основу для метрологического сравнения и оптимизации различных систем.

Δ
Рис. 4. Сравнительные размеры доверительных областей Ψ и Δ для белого шума (оптимальная оценка и SOPRA)
-
4. Aspnes D.E. // J. Appl. Opt. 1975. V.14, N 5. P. 1131–1136.
-
5. Aspnes D.E. Optical Properties of Solids New Developments / Ed. B.O. Seraphin. North Holland, Amsterdam, 1976. 799 p.
-
6. Aspnes D.E. // J. Opt. Soc. Am. 1974. N 64. P. 639.
-
7. Hamilton W. Statistics in physical science. N.Y., 1964. 430 p.
-
8. Courdille M., Steers M. and Theeten J. B. Patent FR 2491234 (29 September, 1980).
Список литературы Развитие эллипсометрии
- Аззам Р., Башара Н. Эллипсометрия и поляризованный свет. М.: Мир, 1981. 583 с.
- Azzam R.M.A. Selected Papers on "Ellipsometry". 1991. SPIE Milestone Series, V. MS27. 707 p.
- De Nijs J.M.M., Van Silfhout A.//J. Opt. Soc. Am. Vol. 1988. V. 5, N 6. P. 773-781.
- Aspnes D.E.//J. Appl. Opt. 1975. V.14, N 5. P. 1131-1136.
- Aspnes D.E. Optical Properties of Solids New Developments/Ed. B.O. Seraphin. North Holland, Amsterdam, 1976. 799 p.
- Aspnes D.E.//J. Opt. Soc. Am. 1974. N 64. P. 639.
- Hamilton W. Statistics in physical science. N.Y., 1964. 430 p.
- Courdille M., Steers M. and Theeten J. B. Patent FR 2491234 (29 September, 1980).


