Субструктура плёнок p-SiC, синтезированных на поверхности скола моно-Si в вакууме и на воздухе
Автор: Солдатенко С.А., Текутьева В.О.
Журнал: Вестник Бурятского государственного университета. Химия. Физика @vestnik-bsu-chemistry-physics
Статья в выпуске: 3, 2024 года.
Бесплатный доступ
Методами ПЭМ, ДБЭ, АСМ, РЭМ и ЭОС исследованы структурнофазовые превращения при карбидизации поверхности (111) Si, созданной расколом в процессе конденсации углерода (ювенильная поверхность), и поверхности, полученной предварительно расколом на воздухе в диапазоне температур от 1073 до 1173 K. Выявлен эффект ювенильной поверхности в процессе ее карбидизации при температурах 1123 и 1173 K, проявляющейся в том, что в этом случае формируется сплошная тектурированная пленка P-SiC с низким значением шероховатости. В случае неювенильной поверхности карбидная фаза образуется локально в местах пробоя естественного оксида.
Карбид кремния, ювенильная поверхность, структура, субструктура, морфология, тонкие пленки
Короткий адрес: https://sciup.org/148330197
IDR: 148330197 | УДК: 539.234:546.261 | DOI: 10.18101/2306-2363-2024-3-11-19
Substructure of p-SiC films synthesized on the cleavage surface of mono-Si in vacuum and in air
We have studied the structural and phase transformations during carbidization of the (111) Si surface created by cleavage during carbon condensation (juvenile surface) and the surface obtained by preliminary cleavage in air in the temperature range from 1073 to 1173 K using ARM, HEED, AFM, SEM and EOS methods. It has been revealed that during carbidization of the juvenile surface at temperatures of 1123 and 1173 K, a continuous textured Р-SiC film with a low roughness value is formed. In the case of a non-juvenile surface, the carbide phase is formed locally at the sites of native oxide breakdown.
Текст научной статьи Субструктура плёнок p-SiC, синтезированных на поверхности скола моно-Si в вакууме и на воздухе
Карбид кремния — один из наиболее перспективных материалов для высокотемпературной, мощной, быстродействующей и радиационностойкой электроники. Высокая стоимость и сложность технологии получения монокристаллических пластин карбида кремния сдерживают массовое применение карбидкремниевой электроники [1]. Как альтернатива предполагаются эпитаксиальные гетероструктуры β-SiC/Si, хорошо совместимые с кремниевой технологией [2]. Но вследствие большого размерного несоответствия кристаллических решеток β-SiC и Si эпитаксиальным пленкам β-SiC на кремниевой подложке свойствена высокая плотность дефектов. И приборы, созданные на основе гетероструктур β-SiC/Si, уступают в качестве приборам, созданным на монокристаллических подложках SiC [3]. Для формирования гетероструктур β-SiC/Si с толщиной слоя карбида кремния 1–10 мкм широко используются различные химические и физические методы синтеза. В [4] показано, что вне зависимости от метода синтеза SiC на Si наилучшее совершенство эпитаксиальных слоев β-SiC достигается с использованием предварительной карбидизации поверхности подложки, то есть создание эпитаксиального буферного слоя β-SiC толщиной 20–50 нм на поверхности Si. Функционально этот слой необходим для последующей гомоэпитаксии, а также для релаксации напряжений, возникающих вследствие большого размерного несоответствия сопрягающихся структур (20%) и большого различия коэффициентов термического расширения (8%) [5]. Карбидизацию поверхности проводят при температуре в диапазоне от 1123 до 1273 К, что на 200 градусов ниже температуры синтеза рабочего слоя β-SiC [6]. Температурный диапазон синтеза обусловлен требованиями к ориентации, субструктуре и морфологии буферного слоя, то есть этот слой должен иметь строгую ориентацию, наследуемую от подложки кремния, и морфологию с низкой шероховатостью.
Предназначение буферного слоя β-SiC на исходной подложке определило исследовательский интерес к его формированию. К настоящему моменту исследованы закономерности ориентированного роста (основное ориентационное соотношение отвечает принципу параллельности плотноупакованных направлений); типы дефектов (дефекты упаковки, микродвойниковые прослойки, антифазные границы, дислокации несоответствия); кинетика роста (установлено, что лимитирующей стадией является диффузия атомов кремния по границам зерен слоя β-SiC).
Рост слоя β-SiC на Si посредством транспорта кремния из подложки приводит к формированию в ее приграничной области полостей, что уменьшает площадь межфазного контакта SiC-Si и увеличивает шероховатость буферного слоя. Частично подавить развитие полостей позволяет оптимизация процесса карбидиза-ции с использованием химических [7; 8] и физических [9] методов предварительной очистки поверхности кремниевой подложки. Согласно методикам, предложенным в этих работах, между процессами очистки поверхности подложки и последующей карбидизацией проходит временной интервал, достаточный для ослабления эффекта чистой поверхности. Максимальный эффект чистой поверхности может быть достигнут в процессе карбидизации поверхности свежего раскола монокристалла в вакууме (ювенильной поверхности), не только вследствие ее предельной чистоты, но и повышенной плотности ненасыщенных (оборванных) связей, активирующих ювенильную поверхность.
Цель работы: выявление эффекта ювенильной поверхности монокристалла кремния при ее карбидизации в процессе электродугового испарения углерода.
Экспериментальная часть
Синтез β-SiC проводили в процессе электродугового испарения и конденсации углерода на поверхность (111) раскола кристалла в вакуумной установке ВУП-5 с давлением остаточной атмосферы в камере 7·10-3Па. Время конденсации — 2 с, скорость конденсации — около 5 нм/с.
Для выявления эффекта ювенильной поверхности в синтезе SiC конденсацию углерода проводили в одном цикле на поверхность свежего раскола в вакууме и на поверхность раскола (неювенильная поверхность), произведенного на воздухе при температурах Т = 1073, 1123 и 1173 K.
Ориентацию, структуру и субструктуру пленок SiC исследовали методом ПЭМ на электронном микроскопе Carl Zeiss Libra 120. Образцы для ПЭМ- исследования готовили отделением пленки SiC от кремниевой подложки в растворе HF: HNO3 = 1: 10.
Элементный состав карбидизированной поверхности кремния определяли методом оже-электронной спектроскопии (ЭОС) на спектрометре ЭСО-3 с анализатором DESA-100, точность определения кинетической энергии оже-электронов до 1 эВ. Анализатор — типа цилиндрического зеркала с коаксиальной пушкой. Энергия первичных электронов — 3 кэВ, угол падения — 450.
Морфологию поверхности исследовали методом атомно-силовой микроскопии (АСМ) на сканирующем зондовом микроскопе Solver P47 Pro (NT-MDT) с кантилевером HA_NC Etalon и методом РЭМ на электронном микроскопе Tescan MIRA-3.
1. Результаты и их обсуждение
Ювенильная поверхность
На рисунке 1 представлены ПЭМ-изображение и картина микродифракции, характеризующие структуру и субструктуру пленки, формирующейся на ювенильной поверхности (111) Si при T = 1073 K. Отделенная от подложки пленка имеет аморфную структуру, кристаллические фазы не обнаружены. Тем не менее неоднородный контраст на участке с подложкой кремния свидетельствует о начале взаимодействия на межфазной границе пленка-подложка. Этим объясняется и присутствие на электронограмме рефлексов 1/3 422, возникающих при дифракции электронов в области межфазной границы кристаллической решетки кремния с нарушенной ABC-упаковкой.
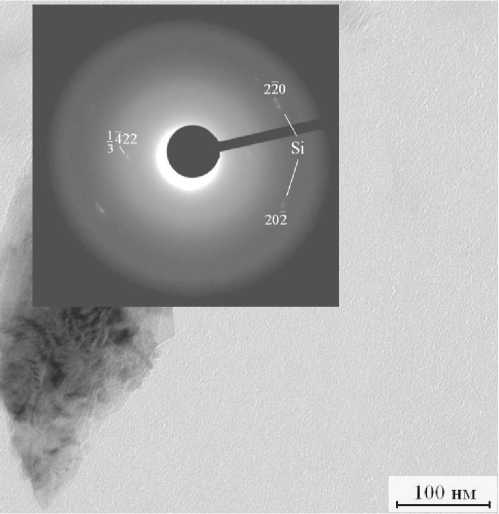
Рис. 1. Картина микродифракции и ПЭМ-изображение от пленки, сформированной на ювенильной поверхности (111)Si при температуре 1073 К
ВЕСТНИК БУРЯТСКОГО ГОСУДАРСТВЕННОГО УНИВЕРСИТЕТА.
На рисунке 2 а,б представлены электронограмма общей дифракции и ПЭМ-изображения, характеризующие фазовый состав и субструктуру пленки, сформированной на ювенильной поверхности (111) Si при T = 1123 K. Анализ электро-нограммы показывает, что на ювенильной поверхности образуется ориентированная пленка фазы β-SiC с параметрами кристаллической решетки а = 0.436±0.005 нм. Субструктура пленки — нанокристаллическая с двухосной текстурой, отвечающей основному ориентационному соотношению:
(111), [110] SiC II (111), [110] Si (1)
в трех симметрично эквивалентных позициях с учетом двойниковых 60 и 180 0 ориентаций. Наряду с ориентацией (1) определены дополнительные двухосные текстуры по следующим соотношениям.
(115), [110] SiC II (111), [110] Si,
(110), [110] SiC II (111), [110] Si.
Азимутальное размытие текстур составляет около 100.

Рис. 2. Электронограмма общей дифракции (а). Светлопольное и темнопольное (в отражении 111) ПЭМ-изображения (б) от пленки, сформированной на ювенильной поверхности (111)Si при T = 1123 K.
б)

Повышение температуры синтеза до 1173 K приводит к совершенствованию субструктуры и ориентации пленки β-SiC. Картина микродифракции и ПЭМ-изображения, представленные на рис. 3, иллюстрируют эти изменения. Из картины микродифракции следует, что в пленках карбида, полученных при этой температуре, азимутальное размытие текстуры не превышает 50. Средний размер зерна составляет 30 нм, размер субзерен — около 7 нм.


Рис. 3. Картина микродифракции (а), светлопольное и темнопольное в отражении 111 (б) ПЭМ-изображения пленки, сформированной на ювенильной поверхности (111)Si при T = 1173 K
Ориентация пленки по соотношению (1) очевидна в силу выполнения в этом случае одновременно двух кристаллогеометрических критериев эпитаксии (параллельность плотноупакованных рядов решеток SiC и Si, высокая плотность совпадающих узлов на межфазной границе SiC/ Si (рис. 3а)). Ориентация (2), не указанная на электронограмме (рис. 2а и 3а), показана на схеме сопряжения обратных решеток по (1) и (2) (рис.4б). Ориентация (2) образуется в результате двойникования по плоскостям {1 1 1} в зернах по (1). Ориентация (3) есть результат двойникования второго порядка, при этом ось <110> SiC разориентирована от <111> S i на 3.70. Схема текстурированной поликристаллической пленки β-SiC в проекции (1 1 0) показана на рис. 4 в. Образование зерен по (1) в параллельной и двойниковых (60 и 1800) позициях обусловлено закономерностями эпитаксиального роста. Образование микродвойников первого и второго порядка по (2) и (3) происходит, по-видимому, вследствие релаксации термических напряжений сжатия.
в)
а)

б)

Рис. 4. Схемы сопряжения решеток β-SiC и Si в плоскости (111) (а), сопряжения обратных решеток β-SiC для ориентации (1) и (2) (б) и схема формирования текстурированной поликристаллической структуры пленки β-SiC в проекции (1 1 0) (в)
Согласно ПЭМ-изображениям (рис. 2б и 3б) для пленки β-SiC характерна блочно-мозаичная субструктура с высокой плотностью дефектов упаковки (ДУ) и микродвойниковых прослоек, что отражается на электронограммах появлением запрещенных для пространственной группы β-SiC рефлексов 1/3 422 и тяжей в направлениях типа <112>.
Результаты АСМ-исследования морфологии карбидизированной ювенильной поверхности скола (рис. 5) хорошо согласуются с результатами ПЭМ и показы-15
вают, что при T = 1123 K на поверхности раскола формируется спло шн а я плен ка с о с ре дн им п ереп а дом высот 6.5 нм и шероховатостью около 1.8 н м. Од н ом о дально ст ь рас пр ед е ле н ия высот на гистограмме свидетельствует об од нор одно с т и морфо лог ии п ле н ки .
а)


Рис. 5. АС М -скан (а) и гистограмма распределения высот (б) ю в е ниль но й по в ер х нос т и, ка р б ид из ир ов а нно й пр и T = 1123 K
Не юв е ни л ьн ая по верх н ос ть
На рисунке 6 п ре дс т авл ены РЭМ-изображения, характеризующие морфоло г и ю н ею в е н ильной п ов е р хн ос т и ( 111) Si , ка рбид и зи рова нной при T = 1123 K (а) и T = 1173 K.
При T = 1 123 K кар бидная фаза представлена островками с попер е чн ым р азмером — 150 н м с к ри сталлографической огранкой (рис. 6а). При T = 11 73 K ра зме р и плот н ост ь ос т ровков соответственно выше, чем при T = 1 123 K, и со с т авляет 700 н м (рис. 6б) .
Ос т ровки выс от ой д о 110 нм зарождаются на террасах в местах проб оя тонкой пленк и ес т е с т ве нн ог о оксид а (Si O 2 ). Точки пробоя оксида хорошо проявляются на АСМ-ска н е в ре ж и ме DFL (рис. 7а). Глубина ямок составляет около 2 н м, ширина террас — о коло 2м км, вы с от а т ер рас д ос т и г ае т 18 н м (рис. 7б ) .

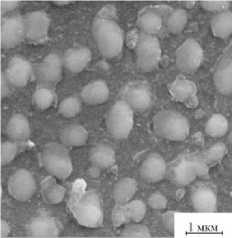
Рис . 6 . РЭМ-изображения пленок β-SiC на неюв е ниль но й по в ер х нос т и р а с кол а (1 1 1 )S i , с фо рмиро ванны х при T = 1123 K (а) и T = 1173 K (б)


Рис. 7. АСМ-скан в режиме постоянной силы (DFL) (а) и перепад высот по линии скана (б) неювенильной поверхности, карбидизированной при T = 1123 K
Присутствие на неювенильной поверхности слоя естественного оксида подтверждается анализом оже-спектра. Так, в приповерхностных слоях (глубина около 1 нм) скола (111)Si содержится 60% углерода, 35% кремния и около 5% кислорода. Пик O KLL (503 эВ ) соответствует аморфной форме SiO 2 . Положение и вид пиков С KLL (269 эВ) и Si LMM (93 эВ) — аморфной форме углерода и кремния [10]. Для сравнения в верхней части рисунка 8 представлен эталонный спектр от глубинных слоев пленки β-SiC, полученой на Si в подобных условиях. На эталонном спектре SiC пик электроположительного элемента Si LMM (91 эВ)

Рис. 8. Дифференцированный оже-спектр с карбидизированной при T = 1123 K неювенильной поверхности (111) Si. Эталонный оже-спектр от пленки SiC (сверху) [11]
сдвинут в низкоэнергетическую сторону, а пик С KLL (273 эВ), напротив, сдвинут в сторону более высоких энергий. Таким образом, по данным оже-спектоскопии, неювенильная поверхность покрыта слоем естественного оксида, аморфным углеродом и аморфным кремнием. Последний, вероятно, поступает из окон пробоя оксида кремниевой подложки.
ПЭМ-изображение и элек-тронограмма, представленные на рисунке 9, характеризуют субструктуру островков β-SiC, образованных при Т = 1173 K. Субструктура островков β-SiC — поликристаллическая с размерами зерен от 20 до 40 нм и субзерен около 10 нм. Для субзерен характерна высокая плотность ДУ и микродвойни- ковых прослоек, чем и объясняются запрещенные рефлексы 1/3 422 и 200 на
электронограмме (рис. 9а). Пучности на кольце 220 дают текстурированные зер-
на, расположенные вблизи ямок пробоя естественного оксида SiO 2 . Зерна вдали от ямок не ориентированы, что обусловлено латеральным ростом островков β-SiC на слое оксида за счет диффузии атомов Si из точек пробоя.


Рис. 9. ПЭМ-изображение (а) и электронограмма общей дифракции (б) пленки β-SiC на неювенильной поверхности Si(111) при T = 1173 K
Заключение
Эффект ювенильной поверхности кремниевой подложки в процессе ее кар-бидизации при температуре в диапазоне от 1123 до 1173 K проявляется в том, что в этом случае формируется сплошная тектурированная пленка β-SiC с низким значением шероховатости. В случае неювенильной поверхности карбидная фаза образуется локально в местах пробоя естественного оксида. Увеличение размеров островков карбидной фазы осуществляется за счет латеральной диффузии кремния из точек пробоя оксида.
Список литературы Субструктура плёнок p-SiC, синтезированных на поверхности скола моно-Si в вакууме и на воздухе
- Дубневский А. Электроника на карбиде кремния: мощнее, быстрее, надежнее. Электротехнический рынок. 2021. № 4–5(100–101). С. 14–17. Текст: непосредственный.
- Кукушкин С. А., Осипов А. В., Феоктистов Н. А. Синтез эпитаксиальных пленок карбида кремния методом замещения атомов в кристаллической решетке кремния // Физика твердого тела. 2014. № 56(8). С. 1457–1485. Текст: непосредственный.
- Via F. La, Severino A., Anzalone R. et al. From thin film to bulk 3C-SiC growth: Understanding the mechanism of defects reduction. Materials Science in Semiconductor Processing. 2018; 78: 57–68.
- Severino A., D’Arrigo G., Bongiorno C. et al. Thin crystalline 3C-SiC layer growth through carbonization of differently oriented Si substrates. Journal of Applied Physics. 2007; 102: 023518-1–023518-10.
- Severino A. 3C-SiC epitaxial growth on large area silicon: Thin films. Silicon Carbide Epitaxy. Research Signpost. 2012: 145–191.
- Ferro G. C-SiC Heteroepitaxial Growth on Silicon: The Quest for Holy Grail. Critical Reviews in Solid State and Materials Sciences. 2015; 40(1): 56–76.
- Massoubre D., Wang L., Chai J. et al. Single-crystalline 3C-SiC thin-film on large Si substrate for photonic applications. Nanotechnology: MEMS, Fluidics, Bio Systems, Medical, Computational & Photonics. 2014; 2: 416–419.
- Wijesundara M. B. J. and Azevedo R. Silicon Carbide Microsystems for Harsh Environments. Springer, 2011, XVI. 232 p.
- Mishra N., Hold L., Iacopi A. et al. Controlling the surface roughness of epitaxial SiC on silicon. Journal of Applied Physics. 2014; 115: 203501-1–203501-8.
- Miyoshi K., Buckley D. H. Surface chemistry and friction behavior of the silicon carbide (0001) surface at temperatures to 1500 deg C. NASA Technical Paper-1813. 1981: 1–10.
- Beisenov R., Ebrahim R., Zommorodian A. et al. AES Studies of Heteroepitaxial SiC Films Deposited on Si and on Sapphire Substrates by MOCVD. Eurasian Chemico-Technological Journal. 2013; 15: 259–263.


