Варикапы на основе многослойных эпитаксиальных GaAs-структур для ВЧ-аппаратуры
Автор: Суменков А.Н., Сурайкин А.И.
Журнал: Огарёв-online @ogarev-online
Статья в выпуске: 18 т.4, 2016 года.
Бесплатный доступ
Представлены результаты разработки и исследования полупроводниковых мезаэпитаксиальных GaAs-варикапов для широкого применения в высокочастотной аппаратуре. Приводятся общие технические требования к GaAs-варикапам, а также основные электрические параметры и характеристики экспериментальных образцов мезаэпитаксиальных GaAs-варикапов.
Арсенид галлия, варикап, добротность, ёмкость, коэффициент перекрытия по ёмкости, мезаэпитаксиальная структура
Короткий адрес: https://sciup.org/147250620
IDR: 147250620 | УДК: 621.382.037.37
Varactor Diodes Based on Multilayer Epitaxial GaAs-composition for High-frequency Equipment
The article presents the results of designing and studying of semiconductor mesaepitaxial GaAs-varactor diodes for general application in high-frequency equipment. The study provides the general technical requirements for GaAs-varactor diodes and the electrical parameters of the experimental mesaepitaxial GaAs-varactor diodes.
Текст научной статьи Варикапы на основе многослойных эпитаксиальных GaAs-структур для ВЧ-аппаратуры
За рубежом и на ряде российских предприятий имеется технология производства многослойных эпитаксиальных GaAs-структур. На сегодняшний день на основе таких структур разработаны быстродействующие высоковольтные p–i–n-диоды для преобразовательной и импульсной техники [1, с. 35–37]. Применение технологии производства быстродействующих высоковольтных p–i–n-диодов для изготовления мезаэпитаксиальных GaAs-варикапов позволяет создать необходимые предпосылки для разработки высокодобротных варикапов с широким диапазоном рабочего напряжения.
Использование в GaAs -диодных структурах зависимости барьерной ёмкости от приложенного обратного напряжения с последующим нормированием этой зависимости позволяет реализовать такой полупроводниковый прибор, как варикап. Характер этой зависимости, то есть вольт-фарадной характеристики, определяется видом распределения концентрации примесей в области объемного заряда р – n -перехода и, соответственно, методом его изготовления. Эти зависимости получены аналитически и достаточно известны как для резких р – n -переходов, таки для плавных р – n -переходов [2]. В данной работе сделана попытка получения варикапа на основе технологии формирования мезаэпитаксиальных диодных структур с резким р – n -переходом.
Основные требования к мезаэпитаксиальным GaAs -варикапам для ВЧ -аппаратуры кратко можно представить в следующем виде:
-
1) ёмкость варикапа при обратном напряжении – U R =4 В: 220–280 пФ (первый вариант исполнения – одиночные кристаллы), 55÷80 пФ (второй вариант исполнения – два варикапа на одном кристалле);
-
2) добротность варикапа при обратном напряжении – U R =4 В: не менее 200 (первый вариант исполнения – одиночные кристаллы), не менее 120 (второй вариант исполнения – два варикапа на одном кристалле);
-
3) коэффициент перекрытия по ёмкости варикапа (отношение ёмкости варикапа при U R =4 В к ёмкости варикапа при U R =100 В): не менее 3,5;
-
4) постоянный обратный ток варикапа при U R =100 В в рабочем диапазоне температур – не более 1 мкА;
-
5) рабочий диапазон температуры окружающей среды от –60 до +85 oC.
Структура кристалла мезаэпитаксиального GaAs -варикапа приведена на рисунке 1.
Структура, приведенная на рисунке 1 формируется методами жидкофазной эпитаксии. Полученные эпитаксиальные p+ – n- – n+ – n+ -структуры имеют несколько металлургических переходов внутри структуры [3, с. 36–47].
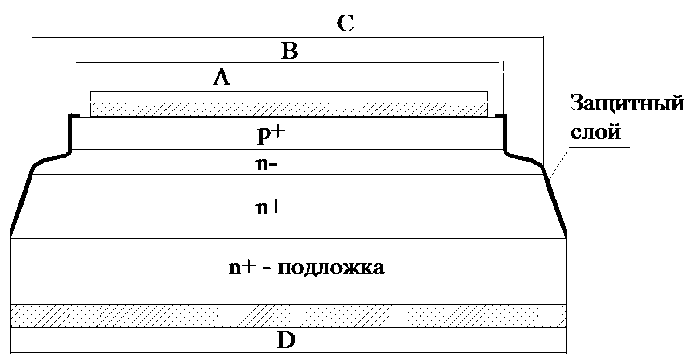
A - контакт анода, B - анодная область (p +), C - высокоомная n "-область, D - катод.
В качестве защитного слоя могут использоваться диэлектрические плёнки SiO 2 и Si 3 N 4 , а также полимерные материалы типа фотоимидов
Рис. 1. Структура кристалла GaAs -варикапа.
Физическая структура и распределение концентрации в p + - n - n + - n + -структуре кристалла варикапа приведена на рисунке 2. Принимая в расчет общую протяженность эпитаксиальных областей и подложки GaAs -варикапа такой, как показано на рисунке 2, то на переходах x ji , x j2 , x j3 возникают диффузионные потенциалы, сумма которых дает полное диффузионное напряжение такое же, как и на GaAs p - i - n -диоде при T =300 K [1-2]:
Uvd = Uxj1 + Uxj2 + Uxj3 ^ 1,2В. (1)
Так как варикап представляет собой, прежде всего, диодную структуру, то практически все параметры, включая присущие непосредственно варикапам, определяются удельным сопротивлением и толщиной высокоомного эпитаксиального слоя. В этом факте содержится как положительный момент (весь расчет варикапа мы можем свести к расчету параметров высокоомного эпитаксиального слоя), так и небольшой минус: неконтролируемое изменение параметров высокоомной эпитаксиальной пленки, а также параметры всех остальных эпитаксиальных слоев, включая паразитные сопротивления металлических контактов приводят к заметному разбросу ряда электрических параметров, таких как ёмкость и добротность.

W SCL – область пространственного заряда в высокоомном эпитаксиальном слое.
Рис. 2. Физическая структура и распределение концентрации носителей заряда в структуре GaAs -варикапа.
Поэтому, в конечном итоге, только исследование экспериментальных образцов варикапов с последующей нормировкой значений электрических параметров позволяет оптимизировать структуру кристалла варикапа.
Используя формулу плоского конденсатора, для структуры, приведенной на рисунке 2, можно записать:
_ £ ’ £ 0 ' S pn VD “ W scl U r ) ,
где ε – диэлектрическая проницаемость GaAs ,
ε 0 – электрическая постоянная;
S pn – площадь p – n -перехода варикапа;
W SCL – ширина области пространственного заряда высокоомного эпитаксиального слоя (базы), зависящая от приложенного обратного напряжения – U R .
Учитывая, что разрабатываемые варикапы на основе GaAs выполнены полностью по эпитаксиальной технологии с разностью концентраций в несколько порядков, то вполне приемлемо приближение «Резкого» асимметричного p–n-перехода. Для такого перехода, в приближении обеднения (при обратных напряжениях), ёмкость можно аппроксимировать следующим соотношением [4, с. 80–88]:
c = S ■
VD pn
q • £ • £ 0 • Nd
V 2 • (Upn + Ur ) ,
где N D – концентрация донорной примеси в базовой области варикапа (высокоомном эпитаксиальном слое);
U* pn – контактная разность потенциалов p – n -перехода варикапа.
Принимая во внимание то, что ёмкость варикапов ( C VD ) и диапазон обратных напряжений ( U R ), как правило, оговариваются в исходных технических требованиях, а контактную разность потенциалов – U* pn можно вычислить в соответствии с (1), то на основании (3) можно определить в первом приближении площадь варикапов при уровне легирования базовой области (1-2) . 10 15 см -3 :
S pn = C vd •
2 • (Upn + Ur )
\ q •£ •£ о • nd ’
Использования соотношения (4) при разработке варикапов удобно тем, что одну и ту же структуру мы можем использовать для изготовления двух типов варикапов.
-
а) При обратном напряжении U R =4 В и ёмкости C VD =250 пФ мы получим значение площади p - n -перехода для первого варианта исполнения варикапа - S pn « 5,5 мм2.
-
б) При обратном напряжении U R =4 В и ёмкости C VD =68 пФ мы получим значение площади p - n -перехода для второго варианта исполнения варикапа - S pn « 1,6 мм2.
Толщину высокоомного эпитаксиального (базового) слоя h Bepi выберем исходя из условия, что данная величина должна быть больше ширины области пространственного заряда ( ОПЗ ) W SCLmax при максимальном обратном напряжении U R max в (5).
h >W
Bepi > W SCL max
2 • £ • £ о • (UPn + Ur max)
q • N D
Согласно (5), при U R max = 100 В, получим W SCLmax « 12 мкм.
Таким образом, на основании полученных данных выбор толщины высокоомного эпитаксиального (базового) слоя h Bepi >12 мкм вполне приемлем.
Все вышеприведенные параметры – концентрация донорной примеси в базовой области варикапа, толщина эпитаксиального слоя базовой области варикапа – непосредственно связаны с величиной добротности (6).
Q=
, π f VD VD
где C VD – общая ёмкость варикапа при некотором заданном обратном напряжении – U R ;
f =50 МГц – частота переменного напряжения, на которой осуществляется измерение добротности при некотором заданном обратном напряжении – U R ;
R VD – общее активное сопротивление структуры варикапа, с приемлемой точностью можно принять равным сопротивлению базовой области варикапа (сопротивлением контактов и высоколегированных областей можно пренебречь).
С учетом вышесказанного, общее активное сопротивление структуры варикапа [5, с. 147– 303]:
RVD ≈ RB
1 WB WB
=⋅B = ρB ⋅ B q⋅µn⋅ND Spn B Spn ,
где ρ B = – удельное сопротивление базовой области варикапа;
q⋅µn ⋅ND
S pn – площадь p – n -перехода варикапа;
W B – толщина квазинейтральной области базы варикапа.
Толщину квазинейтральной области базы варикапа можно вычислить следующим образом (рис. 2):
W B = h Bepi - W SCL = x j 2 - x j 1 - W SCL , (8)
где h Bepi – толщина эпитаксиального слоя базовой области;
W SCL – ширина ОПЗ в базовой области варикапа.
Соотношение (7) показывает преимущества применения полупроводниковых материалов с высокой подвижностью носителей заряда для изготовления варикапов. В данном случае применение GaAs для изготовления варикапов со структурой, приведенной на рис. 1, обеспечивает подвижность электронов в базовой области – µ n ≈ 5000 см2/В . с (для сравнения, в кремнии – µ n ≈ 1420 см2/В . с). Это обеспечивает более низкие, по сравнению с Si , значения полного активного сопротивления варикапов и, как следствие, на основании (6), более высокие значения добротности GaAs -варикапов.
Следует отметить, что и при расчете, и при измерении толщины и удельного сопротивления базового слоя варикапа имеет место существенная погрешность. Кроме всего, что связано непосредственно с объемом структуры варикапов на параметры существенное влияние оказывает поверхность («Меза»-область), где имеют место нарушения кристаллической структуры и, как следствие, высокая плотность зарядовых состояний. Структура «Меза»-области приведена на рисунке 3.
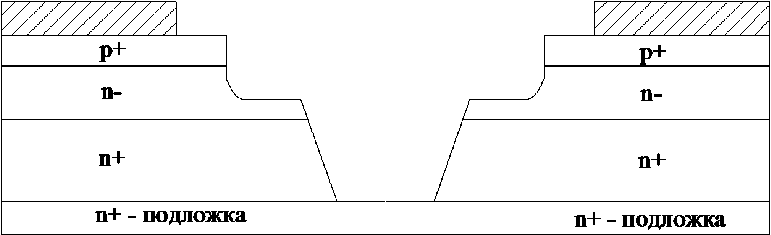
Рис. 3. Структура «Меза»-области кристаллов варикапов.
Поэтому на практике чаще всего сопротивление R VD устанавливают экспериментальным путем на основе измерения динамического сопротивления прямой ветви вольтамперной характеристики варикапа.
После сборки экспериментальных образцов GaAs -варикапов (корпус типа ТО-251), было проведено исследование их вольт-амперных и вольт-фарадных характеристик. Также было проведено измерение добротности.
Вольт-фарадные характеристики 10 штук экспериментальных образцов варикапов первого типа (одиночные кристаллы) при T =300 K приведены на рисунке 4.
Исследуя рисунок 4 можно отметить, что линейность вольт-фарадных характеристик наблюдается практически во всем рабочем диапазоне обратных напряжений, начиная от 4 В и до 100 В. Лишь на участке менее 4 В наблюдается резкое возрастание ёмкости, но это не регламентированный для работы интервал обратных напряжений.

Рис. 4. Вольт-фарадные характеристики десяти экспериментальных образцов
GaAs -варикапов первого типа (одиночные кристаллы) при T =300 K.
Вольт-фарадные характеристики 10 шт. экспериментальных образцов варикапов второго типа (сдвоенные кристаллы) при T =300 K приведены на рисунке 5.
Рисунок 5 показывает результат аналогичный предыдущему (см. рис. 4) с точки зрения линейности характеристики. Отличие в том, что величина ёмкости данного варикапа ниже, чем у предыдущего варианта (измерения проводились на одном, произвольно выбранном варикапе).

Рис. 5. Вольт-фарадные характеристики 10 шт. экспериментальных образцов
GaAs -варикапов второго типа (два варикапа на одном кристалле) при T =300 K.
Измерение добротности варикапов, а также зависимости данной добротности от частоты проводилось с помощью измерителя добротности Е4-11. Результаты измерения приведены на рисунках 6 и 7.

1 – варикапы со средней ёмкостью 350 пФ
2 – варикапы со средней ёмкостью 250 пФ
Рис. 6. Аппроксимированная зависимость добротности варикапов первого типа от частоты.

Рис. 7. Аппроксимированная зависимость добротности варикапов второго типа от частоты (среднее значение ёмкости – 68 пФ).
В результате проведенной работы выполнен расчет физической структуры мезаэпитаксиальных GaAs -варикапов двух типов: однокристальный вариант и вариант с двумя варикапами на одном кристалле. Изготовлены экспериментальные образцы мезаэпитаксиальных GaAs -варикапов, проведено исследование их электрических параметров и характеристик.
В результате исследования электрических характеристик мезаэпитаксиальных GaAs -варикапов, включая вольт-амперные и вольт-фарадные характеристики установлено, что полученные зависимости позволяют использовать их наряду с кремниевыми варикапами в радиотехнической аппаратуре общепромышленного применения. Более широкий диапазон рабочих напряжений мезаэпитаксиальных GaAs -варикапов позволяет применять их более широко, включая высоковольтную аппаратуру. Полученные значения добротности варикапов, величины которых превосходят добротности аналогичных кремниевых варикапов, обеспечивают возможность применения мезаэпитаксиальных GaAs – варикапов в ВЧ - и СВЧ -аппаратуре.
Список литературы Варикапы на основе многослойных эпитаксиальных GaAs-структур для ВЧ-аппаратуры
- Сурайкин А. И. Быстродействующие высоковольтные GaAs-диоды для преобразовательной техники и импульсных устройств // Электроника и электрооборудование транспорта. - 2015. - № 2. - С. 35-37. EDN: TSOMZL
- Сурайкин А. И., Федотов Е. Н. Быстродействующие высоковольтные GAAS диоды для силовой электроники [Электронный ресурс] // Огарев-online. - 2014. - № 22. - Режим доступа: http://journal.mrsu.ru/arts/bystrodejjstvuyushhie-vysokovoltnye-gaas-diody-dlya-silovojj-ehlektroniki. EDN: SNJRTD
- Арсенид галлия. Получение, свойства, применение / Под ред. Ф. П. Кесаманлы, Д. Н. Наследова. - М.: Наука, 1973. - 472 с.
- Зи С. Физика полупроводниковых приборов: В 2-х книгах. Кн. 1. / Пер. с англ. - 2-е перераб. и доп. изд. - М.: Мир, 1984. - 456 с.
- Уотсон Г. СВЧ-полупроводниковые приборы и их применение / Под ред. Г. Уотсона. - М.: Мир, 1972. - 662 с.


