Влияние процессов на стенках капилляра на параметры плазмы положительного столба разряда низкого давления
Автор: Мольков Сергей Иванович
Журнал: Ученые записки Петрозаводского государственного университета @uchzap-petrsu
Рубрика: Физико-математические науки
Статья в выпуске: 2 (123), 2012 года.
Бесплатный доступ
В работе проанализировано влияние эмиссии вторичных электронов, ион-электронной и фотоэмиссии, а также термализации атомов и ионов на стенках капилляра на параметры плазмы положительного столба разряда низкого давления. Рассмотрена роль степени шероховатости поверхности стенки разрядного капилляра в данных процессах.
Разряд низкого давления, эмиссия электронов, коэффициент аккомодации, степень шероховатости стенки, параметры плазмы
Короткий адрес: https://sciup.org/14750112
IDR: 14750112 | УДК: 537.525
Influence of capillary walls’ processes on plasma parameters in positive discharge column of low pressure
The influence of the secondary electron emission, the ion-induced electron, and photoemissions are analyzed. The thermalization of the atoms and ions on the capillary walls on the plasma parameters of the positive discharge column of low pressure are analyzed. The role of the degree of the surface roughness of the discharge capillary wall in the given processes is considered.
Текст научной статьи Влияние процессов на стенках капилляра на параметры плазмы положительного столба разряда низкого давления
ПОСТАНОВКА ЗАДАЧИ
Параметры плазмы газовых разрядов низкого давления зависят от процессов взаимодействия молекул, атомов, ионов и электронов плазмы со стенкой разрядной камеры [5], [10]. Твердые поверхности могут служить источниками заряженных частиц за счет электронной эмиссии [11]. На стенках происходит рекомбинация плазменных электронов и ионов, осуществляется теплообмен [16], имеют место различные химические реакции. Характер взаимодействия кроме свойств материала стенки существенно зависит и от степени ее шероховатости [12]. Результаты упомянутых работ носят качественный характер. В данной работе количественно рассмотрено влияние процессов на стенках разрядной камеры на параметры плазмы положительного столба разряда низкого давления и влияние на эти параметры степени шероховатости поверхности стенки.
ЭМИССИЯ ЭЛЕКТРОНОВ
Электронная эмиссия включает в себя эмиссию вторичных электронов, ионно-электронную и фотоэмиссию. Вторичная электронная эмиссия описывается коэффициентом вторичной электронной эмиссии. При малых энергиях налетающих электронов (до 50 эВ) в потоке вторичных электронов преобладают истинно вторичные электроны с коэффициентом эмиссии δ и энергиями порядка 1 эВ и упруго отраженные электроны с коэффициентом эмиссии r и энергиями, равными энергиям налетающих электронов. Величины δ и r для гладкой поверхности зависят от материала стенки и энергии налетающих электронов ε [4]. Зависимость от угла падения слабая.
Поведение δ и r в зависимости от ε имеет довольно сложный характер. Однако, учитывая, что плазменные электроны имеют существенный разброс по скоростям, тонкая структура δ и r не важна. Кроме того, в конечные выражения коэффициенты эмиссии входят под знаком логарифма. Это позволяет для их описания использовать единые аппроксимационные формулы, учитывающие их основные особенности: рост δ начиная с порогового значения εt и наличие максимума у r, равного rm при энергии εm. Таким условиям удовлетворяют выражения:
-
8 = A ( e- e ) a , r = 2,718 r m — exp J-— L (1)
t —m I 8m J где А, а – постоянные аппроксимации. Используемые нами значения постоянных аппроксимации для диэлектриков, полученные по данным [4], равны: А = 0,18, а = 0,54, εt = 4,5 эВ, εm = 4 эВ, rm= 0,55. Для металлов разброс значений постоянных существенно выше. Поэтому для разрядных камер, собранных из изолированных металлических сегментов, соответствующие коэффициенты аппроксимации даны в таблице.
Коэффициенты аппроксимации
|
А |
a |
εt , эВ |
εm , эВ |
r m |
|
|
Си |
0,044 |
0,73 |
6 |
10 |
0,13 |
|
W |
0,036 |
0,71 |
5,5 |
10 |
0,2 |
|
Al |
0,016 |
0,87 |
5 |
4 |
0,14 |
|
Ni |
0,012 |
0,92 |
4 |
2.5 |
0,11 |
Для расчета средних значений δ и r , получающихся при учете разброса первичных электронов по энергиям и углам падения θ , имеем:
”,,,.__ 1
5 = - JJf 5(8,e)dJ=(u,9) , r = - Jff r ( 8,9 ) dJE(u,9) , (2)
Je 0(2π) J e 0(2π)
где Je – плотность потока электронов на стенку; dJe ( υ , θ ) – плотность потока электронов со скоростями υ в интервале dυ , движущихся к стенке в направлении θ в телесном угле d Ω = sin θ dθ dφ , φ – азимутальный угол. При максвелловской функции распределения электронов (ФРЭ) по скоростям имеем:
dJ e ( и,9) = n e

m^— Ц^зо3 di3cos9 dQ , 2T
e
J = n ee
J e ( 1 - P f 5 ) = J i ( 1 + P f Y f ) , Y f = Y + 510 - 2 Q , / в . (7)
3/2
I I l 2nTe J ’
где m , n e , T e - масса, концентрация и температура электронов, выраженная здесь и ниже в энергетических единицах. Для ФРЭ, отличной от максвелловской, T e - эффективная «температура хвоста» функции распределения -T e' , а перед n e появляется нормировочный множитель X (для газов с высоким потенциалом возбуждения резонансных уровней X ^ 1). Используя выражения (1) по формулам (2), (3), получаем:
5 = A Г (1 + a) 1 + a + — I Tea exp l ^e J

r = 5,44
У £ 1
rm ε m e
^ + T e ) 3 ’
где Г ( x ) - гамма-функция. Для диэлектриков
имеем:
/
5 = 0,25
l
I I
1 + — I T 0 exp |-
T e J I

47,8 T r =------ e—
(4 + T e )' .
Эффективные коэффициенты вторичной эмиссии с поверхности получаем, домножая выражения (4) или (5) на вероятность вылета частицы без вторичных столкновений P
5 f = P f 5, r f = P f r, о ef = P f о = P f ( 5 + r ) . (6)
Эмиссия электронов при взаимодействии со стенкой ионов для условий разряда носит потенциальный характер, так как энергия ионов не превышает 103 эВ. В этом случае коэффициенты ион-электронной эмиссии у слабо зависят от энергии налетающих ионов и их можно считать постоянными. Величина у растет с ростом энергии ионизации E a и уменьшается с ростом работы выхода электронов из материала стенки еф. Для оценки у можно использовать эмпирическую формулу [14]: y ~ 0,016 (Еа - еф ), где Еа , еф выражены в эВ. Величина квантового выхода фотоэффекта Y растет с ростом энергии фотона hv и имеет тенденцию к насыщению. Для инертных газов hv ~10 эВ и Y ~10-3 * 10-1 для различных материалов. С учетом потерь электронов при выходе с шероховатой поверхности имеем: Y f = f Y f f = P f Y ^ 510" P f .
Уравнение баланса зарядов на стенке принимает вид: J. = J e - o ef J e - yJ -Y ff J , где J, Je , J - плотность потока на стенку ионов, электронов и резонансных фотонов. Учитывая, что J /J. = Q / в , где в - коэффициент ионизации; Q -константа скорости возбуждения резонансных уровней, распадающихся спонтанно [3], и используя (6), получаем:
Плотности потоков на стенку J e и J . равны соответственно:
J e
= n g

eN I , I Te + t
T I , J i M m
e
= n g

где M - масса атома (иона); n - концентрация заряженных частиц на границе плазма - слой. Используя выражение (7) для падения потенциала в пристеночном слое объемного заряда Лф, получаем:
T
^Ф = —In e I
где T - «температура хвоста» ФРЭ. При максвелловской ФРЭ T e = T e .
КОЭФФИЦИЕНТЫ АККОМОДАЦИИ АТОМОВ И ИОНОВ
Теплообмен тяжелых частиц со стенкой характеризуется коэффициентом аккомодации, равным отношению энергии, передаваемой частицей стенке при столкновении, к максимально возможной энергии. Будем использовать для коэффициентов аккомодации аппроксимационную формулу для однократного рассеяния атомов на решетке твердых сфер [2]: а 0 = 2,4 ц /(1 + ц )2, где ц = M/M w - отношение массы частицы газа к массе атома поверхности.
Реальная поверхность является шероховатой, и поэтому часть атомов после отражения испытывают столкновения со стенкой. Учитывая, что после n -го столкновения со стенкой атом либо покидает ее с энергией En=2a0T w + ( 1 - а 0) en-] , где s n _ 1 - энергия после n - 1 столкновения с вероятностью Pf , либо испытывает еще одно столкновение c вероятностью 1 - P f , для эффективного коэффициента аккомодации атомов получаем:
α а= =----А.
ао + Pf (1 - ао )
Ионы двигаются к стенке в двойном слое объемного заряда по нормали к средней поверхности. Вблизи стенки их траектории несколько искривляются в соответствии с искажением электрического поля вблизи отрицательно заряженной шероховатой поверхности. В отличие от атомов, которые попадают на стенку под всевозможными углами, ионы попадают на стенку под малыми углами 6. Тогда коэффициент аккомодации для такого столкновения равен 1,5 а0 . Считая, что повторные столкновения описываются коэффициентом аккомодации а0 , и используя такие же, как и при выводе (9), рассуждения для ионов, получаем:
а0(1 + 0.5Pf) ai =-----------—.
ao + Pf(1 - ао)
Кинетические энергии атомов после столкновения со стенкой s a и после рекомбинации иона на стенке s'a определяются уравнениями:
Ea = 2aaTW + ( 1 - aa ) 2 Ta ’ Ea = 2aiTW + ( 1 - ai ) E iW , (11)
где T w - температура стенки; sW - кинетическая энергия иона при столкновении со стенкой. Коэффициент 2 в формулах (13) появляется здесь потому, что, в отличие от средней энергии частицы в разряде, равной 3 T /2, средняя энергия, переносимая частицей на поверхность или с поверхности, равна 2 T Величина s iW равна сумме кинетической энергии иона на границе плазма -слой T /2 [16] и энергии, приобретаемой в слое еЛф = А nT e . Тогда для s W получаем:
S iW = 0.5 Te +^п T e . (12)
ХАРАКТЕРИСТИКИ ШЕРОХОВАТОЙ ПОВЕРХНОСТИ
Будем считать, что поверхность описывается случайной функцией z(x , у) с непрерывными производными z= д z/ д x, z = д z/ 9y, где плоскость ху совпадает со средним уровнем поверхности. Двумерная плотность распределения вероятности случайных величин z 1 , z 2 , соответствующих точкам (x 1 , у), (x2, y) имеет вид [2]:
f ( z 1 , z 2 ) =
2 па \/1 - у2

z 1 2 + z 2 - 2 у z 1 z 2 I
2 a ( 1 — Y 2) J ’
где Y = exp{-t2 /p2} - функция корреляции высот шероховатости; t = (x - x2 )2 + (y1 - у2 )2 - ка жущееся расстояние между точками; о - среднеквадратичное отклонение z от среднего уровня; р - радиус корреляции. При t > р случайные величины z1 и z2 статистически не связаны.
Рассмотрим две близкие точки ( х , у ), ( х + dx , у ) и ( х , у ), ( x + dx , y + dy ). Используя выражение (13), получаем плотности распределения вероятности случайных величин z x и z x , z y :
fL ( z x ) =
ρ
2 πσ

fS ( zx-z, ) =
ρ2 4πσ2

ρ2z
4σ2

ОПРЕДЕЛЕНИЕ ПАРАМЕТРОВ ШЕРОХОВАТОСТИ
Параметры о и р связаны с непосредственно измеряемыми характеристиками поверхности. В частности, о определяется классом точности обработки поверхности, а р можно связать с отношением истинной площади поверхности с кажущейся ^ S , или отношением истинного расстояния на поверхности к кажущемуся ^ L , которое определяется по профилограмме.
Очевидно, что ^s и ^ L равны соответственно математическому ожиданию величин dS / dxdy и dl / dx , где dS и dl - элементы площади и длины на поверхности, соответствующие элементам dxdy и dx в плоскости xy . Учитывая, что dS / dxdy = 1 + z x + z 2 , dl / dx = V1 + z x для ^ S и ^ L , имеем:
+M+M ___________ +К ______
^ s = J J V1 + x X + z y f ( z z y ^dxdy , ^ L = J V1 + 4 fL ( z x ) d x . -К-M -К
Используя формулы (14) для fS , f L и аппроксимируя результаты интегрирования, получаем:
V s = V 1 + nP S , ¥ l = ^ 1 + 4P S /n , (15)
где P s = о/р - параметр шероховатости реальной поверхности. Эти же параметры можно определить независимо по рассеянию лазерного излучения поверхностью [9].
ВЕРОЯТНОСТЬ ВЫЛЕТА ЧАСТИЦЫ С ШЕРОХОВАТОЙ ПОВЕРХНОСТИ БЕЗ СТОЛКНОВЕНИЙ
Электроны, эмитируемые стенкой, атомы после столкновения со стенкой и атомы, образовавшиеся при рекомбинации ионов, могут испытывать повторные столкновения. При этом коэффициент эмиссии электронов уменьшается, а коэффициент аккомодации атомов растет. Учесть это явление можно, вводя вероятность вылета частицы с шероховатой поверхности без столкновений Pf . Для расчета Pf определим среднеквадратичный тангенс угла наклона поверхности. Используя формулу (14) для fL , получаем: zz^ = J z x fL ( zx ) dz x = 2 P s 2. Тогда средний угол наклона поверхности относительно плоскости xy 9f будет приблизительно равен:
O f = arctg^z x = arctgPs . (16)
Пусть ф - угол рассеяния частицы поверхностью, отсчитываемый от среднего уровня. Считая, что все направления в пределах от 0 до п /2 равновероятны, для вероятности рассеяния частицы в пределах dф имеем dP = 2 dф/п. Введем вероятность вылета частицы под углом ср без повторных столкновений P(ф ). Очевидно, P ( ф ) = 0 при 0 < ф < 9f и P ( ф ) = 1 при 9f < ф < п /2. Тогда вероятность вылета частицы с поверхности без столкновений будет равна:
п /2 21
Pf = J P(^)dPT = -arctgYTn?,(17)
0 п2V где для 9f использована формула (16). На рис. 1 приведена зависимость Pf от Ps, рассчитанная по формуле (17), в сравнении с экспериментальными данными по вероятности вылета электронов с шероховатой поверхности для различных материалов с различной степенью шероховатости [4].
Зависимости Pf от материала не прослеживается. Соответствующие значения, приведенные на рис. 1, определены путем обработки профилограмм поверхностей, полученных с помощью электронного микроскопа с использованием формулы (15) для ΨL .
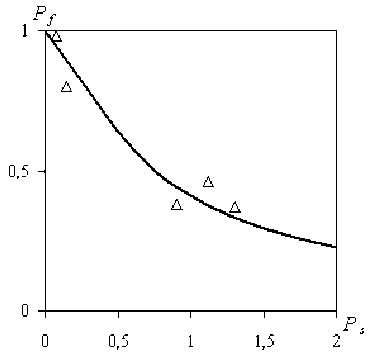
Рис. 1. Зависимость P f от параметра шероховатости Ps ; Δ – эксперимент; ( __ ) – расчет по формуле (17)
УРАВНЕНИЕ РАВНОВЕСИЯ ПЛАЗМЫ И ТЕМПЕРАТУРА ИОНОВ
Теория квазинейтрального положительного столба разряда низкого давления в продольном магнитном поле с индукцией B в режиме, когда длина свободного пробега ионов сравнима с радиусом капилляра, развита в работе [18]. Уравнение равновесия плазмы, выражающее баланс заряженных частиц, имеет вид:
n a в =
S g ( 5 ) / T e + T
R M ,
где Ti – температура ионов; Sg –
безразмерная параметра δ :
эффективная
граница плазмы, зависящая от
m ωe 2
δ=Q ia +
4β 2M n a βv e
v = n Q + n Q — e a ea e ei
частота столкновений электронов с атомами и ионами; Qea , Qei , Qia – транспортные константы скоростей столкновений электронов с атомами и ионами и ионов с атомами; го = eB / m - электронная гирочастота; чертой здесь и ниже обозначается усреднение по сечению разряда. Аппроксимируя результаты [18] для Sg , получаем: Sg = 1,092(1 + 0,142 δ )–1/2. Когда длина свободного пробега ионов λi<< R (режим амбиполярной диффузии, δ велико), уравнение равновесия (18) соответствует результатам теории Шоттки. В случае λi >> R при отсутствии магнитного поля ( δ = 0) уравнение (18) совпадает с уравнением равновесия плазмы Тонкса – Ленгмюра.
ФР ионов по скоростям в разрядах низкого давления существенно анизотропна. Продольная температура ионов TII близка к температуре атомов, а поперечная T существенно превышает Ta, что связано с высокой радиальной скоростью ионов, которая на границе плазмы и пристеночного слоя объемного заряда достигает величины Te/M . В случае свободного падения ионов на стенку: T┴ = 0,56Ta + 0,13Te [6], или T┴ = 0,64Ta + 0,118Te [6]. В общем случае (X. ~ R); используя распределение радиальных скоростей ионов [18] и метод, аналогичный изложенному в [6], получаем аппроксимационную формулу для T┴:
T L = [ 7 - 0.3482 2 ( 5 ) ] T + 0.09482 2 ( 5 ) T , (19)
которая при X i >> R согласуется с результатами [6], [7], а при X. << R дает T = T a . Эффективная температура ионов равна: T ┴ ≅ Ta .
T =( T „+2 T L )/3. ° (20)
ФУНКЦИЯ РАСПРЕДЕЛЕНИЯ ЭЛЕКТРОНОВ ПО ЭНЕРГИЯМ И КОНСТАНТЫ СКОРОСТЕЙ
ПРОЦЕССОВ
На практике используют разряды двух типов: слаботочные тлеющие, где концентрации электронов ne ~ 109–1011 см-3, и сильноточные с накаленным катодом, где ne ~ 1013–1014 см-3. В последнем случае вследствие интенсивных межэлектронных столкновений ФРЭ близка к максвелловской, тогда как в слаботочных разрядах она «на хвосте» обеднена из-за процессов возбуждения, ионизации и ухода быстрых электронов на стенку. Кроме того, длина релаксации ФР по энергии сравнима с R , что приводит к не-локальности ФРЭ [17].
При расчете нелокальной ФРЭ в кинетическом уравнении (КУ) необходимо сохранить члены, описывающие поперечную неоднородность плазмы [17]. Каждый акт ионизации сопровождается уходом одного быстрого электрона на стенку, и эти процессы разделены в пространстве. Для приближенного учета явления нелокальности заменим поперечные члены в КУ, описывающие радиальное движение электронов, добавкой в интеграле столкновений к частоте неупругих столкновений vin частоты ухода быстрых электронов на стенку v w, равной частоте ионизации vi . Таким образом, вместо vin = vex + vi , где vex – частота возбуждения, используем v'in = vex + 2 vi . При этом изотропная часть ФРЭ, полученная по методу [3], ведет к изменению константы скорости возбуждения и коэффициента ионизации на фактор F, а температуры «хвоста» ФР Te , на фактор D :
Q = Q ( T e ) F , в = в Г е ) F , T e = T e D , (21)
где
F = 1 У1 +4 С - 1 D = 2 C = v n = na [ S ex, ( T e ) + 2 в ( Te )]
C 1 + 4 C + 1 , V1 + 4 C + 1 , v ee v ee ’
Q(Te), β(Te) – соответствующие константы при максвелловской функции распределения с эф- фективной температуры Te; ve - частота меж электронных столкновений с энергией, превышающей пороговую для возбуждения.
ЗАКОН ОМА И БАЛАНС ДАВЛЕНИЯ
Для сильноточного разряда необходимо учитывать торможение электронной компоненты при упругих столкновениях с ионами и вытеснение нейтрального газа электронами и ионами.
j = eEz ne m n Q + n Q a ea e ei
P = n a T a + n e ( T e + T ) ,
где j , p - средняя по сечению плотность тока и давление наполнения; Е - напряженность продольного электрического поля. В слаботочном разряде можно положить n e = 0. В уравнении баланса давления пренебрегалось небольшим нетепловым вытеснением нейтрального газа из капилляра вследствие явления электрофореза и температурной транспирации. В сильноточных разрядах электрофорез компенсируется с помощью обводного канала, соединяющего катодный и анодный узлы разрядной трубки.
ТЕМПЕРАТУРА АТОМОВ И БАЛАНС ЭНЕРГИИ
В РАЗРЯДЕ
В слаботочных разрядах температура атомов соответствует температуре стенки. В сильноточных разрядах температура атомов достигает нескольких тысяч градусов Кельвина. Уравнение баланса энергии атомов запишем в интегральной форме:
2nRJ a Х T — T w ) = nR\n a
1Q..3 ( T - T ) + 2 ia 2 i a
+ T7 Q ea "^e — T a ) + в f Е « — "^Ta ^ , M2 ( 2 )
где J a = n a V T a /2 п M - плотность потока атомов на стенку. Левая часть данного уравнения описывает теплообмен атомов со стенкой, первый и второй члены правой части - обмен при столкновениях с ионами и электронами, третий член учитывает, что каждый акт ионизации ведет к появлению атома на стенке с энергией s'a и к «исчезновению» атома в разряде с энергией 3 T a /2.
T a = T W + — n e i 1ПГ 2 a i T W + (1 - “ i )s iW — T T a =
« а П а \^T a L 2 J
-
5 T w + s " e . (23)
Па \ 8Ta «a и T >> TW
Уравнение баланса
В слаботочных разрядах n e /n a ~10 " 7-10 " 6 и T a e TW В сильноточных разрядах ne /na ~10-2-10-1 энергии в разряде в интегральной форме имеет вид:
nR 2 j Ez = 2 n R ' J , . [ E a + a ( е да - 2T W ) -P f Ye , ]+
+ J e [ 2T e - P f ( re r + 5e s ) ] +
+ J a 2 a ( T a - T w ) + J , ( E , - 510 - 2 P f p ) } , где E - энергия резонансных фотонов; sr = 2 Te , £& ~ ^В, S y = 0,5( E a - e Ф )’ S = 0,5( Е Ф - e Ф ) - средние кинетические энергии вторичных электронов: упруго отраженных, истинно вторичных, образующихся при ион-электронной эмиссии и при фотоэффекте. Используя выражения для плотностей потоков частиц на стенку и формулу (23), получаем:
s„ Tз_ jEz = Pa + 'w —5 Ta—Pf Ye, +
R V M a I
+ 1 + Pf Yf [2T — p (re + ge )] + Q^ (e - 510-5 Pf e )|. (24) e f r ° V
-
1 - Pf ap
АПРОБАЦИЯ РЕЗУЛЬТАТОВ
Анализ системы уравнений (18, 19, 20, 22, 23, 24) показывает, что для разрядов низкого давления справедлив приближенный закон подобия, согласно которому при R -преобразовании внутренние инварианты n e R , n a R , T e , T a , T, ER остаются неизменными, если сохраняются внешние инварианты p , jR , BR , а также материал стенки и технология его обработки.
Отклонение от закона подобия связано с зависимостью коэффициента ступенчатой ионизации от концентрации электронов, а не от произведения n R . Наиболее ярко зависимость внутренних параметров плазмы от свойств материала стенки и степени ее шероховатости P s проявляется для сильноточных разрядов.
На рис. 2 представлены зависимости neR и Te от a a и o ef , а также от связанного с ними параметра шероховатости R s для разряда в капилляре из бериллиевой керамики ( a 0 = 0,44, у =0,17, для охлаждаемой стенки TW s 320 K =0,027 эВ). При расчетах использовались данные о сечениях процессов, собранные в [13], а при расчете коэффициентов прямой и ступенчатой ионизации e r , P t , , ( вг = вг + e st ), и констант скоростей Qex , Q - методика [3]. С ростом P s или а величина T уменьшается, а neR растет. Рто обусловлено ростом эффективности теплообмена со стенкой, уменьшением атомной температуры и увеличением концентрации атомов в разряде. При этом температура электронов должна уменьшаться, а для поддержания неизменности тока разряда их концентрация должна возрасти.
С ростом степени шероховатости будет одновременно изменяться величина oef Однако предыдущий вывод остается в силе, так как коэффициент вторичной электронной эмиссии в силу ухудшения условий выхода электронов с поверхности будет уменьшаться, а, как показано на рис. 2б, параметры T e и nR при этом имеют тенденцию к насыщению. Одновременно существенно расширяется область стабильного горения

Рис. 2. Зависимости Те (---) и nR (___) от a a при o f = 0,8 (а) и от o f при a a =0,9 (б); pR = 0,06 Торсм,
* jR = 50 Асм-1 (1), 100 (2); pR = 0,2, jR = 50 (3), 100 (4)
разряда по току, так как обрыв разряда, обусловленный вытеснением нейтрального газа из капилляра, происходит при больших токах [8].
При данных значениях pR и BR величина nR с ростом jR уменьшается вследствие разогрева нейтрального газа и его вытеснения электронами, а электронная температура растет. Это приводит при некотором критическом значении (jR ) cr к нарушению равновесия между частотой ухода ионов на стенку, неограниченно растущей с ростом электронной температуры
Vw = ( SgjR W+t№ , и частотой ионизации n j e, ограниченной в силу уменьшения naR и насыщения в , и к обрыву разряда. Для расчета (jR ) cr необходимо к рассмотренной системе уравнений добавить условие (djR/ 9 T ) R BR = 0 . На рис. 3 представлены зависимости nR от jR и (jR ) cr от pR в сравнении с экспериментальными данными.
Отметим, что вблизи обрыва разряда возбуждаются плазменные неустойчивости [8], [1], что, по-видимому, приводит к превышению расчетных значений над данными эксперимента.

Рис. 3. Зависимости nR от jR (а) при pR = 0,03 Тор см (1), 0,1(2), 0,4 (3); (—) BR = 0, (—) - 10-2 Тсм-1 , (-■-■-■) - 2 • 10-2; эксперимент: * - pR = 0,03 Тор см, Br = 0; + - 0,4,0; □ - 0,11, 0; ° - 0,38, 0; А - 0,06, 0 [10]. Зависимости (jR) от pR (б) при P = 3 (1), BR = 0,10-2 Тсм, 2 • 10-2; при P = 4, BR = 0 (2). Эксперимент: ° - BR = 0; □ - BR = 0,6 • 10-2 Тсм;
1 х - BR = 1,5 • 10-2 Тсм [8]; А - BR = 1,7 • 10-2 Тсм; ◊ - BR = 0 [1]
ЗАКЛЮЧЕНИЕ
Из приведенных данных следует однозначный вывод: при расчетах параметров плазмы разрядов низкого давления необходимо учитывать процессы на стенках разрядного капилляра. Отметим, что аналогичные явления имеют место в многочисленных исследованиях последнего времени, касающихся пылевой плазмы [15]. Так, при расчете зарядки пылевых частиц необ- ходимо учитывать эмиссию вторичных электронов, ион-электронную и фотоэмиссию. Кроме того, разогрев пылевых частиц при бомбардировке их ионами и последующей рекомбинации с электронами приводит к термоэмиссии электронов. При теоретическом анализе этих процессов также могут быть использованы полученные в данной работе результаты для коэффициентов эмиссии.
Список литературы Влияние процессов на стенках капилляра на параметры плазмы положительного столба разряда низкого давления
- Алферов Г. Н., Донин В. И., Смирнов Г. И. О неустойчивости плазмы ионных лазеров//Квантовая электроника. 1981. Т. 6. № 1. С. 13-19.
- Баранцев Р. Г. Взаимодействие разряженных газов с обтекаемыми поверхностями. М.: Наука, 1975. 343 с.
- Биберман Л. М., Воробьев В. С., Якубов И. Т. Кинетика неравновесной низкотемпературной плазмы. М.: Наука, 1982. 376 с.
- Бронштейн И. М., Фрайман Б. С. Вторичная электронная эмиссия. М.: Наука, 1969. 407 с.
- Елагин В. В., Лукин А. Я., Фотиади А. Э. О влиянии процессов на стенках разрядной трубки ионных лазеров на их выходные характеристики//Труды ЛПИ. 1985. № 412. С. 70-72.
- Захаров П. Н., Пекар Ю. А. О радиальной функции распределения ионов в разряде низкого давления//ЖТФ. 1970. Т. 40. № 8. С. 1664-1668.
- Захарова В. М., Каган Ю. М. О движении ионов и атомов в плазме//Спектроскопия газоразрядной плазмы. Л.: Наука, 1970. С. 291-318.
- Кирсанов А. В., Мольков С. И. Устойчивость существования положительного столба сильноточного разряда низкого давления в продольном магнитном поле//Материалы VI Всесоюзной конференции по физике плазмы. Л., 1983. С. 434-437.
- Мольков С. И. Влияние шероховатости поверхности стенок разрядной камеры на работу газоразрядных лазеров//Лазеры, измерения, информация. СПб.: Изд-во СППУ, 2010. Т. 1. С. 14-25.
- Мольков С. И., Степанов В. А. Расчет параметров плазмы разряда низкого давления с учетом элементарных процессов на поверхности стенок разрядной трубки//Электронная техника. Сер 4. Вып. 4. 1986. С. 15-22.
- Привалов В. Е. О виртуальных катодах в разряде газового лазера//Оптика и спектроскопия. 1994. Т. 77. № 2. С. 307.
- Привалов В. Е., Фридрихов С. А., Шишкин Г. А. Экспериментальное исследование реактивных колебаний в разрядном промежутке He-Ne лазера//Оптика и спектроскопия. 1974. Т. XXXIV. № 5. С. 982-986.
- Райзер Ю. П. Основы современной физики газоразрядных процессов. М.: Наука, 1980. 415 с.
- Фоменко В. С., Подчерняева И. А. Эмиссионные и адсорбционные свойства веществ и материалов. М.: Атомиз-дат, 1975. 147 с.
- Фортов В. Е., Храпак А. Г., Храпак С. А., Молотков В. И., Петров О. Ф. Пылевая плазма//Успехи физических наук. 2004. Т. 174. № 5. С. 494-544.
- Цендин Л. Д. Переход плазмы низкого давления в высокоионизованное состояние//ЖТФ. 1973. Т. 43. № 8. С. 15951602.
- Цендин Л. Д. Нелокальная кинетика электронов в газоразрядной плазме//Успехи физических наук. 2010. Т. 180. № 2. С. 139-164.
- Forrest J. R., Franklin R. N. The Positive Column in a Magnetic Field at Low Pressures: the Transition from Free-Fall to Ambipolar Conditions//British J. Appl. Phys. 1966. Vol. 17. № 12. P. 1569-1574.


