Влияние упругих напряжений на формирование структурных дефектов в полупроводниках
Автор: Логинов Ю.Ю., Мозжерин А.В., Брильков А.В.
Журнал: Сибирский аэрокосмический журнал @vestnik-sibsau
Рубрика: Технологические процессы и материалы
Статья в выпуске: 2 (48), 2013 года.
Бесплатный доступ
Методом просвечивающей электронной микроскопии исследованы закономерности образования структур- ных дефектов в полупроводниках CdTe, HgTe, ZnTe, ZnSe, ZnS, Si и GaAs. Установлено, что при одних и тех же условиях обработки в полупроводниках группы А2В6 образуются дефекты наибольших размеров и с более высо- кой плотностью по сравнению с Si и GaAs. При этом степень нарушений кристаллической решетки и интен-сивность дефектообразования убывает в следующей последовательности: от ZnS → ZnSe ≈ CdS → CdTe ≈≈ HgTe → ZnTe → GaAs ≈ Si. Экспериментальные результаты объясняются на основе анализа упругих напря-жений, создаваемых в материале в результате образования структурных дефектов.
Структурные дефекты, упругие постоянные, электронная микроскопия, полупроводники
Короткий адрес: https://sciup.org/148177059
IDR: 148177059 | УДК: 548.571
Effect of elastic stresses on the formation of structural defects in semiconductors
The structural defects formation in semiconductors CdTe, HgTe, ZnTe, ZnSe, ZnS, Si and GaAs were investigated by method of transmission electron microscopy. It is found that the same processing conditions in semiconductors А2В6 defects are formed with largest dimensions and higher density as compared with Si and GaAs. The degree of crystallattice irregularities and defect formation intensity decreases in the following order of ZnS → ZnSe ≈ CdS → CdTe ≈≈ HgTe → ZnTe to GaAs and Si. The experimental results are explained on the basis of analysis of the elastic stressesin the material generated as a result of the formation of structural defects.
Текст научной статьи Влияние упругих напряжений на формирование структурных дефектов в полупроводниках
Полупроводниковые материалы и приборы широко применяются в космических аппаратах, устройствах электроники, изготовлении солнечных элементов [1]. В процессе выращивания полупроводниковых кристаллов и эпитаксиальных структур, облучения и термообработки в них формируются структурные дефекты, размеры и плотность которых зависят от условий обработки и природы материалов [1; 2]. Методом просвечивающей электронной микроскопии установлено, что при сравнении полупроводников группы А 2 В 6 (CdTe, HgTe, ZnTe, ZnSe, ZnS), кремния и GaAs при идентичных условиях обработки наиболее интенсивное дефектообра-зование наблюдается в полупроводниках А 2 В 6 , а не в Si и GaAs [2]. Легче всего процесс дефектообразования происходит в ZnS и CdS, в которых образуются дефекты с наибольшими размерами и высокой плотностью. Труднее всего процесс дефектообразования происходит в Si и GaAs, в которых наблюдаются дефекты с небольшими размерами и меньшей плотностью.
В данной работе методом просвечивающей электронной микроскопии исследованы полупроводниковые кристаллы CdTe, HgTe, ZnTe, ZnSe, ZnS, Si и GaAs.
На рисунке показаны структурные дефекты, образующиеся в CdTe, выращенном методом металл-органичес-кой парафазовой эпитаксии на монокристаллической подложке GaAs, в результате облучения структуры CdTe/GaAs электронами с энергией 100 кэВ непосредственно в электронном микроскопе. Дефекты представляют собой преимущественно скопления вакансий в виде пор и скопления атомов в форме темных образований. Непосредственно на границе «эпитаксиальный слой – подложка» также формируется переходный слой толщиной А х ® 35 нм, который расширяется с ростом дозы облучения и связан со стоком точечных дефектов на границу раздела. Каких-либо изменений в GaAs не происходит, т. е. GaAs является радиационно-стойким материалом к облучению электронами данной энергией.
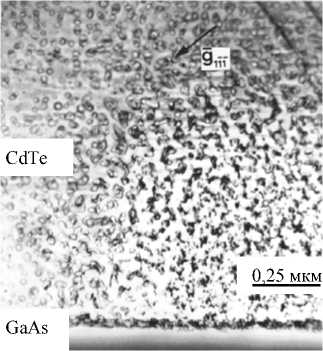
Формирование структурных дефектов в CdTe, выращенном на подложке GaAs, при облучении электронами с энергией 100 кэВ, интенсивностью 4,7∙1018 электрон/(см2·с), потоком 2,5∙1021 электрон/см2
В результате электронно-микроскопических исследований установлено, что степень нарушений в полупроводниках уменьшается от ZnS ^ ZnSe ® CdS ^ ^ CdTe ® HgTe ^ ZnTe ^ GaAs ® Si, что можно объяс- нить увеличением значения энергии дефекта упаковки (ЭДУ) материалов [2]. При этом размеры скоплений вакансий и междоузельных дефектов в виде пор и дислокационных петель больше в CdTe, чем в других исследованных полупроводниках А2В6, и значительно меньше в Si и GaAs при идентичных условиях обработки.
С точки зрения упругих напряжений, создаваемых в материале в результате образования структурных дефектов, можно рассчитать плотность внутренней энергии U , связанной с образованием скоплений точечных дефектов. Зная компоненты тензоров модулей упругости Cijkl и податливости Sijkl , выражение можно записать в общем виде [3]:
U = 2 S ijkiA^ki , (1)
где Ai σ jkl – тензор дисперсии внутренних напряжений, связанных со структурными дефектами. Для кристаллов с кубической симметрией, содержащих скопления вакансий или междоузельных атомов в виде дисков или дислокационных петель, значение U можно вычислить по формуле [3]:
U = | о [ L ( S 11 + 2 S 12 ) + 11 S n + 7 S 44 ] , (2)
о 2 5 b2 <ц)2
где g =----—; здесь 5 - относительный объем,
h2
занятый дислокационными дисками, b – величина вектора Бюргерса, L = 96m2– 64m + 7; здесь
_ 3 m = 2-----------, h - толщина дисков, <к),<ц) - 3< K) + 4<Ц) усредненные значения объемного модуля упругости и модуля сдвига, которые в случае кубической симметрии определяются стандартными выражениями: < к )= 3 (С11 + 2 С12), <ц)= 5 [(С11 - С12 ) + 3С44 ] . (3) Принимая h « b и зная упругие постоянные [3; 4] (табл. 1) можно рассчитать плотность внутренней энергии на единицу относительного объема, занимаемого структурными дефектами, U/δ , например, при 300 К. В табл. 2 приведены расчетные значения U/5 для исследованных материалов. Из табл. 2 видно, что U/5 меньше в CdTe и HgTe, затем несколько выше в ZnTe, ZnS и ZnSe и значительно больше в GaAs и Si. Таким образом, из упругих свойств рассмотренных материалов следует, что в полупроводниках А2В6 энергетически оправданно образование скоплений точечных дефектов с размерами больше, чем в Si и GaAs, а скопления вакансий или междоузельных атомов в виде дисков в CdTe и HgTe могут занимать больший относительный объем, чем в ZnS, ZnTe или ZnSe. Это согласуется с экспериментальными данными, когда при идентичных условиях облучения электронами размеры образующихся скоплений точечных дефектов в CdTe больше, чем в ZnTe, ZnS и ZnSe, и практически равны нулю в Si и GaAs [2]. Таблица 1 Упругие постоянные Сij (1010 Н/м2) и Sij (10–11 м2/Н) соединений А2В6, GaAs и Si Материал (кубич. сист.) C11 C12 C44 S11 S12 S44 CdTe 5,35 3,69 2,02 4,27 –1,74 4,95 HgTe 5,32 3,68 2,08 4,33 –1,77 4,80 ZnTe 7,15 4,08 3,11 2,39 –0,85 3,25 ZnSe 8,50 5,02 4,07 2,11 –0,78 2,46 ZnS 10,10 6,44 4,43 1,97 –0,76 2,26 GaAs 11,80 5,35 5,94 1,175 –0,366 1,68 Si 16,50 6,40 7,92 0,774 –0,216 1,26 Таблица 2 Значения упругих параметров Материал <µ>, 1010н/м2 m L U/δ, 1010Дж/м3 CdTe 4,243 1,544 1,509 129,305 1,46 HgTe 4,23 1,576 1,50 127,0 1,50 ZnTe 5,10 2,48 1,41 107,62 2,527 ZnSe 6,18 3,14 1,394 104,33 3,21 ZnS 7,66 3,39 1,44 113,906 3,40 GaAs 7,50 4,854 1,31 87,91 5,0 Si 9,77 6,77 1,28 82,37 6,95 С ростом температуры размеры скоплений точечных дефектов будут увеличиваться, поскольку численные значения упругих постоянных Cij и Sij при этом уменьшаются [3; 4], а следовательно, уменьшается и величина U/δ. Так, значение U/δ в CdTe составляет 3,42·1010 и 1,42·1010 Дж/м3 при 77 и 300 К соответственно. Это проявляется, в частности, в укрупнении пор, образовавшихся в ZnS, CdTe и CdS в результате электронного облучения, при последующем термоотжиге, что наблюдалось нами ранее [2]. Таким образом, проводя анализ упругих постоянных, можно объяснить обнаруженную закономерность образования структурных дефектов в полупроводниках CdTe, HgTe, ZnTe, ZnSe, ZnS, GaAs и Si.


