Разработка источника ленточных пучков ионов газов для модификации рулонных материалов
Автор: Емлин Даниил Рафаилович, Меньшаков Андрей Игоревич
Рубрика: Контроль и испытания
Статья в выпуске: 33 (292), 2012 года.
Бесплатный доступ
Описаны принцип работы, конструкция и приведены результаты испытаний ленточного источника газовых ионов на основе несамостоятельного газового разряда низкого давления, поддерживаемого эмиссией плазменного катода с сеточной стабилизацией. Источник генерирует пучки ионов газов (N 2, Ar, O 2 и их смесей) в импульсно-периодическом режиме (5-1000 Гц, 0,25-0,5 мс). Поперечное сечение пучка 650x80 мм 2. Энергия ионов регулируется в пределах 15-40 кэВ, средний ток пучка от 0,5 до 200 мА, неоднородность распределения плотности тока вдоль большой оси сечения пучка ±10 %. Источник работает в диапазоне давлений 0,03-0,07 Па, обеспечиваемых паромасляным насосом. Высокая надежность и большой ресурс ионного источника обусловлены использованием в его газоразрядной системе плазменного катода на основе тлеющего разряда.
Тлеющий разряд, плазма, ленточный ионный источник, ионный пучок, модификация поверхности материалов
Короткий адрес: https://sciup.org/147151578
IDR: 147151578 | УДК: 533.9.03,
The development of a source of gaseous ions’ ribbon beams for modification of roll materials
The operating principle, design, and test results of a source of gaseous ions’ ribbon beam are described. The source was based on non-self-sustained gas glow discharge of low pressure supported by emission of grid stabilized plasma cathode. Beams of gaseous ions (N 2, Ar, O 2 and their mixes) were generated in pulse-periodic mode (5-1000 Hz, 0.25-0.5 ms). Beams cross section made 650x80 mm 2. Ions energy was adjusted within the range 15-40 keV, the average beam current being 0.5-200 mА, the heterogeneity of current density distribution along the large axis of beam cross-section being ~10%. The source operated under pressures 0.03-0.07 Ра provided by diffusion pump. High reliability and large resource of the ion source are caused by the use of plasma cathode based on glow discharge in its discharge system.
Текст научной статьи Разработка источника ленточных пучков ионов газов для модификации рулонных материалов
Введение. Полимерные волокнистые композиционные материалы должны обеспечивать высокую прочность, стойкость к динамическим и статическим нагрузкам, вибро- и трещиностой-кость, долговечность и т. д. На современном этапе развития технологий получения таких материалов основным фактором, ограничивающим область их применения, является невысокий уровень адгезионного взаимодействия наполнителя и связующих компонентов [1]. Для повышения взаимодействия между наполнителем и связующим применяют химические и физические методы предварительной обработки армирующего наполнителя. Одним из методов структурной модификации поверхности и увеличения межфазного взаимодействия материалов является ионнолучевая обработка пучками ионов с энергией 10-40 кэВ, которая приводит к распылению граничных слоев материала, изменению химического состава, структурно-фазовым изменениям приповерхностного слоя, а также активизирует поверхностные связи [2-9]:
-
1) обработка полимеров импульсным пучком газовых ионов (1-20 мА/см2, 0,03-1 мс) с флюенсом выше 3•1014 ион/см2 приводит к разрыву части химических связей, появлению свободных радикалов, деполимеризации с выделением мономеров и их фрагментов, а также образованию
сшивок, повышению твердости поверхности за счет карбонизации [7–9]. Повышение плотности тока приводит к росту концентрации дефектов структуры макромолекул, появлению активных молекулярных обрывков и атомов в нейтральном и ионизированном состоянии, повышает локальный разогрев вблизи латентного трека, который влияет на состав и структуру поверхностного слоя полимера, а также усиливает рост карбонизированной фазы [8, 9]. Разрушение химических связей в полимерах носит селективный характер и направлено на деструкцию более слабых связей и трансформацию функциональных химических групп;
-
2) обработка пучком ионов азота (1–3 мА/см2, 30 кэВ, флюенс ~1017 ион/см2) графита и карбоволокна приводит к увеличению угла смачивания жидкой медью с 120 до 133°, глубина проникновения азота достигает 80 нм. При флюенсе ~1018 ион/см2 происходит аморфизация приповерхностного слоя [3, 4, 10, 11];
-
3) при нанесении металлических покрытий на полимеры перемешивание атомов в переходном слое пучком ионов с удельной мощностью 0,4–0,16 Вт/см2 обеспечивает при кратковременном воздействии (~0,25–2 мин) прочность соединения на разрыв 6,5 ГПа даже для таких химически инертных пар материалов, как полиэтилен и медь [5]. Глубина перемешивания достигает 30 нм.
Таким образом, ионное облучение способно оказать определяющее влияние на физико-химические свойства материалов и прочность их адгезионного соединения.
Большие поверхности материалов целесообразно обрабатывать ленточными ионными пучками с близким к однородному распределением плотности тока вдоль длинной оси его поперечного сечения. Скорость перемещения материала в зоне облучения определяется требуемым флюенсом ионного облучения, плотностью тока пучка и допустимой температурой обрабатываемого материала. Трудности создания мощного ионного источника такого класса обусловлены как сложностью генерации однородной плазмы в электродной системе значительной протяженности, так и процессами взаимодействия ускоренных ионов с газом в системе формирования ионного пучка, приводящими к потере мощности пучка и нагреву электродов источника до высоких температур.
В работе приводятся результаты испытаний источника ленточного пучка газовых ионов с поперечным сечением 650×80 мм2, работающего в импульсно-периодическом режиме генерации пучка и предназначенного для обработки больших поверхностей материала в рулонах или листах.
Эксперимент. Опыт разработки технологических ионных источников показал, что низковольтный разряд, поддерживаемый эмиссией плазменного катода с сеточной стабилизацией (СПК), способен генерировать плотную плазму с незначительным содержанием продуктов эрозии электродов при пониженном давлении газа (до 0,01 Па) [12, 13]. При использовании полого катода и анода малого размера осцилляция эмитированных СПК и ускоренных в двойном слое быстрых электронов обеспечивает пространственную однородность генерируемой плазмы независимо от направления инжекции электронов относительно направления извлечения ионов из плазмы даже при малых размерах плазменного катода (доли см2) [12].
Если электроны вводятся в разряд по нормали к направлению извлечения ионов, то отсутствие жесткой связи размеров и формы электронного и ионного плазменных эмиттеров позволяет создавать источники ленточных ионных пучков значительной протяженности (~1 м). Для этого требуется удовлетворить нескольким условиям [14–17]: 1) длина пути быстрых электронов в плазме должна намного превосходить длину плазменного эмиттера ионов; 2) в электродной системе должен быть минимизирован продольный градиент давления газа; 3) следует исключить возникновение пучково-плазменного разряда. Для выполнения последнего условия снижают плотность тока электронного пучка в плазме увеличением площади сетки плазменного катода. Снижение плотности эмитирующей электроны плазмы в СПК приводит к увеличению толщины ионного слоя пространственного заряда между плазмой и поверхностью сетки, что обеспечивает выполнение условия сеточной стабилизации [18] при увеличенном размере отверстий сетки. В результате применения в СПК перфорированных электродов толщиной 2–4 мм с отверстиями диаметром 3–5 мм взамен мелкоструктурной плетеной сетки с ячейкой менее 1 мм ресурс катодного узла увеличивается до нескольких тысяч часов [15].
При испытаниях прототипа ленточного ионного источника в непрерывном режиме генерации пучка [16] было показано, что при достаточно большой длине ускоряющего зазора (до 12 см), которая в соответствии с соотношением Чайлда – Ленгмюра определяется сочетанием плотности тока ионного пучка (0,1–0,3 мА/см2) и величиной ускоряющего напряжения (до 40 кВ), в ускоряющем промежутке в результате процессов перезарядки и ионизации атомов газа ускоренными ионами, сечения которых в используемом диапазоне энергий ионов (25–40 кэВ) имеют порядок ~ 10–15 см2 [17, 19], появляются вторичные заряженные частицы, которые ускоряются в электрическом поле и бомбардируют электроды ионного источника. Следствием этих процессов являются нагрев и значительное линейное расширение протяженных электродов, их коробление и нарушение юстировки отверстий ионной оптики, а также снижение энергетической эффективности источника ионов в целом. Перевод ионного источника из непрерывного режима работы в импульсно-периодический режим (длительность импульса 0,25 и 0,5 мс; 5–1000 Гц) сопровождается увеличением импульсного значения тока пучка при сохранении среднего тока, что позволяет уменьшить длину ускоряющего зазора и снизить тем самым интенсивность процессов взаимодействия ускоренных ионов с атомами газа. При ускоряющем напряжении 40 кВ увеличение плотности тока ионов в импульсе до j~ 1 мА/см2 приводит к сокращению требуемой длины зазора до d = 4 см, что должно привести к примерно трехкратному уменьшению тока вторичных частиц на электроды источника [20].

а)
Рис. 1. Ионный источник: а – схема: 1 – полый катод, 2 – сетка плазменного катода (СПК), 3 – плазменная камера, 4 – стержневой анод, 5, 6 – экранный, ускоряющий электроды ионно-оптической системы, 7 – водоохлаждаемый коллектор; б – конструкция: 1 – корпус, 2 – посадочный фланец, 3 – полый катод, 5 – плазменная камера, 6 – анод, 7 – сетка СПК, 8 – керамический изолятор, 9, 10 – экранный и ускоряющий электроды, 11 – радиатор; в – общий вид

б)

в)
Источник (рис. 1) работает следующим образом: рабочий газ (Ar, N2) напускается в разрядную систему (рис. 1, а) с противоположных торцов. Импульсный тлеющий разряд зажигается между полым катодом 1 и сеткой плазменного катода 2 через отверстие в конической вставке, которая обеспечивает расширение столба разряда в его анодной части до размеров сетки 2. Электроны через сетку плазменного катода 2 поступают в полость плазменной камеры 3. На противоположном от сетки торце камеры установлен стержневой анод 4. Напряжение U2 (50–250 В) между сеткой 2 и стержневым анодом 4 определяет начальную энергию быстрых электронов. Быстрые электроны осциллируют в плазменной камере и ионизуют газ. В результате создается однородная по длине камеры плазма, имеющая потенциал, близкий к потенциалу анода, и отде- ленная от стенок плазменной камеры катодным слоем. Ионный пучок с поперечным сечением 650×80 мм2 формируется двухэлектродной многощелевой ионно-оптической системой 5, 6, электроды которой установлены на боковых поверхностях камеры и корпуса источника ионов. Геометрическая прозрачность ионной оптики составляет 80 %. В испытаниях ионный пучок принимался на водоохлаждаемый коллектор 7. Отрицательный потенциал, приложенный к ускоряющему электроду 6, создает потенциальный барьер, препятствующий поступлению электронов из плазмы, образующейся в пространстве дрейфа ионного пучка, в ускоряющий промежуток системы формирования ионного пучка 5, 6.

Рис. 2. Зависимость тока ионов на коллектор от тока в цепи стержневого анода.
Энергия ионов 15-35 кэВ. Р= 0,04 Па, газ - Ar
Рабочий диапазон изменения давления газа в камере (0,015–0,08 Па) определяется тем, что при уменьшении давления не зажигается самостоятельный тлеющий разряд в электродной системе СПК, а при повышении давления происходит пробой высоковольтного ускоряющего промежутка.
Измерение токов в цепях полого катода 1, стержневого анода 4 позволяет оценивать ток эмиссии ионов из плазмы и среднее число ионизаций n в расчете на один быстрый электрон. В высокоэффективном режиме эмиссии СПК [20] ток тлеющего разряда близок к току эмиссии электронов, а разность тока в цепи стержневого анода и тока эмиссии электронов равна току генерируемых в плазменной камере ионов. Ток тлеющего разряда в цепи полого катода 1 (I1) регулировался в пределах 1–3 А. Ток в цепи стерж- невого анода 4 при этом достигал 3–10 А. Таким образом, в расчете на один быстрый электрон в плазменной камере генерируется n~Iе/(Iа- Iе) ~2–3 иона, где Iе – ток электронов эмитиро- ванных из плазмы самостоятельного тлеющего разряда, Iа – ток в цепи стержневого анода 4.
Поскольку прямые электрические измерения тока пучка на коллектор невозможны из-за наличия пучковой плазмы, ток оценивался калориметрическим методом. Измерение объемного расхода воды через коллектор ( dV/dt ) и разности температур Δ T на входе и выходе коллектора 7 позволяет оценить мощность и ток ионного пучка из соотношения: UHV Ik = ρ ( dV / dt ) C Δ T , где U HV – ускоряющее ионы напряжение , I к – ток на коллектор, С – теплоемкость, ρ – плотность охлаждающей жидкости.
Качественно характер распределения плотности тока вдоль длинной оси поперечного сече- ния пучка определялся с помощью подвижного стержневого зонда, расположенного на расстоянии ~150 мм от ионно-оптической системы.
Конструкция ионного источника.
Электроды газоразрядной системы ионного источника (рис. 1, б) смонтированы внутри цилиндрического корпуса 1 (1300 мм × ∅ 320 мм), который присоединяется к вакуумной камере через переходной патрубок с фланцем 2. На торце корпуса установлен полый катод 3, с выходной апертурой ∅ 10 мм. На другом торце установлена сборка, содержащая плазменную камеру 5 ( h 750 мм, ∅ 150 мм) со стержневым анодом 6 ( h 700 мм, ∅ 4 мм) и сеткой плазменного катода 7, изготовленной из нержавеющей стали ( ∅ 90 мм, h ~2 мм, ~310 отв. ∅ 3 мм). Электроды смонтированы на керамических высоковольтных изоляторах 8, ∅ 110 мм и высотой 80 мм (ОАО «Ваккер», Москва), в полости которых размещены кабельные вводы, а также фторопластовые трубки для подачи газа и дистиллированной воды. Прокачка воды обеспечивает охлаждение зон крепления электродов, защищает от перегрева резиновые уплотнители и расположенные в полости высоковольтных изоляторов полимерные изоляционные элементы.
Экранный электрод 9 ионно-оптической системы образован набором стержней из вольфрама диаметром 2 мм, расположенных в одной плоскости с шагом 10 мм. Способ установки стержней в электроде допускает их свободное линейное расширение при нагреве, что исключает их короб- ление и нарушение юстировки отверстий ионной оптики. Для снижения провисания потенциала в щелях и уменьшения напряжения отсечки вторичных электронов ускоряющий электрод 10 содержит два параллельных ряда таких стержней. Длина ускоряющего зазора - 40 мм. Корпус 1 и посадочный фланец 2 охлаждаются прокачкой воды через радиатор 11. Расположение источника -вертикальное. Внешний вид источника показан на рис. 1, в.
Результаты эксперимента и их обсуждение. Калориметрические измерения показали, что ток пучка ионов в диапазоне энергий 15-35 кэВ прямо пропорционален току в цепи анода несамостоятельного разряда (рис. 2). Линейность зависимости тока пучка от тока разряда свидетельствует о малых потерях пучка на электродах ионной оптики в широком диапазоне энергий ионов и позволяет с точностью до 10 % оценивать ток пучка, измеряя ток в цепи анода ( I к~1/8• 1 а ).
Отношение тока ионов на коллектор к току в цепи высоковольтного источника характеризует эффективность преобразования электрической энергии в энергию ионного пучка. Это от- ношение практически не зависит от тока разряда и тока в цепи источника высокого напряжения Ii (0,1-2 А), но существенно меняется в функции ускоряющего напряжения. На рис. 3 представлена зависимость отношения тока ионного пучка в цепи коллектора, измеренного калориметри- ческим методом, к току источника ускоряющего напряжения Iк/Ii от энергии ионов. Увеличение энергии ионов вызывает снижение тока пучка, поступающего на коллектор, по следующим причинам:
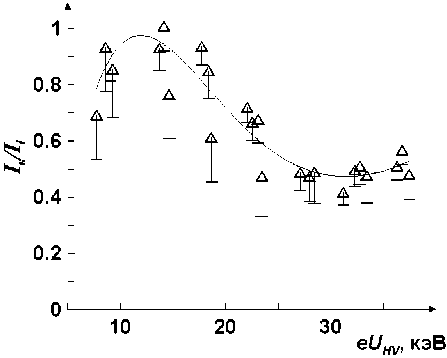
Рис. 3. Зависимость отношения тока ионов на коллектор к полному току в цепи источника питания от энергии ионов. P= 0,04 Па, Ar. I 1 ~ 1,2 – 3 А
-
1) ионизация газа быстрыми ионами в ускоряющем промежутке и возникновение пучков электронов и вторичных ионов. Ускоренные электроны нагревают плазменную камеру 3; вторичные ионы бомбардируют ускоряющий электрод, что приводит к дополнительной эмиссии Y -электронов. Сечение ионизации ионным ударом о для аргона достигает максимума в области 35-45 кэВ [16, 17], которой соответствуют минимальные значения тока в цепи коллектора (рис. 3) . Приращение тока в цепи высоковольтного источника составляет ~(2 + Y 0,5) IkL о n ,
( n - плотность остаточного газа, L - длина ускоряющего зазора, коэффициент ионно-электронной эмиссии y ~ 2 [2], о ~2-10-15 см2 [17, 21]). Вклад этого фактора в снижение мощности пучка, поступающего на коллектор, оказывается самым значимым (~30 %);
-
2) неоптимальные условия формирования импульсного пучка на фронте и спаде импульса тока, длительностью 40-140 мкс, в течение которых переносится от 5 до 20 % от полного заряда в импульсе. Во время изменения плотности эмиссионного тока пучок не фокусируется, поэтому часть ионов попадает на электроды источника. Поскольку с ростом энергии ионов увеличивается коэффициент ионно-электронной эмиссии, то даже при постоянном токе ионных потерь суммарные потери, определяемые с учетом вклада Y -электронов, будут возрастать. Оценка вклада этого фактора в снижение мощности пучка дает ~13 %. Косвенным доказательством правильности проведенной оценки служит увеличение среднего тока ионов на коллектор на ~7 % при уменьшении длительности фронта импульса в ~2 раза или при соответствующем увеличении длитель-
- ности импульса;
-
3) существование потока ионов из пучковой плазмы, поступающих на ускоряющий электрод. Часть эмитированных в результате ионной бомбардировки Y -электронов попадает в ускоряющий промежуток, создавая встречный электронный пучок. С ростом энергии ионов ионизация газа и ток электронов возрастает. Полагая, что на ускоряющий электрод поступает ~1/6 от полного тока ионов из пучковой плазмы и ~50 % Y -электронов попадает в ускоряющий промежуток, можно оценить ток Y -электронов как ~ —Ik — Lоn (о - эффективное сечение ионизации ~2-10-15 см2, 2 6
коэффициент ионно-электронной эмиссии γ ~0,6). Потери мощности в результате действия этого фактора составят 4–10 %;
-
4) перезарядка ионов на атомах остаточного газа в ускоряющем промежутке ( σ ~10 –14 см 2 [19]) и последующая эмиссия γ -электронов в результате бомбардировки ускоряющего электрода вторичными ионами, дает значение потерь ~3–6 %.
В результате использования импульсно-периодического режима генерации ионного пучка уменьшение ускоряющего зазора и, следовательно, т ока вторичных части ц [20] позволило снизить нагрев разрядной системы и корпуса источника в ~1,5–2 раза. Кроме того, в так о м режиме при любом среднем токе пучка изменением частоты повторения импульс о в обеспечивается оптимальная фокусировка пучка без изменения длины ускоряющего промежутка, поскольку импульсная плотность тока пучка остается постоянной.
На рис. 4 приведена экспериментальная зависимость амплитуды максимального то к а пучка на коллекторе от ускоряющего ионы напряжения. При низких энергиях ионов ускоряющий зазор, рассчитанный на энергию 30 кэВ, не пропускает большие плотности ионного тока; а при энергии выше 25 кэВ ток вторичных частиц дополнительно нагружает источник питания, в результате ток пучка ограничен мощностью источника электропитания. В результате, максимальный ток ионов на коллектор (1 А) при длине ускоряющего зазора 4 см достигается в диапазоне энергий 15–25 кэВ.

Рис. 4. Вольт-амперная характеристика источника. 0,5 мс, 100 Гц, I a ~ 3–9 A. P= 0,04 Па, Ar

Рис. 5. Продольное распределение плотности тока ионного пучка: а – односторонний, б – двухсторонний напуск газа. Р= 0,04 Па. Ar
Измерения продольного распределения плотности тока ионов показали, что основным фактором, влияющим на степень неоднородности плаз м ы, является градиент плотности газа, обусловленный прокачкой газа через электродную систему [16, 20]. При двустороннем напуске газа и односторонней инжекции электронов в камеру длиной 800 мм, близкое к однородному распределение достигается на длине ~650 мм. Краевые эффекты, приводящие к снижению плотности ионного тока, проявляются на расстоянии от торцо в камеры ~75 мм. Распределения плотности тока ионов вдоль длинной оси сечения пучка (600×5 0 мм2) приведены на р и с. 5. Локальные неоднородности плотности тока обусловлены структурой ионно-оптической системы и могут быть уменьшены увеличением расстояния от источника до коллектора.
Заключение. Применение несамостоятельного разряда с плазменным катодом и о т бором ионов в направлении, нормальном направлению инжекции электронов, обеспечивает формирование ленточного ионного пучка значительной протяженн о сти с близким к равномерному распределением плотности тока вдоль большой оси сечения пучка.
Эффективность генерации пучка ионов с энерг и ей в несколько десятков кэВ при давлении газа в ускоряющем промежутке 0,025–0,05 Па ограничивается неупругими процессами взаимодействия ионного пучка с газом, влияние которых снижается при испо л ьзовании импульснопериодического режима генерации пучка.
Разработан источник, генерирующий ленточные пучки ионов газов (N 2 , Ar, O 2 и их смесей) в импульсно-периодическом (5–1000 Гц, 0,25–0,5 мс) режиме с импульсным током до 1 А , со средним током до 0,2 А и энергией ионов 15–40 кэВ.
Неравномерность распределения плотности тока вдоль длинной оси сечения пучка ~(650×80 мм2) составляет ± 10 % в диапазоне давлений газов (2,5–5)·10–2 Па.
Высокая надежность и ресурс электродов источника (более 1000) часов обусловлены использованием в плазменном катоде с сеточной стабилизацией тлеющего разряда с холодным катодом и крупноструктурной сетки с размером отверстий 2 мм.
Источник может быть использован для модификации поверхности различных классов материалов: в результате ионной бомбардировки происходят очистка поверхности, активация поверхностных связей и ионно-лучевое перемешивание, что позволяет в несколько раз усилить адгезионные связи между наполнителем и связующим (или подложкой и покрытием). Изменение химического состава и структуры материала ионной имплантацией позволяет повышать твердость (5–50 %), износостойкость (до 2 раз), усталостную прочность и т. д. Результат воздействия зависит от выбора материала, имплантируемой примеси и режимов обработки.
Исследования частично проводились в рамках проекта Областной Программы НИОКР в области нанотехнологий в интересах инновационного развития Свердловской области (2008–2010 гг).
Список литературы Разработка источника ленточных пучков ионов газов для модификации рулонных материалов
- Хаит, Г.И. Исследование прочностных свойств композитов с сильно выраженной неоднородностью/Г.И. Хаит, под ред. Ю.В. Соколкина//Деформирование и разрушение композитов: сб. -Свердловск: УНЦ АН СССР, 1985. -C. 25-28.
- Плешивцев, Н.В. Физика воздействия ионных пучков на материалы/Н.В. Плешивцев, А.И. Бажин. -М.: Вуз. кн., 1998. -392 с.
- Влияние облучения ионами азота на свойства пиролитического графита/Е.А. Лигачева, М.Б. Иванов, Н.В. Гаврилов и др.//Изв. вузов. Порошковые материалы и функциональные покрытия. -2008. -№ 2. -С. 42-45.
- Ion irradiation of carbon fibers/N.V. Gavrilov, A.E. Ligachev, E.A. Ligacheva, D.R. Emlin//6th international conference of modification of materials with particle beams and plasma flows, 23-28.09.2002. -Tomsk, 2002. -P. 351-352.
- Влияние режимов ионного облучения на адгезию медного покрытия к полиэтилену/Н.В. Гаврилов, Д.Р. Емлин, А.В. Кондюрин, В.Н. Мизгулин//Хим. физика и мезоскопия. -1999. -Т. 1, № 1. -C. 48-59.
- Модификация оксидированных Zr-Nb сплавов ионными пучками высокой интенсивности/Т.А. Белых, Н.В. Гаврилов, О.А. Голосов и др.//Физика и химия обработки материалов. -2003. -№ 6. -С. 14-20.
- Structure of Polyethylene After Pulse 1on Beam Treatment/N. Gavrilov, D. Yakusheva, A. Kondyurin et al.//J. Applied Polymer Science. -1998. -Vol. 69. -P. 1071-1077.
- 1on beam modification of polyethylene and adhesion to epoxy adhesive/G.A. Mesyats, Yu.S. Klyachkin, N.V. Gavrilov et al.//Vacuum. -1996. -Vol. 47, № 9. -P. 1085-1087.
- Модификация полимерных пленок ПЭ, ПТФЭ, ПК, ПИ импульсными ионными пучками/Н.В. Гаврилов, В.Н. Мизгулин, Р. Стиннетт, А.В. Кондюрин//Хим. физика и мезоскопия. -1999. -Т. 1, № 1. -C. 39-47.
- Влияние облучения ионами азота на свойства пиролитического графита/М.Б. Иванов, Н.В. Гаврилов, Д.Р. Емлин и др.//Взаимодействие излучений с твердым телом: материалы 7-й междунар. конф., Минск, 26-28 сент. 2007. -Минск: Издат. центр БГУ, 2007. -C. 20-23.
- 1nfluence of ion irradiation on properties of graphite/Е.А. Лигачева, М.Г. Иванов, Н.В. Гаврилов и др.//Изв. вузов. Физика. -2006. -№ 8, Прил. -C. 316-317.
- Несамостоятельный тлеющий разряд с полым катодом для широкоапертурных ионных источников/А.В. Визирь, Е.М. Окс, П.М. Щанин, Г.Ю. Юшков//ЖТФ. -1997. -Т. 67, № 6. -С. 27-31.
- Гаврилов, Н.В. Характеристики ионного источника с плазменным катодом и многополюсной магнитной системой удержания быстрых электронов/Н.В. Гаврилов, А.С. Каменецких//ДАН. Сер. физ. -2004. -Т. 394, № 2. -С. 183-186.
- Незлин, М.В. Динамика пучков в плазме/М.В. Незлин. -М.: Энергоиздат, 1982. -218 с.
- Гаврилов, Н.В. Расширение рабочего диапазона давлений газа и увеличение ресурса сетки плазменного катода в ионном источнике/Н.В. Гаврилов, А.С. Каменецких//ЖТФ. -2007. -Т. 77. -Вып. 3. -С. 12-16.
- Источник ленточного пучка ионов газов/Н.В. Гаврилов, Д.Р. Емлин, О.А. Буреев и др.//Труды 111 Междунар. семинара «Плазменная эмиссионная электроника». -Улан-Удэ: Изд-во БНЦ CO РАН, 2009. -С. 92-99.
- Gilbody, H.B. 1onization by positive ions/H.B. Gilbody, J.B. Hasted//Proc. Roy. Soc. (London). Series A, Math. and Phys. Sciences. -1957. -Vol. 240. -1ss. 1222. -P. 382-395.
- Гаврилов, Н.В. Стабилизация сеточно-плазменного катода в широком диапазоне давлений газа/Н.В. Гаврилов, Д.Р. Емлин, А.С. Каменецких//Изв. вузов. Физика. -2007. -№ 10/2. -С. 154-160.
- Майоров, С.А. Расчет сечений резонансной перезарядки ионов гелия, неона, аргона, криптона, ксенона, рубидия, цезия и ртути/С. А. Майоров//Труды XXXIV Междунар. конф. по физике плазмы и УТС, 12-16 февр. 2007 г. -Звенигород, 2007.
- Формирование ленточного эмиттера ионов в импульсном разряде с плазменным катодом/Н.В. Гаврилов, Д.Р. Емлин, А.С. Каменецких, А.И. Меньшаков//Изв. вузов. Физика. -2009. -Т. 52, № 11/2. -С. 85-90.
- Proton and helium stopping cross sections in H2, He, N2, O2, Ne, Ar, Kr, Xe, CH4 and CO2/G. Reiter, N. Kniest, E. Pfaff, G. Clausnitzer//Nucl. 1nstrum. Methods Phys. Res. -1990. -Sect. B 44. -P. 399-411.


